基于范德华异质结的多功能场效应晶体管制备及性能研究
2023-09-07胡永康许易龙郝俊王瑞洲朱金龙毛彩霞薛丽胡永红
胡永康,许易龙,郝俊,王瑞洲,朱金龙,毛彩霞,薛丽,胡永红
(1.湖北科技学院核技术与化学生物学院, 湖北 咸宁 437100;2.湖北科技学院电子与信息工程学院, 湖北 咸宁 437100)
0 引言
二维(2D)材料的兴起为电子器件设计带来了全新的机遇[1]. 2D材料具有各种电子特性,例如六方氮化硼(h-BN)具有绝缘体性质,石墨烯具有半金属性,而二硫化钼(MoS2)具有半导体性质[2]. 其平坦性和超薄的几何结构特点与目前的硅加工技术兼容.且不同的2D材料可以通过弱vdW相互作用垂直组装,形成范德华斯(vdW)异质结构,而不受晶格失配的限制. 因而可以结合各种2D材料的不同特性,并在器件设计中灵活运用[3].目前,已有一系列基于2D vdW异质结的新型器件见诸报道,例如石墨烯/氮化硼共振隧道二极管[4-5],由黑磷(BP)/Al2O3/BP制成的隧道场效应晶体管[6],以及基于MoSe2/WSe2的多结横向异质结构[7-9].石墨烯/氮化硼/石墨烯异质结构具有超快遂穿载流子渡越时间和室温负微分电导,在高频和逻辑器件方面有潜在应用[4].(BP)/Al2O3/BP范德华异质结隧道场效应晶体管具有临界输运条件的电场可调特性、遂穿载流子对驱动电流的有效静电调控特性,以及宽温度范围内的瞬时切换特性[6].通过顺序边缘外延法合成的MoSe2/WSe2横向异质结构具有更多的柔性特点,在柔性光电器件等方面大有优势[7]. 然而,逻辑操作和数据存储功能相结合的多功能设备的相关研究报道少见.
这里报道一种由石墨烯、六方氮化硼和二硫化钼异质结制成的半浮栅(HFG)控制的场效应晶体管.它可以在单个器件中实现和调制三种不同的功能,包括金属氧化物半导体场效应管(MOSFET)、非易失性存储器和二极管.作为逻辑MOSFET,它的开/关比为105,作为二极管,它的整流比为103,作为非易失性存储器,它的有效期为10年.因此这种异质结材料具有优异的性能,它可能在电子和光电子学器件中具有潜在应用前景,例如存储器、光伏、光电探测器、逻辑整流器和逻辑光电电路等.
1 实验部分
1.1 二维材料的制备机械剥离法是制备单层或者少层二维晶体薄膜的主要方法之一. 这种制备工艺属于“自上而下”法,因为二维晶体材料层间依靠微弱的范德华力相互结合而成,因此通过外部的作用力可以将体块状的二维晶体材料解离成少层或者单层的薄膜. 以石墨烯的剥离为例,原料为高定向热解石墨. 利用Scotch透明胶带从体块的石墨片上剥离出薄片,并多次对折胶带来减薄石墨片的厚度,然后将粘有材料的胶带充分贴合在衬底上. 由于二维晶体材料的表面和衬底(SiO2等)之间的结合力要大于二维晶体材料层间的范德华力,随着胶带和衬底分离,部分薄层二维晶体材料会黏附在衬底上. 在光学显微镜下可以清晰的观察到300 nm SiO2/p++Si衬底上不同厚度的石墨烯.
1.2 MoS2/BN/Graphene异质结的制备首先,通过胶带法进行机械剥离,在带有300 nm SiO2/p++掺杂的Si衬底上得到石墨烯薄片(4.4 nm). 然后,在N-甲基吡咯烷酮(NMP)和丙酮中清洗以去除有机残留物. 将h-BN薄片剥离到聚二甲基硅氧烷(PDMS)薄膜上,并进行选择. 在光学显微镜下,将所需的h-BN薄片(20~30 nm)转移到石墨烯薄片的顶部,并进行精确对准,形成原子级锋利的h-BN/石墨烯异质结构. 类似地,h-BN/石墨烯异质结也在NMP和丙酮中清洗以去除有机残留物. 然后将h-BN/石墨烯异质结在250 ℃的N2/Ar中退火30 min,去除在转移过程中产生的少量气泡.接下来,在PDMS上剥离几层MoS2薄片(2~5 nm),并在光学显微镜下以精确的对准转移到hBN/石墨烯异质结的顶部,形成MoS2/h-BN/石墨烯异质结. 之后在NMP和丙酮中清洗,并在250 ℃的N2/Ar中退火30 min.
1.3 浮栅晶体管的制备采用紫外光刻工艺以及电子束金属蒸镀工艺制备合适的金属电极. 工艺流程:第一,在带有坐标的方形衬底上完成二维晶体材料或者二维异质结的制备;第二,旋涂光刻胶,预先旋涂光刻胶LOR-10A作为剥离层,并在150 ℃烘箱中烘烤1 h,接着旋涂紫外光刻胶薄胶S1813作为曝光层,烘烤13 min;第三,借助紫外无掩模光刻设备完成异质结套刻标记的对准、曝光,随之进行显影和氮气吹干;第四,采用电子束蒸镀工艺,在接触区域沉积50 nm厚的Ag作为接触电极;第五,完成金属沉积后,在NMP以及丙酮溶液中进行剥离和清洗,随之氮气吹干,即完成了整个器件的加工和制备.
1.4 电学测试对二维晶体材料器件进行的主要电学特性测试,所使用的设备包括低温探针台和半导体参数仪. 其中探针台同时集成了20倍的显微成像系统,以及三轴位移平台,可以方便的调节测试探针与接触电极的位置. 由于二维晶体材料超薄的特性,空气中的活性气体分子很容易影响器件的测试,因此,在测试过程中需要使用N2清洗测试腔室,具体步骤如下:第一,放入样品后,密封腔室,开启机械泵;开始抽真空;第二,待真空至2×10-2torr时,关闭机械泵,打开阀门,通入N2;第三,重复上述步骤一和二,总计3次. 完成腔室清洗后,校正测试设备,开始测试.
1.5 主要实验设备材料结构表征和电学性质测量设备及型号参数:拉曼光谱(Horiba Raman spectrometer)、原子力显微镜(Primaries FS 380parameter)、电特性表征(Lakeshore CRX-4K cryogenic,300K).
2 结果与讨论
2.1 结构分析图1(a)展示了基于二硫化钼/六方氮化硼/石墨烯的半浮栅场效应晶体管(HFG场效应晶体管)器件的配置.MoS2用作沟道材料,而h-BN和石墨烯分别用作隧道层和浮栅.只有部分二硫化钼薄片排列在石墨烯薄片上,形成HFG-场效应晶体管器件结构.图1(b)显示了典型二硫化钼/六方氮化硼/石墨烯结构的光学显微镜图像.拉曼光谱证实了其2 D异质结构.该异质结构中的二硫化钼、六方氮化硼和石墨烯区域分别用紫色、蓝色和红色实线标出.比例尺为20 μm.在图1(b)中分别用紫色、蓝色和红色虚线标记的位置测量二硫化钼、六方氮化硼和石墨烯片的厚度分布.在图1(c)是二硫化钼/六方氮化硼/石墨烯异质结构的拉曼光谱表征.五条拉曼谱线是在所示异质结构的5个不同点获得的.拉曼光谱分别显示出二硫化钼(在387.6 cm-1和407.8 cm-1处有两个峰)、h-BN(在1 366 cm-1处有一个峰)和少层石墨烯(在1 580.6 cm-1和2 721 cm-1处有两个峰)的特征[10-12].在图1(d)中,原子力显微镜显示二硫化钼、六方氮化硼和石墨烯薄片的厚度分别为2.4 nm、30 nm和4.4 nm.
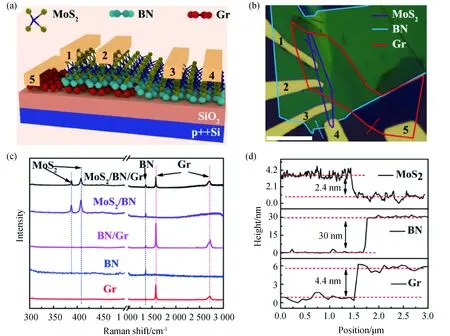
图1 HFG场效应晶体管的二硫化钼/六方氮化硼/石墨烯范德华异质结构及性能表征(a)基于二硫化钼/六方氮化硼/石墨烯的半浮栅场效应晶体管结构图;(b)典型制造器件的光学图像;(c)异质结构的拉曼光谱表征;(d)原子力显微镜显示的各材料薄片的厚度
在这个基于2D范德瓦尔斯异质结构的HFG场效应晶体管器件中,一个场效应晶体管、一个非易失性存储器和一个二极管集成到一个器件中(见图2).MOSFET(器件A)在图2(a)中用黑色虚线矩形标出,其中二硫化钼、六方氮化硼、石墨烯片分别形成器件沟道、电介质材料和栅极.电极1和2形成源极和漏极,电极5用作栅极.浮栅非易失性存储器(器件B)在图2(a)中用蓝色虚线矩形标记,其中高掺杂p型硅衬底用作控制栅电极,而二硫化钼、六方氮化硼和石墨烯片分别用作沟道层、隧道层和俘获层.在这种情况下,电极1和2仍然用作源极和漏极.二极管(器件C)在图2(a)中用紫色虚线矩形标出.在该器件中,只有一半的二硫化钼在石墨烯片上排列,形成半浮栅器件结构,其中二硫化钼作为传输通道,石墨烯是半浮栅,硅衬底是控制栅.电极2和3用作源极和漏极.图2(b、c和d)分别显示了集成MOSFET、存储器和二极管器件的电路元件符号和电子特性曲线.
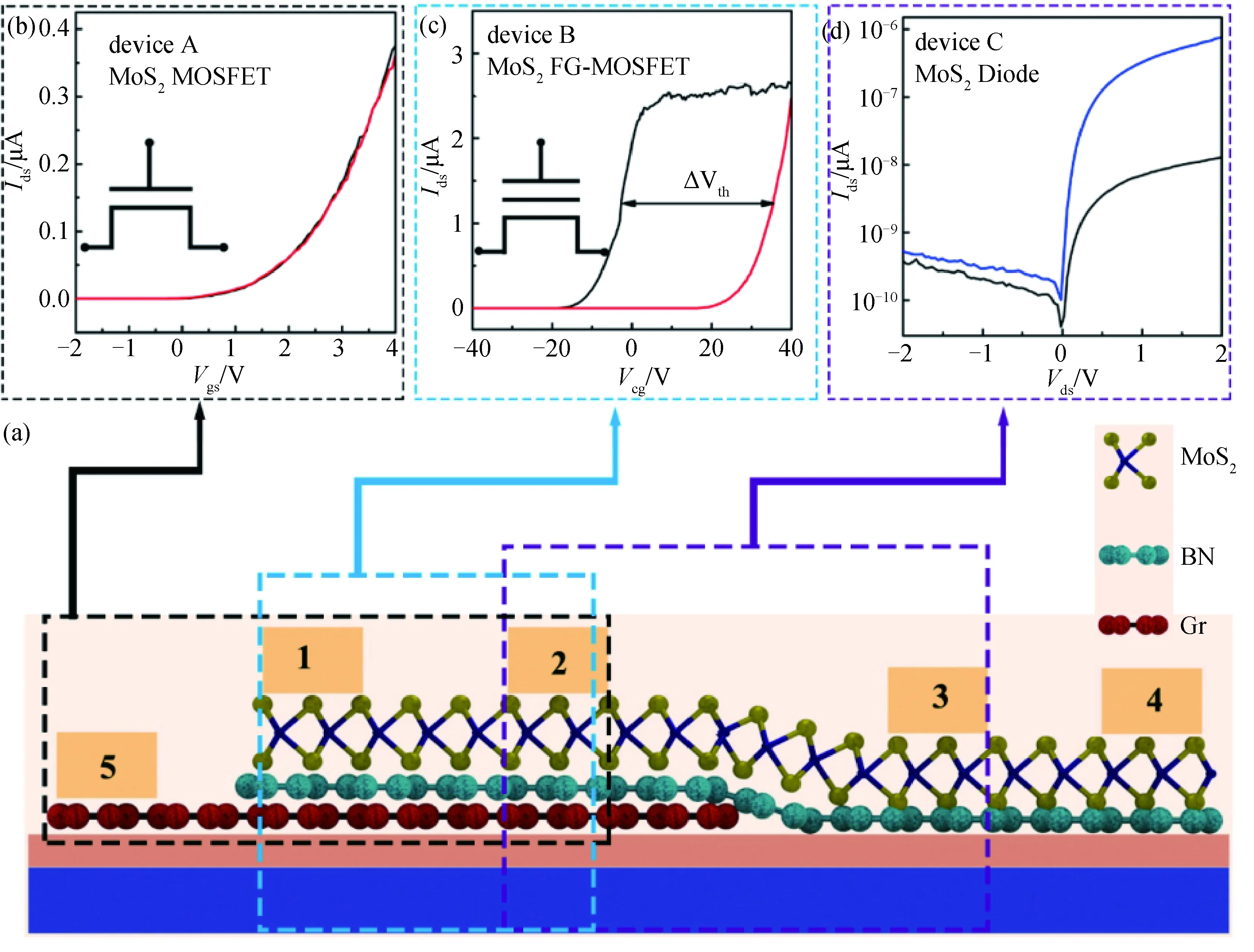
图2 HFG场效应晶体管的结构及性能测试(a)二硫化钼/氮化硼/石墨烯范德瓦尔斯异质结的结构,(b)器件中二硫化钼场效应管的Ids-Vgs曲线,(c)器件中二硫化钼半浮栅场效应管的Ids-Vcg曲线,(d)器件中不同控制栅压下二硫化钼二极管的Ids-Vds曲线
2.2 电子特性和工作机制首先研究场效应晶体管的电子特性.向石墨烯薄片施加电压Vg,石墨烯薄片通过30 nm纳米厚的h-BN薄片与二硫化钼分离,同时保持基底接地.图3(a)显示了器件A的Ids-Vds特性.Ids与Vds的线性关系表明二硫化钼薄片和金属电极之间有良好的欧姆接触.根据图3(b)所示的传输特性,可以由公式(1)得出15 cm2V-1s-1的低场场效应迁移率:
(1)
其中,L=5.5 μm为沟道长度,W=1.6 μm为沟道宽度,Ci=1.03 ×10-3F/m2为单位面积沟道与背栅之间的电容.请注意,该值代表载流子迁移率的最低限制,因为接触电阻被忽略.图3(b)中的绿线是栅极泄漏电流(Ig),比Idsat关闭状态小一个数量级,比Idsat开启状态小5个数量级.这意味着30 nm厚的六方氮化硼层具有优异的电绝缘性能.该器件的迁移率为15 cm2·V-1·s-1,电流开/关比为105,在漏极-源极偏置(Vds)为+2V时的非稳态电流密度为0.25 μA/μm.

图3 HFG场效应晶体管的二硫化钼/六方化硼/石墨烯范德瓦尔斯异质结构中场效应晶体管的表征结果(a)不同栅源电压下的Ids-Vds曲线;(b) 不同漏源电压下的Ids-Vgs曲线,绿色曲线是2 V偏置电压下栅极漏电流
其次,研究浮栅存储器(器件B)的电子特性.这种基于2 D异质结构的存储器的工作机制如图4所示.图4(f)显示了二硫化钼/六方氮化硼/石墨烯异质结构的平坦能带图.少层石墨烯的功函数为4.6 eV[11].2 D二硫化钼的电子亲和势为4.0 eV,带隙在1.2至1.8 eV之间变化,取决于层数[13-14].而绝缘体h-BN的电子亲和势较小(2.0 ~ 2.3 eV),带隙较大(5.2 ~ 5.9 eV)[13].它可以在石墨烯和二氧化硅之间产生巨大的潜在障碍.如图4(a)所示,当在硅衬底上施加正电压时,电子聚集在硅衬底2中.同时,石墨烯和二硫化钼之间形成正电势,使得积累的电子从二硫化钼隧穿到浮动栅极石墨烯(见图4(a)和图4(e)).一旦从硅衬底上移除正电压(见图4(b)),二硫化钼中的电子将消失.然而,由于六方氮化硼和二氧化硅之间的势垒,隧穿的电子仍然被捕获在石墨烯层中.没有电子可以通过源极到漏极,器件被切换到关闭状态.这是非易失性存储器的编程过程.相应地,在负栅极电压的作用下,电子将从半浮栅中被提取出来(见图4(c)和4(g)).二硫化钼中的载流子浓度将被设置回原始基线水平(见图4(d)),器件切换至开启状态.这是非易失性存储器的擦除过程.
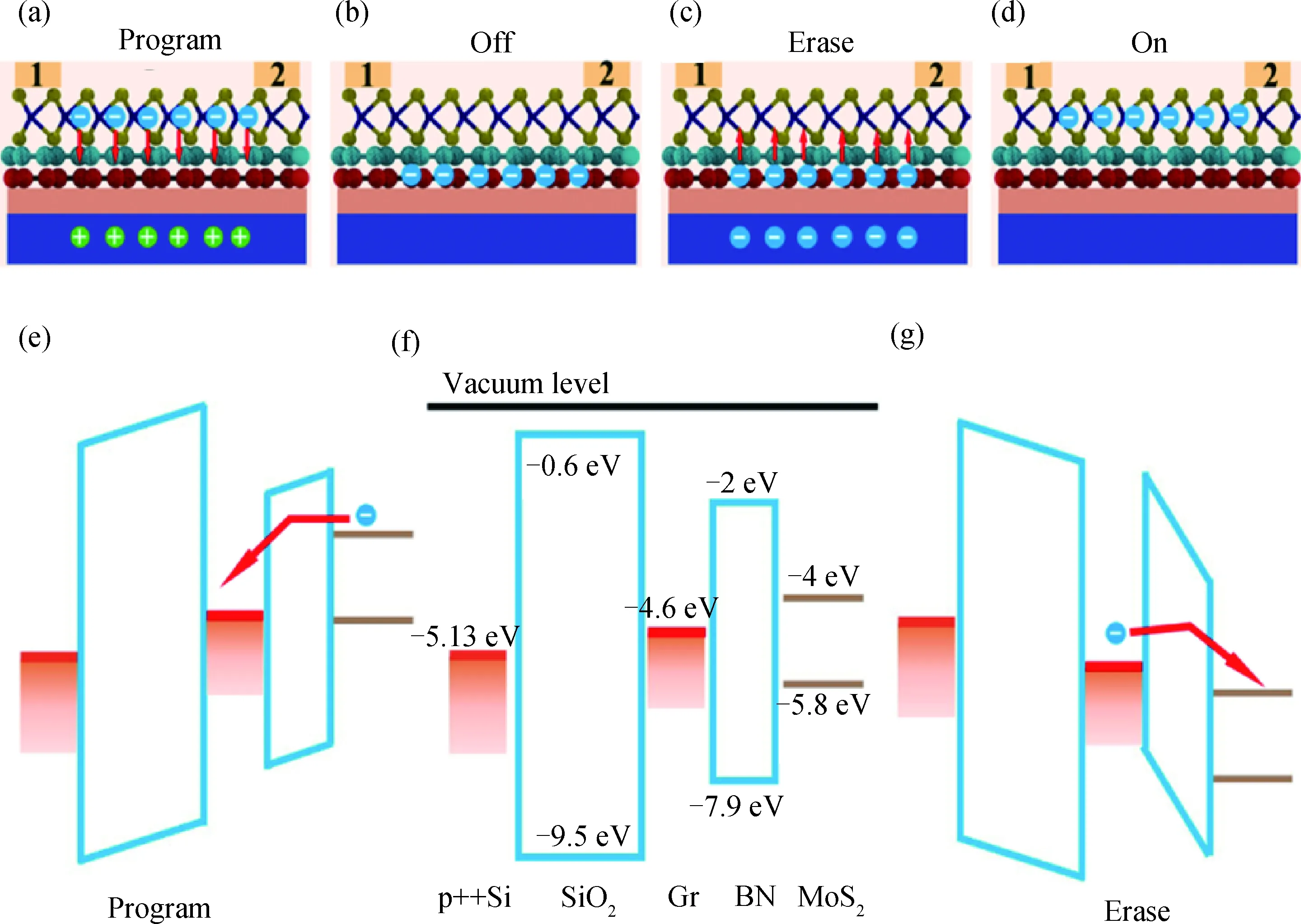
图4 基于2D异质结构的浮栅存储器工作机制的简化能带图(a)正栅压下器件的电荷掺杂态;(b)移除正栅压后器件的电荷掺杂态;(c)负栅压下从石墨烯中提取电荷;(d)移除负栅压后器件的电荷掺杂态;(e)正栅压下平能带图;(f)组合前构成异质结的不同材料的能带图;(g)负栅压下平能带图
我们测量了器件B的传输特性,结果如图5(a)所示.在这项研究中,漏极-源极电流在恒定的漏极-源极电压(Vds= 1 V)下测量,施加在硅衬底上的背栅电压在40 V范围内扫描.存储行为表现为晶体管阈值电压(Vth)的偏移,该偏移由电荷俘获层中存储的电荷量控制.存储器阈值电压的总偏移给出了35 V的估计存储器窗口.这里,我们可以使用等式(2)来估计存储在石墨烯浮栅中的电荷密度.
(2)
其中q为电子电荷,ΔV为阈值电压偏移.Ccg-fg是硅控制栅和石墨烯浮栅之间的电容,由等式(3)和(4)计算[15]:
(3)
(4)
二氧化硅、石墨烯和氮化硼的εr值分别为3.9、5.6和3.5[14].我们可以得到存储电荷的密度约为2.2×1012cm2.
当恒定电压施加于栅极时,测量漏极-源极电流(Ids)与Vds的关系(如图5(b)所示).设备B的存储状态可以通过以恒定的Vds测量Ids来读出.结果表明,存储器件B的开和关状态可以用Vcg来切换.在导通状态下,Ids相对于Vds的线性行为表明器件沟道和金属电极之间的接触类似欧姆接触.我们进一步研究了对数据存储至关重要的非易失性存储器件B的编程/擦除状态的保持特性.如图5(c)所示,通过脉冲宽度为100 ms的+40 V/-40 V电压脉冲,器件在OFF(ON)状态下被编程(擦除).在20 s的连续测量期间,器件B保持超过103的开关比,其中开状态电流呈现可忽略的变化,而关状态电流从10-13A变化到10-11A.这些结果证明存储器件B具有高度可靠的保持特性.我们还研究了器件B在编程和擦除状态之间的动态切换行为,如图5(d)所示.编程状态和擦除状态之间的切换是通过在1 ms内向控制栅极提供40 V的周期性正负电压脉冲来实现的,同时将Vds设置为+50 mV.设备B最初处于低电流状态,对应于关闭(编程)状态.然后,当负电压脉冲(-40 V,100 ms)施加到控制栅极时,器件B被设置为导通(擦除)状态,保持稳定的高电流0.06 μA.当控制栅极电压被重置为0 V时,器件仍工作在导通状态.在控制栅极上施加对称正脉冲(+40 V,1 ms)后,器件B恢复到初始关断状态(10-11A).这里,我们使用传统的存储器方法来估计器件B中俘获电荷的保留.阈值电压取决于器件中的俘获电荷.这意味着我们可以根据阈值电压的变化来估计俘获电荷的保留.在图5(e)中,转移曲线是通过在0 V至+5 V的相对较窄范围内扫描Vcg来获得的,以防止石墨烯浮栅处所需的电子耗尽或注入.如图5(f)所示,104 s后,提取的阈值电压从2.2 V降至1.8 V,几乎与时间呈指数关系.因此,我们可以估计36.4%的俘获电荷将在10年后消失.这一结果证明,石墨烯的电荷泄漏相当缓慢,可以以年为单位进行测量,表明异质结构中的器件B是非挥发性存储器应用的有前途的候选器件.

图5 HFG场效应晶体管二硫化钼/氮化硼/石墨烯范德瓦尔斯异质结构中非易失性存储器特性的表征(a)半浮栅场效应管的Ids-Vcg曲线;(b)开和关状态下半浮栅场效应管的Ids-Vds曲线;(c)编程和擦除状态下半浮栅场效应管的保留特性;(d)动力学切换行为;(e)不同时间间隔的Ids-Vcg曲线;(f)编程脉冲后Vth的时间分辨演化
最后,研究器件C的整流特性.操控硅控制栅极以控制石墨烯薄片中捕获的电子数量,并在二硫化钼沟道的右侧部分和与石墨烯重叠的左侧部分之间引入势垒.如图6(a)所示,当在硅衬底上施加正电压时,由于场效应,电子聚集在硅衬底中.同时,石墨烯和二硫化钼之间的正电势将使积累的电子从二硫化钼光子隧穿.六方氮化硼和二氧化硅的巨大势垒可以有效地将这些电子捕获在石墨烯层中.这些被俘获的电子可以屏蔽控制栅的正电势,降低与石墨烯层重叠的二硫化钼左边部分的电荷浓度.2D MoS2表现出单极性特性(见图3(b)).由于费米能级钉扎效应,编程后MoS2左侧部分仍为n型掺杂,但电荷载流子浓度大幅降低.通过这种方式,沿着MoS2通道创建了一个n+-n结.图6(a)显示了当二硫化钼弯曲到石墨烯边缘时,所产生的n+注入的可能能带结构.图6(b)显示了在硅控制栅极上施加+10 V~+40 V电压时的Ids-Vds曲线.它表现出明显的整流特性,整流比超过103(Vds=±2 V).跨越n+-n个二极管的电输运可以由修正的肖克利方程(5)表示:
(5)
其中VT=kBT/e是温度T时的热电压,kB、e、I0、W和n分别是玻尔兹曼常数、电子电荷、反向饱和电流、朗伯W函数和理想因子.RS是串联电阻.通过用方程拟合Ids-Vds曲线,我们发现n+-n结的n=1.45,I0=4×10-10A,RS=1.1 MΩ,可以通过改变电压进一步调制.理想因子的值通常表示二极管的传输机制.如果n=1,扩散机制将在二极管中发挥重要作用.当n=2时,它由一个重组过程支配.HFG场效应管中二极管的较大理想因子(1.45~ 1.75)表明输运受复合过程控制[16].由于材料生长和器件制造的非理想过程,二硫化钼表面经常存在高密度的陷阱态.这些陷阱态可以作为复合中心[17].与图3(b)中器件B的Ids-Vds曲线相比,没有HFG结构的MoS2器件的Ids-Vds曲线的线性行为没有表现出整流特性.图6(c)显示了反向Vds=-2 V和正向Vds=+2V时n+-n结的动态性能.结果表明,通过施加不同的电压,器件可以很好地在开和关状态之间切换.
3 结论
本研究设计并制作了一种基于范德瓦尔斯集成MoS2/h-BN/石墨烯异质结构的多功能半浮栅控制场效应晶体管. MOSFET、非易失性存储器和二极管功能在这种单一器件配置中同时成功实现. 作为经典的MOSFET,该器件可用于逻辑运算. 作为一个非挥发性记忆,它可以保留10年,开/关比为103. 作为一个n+-n二极管,它表现出良好的整流性能,整流比高达103,这个值可以通过不同的Vcg进一步调制. 我们的多功能场效应晶体管可以在逻辑运算、数据存储、整流器开关等方面找到潜在的应用.
