金锡镀层在CSP 气密封装中的应用及其可靠性
2023-12-19李亚飞王宇翔籍晓亮温桎茹米佳汪红兵郭福
李亚飞,王宇翔,籍晓亮,温桎茹,米佳,汪红兵,郭福
(1.中国电子科技集团公司第二十六研究所,重庆,404100;2.北京工业大学,材料科学与工程学院,北京,10024)
0 序言
随着电子器件的可靠性要求越来越高,微小尺寸器件的气密性封装技术被越来越广泛的研究和应用[1-2].目前微小尺寸器件的封装形式主要采用芯片级尺寸封装(chip scale packaging,CSP)[3],在CSP 器件的气密性封装结构中,使用高温共烧陶瓷作为载体或基板,而管帽则由金属材料制成,从而实现对内部芯片的有效保护[4].Au-Sn 共晶焊料由于具有优异的焊接性能和力学性能[5],成为CSP 器件封装系统内实现金属管帽与陶瓷基板之间气密性可靠互连的首选材料[6].
Au80Sn20 共晶钎料的熔点为278 ℃,钎焊温度达到了300~ 310 ℃,可以替代熔点在280~360 ℃内的高熔点铅基合金钎料,并且能够承受较高的处理温度,保证良好的耐腐蚀性和抗蠕变性.Au80Sn20 共晶合金由两种金属间化合物ζ 相和δ/AuSn 相组成,具有较大脆性,用常规的方法难以加工成形[7].常用的制备技术有预成形片法[8]、丝网印刷法[9]、蒸发/溅射沉积法[10]和电镀沉积法[11-12]等.
预成形焊片法采用熔铸增韧工艺、叠层冷轧工艺或机械合金化工艺制备Au-Sn 共晶焊料,但是合金成形困难,加工过程易氧化;丝网印刷法是将焊膏印刷在封装焊盘的金属化层上,通过回流熔融形成Au-Sn 共晶合金,这种方法对印刷质量要求较高,回流时易形成空洞;蒸发/溅射沉积法通过分层沉积不同厚度的金层与锡层(或Au-Sn 混合层),这种方法需要使用真空系统,存在设备昂贵、加工周期长、材料利用率低等问题,不适合大规模生产;电镀沉积法利用电化学方法将Au 和Sn 离子在基体表面实现沉积,可以精确控制镀层的厚度及图形,具有设备简单、成本低廉、工艺成熟、易于大规模生产等优势.
采用电镀沉积法在陶瓷基板上制作了金锡镀层,并对镀层质量进行了表征分析,通过熔封曲线的调控实现了CSP 器件的气密性封装,对金锡焊料的工程应用、工艺优化及封装结构可靠性具有重要意义.
1 试验方法
与其它方法相比,金锡分层电镀沉积法可控性强,能够精确控制Au 和Sn 元素成分比例,因此采用电镀沉积方法在高温共烧陶瓷(HTCC)基板上制备了金属层,层结构如图1 所示,其中W 层作为陶瓷基板上的黏附层,Ni-Co 则起到了扩散阻挡层和浸润层的作用.通过分层电镀沉积不同厚度的金层与锡层,组成Au80Sn20(质量分数,%)共晶钎料,为了实现该比例,控制金层和锡层的厚度比为1.5∶1.金/锡/金共晶焊料层总厚度设计为12 μm,另外Au 元素和Ni 元素之间无限互溶,进一步加强了镀层之间的浸润,表层的金则起到了抗氧化的作用.
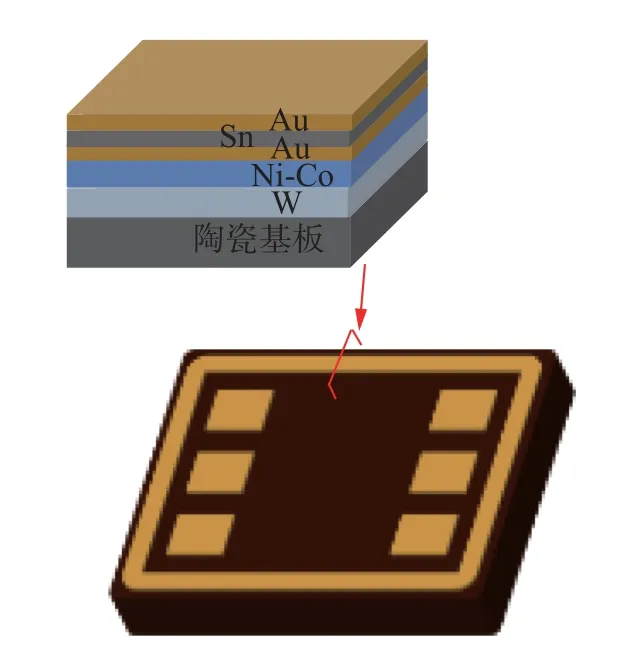
图1 CSP 封装系统的镀层结构Fig.1 Structure of electroplated lay in CSP packaging system
为了评估金/锡/金镀层质量对互连界面的影响,分别选取两种镀层的基板进行金相表征和显微组织分析,显微组织分析采用FEI 公司的环境扫描电子显微镜(scanning electron microscopy,SEM,Quanta 200),并利用其附带的EDAX 能谱仪进行界面显微元素分析.
为了研究Au-Sn 合金镀层质量对熔封效果的影响,将电镀后的高温共烧陶瓷基板置于320 ℃加热台回流30 s,对金/锡/金镀层的表面状态和横截面进行观察,确认Au-Sn 镀层质量.此处CSP 器件封装管帽采用可伐合金材料冲压而成,其与基板的熔封在真空回流炉中实现,先抽真空,后充入高纯氮气,以使炉腔均匀快速升温,封装回流曲线如图2 所示.焊接工艺设置了预热阶段,预热至120 ℃并保持60 s,然后继续升温至310 ℃,保温90 s 后空冷至室温.

图2 管帽封装回流曲线Fig.2 Soldering curve used for cap packaging
回流完成后,对管帽与陶瓷基板的互连界面进行显微组织分析,同时对封装好的器件进行加压检漏和热循环试验,试验条件为-55~ 85 ℃.采用SEM 表征热循环之后互连界面的微观组织变化,进而评估金和锡镀层对管帽封装热循环可靠性影响.
2 试验结果
2.1 陶瓷基板金属镀层的显微组织
图3 为电镀完成后陶瓷基板表面的金属镀层显微形貌.图3a 为镀层质量差的陶瓷基板表面,由图可以看出,金/锡/金镀层质量差主要体现为①两侧金镀层厚度差距大,上侧金镀层较薄,仅有~ 2 μm,而下侧金镀层较厚,厚度为~ 6 μm;②下侧金层出现了孔洞,而且孔洞出现在金层和锡层之间,这说明金/锡/金镀层的层间结合力差.与之相比,图3b 显示的陶瓷基板上侧金/锡/金镀层的质量优良,两侧金镀层厚度差较小,上侧金镀层约为~ 3 μm,下侧金镀层厚度约为~ 4 μm,而且镀层的界面处未发现孔洞.
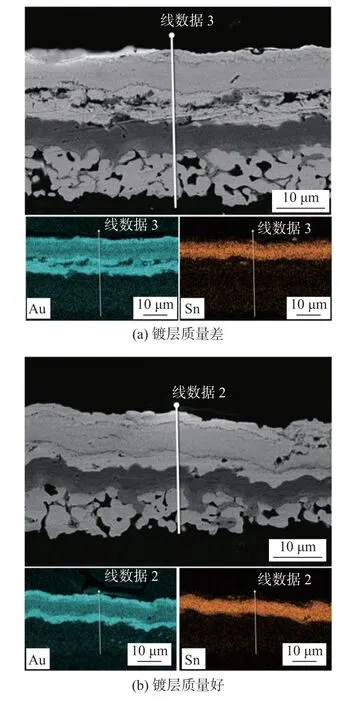
图3 电镀后陶瓷基板上金属层界面显微组织和元素分布Fig.3 Microstructures of electroplated metallic layer and elemental distribution maps on the surface of HTCC.(a) poor electroplated layers;(b) good electroplated layers
2.2 陶瓷基板金属镀层熔融后的显微组织
为了研究镀层质量对金/锡/金熔封过程的影响,进而阐明陶瓷基板上金属镀层的互连冶金过程,采用320 ℃加热台对陶瓷基板首先进行熔融处理.图4 为熔融完成后两种陶瓷基板表面的金相显微形貌,由图4a 可知,金/锡/金镀层质量差的基板镀层熔融后,表面质量差,局部区域出现凹陷不平状,并伴有灰褐色斑块浮现.与之相比,金/锡/金镀层质量优良的基板的镀层熔融后,表面光亮饱满,富有金属光泽,并未看到凹陷.在局部区域甚至可以看到Au-Sn 的共晶组织,如图4b 所示,因此金/锡/金电镀层的质量对陶瓷基板熔融后的形貌与组织产生显著的影响.
为了深入分析金/锡/金电镀层的熔融过程,对熔融后陶瓷基板上侧的横截面组织进行了SEM 表征,结果如图5 所示.可以看出,质量差的金/锡/金电镀层熔融之后,上侧的Au-Sn 共晶层变得很薄,仅有~ 4 μm,这对应了图4a 中陶瓷基板表面的凹陷部分.与之相比,质量优良的金/锡/金电镀层熔融之后,形成了良好的Au-Sn 共晶组织,如图5b 所示,共晶层整体厚度均匀,与熔融前金/锡/金镀层厚度一致,约为11 μm(图3b).

图5 熔融后陶瓷基板上金属层界面显微组织与元素分布Fig.5 Microstructures and elemental distribution of electroplated metallic layer on HTCC after melting.(a) poor electroplated layers;(b) good electroplated layers
考虑到金/锡/金电镀层熔融是一个连续升温的过程,而Au-Sn 发生共晶反应的温度是278 ℃,因此在温度上升至320 ℃的过程中,中间的锡镀层会首先发生熔化,形成一个“熔池”;熔化的锡会溶解金层,形成Au-Sn 化合物,但是当流动的锡熔体遇到镀层界面的孔洞时,没有金溶解,这就导致锡熔体流动到基板的其它地方,造成该处镀层变薄,凝固后出现凹陷.
以上分析进一步说明,与传统Au-Sn 共晶焊不同,此处使用分层电镀方法制备的金/锡/金镀层并没有直接生成Au-Sn 共晶组织,而是在升温过程中首先熔化的锡镀层溶解固态的金镀层,形成Au-Sn 间化合物;当温度高于共晶温度278 ℃时,金/锡/金镀层才会迅速液化,发生共晶反应;随后冷却过程中,由液相中生成ζ 相和δ 相AuSn,ζ 相和δ相以层片状排列,构成共晶组织,如图5b 所示.表1 是图5b 中共晶层的两相的能谱分析结果,由此可知,图5b 中浅色的组织是ζ 相,深色的组织是δ 相(AuSn).对比图5a 和图5b 可知,质量较差的金/锡/金镀层经历熔融和凝固之后,虽然生成了浅色的ζ 相和深色的δ 相,但其并没有形成层片状共晶组织,这说明金/锡/金镀层的质量直接影响熔封之后AuSn 共晶组织的形态,进而影响陶瓷基板与金属管帽之间的互连结果与可靠性.

表1 图5b 中Au-Sn 化合物的成分(原子分数,%)Table 1 Au-Sn intermetallic compounds in Fig.5b
2.3 管帽与陶瓷基板封接后的界面组织分析
CSP 封装结构的微腔保护了芯片的工作区域不受外界湿气和电磁的干扰,因此封装结构中管帽和陶瓷基板的互连可靠性关系到封装器件是否可以正常工作.图6a 是CSP 器件封装结构的剖面图,冲压制作的可伐合金管帽与电镀后的HTCC 基板上的Au-Sn 焊料环熔封焊接,封装回流曲线如图2 所示,采用缓慢升温的方式进行器件熔封,焊接峰值温度为310 ℃,保温90 s.图6b 是管帽与陶瓷基板互连处的SEM 表征与相应的界面各元素分布的能谱面扫描结果.陶瓷基板上制备了质量优良的金/锡/金镀层(图3b),将可伐合金管帽与基板压在一起,然后升温实现连接.表2 是与图6b 对应的界面Au-Sn 共晶层的相组成分析结果.根据界面的SEM 形貌(图6b)和相分析(表2)可知,可伐管帽和HTCC 基板之间形成了良好的连接,在Au-Sn 共晶焊料层内生成了ζ 相和δ/(Au,Ni)Sn 相,其中(Au,Ni)Sn 相主要分布在两侧,中间则是ζ 相和富Sn 相.

表2 图6b 中Au-Sn 共晶层相成分(质量分数,%)Table 2 Au-Sn intermetallic compounds in Fig.6b
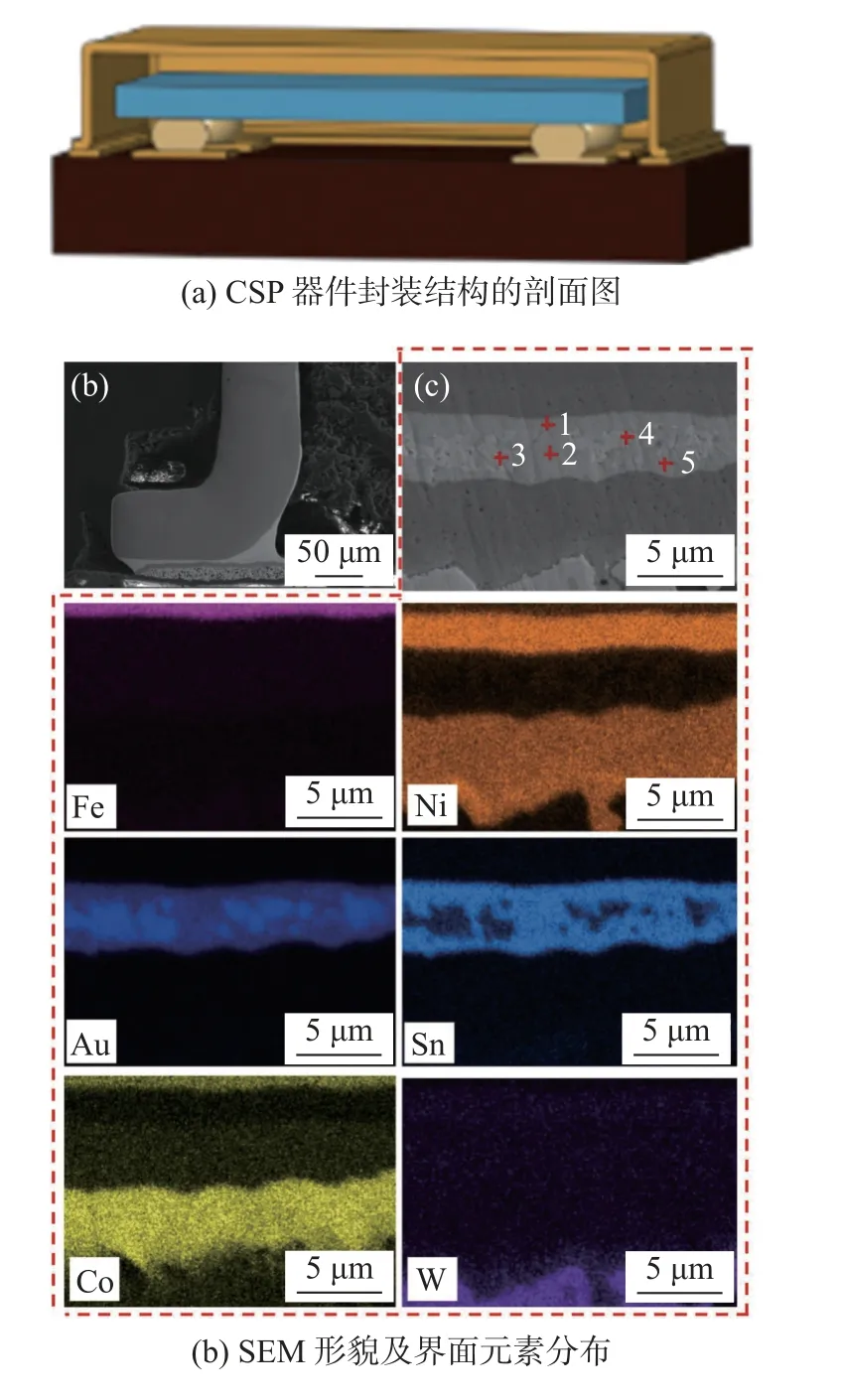
图6 可伐管帽与基板互连界面处的显微组织与元素分布Fig.6 Microstructures and elemental distribution of interconnection between Kovar cap between HTCC substrate.(a) cross sectioned map of CSP component;(b) SEM micrograph and teelemental distribution maps
根据2.2 节的分析,当温度升高时,中间的锡镀层首先发生熔化,由中间向两侧溶解金层;温度升高至Au-Sn 共晶点以上,Au-Sn 之间发生共晶反应,金/锡/金镀层快速液化,进而溶解可伐合金镍层,形成ζ 相和δ/AuSn 相,其中由于金和镍是无限互溶的,镍会进入Au-Sn 相的晶格内,形成(Au,Ni)Sn界面金属间化合物,实现可伐合金引脚与陶瓷基板的互连.
为探究不同封装回流曲线对Au-Sn 共晶焊料封接效果的影响,将预热温度和峰值温度分别提高至220 和330 ℃,同时提高了升温速率,但是将在峰值温度的保温时间缩短至30 s,改进后封装回流曲线如图7 所示.

图7 改进后管帽封装回流曲线Fig.7 Soldering curve used for cap packaging
图8 是采用图7 所示的曲线获得的管帽-基板互连界面的微观组织形貌和面能谱分析.改变封装回流曲线之后,可伐管帽与HTCC 基板之间也获得了良好的互连;但采用图7 所示的曲线,共晶焊料层的组织形态发生了变化,即共晶焊料层内出现了明显的分层,中间没有锡剩余.结合表3 所示的相成分分析,此时共晶焊料层由δ/(Au,Ni)Sn—ζ 相—δ/(Au,Ni)Sn 夹层结构组成.

表3 图8 中Au-Sn 共晶层相成分(原子分数,%)Table 3 Au-Sn intermetallic compounds in Fig.8b
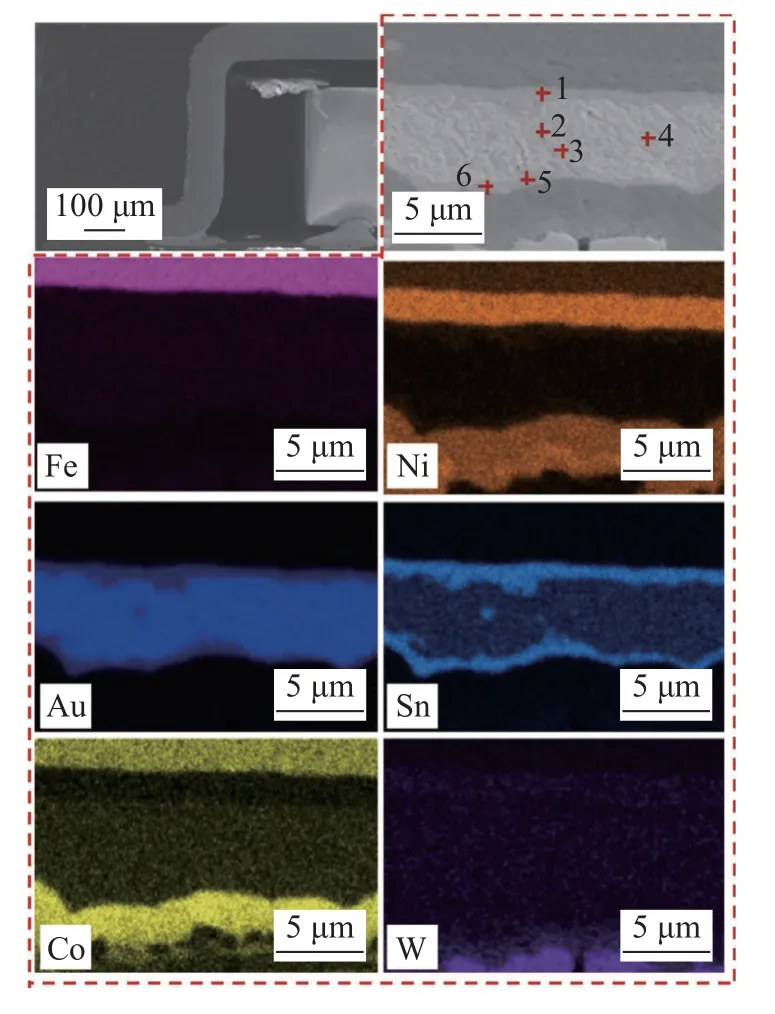
图8 改进后可伐管帽与基板互连界面处的显微组织与元素分布Fig.8 Microstructures and elemental distribution of interconnection between Kovar cap and HTCC substrate
对比两种曲线获得的互连界面组织,可以发现,当焊接峰值温度为310 ℃时(图2),金和锡之间反应并不完全,导致中间锡层仍有锡残余;当焊接峰值温度为330 ℃时(图7),虽然保温时间由90 s 缩短至30 s,中间锡层已经全部转变成了Au-Sn 化合物ζ 相,说明此时金和锡之间反应完全.根据前述管帽封接过程中金/锡/金镀层共晶冶金机理,Au-Sn 共晶反应需要快速完成,避免升温过程中熔融锡过多消耗.采用图2 所示曲线时,由于升温速率慢,熔融的锡在溶解金形成富锡金属间化合物的同时,其熔池界面处的熔点也在升高,导致其溶解金能力下降,结果中间锡层没有反应完全,仍有大量的锡残留.因此相对于保温时间,峰值温度对Au-Sn 熔封的结果影响更大,采用快速升温方法达到更高的焊接温度所产生的熔封效果更好.
两种曲线获得的管帽-基板界面均出现了δ/(Au,Ni)Sn 相偏聚在可伐管帽引脚一侧,这与图5b所示的陶瓷基板直接熔融之后形成的层片状共晶组织不同,其原因是管帽引脚镍层部分溶解进入δ/AuSn 相所致,表明金锡共晶焊料与可伐管帽实现了有效焊接.
2.4 互连界面的热循环可靠性分析
对采用图7 焊接曲线封装的管帽-基板进行检漏试验,试验条件如表4 所示,检漏结果为合格.

表4 密封检漏试验条件Table 4 Test conditions of leakage detection
剪切力是衡量金锡焊料封接质量的另一项重要指标.将器件固定在推力测试台上,平行于基板方向施加推力进行剪切力测试,测得管帽脱离推力分布在6 500~ 7 500 g,根据管帽封接环尺寸计算,其抗剪强度分布在41.88~ 48.32 MPa.如图9 所示,管帽推落端口焊缝规则完整,基板表面粘附层有拉扯脱落,表明金锡共晶封接质量较好.

图9 剪切力测试基板形貌Fig.9 Morphology of HTCC substrate after shearing-teat
对封装后的管帽-基板进行-55~ 85 ℃的热循环测试,试验按照GJB 548B—2005 中方法1010.1和下述规定进行,如表5 所示.在温度循环测试完成后,对封装的器件进行机械冲击测试,测试条件按照GJB 548B—2005 中方法2002,即冲击力1 500 g,冲击方向为y1方向,冲击10 次.对经历温度循环和冲击测试后的器件,再次进行检漏,检漏结果器件合格,对其进行剪切力测试,抗剪强度保持在40 MPa 以上,与试验前无明显改变.图10 是300 次循环后界面的显微组织与元素分布.

表5 温度循环试验条件Table 5 Test conditions of temperature cycle

图10 300 次循环后管帽引脚与基板界面的显微组织与元素分布Fig.10 Microstructures and elemental distribution of interconnection between Kovar cap and HTCC substrate after 300 temperature cycle
表6 是图10 中Au-Sn 互连层内的相分析结果.由图10 和表6 可知,经历300 次循环之后,互连界面的形态和组织并没有发生明显变化,Au-Sn 互连层保持δ/(Au,Ni)Sn—ζ 相—δ/(Au,Ni)Sn 分层结构,在界面上并没有观察到疲劳裂纹,这表明采用金/锡/金电镀层,通过Au-Sn 共晶反应实现CSP 器件的金属管帽与陶瓷基板之间的封接是稳定可靠的.

表6 图10 中Au-Sn 共晶层相成分(质量分数,%)Table 6 Au-Sn intermetallic compounds in Fig.10
3 结论
(1)分层电镀沉积法制备的金/锡/金镀层的质量,尤其是层厚度和层间的结合力,将会严重影响Au-Sn 共晶焊料的封接质量.
(2)在焊接时,锡镀层首先熔化形成“熔池”,溶解上下两侧的金镀层,直至完成共晶反应生成δ/(Au,Ni)Sn—ζ 相—δ/(Au,Ni)Sn 分层组织结构.
(3)相比于保温时间,焊接温度对Au-Sn 共晶焊料的封接结果影响更大,为了形成Au-Sn 共晶组织,需要优化调整封装回流曲线.
(4)在HTCC 基板上分层电镀金/锡/金,焊接温度在330 ℃,时间维持30 s 时,Au-Sn 共晶反应完全,实现可伐管帽与HTCC 基板的可靠密封,该工艺稳定可靠,适合于批量化生产.
