低温烧结银与金基界面互连研究进展
2023-12-19汪智威林丽婷李欣
汪智威,林丽婷,李欣
(天津大学,天津,300072)
0 序言
近年来,相比于硅基(Si)器件,第三代半导体如碳化硅(SiC)和氮化镓(GaN)等器件,由于具有更大的禁带宽度和击穿场强,更高的导热性、耐热性,越来越广泛地应用在电动汽车和航空航天等领域[1].为满足第三代半导体器件的高温、高功率密度的可靠应用,相应封装互连材料必须具有热、电和力学性能的良好匹配.新型连接材料—烧结银焊膏,利用微/纳米银颗粒在加热或加压条件下,可以相互扩散,并形成致密多孔烧结银结构的特点,满足了低温烧结(≤250 ℃)和高温应用(≥500 ℃)的应用需求,同时烧结后具有良好的力学强度、热、电和可靠性,在许多应用场景中已经代替无铅焊料,成为首选的互连材料[2-4].
在半导体器件封装中,通过互连材料实现芯片与基板之间的机械和电气连接,互连接头质量密切影响着器件的寿命.影响互连质量的因素除了材料本身外,还有界面连接质量这一关键因素,而界面处多为异种金属之间的连接,往往易出现分层、裂纹等缺陷.正如烧结银焊膏的主要成分为银,而基板表面通常为铜铝材料,同时为避免其氧化,提高可焊性,工业上又常对其进行镀银、镀镍或镀金(镀金之前普遍需要先预镀镍层)的表面处理[5],因此烧结银与不同金属界面之间的互连已成为研究热点,其中银-金界面互连近些年受到了更多的关注,这是由于金基界面具备高导电性和低接触电阻等特性,镀金基板已逐渐被应用,以提升半导体器件的性能.
已有学者进行对比试验发现,烧结银与金基界面的互连性能远不如烧结银与银基界面[6],目前烧结银-金互连可靠性仍存在诸多质疑与问题,受到业内学者广泛关注.文中由介绍烧结银与不同表面互连机制入手,阐明烧结银-金互连的问题与挑战,从接头互连工艺、接头服役可靠性等方面对烧结银-金接头的研究现状总结归纳,旨在更好解决烧结银-金基界面互连问题.
1 烧结银与金属化界面互连机制
有学者曾对两种材料间的连接机制进行总结,一般可以分为物理、机械、静电、扩散以及化学键连接等[7-8].表面金属化结构的不同、烧结工艺的差异都会造成烧结银与界面连接机制的不同.
1.1 烧结银与裸铜界面互连
烧结银中的有机物体系需要烧结气氛中一定的氧分压才能热分解,但铜在该环境下即生成氧化膜.不少学者认为烧结银与铜表面依靠Ag-Cu 金属键形成互连,而铜基板表面氧化膜阻碍键合.Ide 等人[9]采用纳米银-有机壳覆盖的银焊膏,在辅助烧结压力5 MPa 的条件下,还原铜表面氧化物,制备得到互连性能良好的银-铜接头.有试验对比空气和低真空环境烧结得到的银-铜接头的服役可靠性,空气烧结接头由于存在氧化物层,加剧接头内因热膨胀系数不同而产生的热应力,导致其可靠性远低于低真空环境烧结接头[10].但Du 等人[11]通过透射电子显微镜(transmission electron microscope,TEM)观察发现(图1),空气气氛烧结得到的银-铜接头形成了Ag-Cu2O 化学键和Ag-Cu 金属键,由于晶格常数差异,学者认为前者对接头互连贡献更大.

图1 烧结银与铜及其氧化物层的界面晶格[11]Fig.1 Lattice images of the interface between sintered Ag and oxide layer.(a) Ag/Cu2O interface;(b)Ag/Cu interface
1.2 烧结银与银基界面互连
烧结银可以实现与银基表面的良好互连,因为二者晶格常数相同,Ag 原子可在银基表面外延生长,无压烧结下,接头抗剪强度可达到70 MPa,断裂形式通常为穿晶断裂[12-13].有学者观察烧结银-银基界面接头断面,断裂位置出现在烧结银靠近上焊盘或下焊盘界面的烧结银内部,表明烧结银与银基界面的连接强度与烧结银的内聚强度相当[14].此外,烧结银与银基界面互连的接头具有更高可靠性:有学者将烧结银-银接头置于200~ 300 ℃的环境下进行50 h 的高温老化,发现银-银接头连接层进一步致密化,抗剪强度不降反升[15].将烧结银-银基界面接头放置在300 ℃环境中,1 000 h 后仍保持高于30 MPa 的抗剪强度[16],将这一现象归因于相较于其它类型接头,烧结银与银基界面互连具有最高界面连接比和最小接触角,能有效增加裂纹扩展面积,减小界面的应力集中,如图2 所示[17].
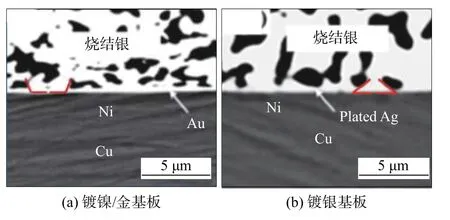
图2 烧结银与不同界面互连接头[17]Fig.2 Sintered Ag joints on different metallization.(a)Ni/Au plated substrate;(b) Ag plated substrate
1.3 烧结银与金基界面互接
早在2008 年,有学者在块状金表面进行烧结银互连,由于银与金晶格常数接近(银为0.408 6 nm,金为0.407 9 nm),银-金界面处的微观组织形貌如图3 所示,银纳米颗粒沿金层晶粒取向形成外延层,实现连接[18].2014 年,Paknejad 等人[19]在300 ℃高温老化24 h 的烧结银-金接头中,同样观察到这一现象(图3a).另外,进行TEM 表征,发现在接头界面位置,Ag 和Au 原子沿晶界发生了剧烈互扩散现象(图3b),可知烧结银-金互连主要依靠银-金间互扩散实现.

图3 银-金界面处的微观组织形貌[19]Fig.3 Interfacial microstructure at Ag-Au metallization.(a) orientation relationship between Ag layer and Au layer;(b) TEM image of Ag-Au interdiffusion
有部分学者关注银-金接头中互扩散现象的影响因素.Xu 等人[20]对比化学镀和电镀得到金基表面,化学镀的表层金晶粒小于100 nm,远小于电镀表面金晶粒尺寸,烧结后,前者互连界面处产生连续分层(delamination region),烧结银-金接头如图4所示,这是因为小的金晶粒具有更多晶界,为Ag 原子提供更多扩散至金镀层的通道,Ag 原子大量溶于金层最终导致分层.Lin 等人[21]利用分子动力学模拟设计对比金层晶粒取向对银金扩散的影响,相同时间下,Ag 原子在金的高角度模型中的平均扩散距离是Ag 原子在低角度模型中的4 倍,在烧结互连时,金层表面的高角度晶界可作为Ag 原子的高速扩散通道,促进Ag 原子迁移.

图4 烧结银-金接头[20]Fig.4 Sintered Ag-Au joints.(a) interfacial microstructure;(b) the distribution of element
2 烧结银与金基界面互连问题与挑战
2.1 不平衡互扩散
以烧结温度为300 ℃为例,银在金中的扩散系数为3.42 × 10-17cm2/s,远大于银在银中和金在银中的扩散系数(二者分别为5.99 × 10-18和4.67 ×10-19cm2/s),保温10 min,Ag 原子在银基体的扩散长度为0.60 nm,而在金基体的扩散长度可达到1.43 nm.烧结过程中,靠近银-金界面处的Ag 原子快速迁移进入金层,而距离界面较远的Ag 原子来不及补充空位,导致互连界面处产生致密层(void-free layer),即银-金固溶层,在致密层上方形成高孔隙层(high-porosity layer),一旦孔隙之间连续形成分层(delamination)严重恶化接头性能.该现象同样出现在烧结银-金接头老化过程中,Paknejad等人[19]在300 ℃高温老化500 h 后,烧结银-金接头中伴随镀金层逐渐溶解烧结银中,界面位置无孔隙层增厚,其上方形成分层,如图5 所示,接头的抗剪强度由初始状态下的22.5 MPa 下降至7.5 MPa.

图5 高温老化接头形貌变化[19]Fig.5 Microstructure evolution of sintered Ag-Au joints during high-thermal aging.(a) initial stage;(b)after 24 h;(c) after 100 h;(d) after 500 h
Chen 等人[22]将烧结银-金接头置于250 ℃环境中进行老化,银-金接头间存在剧烈互扩散,高温作用下,原子运动加剧,老化1 000 h 后,出现“吃金”现象,即Au 原子已全部溶入烧结银,接头形貌变化和界面反应如图6 所示,与此同时,由于无金层阻挡作用下,镀镍层和铜层也发生一定程度的扩散.
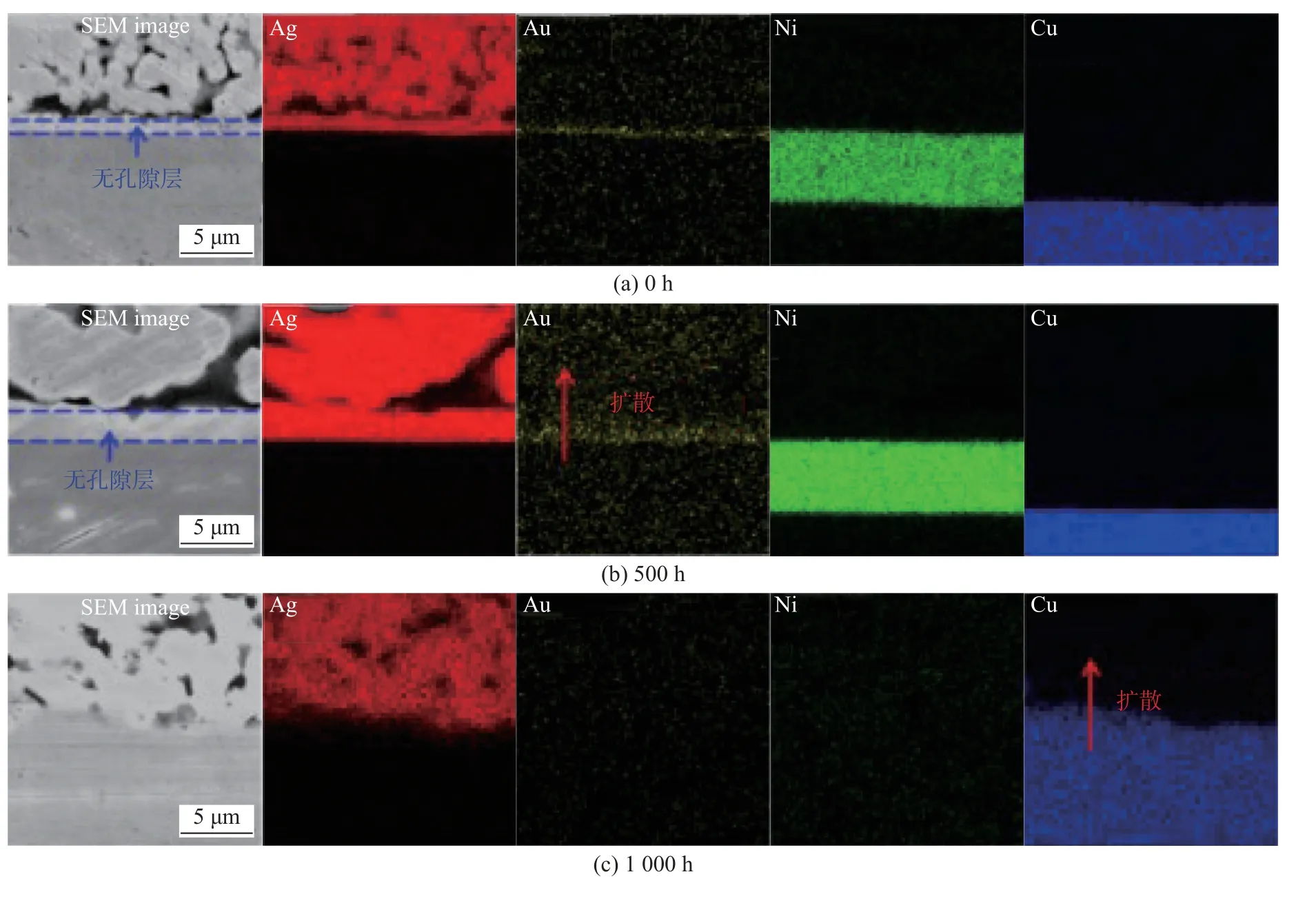
图6 高温老化下接头形貌变化和界面反应[22]Fig.6 Microstructure evolution and interfacial reaction of sintered Ag-Au joints during high thermal aging.(a) 0 h;(b)500 h;(c) 1 000 h
2.2 镍层氧化
在金基表面化处理过程中,为提高金层与铜基体结合力,并抑制二者互扩散,在镀覆金之前,一般镀3~ 7 μm 的镍层[23].镀金液对镍层具有腐蚀性,如果工艺不当,往往会在表面造成黑板和针孔等缺陷[24].除银-金过渡互扩散外,由于互连后的金层为疏松多孔结构,镀镍层直接与连接层接触,镍层对接头互连存在一定影响.有学者对比基板镀镍层有无针孔(pinhole)缺陷的烧结银接头的互连性能,二者初始状态下强度相同,但经过500 h 的250 ℃高温老化试验,无针孔缺陷的基板烧结银接头抗剪强度下降17%,有缺陷基板对应接头强度下降26%,烧结银-金接头断面电子显微探针结果,如图7 所示,认为镀镍层的针孔缺陷为氧气提供快速扩散通道,导致镀镍层氧化,镍氧化物成为断裂敏感区,剪切试验中,接头发生脆性断裂[25].同样有学者通过XPS 手段观察到,由于化学浸金过程中金层产生孔隙,烧结过程中Cu 和Ni 原子在金表面聚集形成氧化物,恶化接头性能[26].
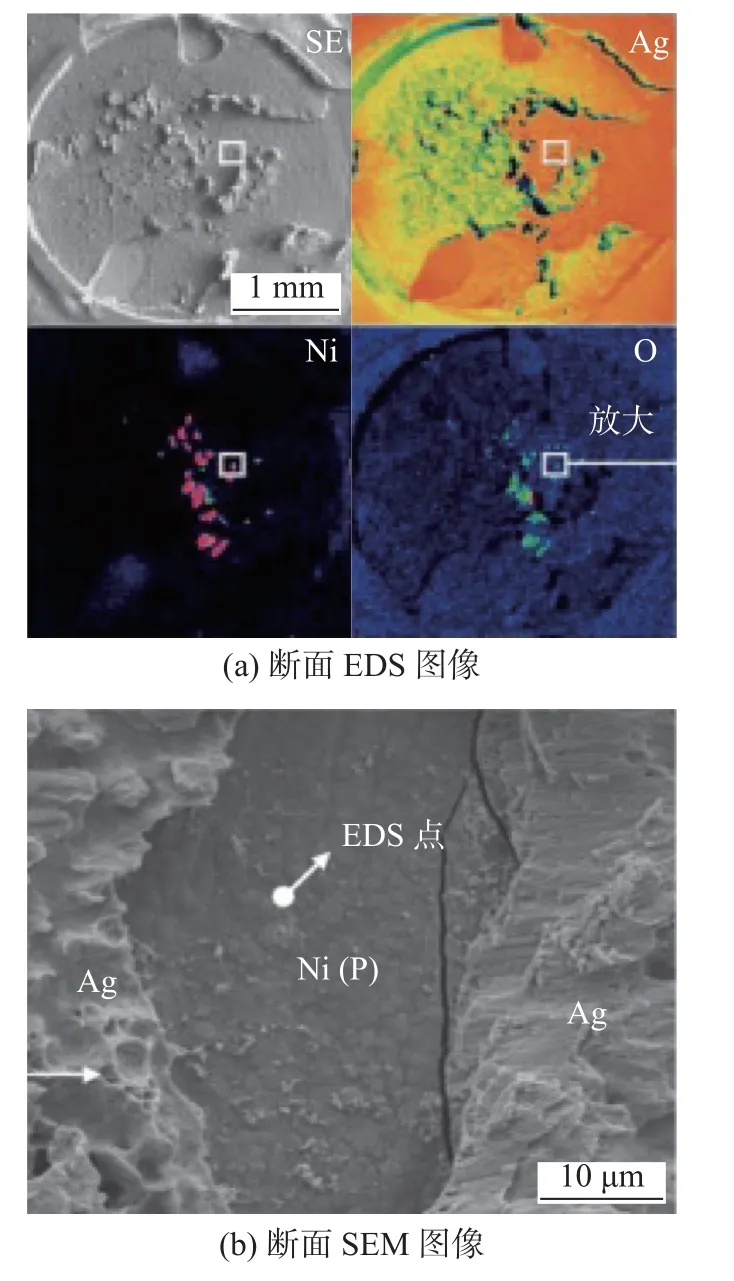
图7 烧结银-金接头断面Fig.7 Fracture surface of sintered Ag-Au joint.(a) EDS image of the fracture surface;(b) SEM image of the fracture surface
与此同时,镍层氧化问题严重限制烧结银-金接头的高温服役性能,在350 ℃的高温老化试验中,Zhang 等人[27]观察到银-金接头由镍氧化导致的失效模式,如图8 所示.外界气氛中的氧和有机溶剂分解形成的氧在高温作用下,沿多孔烧结银晶界和缺陷位置迅速扩散,造成镍层氧化,与互连层分离,最终导致剪切过程中接头的脆性断裂.有学者观察250 ℃高温老化过程中不同阶段的接头剪切断面,发现随着老化时间增加,接头断面出现镍氧化物增多,镍氧化物抑制烧结银粗化,未粗化烧结银成为脆弱区域,降低接头可靠性[28].

图8 高温老化下由镍氧化导致的接头失效模式[27]Fig.8 Failure mode of Ag-Au joint with Ni oxidation.(a) dense sintered silver joint; (b) pore coarsening and oxygen ingres;(c) oxidation of nickel layer
3 烧结银-金接头互连改进研究进展
3.1 快速烧结工艺
通过比较不同温度银-金间互扩散系数,学者认为,烧结开始时扩散没有发生,温度升高后,Ag 原子向金层中扩散,随着温度逐渐升高,Ag 原子在金中的扩散速度越来越快,并且大于Ag 原子在银中的扩散速度,空洞出现,最终高温长时间烧结使得空洞连接形成分层.基于该认识,王晓敏[29]针对平均金晶粒尺寸小的化学镀镍/金基板提出一种改进烧结工艺,引入30 min,150 ℃的预干燥阶段,保证有机物充分挥发的同时,减少烧结过程中在高温段的停留时间,降低Ag 原子的非致密扩散,扩散示意图如图9 所示,以避免发生界面分层的问题.通过比较不同温度下银-金互扩散系数大小,Wang等人[30]提出使用快速升温的方法避开常规烧结过程中的低温区段,以避免接头发生非致密化扩散,工艺改进后,接头强度提高至18.5 MPa.后续大量学者以这一改进后的烧结工艺为基础,进行试验研究.Zhang 等人[31]通过“阶梯式“烧结曲线:150 ℃,保温5 min→250 ℃,保温5 min→最后300 ℃,保温15 min 烧结,制备得到互连强度为30 MPa 的烧结接头.
3.2 增大金晶粒尺寸抑制扩散
基于前人对银-金扩散主要是以晶界为扩散通道这一认知,平均晶粒尺寸小的金层可以提供更多的晶界,促进银原子向金层扩散[31],金晶粒尺寸对接头互连影响如图10 所示,进而形成厚银-金固溶层和薄弱烧结颈.有学者由增大表层金晶粒尺寸,抑制银-金间不平衡互扩散入手,通过热处理提高金基表面的平均晶粒尺寸;将镀金基板置于250 ℃环境下1 h,晶界迁移速率加快,晶粒迅速长大,表层金平均晶粒尺寸由317 Å长大至516 Å,而接头抗剪强度提高84.05%[32].但也有研究发现,对镀镍/金结构基板进行1 h,250 ℃热处理后,表面金层出现镍氧化物,反而降低焊料与基板润湿性,难以形成可靠接头[33].有学者比较金层厚度为0.15,0.3 和0.8 μm 的基板与烧结银互连接头的连接性能,随镀层厚度增加,金晶粒显著增大,相应地,接头抗剪强度由14.7 MPa 提高至30.9 MPa[34],但这一举措极大提高了加工成本,同样不是理想的工艺途径.
3.3 使用镍/钯/金的金基界面结构
相较于最常见的镍/金结构,镍/钯/金结构的金基界面具有更高的化学稳定性和抗氧化性,此外引入镀钯层还可以减少70%的金消耗量,降低实际生产成本.近年来,已有部分学者将镍/钯/金结构应用在烧结型互连中[35],其主要优势:一方面,钯层提高金基表面质量,提高接头高温环境下抗氧化能力[36-37].有试验将镍/银基板、镍/金基板和镍/钯/金基板置于350 ℃老化1 h,镍/钯/金基板表面氧含量与镍/银基板的接近,远小于镍/金基板[38];另一方面,依附于镍层镀覆的金晶粒远小于依附于钯层制备金基界面,而大晶粒尺寸有利于抑制银-金不平衡互扩散.有学者比较在镍/金结构和镍/钯/金结构金基表面的烧结银接头的互连性能,镍/金表面金晶粒尺寸为0.09 μm,而镍/钯/金表面金晶粒尺寸为0.12 μm,相同烧结工艺下,前者接头的抗剪强度低于后者[39].
前文银-金接头的高温服役可靠性,主要是以镍/金结构的金基界面为研究对象,而有学者对镍/钯/金结构烧结银接头进行250 ℃的高温老化试验,银-金固溶层随时间增加而增厚,但1 000 h 后接头仍未出现明显分层和镍氧化现象,其强度仍保持在36.5 MPa[40].大阪大学对烧结银与镍/钯/金界面互连接头进行-55~ 250 ℃的极端条件温度循环试验,由于材料内部热膨胀系数差异大,热应力作为Ag 原子迁移的主要驱动力,导致不同区域的银-金固溶带影响形貌差异大,温度循环下接头界面形貌变化如图11 所示.接头失效主要是因为芯片-互连层-基板3 种材料的热膨胀系数不匹配,导致接头开裂,与银-金界面反应无关[41],镍/钯/金界面与烧结银互连表现出优越服役可靠性.
4 结束语
(1) 对比分析了烧结银与裸铜界面、银基界面和金基界面的互连机制和互连性能,并指出银-金互连的问题主要在于银-金不平衡互扩散和扩散阻挡层—镍氧化两方面.目前,对后者的机制认知还不完整,需进一步明晰镍氧化影响银-金互连的本质.
(2) 系统全面地概括了现有改善烧结银-金互连质量的3 种方法:快速烧结工艺和通过预热增大金晶粒尺寸的方法,虽然能有效提高接头互连质量,但仍然各有弊端;以镍/钯/金结构替换常见的镍/金结构的方法可以显著提高银-金互连质量和可靠性,因此被认为是具有潜力的新方案.
