Sn-58Bi 微焊点组织与力学性能的尺寸效应行为
2023-12-19王小伟王凤江
王小伟,王凤江
(江苏科技大学,镇江,212000)
0 序言
为了满足电子产品小型化、低功率、低成本和多功能化的市场需要,电子制造及封装已经向着微型化的方向快速发展,特别是3D 芯片异构集成封装提供了大量的跨尺度封装,增加了电子元件设计和生产的灵活性[1-2],同时由于焊点尺寸的稳步减小,放大了焊点的物理冶金效应和微观结构演变,即存在焊点尺寸效应的问题,导致各级芯片封装互连结构的焊点性能存在显著差异.
在界面反应方面,Adawiyah 等人[3]研究表明,随着焊点尺寸的减小,界面金属化合物的厚度有显著的增加.焊点尺寸对界面化合物尺寸的影响不仅体现在化合物的整体厚度,对单个界面化合物晶粒的尺寸和形貌也会造成影响[4-6];Fan 等人[7]研究表明,200~ 500 μm 焊点经过一次回流焊后界面单个化合物晶粒分别呈现出块状、八面体状和针状,界面化合物的尺寸和形貌的改变和焊点内Cu 原子的扩散速度有很强的关联性.Yang 等人[8]研究表明,Cu 原子的加入,小尺寸焊点中界面化合物从(Cu,Ni)6Sn5转变为(Cu,Ni)3Sn4需要的时间更短.此外焊点的结构和老化温度对焊点尺寸改变的响应方式也不同.
在力学性能方面,焊点的宏观几何尺寸和微观结构尺寸都会影响其机械特性.Qin 等人[9]研究表明,小尺寸焊点有更高的抗拉强度,并且焊点的抗剪切强度也随着焊点厚径比的减小而增加,焊点从韧性断裂转变为脆性断裂[10-11].
尽管目前针对焊点尺寸效应行为的研究已经取得一些成果,但是焊点尺寸的改变对Sn-58Bi 焊点组织和性能的影响研究仍不充分.Sn-58Bi 钎料的熔点为138 ℃,更加接近传统的Sn-Pb 钎料,有很好的工艺兼容性,并且低熔点有很大的优势.文中选用Sn-58Bi 钎料,对不同热老化时间下的BGA 焊点的微观形貌、界面行为和剪切力学性能进行对比,探讨Sn-58Bi 焊点中尺寸效应行为.
1 试验方法
采用直径为300,400,760 μm 的Sn-58Bi BGA焊球,试验所用的PCB 板为定制FR-4 基板,焊盘直径为250,340 和600 μm.将助焊剂涂敷于PCB 板表面,将小球置于焊盘上,在氮气气氛下进行回流并随炉冷却,回流后使用酒精浸泡试样去除表面残留的助焊剂.
将回流后的试样放置于热老化试验箱,进行热老化试验.考虑到Sn-58Bi 钎料的熔点为138 ℃,为获得合适的界面IMCs 生长速率,并避免低熔点相的熔化,热老化试验箱温度设置为100 °C,老化时间分别设置为20,40,60,80 d.将经受设定老化时间的试样取出进行镶嵌、粗磨、精磨、粗抛、精抛,使用扫描电子显微镜(SEM)观察制备好的试样,并使用MATLAB 计算回流后显微组织中锡相和铋相的晶粒尺寸与不同热老化时间试样的界面IMC 厚度.使用剪切力试验机对试样进行剪切性能测试,剪切刀头距PCB 板的高度为50 μm,剪切速度控制在0.1 mm/s.
2 试验结果与分析
2.1 焊点尺寸对回流后显微组织形貌的影响
根据Sn-Bi 二元合金相图可知,Sn-58Bi 焊点中Sn 和Bi 元素不会产生化合物,在平衡凝固条件下,当温度下降到138 ℃时,Sn-58Bi 产生共晶反应,由液相生成β-Sn 和Bi,最终显微组织为富锡相和铋相组成的共晶组织.一般而言,因为合金凝固时的过冷度比平衡凝固时的过冷度大,合金在常规的凝固条件下通常为非平衡凝固,在非平衡凝固条件下,Sn-58Bi 合金产生亚共晶反应,其凝固过程为L→L'+β-Sn(初生相)→β-Sn(初生相)+β-Sn +Bi,导致有初生相β-Sn 的形成.
图1 是Sn-58Bi 焊点回流后的显微组织形貌,图中用红色箭头标注了初生相,3 种尺寸的Sn-58Bi焊点中都形成了长条状的初生β-Sn 相,300 μm 焊点中形成的初生相贯穿整个截面,面积占比较大,而760 μm 焊点的初生相数量较多,单个初生相的面积占比较小.大块初生β-Sn 相的形成是因为焊点在熔点温度以下快速冷却,在凝固过程中有较大的过冷度,不同尺寸焊点在相同的冷却条件下具有不同的过冷度.焊点尺寸对过冷度的影响计算式为[12]

图1 Sn-58Bi 焊点回流后显微组织Fig.1 Microstructure of Sn-58Bi solder joint after reflow.(a) 300 μm;(b) 400 μm;(c) 760 μm
式中:djoint为焊点直径;r为恒定的冷却速率;ΔT为过冷度;ks为决于原子振动频率的复合函数;γsl为晶核与液体之间的界面能量;LV为单位体积的熔焓;f(θ)为催化效力因子;TM为熔点;TN为凝固温度;k为玻尔兹曼常数.过冷度随着焊点尺寸的减小而增大,加剧了凝固过程中的非平衡凝固.
图2 为Sn-58Bi 焊点内锡相和铋相的晶粒尺寸统计.Sn-58Bi 焊点内主要是树枝状的共晶形貌,导致3 种尺寸焊点内都有许多微小尺寸的锡相和铋相,300 μm 和400 μm 焊点内锡相和铋相的晶粒长度主要分布在0.5~ 3 μm,使得共晶相组织比较均匀、致密,760 μm 焊点内存在数量较多的大面积的铋相,焊点内部分锡相和铋相的晶粒长度达到了6~ 10 μm,760 μm 的焊点因为在冷却过程中形成了过多的初生β-Sn 相,造成了局部成分偏析加剧,导致大尺寸焊点的熔点上升,同时增加了共晶形成后在高温停留时间,延长了共晶长大的时间.固溶在锡中的铋有更多析出的时间,使得铋相更加粗大,也导致铋相和锡相之间的层间距增大,整体形貌尺寸分布不均匀,并且铋相是脆性相,大尺寸铋相越多,焊点的脆性越大,不同尺寸焊点内大尺寸铋相数量的不同,直接导致焊点的力学性能产生差异.

图2 Sn-58Bi 焊点晶粒尺寸统计Fig.2 Statistics of grain size of Sn-58Bi solder joints.(a) Bi;(b) Sn
2.2 焊点尺寸对界面反应的影响
图3 为3 种尺寸的Sn-58Bi 焊点回流后及经过不同老化时间的界面显微组织,图中灰白色为铋相,浅灰色为β-Sn 相,深灰色为界面IMC.300 μm的Sn-58Bi 焊点回流后界面IMC 形态呈扇贝状,如图3a 所示,400 μm 和760 μm 焊点回流界面IMC不连续且有间断现象,呈现锯齿状.Sn-58Bi 焊点中形成界面IMC 所需要的Cu 原子全部来自于焊盘,界面IMC 的平均厚度和形貌取决于流入界面的Cu 原子数量.图4 为Sn-58Bi 3 种超尺寸焊点回流后以及经过不同老化时间界面IMC 厚度统计,从图中可知400 μm 和760 μm 焊点回流后界面平均IMC 厚度小于300 μm 界面IMC 厚度,这是因为300 μm 焊点有更短的Cu 原子扩散距离,Cu 原子的浓度梯度更大,加快了Cu 原子的扩散速度,使得单位面积焊盘上更多的Cu 原子从焊盘进入焊点,导致300 μm 焊点界面更厚的IMC 层.

图4 Sn-58Bi 焊点在不同老化时间界面IMC 厚度Fig.4 IMC thickness of Sn-58Bi solder joints after different aging times
300 μm 焊点中扇贝状IMC 层随着老化时间的增加逐渐平缓,经过40 d 热老化时间后,扇贝状IMC 成长为平板状.400 μm 和760 μm 焊点的界面IMC 在老化40 d 时呈扇贝状,IMC 之间生长不完全的现象消失,在老化时间达到80 d 后,呈现平板状.300 μm 焊点界面IMC 形貌的转变所需要的老化时间比400 μm 和760 μm 更短,因为300 μm焊点有最小的钎料球体积与焊盘面积比,300 μm 焊点中Cu 原子浓度上升的更快,焊点最先达到Cu 原子饱和,在热老化过程中更多Cu 原子参与到界面IMC 的长大过程,导致300 μm 焊点界面IMC 形貌转变需要时间更短,并且有最快的IMC 层厚度增长速度.
Sn-58Bi 焊点界面处IMC 层在老化过程中的生长由Cu 原子扩散机制主导,遵循抛物线生长规律,即IMC 层的生长厚度与时间的平方根成正比,其表达式为[13]
式中:t为时效时间;X为时效时间t时IMC 层的平均厚度;X0为时效开始时IMC 层的平均厚度;D为扩散系数.通过式(2)中的值,可以得出焊点界面化合物的生长速率.3 种尺寸的Sn-58Bi 焊点在100 ℃老化过程中界面IMC 层的生长速率分别为0.324,0.283,0.249 μm/day1/2.可以看出300 μm焊点界面IMC 的增长速率大于400 μm 和760 μm 焊点的界面IMC 生长速率,焊点界面的扩散系数D也遵循同样的规律,焊点尺寸越小,原子扩散系数越大,3 种尺寸Sn-58Bi 焊点界面反应的原子扩散系数D计算结果见表1.扩散系数D是表示粒子扩散速度的一个重要参量,它与温度、固溶体类型、晶体结构、晶体缺陷和组元的浓度等因素有关,根据传统的扩散理论,宏观尺度下组元浓度很低或变化不大时,通常近似认为扩散系数D不受组元浓度的影响;而在细观尺度下,微焊点受可扩散区域和参与界面反应物质的量所限制,组元浓度随扩散时间和温度会发生明显的变化,因而扩散系数D会随之发生变化[14-15].微尺度下,微焊点的几何尺寸通过影响组元的浓度变化间接影响界面元素的扩散.

表1 3 种尺寸焊点的原子扩散系数Table 1 Atomic diffusion coefficients for three sizes of solder joints
2.3 焊点尺寸对剪切性能的影响
图5 为3 种尺寸的Sn-58Bi 焊点随老化时间的抗剪切强度变化曲线.从图中可知,回流后30 μm焊点的平均抗剪切强度高于回流后400 μm 和760 μm 焊点的平均抗剪切强度,达到了70.89 MPa.400 μm 和760 μm 的Sn-58Bi 焊点平均抗剪切强度分别为67.19 MPa 和60.97 MPa,Sn-58Bi 焊点的抗剪切强度随着焊点尺寸的下降呈现明显的上升趋势,因为300 μm 焊点界面IMC 为连续不断的扇贝状,扇贝状的界面IMC 与钎料有较大的接触面积,接触强度也优于间断的锯齿状界面IMC.Bang 等人[16]在先前的研究也得出相同的结论,认为裂纹的扩展速率在不同尺寸焊点中存在差异,大尺寸焊点在剪切过程中存在更大的垂直分量,导致裂纹扩展速率加快,焊点更加容易失效.Qin 等人[17]验证了拉伸载荷下焊料中高应力三轴度引起的机械约束效应同样适用于承受剪切载荷样品中.应力三轴度Rσ可定义为
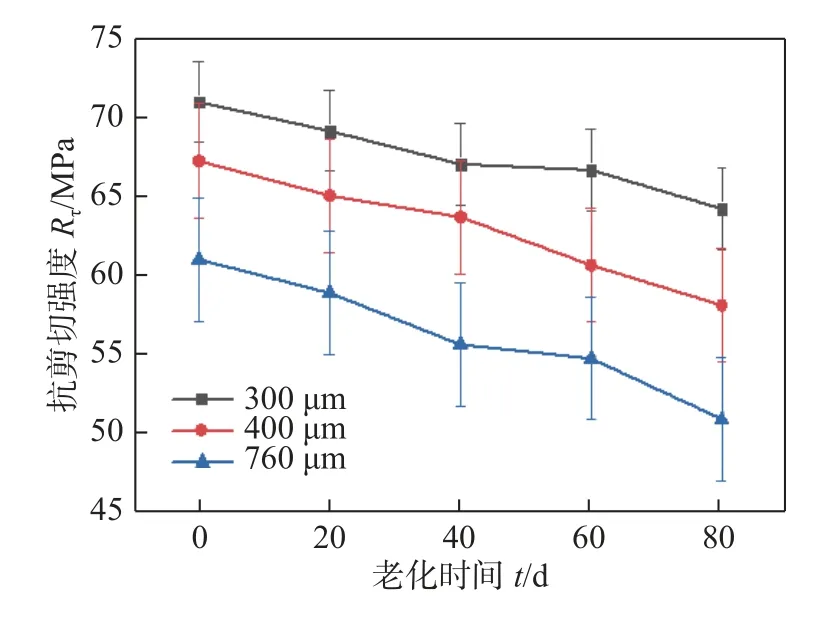
图5 Sn-58Bi 焊点随老化时间的抗剪切强度Fig.5 Shear strength line graph of Sn-58Bi solder joints with aging time
式中:σm为静应力;σeq为等效应力.二者计算式分别为
式中:σ1,σ2和 σ3为3 个主应力.在承受外载荷时,焊点铜基板、界面IMC 和焊料之间的弹性模量和泊松比收缩效应失配,产生了高的机械约束应力.随着焊点高度的降低,机械约束力增加,σ1,σ2和σ3之间的差距缩小[18].根据式(3)~ 式(5),焊点高度的减小,使得 σeq减小和Rσ提高,导致小焊点表现出了更强的抗剪切强度.
随着老化时间的增加,Sn-58Bi 焊点的抗剪切强度不断减小,时效80 d 后焊点最小的抗剪切强度分别为64.17,58.1 和50.93 MPa,最大下降幅分别达到了9.48%,13.53%和16.47%,这是因为界面IMC 在时效过程中从扇贝状成长为平板状,减少了与焊料基体之间的接触面积和结合力,使得焊点的剪切性能呈现下降趋势.
3 结论
(1) 小尺寸Sn-58Bi 焊点在回流后的共晶形貌更加均匀致密,大尺寸Sn-58Bi 焊点因为在凝固过程中形成了过多的初生β-Sn 相,造成局部偏析严重,形成较多大块铋相和锡相,整体形貌分布不均.
(2) Sn-58Bi 焊点尺寸的减小更有利于形成扇贝状IMC 层,并且小尺寸焊点在热老化过程中IMC 的生长速率更大.
(3) 小尺寸焊点中存在更大的机械约束效应,导致Sn-58Bi 焊点的抗剪切强度随着焊点尺寸的减小而增加,这个趋势没有随着老化时间的增加发生改变.
