GaN HEMT 电力电子器件技术研究进展*
2021-03-22周德金陈珍海宁仁霞吴伟东
鲍 婕,周德金,陈珍海,宁仁霞,吴伟东,黄 伟
(1.黄山学院智能微系统安徽省工程技术研究中心,安徽黄山 245041;
2.多伦多大学电气与计算机工程学院,加拿大多伦多 M5S3G4;
3.复旦大学微电子学院,上海 200443;
4.清华大学无锡应用技术研究院,江苏无锡 214072)
1 引言
GaN 高电子迁移率晶体管(HEMT) 由于AlGaN/GaN 界面生长的异质结,具有击穿电压高、热稳定性好、平均电子漂移速度高、宽且可调的带隙等优势,比传统的硅功率器件更适合大功率以及高速电子产品[1-2]。击穿场强高以及高迁移率都利于器件中制作较薄的漂移区,获得较低的导通电阻,较小的芯片尺寸就能实现需要的电流能力,从而降低输入和输出电容,而高饱和速度和低电容都能加快瞬时状态变化。GaN 器件在高达650 V 额定电压等级的高效、高频转换器等应用中成为了研究热点[3-4]。除了高频应用优势以外,GaN HEMT 在空调、冰箱、牵引逆变器以及储能系统等开关频率不足50 kHz 的应用场合,相比硅器件也具有开关损耗与传导损耗都有效改善的性能优势[5]。
目前国内外已有多家公司对GaN HEMT 器件进行研究,以加拿大的GaN Systems 公司和美国的Transphorm 公司为主。前者推出了高压单管增强型GaN HEMT,后者推出了高压级联增强型GaN HEMT。美国宜普(EPC) 公司主要生产低压增强型GaN HEMT,技术较为成熟。此外,还有纳微(Navitas)和罗姆(ROHM) 株式会社等公司,均积极开展GaN HEMT 功率半导体业务,并获得广泛应用[6-8]。在国内,富士通公司在2013 年与Transphorm 公司合作,也推出了自己的级联型GaN HEMT;苏州能讯半导体当前已经研制出600 V/17 A 的级联型GaN 器件。
2017 年,Transphorm 公司推出全球第一款同时通过JEDEC 和AEC-Q101 认证的GaN 场效应晶体管(650 V、49 mΩ)。2018 年EPC 的GaN 功率器件产品(80 V、脉冲电流75 A、16 mΩ) 首次获得汽车AEC-Q101 认证。该产品的体积远小于传统的Si MOSFET,且开关速度是后者的10~100 倍,产品主要用于激光雷达、高强度汽车前灯、48~12 V DC-DC 变换器、超高保真信息娱乐系统等汽车应用领域。
为了在应用中充分发挥GaN HEMT 器件的优势,与其关键参数如导通电阻、击穿电压、阈值电压等密切相关的器件工艺结构和材料特性,就需要从仿真和实验多角度进行详细研究。本文首先介绍了GaN HEMT 的器件类型,然后将器件工艺结构和材料对GaN HEMT 特性影响的研究现状进行了综述,最后概括总结了GaN HEMT 器件的技术发展趋势和最新参数指标。
2 GaN HEMT 电力电子器件类型
2.1 耗尽型GaN HEMT
GaN HEMT 中AlGaN 和GaN 两层材料的界面由于晶体极性,形成了一层叫做“二维电子气(2DEG)”的高迁移率电子,在器件的源极和漏极之间形成了天然的沟道,如图1(a)[4]所示,使GaN HEMT 具有了固有的常开属性,即耗尽型(D 型)器件。
常开特性是GaN HEMT 应用的主要障碍,因为在功率转换器中当栅驱动输出零电压时,开关要保持在常关状态,而GaN HEMT 的负关断栅压对栅驱动电路的复杂度要求较高,也增加了电路失效的风险。因此,通常将D 型GaN HEMT 与硅基低压E 型MOSFET封装在一起,组成级联共源共栅器件,电路结构如图1(b)[9]所示。MOSFET 的漏源电压决定了HEMT 的栅源电压,构成常关器件,其驱动电路采用传统硅基器件的驱动即可。

图1 耗尽型GaN HEMT
2.2 增强型GaN HEMT
改变GaN HEMT 栅极的工艺结构来转换阈值电压极性可以制作出增强型(E 型)GaN HEMT 器件。JONES 等[4]综述了目前报道的几种典型的E 型GaN HEMT 工艺结构,包括P 掺杂GaN(或AlGaN)栅、等离子处理的金属-绝缘体-半导体(MIS)结构、栅极嵌入式以及它们的改进结构等,如图2 所示。
工艺结构改变的宗旨是在无加载电压的情况下将栅极下方的2DEG 耗尽,才能使得正向阈值电压增强2DEG 而形成沟道。图2(a)中的P 掺杂GaN 栅是在栅极构造类似二极管特性的结构,通过二极管压降抬高阈值电压;图2(b)是在栅极下方通过等离子处理技术注入氟离子,有效耗尽2DEG;图2(c)通过精确刻蚀掉栅极下方一定深度的AlGaN 构造出栅极嵌入式结构,可以和MIS 结构等其他工艺共同作用,进一步提升阈值电压。
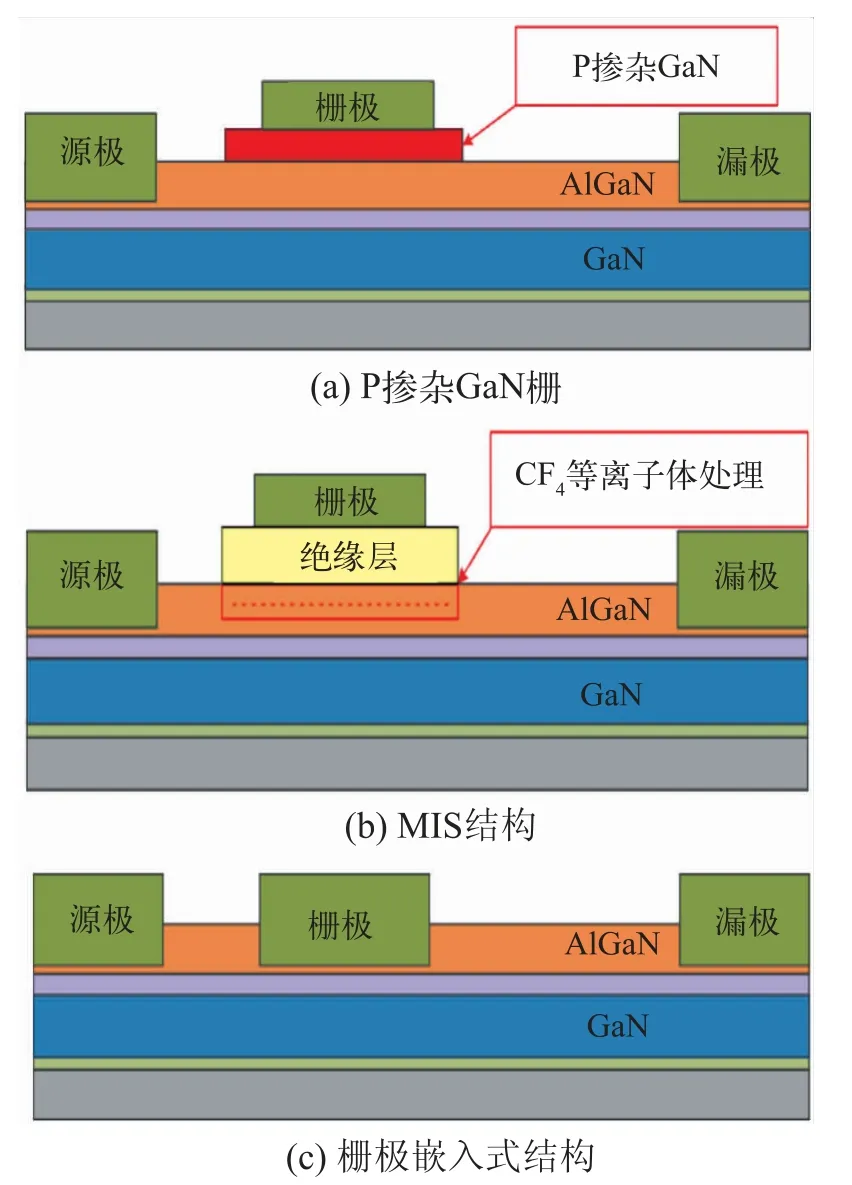
图2 增强型GaN HEMT
3 GaN HEMT 器件关键技术
3.1 器件工艺结构
3.1.1 P-GaN 栅HEMT
P-GaN 栅是一种典型的构造E 型GaN HEMT 的方案[10-13],在AlGaN 层上面生长例如Mg 掺杂的P 型GaN 或AlGaN 层。这种结构最大的优势就是可以通过金属/p-GaN 之间的高肖特基势垒高度而减小栅极泄漏电流,提供较高的正向阈值电压VTH[14-15]。P 型材料的有效浓度、厚度以及势垒层的结构都对E 型HEMT 的构造有直接的影响[16-17]。LI 等[18]还通过仿真发现,P-GaN 栅的长度对器件的阈值电压改善不大,同时却对电流能力有着负面影响,P-GaN 栅越长,沟道区域就越长,通态下器件电流会下降,而击穿电压随之先增大再趋于饱和。
很多报道都认为P-GaN 栅HEMT 在栅极正向偏压应力下和关断应力下阈值电压不稳定[19],其原因是P-GaN 区域空穴的积聚或耗尽影响[20],以及AlGaN 区域的电子俘获作用[21]。MURUKESAN 等[22]提出在测量阈值电压过程中栅极偏压的加载方式对Vth数值具有直接影响,要对P-GaN 栅HEMT 的阈值电压给出标准化定义还有待深入研究。SHI 等[23]通过研究电子空穴陷落和脱陷的潜在物理机制,在长时间栅偏应力下观察到P-GaN 栅HEMT 具有栅极退化性能自恢复的能力。
3.1.2 MIS/MOS-HEMT
由于GaN HEMT 器件栅极和缓冲区泄漏电流是限制其性能和可靠性的主要因素,因此一般在栅金属和沟道之间会制作肖特基接触,栅极电压就可以控制沟道电势,不需要做氧化层,只需要两步光刻工艺,性价比高。但最大的缺点是肖特基接触的开启电压很低,因此阈值电压就需要更低,这在高压应用中很不利[24-25]。而在栅极和沟道之间使用一层绝缘氧化层,构成MIS-HEMT 或氧化物-半导体(MOS)HEMT 结构,虽然减小了电子迁移率,但栅极泄漏电流可以减小6~10 个数量级[26-27]。SiO2和Al2O3由于宽带隙和高化学稳定性等良好的介电性能,通常被选作绝缘栅材料应用[28]。
MUKHERJEE 等[2]通过仿真对比研究了双栅MOS-HEMT 和肖特基HEMT 的输出特性,前者虽然跨导和瞬态变化速度不如后者,但其驱动电流能力、低阈值电压、电流开关比以及固有最大增益都更胜一筹。研究者们[24,29]以Al2O3作为介质层制作的MOSHEMT,对比传统HEMT 结构具有更为优异的直流和射频性能,更适合大功率高频应用。WANG[25]等为了解决MIS-HEMT 中2DEG 载流子迁移率变小的问题,采用AlGaN 部分凹进,即栅极嵌入式结构,再辅以多层Al2O3栅介质的氟化处理,使氟离子分布在2DEG 沟道足够的距离之外,同时精确控制其数量,实现在栅极阈值电压VTH提高至+6.5 V 的同时,漏极饱和电流保持在340 mA,以及较低的栅极泄漏电流和高击穿电压。
3.1.3 场板结构及尺寸的影响
使用源极和栅极场板能够使栅漏之间的电场重新分布,不再集中在栅极边缘处,减轻电流崩塌效应,提高击穿电压[30-31]。GODFREY 等[31]仿真分析得到随着源极场板的长度增加,GaN HEMT 的击穿电压随之增大,然后趋于饱和。当栅偏压过高时,栅击穿,栅极泄漏电流突然增大,会导致器件失效,因此关断状态下的封阻能力对HEMT 很重要。JIANG 等[32]提出了带有栅极场板的T 形栅结构,相比于传统的P-GaN 栅HEMT,减小了金属/P-GaN 的接触面积,在高栅压情况下保护P-GaN/AlGaN/GaN 形成的P-i-N 二极管不被破坏,从而保证了反向阻断能力,电场分布的仿真结果如图3 所示。LEI 等[33]提出了一种双嵌入式门控肖特基漏极的MIS-HEMT,如图4 所示,嵌入的金属-2DEG 肖特基接触带来了低导通电压,MIS 场板起到了将肖特基结与高电场屏蔽的作用,从而使反向关断状态时泄漏电流小,同时导通电阻很低。
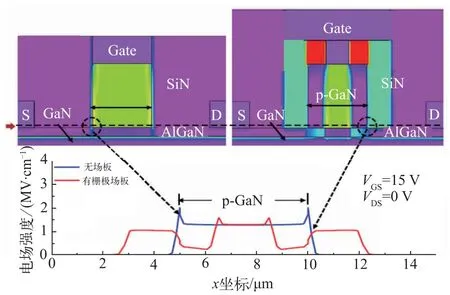
图3 T 形栅场板结构与传统结构的电场分布对比[32]
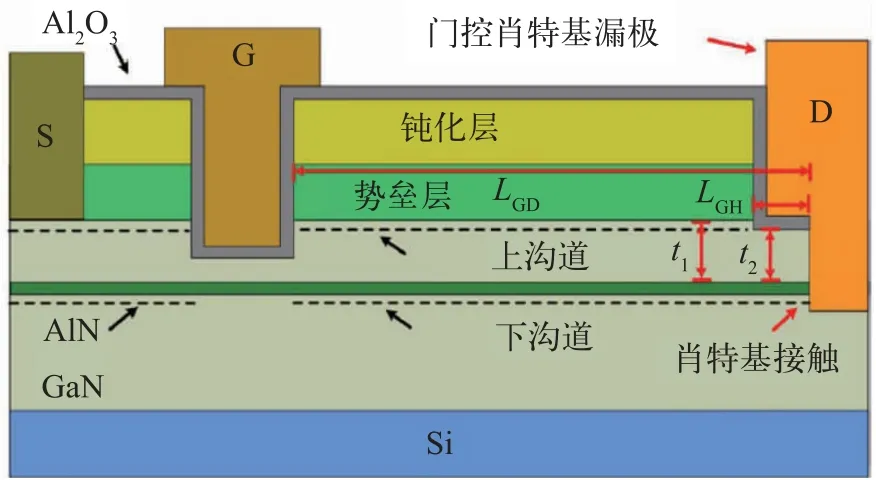
图4 双嵌入式门控肖特基漏极结构的MIS-HEMT[33]
除了场板结构以外,各极尺寸和间距、栅极嵌入深度等[34]也对器件性能有直接的影响。VERMA 等[35]仿真得到随着栅漏极间距的增大,2DEG 浓度先增加再减少,GaN HEMT 器件性能随之先提升再下降。NG等[36]在独立GaN 衬底上制作HEMT 样品,测试发现随着栅漏距离的增大,击穿电压随之增大,到临界值后趋于饱和。OZAWA 等[37]在栅极和漏极之间制作了单独的P-GaN 层。实验发现该结构显著抑制了电流崩塌现象,P-GaN 的位置越靠近栅极改善作用越明显,因为P-GaN 层注入的空穴有效中和了栅极边缘附近的捕获电子。然而栅漏距离增大虽能提高击穿电压,但同时会增大导通电阻;栅极过长会增大栅极泄漏电流,过短会加重自热效应[38],导致器件可靠性退化;场板悬垂长度虽然能提高击穿电压,但过长也会引起额外的电流泄漏[39]。因此上述结构尺寸都需要根据实际器件结构做出平衡各方面性能的优化选择。
3.2 器件材料特性影响
GaN HEMT 是在衬底上外延生长的多层薄膜,自下而上通常包括成核层、过渡层、缓冲层、沟道层、势垒层、盖帽层以及钝化层[40]。成核层如AlGaN 或AlN 用来阻止衬底材料向GaN 外延层扩散;过渡层可能包含分级AlGaN、AlN/GaN 超晶格或者多层AlN,用来平衡GaN 和衬底之间的应力;势垒层AlGaN 中Al 成分的比例越高,异质结处的2DEG 浓度升高,器件的阈值电压会随之下降,电流容量会增大,随着Al 比例继续提高,异质结晶格失配程度更高,导致电子迁移率下降带来电流容量的减小[18]。除了上述基本结构以外,GEDDAM 等[41]还分析了沟道与势垒层之间引入AlGaN 隔离层对HEMT 器件性能的影响,除了室温下增强型器件特性更好以外,其他特性都不如没有隔离层的p-GaN HEMT 结构,后者更适合高温大功率应用。其他各层材料特性对器件性能的研究现状具体分析如下。
3.2.1 钝化层
由于活性表面区域缺陷移位造成的表面态会影响电子俘获,而使器件的电流特性退化。在GaN HEMT 的栅源和栅漏之间都需要覆盖有表面钝化层,如SiN、SiO2、Si3N4、Al2O3、AlN 和HfO2等。KOEHLER等[42]在通常等离子体增强化学气相沉积(PECVD)的SiN 钝化层下面引入了10 nm 原位SiN 层,保护AlGaN 势垒层表面在PECVD 过程中不会受到等离子体的破坏,从而大幅降低了动态导通电阻的增长。
高介电常数钝化层可以提高击穿电压、漏极电流和跨导[28,43-44]。MADAN 等[44]仿真分析了不同介质材料作为钝化层对器件特性的影响,HfO2/Si3N4的堆叠复合一方面由于HfO2的高介电常数和热稳定性带来很好的电性能,另一方面Si3N4与GaN 的界面相容性更好,用作表面钝化层能够获得大电流和高击穿电压。如图5 所示,高介电常数表面钝化层更利于疏缓漏极附近的高电场而抑制电子俘获,再加上较低的界面缺陷密度,HfO2/Si3N4的堆叠复合钝化层得到最高的击穿电压。

图5 不同钝化层材料的HEMT 击穿电压对比[44]
3.2.2 盖帽层
GaN HEMT 由于靠近漏极一侧的栅极边缘电场集中,限制了击穿电压,增大了导通电阻。除了采用表面钝化层和场板技术可以改进器件的表面电场分布外,使用较厚的盖帽层也是增强击穿电压、抑制电流崩塌的可行办法。HAO 等[45]在常关AlGaN/GaN HEMT 中通过自对准氢等离子体处理技术,在器件栅漏和栅源之间制作高阻GaN 盖帽层,如图6 所示,得到高达1020 V 的击穿电压,且动态导通电阻仅为静态时的2.4 倍,有效抑制了电流崩塌效应。LIU 等[46]采用氧等离子体处理技术制作高阻GaN 盖帽层,实现了漏极泄漏电流低至4.4×10-7mA。YOSHIDA 等[47]通过实验验证了GaN 盖帽层厚度增加,动态导通电阻随之下降,而钝化层制作之前使用氧气等离子预处理也可以得到电流崩塌效应的改善。
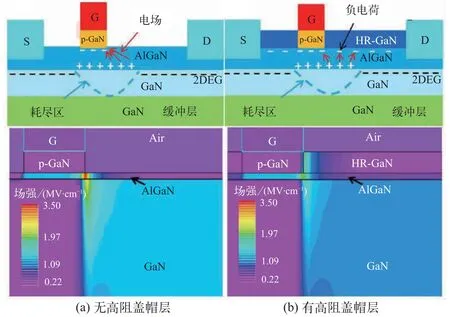
图6 有无高阻盖帽层的HEMT 结构示意图和电场分布图对比[45]
3.2.3 缓冲层
在GaN HEMT 结构中,需要沉积缓冲层用来消除衬底与GaN 之间的应力,通过碳掺杂或铁掺杂获得的高阻GaN 缓冲层对于获得优异的器件性能起到关键的作用。掺杂元素能够增加电阻率、减小缓冲区泄漏电流,增强击穿电压。DHARMARASU 等[48]通过调整GaN 缓冲区生长参数,得到高达3×1018cm-3的碳掺杂浓度。在对2DEG 性能、表面形态和晶体质量没有产生大影响的基础上,有效减小了缓冲区泄漏电流,增大了关断时的击穿电压。
LEE 等[49]采用周期重复的碳掺杂(PCD)GaN 缓冲层结构,即6 nm 厚碳掺杂GaN 和12 nm 厚非故意掺杂GaN 组成的结构周期重复,组成总厚度为2 μm 的缓冲层,有效抑制了不良陷阱效应,从而改善电流崩塌现象。为了进一步提升器件的动态特性,LEE 等在此基础上又在GaN 沟道和缓冲层之间引入了AlGaN背势垒层,如图7 所示,该结构将泄漏电流降低了2 个数量级,得到高达2 kV 的击穿电压。HAMZA 等[50]也报道了背势垒层可以减小HEMT 器件的泄漏电流,同时阈值电压向正向移动了1 V。
3.2.4 衬底材料
以SiC 为衬底材料,由于低寄生电容、较少的表面和界面陷阱效应等,相比其他材料上制作的GaN HEMT 开关速度、击穿电压以及直流特性等都更为优越,但制作成本一直是制约其发展的重要因素。PANDIT 等[51]仿真分析了SiC 衬底上的GaN HEMT,沟道具有很高的电子迁移率,从而得到非常低的导通电阻。
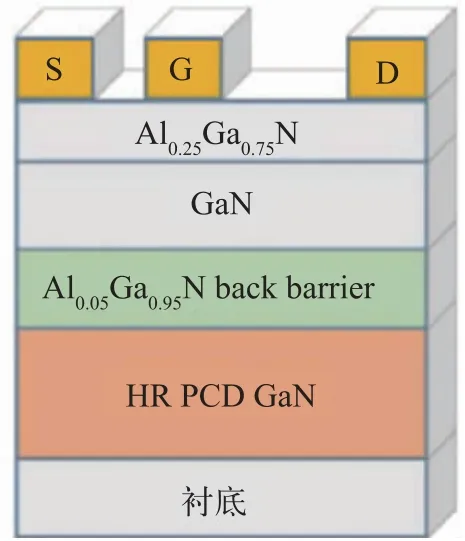
图7 PCD GaN 缓冲层及AlGaN 背势垒层结构示意图[49]
ANDERSON 等[52]使用金属-氧化物化学气相沉积方法在SiC、氢化物汽相外延(HVPE)GaN 以及氨热法GaN 衬底上生长GaN HEMT,实现了扩展缺陷密度超过5 个数量级的改变,增加了2DEG 迁移率,但抑制了欧姆接触的形成而使接触电阻增大。氨热法GaN 衬底上的HEMT 泄漏电流变大,而HVPE GaN衬底上的HEMT 由于缓冲区陷阱减少,器件的电流崩塌效应得到明显改善。KUMAZAKI 等[53]也在半绝缘铁掺杂的独立GaN 衬底上通过HVPE 制作了GaN HEMT,由于结晶质量的改善,同样发现缺陷带来的电流崩塌现象大幅减少。
硅上GaN 技术被公认为功率电子发展的重要突破[40],而大尺寸硅衬底上制作高压GaN 器件,与硅CMOS 工艺兼容还是有很多挑战的[54-55]。首先高压器件需要较厚的缓冲叠层,晶圆翘曲要控制在限度内以满足击穿电压需求,其次就是晶圆的机械强度要能承受工艺损伤,以及器件封装时背部减薄和金属化的实施等。LIU 等[56]将硅上GaN HEMT 转移到SiO2/Si 衬底上,打破了外延层厚度的限制,只有3.2 μm GaN 外延层的情况下,得到高达2200 V 的击穿电压,如图8(a)所示。缺点是SiO2的热导率较差,相比原来的硅上GaN 器件热阻明显增大,如果将SiO2替换为AlN 将带来极大改善,如图8(b)所示。
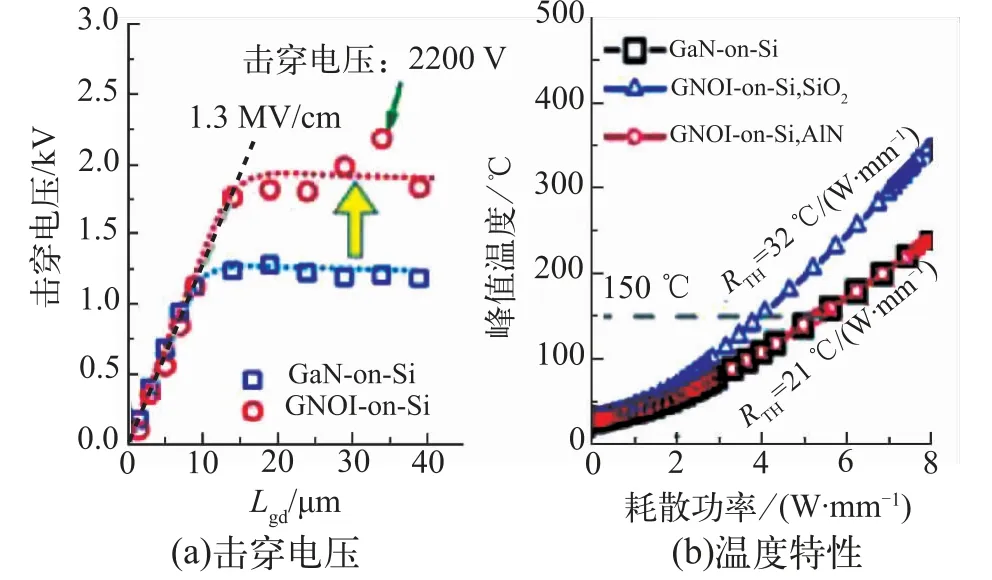
图8 GNOI-on-Si HEMT 与GaN-on-Si HEMT 的性能对比[56]
除了上述器件结构和材料以外,电荷俘获现象对GaN HEMT 器件性能的影响也不容忽视。器件在关断状态时,表面钝化层和界面中的杂质会在电场集中的近漏侧栅极边缘捕获电荷,当器件再次导通,这些电荷作为虚拟栅极会削弱2DEG[4,57],这个问题可以通过优化表面处理以及使用合适的钝化层彻底解决;MIS-HEMT 中栅绝缘层中的电子俘获会带来阈值电压位移,从而造成器件电学性能的不稳定[58];另外,器件在高温下工作时,热电子会注入到深度陷阱中,尤其是缓冲层掺杂带来的陷阱,这些捕获电荷也会削弱2DEG,增大导通电阻,可能造成器件的长期退化[59-61]。通过优化外延结构、减小垂直泄漏电流比例,可以显著降低陷阱效应带来的动态电阻增加。
4 GaN HEMT 器件最新研究进展
为了对比目前GaN HEMT 器件的技术发展和参数指标,将相关文献中的最新研究现状概括如表1 所示(“—”代表对应参数文献中未提及)。LEE 等[49]采用周期重复的碳掺杂GaN 缓冲层结构以及AlGaN 背势垒层,得到的D 型HEMT 泄漏电流低至2×10-3μA;LIU 等[56]以200 mm SiO2/Si 为衬底制作的D 型HEMT,击穿电压高达2200 V。
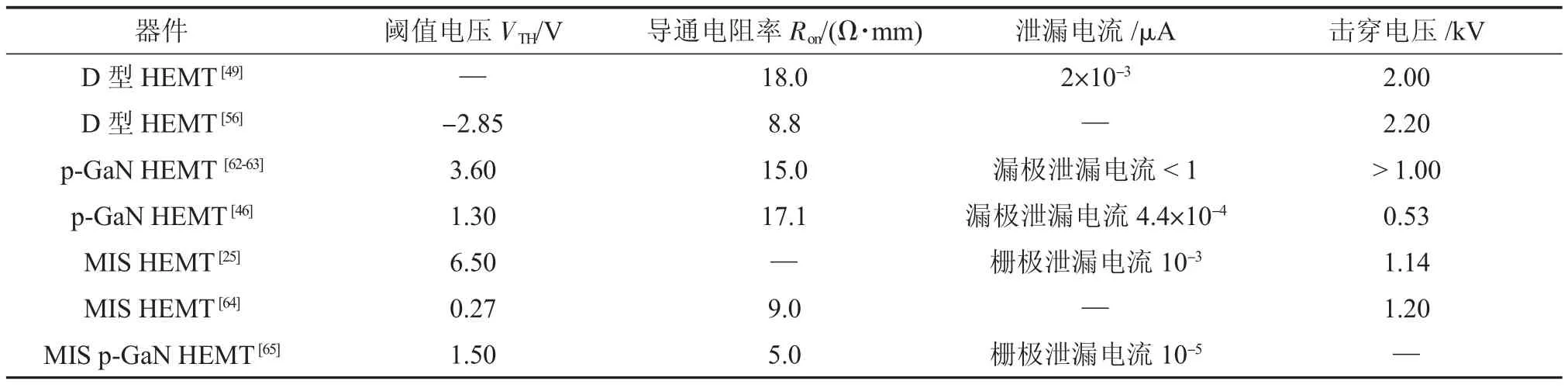
表1 GaN HEMT 器件最新参数指标对比
GREENS 等[62]在200 mm 多晶AlN 陶瓷芯和单晶硅组成的特制基板上成功制作出650 V p-GaN 栅HEMT,VTH高达3.6 V,Ron低至15 Ω·mm,关断状态下150 ℃击穿电压高达650 V 时,漏极泄漏电流只有1 μA。这种CMOS 工艺兼容的技术非常适合600 V 以上的电机驱动等应用,因为晶圆尺寸和缓冲区厚度都能得以满足;POSTHUMA 等[63]在200 mm P+硅衬底上制作了性能与参考文献[62] 类似的650 V P-GaN 栅HEMT,VTH略低,为2.8 V。
LIU 等[46]制作的含高阻GaN 盖帽层的p-GaN 栅HEMT 漏极泄漏电流很低;WANG 等[25]采用多层氟化栅堆叠制作的MIS-HEMT 得到高达6.5 V 的阈值电压;考虑到大尺寸晶圆工艺一致性带来的良率问题,HUANG 等[64]提出了超薄势垒层无嵌入技术,器件结构如图9 所示。以5 nm 厚的超薄AlGaN 势垒层来形成栅极沟道的常关特性,再通过低压化学气相沉积钝化层介质来恢复栅源和栅漏区域的2DEG,从而大幅降低导通电阻。由于去掉了嵌入刻蚀工艺,GaN HEMT的生产良率可以得到明显改善;YU 等[65]报道了一种新型E 型MIS HEMT 结构,如图10 所示,在p-GaN栅周围沉积绝缘层和栅金属,构成MIS 结构,栅极泄漏电流相比于肖特基栅HEMT 下降了8 个数量级。
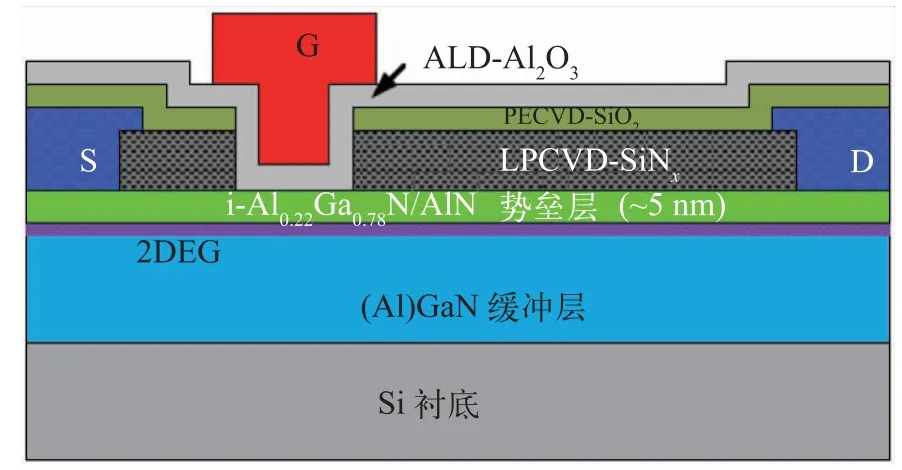
图9 超薄势垒层无嵌入结构MIS-HEMT[64]
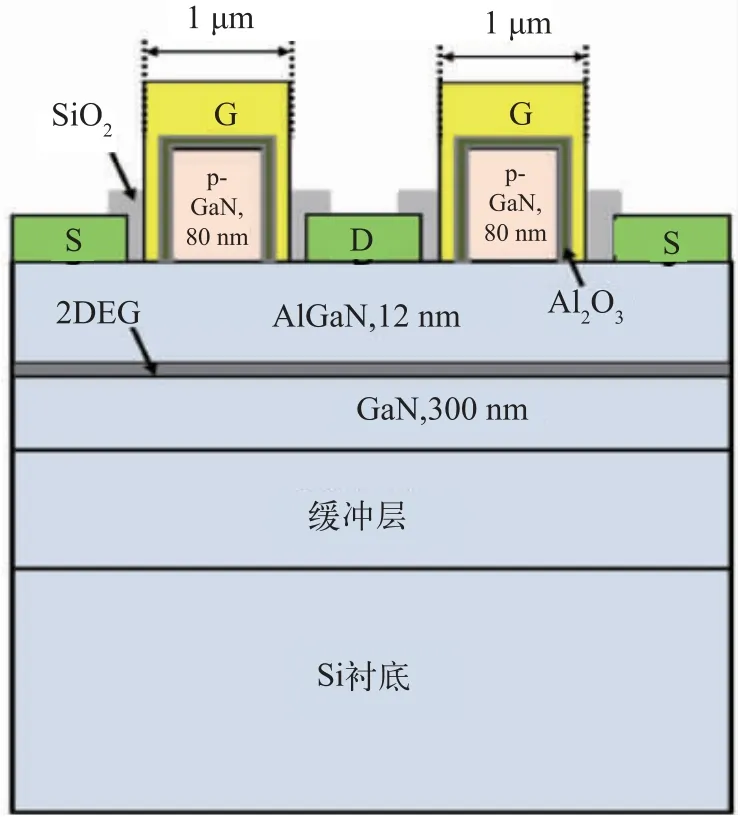
图10 栅包围MIS p-GaN HEMT 结构示意图[65]
5 结论
GaN HEMT 器件在工作过程中,电流崩塌现象以及击穿电压、泄漏电流等关键参数与器件工艺结构和表面钝化层、盖帽层、缓冲层以及衬底材料特性紧密相关。本文对国内外的相关研究现状进行综述,对p-GaN 栅、MIS HEMT 等构造增强型GaN HEMT 的典型技术方案进行总结分析,为GaN HEMT 的研发及其在应用中优越性能得以充分发挥提供了有价值的参考。
