GaN 单片功率集成电路研究进展*
2021-03-22赖静雪陈万军孙瑞泽
赖静雪,陈万军,孙瑞泽,刘 超,张 波
(电子科技大学电子薄膜与集成器件国家重点实验室,成都 610054)
1 引言
第三代宽禁带半导体材料和器件的发展促进了功率集成电路整体性能的提升。由于GaN 材料和AlGaN/GaN 异质结结构的优异特性,AlGaN/GaN 高电子迁移率晶体管(HEMT)已经开始作为主要开关器件被广泛应用于各类高频、高效功率变换器中[1-2]。基于GaN 器件的应用导向型集成技术的市场价值正在逐渐扩大,为了更好地发挥GaN 基功率集成电路的性能优势,需要尽可能提高开关器件、控制电路和无源器件间的集成度[3],将控制、监测和保护等电路单片集成可显著提升GaN 集成电路的多功能性与集成度[4]。
应用于功率转换领域的GaN 单片集成电路的工艺平台可采用已有的商业化耗尽型HEMT 器件工艺平台[5]。RODRÍGUEZ 等利用0.15 μm GaN-on-SiC/Si耗尽型工艺平台实现了集成栅驱动的GaN 半桥功率变换器[6-8]。随着增强型HEMT 工艺的出现,采用增强型HEMT 器件的GaN 集成电路开始快速发展[9-12]。研究者提出了多种基于增强型GaN HEMT 的模拟或数字集成电路[3,12-14],包括模拟电路中的比较器[15-16]、电压基准源[15]、温度传感器[17]、数字功能IC[18]和逻辑门电路[19]。研究人员采用多种不同的增强型工艺流程来制造GaN 单片集成电路,例如氟离子注入技术[9,20]、凹槽栅技术[10]、栅注入晶体管[21-22]和p-GaN 帽层结构[23-25],同时多种新型器件结构和技术也可应用于GaN 集成工艺平台中[26-28]。
全GaN 单片集成电路技术的发展需要在稳定的工艺平台基础上,深度优化基本功能子电路设计,才能研制出性能更佳、功能更丰富的全GaN 单片功率集成电路。本文介绍了不同类型的全GaN 集成工艺平台以及GaN 基功能子电路的研究进展,并对GaN 单片功率变换集成电路的研究现状进行了综述。
2 GaN 功率集成工艺平台
AlGaN/GaN 异质结界面处由于极化效应而存在二维电子气沟道,因此未作增强型处理的GaN HEMT是常开器件,这导致早期GaN 工艺平台以耗尽型工艺为主。由于GaN HEMT 在微波射频IC 领域的广泛应用,早在2004 年就有报道基于耗尽型GaN HEMT 器件的集成功率变换器[29]。2016 年RODRÍGUEZ 等利用商用0.15 μm GaN-on-SiC/Si 耗尽型工艺平台实现了应用于降压变换的GaN 功率IC,该GaN 功率IC 单片集成了栅驱动和功率开关[6-8]。该耗尽型工艺平台如图1 所示,其中有源器件包括0.15 μm T 型栅HEMT、肖特基二极管、0.5 μm 100 V HEMT 功率开关,同时还集成无源MIM 电容。
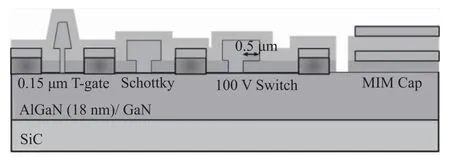
图1 0.15 μm GaN-on-SiC/Si 耗尽型工艺平台
然而利用耗尽型HEMT 工艺流程来实现集成栅驱动的GaN 半桥功率变换器,意味着电路中HEMT器件的阈值电压均为负值[6-8],需要额外电压源来提供负栅驱动偏压,同时耗尽型HEMT 器件栅压摆幅小,这都使GaN 功率变换器IC 设计变得更为复杂。增强型GaN HEMT 则不需要额外的负电压源[9-10,12,20,30],能够极大简化GaN 集成电路的设计和工艺复杂度。因此,随着增强型技术的发展,采用增强型HEMT 技术的GaN 集成电路平台逐渐成为主流。
2005 年,香港科技大学提出氟离子注入增强型HEMT 器件结构[31],在该结构的基础上大力发展增强型与耗尽型HEMT 器件的单片集成技术,实现了数字逻辑电路、反相器、环形振荡器等多种电路结构[32]。2009 年,香港科技大学报道了基于氟离子增强型结构的GaN 智能功率集成平台[9,15,33],如图2 所示,并基于该平台实现了GaN 基比较器和基准电压源等电路。
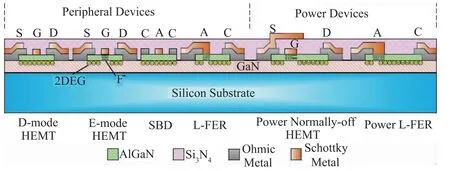
图2 基于氟离子增强型技术的GaN 智能功率集成平台[15]
尽管采用增强型HEMT 技术的GaN 集成电路不需要额外的负电压源,但器件栅压摆幅仍然被栅极肖特基结构的耐压能力所限制,导致器件极容易因为栅极泄露电流或栅极击穿而出现性能退化。p 型(Al)GaN帽层增强型技术可以有效地减小栅极泄漏电流并扩大栅压摆幅[11,21-22]。德国夫琅禾费应用固体物理研究所于2018 年报道了其开发的p 型栅增强型集成工艺平台[34],如图3 所示。该工艺平台实现了GaN 功率管内集成肖特基二极管,并集成了电流和温度传感器,更有利于全GaN 集成电路的设计与功能实现。基于该工艺平台,德国夫琅禾费应用固体物理研究所实现了可工作在3 MHz 的400 V 转200 V 全GaN 降压功率IC。
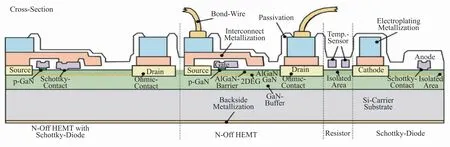
图3 基于p 型栅增强型集成工艺平台[34]
台积电也基于p 型(Al)GaN 帽层增强型技术开发了商业化100 V/650 V GaN-on-Si 增强型功率IC 工艺平台,如图4 所示,台积电利用该工艺平台为包括GaN System、Navitas 等在内的多家公司代工。

图4 基于p 型栅100 V/650 V GaN-on-Si 功率IC 工艺平台
除氟离子注入技术和p 型栅结构外,凹槽栅结构也是实现增强型GaN HEMT 器件常用的技术。电子科技大学功率集成技术实验室通过凹槽栅增强型技术,开发了一套基于AlGaN/GaN MIS-HEMT 的全GaN集成工艺平台,如图5 所示。该工艺平台具有无金欧姆接触,与CMOS 工艺相兼容,同时在功率器件中集成了嵌入式电流传感器结构[35]以实现功率变换器的电流反馈控制功能。基于该工艺平台,电子科技大学功率集成技术实验室实现了具有多种功能的全GaN 智能功率变换器[36]。

图5 基于MIS 凹槽栅技术的GaN 功率集成工艺平台[36]
耗尽型GaN 集成工艺平台主要应用于微波射频IC,而增强型GaN 集成工艺平台更适用于高压功率IC 的制造,尤其是高压功率变换的应用,在此类功率变换集成电路中往往存在高低压器件隔离问题,而传统的GaN 功率集成工艺平台多采用离子注入隔离或槽隔离技术,这2 种隔离技术都不能完全解决集成电路中的高低压串扰问题。基于此问题,比利时IMEC 研究所提出GaN-on-SOI 工艺平台,解决了高低压隔离和衬偏效应。但该工艺平台的SOI 隔离技术散热性能和可靠性有所不足。因此,如何能够在不影响GaN 集成电路可靠性的同时解决高低压隔离和衬偏效应是未来GaN 集成工艺平台发展中需要解决的问题之一。
3 应用型功能子电路模块
GaN 基功能子电路是设计和实现全GaN 功率集成电路的基础。全GaN 功率IC 本质上是由不同的功能子电路模块构成,通过集成不同的子电路模块来实现功能更丰富、更完善的全GaN 功率IC。以全GaN 功率变换器IC 为例,图6 为电子科技大学功率集成技术实验室设计的全GaN 功率变换器IC 的原理框图,该功率变换器主要由高边栅驱动、过流保护、脉冲宽度调制(PWM)信号发生器、反馈控制回路和功率变换回路5 个模块组成,其中功率变换模块是整个GaN 功率变换器的核心,其余的功能子电路则有助于在全GaN单片集成电路中实现功能更加完善的功率变换器。因此了解GaN 基功能子电路的设计和发展是实现全GaN 单片集成电路的前提和基础。

图6 全GaN 功率变换器IC 原理
3.1 反相器
反相器是功率变换电路中最基础的组成部分。基于反相器结构,可以实现缓冲器、驱动、环形振荡器等多种功能电路。因此,对GaN 单片集成电路的研究最早从反相器这种基础电路结构入手。图7(a)所示为基于n 沟道GaN HEMT 器件的反相器电路结构。反相器由一个耗尽型GaN HEMT 和一个增强型GaN HEMT构成。反相器作为模拟电路和数字电路中最常见的模块,可以实现信号180°相位翻转。在NMOS 逻辑下,耗尽型GaN HEMT 作为有源负载,而输入信号则施加在增强型GaN HEMT 的栅极上。
早在2005 年,香港科技大学团队就基于所提出的氟离子注入增强型技术实现了GaN 基反相器集成电路[31],该反相器在Vdd为1.5 V 时的输出逻辑摆幅为1.25 V,低电平噪声容限为0.21 V,高电平噪声容限为0.51 V。香港科技大学团队并在此GaN 基反相器的基础之上实现了单片集成的GaN 基17 级环形振荡器,图7(b)展示了该环形振荡器的电路结构,该电路由36个晶体管组成,基本工作频率为193 MHz,Vdd=3.5 V时每级延迟为0.13 ns,Vdd=1 V 时每级产生的延迟功耗低至0.113 pJ。香港科技大学团队还在2007 年报道了所制造的反相器和环形振荡器在375 ℃时的高温特性[32],且2017 年报道了利用新型0.5 μm p-GaN 增强型工艺实现的性能更佳、结构复杂的101 级环形振荡器,该振荡器在输入电压为4 V 时,每级延迟仅为0.1 ns[18]。香港科技大学在最新发表的论文中报道了利用新型GaN E-mode n-/p-channel HEMT 工艺所实现的反相器集成电路[37],电路拓扑和器件工艺结构如图8 所示。该反相器由GaN p-FET 和n-FET 组成,p-FET采用MIS 凹槽栅埋层p 沟道工艺,n-FET 则采用p-GaN 栅增强型技术,得以首次在GaN 集成电路中实现CMOS 逻辑,该反相器可实现5 V 的轨对轨输出。
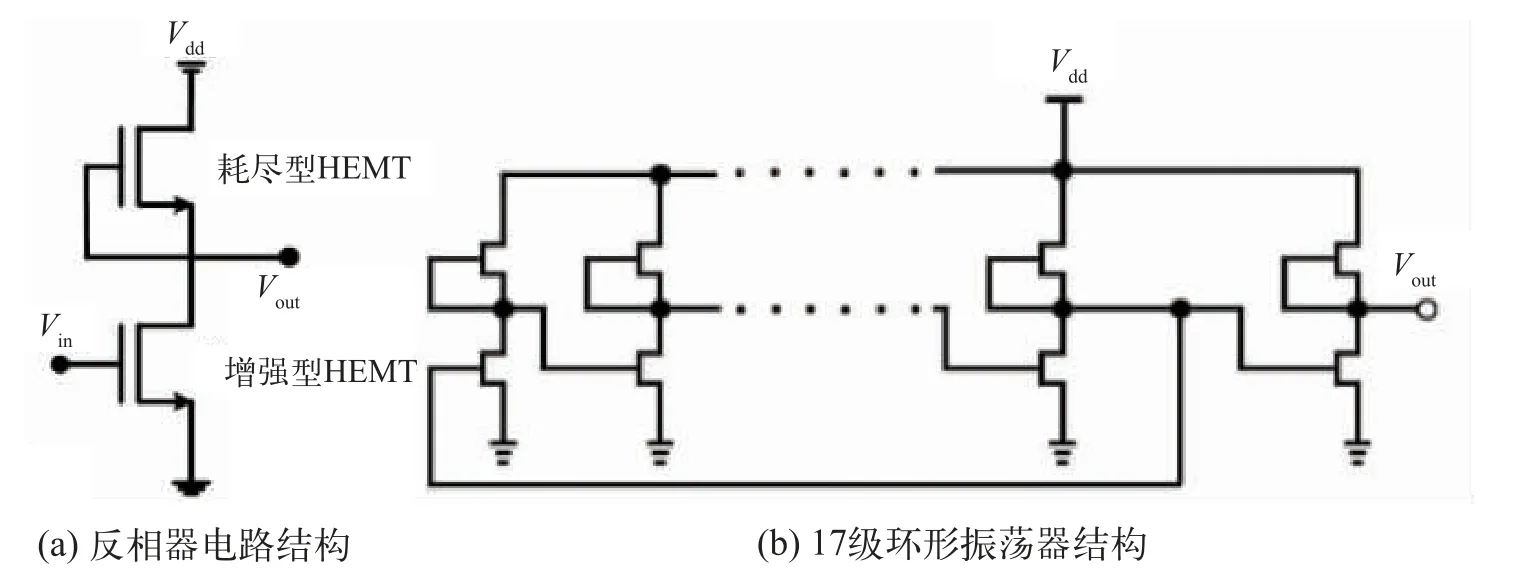
图7 反相器和环形振荡器电路[31]
此外,2014 年,中国电子科技集团公司第55 研究所基于MIS 凹槽栅技术实现了Vdd为5 V 时输出摆幅为3.75 V 的GaN 基反相器IC 和51 级环形振荡器[38],该环形振荡器基本工作频率为427 MHz,每级延迟仅为0.023 ns。2015 年,新加坡国立大学采用MIS 凹槽栅和氟离子注入相结合的技术实现了Vdd为10 V、最大输出摆幅为9.66 V、高低电平噪声容限分别为4.9 V和3.2 V 的GaN 基反相器IC[39]。图9 展示了该反相器在输入100 kHz 方波信号时的输入和输出波形。2018年ZHU 等采用MIS 凹槽栅工艺基于反相器结构实现了非门、与非门和或非门3 种逻辑门电路,并且该数字逻辑IC 在高温下仍然保持良好特性[19]。表1 给出了部分报道的GaN 基单片集成反相器IC 的工艺性能等关键参数的对比总结,其中NMOS 逻辑是GaN 基集成电路常用逻辑,但无法实现如CMOS 逻辑一样的轨对轨输出,始终存在一定的功率损耗。

图8 基于GaN E-mode n-/p-channel HEMT 工艺的反相器[37]

图9 100 kHz 下反相器动态性能[39]

表1 已报道的部分GaN 基反相器IC 关键参数对比
3.2 比较器
比较器是模拟电路实现比较和计算功能的基本单元,功率变换电路中的PWM 信号发生器和反馈控制回路等比较器都是其重要组成部分。采用单输出结构[16]的比较器电路如图10(a)所示,常见的单输出比较器由2 个耗尽型MIS-HEMT 构成电流镜的有源负载,增强型MIS-HEMT 作为差分输入对,并采用一个栅源短接的耗尽型MIS-HEMT 作为电流偏置。2009 年香港科技大学基于所开发的GaN 智能功率集成平台设计制造了一款GaN 基比较器[15],通过为用作电流偏置的HEMT 器件栅极额外提供具有温度补偿特性的偏置电压电路,使得该比较器与传统比较器相比具有更好的温度稳定性,该比较器结构如图10(b)所示。2019年电子科技大学功率集成技术实验室则利用MIS 凹槽栅工艺平台实现了采用单输出结构的GaN 基比较器[36],该比较器的输入信号电压范围为0~10 V,当参考电压Vref为2 V、3 V、4 V、5 V、6 V、7 V、8 V 时,该比较器均能实现比较功能。
3.3 PWM 信号发生器
PWM 信号发生器是功率变换器中的重要组成单元,主要用于为驱动提供栅信号,并且可通过反馈回路调制PWM 信号的占空比从而控制功率变换输出电压。PWM 信号发生器由锯齿波发生器和PWM 比较器2 部分构成,将锯齿波发生器产生的锯齿波信号与反馈回来的变换器输出信号进行比较并输出相应的PWM 信号,其中PWM 信号的频率由锯齿波信号决定,占空比则由输出信号调制得到。
2015 年香港科技大学报道了所设计的PWM 集成电路,该PWM 信号发生器由锯齿波发生器和PWM比较器两块GaN 基IC 组成,该GaN PWM 信号发生器工作频率为1 MHz,且在250 ℃高温下也能正常工作[40]。2019 年电子科技大学功率集成技术实验室首次报道了全集成式的GaN 基PWM 信号发生器[36],芯片显微图像和电路拓扑结构如图11(a)所示,包括了迟滞比较器、锯齿波单元和PWM 比较器3 部分,PWM 信号频率为10.8 kHz,反馈电压范围为3~8 V 时,输出信号占空比范围为28.1%~76.8%,其输出结果如图11(b)所示。

图10 比较器电路[15-16]

图11 全集成式GaN 基PWM 信号发生器[36]
3.4 基准电压源
基准电压源负责为电路提供稳定的参考电压,因此对基准电压源的精度和温度稳定性要求较高。传统带隙基准和CMOS 基准的工作温度范围较低,在极限温度环境中工作性能不佳。而得益于GaN 材料的宽禁带特性和良好的温度特性,GaN 基基准电压源的工作温度范围更广。
2009 年香港科技大学首次利用所开发的GaN 智能工艺平台实现了GaN 基基准源IC,该基准源IC 的电路结构和芯片显微图像如图12(a)所示,该基准源的工作温度可高达250 ℃且温漂小于70×10-6/℃[15]。2020年LIAO 等采用P-GaN 增强型技术设计实现了一款性能更佳的GaN 基基准源IC,其芯片显微图像如图12(b)所示,该基准源IC 输入电压范围为3.9~24 V,工作温度范围为-50~200 ℃,其温漂为23.6×10-6/℃[41]。
3.5 保护功能电路
在功率变换集成电路中,保护电路可分为过压保护和过流保护2 种,过压保护主要针对开关器件的栅极保护,过流保护则是避免因负载短路或上下管穿通导致电流过大进而开关管烧毁的情况。
在功率变换应用中,为了获得更小的导通压降,高边开关管在开关过程中往往是过驱动状态,肖特基金属栅极漏电较高,在正向偏压下栅极漏电与栅压呈指数关系,因此过驱动状态下栅极漏电会迅速升高导致器件性能退化甚至失效。2013 年香港科技大学通过在GaN E-HEMT 栅极处集成一个栅源短接D-HEMT器件来钳制栅极电流大小以实现栅极过压保护的功能,该集成电路显微图像和电路结构如图13 所示,该栅极过压保护IC 实现了超过20 V 的栅压摆幅并且导
通电流和耐压与传统E-HEMT 相比没有下降[42]。
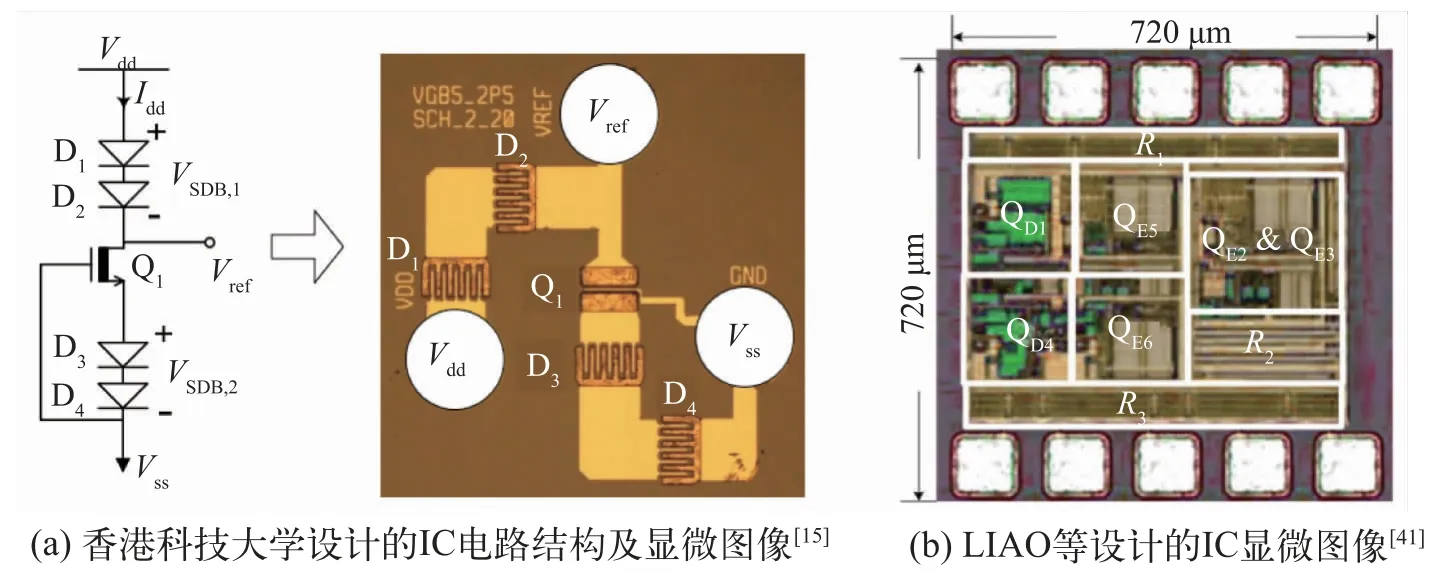
图12 GaN 基基准源
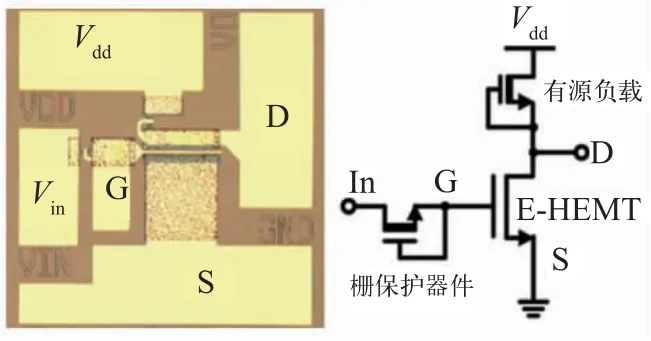
图13 GaN 栅极过压保护IC 显微图像及电路结构[42]
过流保护电路的结构相对更加复杂,通过将变换器主回路电流或电压采样返回的信号与参考电压进行比较,若过流则最终输出过流保护信号控制栅极驱动关断开关器件。2019 年香港科技大学提出了一种过流保护电路结构,并基于其GaN 基工艺平台将过流保护回路与驱动和功率开关管集成在一起,其过流保护IC 将传感组件和时间控制器分开,进一步提升过流保护系统的响应速度,如图14(a)所示为该过流保护IC的电路拓扑图,除负载外所有元件均集成在同一块GaN 基IC 上[43]。2020 年电子科技大学功率集成技术实验室基于所开发的GaN MIS 凹槽栅增强型工艺平台实现了过流保护回路与驱动和开关器件的集成,图14(b)展示了该集成电路的图像[44],蓝色线条为测试时外接的无源器件和二极管,红色箭头标识所加电源和测试点位置。
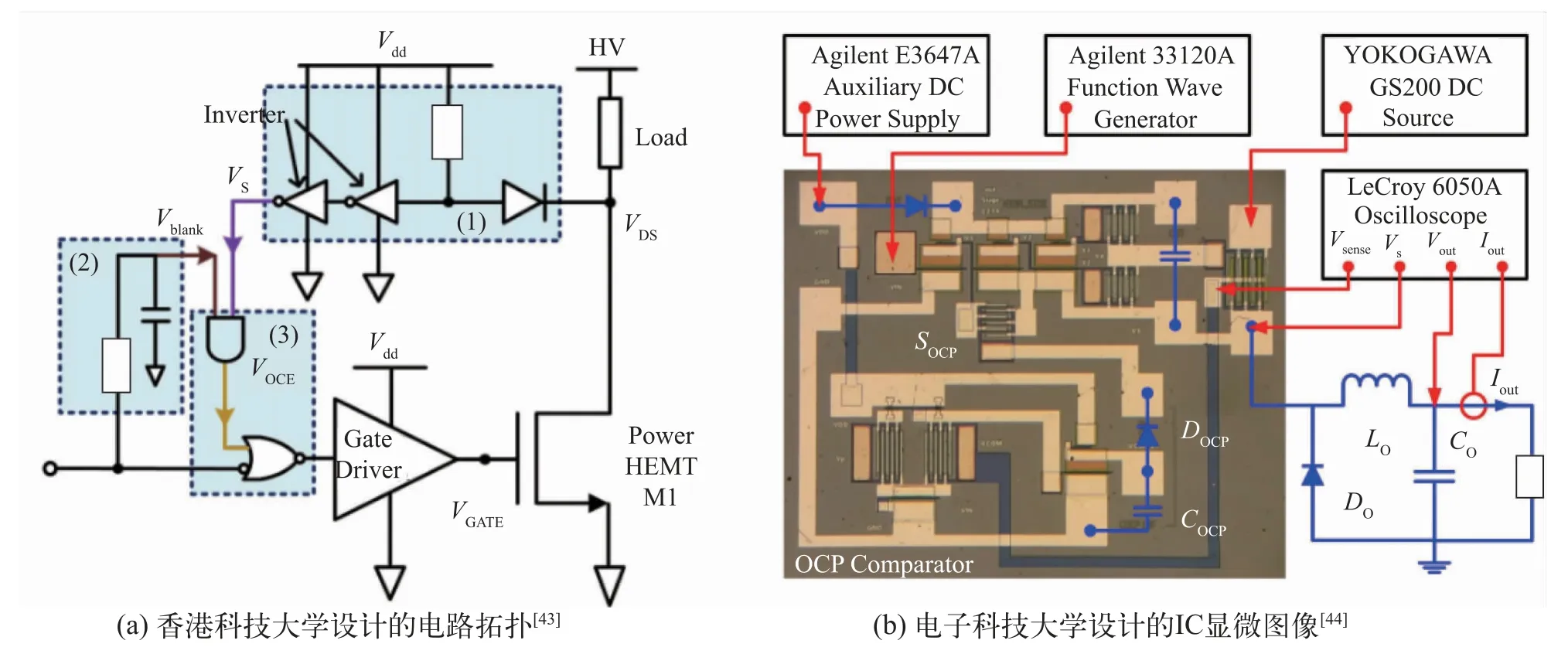
图14 GaN 过流保护IC 电路[43-44]
随着GaN 器件增强型技术的不断完善,GaN 功率集成技术朝着更丰富的集成功能、更高的工作频率、更大的输出功率与更高的集成度等多方向发展。除以上主要应用于功率变换领域中的功能子电路外,也有其他的子电路类型,如GaN 模拟IC、数字IC 或数模混合IC,香港科技大学曾于2012 年报道过设计制造的应用于数模转换的2 级GaN 基数字转换器以及寄存器[45]。
4 全GaN 功率变换器IC
由于电路中的寄生参数以及硅驱动电路工作频率的限制,采用GaN HEMT 作开关器件的分立型功率变换器并不能完全发挥出GaN HEMT 的性能优势。低寄生参数、高功率密度、高工作频率的全集成式GaN功率变换器正在快速发展。
2008 年香港科技大学基于氟离子注入增强型技术实现了HEMT 与二极管单片集成功率变换器[46],这是最早的GaN 集成功率变换器的报道,所制造的GaN 功率集成变换器芯片的显微图像及电路结构如图15 所示,该变换器实现了1 MHz 频率下10~21 V的升压功率变换,效率达到84%。2012 年日本松下公司报道了应用于DC-DC 变换器的集成硅肖特基二极管的GaN 半桥结构[47];2016—2017 年德国夫琅禾费应用固体物理研究所报道了集成续流二极管的GaN-on-Si 半桥结构,并对600 V/20 A 量级的GaN 集成半桥的衬底偏置效应进行了研究[48-49]。

图15 单片集成式GaN 功率变换IC 电路结构及照片[46]

图16 集成栅极驱动的GaN DC-DC 变换器IC 显微图像和电路拓扑[22]
在半桥结构的基础之上,为进一步缩小面积、提升功率密度,一些研究者和公司将栅极驱动集成到功率半桥上实现集成功率变换器。2014 年日本松下公司报道了集成栅极驱动的GaN DC-DC 变换器IC,该变换器IC 可实现2 MHz 频率下12 V 转1.8 V 降压功率变换,效率达到86.6%,所制造的GaN DC-DC 变换器IC 的电路拓扑结构和显微图像如图16 所示[22]。此后2015 年、2018 年德国夫琅禾费应用固体物理研究所[50]和香港科技大学[51]也分别报道了集成栅极驱动的600 V 和650 V 量级的GaN IC。
虽然GaN 集成功率半桥已经能够让工作频率从传统的65~100 kHz 提升至1 MHz 以上,全GaN 功率变换器可进一步减小寄生参数以进一步提升工作频率。2015 年美国科罗拉多大学波德分校报道了采用商用0.25 μm 耗尽型HEMT 工艺平台所制造的全GaN降压功率变换器,该变换器工作在25 V、20 MHz 时效率可达89.7%[52]。2016 年美国Teledyne 公司利用所开发的0.15 μm GaN-on-SiC/Si 耗尽型工艺平台实现了20 V、5 W、100 MHz 降压功率变换器[7]。通过采用p 型栅增强型集成工艺平台,德国夫琅禾费应用固体物理研究所于2018 年报道的全GaN 降压功率集成电路在3 MHz 频率下可实现400~200 V 功率变换[34]。该研究所制造的GaN 功率IC 显微图像如图17 (a) 所示,该GaN 功率变换IC 在输入200 V 时的VSW信号、高低边栅信号(VGS)和电感电流信号(IL)的波形变化如图17(b)所示,其工作频率可达40 MHz。2016—2019 年基于所开发的凹槽栅增强型集成工艺平台,电子科技大学功率集成技术实验室报道了从器件到功能子电路再到应用型GaN 功率变换器IC 的完整集成方案,该全GaN 智能功率变换器集成了包括栅极驱动、反馈控制和过流保护等多种功能,并实现了15~30 V 转10 V 的降压变换[36]。
表2 总结了2008 年以来部分团队发表的关于全GaN 单片集成功率变换器的工作成果。从表中可以了解到全GaN 功率变换IC 的集成度在逐渐增加,2015年前GaN 基功率变换IC 主要集成相对简单的功率变换开关模块或栅驱动模块,2015 年后开始出现集成电路更复杂完善、功能更丰富的全GaN 式功率变换器。对比表中采用不同工艺的全GaN 功率变换IC 的性能可知,采用耗尽型HEMT 工艺的全GaN 集成功率变换器IC 的工作频率相对更高甚至能达到上百兆赫兹,而采用增强型HEMT 工艺的全GaN 集成功率变换器IC 的工作频率主要集中在1 MHz 左右,但在600 V 量级的高压、高频领域具有更大的应用潜力和优势。

图17 应用于功率变换的全GaN 功率IC[34]

表2 已报道的部分GaN 基功率变换IC 关键参数对比
5 结论与展望
全GaN 集成功率变换器IC 具有低寄生参数、高功率密度、高工作频率等优点,各种丰富的GaN 基功能子电路的实现促进了全GaN 单片集成功率变换IC的发展,现有研究的报道成果也证明了全GaN 单片集成功率变换器IC 在高频功率变换领域中的优势。然而由于传统GaN HEMT 主要为n 沟道器件,所以大部分GaN 基集成电路均采用NMOS 逻辑,NMOS 逻辑与CMOS 逻辑相比仍然存在一定的功耗损失,因此若要进一步提高全GaN 集成电路整体性能,除了改进工艺和电路拓扑结构外,另一个直接的方法则是采用CMOS 逻辑。但GaN p 沟道HEMT 的性能与n 沟道HEMT 相差较大,难以匹配,若直接采用CMOS 逻辑反而会拉低整个电路的性能,限制GaN 基CMOS 逻辑集成电路发展的最大障碍就是GaN p 沟道器件的性能提升。因此未来对GaN p 沟道HEMT 器件结构的改进及工艺水平的提升将是促进全GaN 单片集成电路的发展和革新的方向之一。
本文介绍了不同类型的全GaN 集成工艺平台以及部分GaN 功能子电路的研究发展,并对GaN 功率变换器单片集成电路的研究现状进行了综述,希望为未来全GaN 集成功率IC 的发展和应用提供有价值的参考。
