抛光介质对镁合金化学机械抛光的影响*
2016-09-13黄华栋杨大林闵鹏飞赵永武
黄华栋 卞 达 杨大林 闵鹏飞 赵永武
(①苏州工业职业技术学院,江苏 苏州 215104; ②江南大学机械工程学院,江苏 无锡 214122)
抛光介质对镁合金化学机械抛光的影响*
黄华栋①②卞达②杨大林②闵鹏飞②赵永武②
(①苏州工业职业技术学院,江苏 苏州 215104; ②江南大学机械工程学院,江苏 无锡 214122)
利用扫描电镜、X射线光电子能谱仪和白光干涉仪研究了碱性抛光液中不同有机溶剂与无机溶剂包括乙二醇、聚乙二醇、去离子水和1%磷酸氢二钠水溶液对镁合金化学机械抛光效果的影响,测试了材料的去除率。结果表明,当采用乙二醇、聚乙二醇等有机溶剂作为抛光液的抛光介质时,能够有效改善镁合金在抛光过程中的点蚀现象,但材料去除率较低;采用去离子水作为抛光介质时,虽然材料去除率较高,但抛光后镁合金表面点蚀现象严重;采用去离子水作为抛光介质并添加1%的缓蚀剂磷酸氢二钠时,能够在保证材料去除率的同时,有效改善镁合金抛光后的表面质量,而且几乎没有点蚀出现。
化学机械抛光;抛光介质;粘度;去除率;粗糙度;点蚀
随着科技和工业的快速发展,镁合金在工业上的应用越来越多,与其他结构材料相比,镁合金具有如密度低、比强度和比刚度高、减振性好、抗辐射等优点,在电子、汽车、航空航天等领域都体现着重要的应用价值,由于应用前景广阔,所以追求其表面完美性要求也随之提高。目前,国内外对于微电子半导体领域的化学机械抛光(CMP)已经做了大量研究[1-6],但对于合金尤其是镁合金的化学机械抛光研究较少。CMP技术就是通过表面化学作用和抛光磨粒等机械作用二者协同达到材料表面的整平去除[7-11]。本文选用碱性抛光液体系[12],针对不同抛光介质对镁合金化学机械抛光效果和去除率的影响,展开抛光实验和理论研究。
1 实验
1.1实验材料
试样为20 mm×20 mm×5 mm的AZ91D镁合金基片,先用砂纸打磨,后经过微米CeO2磨粒抛光液粗抛,最后用丙酮超声波清洗并冷干处理。
自制纳米CeO2磨粒碱性抛光液,母液主要成分为:磨料{CeO2,60 g (15wt%)}、表面活性剂{TX-10,8 g (2wt%)},同时通过有机碱将抛光液pH值调节至10。
乙二醇(水分≤0.1%,分析纯AR,分子量62.07),聚乙二醇(液体,化学纯CP,平均分子量190~210),磷酸氢二钠(十二水合磷酸氢二钠,分析纯AR,分子量358.14),国药集团化学试剂有限公司。
1.2实验设备
抛光机:UNIPOL-1200S自动压力研磨抛光机(沈阳科晶设备有限公司);超声波清洗机:UC1800(广州维利超声电子设备有限公司);称重天平:XS205-DU精密天平,精度为0.1mg(梅特勒-托利多);能谱仪(EDS):Phoenix(美国伊达克斯有限公司);场发射扫描电子显微镜(SEM):S-4800(日立);白光干涉仪:Contour GT(布鲁克); X射线光电子能谱仪:Kratos AXIS Ultra DLD(日本岛津-KRATOS公司);旋转粘度计:NDJ-1(北京中仪科信科技有限公司)。
1.3抛光参数
抛光液流量120 mL/min,抛光压力20.4 kPa,抛光盘上下盘转动方向相同[8],转速为120 r/min,抛光时间4 min。选用磨砂革抛光垫,抛光后用无水乙醇在超声波清洗机中清洗20 min。
1.4性能检测
采用EDS分析镁合金基片中元素的具体成分含量;采用SEM观测磨粒,对粒径大小以及形状进行表征;采用白光干涉仪对微米CeO2磨粒抛光液抛光处理后的镁合金基片表面,进行形貌观测和粗糙度测量;采用旋转粘度计测量不同抛光介质配制而成的抛光液粘度值,结合材料去除率,分析不同抛光介质对镁合金材料去除率的影响;采用精密天平测定抛光前后镁合金基片的质量损失(Δm)并计算抛光去除速率MRR为:
(1)
式中:M0为抛光前镁合金基片质量,g;M1为抛光后镁合金基片质量,g;ρ为镁合金密度,g/cm3;S1为镁合金基片面积,cm2;T为抛光时间,min。
2 结果与讨论
2.1磨粒表征及试样粗抛表征
实验试样为镁合金基片,其化学成分通过EDS分析如图1a所示,镁合金基片其镁元素含量为97.25wt%,铝元素含量为2.75wt%;由图1b看出,自制纳米CeO2碱性抛光液母液磨粒的平均粒径为50 nm左右,磨粒形貌为圆形。图2是镁合金基片经微米CeO2抛光液预抛光处理后的表面形貌及粗糙度,由图看出,预抛光处理后的试样表面粗糙度为0.55 μm左右。
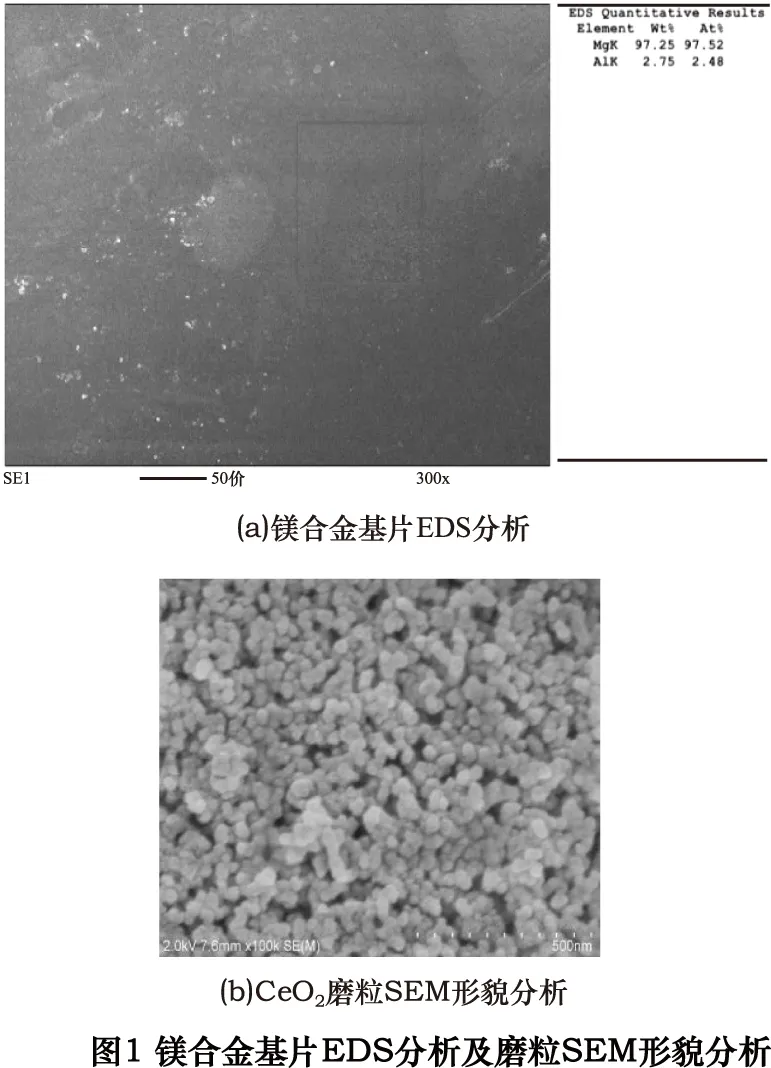

2.2不同抛光介质对镁合金CMP点蚀的影响
实验分4组进行抛光实验,抛光介质分别为:抛光液(A)“乙二醇”,抛光液(B)“聚乙二醇”,抛光液(C)“去离子水”,抛光液(D)“去离子水 + 缓蚀剂{Na2HPO44g(1wt%)}”。采用50 nm粒径15wt%的CeO2磨粒,在上述1.3节抛光参数条件下,对镁合金基片进行不同抛光介质下的抛光后,镁合金表面点蚀情况见图3所示。

从表面形貌图3中d-b、a-c的色泽反映为:其粗糙度值依次增大。在白光干涉仪测量的表面形貌图3a、b、c可以看出,采用抛光液(A、B、C)抛光后的镁合金基片表面均存在一定的点蚀现象,并且图3c的点蚀现象比图3a、b明显。图3d所示镁合金基片表面形貌较好,几乎没有点蚀存在。分析认为:抛光液(A、B)是分别以乙二醇和聚乙二醇两种有机溶剂作为抛光介质的抛光液,而镁合金在有机溶剂抛光介质中几乎不发生腐蚀反应,所以点蚀现象轻微;抛光液(C)是以去离子水为抛光介质的抛光液,由于镁合金基片性质活跃,其表面与去离子水接触发生腐蚀反应,从而在抛光后点蚀现象明显;抛光液(D)是以去离子水为抛光介质并添加缓蚀剂Na2HPO4(1%)配制而成的抛光液,抛光后镁合金基片表面几乎没有点蚀现象出现,如图3d。
2.3磷酸氢二钠对镁合金CMP缓蚀作用
图4为镁合金基片经Na2HPO4(1wt%)水性抛光液抛光后的表面XPS图谱,其Mg、Na、C、O、P等元素的峰位置见表1。发现在130.6eV处有P2p峰,分析认为当抛光液中添加磷酸氢二钠后,在抛光液中镁合金表面发生如下化学反应:
Mg2++HPO42-→MgHPO4
(2)
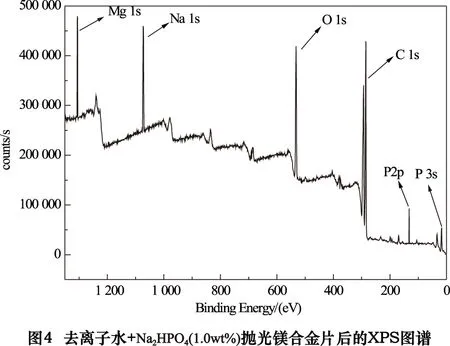
表1XPS图谱中Mg、Na、O、C、P的峰值位置

元素峰位置/eVMg1s242.22Na1s1072.0O1s531.32C1s399.98P2p130.6
反应生成的MgHPO4沉淀物与镁合金基片上生成的Mg(OH)2共同沉积在基片表面,从而有效抑制镁合金在抛光液中的腐蚀反应,起到缓蚀作用,使镁合金基片抛光表面几乎没有点蚀现象出现。
2.4不同抛光介质对镁合金CMP粗糙度与去除率的影响
在上述4组抛光实验中,镁合金基片抛光后的表面粗糙度、材料去除率与抛光液粘度数据见表2。可以看出,抛光介质不同,抛光液粘度、镁合金材料去除率以及抛光后表面粗糙度均有显著差异。在四组抛光液中,以去离子水作为抛光介质并添加缓蚀剂Na2HPO4(1wt%)的抛光液对镁合金基片抛光效果最佳,抛光后表面粗糙度为9.835 nm,且材料去除率也较高为700.12 nm/min。以去离子水作为抛光介质但不添加缓蚀剂的抛光液,镁合金基片虽然材料去除率最高可达1 302 nm/min,但抛光后表面粗糙度值达60.047 nm。采用乙二醇和聚乙二醇有机溶剂作为抛光介质的抛光液对镁合金基片抛光后,表面粗糙度值较小仅仅20 nm左右,但在相同的抛光工艺参数下材料去除率较低为250 nm左右,并且采用两种有机溶剂作为抛光介质配制成的抛光液粘度较大为80 mPa·s左右,由于流动性差,存在抛光后镁合金基片与抛光盘不易清洗的现象。
表2镁合金片在不同抛光介质中的抛光结果

抛光介质 (溶液)因素乙二醇聚乙二醇去离子水去离子水+磷酸氢二钠抛光液粘度(mPa·s)79871723材料去除率/nm/min242.22263.891302700.12抛光前表面粗糙度/μm0.0430.0580.0640.057抛光后表面粗糙度/nm20.12518.33360.0479.835
3 结语
(1)选用乙二醇和聚乙二醇有机溶剂作为抛光介质配制而成的抛光液,对镁合金基片抛光表面形貌有很好的改善作用,点蚀不明显,表面质量好,但材料去除率较低且抛光液粘度较大。
(2)以去离子水作为抛光介质配制而成的抛光液,对镁合金基片材料去除率大,但抛光后镁合金表面点蚀现象明显且表面较粗糙。
(3)以去离子水作为抛光介质并加入适量磷酸二氢钠缓蚀剂配制而成的抛光液,不仅能够有效抑制抛光过程中的点蚀现象,达到理想的表面粗糙度,同时较低的粘度保证了较高的材料去除率。
[1]武晓玲,刘玉岭,贾英茜,等. CLBO晶体化学机械抛光技术的研究[J]. 微纳电子技术,2006(10): 496-498.
[2]李军,朱永伟,左敦稳,等. 软脆易潮解晶体化学机械抛光用无水无磨料抛光液[P]. 中国专利,CN102660198A. 2012-09-12.
[3]刘玉岭,王胜利. 用于硼酸锂铯晶体的化学机械无水抛光液及平整化方法[P]. 中国专利,CN1858134. 2006-11-08.
[4]何捍卫,胡岳华,周科朝,等. 铜在甲胺铁氰化钾化学机械抛光液中的腐蚀与钝化[J]. 功能材料,2004,35(3): 392-394.
[5]刘宇宏,董莹,戴媛静,等. 铜抛光液中缓蚀剂5-氨基四唑(ATA)的作用机制研究[J]. 润滑与密封,2012,37(5): 1-6,22.
[6]张伟,路新春,刘宇宏,等. 氨基乙酸-H2O2体系抛光液中铜的化学机械抛光研究[J]. 摩擦学学报,2008,28(4): 366-371.
[7]Song M Y, Manaud J P, Darriet B. Dehydriding kinetics of a mechanically alloyed mixture Mg-l0wt.%Ni [J]. Journal of Alloys and Compounds,1999,282(1-2): 243-247.
[8]Lunder O, Lein J E, Aune T K,et a1. The roll of Mgl7A112 phase in thecorrosion of mg alloy AZ91 [J]. Corrosion,1989,45(9): 741-748.
[9]Beldjoudi T, Fiaud C, Robbiola L. Influence of homoge-nization and artificial aging beat treatments on corrosion behavior of Mg-A1 alloys [J]. Corrosion,1989,49(7): 738-745.
[10]李秀娟,金洙吉,康仁科,等. 抛光液中缓蚀剂对铜硅片的影响[J]. 半导体学报,2005,26(11): 214-218.
[11]龚桦,王宁,顾忠华,等. 铜化学机械抛光中复合缓蚀剂的作用机制[J]. 润滑与密封,2013,38(9): 6-10+32.
[12]陈景,刘玉岭,王晓云,等.镁合金抛光机理与CMP工艺研究[J].微钠电子技术,2008,45(2):114-117,122.
(编辑谭弘颖)
如果您想发表对本文的看法,请将文章编号填入读者意见调查表中的相应位置。
Effect of polishing medium in the chemical mechanical polishing of Mg alloy
HUANG Huadong①②,BIAN Da②,YANG Dalin②,MIN Pengfei②,ZHAO Yongwu②
(①Suzhou Institute of Industrial Technology, Suzhou 215104, CHN; ②School of Mechanical Engineering, Jiangnan University, Wuxi 214122, CHN)
Scanning electron microscope(SEM), X-ray photoelectron spectroscopy(XPS) and scanning white light interferometer(SWI) were used to investigate the effect of polishing medium on the chemical mechanical polishing(CMP)of magnesium alloy. And the material removal of magnesium alloy was also calculated. It was found that: less surface pittings were found on the polished surface by the organic polishing medium, such as Ethylene glycol and polyethylene glycol. However the material removal of magnesium alloy was low; in contrast, the material removal of magnesium alloy was high when the demonized water was used as polishing medium, while much surface pittings were found on the finished surface; when the demonized water with 1% disodium hydrogen phosphate was used as polishing medium, the material removal of magnesium alloy achieved high level and the quality of polished surface was approved with less surface pittings.
chemical mechanical polishing;polishing medium;viscosity;removal rate;roughness;pitting
TG146.2
A
10.19287/j.cnki.1005-2402.2016.06.023
黄华栋,男,1976年生,硕士,副教授,专业带头人,从事摩擦学与表面工程技术、先进制造技术研究与教学工作,已发表论文26篇。
2015-08-26)
160639
* 国家自然科学基金资助项目(51005102) ;清华大学摩擦学国家重点实验室开放基金项目(SKLTKF101304) ;中央高校基本科研业务费专项资金资助项目(JUDCF13028) ;江苏省高等职业院校国内高级访问学者计划资助项目(2014FX057) ;江苏省高校品牌专业建设工程项目(PPZY2015B186)
