先进光刻中的聚焦控制预算(I)-光路部分
2021-10-10钟志坚李琛毅李世光韦亚一
钟志坚,李琛毅,李世光,3*,郭 磊,3,韦亚一
(1.中国科学院微电子研究所,北京 100029;2.中国科学院大学,北京100049;3.江苏影速集成电路装备股份有限公司,无锡214142)
1 引 言
集成电路(Integrated Circuit,IC)是信息时代各行各业快速发展的基础。集成电路发展至今仅有70余年,但一直快速发展。从1949年晶体管效应的发现,到1958年世界上第一块集成电路的搭建,再到国际先进半导体制造工艺在2018年实现7 nm工艺制程量产、2020年实现5 nm工艺制程量产[1],集成电路行业飞速发展,晶体管密度逐渐提高。这不仅得益于制造工艺的不断革新,也得益于生产设备的改造升级。早在1965年,英特尔公司的创始人之一戈登.摩尔(Gordon Moore)就提出了著名的摩尔定律[2]:集成电路上的晶体管数量约每隔24个月增加一倍。
也正是在摩尔定律的驱动下,集成电路不断向更小尺度发展,目前技术节点已达到5 nm及以下。从每一个技术节点到下一个技术节点,器件的关键线宽(Critical Dimension,CD)也会按0.7倍缩减。集成电路制造的难点在于其复杂的制造工艺和制造装备,其中涉及切片、抛光、涂胶、光刻、显影、刻蚀、切割、封装等一系列步骤。光刻技术是半导体行业的核心技术之一。光刻的本质是利用光化学原理将掩模版上的图案转移到衬底上。在这个过程中,会涉及到光源、掩模版、投影物镜、晶圆、光刻胶、等部件或材料。光刻曝光时,需要将晶圆送至指定的高度范围内,在该高度范围内,晶圆曝光的质量是可以保证的,这个高度范围称为聚焦深度(Depth Of Focus,DOF)。
聚焦深度是衡量光刻工艺窗口质量的参数之一。在制造纳米级集成电路图形时,工艺窗口极大地决定了光刻曝光的难易程度。当硅片上包含多种特征图形时,光刻聚焦深度为所有特征图形的公共DOF范围,称为可用聚焦深度(Usable Depth Of Focus,UDOF)。硅片扫描曝光时,待曝光区域超出UDOF将导致成像质量变差,产品良率降低,因此必须加以控制。光刻过程中,控制待曝光区域在UDOF范围内的过程称为聚焦(Focus)或聚焦控制(Focus Control)。在光刻机的顶层关键功能中,聚焦控制是其中之一,精准的聚焦控制是保障曝光质量、光刻成像质量,良好光刻工艺窗口的重要保证[3-4]。根据ITRS路线图,对于7 nm节点的逻辑器件,其聚焦深度仅为50 nm[5]。在光刻机这样的精密设备中,整机性能与子系统性能之间存在千丝万缕的联系,子系统之间相互制约。聚焦控制精度不仅与光刻机内上百项部件级别的因素有关,还与系统控制、光刻工艺、测量手段、用户使用状态等有关。50 nm这个指标对拥有成千上万零部件的系统来说,是极为苛刻的,此时任何一项误差因素被忽略或没被适当控制,都可能导致聚焦深度变小,曝光质量变差。只有将这些因素尽可能全面地提取出来,详细分析,并将总的聚焦精度控制在UDOF范围内,才能曝光出满意的产品。
然而,对于这样一个庞大的系统工程,公开文献中对此进行专题总结的研究非常少,很多内容只是零散地分布在文献中。目前尚未见到专门介绍与聚焦控制有关的聚焦偏移因素和DOF方面的综述性报道。本文将尽可能全面地总结先进光刻机中,光路部分对聚焦控制产生影响的各种因素,并对这些因素的研究方法,作用机理进行归纳总结,最终对各影响因素提出合理的精度要求,称为聚焦控制预算[6-7],以便为先进光刻聚焦控制系统的研究提供有意义的参考。
本文作者将分三篇文章系统介绍先进光刻中的若干聚焦偏移因素及其与工艺窗口/DOF的关系,总结各种光刻聚焦预算形式,建立以芯片良率为最终评价指标的误差叠加方法。本文侧重总结EUV光刻机中,光路部分中导致聚焦偏移和工艺窗口/DOF变化的各种因素,下一篇为非光路和工艺部分的各种因素,第三篇为聚焦预算形式和误差叠加方法。
2 先进光刻机中的光路
瑞利判据(Rayleigh Criterion)[8]告诉人们,晶圆表面清晰成像的两个点的最小距离由工艺因子k1,曝光波长λ,投影物镜的数值孔径NA决定。通过减小曝光波长λ,工艺因子k1,或者增大数值孔径可以使最小线宽减小,降低技术节点。后两种方案由于物理限制,几乎已经达到了极限,所以通过减小曝光光源波长在光刻技术发展史中,一直是科研人员探索的主要方向。光刻机的曝光波长经历了从435 nm(G线)、365 nm(I线)、248 nm(KrF),再发展到193 nm(ArF)、13.5 nm波长的极紫外光刻。其中,248 nm的KrF和193 nm的ArF准分子激光始于上个世纪90年代中期,属于深紫外波段(Deep Ultraviolet,DUV)。荷兰光刻机制造公司Advanced Semiconductor Material Lithography(ASML)于2018年生产的193 nm波长曝光光源的NXT:2000i为目前技术水平最高的DUV浸没式光刻机。其套刻(Overlay)精度可以达到1.4 nm[9]。迄今为止最先进的量产光刻机为EUV光刻机。ASML于2017年生产的EUV光刻机TWINSCAN NXE:3400B,可支持7 nm和5 nm技术节点批量生产,并明确提出了聚焦控制指标为60 nm[10]。极紫外光刻机的光路如图1所示,包括光源、照明系统、掩模和投影物镜。其传播路径可简单概括为:光源发出的光,经过照明系统后到达掩模,从掩模反射的光,再通过投影物镜成像于硅片上的光刻胶上。

图1 EUV光刻机中的光路示意图[11]Fig.1 Schematic diagram of optical system of EUV lithography machine[11]
由于几乎所有的光学材料对13.5 nm波长的EUV光都具有很强的吸收,因此EUV光刻机中的所有光学元件均采用反射式结构[11]。为了提高反射镜的反射率,通常会在反射镜的表面镀上多层膜(Mo/Si),依靠这种结构的相长干涉(Constructively Interference)来增大反射率。EUV光刻机中的照明系统是由一系列反射镜组成的,通过若干个反射镜形成所需要的照明方式。在EUV光刻中,掩模版也是反射式的,经过掩模版反射的光,携带了掩模版上的图形信息。掩模和晶圆之间的光路称为投影物镜(Projection Lens),也称为投影光路(Projection Optics)。
由于EUV光的曝光波长比DUV的更短,且光刻机的光路部分为反射式,因此部分存在于DUV中的影响因素,在EUV中会更明显,例如掩模的三维效应(Mask 3D Effect,M3D)。除此之外,还会出现与DUV系统不同的影响因素,例如反射镜的结构、多层膜厚、入射出射光锥角度等等。因此,本文将重点关注EUV光刻,并按照光路部分光的传播顺序,即从光源出发,经过照明系统到达掩模,再经过投影物镜到达晶圆表面上的光刻胶的顺序,一一给出介绍。
3 光源与照明
在光刻机中,从激光光源发出的激光光束,在到达掩模和投影物镜之前,一般需要经过机器内部的照明系统,照明系统对光束进行扩束和均匀化,并可以改变光束方向。其中的光瞳整形单元通过调整衍射光学元件、变焦准直镜组和锥形镜组实现各种照明方式[12]。简而言之,照明系统用于对光强分布做空间变换,使之以一定的方式照明在掩模上。在实际工艺中,必须根据掩模上的图形来调整照明方式,以获得最大的工艺窗口。可以说,照明方式是光刻工艺中最为关键的因素之一,也是实际应用中调整的最多的参数之一。
除此之外,光源的偏振态、带宽、相干系数,甚至在EUV中,杂散光也会对聚焦控制产生不同程度的影响。
3.1 EUV照明方式对聚焦控制的影响
在EUV光刻机中,如ASML NXE:3300能够为用户提供7种照明方式,除了常规照明(Conventional Illumination)外,还能提供另外6种离轴照明方式[13]。EUV光刻机的照明方式对于工艺窗口的影响是显著的。比利时微电子的Eric Hendrickx等人采用ASML NXE:3100 EUV光刻机,实验研究了采用相同光刻胶,不同光照条件下的DOF[14],图2(彩图见期刊电子版)给出了实验结果。
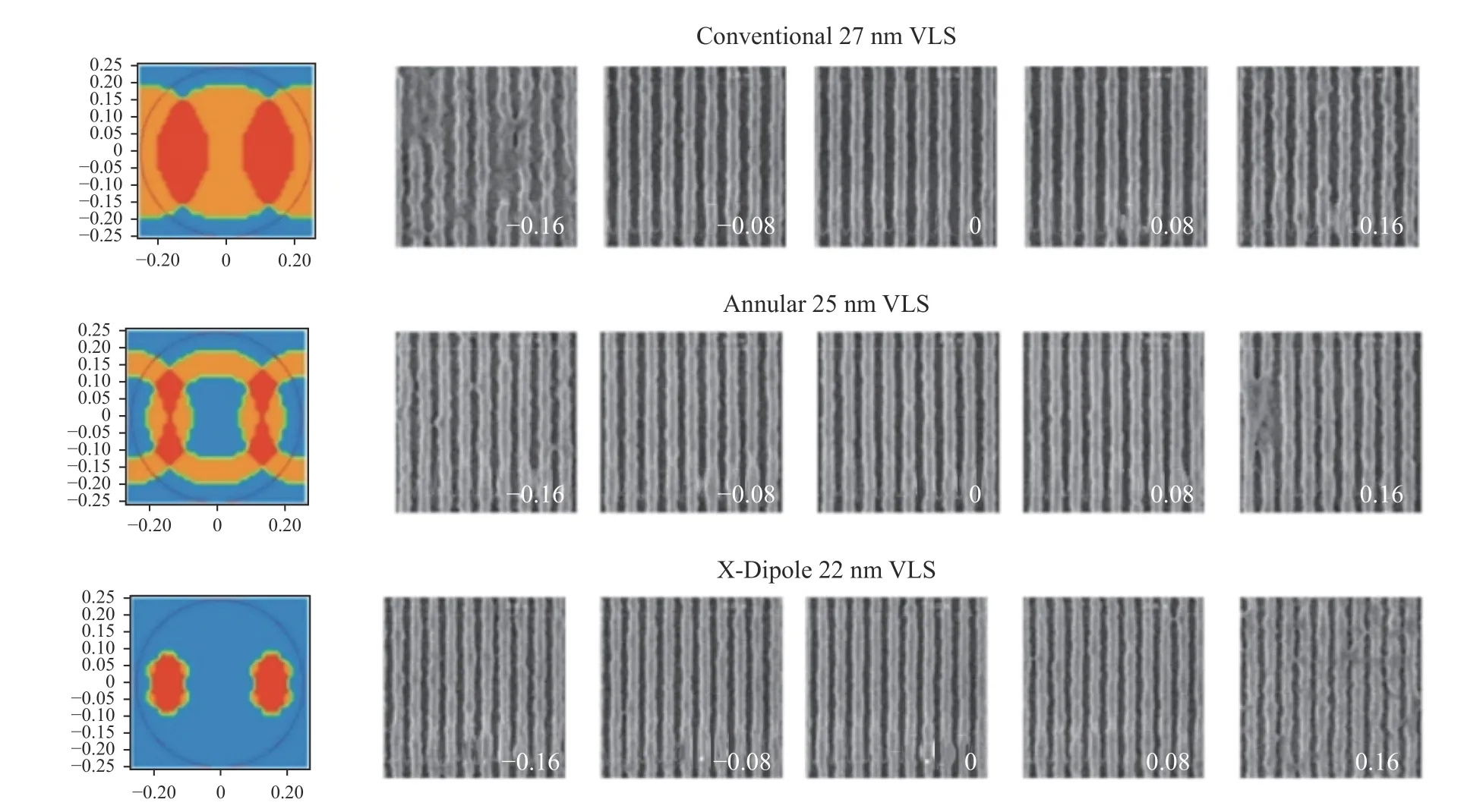
图2 NXE:3100在不同光照条件下(常规,环形,双极)获得的光刻胶图案的电子显微照片[14]Fig.2 Electron micrographs of photoresist patterns obtained by NXE:3100 under conventional,circular,dipole illuminations[14]
实验结果表明,双极照明可以为22 nm的密集线条提供大于±0.16μm的聚焦深度,而对于常规照明,即使曝光27 nm密集线条,在聚焦偏移量为−0.16μm时也出现了明显的缺陷。而环形照明方式的聚焦深度范围介于常规照明和双极照明之间。这表明照明方式是影响聚焦深度大小的一个因素。
类似的,英特尔的Lee等人研究了EUV系统中不同照明设置下的DOF大小[15]。他们采用Intel公司的光刻模拟工具I-Photo对不同照明方式下的工艺窗口进行了仿真。并对比了45 nm和50 nm密集线的仿真和实验结果。结果表明,与环形照明(Annular)相比,双极照明(Dipole)和四级照明
(Quadrupole)的DOF更大。该研究还发现,在环形照明中,较大的环形宽度会有更大的DOF。而双极照明会为密集线生成最大的工艺窗口。这进一步证明在EUV中,照明方式对DOF的大小有着显著的影响。
3.2 光源的其他性质对聚焦控制的影响
光源的相干设置会对光刻曝光的最佳焦点产生影响,这一影响需要联系掩模的三维效应进行讨论,将在4.1节给出。此处仅给出其对于经过投影透镜对晶圆表面成像的理论关系。叶变换,由于物镜的尺寸是有限的,不是全部的衍射光都穿过透镜,用空间频率的函数P=(fx,fy)表示大于一定空间频率的衍射光束被光瞳挡住,

如果假设光线由一点发出,经过投影透镜后形成平行的光沿着一个方向照射到掩模上,这便是相干光源。在这种情况下,假设掩模透射函数为tm(x,y),对于薄掩模,则在不透光区域近似有tm(x,y)= 0,在透光区域tm(x,y)=1。 将(x,y)看作掩模平面内的坐标,(x′,y′)是投影透镜平面内的坐标;(u,v)为晶圆表面上的坐标。z是掩模到投影透镜之间的距离;n为掩模和投影透镜之间介质的折射率;E(x,y)是入射在掩模平面上光线的电场强度;衍射图形在(x′,y′)平面内的空间频率可以定义为fx=nx′/zλ,fy=ny′/zλ。那么薄掩模近似下衍射图形在(x′,y′)平面内的电场强度可以表示为[16]:
这也就是说,衍射图形是掩模上图形的傅立

则会聚在晶圆表面上的电场强度可表示为:

式中,F−1表示傅立叶逆变换,晶圆表面的光强分布有I(u,v)=|E(u,v)|2。以上推导都是基于相干光源,实际情况中,照射在掩模上的光是来自一个角度范围内的相干光源,这种照明叫做部分相干照明[17]。部分相干系数也被定义为:


在σ空间中创建瞳孔坐标,则有

光源形状函数可以归一化为

所以

由此可见,在先进光刻曝光时,空间像的强度可以通过瞳孔坐标来表征,这也表明了空间像的强度与相干因子是相关的。
需要注意的是,在EUV光刻中,由于采用反射式光路,掩模也采用反射型掩模,因此在掩模处会形成入射光锥和出射光锥。图3给出了EUV光刻中出射和入射光锥的两种状态。0.33 NA的EUV光刻可以提供11 nm的分辨率,小于此分辨率的图形,必须依靠更大数值孔径的EUV光刻机,或者使用0.33 NA的光刻机进行多次曝光[18]。为了实现大于0.33 NA的EUV光刻机,其光路系统的设计必须考虑一个问题,即会聚在掩模上的入射光形成的锥体不能与掩模上反射光形成的锥体有重叠。随着NA的增大,为了保证入射出射光锥不重叠,只有增大入射角(Chief Ray Angle),或者是增大缩小倍数M(掩模和晶圆上的图形大小之比),才不至于使得曝光时产生阴影效应(Shadow Effect)。因为阴影效应将会导致CD的偏差和对比度的损失[19]。
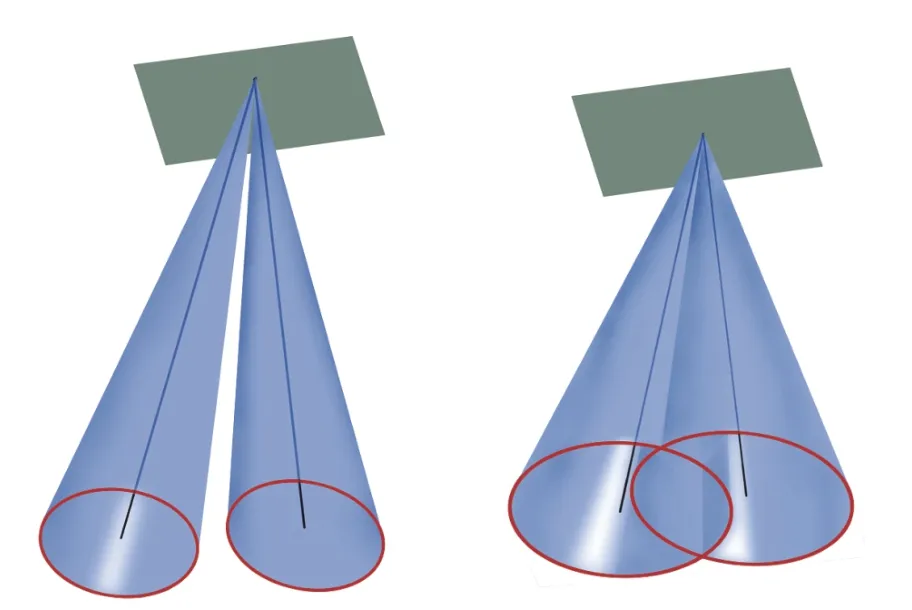
图3 EUV入射光锥与出射光锥的重叠与不重叠状态Fig.3 The overlapping and non-overlapping states of the exiting light cone and the incident light cone in EUV
3.3 EUV中的其他潜在影响因素
在DUV中,光源的带宽、照明的偏振都将引起最佳焦点的偏移。虽然在目前公开文献中暂时还未发现EUV中的有关研究,但由于EUV光刻中,对激光的输出脉冲频率及能量的稳定性要求极高,在中间会聚点处(Intermediate Focus,IF)所要求的大功率,比DUV中的光源要求更为苛刻。因此,DUV中的有关影响因素具有积极的借鉴意义。以下给出光源的色差和偏振照明在DUV中的影响。
在DUV光学系统中,由于色差的存在,光源带宽对工艺窗口有明显影响,这是因为图像的形成是各个波长叠加的结果。当光源波长存在有限带宽时,图像叠加会导致聚焦模糊,从而使对比度变差。Conley等人对比了光源带宽为200 pm和300 pm两种情况下工艺窗口的变化[20]。结果显示,5个不同的特征图形在使用较低带宽时,聚焦深度都有不同程度的增加。
在早期的光刻成像中,偏振并不是一个需要考虑的因素,但是当掩模上的图形CD远小于曝光光源波长时,偏振特性对于成像的影响必须要考虑,并且有可能需要联合掩模的三维效应进行考虑。ASML的Johannes Ruoff等人进行了偏振照明的实验和仿真分析[21]。仿真采用修正的Kirchhoff模型,即考虑三维效应的掩模模型,通过在掩模侧壁添加扰动来实现。仿真结果表明,对于TM和TE模式偏振光,该扰动的幅值和位相不同,从而导致位相差,并最终导致不同偏振光之间最佳焦点的差异。实验使用Twinscan XT1400光刻机,掩模上的结构为孤立的180 nm铬(Cr)线条,使用y向偏振光,并在0.85 NA下曝光了水平和垂直两种图样。结果显示偏振引起的最佳焦点的变化为30 nm。当曝光剂量增加时,最佳焦点的差异会增加。当曝光剂量增至45 mJ/cm2时,最佳焦点偏移达到了300 nm。
由此可见:(1)考虑掩模三维效应时,不同偏振将引起最佳焦点的变化;(2)同一偏振光,对于不同方向的线条,也会引起最佳焦点的变化。在DUV中其量级可能达到百纳米级别。考虑到在EUV中光源波长更短,与掩模上的金属材料等作用更加剧烈,因此偏振在EUV中也应当引起研究人员的重视。上文也提到了掩模的两种模型,分别为Kirchhoff和考虑三维效应的模型。光线经过照明系统后,下一步将经过掩模,下一章节将对掩模对聚焦控制的影响进行详细介绍。
4 掩模
掩模版(Mask)简称掩模,其上承载有设计图形,光线经过照明系统之后,透过掩模之后便携带了掩模上的图形信息。EUV中的反射式掩模形式更为复杂,如图4所示的,EUV中的掩模,基本结构由5部分组成,分别是:吸收层(Absorber Stack),覆盖层(Capping Layer),多层膜结构(Multilayer Stack),衬底(Substrate),导电层(Conductive Layer)。
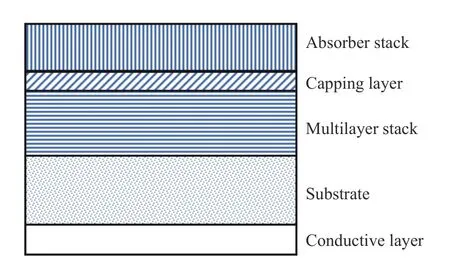
图4 EUV掩模结构Fig.4 Structure of EUV mask
EUV掩模结构比DUV掩模结构更为复杂,又是斜入射照明,掩模在EUV光刻中具有重要研究价值。本章节将从以下几方面进行介绍:(1)通过理论推导和实验仿真,重点介绍掩模的三维效应及其他方面对于聚焦控制的影响;(2)如何在实际中减轻掩模三维效应的负作用;(3)掩模的其他方面的影响。
4.1 EUV光刻中掩模影响聚焦控制的因素
在掩模的实际生产中,通常需要考虑三维效应(Mask 3D Effect,M3D)。掩模三维(Mask 3D)效应指的是掩模上的遮光材料与光波相互作用,导致曝光时最佳焦点随着图形的尺寸发生偏移。这种效应,同时存在于DUV和EUV中。考虑三维效应的影响可以很好地从理论上解释光刻工艺实际生产中遇到的问题。详细了解其作用机理需要经过严格的三维电磁场计算来求解,也就是时域有限差分分析(Finite Difference Time Domain,FDTD)[22],但是由于该方法计算量过大,不适用于实际生产中的全版图设计。因此也有二维薄掩模近似,其适用于掩模上的图形在XY方向的尺寸远远大于掩模在Z方向上的尺寸的情形。这种近似又被称作Kirchhoff近似[23]。
如图5所示,假设掩模上的一维图形是光栅线条,入射光以θinc与−θinc的方向射向掩模,入射光电场平行于光栅取向,也就是TE偏振光,这种入射光可以使用对称的双极照明获得。

图5 在双极TE照明下的一维图形(光栅)成像Fig.5 One-dimensional graphic(grating)imaging under dipole TE illumination
把两个非相干的光源在晶圆表面所成的像叠加,并假设k0=2π/λ,可以得到晶圆表面的光强分布I[24]:

式中,C和a是 常数,x是晶圆平面内的坐标,z是晶圆表面的位置高度。sinθd=sinθinc−λ/Pmask,Pmask是掩模上光栅的图形周期。δ是掩模的三维效应所引起的0级和1级衍射光之间的相位差,δ与掩模材料和厚度、入射光的方式和角度、以及掩模上的图形等都有关系。最佳焦点处满足∂I/∂z=0。故可得到:

上式说明,最佳焦点除了与掩模上的图形和光照方向有关外,还与0级和1级衍射光之间的相位差呈线性关系,这一相位差与掩模的材料、图形尺寸和密度有关。有研究表明,当不考虑掩模的三维效应时,0级和1级衍射光相位差为0,最佳焦点不会随着掩模上图形的尺寸而变化[25]。这一观点在仿真中也得到了佐证,M.Saied等人分别使用Kirchhoff模型和FDTD模型对掩模进行仿真[26]。在他们的研究中,将最佳焦点定义为空间像中最大对比度所对应的点,如图6所示。对于Kirchhoff模型而言,最佳焦点为常数,当考虑三维掩模效应时,最佳焦点偏移量会随着图形周期(Pitch)的增大而增大。

图6 Kirchhoff和三维模型下的掩模最佳焦点的偏移情况[26]Fig.6 Best focus shift of the mask with Kirchhoff and the 3D model[26]
Intel的Yan[27]等人在EUV上进行仿真,也得到了类似结果。如图7所示,对于初始周期为30 nm的线条,随着周期的增大,密集线逐渐变为孤立线,其最佳焦点偏移量随着图形周期的增大而增大。该研究指出,这种现象是由于考虑了掩模的非平面几何特征,即考虑了三维效应。该研究试图通过近场衍射来解释这种现象,认为掩模边缘的电场分布是来自在掩模边缘衍射的光和来自反射基板的光的组合光。也正是掩模边缘导致光线产生了额外的振幅和相位偏差,从而导致了最佳焦点随着图形周期变化而变化的现象。

图7 焦点偏移与pitch间的关系[27]Fig.7 Relationship between focus shift and pitch[27]
为了更好地解释掩模在二维Kirchhoff近似与考虑三维效应下不同的表现,Erdmann使用严格的电磁场理论(Rigorous Diffraction Theory)分析了Cr双极型掩模上密集线条的三维效应,并和Kirchhoff的分析结果作了对比[28]。
图8 是第0级和第1级的衍射相位随掩模图形周期变化的结果。其中Rigorous代表掩模三维效应曲线。衍射级的相位是指衍射光束与入射在掩模上光线之间的相位差。计算时的仿真条件为:垂直入射光,波长为248 nm,TE极化,Cr的折射率N=2.5−2.0i,衬底为SiO2。结果表明,在二维Kirchhoff近似下,衍射级的光强和相位不随线条的周期变化,但是在考虑掩模三维效应后,随着线条周期的不断减小,即线条越密集,相位偏差越大,从而导致最佳焦点的偏移。尽管在此仿真中,使用的是Cr双极型掩模,但是随着掩模图形尺寸的不断缩小,材料更为复杂,可以预见,该结论仍然具有十分重要的参考意义。

图8 0级和1级的衍射相位随图形周期的变化情况[28]Fig.8 Results of diffraction phase of the 0th and 1st order varying with pitch[28]
除此之外,由于用于EUV的掩模结构更为复杂,由吸收层和多层膜结构组成。有关研究[29-30]表明在EUV光刻机成像过程中,掩模的吸收层也会导致最佳焦点的偏移。其作用机理可以概括为以下两点:(1)光在吸收层与真空界面附近的传播相对于不在吸收层附近的光具有不同程度的相位差;(2)由于吸收层/真空介电常数的失配,也会导致最佳焦点的偏移。
4.2 改善掩模三维效应的措施
为了减轻EUV成像中的掩模三维效应,也有科研团队进行了相关研究。Erdmann在文献[31-32]中提出,掩模在EUV中表现出的三维效应是由于掩模影响了衍射光的相位,而这种相位差可以综合近似为光学系统的像差。也正是这些类似于像差行为的存在,导致成像时,出现了最佳焦点的偏移和工艺窗口的倾斜。这提示人们,进行适当的像差补偿,也许能够补偿EUV中的掩模三维效应。
Haque[33]在研究EUV系统上的三维掩模效应时,提出三维效应可以近似为球差,并且可以通过球差对三维效应导致的最佳焦点偏移进行补偿。在透镜上添加−10mλ三 阶和+10mλ五阶球差,对于吸收层厚度为45 nm的掩模,最佳焦点偏移20 nm,补偿后减小到5 nm。对于厚度为60 nm和70 nm的吸收层,也达到了一定的效果。
除此之外,还有添加辅助图形的方法能够减轻掩模的三维效应。辅助图形是在进行光学邻近效应校正(OPC)时,放置在掩模上的一些曝光图形。它们被放置在稀疏设计图形的周围,使得稀疏图形看起来更密集一些,其作用是为了使适用于密集图形曝光的光照条件也能适合稀疏图形的曝光,增大工艺窗口。
比利时微电子中心Iacopo Mochi联合ASML团队提出[34],如果使用平面掩模做薄掩模近似,可研究掩模三维效应对于最佳焦点和工艺窗口的影响。仿真设定为EUV光刻,采用扇形(Quasar)照明,在ASML NXE:3300光刻机中观察了辅助图形对最佳焦点产生的影响。使用了两种辅助图形,分别是对称(ASY)的图形和不对称(SYM)的图形。图9显示了周期分别为64 nm和96 nm线条引入辅助图形前后,最佳焦点和聚焦深度的变化。Y向双极照明(Y-Dipole)实验结果显示,引入辅助图形之后,两种线条曝光时的最佳焦点的变化约为45 nm,并且DOF都有明显的增加。

图9 64 nm、96 nm周期线条下的最佳焦点(点)和聚焦深度(柱)[34]Fig.9 Best focus(point)and DOF(bar)of different pitches(64 nm,96 nm)[34]
在早期DUV下的三维掩模效应中,也有相关学者提出了改善措施。ASML的Anita Bouma等人[35]在研究中指出,掩模吸收层的有限厚度对不同特征的最佳焦点有显著影响。这是因为吸收材料的有限厚度导致衍射级的附加相位分配。对具有不同折射率n的几种材料的仿真结果显示,当光程n·d接近波长(193 nm)时,聚焦深度将变得很小。如果光程在某一最佳吸收层厚度范围内,聚焦深度就会增大。因此,光刻工艺制备掩模时,通过微调吸收层厚度可能会改善聚焦深度。在早期的DUV浸没式光刻机NXT:1950i中,ASML搭载FlexWave模块,该模块放置在投影物镜瞳孔平面附近,通过局部加热改变光程,调整波前相位,可以减轻掩模三维效应[36]。
4.3 EUV中掩模的其他影响因素
除去三维效应之外,掩模在光刻机中会通过卡盘(Chuck)紧紧吸附在曝光光路中,有关报道显示,掩模卡盘对掩模的吸附会引起掩模的局部或整体变形。如图10所示,由于卡盘导致的掩模弯曲引起了在Z向上的高度变化,进而引起了最佳焦点的偏移。这种偏移如果不进行校准,将会超过100 nm。由此引起的最佳焦点偏移,可以利用空间像传感器(Aerial Image Sensor,AIS)进行标定以消除[37]。

图10 掩模弯曲对聚焦偏移的影响[37]Fig.10 Effect of mask bending on focus shift[37]
在EUV光刻中,掩模的模型也具有特殊性。如图11所示,照射在EUV掩模上主光线的入射角是6°,这使得当掩模在垂直方向(Z)上发生聚焦偏移(Off-focus)时,成像位置将沿水平方向移动(X/Y)。掩模的聚焦偏移将会导致晶圆上图像成像的偏移。由于EUV采用斜入射光线角照射反射型掩模,其将存在与采用折反式光路的DUV不同的影响因素。ASML的Peng Liu[38]等人通过仿真实验表明,EUV投影物镜系统的非远心性要求掩模处在一个最佳焦平面上,以减小图形偏移。并且,EUV掩模必须采用倾斜入射光线照射,因此,掩模侧的远心条件不再满足,在这种情况下,掩模离焦的影响不能忽略。遗憾的是,该研究只是定性给出最佳焦点的偏移与掩模上图案形状具有相关性,但却未给出定量的结论。
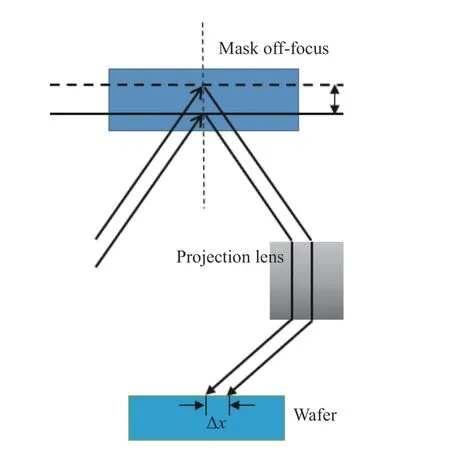
图11 EUV光刻机中的掩模聚焦偏移Fig.11 Mask defocus of EUV lithography machine
从上述内容中可以看出,在EUV光刻中,掩模的三维效应是导致最佳焦点产生偏移的主要因素,另外,吸收层的厚度和材料也会影响最佳焦点的偏移。
要改善EUV光刻中的三维掩模效应,可采用以下措施:(1)补偿相应的像差;(2)使用辅助图形;(3)虽然暂无EUV中,调整吸收层厚度的报道,但已有EUV中掩模吸收层厚度影响最佳焦点的例子,或许可借鉴DUV中微调吸收层厚度这一措施。除此之外,掩模自身的卡盘和离焦也是潜在的影响因素,需要引起重视。
5 投影物镜
光线经过掩模之后,进入到投影物镜中。如第二章节所述,EUV的投影物镜由数个反射镜构成。本章节将对投影物镜中影响聚焦控制的因素进行介绍。
5.1 像差
镜头的像差有两种表征方式,一种是泽尼克像差,另一种是赛德尔像差。在光刻机中,投影物镜产生的最佳焦点偏移归根结底是由于像差造成的。像差的大小可以用光曈位置处实际波面偏离理想波面的光程差(Optical Path Difference,OPD)表示,该OPD通常分解为Zernike多项式,如下:

其中,Zm(ρ,θ) 是Zernike多项式,Cm是Zernike系数(m=1,2,3……),(ρ,θ)是出瞳处(Z0)平面的极坐标。图12表 示 了Zm(ρ,θ)的 空 间 分 布,在Zm(ρ,θ)图中,m=0,2,4…代表偶数像差,m=1,3…代表奇数像差。对于偶数项像差,它是X和Y方向对称的,它的存在会导致聚焦的偏移,使CD出现偏差。奇数项像差只沿X或Y方向对称,它的存在会导致图形沿X或Y方向移动,会形成图形在晶圆上的放置误差(Placement Error)[39-40]。为了达到最佳的聚焦效果,必须有效降低投影物镜的偶数像差。
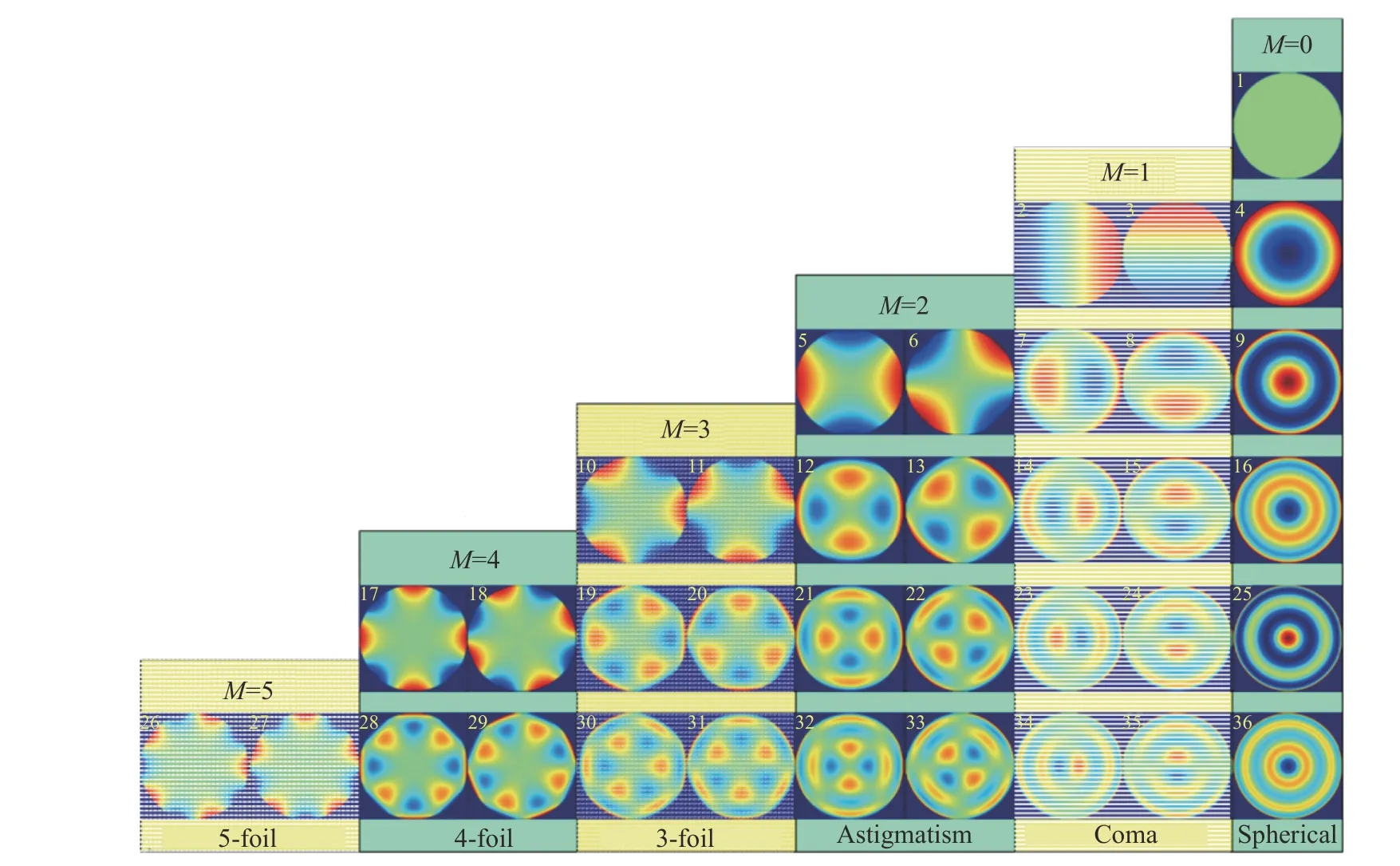
图12 泽尼克多项式[41]Fig.12 Zernike polynomials[41]
图12 中,每一个图样代表了该像差对成像的影响。例如最右侧的Z9表征的是球差,球差的存在使得成像对比度在对称点处不同。这意味着最佳焦点偏移将会导致晶圆上的线宽发生变化。镜头像差的另一种表征方式是赛德尔像差,它指光线通过镜头实际的追迹结果与近轴光线追迹结果的偏差。图13给出了像散与场曲对UDOF的影响[42]。

图13 像散与场曲对UDOF的影响[42]Fig.13 Effects of astigmatism and field curvature on UDOF[42]
场曲使得各个视场聚焦不同,像散则使X、Y方向的图形聚焦不同,两者共同作用,使UDOF大幅减小。相比于Zernike多项式,它可以更方便地表征与视场有关的像差,例如场曲、畸变等。
5.2 投影物镜热效应
投影物镜的热效应,在先进光刻机中的影响同样显著。一个明显的影响是,它将引起附加波像差,恶化成像质量,必须加以有效控制[43]。图14为镜头热效应示意图,衍射光束透过掩模之后,被投影光学系统收集会聚在晶圆表面。
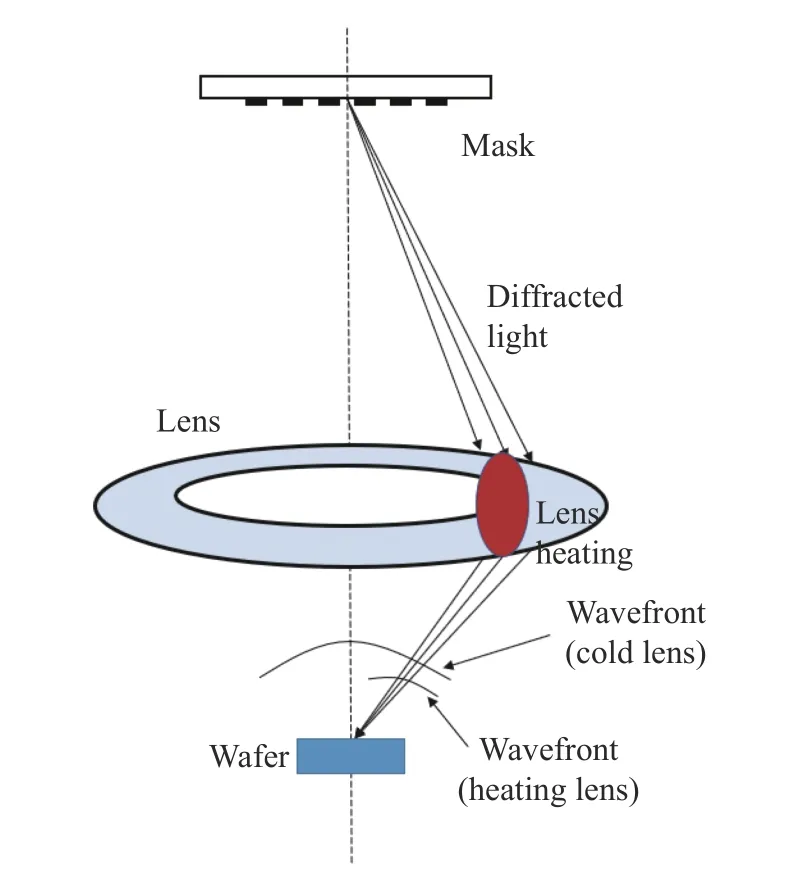
图14 曝光导致的透镜热效应Fig.14 Lens heating caused by exposure
在这个过程中,透镜吸收的光使得透镜局部温度升高,这将导致两个后果:一个是投影透镜材料膨胀,从而改变光学系统局部形状;另一个是改变了光学系统的折射率等光学参数。受热透镜与冷透镜形成的波前不同,这将引起附加像差,进一步损失工艺窗口。由此可知,投影物镜中,由于各类像差的存在,将导致聚焦深度减小,而投影物镜的热效应同样会导致波前误差,也可看作是像差的一种。因此,应用波前校正能够改善聚焦深度[44],图15(彩图见期刊电子版)给出了一个例子。
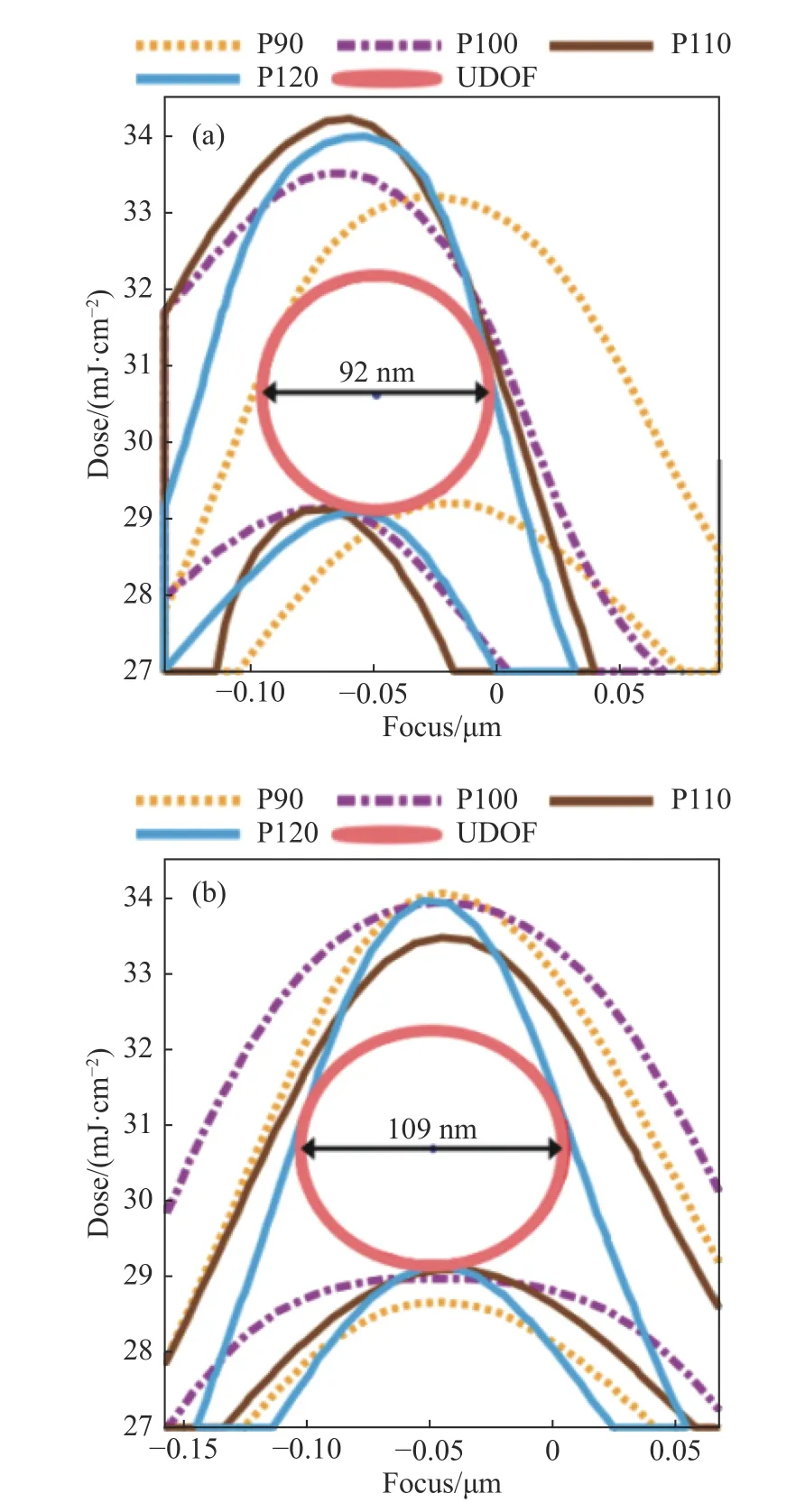
图15 (a)波前校正前的(b)波前校正后公共聚焦深度[44]Fig.15 Common UDOFs(a)without and(b)with appling wavefront[44]
图15 (彩图见期刊电子版)给出了波前校正前后,周期分别为90、100、110、120 nm的特征图形的工艺窗口。其中,红色椭圆区域代表波前校正前后,它们共同的工艺窗口,而该椭圆区域对应的最大聚焦值范围,则为可用聚焦深度。通过应用波前校正,聚焦深度由92 nm增至了109 nm。
ASML提出了一个透镜热效应导致的焦点偏移的公式[45]:

其中,F(t)表示投影物镜由于热效应导致的最佳焦点变化,T表示掩模透射系数,S表示掩模遮蔽面积,Q表示强度,t表示曝光时间,µ1,µ2表示修正比例系数,τ1,τ2为时间常数。在Ho[45]等人的实验中,最佳焦点偏移F(t)由FOCAL所确定,然后导出修正系数µ1和µ2。FOCAL是ASML公司采用的通过对准系统读取的FOCAL标记,确定曝光系统最佳焦点的测试方法[46]。Cui[47]指出,该模型还需要考虑硅片表面反射、减反膜等。热效应还依赖于照明设置,例如数值孔径,Sigma设置等。在诸多文献[45,48]中,最佳焦点偏移用CD变化间接表示。Cheng等人[49]测试了8个硅片上、一个曝光场(Field)内7个曝光点处由于热效应造成的CD变化。结果显示,不同硅片上、一个曝光场内不同位置处的CD值不同,但趋势基本相同,在曝光场中心位置有较小的CD,边缘处的CD逐渐增大。这意味着,透镜热效应导致硅片的边缘处有较大的最佳焦点偏移。
5.3 杂散光和物镜制备
DUV光刻机的光学系统由很多透镜和光瞳组成,EUV主要的部件则是反射镜,其上还镀有增强反射的反射膜。这些精密光学元件存在着很多的界面,这些界面上的折射,或者表面粗糙度和玻璃不均匀性都会导致杂散光(Flare)的出现。因此,在EUV中,杂散光也是一个影响曝光系统聚焦控制的重要因素。Sang Hun Lee等人[50]提出在EUV光刻中,杂散光对整个工艺窗口有着重大影响。如图16所示,令透镜像差固定为0.75 nm RMS,当杂散光小于10%时,杂散光对UDOF的影响较小,且随杂散光的变化UDOF的变化幅度较小。当而当杂散光大于10%时,UDOF随杂散光的增大迅速下降。当杂散光达到20%时,相较于10%的杂散光,UDOF减少了130 nm。
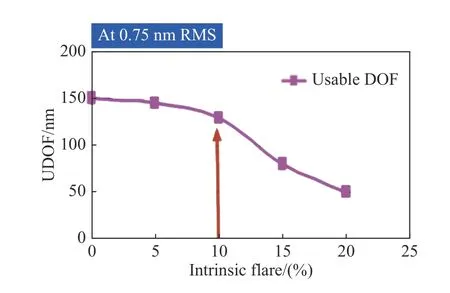
图16 杂散光对聚焦深度的影响[50]Fig.16 Effect of flare on depth of focus[50]
除了投影物镜的像差外,镜片上多层膜制备工艺也可能引起像差。文献[51]指出,优化EUV反射率后的Mo/Si多层膜的应力通常为−420 MPa(压缩),Mo/Be多层膜的应力为+330 MPa(拉伸),这么大的薄膜应力足以使EUV投影光学系统产生图形变形。采用非晶硅和Mo/Be缓冲层(Buffer Layer)的非热缓冲层技术,Mo/Be和Mo/Si多层膜净应力可以接近于零,而反射率损失小于1%。
综上所述,投影物镜最主要的影响因素在于像差。除了光学像差外,物镜在光线传输时的热效应,同样导致波前的变化,物镜上的多层膜,也将引起像差或者类似像差的现象。像差的存在导致聚焦深度减小,最佳焦点偏移。而这可以通过应用波前校正来改善。此外,杂散光也会导致聚焦深度的明显减小。
6 光刻胶及光路联合优化
以上章节均单独分析了先进光刻机中光学系统各个部分对最佳焦点和聚焦深度的影响,事实上,最终的最佳焦点和聚焦深度是所有这些部分综合作用的结果,因此光路各部分通常需进行联合优化,有时还会加上光刻胶的影响。
6.1 综合考虑光刻胶的三维效应的影响
有关研究表明,类似的,光刻胶也有三维效应[52]。如图17所示,入射到光刻胶表面的光束,会发生折射,不同入射角对应的折射角不同,汇聚于光刻胶内的不同位置。
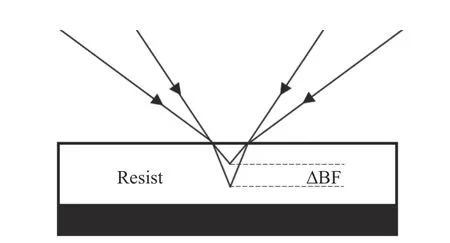
图17 光刻胶三维效应导致最佳焦点偏移Fig.17 Best focus shift caused by resist 3D effect
这种由于光刻胶折射导致的最佳焦点的不同与光刻胶的光学参数(n,k)有关,对于1.35 NA的光刻工艺以及折射率n为1.7的光刻胶,最佳焦点偏移已经接近25 nm左右。在20 nm逻辑技术节点,关键光刻层的最大DOF仅仅在100 nm左右,25 nm的最佳焦点偏移不能忽略。
6.2 综合考虑光源、掩模的影响
综合考虑光源和掩模的影响,也叫做光源与掩模的协同优化(Source Mask Optimization,SMO)。它是一项为整机设计提供顶层光学计算模型的技术。在实际的生产工艺中,照明方式应该根据掩模上的图形来设置,以便为所有图形提供最大的工艺窗口。通过SMO进行计算的包括光源形状和光强分布,通常又称为光源图(Source Map)。这种光源图通常不再是前文介绍的规则照明方式(环形、双极等),而是像素式的光照,也称之为自由形式光照(Freeform Illumination)[53]。这意味着照明中每一个像素处的光照都是可以调整的。
有关团队研究了EUV中的光源掩模协同优化[54],针对EUV中的特殊效应例如反射型掩模、反射型光路,引入了掩模三维效应。针对掩模离焦导致晶圆上成像偏移这一情况,通过SMO引入非对称照明,从而保证了掩模离焦时,成像不发生偏移。中芯国际的吴强对14 nm技术节点的SMO进行了研究[55]。在该技术节点下,利用明场照明,结合衰减相移掩模(Attenuated Phase Shift Mask,Att-PSM)能够有效地改善工艺窗口。类似的,三星的Jia提出掩模的三维效应需要联合照明方式来讨论[56]。在不同照明方式下,掩模可分为亮掩模和暗掩模。实验表明,虽然亮掩模导致的透镜热效应很明显,但其掩模的三维效应并不明显。而暗掩模正好相反,暗掩模不会导致透镜的热效应,然而其掩模的三维效应却非常明显。如图18所示的,当掩模上图形的线宽不变(50 nm)时,随着图形周期的不断增大,亮掩模上不同图形的最佳焦点非常接近,而暗掩模上不同图形的最佳焦点变化较大。

图18 亮掩模和暗掩模上不同图形的最佳焦点[56]Fig.18 Best focus through pitch on bright and dark mask[56]
SMO的目的是计算最佳照明方式,而光学邻近效应修正(Optical Proximity Correction,OPC)则是对掩模上的图形进行修改,以得到最大的工艺窗口。显然OPC的结果与SMO是相关联的。为了保证工艺窗口足够大,如果OPC不够理想,则可通过SMO使用较复杂的照明来补偿。同样,如果光刻机不具备先进的照明系统,则可以使用较复杂的OPC模型对掩模进行设计,以达到补偿的目的。
7 总结与展望
在光刻机研发过程中,为了保证研制出的系统满足预期性能需求,需要进行指标预算,预测系统的工作性能。这一过程非常重要,它是确保研制出来的系统不会出现设计(过设计或者欠设计)方面问题的关键。光刻机是一台由成千上万的零部件构成的整机,我国目前正在研发攻关的先进光刻机,要求的聚焦精度不断缩小。因此,明确关键子系统中影响聚焦控制精度的重要因素,提出聚焦控制指标中所能允许的该因素导致的最大误差范围,才能满足越来越小的聚焦预算空间。这可以降低研发过程中潜在的设计风险,也是当前最前沿的光刻技术背景的要求。
在最先进的量产光刻机——EUV光刻机中,影响光刻聚焦精度的因素很多,光路部分的光源、照明光路、掩模、投影光路和光刻胶均对其产生影响,按照光路顺序,涉及到的影响项有:光源的照明方式、激光带宽和偏振态,掩模的受热变形、三维效应、吸收层和自身聚焦偏移,掩模卡盘的平整度,投影光路的像差、热效应、杂散光和镀膜,以及光刻胶的三维效应等。其中,掩模的三维效应是一个重要因素。鉴于上述内容,结合当前业界发展趋势,为了提高先进光刻中的聚焦控制精度,在光路设计时,可通过以下方式进行提升:
(1)投影物镜系统中,固有像差及热效应导致的额外像差,可通过波前校正进行补偿,并能有效增大聚焦深度;
(2)为了降低掩模的三维效应,可以通过添加辅助图形,或者优化掩模制备材料的光学参数和光刻胶的化学参数。另外,由于影响因素之间存在关联,例如掩模对聚焦的影响实际是掩模对光位相的影响,因此,该影响可与投影物镜像差统一考虑,进行补偿;
(3)在实际开发中,考虑到某一影响可能并不是独立作用的,因此从光学仿真方面可提出以下两点意见:
第一、考虑EUV波段的掩模三维效应时,利用光源-掩模协同优化(SMO)技术,不断贴近最佳模型。该技术优势在于其像素式的光照分布能够使用一个参考光照条件作为起点,不断迭代到新的照明方式,提供最大的工艺窗口。
第二、通过光学邻近效应校正(OPC)指导掩模图形设计,SMO是找到最佳照明方式,OPC则是优化掩模图形设计,并联合与工艺窗口相关的OPC(Process Window OPC,PWOPC),通过分析经OPC修正后的图形,可快速地发现哪些图形的聚焦深度较小。
当然,现在此工作还存在着需要完善的部分,这也是将来前进的方向。例如,每一项影响聚焦控制因素的具体作用模型尚不明晰,不同因素间之间的联合作用仍需深入研究。这些问题涉及的技术难度大,瓶颈多,可借鉴的资料少,对于我国的光刻技术发展是一大挑战。但同时也要看到,在EUV光刻研发方面,中国科学院长春光学精密机械与物理研究所承担的国家科技重大专项项目“极紫外光刻关键技术研究”顺利通过验收[57],并研制出了高性能的投影曝光装置,可满足线宽32 nm的需求。近日,清华大学团队报告了一种新型粒子加速器光源“稳态微聚束”的首个验证实验[58],有望为EUV光刻光源提供新的技术路线,这也给国内光刻机研发提升了信心。虽然说我国在设备产品方面与国外顶尖光刻机制造厂商还存在着较大差距。但相信只要不断学习借鉴国内外同行优秀技术,组织科研团队扎实研究,就一定能在核心技术上取得创新和突破,为解决“卡脖子”问题提供助力。
