肖特基型p-GaN栅极电致发光研究
2021-05-18刘禹涵李百奎
邱 然,刘禹涵,李百奎
深圳大学物理与光电工程学院,光电子器件与系统教育部/广东省重点实验室,广东深圳 518060
宽禁带半导体氮化镓(GaN)开关型功率电子器件具有耐高温、导通电阻小、开关频率高及抗辐射等特性,是发展下一代低损耗、高功率密度、高可靠性及高效电源转换系统的核心器件[1-2]. GaN开关型功率电子器件为基于AlGaN/GaN异质结的高电子迁移率场效应管(high electron mobility transistors, HEMTs),其电子沟道由界面处的二维电子气(2-dimensional electron gas, 2DEG)提供. 2DEG的形成源于氮化物半导体的极化特性[3]. 高浓度、高迁移率的2DEG沟道,在实现低导通电阻的同时,也决定了AlGaN/GaN HEMTs为常开型,即在零栅压时,沟道处于导通状态. 为简化驱动并保证驱动失效时的安全,常关型器件在应用中具有更大优势. 目前,可通过多种不同沟道耗尽技术来制造常关型GaN器件,如氟离子注入[4]、势垒层再生长[5]、超薄势垒层[6]、栅区势垒层移除[7-8]及p-GaN 栅[9-11]技术等. 由于缺少理想的栅介质,尽管可以实现较大的栅压摆幅,基于前4种技术的金属绝缘体半导体(metal insulator semiconductor, MIS)或金属氧化物半导体(metal oxide semiconductor, MOS)栅常关型GaN功率HEMTs的发展受到限制. p-GaN栅技术,即在AlGaN/GaN异质结上引入p-GaN层形成“金属/p-GaN/AlGaN/GaN”结构的栅极,可以有效耗尽沟道2DEG,是目前制造常关型GaN功率HEMTs的主流方案,为世界各主要电子器件制造商所采用.
p-GaN栅为金属/p-GaN/AlGaN/GaN形成的金属半导体(metal semiconductor, MS)肖特基结+直接带隙半导体双边异质PIN结. 在正向栅压下,p-GaN栅不可避免地发生电子和空穴的双向注入以及电致发光,给器件的可靠性和稳定性带来复杂影响. 如电子由2DEG沟道注入到p-GaN层并被电子陷阱俘获时,将导致阈值电压漂移[12]. 空穴由p-GaN注入到沟道层并与2DEG电子复合时,可以发射高能量的紫外光. 紫外光可以激发GaN缓冲层中的复合缺陷中心,导致关态漏电的增加[13]. 因此,研究p-GaN栅极在正向栅压下电子和空穴的注入与复合过程,以及温度对载流子注入的影响,是全面理解p-GaN栅HEMTs工作特性的重要组成部分.
本研究制造了肖特基型的p-GaN栅器件,即肖特基金属/p-GaN/AlGaN/GaN器件,并测试了该器件在不同偏压下的电致发光光谱. 结果表明,在正向栅压下,电子首先被注入到p-GaN层中. 当栅压超过6 V时,空穴可以被注入到沟道层与2DEG电子复合. 在固定偏压下,当温度升高时,p-GaN栅极的电致发光强度增加.
1 晶圆结构、器件制造及表征
实验所用晶圆为利用金属有机物化学气相沉积法(metal-organic chemical vapor deposition, MOCVD)在直径15 cm(111)硅衬底上生长的p-GaN/AlGaN/GaN-on-Si结构,具体包括厚度为70 nm的p-GaN层、厚度为15 nm的Al0.2Ga0.8N势垒层、厚度为300 nm的GaN沟道层以及厚度为4 μm的缓冲层.其中, p-GaN层中Mg的掺杂密度约为1×1019cm-3.
器件制造采用标准的光刻方法,主要流程包括:① 利用氯基感应耦合反应离子(inductively coupled plasma - reactive ion etching, ICP-RIE)刻蚀传输区的p-GaN层;② 利用电子束蒸发在AlGaN表面蒸镀Ti/Al/Ni/Au金属,然后经过850 ℃高温快速退火30 s,形成2DEG沟道的欧姆接触电极;③ 在p-GaN表面利用电子束蒸镀Ni/Cr(厚度为5 nm/6 nm)的半透明电极;④ 利用等离子体增强化学气相沉积(plasma-enhanced chemical vapor deposition, PECVD)方法在器件表面沉积厚度为50 nm的SiN作为钝化层,沉积温度为300 ℃. 器件之间的绝缘隔离利用氟离子注入实现[14];⑤ 用氟基ICP-RIE将电极上部分区域的SiN刻蚀并蒸镀Ni/Au(厚度为50 nm/150 nm)金属作为引线电极.器件结构如图1.
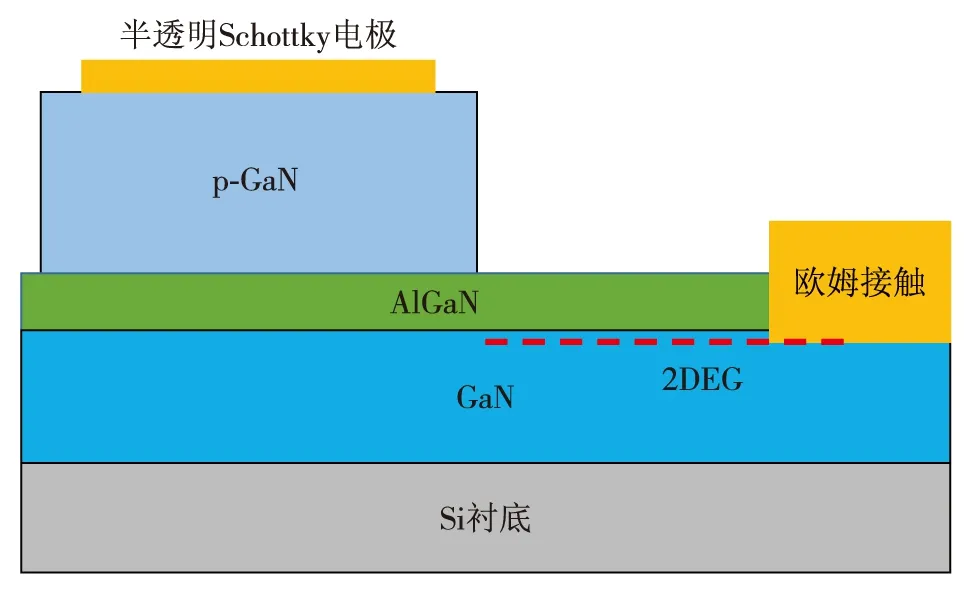
图1 p-GaN栅结构示意图Fig.1 (Color online) Schematic cross section of a metal/p-GaN/AlGaN/GaN device
采用半导体参数测试仪(型号为Keysight1505)表征器件的电流-电压曲线,并将其用作测量电致发光光谱时的恒定电压源. 电致发光光谱由光谱仪(型号为Andor550)和电荷耦合器件(charge coupled device, CCD)探测器(型号为Newton920)采集.器件放置于小型冷热台(型号为Linkam420)中,以实现室温到高温的电致发光测试.
2 不同偏压下的电致发光光谱
在正向栅压下,p-GaN栅结构中的PIN结,即p-GaN/AlGaN/GaN(2DEG)为正向偏置. 电子可以由2DEG沟道越过AlGaN势垒层注入到p-GaN层. 而p-GaN栅结构中的肖特基结,即金属/p-GaN结为反向偏置. 尽管该肖特基结的势垒高度大于1 eV,但p-GaN上的肖特基结一般具有较大的反向漏电[15-16],在较大偏压下,该肖特基界面也存在空穴注入. 图2为肖特基型p-GaN栅结构的电流电压曲线.

图2 正向偏置肖特基型p-GaN栅在室温下的电流电压曲线Fig.2 Current-voltage curve of the metal/p-GaN/AlGaN/GaN diode under forward bias measured at room temperature
GaN为直接带隙半导体,电子空穴双向注入时,将发生电致发光. GaN的发光特征与掺杂情况密切相关[17]. Mg掺杂的p-GaN发光谱主要为峰值在 2.8 eV的蓝光峰和在1.8 eV的红光,其中,红光的光强相对较弱. 非有意掺杂的GaN发光谱包括峰值在3.4 eV的带边峰和峰值在2.2 eV的黄光峰. 低激发功率或低注入电流时,低光子能量的发光峰占主导. 随着激发功率或注入电流的增加,高光子能量发光峰的强度增加[17]. 因此,通过不同偏压下的电致发光光谱,可以分析电子和空穴的注入过程.

图3 室温下肖特基型p-GaN栅极在不同正向栅压的电致发光光谱Fig.3 (Color online) Electroluminescence spectra of a metal/p-GaN/AlGaN/GaN diode under different forward bias voltages measured at room temperature
图3为室温下肖特基金属/p-GaN/AlGaN/GaN器件在不同偏压的电致发光光谱.可见,在4.5 V的偏置电压下,电致发光谱中仅有峰值在1.8 eV的红光峰,表明电子首先由2DEG沟道注入到了p-GaN层. 在p-GaN层中,电子弛豫到深施主能级,空穴弛豫到深受主能级,然后复合发出红光. 当偏置电压大于5 V时,电致发光光谱中出现了峰值在2.2 eV的黄光峰,表明空穴由p-GaN层中被注入到沟道层. 在非有意掺杂的沟道层中,空穴首先弛豫到深受主能级,然后与沟道电子复合发出黄光. 当偏置电压继续增加时,更多电子被注入到p-GaN中,随着深施主-深受主复合中心饱和,导带电子和深受主能级上的空穴复合,发出峰值在2.8 eV的蓝光;更多的空穴被注入到沟道层,随着深施主能级的饱和,空穴和电子发生带边复合,发射GaN带边3.4 eV的紫外光. 随着偏置电压的进一步增加,3.4 eV的带边发光强度继续增强. 电致发光光谱中的强度震荡来自电致发光在样品上表面和下面反射所导致的干涉现象.
电致发光光谱揭示了p-GaN栅结构在正向栅压下的电子和空穴注入顺序,这有助于研究p-GaN栅HEMT的阈值电压漂移机制. 当“开”态栅压较低时,电子被注入到p-GaN,有可能被电子陷阱俘获,从而导致阈值电压正向漂移. 而当“开”态栅压大于6 V时,大量空穴被注入到沟道层并与2DEG电子复合发射带边紫外光. 高光子能量的紫外光可以激发电子陷阱,抑制阈值电压漂移. 同时,这些高能量光子也可以激发沟道层或缓冲层中的扩展缺陷中心,产生持续光电导效应,从而导致“关”态的漏电增加,影响器件的可靠性.
3 变温电致发光光谱
开关型p-GaN栅功率HEMTs工作时,由于存在导通损耗和开关损耗,器件温度可达150 ℃以上[18]. 因此,研究高温下的电致发光光谱和载流子注入过程,对于p-GaN栅HEMTs的应用具有重要意义.
图4为p-GaN栅极在不同温度下的电致发光光谱,正向栅压为8 V. p-GaN中的复合效率远低于非有意掺杂沟道层中的复合效率[17]. 在8 V栅压下,p-GaN栅极的电致发光光谱主要表现为源自沟道层的黄光峰和带边紫外发光峰. 当温度升高时,GaN中的辐射复合效率下降[17],这是导致LED在高温下发光强度降低的主要原因. 而在p-GaN栅极中,当温度从0 ℃升高到200 ℃时,8 V栅压下的电致发光强度增加了2个数量级,如图4,表明随着温度增加,更多空穴被注入到了沟道层.

图4 栅压为8 V时,p-GaN栅极在不同温度下的电致发光光谱Fig.4 (Color online) Electroluminescence spectra of a metal/p-GaN/AlGaN/GaN diode with 8 V bias voltage measured at different temperatures
正向栅压下,金属/p-GaN肖特基结处于反偏状态. 空穴在反偏肖特基界面的注入机制包括:① 从金属费米能级到p-GaN导带的热致激发;② 直接隧穿注入或通过p-GaN层中的缺陷态隧穿注入. 当温度升高时,空穴的热动能增加,通过热致激发可以使更多空穴注入到p-GaN中. 另外,由于p-GaN层中Mg中心的激活能为170 meV[19], 室温下仅有10%左右的Mg掺杂中心被激活. 随着温度升高,Mg中心的激活效率增加,p-GaN中的空穴浓度增加. 当半导体中的载流子浓度增加时,肖特基结的耗尽区变窄[20],有助于空穴直接隧穿或者通过缺陷态隧穿注入. 因此,当温度升高时,金属/p-GaN肖特基界面处的热致空穴注入增强,更多空穴被注入到沟道区中,从而导致高温下的电致发光增强.
更多的空穴注入和更强的紫外光辐射,有利于抑制电子陷阱对p-GaN栅HEMTs稳定性的影响,如阈值电压漂移或电流坍塌等. 更强的紫外光增加了复合缺陷中心被激发的概率. 但当温度升高时,复合缺陷中心在平衡态下被电子占据的概率降低,恢复时间更短. 因此,需要进一步研究评估高温下栅极电致发光增强对p-GaN栅HEMTs稳定性和可靠性的影响.
结 语
通过研究p-GaN栅极的电致发光光谱,揭示了p-GaN栅极在正向偏压下的电子和空穴双向注入过程. 当栅压较低时,电子首先由沟道注入到p-GaN层中;栅压增加时,空穴由p-GaN注入到沟道层. 当温度升高时,固定栅压下的电致发光强度显著增加,揭示了在金属/p-GaN界面处的热致空穴注入增强现象.
