高压IGBT芯片高温测试温度的阈值电压标定
2017-10-24涂启志凌浪波
涂启志,凌浪波
(1.无锡广播电视大学,江苏无锡214011;2.株洲中车时代电气有限公司,湖南株洲412000)
高压IGBT芯片高温测试温度的阈值电压标定
涂启志1,凌浪波2
(1.无锡广播电视大学,江苏无锡214011;2.株洲中车时代电气有限公司,湖南株洲412000)
IGBT(Insulate Gate Bipolar Transistor,绝缘栅双极晶体管)已得到广泛应用。为提高封装阶段的成品率,需对芯片的高温漏电特性进行测试。通过对芯片测试参数的分析,提出了可通过对Vgth(阈值电压)的测试、比对,实现对芯片在高温测试条件下实际测试温度的校正。
IGBT;阈值电压;高温;漏电流
1 引言
IGBT(Insulate Gate Bipolar Transistor,绝缘栅双极晶体管)目前已经在各种电力电子变换装置中得到了广泛的应用,成为中、大功率电力电子装置的主导器件,不仅广泛应用于电力系统,而且也广泛应用于一般工业、交通运输、通信系统、计算机系统和新能源系统。
IGBT器件的纵向剖面结构如图1所示。从剖面结构来看,它可视为功率场效应晶体管(MOSFET)和双极型晶体管(BJT)结构的复合器件,其输入极为MOSFET,输出极为PNP晶体管。因此,可以将其看作是MOS输入的达林顿管。其简化等效电路图如图2所示。
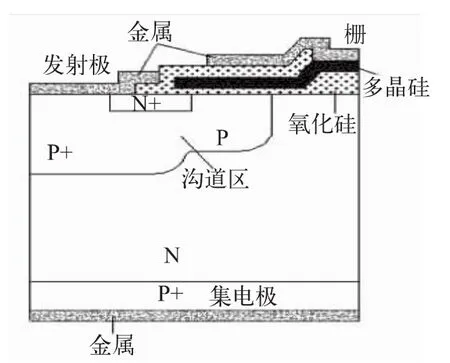
图1 IGBT器件的剖面示意图
由于其输入极为MOSFET,输出极为PNP晶体管,所以IGBT具有输入阻抗高、开关速度快、驱动功率小、饱和压降低、控制电路简单和承受电流大等特性。
由于其广泛应用于电力系统中,使得IGBT器件经常需要工作在高温环境中,因此,器件在高温环境下的高压漏电流将直接影响到系统的稳定性和可靠性。
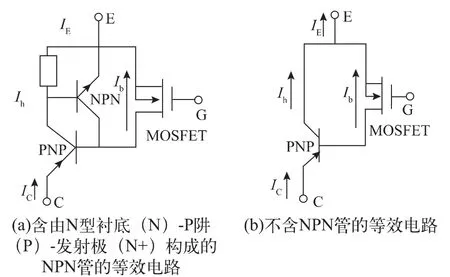
图2 简化等效电路图
同时,大功率IGBT模块通常由多个IGBT芯片并联封装而成。因此倘若个别IGBT芯片在模块进行高温测试时出现漏电失效的问题,则会造成整只模块的报废,使得该模块中其余正常芯片被报废,连同相应的封装、测试成本损耗,从而形成极大的损失。
由此,在芯片测试阶段对芯片进行高温漏电测试,将极大地减少后端工艺的失效率,对提高产品成品率、降低生产成本具有重要的意义。
2 高压反向漏电流与温度的关系
IGBT高压反向漏电流为发射极和栅极接地、集电极加高压偏置时集电极上通过的电流。为防止器件出现闩锁,IGBT的寄生PNP晶体管的放大倍数被严格限制,使得PNP管的放大效应可以被忽略。
由图1可以看出,器件的反向漏电流的大小由P阱和N衬底构成的PN结的反向漏电流确定。其反向漏电流公式为:

反向漏电流由产生电流和扩散电流两部分构成,室温附近是产生电流起主导作用,而高温区是扩散电流起主导作用。

而扩散电流随温度的变化主要由exp[-Eg/(k0T)]决定,因此反向漏电流在高温区将随着温度的升高而迅速增大。由此可知确保测试温度的准确和稳定对芯片的高温漏电测试意义重大。
同时,对于高电压电子器件,在芯片测试时若器件处于通常的大气环境中,由于测试针卡与基板间距离有限,在测试高压参数的过程中,易发生空气电离,进而在针卡与基板形成导电通道,将严重影响测试的准确性,情况严重时甚至会造成芯片的损伤。在进行2500 V及以上电压的测试时,此类现象尤其明显。
通过提高测试区域的大气压力,并采用干燥氮气(N2),可以有效避免此类气体放电现象的发生。因此需要对针卡进行特殊的设计。
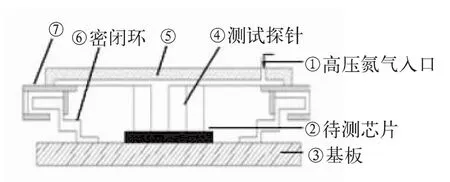
图3 针卡测试示意图
图3中,由①进入的氮气封闭在由③、⑤、⑥、⑦形成的空腔内,使得空腔内的压力达到数个大气压,同时,在密闭环的底部设置有小孔,可形成高压气幕,避免因基板和密闭环接触不够紧密而漏气,并进而影响到空腔内的压力。
通过此类针卡虽然可以实现在高气压环境下进行测试,但在进行高温漏电流测试时出现了如图4所示的分布特性。每个批次的前几只芯片漏电流明显大于其他芯片,且随着测试的进行,漏电流逐渐变小并最终达到平衡。

图4 高温静态漏电测试分布特性曲线
经分析,该现象是由于高压氮气的流动,使基板的表面温度发生变化而引起。当刚开始测试时,基板表面温度较高,随着测试到一定的时间,基板表面温度逐渐降低,并最终达到平衡。但由于设备中温度传感器放置位置的原因,使得基板表面的温度变化在设备上无法得到显示,无法确定芯片的实际测试温度。
为准确得到芯片的实际结温,根据IGBT芯片的器件特性,设计了以下实验。
3 实验设计与实验验证
经分析,并非所有IGBT芯片的静态参数测试都需要施加高电压。当进行Vgth测试时,VCE仅需在0~6 V之间进行扫描。因此Vgth可在大气环境下进行测试。由半导体理论可知:

式(3)表明,阈值电压随着温度的升高而下降。由此可以测出在大气环境下Vgth随温度变化的曲线,并加以拟合,再与标准高温测试时的Vgth测试值相比较,即可得出相应的温度值。
通过对多批次测试数据的分析,发现每个批次均在其测试的最初大约10~15只漏电流偏大,其后的芯片即可达到平衡。由此可先行对整批IGBT芯片进行高温测试,再在温度平衡区域内选出若干芯片,采用不加气压的方式,在不同的温度下只测试其Vgth,为确保取样的准确性,实验设定选取15只芯片,其按照标准高温测试条件所得Vgth测试值如表1所示。
保持芯片的测试顺序不变,在大气环境下对相同的芯片在不同温度下测试其Vgth,起始温度为60℃,测试温度间隔为30℃,为确保过程中芯片与基板达到热平衡,每次测试前芯片需在基板上置放90 s,以使芯片充分加热。测试结果如表2所示。

表1 标准高温测试条件下的V gth值

表2 V gth在大气环境不同温度下的测试值
结合表1和表2可以看出,不管是特定芯片还是所有芯片的平均值,其标准高温测试条件下的Vgth值均在大气环境下的120~150℃的测试值之间,且更接近120℃的测试值。为消除器件分布离散性和测试条件波动的影响,对大气环境下测试值的平均值采用2次回归进行曲线拟合,得出拟合曲线如图5所示。
由此,得出Vgth与温度关系的拟合方程:

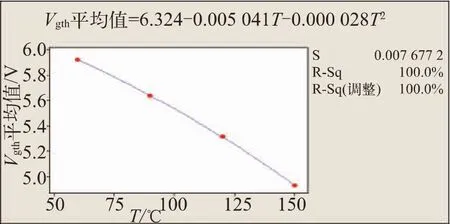
图5 平均值的2次回归拟合曲线
将标准高温测试条件下的Vgth平均值5.159 V代入式(4),可得解 T=133℃。
测试130℃下大气环境中芯片的Vgth,如表3所示。
比较表 1 和表 3,发现 #3、#5、#8、#9、#11、#13、#14、#15芯片,共有8只芯片两次测试的数据相同,其余7只芯片表3数值略大于表1,考虑在连续测试下温度为一动态平衡状态,基板表面温度出现一定的波动为正常现象。通过对不同芯片的单片测试数据进行拟合,通过计算,可知基板表面温度在130~135℃之间波动。

表3 130℃大气环境下V gth测试值
4 结论
高压IGBT芯片在进行高温静态测试时,需置于高压氮气(N2)的保护下,以防止气体电离而引发测试偏差甚至损伤器件。但此种方式也带来了芯片测试温度发生改变的问题。
通过实验验证,确定可以通过在大气环境下对Vgth进行温度曲线测试、并将测试结果和标准高温测试时的Vgth进行比较的方式实现对测试温度的校正。
芯片高温测试温度达到平衡时,基板温度处于一种动态平衡的状态,该状态下不同芯片的测试温度出现一定的波动为正常现象。当动态平衡时平均温度为133℃时,该实验机台的实际波动范围在130~135℃之间。
[1]袁寿财.IGBT场效应半导体功率器件导论[M].北京:科学出版社,2007.
[2]于坤山,谢立军,金锐.IGBT技术进展及其在柔性直流输电中的应用[J].电力系统自动化,2016,06.
[3]周卫平,刘建华,张栋.6500 V超高压、大电流IGBT芯片的工艺研究[J].集成电路应用,2016,06.
[4]刘宾礼,唐勇,罗毅飞.基于电压变化率的IGBT结温预测模型研究[J].物理学报,2014,17.
[5]冯松,高勇.温度对三种IGBT结构通态特性的影响[J].电力电子器件,2016,06.
[6]高明超,韩荣刚.压接式IGBT芯片的研制[J].固体电子学研究与进展,2016,01.
[7]Kuang S.Design,modeling and application of the IGBT[D].Edinburgh:Heriot-Watt University,1999.
[8]Khanna V K.Power IGBT design and characterization by two-dimensional thermal simulation[J].Physics of semiconductor devices,2002, 4746(2):436-439.
VgthMethod During High Temperature Test of High-Voltage IGBT Chip
TU Qizhi1,LING Langbo2
(1.Wuxi Radio&Television University,Wuxi 214011,China;2.TEG of CRRC,Zhuzhou 412000,China)
The IGBT (Insulate Gate Bipolar Transistor)has been extensively used in all kinds of power electronics devices.It is important to check if chips would fail during high temperature tests.In the paper,the method of using the Vgthto check the temperature of chip surface during the high temperature test is discussed.
IGBT;Vgth;high temperature;leak current

TN407
A
1681-1070(2017)10-0013-04
2017-4-27
涂启志(1968—),女,江苏无锡人,硕士学历,讲师,现从事电子类课程的教学工作。
