长寿命抗干扰测试针在SOT363半导体高频器件测量中的应用
2017-07-20唐明津陈伟陈新
唐明津,陈伟,陈新
(英飞凌(无锡)科技有限公司,江苏无锡214028)
长寿命抗干扰测试针在SOT363半导体高频器件测量中的应用
唐明津,陈伟,陈新
(英飞凌(无锡)科技有限公司,江苏无锡214028)
在半导体器件生产企业中,使用测试针接触器件的引脚进行电参数测量,必须考虑两个问题。一个问题是降低测试针与器件引脚间的接触电阻。在自动化生产线中,企业要想得到高精度的测量值,必须经常替换已磨损的测试针,才能获得更高的成品率。另一个问题是降低外部信噪对半导体高频器件(工作频率>2 GHz)HFE参数测量的影响。外部信噪会使高频器件的HFE参数不稳定,造成成品率的降低。通过SOT363测试针设计实例,介绍了新型长寿命抗干扰测试针的设计方法。
长寿命抗干扰测试针;高频器件;成品率
1 引言
随着半导体设计技术朝着高效率、多功能、小体积的方向高速发展,相应的封装形式也越来越多样化。其中SOT是小型晶体管表面贴装型式,其在汽车电子和通信行业中的应用非常广泛,常见有SOT23、 SOT223、SOT363、SOT89等,如图1所示。
要想对SOT半导体器件的电参数进行精确测量,企业都会选择高效的测量系统。一个完整的测量系统必须包括测量仪表、测量电缆、测试针和器件四个要素,见图2。
工作原理:测量仪表通过测量电缆和测试针将电压或电流加到器件特定的引脚上,测得相应引脚上的电流或电压的值,计算出电参数的数值。
测试针与半导体器件的引脚直接接触,它的设计要求非常严格,不仅要求导电性能好,接触电阻极小,还希望使用寿命较长,维护成本低。

图1 SOT半导体器件

图2 SOT363测量系统
2 SOT363测试针材料的选择
常见的测试针材料有钨钢、铍铜、磷铜、黄铜等原材料。材料的选择是由半导体器件内部芯片的金线或铜线的直径决定的,直径大的能通过很大的电流,直径小的只能通过较小的电流。
例如SSO8,它能通过50 A的大电流,而且引脚厚度较大,测试针材料使用的是钨钢,它具有硬度高、耐磨、强度和韧性较好、耐热、耐腐蚀等一系列优良性能,但是它的导电性能没有铍铜好。
但是对于通过小电流或低电压的半导体器件,例如SOT363,它只能通过100 mA的小电流,所以测试针的材料必须选择导电性能更好的铍铜,接触电阻很小,没有电压损耗。铍铜是以铍为主要合金元素的铜合金,又称之为铍青铜。它是铜合金中性能最好的高级有弹性材料,有较高的强度、弹性、硬度和疲劳强度。
铍铜和钨钢相比,导电性能更好,接触电阻更小,但是硬度较低,容易磨损,使用寿命短。因此使用铍铜为SOT363的测试针材料,就必须考虑通过改进测试针的结构来提高测试针的使用寿命。
3 SOT363长寿命抗干扰测试针的设计
3.1 扁平测试针设计
扁平测试针在SOT363测试包装机上的使用非常广泛。它的外形见图3,与测量电缆的连接见图4。
3.1.1 扁平测试针的工作方式
扁平测试针由于长度较短,工作方式采用的是压测方式。这种工作方式很简单,就是让测试包装机的吸嘴将器件吸起,然后把器件的引脚压在测试针的前针和后针上,先进行Kelvin测试,然后进行电参数测试。
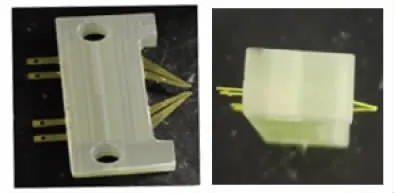
图3 扁平测试针的外形
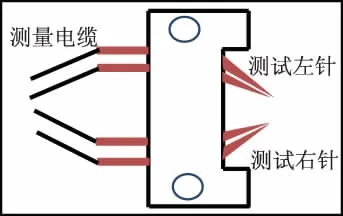
图4 扁平测试针与测量电缆的连接
3.1.2 扁平测试针的优缺点
优点:测试针长度较短,技术员调整测试针与器件引脚的接触位置方便,HFE测量值稳定,可以测量半导体高频器件(2 GHz以上)。缺点:使用寿命较短,接触次数在250万次左右。因为使用压测方式,测试针与器件引脚接触的地方工作过一段时间后,测试针会被引脚压出一个凹坑。这时测试针必须要更换,否则会降低产品的成品率。
3.2 长测试针设计
为了解决扁平测试针使用寿命较短的问题,我们通过增加测试针的长度,改变测试针的工作方式,设计出了长测试针。它的外形见图5,与测量电缆的连接见图6。
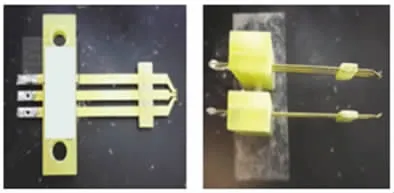
图5 长测试针的外形

图6 长测试针与测量电缆的连接
3.2.1 长测试针的工作方式
长测试针的长度长,不能采用压测工作方式(否则容易折断),必须使用夹测方式。这种工作方式是测试针在打开和合上时在凸轮的作用下做圆弧运动,器件的引脚被测试针的上针和下针夹住,先进行Kelvin测试,然后进行电参数测试。夹测工作方式见图7。
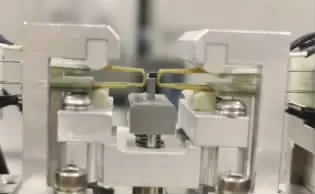
图7 测试针的夹测工作方式
3.2.2 长测试针的优缺点
优点:使用寿命长,接触次数在500万次左右。缺点:由于测试针较长,测量半导体高频器件(2 GHz以上)时,对抗外部信噪干扰的能力不强,HFE参数测量值不稳定,会降低产品的成品率。长、短测试针在测量频率中量值的经验值见图8。

图8 长、短测试针在测量频率中量值的经验值
长测试针在测试半导体器件上具有一定的局限性。它只能测试工作频率低于2 GHz以下的半导体器件,工作频率高于2 GHz的半导体器件仍然离不开扁平测试针,所以长测试针没有得到很大的推广。
3.3 长寿命抗干扰测试针
在SOT363半导体测试设备中,同时使用两种不同样式的测试针,这对于设备的使用和备件的管理是很不方便的。这就迫切要求我们能设计出一种同时具有扁平测试针和长测试针优点的测试针来满足生产的需要。
扁平测试针的优点是测量工作频率高于2 GHz的器件时HFE参数稳定,原因是测试针接触器件引脚处距离测量电缆的长度短。长测试针使用的是夹测方式,优点是寿命长。因此要想同时具有扁平测试针和长测试针的优点,测试针的结构设计就必须同时具备上面两种测试针的结构特点。
3.3.1 长寿命抗干扰测试针的设计理念
(1)为了在有外部信噪干扰时保持HFE参数稳定,我们采用了匹配和屏蔽等抗干扰手段,所有的测试电缆都带有屏蔽层,并且测试电缆到测试针焊点的长度都是相同的。同时保证测试针与器件引脚的接触点到测量电缆焊点的长度不大于扁平测试针的长度。
(2)为了降低测试针的磨损,提高测试针的使用寿命,测试针不能使用压测工作方式,而必须使用夹测工作方式。为了方便技术员调整测试针与器件引脚的接触位置,测试针的安装孔到测试针与器件引脚的接触位置的长度不小于长测试针的长度。
为此,我们经过多次的试验和改进,终于找到了解决问题的方法。在测试针尾端到测试针的安装孔位置之间加装弹簧片来保证其总长度与长测试针相同。同时可以在测试针的尾端焊接测试电缆,测试针的尾端到针尖处的长度没有超过扁平测试针的长度。长寿命抗干扰测试针的设计原理见图9。

图9 新型长寿命抗干扰测试针的设计原理
3.3.2 长寿命抗干扰测试针设计
通过设计人员的不懈努力,对测试针的不断改进和样品试制,我们最终完成了长寿命抗干扰测试针的设计工作。图10所示就是测试针在SOT363半导体包装机测试夹上的安装图。
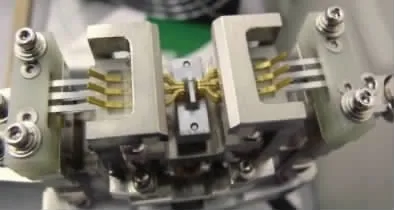
图10 长寿命抗干扰测试针的安装图
长寿命抗干扰测试针是由测试针和弹簧片组成的。测试针的长度等于扁平测试针的长度,测试针和弹簧片的总长度等于长测试针的长度。它的外形见图11,与测试电缆的连接见图12。
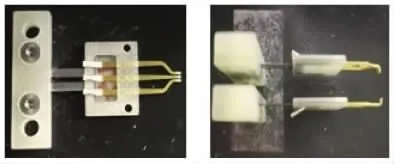
图11 长寿命抗干扰测试针的外形
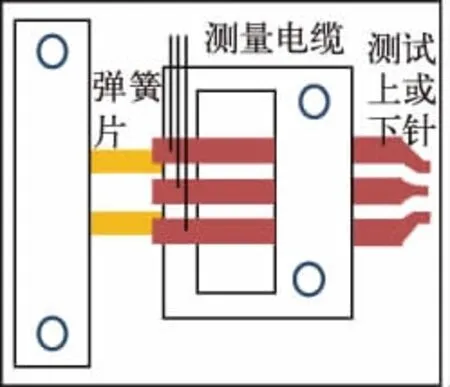
图12 长寿命抗干扰测试针与测量电缆的连接
3.3.3 长寿命抗干扰测试针的工作方式
长寿命抗干扰测试针的工作方式与长测试针的工作方式完全相同,也使用夹测的工作方式。测试针不但能与SOT363器件的引脚可靠接触,而且也不会很快被压出凹坑,它的运动轨迹见图13。

图13 长寿命抗干扰测试针的上下针运动轨迹
3.3.4 长寿命抗干扰测试针的优点
长寿命抗干扰测试针同时具有扁平测试针和长测试针的优点。在有外部信噪干扰时,测量工作频率高于2 GHz的器件时HFE参数测量值稳定,同时使用寿命长,触点接触次数在2500万次左右。使用寿命比扁平测试针多达10倍,技术员调整测试针的位置方便。长寿命抗干扰测试针在SOT363半导体包装机上使用至今已超过2年,没有任何问题出现。
4 结论
测试针是半导体器件测量系统的重要组成部分。使用长寿命的测试针是企业保证测量准确度和降低设备维护成本的重要因素之一。新型长寿命抗干扰测试针的寿命已经被证明是扁平测试针的10倍以上,而且解决了高频器件HFE测量值不稳定的问题。
Application of Long-Life and Anti-Interference Contact Finger for High-Frequency SOT363 Semiconductor Device Measurement
TANG Mingching,CHEN Wei,CHEN Xin
(Infineon Technologies(Wuxi)Co.,Wuxi 214028,China)
During semiconductor test measurements,the contact finger is one of the mAin contributors to high accuracy and precision.Two concerns must be focused to design a good test contact finger.One is good kelvin test contact at test device lead pad,another is test interference from external electrical noise for high frequency (HF)SOT device(>2 GHz).To achieve a high precision test measurement in auto mAtic production line, frequent replacement of the worn-out test contact fingers should be performed to sustain good test yield. Another concern is high frequency devices facing HFE test oscillation and causing yield loss.To solve these issues,a new design of long life test contact fingers and high consideration of anti-oscillation/anti-electrical noise design must be developed.In the paper,the new design method of long life span and anti-interference test contactfingerisintroduced via SOT363 testcontactfinger.
long-life and anti-interference contactfinger;high frequency devices;yield

TN304.07
A
1681-1070(2017)07-0008-03
唐明津(1955—),男,马来西亚人,本科,高级工程师,现任职于英飞凌(无锡)科技有限公司,主要负责改进和研发新型半导体测试技术和测试设备。
2017-2-24
