塑封互联MIS高可靠性封装及板级封装新技术
2017-07-20王新潮陈灵芝
王新潮,陈灵芝
(1.江苏长电科技股份有限公司,江苏江阴214400;2.江阴芯智联电子科技有限公司,江苏江阴214400)
塑封互联MIS高可靠性封装及板级封装新技术
王新潮1,陈灵芝2
(1.江苏长电科技股份有限公司,江苏江阴214400;2.江阴芯智联电子科技有限公司,江苏江阴214400)
塑封互联MIS技术是一种高性能、高可靠性封装基板及板级嵌入式封装技术,其灵活的布线及特有的材料结构及工艺特点,结合MIS基板中铜布线超粗化等表面处理工艺,在电、热性能及可靠性方面相比现有BGA、QFN等封装凸显出显著的优势。基于MIS工艺的灵活性,目前在封装领域尤其在嵌入式封装、系统级封装等方面表现优异,已广泛应用于手机、工业控制、IOT等电子产品的射频类、电源管理类器件的封装中。文章对MIS技术主要工艺流程、技术特点、在各类封装中的应用、电热性能等进行了阐述。
MIS;嵌入式封装;铜柱;半蚀刻
1 引言
随着集成电路产品性能的进一步提高及超薄的需求,芯片制造工艺中节点微缩的难度及成本越来越高,进一步的功能集成及性能提升逐步转向封装技术的研发与整合,封装在半导体产品中的相对价值越来越高,封装行业的技术进步和增长逐步支撑集成电路产业的整体增长,成为集成电路产业发展的重要推动力。为了满足未来5G通信技术、无人驾驶、智能穿戴等应用领域的发展趋势,以及随之而来的高频信号传输与高速数据交换,对产品的电热性能及可靠性提出了更高的要求,同时要求支持高密度、多功能系统集成,使得芯片制造与封装、封装与基板制造、封装与组装等开始逐步相互渗透、相互融合,推动了半导体产业链的上下整合。
Molded interconnect system(MIS)[1]技术作为一项新的封装基板及板级(panel level)嵌入式封装技术被提出,创新性地将封装工艺与高密度基板制作技术相结合,导入高密度互联布线设计,嵌入芯片或被动元件等,极大地提高了封装的灵活性,可满足当今电子产品高频、高速、多功能以及更轻、更小和更薄的需求,具有广阔的应用市场和发展前景。
2 MIS封装技术流程及主要特点
MIS封装技术是在金属载板上图形电镀及实心铜柱电镀成形工艺的基础上,借助封装技术中的包封工艺、芯片贴装工艺(FC或WB)、元件贴装工艺等来实现更高的布线密度、更优的电传输性能,以完成多功能集成的一项新型封装技术。
MIS板级封装技术的实现方法为:在覆铜金属板上通过光刻(lithography)、电镀成形来完成内层线路的布线及导通铜柱的制作;然后通过预包封工艺,实现线路的嵌入式结构与线路间的绝缘;再通过芯片贴装或被动元件贴装来完成芯片或被动元件的嵌入,最后通过窗口蚀刻完成外引脚的露出等。具体工艺流程如图1所示。

图1 MIS板级封装技术典型工艺流程
从以上简要流程中可以看出:MIS基板封装工艺技术在增层工艺(build-up)的基础上,根据产品需求,可以对布线、压膜、芯片贴装及SMT等工艺进行组合运用,是一种全新的封装与基板融合技术,给设计及系统集成带来了很大的灵活性。另外,由于在工艺过程中,层间布线连接采用的是实心铜柱电镀工艺,绝缘材料选用的是塑封树脂材料,如图2(a),该材料结构给所封装产品带来了优异的电性能、热性能;同时,在金属层表面及侧壁运用粗化处理工艺,如图2(b),加大了金属与绝缘材料、金属表面与芯片结合处等的结合力,降低了分层风险,显著提升了封装的可靠性。

图2 MIS实心铜柱结构
3 MIS封装技术的典型应用
MIS封装技术因其在材料结构及工艺上特有的优势,在多功能系统集成及高散热、低功耗及高可靠性上具有优势。
3.1 高可靠性MIS封装应用
一直以来,陶瓷封装是封装领域中高可靠性封装的代表,在一些可靠性要求较高的领域,由于常规引线框架或有机基板模塑封装很难达到这一要求,使得很多情况下使用者只能选择气密性陶瓷封装来实现,但是随着产品小型化、多功能集成以及陶瓷基板在高密度布线上的困难,促使部分陶瓷封装产品有转用塑封封装的需求。然而在这些封装产品领域中,分析其可靠性要求,首先最基本的是必须达到在封装器件层面上要通过高加速温湿度及偏压测试HAST500(Highly Accelerated Stress Test,HAST)试验考核,而这一试验考核是在130℃、相对湿度85%同时加负载的条件下进行的,对目前常规有机基板类封装及引线框架类封装来讲,该可靠性试验通过的可能性较低。但是MIS封装利用电镀铜柱技术及粗化处理,以及对绝缘材料的选型,在多个产品上做到了可通过HAST500的试验考核,表明MIS封装相比常规塑封封装,具备低吸潮性及低渗水性,为部分陶瓷封装转用塑封封装或高可靠性封装产品提供了新的选择,如图3(a)、图3(b)。
3.2 侧壁上锡的MIS封装技术
为了提高汽车器件焊接的可靠性,器件会要求其贴装到PCB板上时引出端具备侧壁爬锡的要求,以直观地检查焊接质量及确保可靠的焊接性。目前多数QFN引线框都是通过在管脚上蚀刻出一个凹槽的结构来实现侧壁上锡,典型结构如图4所示,封装侧壁的引出端部位有露铜问题。
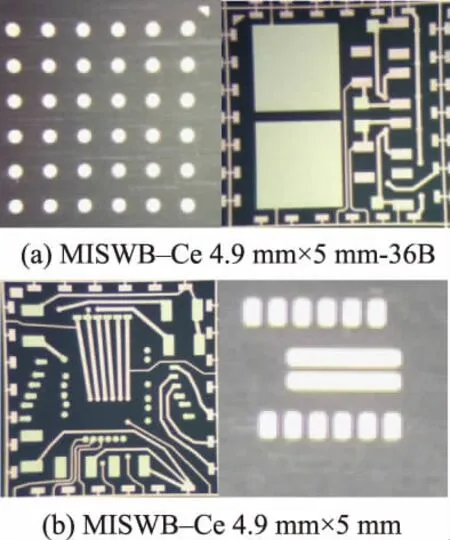
图3 通过HAST500考核的部分产品设计

图4 典型QFN引线框凹槽结构及爬锡图
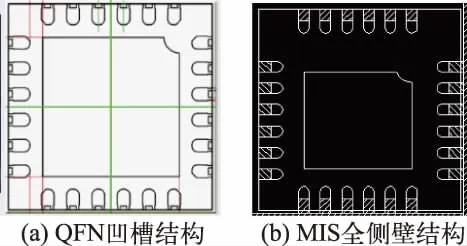
图5 可侧壁爬锡俯视结构对比图
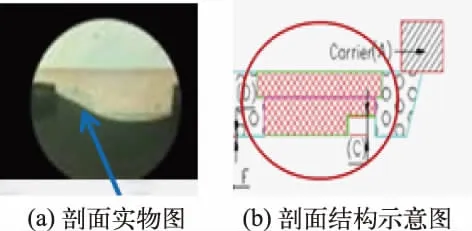
图6 可侧壁爬锡的MIS结构
图5是可侧壁爬锡俯视图QFN与MIS结构对比,图6是通过半蚀刻技术实现的可侧壁爬锡的MIS产品剖面结构示意图及实物图,比只有凹槽的QFN引出端具有全侧壁可爬锡,在焊接焊点外观及焊接可靠性上表现更优。加上MIS灵活的布线及MSL1的可靠性,为可靠性要求高的汽车产品封装提供了新的解决方案。
3.3 MIS板级fan out及3D封装技术
为了进一步缩小封装尺寸及适应高频、高速信号传输的要求,同时进一步提升封装产品的电、热特性及机械性能等,新兴的板级fan out技术及3D封装技术越来越成为未来又一主要的先进封装技术。MIS技术整体以Build-up工艺为基础,为其从基板制造进一步延伸到板级封装或3D集成封装赋予了优势,同时MIS技术采用特有的超高铜柱电镀技术、研磨技术等,也在板级fanout及3D封装中凸显出其特有的性能优势。

图7 MIS板级fan out及3D封装结构图
图7(a)是一款封装体内集成天线的产品示意图,为了匹配未来5G通信技术产品的需求,考虑到产品的高频传输要求,在绝缘材料的选型上,特别针对不同高频介电性能的绝缘材料进行了对比选择。由于5G通信技术平台上信号传输频率会达到几十GHz,接收发送天线的尺寸显著减小,使得天线集成在封装体内成为可能。图7(b)为MIS-3D封装,在芯片嵌入的基础上,三维迭加电感、电阻等被动组件,实现MIS 3D封装,目前该MIS-3D封装技术已被成功应用到多款穿戴式电子产品的电源管理芯片中。
4 MIS封装热性能、电性能
4.1 热性能仿真
为了评估MIS封装与目前先进封装代表eWLB封装的散热性能,分别选用MIS封装与eWLB封装进行了热仿真分析,仿真产品具体封装结构、各材料热导率及PCB板结构如表1~3所示。

表1 两种封装结构参数表

表2 各材料热导率表

表3 PCB结构参数
MIS封装与eWLB封装的仿真结果如表4和图8所示(热阻仿真根据标准EIA/JESD51-2进行)。

表4 热阻仿真分析结果
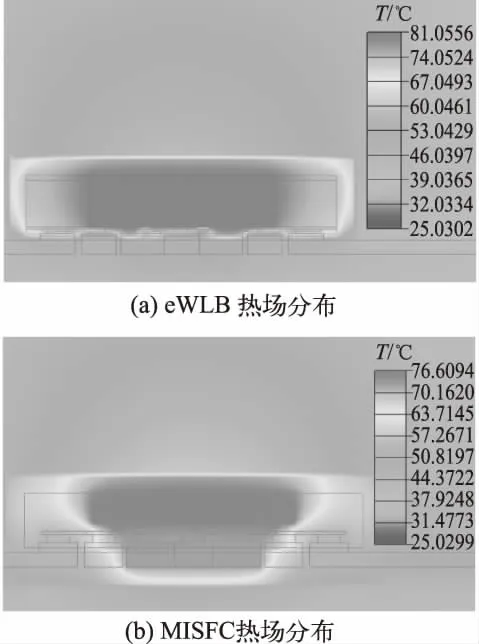
图8 热场分布图
分析结果显示,对于同一款设计的产品,MIS封装与eWLB封装相比,在环境温度25℃、功耗为0.3 W的条件下,其封装体热阻要低8%左右。
4.2 电性能仿真
针对MIS基板封装产品与有机基板封装产品进行了电性能仿真分析对比,任意选取MIS基板及常规IC基板完全一致的6条金属线路,对比分析金属线路的寄生电感、寄生电阻及寄生电容,MIS基板结构及有机基板结构如图9所示。
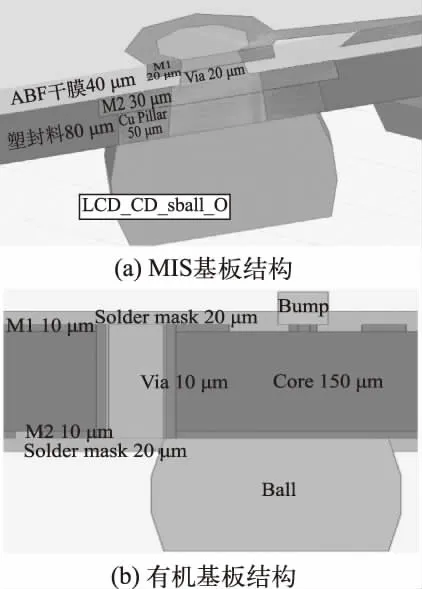
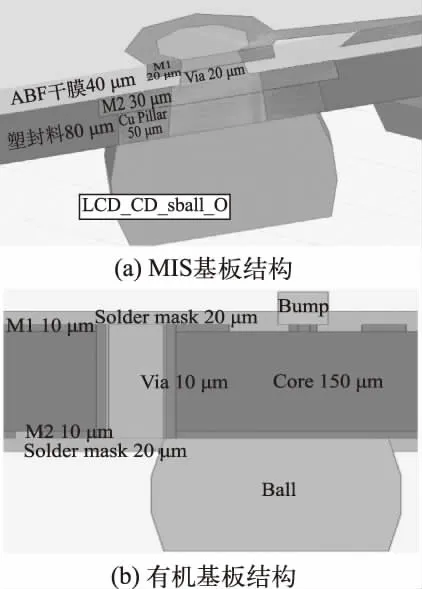
图9 用于电性仿真分析的MIS基板及有机基板结构图
各材料电性参数如表5所示。

表5 材料电性参数
经过仿真分析,结果如表6所示。

表6 MIS与有机基板电性仿真分析数据
数据显示MIS结构金属线路,不管是寄生电阻还是寄生电容、寄生电感总体上优于有机基板金属线路,较小的寄生电阻、电容及电感更加适用于未来高频、高速信号传输产品电性能的提升。
5 结束语
MIS技术作为一项全新的封装基板及板级封装技术,展现了灵活的布线设计、更高的布线密度、得天独厚的芯片嵌入及被动元件嵌入的板级封装能力,再加之其更优的电热性能及可靠性,顺应电子产品不断向高性能、多功能、高频传输方向发展的需求,具有非常广阔的市场前景。
[1]Chew Hwee-Seng Jimmy.Semiconductor Package for Fine Pitch Miniaturization and Manufacturing Method There of [P].US patent No.7795071.
New MIS Technology for High Reliability and Panel-Level Packaging
WANG Xinchao,CHEN Lingzhi
(1.Jiangsu Changjiang Electronics Technology Co.,Ltd.,Jiangyin 214400,China; 2.MISpak Technology Co.,Ltd.,Jiangyin 214400,China)
MIS is an emerging electronic packaging technology developed for high reliability and panel level embedded packaging.Due to its flexible trace routing capability,unique material structure,process features and surface roughness treatment,MIS is of higher reliability,better electrical and thermal performance compared to standard BGA,QFN or other package types.MIS process's flexibility has distinguished it in embedded packaging or SiP packaging arena.At present,MIS has been widely applied to RF device and power management devices of cell phone,industrial control,IoT,etc.In the paper,technological features,packaging application and E&T performance of MIS technology are presented and the process flow is overviewed.
MIS;embedded packaging;copper pillar;half-etching
TN305.94
A
1681-1070(2017)07-0001-04
王新潮(1956—),男,江苏江阴人,博士学历,江苏长电科技股份有限公司董事长,兼任国家集成电路封测产业战略联盟理事长,高密度集成电路封装技术国家工程实验室理事长,SEMI全球董事,中国半导体行业协会副理事长,江苏省半导体行业协会理事长,江苏制造强省建设专家咨询委员会委员,南京大学产业教授,华中科技大学、东南大学兼职教授。

2017-6-5
