In掺杂GaN/ZnO/GaN 范德瓦尔斯异质结的电子结构和光催化特性研究
2021-10-27薛丽丽李洪亮卢金铎
薛丽丽,李洪亮,窦 慧,卢金铎,高 静,信 天,王 强
(1.山东省产品质量检验研究院,山东 济南 250102;2.山东大学 微电子学院,山东 济南 250101)
0 引言
太阳能电池是指将太阳光转换成电能(包括电压、电流等)的装置.第一代太阳能电池是Si、Ga半导体,第二代太阳能电池则是由第一代衍生出来的薄膜电池.前两代太阳能电池基本材料都是半导体,所以又称为半导体电池[1-3].但是半导体电池能量转换效率不是很高,为了提高光的转换效率,1991年,Regan和Gratzel[1]提出了染料电池的概念,并首先用TiO2作为接收板,以酞菁染料为光催化剂制作成了首个染料电池.由于染料电池的光转换效率高,制作成本低,光催化染料分子易获得且无污染,因此该电池成为了第三代光伏电池,而Ga N、Sn O2、SiC、Zn O 等由于特定的能带结构被选为光生载流子接收板.其中Zn O 由于具有优良的半导体光学效应以及化学稳定性等一系列的优点,在光催化领域得到广泛的应用[4,5].但是纤锌矿Zn O 带隙宽度过宽(3.2 eV)[6],只对紫外光有活性,光吸收效率低,另外和其他半导体一样光生载流子复合率高,导致了光生载流子损失严重[7],降低了导带中的电子浓度以及光电流的产生.因此减少光生载流子复合,提高对光的吸收率是需要解决的两个问题.
常见的减少光生载流子复合、提高对可见光的吸收的方法包括掺杂[8,9]、复合半导体等[10,11].复合半导体由于是由不同的半导体材料叠加在一起构成的结构,而两种不同的半导体的费米能级不同,结合后电子由费米能级高的一端流向费米能级低的一端,在界面处构建起微电场,能够有效阻止载流子复合.纤锌矿结构的GaN 也是常见的半导体材料,与Zn O 具有类似的结构,都属于六方晶体,晶格失配度仅为1.8%[12],容易结合形成稳定的异质结,因此Ga N/Zn O 异质结被广泛应用于光催化材料领域[13,14].虽然Ga N/Zn O 异质结能够有效分离光生电子和空穴但是对于带隙的减小却比较有限,因此对于可见光的吸收不是很理想.为了进一步减小带隙宽度,提高对可见光的吸收,各类金属和非金属掺杂Ga N 和Zn O 半导体得到广泛的研究.在元素周期表中In与Ga、Zn原子序数相近,因此In 掺杂Ga N 和Zn O 得到广泛的关注:Alamdari等[15]研究发现Al-In共掺杂使得Zn O的带隙宽度由3.75 e V 减小到3.7 e V,相应的吸收边也发生了红移;Mourad等[16]发现In掺杂能够减小Zn O 的带隙宽度,促进对可见光的吸收;Mimouni等[17]发现Cr-In共掺杂使Zn O 带隙宽度由3.3 e V 减小到3.1 e V,提高了光催化效率;Liau等[18]发现In-Ga共掺杂Zn O 能同时降低价带和导带的位置,减小带隙宽度;Yu等[19]发现In掺杂GaN/Zn O 异质结后带隙减小,发光谱红移;Ganesh等[20]发现In掺杂In GaN/GaN 多层量子阱结构能明显增强光电流.虽然In 掺杂Zn O 和Ga N 后能够减小带隙的宽度,提高可见光的吸收效率,但是In掺杂GaN/Zn O/GaN 双层异质结对可见光吸收的研究还未见报道.鉴于此,采用第一性原理研究In 元素对Ga N/Zn O/Ga N 双层异质结的稳定性、电子结构以及光学特性的影响,为设计新型可见光催化剂提供理论依据.
1 计算方法与模型构建
为了得到准确的计算结果,采用了基于密度泛函理论的第一性原理对结构进行了优化,广义梯度近似采用的是Perdew-Burke-Ernzerhof(PBE)泛函,考虑到异质结长程作用力很小,计算过程中采用了DFT-D2 方法[21],采用超软赝势(Ultra-soft pseudo potential,USPP)[22]来描述价电子间的相互作用.自洽场中的结构优化和能量计算选取的Monkhorst-Pack[23]k点网络为5×5×2.考虑到密度泛函理论在计算能带结构时由于库伦屏蔽导致的数据偏小,采用了杂化泛函HSE06[24,25]对能带、电子结构以及光学性质进行计算.结构优化收敛标准为:截断能450 e V,最大Hellmann-Feynman力偏差小于0.01 e V/atom,最大应力偏差低于0.05 Gpa,总能量小于1.0×10-5eV/atom.

以GaN 为基底生长Zn O 薄膜通常沿着密排面(0001)进行,另外通过上面的计算可知在(0001)面上两种不同晶格常数a的错配度只有1.85%左右,因此容易形成异质结.所以Ga N/Zn O/Ga N 双层异质结也是在(0001)密排面上搭建的.纤锌矿结构的GaN 与ZnO 具有类似的结构,都属于六方晶体,在c轴方向上按照…ABABAB…方式排列,因此Ga N 有两个不同的原子面Ga N(A)和Ga N(B),图1(a)、(b)即为Ga N 两个不同的原子面,同理Zn O 也有两个不同的原子面Zn O(A)和Zn O(B),图1(c)、(d)即为Zn O 两个不同的原子面,所以Ga N/Zn O 异质结共有4种不同的结合方式.为了分析不同原子面之间的结合情况,分别计算了原子层面的结合能、层间距以及原子间距.异质结的结合能

图1 GaN 和Zn O 不同的原子面

方 程(1)中:EGaN/ZnO、EGaN、EZnO分别为GaN/Zn O、GaN、ZnO的总能量.
表1给出了原子层面的结合能、层间距以及原子间距.可以看出Ga N(A)/Zn O(A)结合能最小异质结原子层间距最小(d=因此GaN(A)/Zn O(A)结合最稳定.另外比较层内的Ga-N、Zn-O 键可知,键长基本在1.895~1.897,层内原子键变化不是很明显,本文所有的计算都是在GaN(A)/ZnO(A)/GaN(A)模型基础上展开的.

表1 不同原子层面的结合能、层间距以及原子间距
图2 即为Ga N/Zn O/Ga N 双层异质结,两侧为GaN,中间部分为ZnO.为了分析In原子取代不同位置的Ga和Zn的稳定性,分别选取了异质结附近的Ga、Zn原子,即Ga(near1)、Ga(near2)、Zn(near)以及远离异质结的Ga、Zn 原子,即Ga(far1)、Ga(far2)、Zn(far)作为被取代的原子进行建模.为了研究单个异质结的光学性质,阻止临近异质结的相互影响,在(0001)平面上设置了20Å的真空层.

图2 Ga N/Zn O/Ga N 范德瓦尔斯异质结
2 结果与讨论
2.1 优化结果
Yu等[19]发现In掺杂GaN/Zn O 异质结后浓度为6.5wt%时带隙最小;Ganesh 等[20]发现以5wt%的In掺杂In GaN/GaN 多层量子阱结构后能明显增强光电流.查找相图发现纤锌矿结构的GaN 与In能够形成InGa3N4的结构,即In在纤锌矿结构GaN 最高能占到12.5at%,纤锌矿结构的Zn O 与In能够形成In2Zn4O6的结构,即In在纤锌矿结构Zn O 最高能占到16.6at%.考虑到In在Ga N 和Zn O 中的固溶度,超晶胞选取的是2×2结构,对应的In在GaN 和Zn O 中的含量为7at%.为了研究In原子取代Ga、Zn的难易,本文计算了掺杂后的形成能,形成能越小越容易形成.

从表2可以看出,异质结附近的Ga、Zn原子,即Ga(near1)、Ga(near2)、Zn(near)被In取代后的形成能分别为-3.68 e V、-3.72 e V、-4.25 eV,而远离异质结的Ga、Zn原子,即Ga(far1)、Ga(far2)、Zn(far)被In取代后的能量分别为-3.35 e V、-3.42 e V、-4.01 e V.可以看出,在界面处的形成能相对较低,因此更容易形成,这主要是因为界面处的原子层面间距较大,因此掺杂原子在界面处引起的晶格畸变比较小,所以能量较低.另外比较表1中Ga N(A)/Zn O(A)原子层面间距与掺杂后的原子层面间距可知,在界面处掺杂后原子层面间距约为2.4,而未掺杂前约为2.5,减小了约4%,主要是由于掺杂原子与基体原子存在库伦吸引作用,但是由于层面距离较大,因此作用非常有限,而基体内部区域的掺杂对于异质结基本没有影响.由于In更容易在界面处形成,故关于光学和催化性质的计算都是In取代界面处的Ga和Zn原子展开的.

表2 In掺杂GaN/ZnO/GaN 范德瓦尔斯异质结不同点阵位置的形成能、层间距以及原子间距
2.2 态密度
图3是In 掺杂GaN/Zn O/GaN 范德瓦尔斯异质结的态密度图,图中虚线位置为费米能级Ef.图3(a)是纯净的GaN/Zn O/GaN 范德瓦尔斯异质结的态密度图,可以看出价带主要由Ga-4s、Ga-4p、Zn-3d、O-2p、N-2p态组成,导带主要由Ga-4s、Ga-4p、Zn-3p、O-2p、N-2p态组成.
图3(b)是In取代Ga之后的态密度图,可以看出Ga的导带底4p态由3.2 eV向下移动到2.78 eV处,而价带顶几乎没变化,因此带隙宽度由3.03 eV减小到2.88 eV.这主要是由于In的导带部分和Ga的导带电子云存在重叠,根据能带理论可知,电子云重叠产生的重叠积分会导致能带展宽,所以Ga原子的导带向两侧展开,最终压缩带隙减小.
图3(c)是In取代Zn之后的态密度图,可以看出In取代Zn之后Zn的价带顶3d态向上移动到0.13 eV处,而Ga的导带底4p态由3.2 eV 向下移动到2.15 eV处,最终导致带隙宽度减小到2.02 eV.In的价带部分和Zn的价带也有很大区域重叠,导致价带顶向高能级方向移动,减小了带隙宽度.
图3(d)是In同时取代Ga和Zn之后的态密度图,In同时取代Ga和Zn之后Ga的价带顶和导带底已经融合在一起,半导体性质消失.从图3可以看出In取代Ga和Zn都能够减小带隙宽度,而In取代Zn效果更加明显.由于In同时取代Ga和Zn之后异质结带隙消失,不再具有半导体性,因此对于光学性质的计算没有考虑In同时取代Ga和Zn的情况.
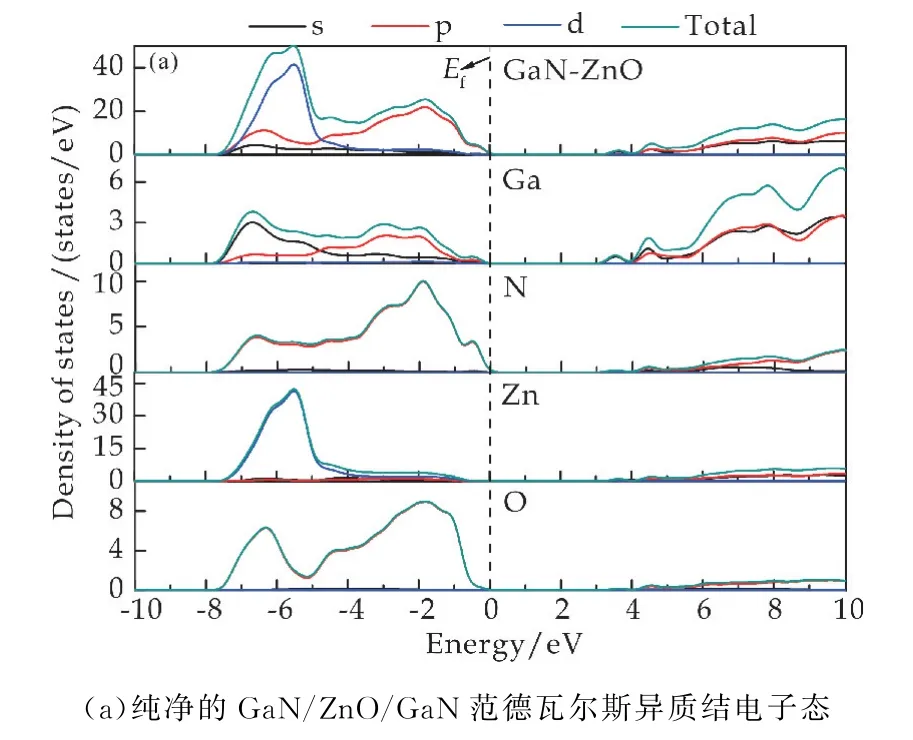
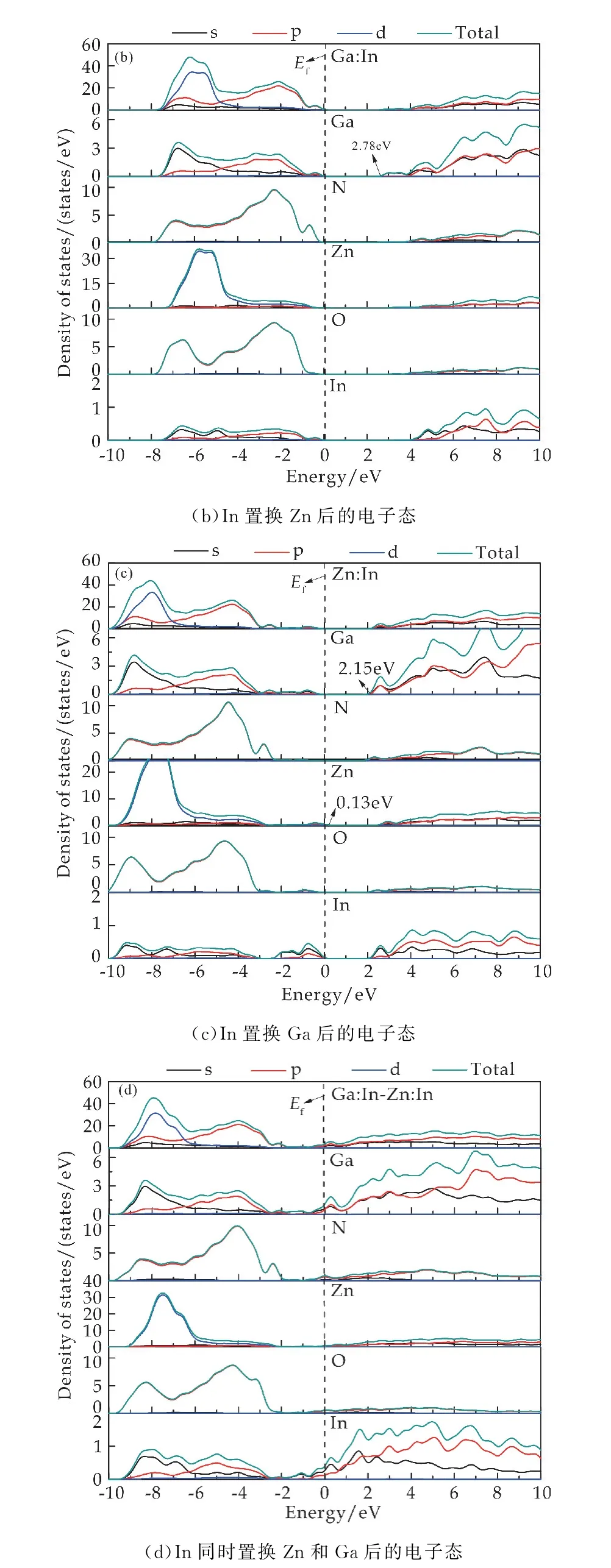
图3 In掺杂Ga N/Zn O/GaN 范德瓦尔斯异质结的电子态(Ef为费米能级)
2.3 吸收系数
在计算光学吸收的过程中应该清楚介电常数方程的含义,介电常数方程包括实部(ε1)和虚部(ε2)两部分,ε1、ε2和价带以及导带的关系由方程(3)、(4)给出[28]

方程(3)、(4)中:ω是圆频率,e是一个电子电量,C是导带,V是价带,BZ为第一布里渊区间.吸收系数I和ε1、ε2的关系可由方程(5)给出[27]

图4 是In 掺杂GaN/Zn O/GaN 范德瓦尔斯异质结的吸收系数.未掺杂的GaN/Zn O/GaN 范德瓦尔斯异质结吸收边基本都大于3 eV,而在可见光区域(1.64~3.19 eV)几乎没有吸收,这主要是由于纯净的GaN/Zn O/GaN 范德瓦尔斯异质结带隙过宽造成的.In取代Ga和取代Zn的吸收光谱向图的左部(低能级方向)移动,也就是产生了红移,但是In取代Zn之后红移的效果更加明显,且在2.1 e V 位置处存在一吸收峰.图4吸收系数的变化规律与图3 中带隙宽度的变化规律一致:In取代Ga和取代Zn后都能够减小带隙宽度且取代Zn后的带隙宽度减小更为明显.

图4 In掺杂GaN/Zn O/GaN 范德瓦尔斯异质结的吸收系数
2.4 复折射率
光在介质中的吸收和传播还可以通过折射率来研究,其中实部(n)与光的折射有关,实部越大则折射率越大,虚部(k)与光的吸收有关,又称为消光系数,虚部越大则吸收越强.折射率和介电常数从不同的角度描述了光的介质中的传播和吸收,两者之间的关系可由方程(6)、(7)得到[29]

图5 是In 掺杂GaN/Zn O/GaN 范德瓦尔斯异质结的折射率,图5(a)是折射率的实部(n),可以看出,在可见光区间,In取代Ga和Zn之后的折射率都要高于纯净的GaN/Zn O/GaN 范德瓦尔斯异质结的折射率,且In取代Zn之后的折射率提高的更加明显.图5(b)是折射率的虚部(k),在可见光区间In掺杂Ga N/Zn O/Ga N 范德瓦尔斯异质结后导致了折射率虚部(k)向低能级方向移动,即产生红移,与吸收系数的变化规律一致,且In取代Zn的效果更明显.
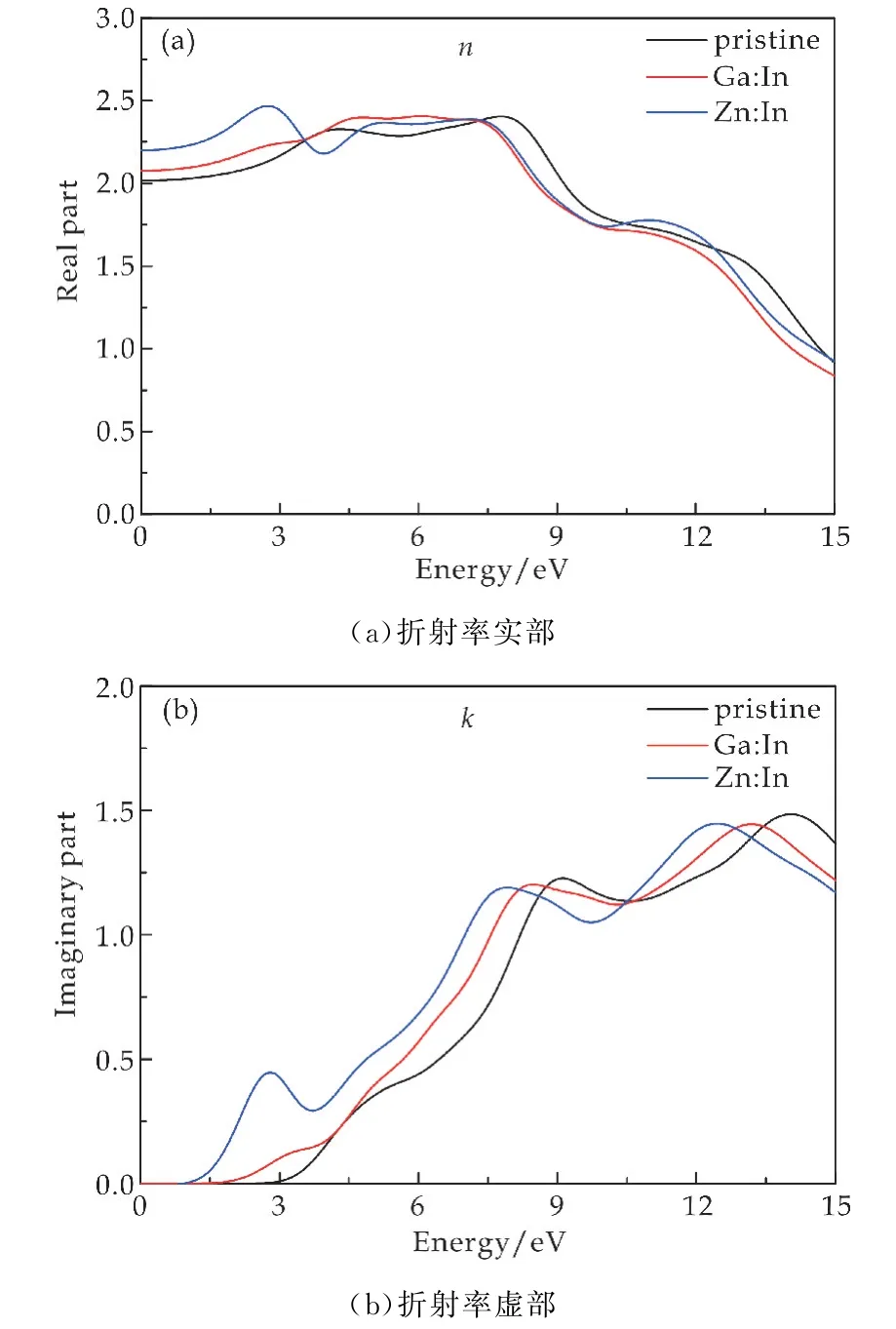
图5 In掺杂GaN/Zn O/Ga N 范德瓦尔斯异质结的折射率
2.5 光电导
半导体材料受到光照后产生的非平衡载流子增大,因此导电性增强.对于掺杂半导体,除了产生本征光电导外,电子还可以从施主激发态跃迁到导带底部,或者空穴从受主激发态跃迁到价带顶部,这是两种形式的杂质光电导.根据半导体理论可知,掺杂半导体的光电导可以由方程(8)得到,其中σ为光电导,n0为电子浓度为电子有效质量,τe为弛豫时间,E为光子能量.从中也可以看出电子浓度n0与光子能量E有关,暨光电导与光子能量有关.


由于图6 是In 掺杂GaN/Zn O/GaN 范德瓦尔斯异质结的光电导,单位为S/cm,计算过程仅考虑了光生载流子的效应,没有计入载流子迁移率等因素.从图中可以看出,在可见光区间光电导与吸收系数非常相似:In取代Ga和Zn之后的光电导发生红移,因此光生载流子浓度增大,有利于吸收可见光,且In置换Zn元素光电导在2.7 e V 附近产生了一个峰值,有利于光生载流子的产生和移动.由于没有计入载流子迁移率等因素,比较图4吸收系数和图6光电导可知:虽然总体变化趋势一致,但是局部存在一定的差别,如In取代Zn后的光电导在2.75 e V 处非常强,但是吸收系数不是很明显.
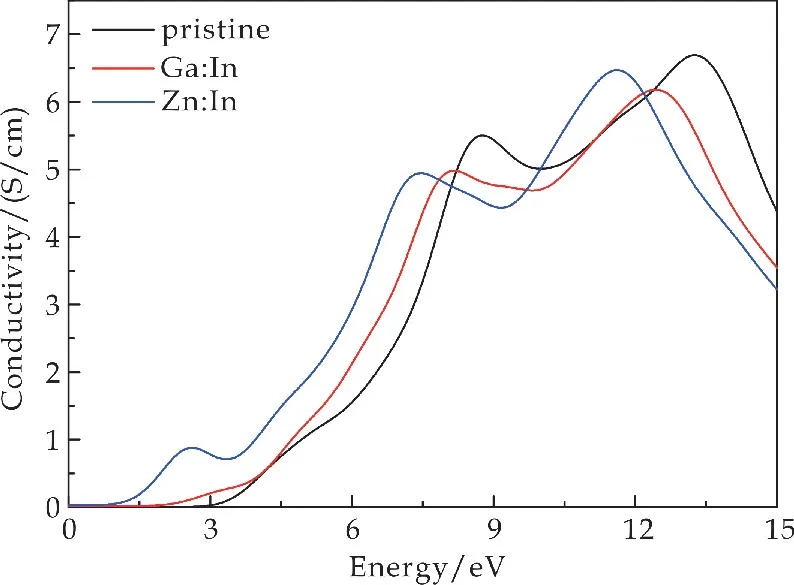
图6 In掺杂GaN/Zn O/GaN 范德瓦尔斯异质结的光电导
2.6 光催化特性
为了研究Ga N/Zn O/Ga N 范德瓦尔斯异质结光催化水解制氢的作用,采用了HSE06计算了异质结的能带排列.Nethercot[30]研究发现半导体存在良好的光催化效果必须满足电化学条件,即:导带边的电势不能高于H+/H2的还原电势 (0 e V),价带边的电势不能低于O2/H2O 的氧化电势(1.23 e V),只有满足这两方面的条件光生载流子才能产生.带边位置可由方程(9)、(10)计算得到.

方程(9)、(10)中:Ee是标准氢电势(Normal Hydrogen Electrode,NHE)约为4.5 e V,X是研究体系的平均电负性,Eg是带隙宽度.
图7 是计算得到的In 掺杂GaN/ZnO/GaN范德瓦尔斯异质结带边位置.纯净的Ga N/Zn O/GaN 范德瓦尔斯异质结、In取代Ga和Zn的导带边位置分别为-0.42 e V、-0.47 e V、-0.58 e V,低于H+/H2的还原电势(0 e V).价带边位置分别2.61 e V、2.41 e V、1.44 e V,价带边位置上移,说明氧化性在减弱,但是仍然大于O2/H2O 的氧化电势.综上所述,In掺杂Ga N/Zn O/Ga N 范德瓦尔斯异质结满足光催化制氢条件.综合图4吸收系数和图7带边位置可以看出,In 掺杂Ga N/Zn O/Ga N范德瓦尔斯异质结后能够提高对可见光的吸收,同时满足催化制氢条件,因此有利于可见光分解水制氢气.

图7 In掺杂Ga N/Zn O/GaN 范德瓦尔斯异质结带边位置
3 结论
采用第一性原理计算了In 掺杂Ga N/Zn O/Ga N 范德瓦尔斯异质结的电子结构和光催化特性,得出以下结论:
(1)In取代异质结界面处的Ga和Zn形成能低,因此容易在界面处偏聚.
(2)In取代Ga、Zn后Ga的4p态向低能级方向移动,Zn的3d态向高能级方向移动,最终带隙宽度减小,尤其是In取代Zn后更为明显.
(3)In取代Ga、Zn后吸收系数和光电导都产生红移,且取代Zn后在2.1 eV 处产生吸收峰,与带隙的变化规律一致.掺杂后在可见光区间的折射率实部增大,虚部产生红移.
(4)计算带边位置可知,In取代Ga、Zn的导带边位置分别为-0.47 e V、-0.58 e V,价带边位置为2.41 e V、1.44 e V,满足光催化制氢的条件.
