中子辐照SiC晶格肿胀及退火回复机理研究
2021-04-07梁晓波高云端黄漫国崔晓红张守超
李 欣, 梁晓波, 高云端, 黄漫国, 崔晓红, 张守超
(1.航空工业北京长城航空测控技术研究所,北京 101111; 2.状态监测特种传感技术航空科技重点实验室,北京 101111;3.天津城建大学 理学院,天津 300384)
由于晶体测温技术具有测温精度高、测温范围广、无源无引线、微型化及可分布测温等特点,对于高速旋转部件、复杂结构件和封闭空间等特殊环境下的测温具有显著优势,特别适用于航空发动机涡轮叶片、高速飞行器热防护层等表面温度测量[1-3]。
晶体测温技术源于晶体辐照肿胀效应,常用基质材料为金刚石和碳化硅(SiC)晶体。中子辐照SiC晶体会产生诸多缺陷,例如空位、间隙原子,以及它们的团簇、位错环,甚至会使晶体发生非晶化。辐照缺陷的活化能谱从几分之一到几个电子伏特,并且连续。缺陷的消除与热处理温度和时间直接相关,不同热处理过程可以消除不同的缺陷。宏观上辐照缺陷的最重要的表现形式之一是晶格肿胀和晶格排列无序度增加,晶体温度传感器正是利用了辐照缺陷引起SiC晶体晶面间距变大及晶面衍射峰半高宽变大(Full Width at Half Maximum,FWHM),经过热处理后,随着缺陷的消除,晶面间距和FWHM逐渐回复到未辐照的数值,建立晶格肿胀回复率和退火温度之间,以及FWHM和退火温度之间对应关系。美国LG Tech-Link公司[4]、国内沈阳发动机研究所[2]、中国航发四川燃气涡轮研究院[3]和天津大学[5]等单位均开展了晶体测温技术研究,开发出Uniform Crystal Temperature Sensor (UCTS)和FWHM Crystal Temperature Sensor等晶体温度传感器。笔者所在单位对晶体温度传感技术及工作原理开展了深入研究,开发的晶体温度传感器平面尺寸为0.2 mm×0.2 mm,测温上限达1450 ℃。本文将重点研究退火温度和退火时间对中子辐照6H-SiC晶格肿胀回复的影响,探讨辐照产生缺陷的构型及退火回复机制,为进一步研究SiC中子辐照效应及提高传感器测温精度提供支撑。
高能粒子辐照可造成晶体内部缺陷,点缺陷是晶体肿胀的直接原因,空位、间隙原子等点缺陷均可破坏晶格点阵的周期性结构,并产生晶格肿胀。一个空位增加约0.5个原子体积的晶格肿胀,一个间隙原子增加约1个原子体积的晶格肿胀[6]。空位和间隙原子是辐照过程中产生的最基础的点缺陷,随着辐照条件的变化,辐照缺陷发生演变,辐照通量越大,产生的点缺陷密度越大,甚至产生位错及产生非晶化现象。辐照晶体一旦产生非晶化现象,高温作用将无法使晶格回复,晶体测温性能将失效。Niu等[7]利用分子动力学方法(Molecular dynamics,MD)模拟计算研究了中子辐照3C-SiC的辐照损伤机制,重点研究了点缺陷团簇聚集到非晶化转变中的驱动机制。研究显示C原子空位大量产生及2配位Si原子随辐照通量的增加迅速增多并连接是SiC晶体非晶化产生的主要原因。在1.0 MeV中子辐照下3C-SiC晶体非晶化通量为0.27 dpa。Yano等[8]研究发现在中子能量E>0.1 MeV、辐照温度为423 K的辐照条件下,当辐照通量大于2×1026n/m2时,点缺陷开始聚集形成缺陷团簇,在晶体内部出现位错、位错环等线缺陷或面缺陷;当辐照通量达到1.9×1027n/m2时,缺陷团簇均匀分布在晶体内部,晶体产生非晶化,此实验结果与Niu的理论模拟吻合。
综上,辐照缺陷对SiC晶格肿胀的作用机制及高温退火回复机理尚未完全揭示,包括辐照温度、辐照通量、退火温度及退火时长等物理因素对缺陷产生、演化甚至回复的影响及其作用机制有待进一步研究。本文从缺陷迁移能角度,计算并分析了辐照缺陷产生的类型及缺陷高温演化规律,对进一步提高晶体温度传感精度提供理论及实验支撑。
1 实验及结果讨论
实验用晶片为掺氮6H-SiC晶片(简称SiC,下同),购于北京天科合达半导体股份有限公司,掺氮浓度约为1019n/cm3,电阻率小于0.1 Ω·cm。根据实验需求将晶体分割为平面尺寸为0.2 mm×0.2 mm的晶粒和0.5 mm×0.5 mm的晶片。利用X射线衍射仪(Cu Kα线,λ=0.154056 nm,40 kV,100 mA)在扫描角度2θ为10°~80°的范围内测试0.5 mm×0.5 mm晶片的X射线衍射图(XRD)。采用单晶X射线衍射仪(Mo Kα线,λ=0.071359 nm,50 kV,20 mA)测试了晶体结构和晶胞参数。FWHM测试在常温下进行,晶胞参数测试在低温80 K环境下进行。
1.1 SiC中子辐照实验
6H-SiC具有纤锌矿晶体结构,属于P63mc空间群,晶格结构如图1所示。实验测得6H-SiC晶体晶胞参数为a=b=3.0807 Å(1Å=10-10m),c=15.1219 Å;α=β=90°,γ=120°;晶胞体积V=124.2930 Å3。在中国核动力研究院进行了全能谱中子辐照,快中子约占80%,辐照温度范围为150~200 ℃。中子辐照累计辐照通量分别为5.74×1022n/m2、1.72×1023n/m2和2.85×1024n/m2。图2(a)为利用单晶X射线衍射获取的SiC晶胞体积随辐照通量的变化,辐照通量越大,晶格膨胀越大。经2.85×1024n/m2通量中子辐照,SiC晶胞参数变为a=b=3.0939 Å,c=15.1848 Å;α=β=90°,γ=120°;晶胞体积V=125.8840 Å3。相比辐照前,a和c分别增大了0.428%和0.416%,增大幅度接近。晶胞体积V肿胀显著,较辐照前增大1.28%。辐照缺陷诱发晶格肿胀,单晶X射线衍射测试结果显示SiC晶体结构完整,依然保持六方晶系单晶体结构。图2(b)为辐照前后SiC(006)晶面X射线衍射峰图谱。辐照使得(006)晶面衍射峰中心位置向小角度平移,衍射峰强度降低,FWHM由12.2′增大至14.3′,这与Ruan[5]、Yano[8]等报道的中子辐照6H-SiC和3C-SiC现象一致。由Bragg衍射公式2dsinθ=kλ可知,衍射角变小,晶面间距增大。辐照缺陷的产生是造成晶面间距增加的主要因素,空位与间隙原子均可造成晶胞体积膨胀,一个空位增加约0.5个原子体积的晶格肿胀,一个间隙原子增加约1个原子体积的晶格肿胀[6]。2.85×1024n/m2中子辐照通量下,(006)晶面衍射峰清晰可辩,衍射峰未出现非晶化特征,这与单晶X衍射测试结果一致。辐照缺陷是晶格肿胀的直接原因,但缺陷类型和产生机理需进一步分析。

图1 6H-SiC晶体的晶格结构
1.2 辐照晶体高温退火实验
为研究退火对缺陷复合及缺陷复合对晶格回复的影响,对辐照通量为2.85×1024n/m2的6H-SiC晶体进行了退火处理,退火范围从室温起至1600 ℃,退火时长275 min。为降低退火过程升、降温时长对晶体缺陷回复的影响,利用自行开发的急速升降温装置对所有样品进行退火处理,退火升温和降温时长均控制在2 min以内。
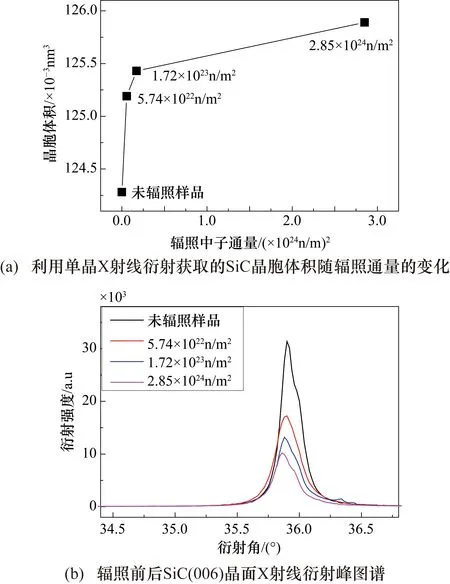
图2 不同中子辐照通量下6H-SiC晶体晶胞体积变化及X射线衍射图谱与(006)晶面衍射峰变化
利用单晶X射线衍射仪测试了不同退火温度晶体晶胞参数,测试结果如图3所示。a、c及V变化趋势具有一致性,本文以晶胞体积V作为分析对象,对晶胞参数变化过程进行分析。实验样品的辐照温度范围为150~200 ℃,研究表明,当退火温度高于辐照温度,辐照引起的晶格膨胀开始回复[9]。晶胞体积随退火温度变化趋势与Ruan等[5]报导的FWHM高温退火变化趋势相似,即晶胞体积V随退火温度的变化趋势呈现反S形曲线,室温至200 ℃区间V值基本无变化;200~1450 ℃区间V值随退火温度升高减小至辐照前水平;1450~1700 ℃退火区间,V值稳定,不再变化。
中子辐照SiC将产生大量缺陷,随着辐照通量的增加,缺陷密度增加,缺陷造成晶胞体积肿胀。中子通量低于1.5×1026n/m2,辐照缺陷以间隙原子、空位及Frenkel缺陷为主。随着辐照通量持续增加,位错、位错环、空洞等线缺陷和体缺陷开始出现并逐渐增多,原子排列有序度逐渐降低,晶格完整性遭到破坏,甚至出现非晶化现象。3C-SiC晶体非晶化的辐照通量为1.7×1027n/m2[8],此实验结果与Niu[7]、Gao[10-11]等通过MD计算模拟方法的结论一致。本研究中最大中子通量为2.85×1024n/m2,较位错等线缺陷产生的辐照通量1.5×1026n/m2低2个数量级,由此推断样品中主要的缺陷为点缺陷,单晶衍射和(006)晶面X射线衍射峰清晰可辩也证实了晶体晶格结构的完整性。由此推断晶胞体积高温退火回复过程主要源于点缺陷复合,点缺陷复合过程有待进一步分析。
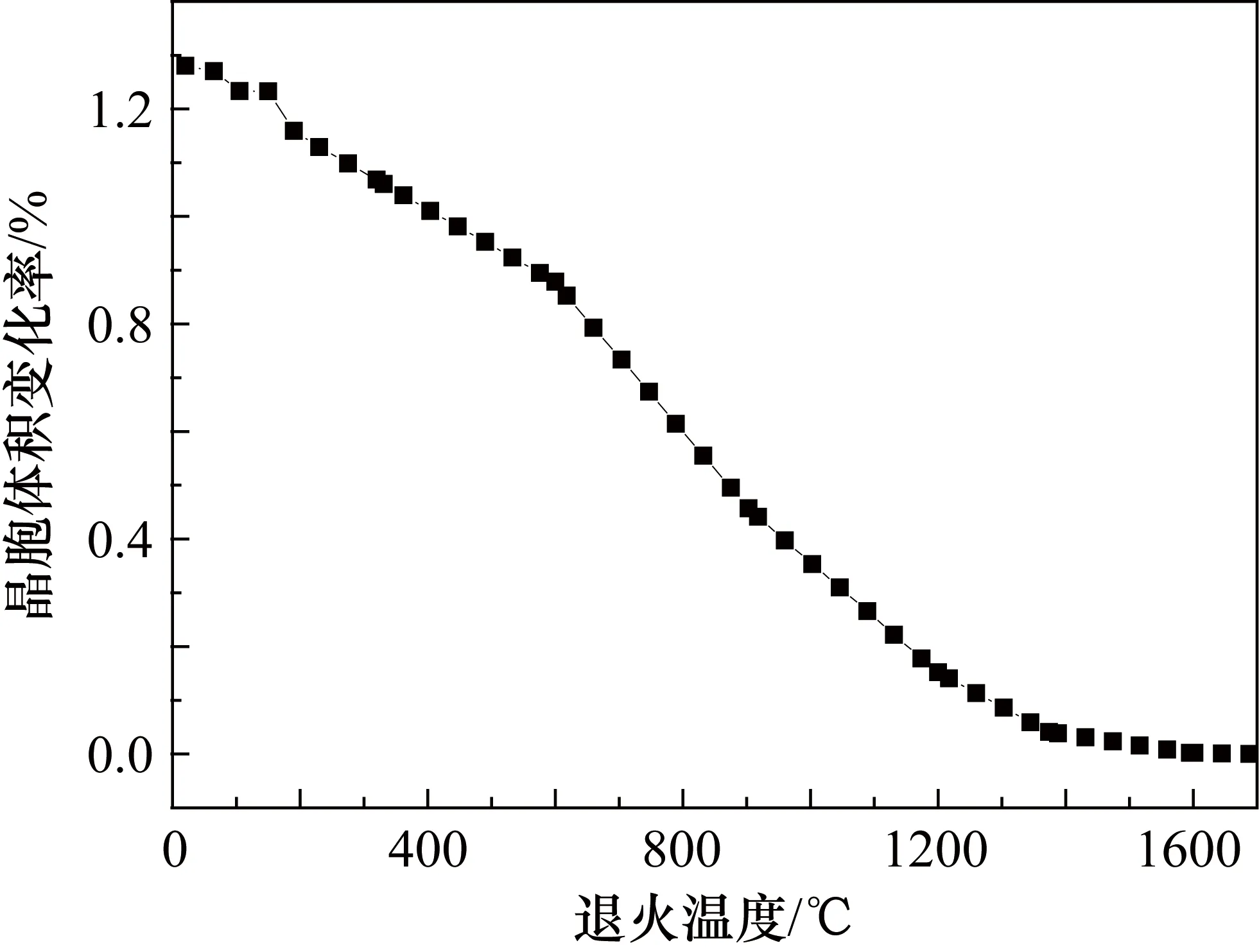
图3 中子辐照6H-SiC晶体晶胞体积参数随退火温度变化关系
1.3 等温退火实验及缺陷迁移能计算
高温退火可有效消除辐照产生的点缺陷,点缺陷复合使得肿胀晶格逐渐回复到辐照前水平。为研究退火温度、退火时长等对缺陷迁移、复合的影响,本文对辐照SiC晶体展开了等温退火实验。晶格回复可用晶体宏观尺寸随高温退火变化进行标识,亦可用晶面间距变化进行表征。本文采用晶胞体积V的变化表征晶格肿胀的回复,V值通过单晶X射线方法多次测量取均值获得。
由间隙原子、空位以及Frenkel缺陷等点缺陷复合造成晶体体积随时间的变化符合式(1)所示的一级反应方程,即晶胞体积取自然对数后的差值与退火时长呈直线关系,直线斜率k为缺陷迁移概率;点缺陷的迁移和扩散受缺陷迁移能和温度的影响,符合Arrhenius方程(式(2))[12]。
lnV-lnV0=-kt
(1)
(2)
式中,V为辐照晶体高温退火晶胞体积;V0=124.2930 Å3,为未辐照晶体的晶胞体积;k为点缺陷迁移概率;t为高温退火时长;Ea为缺陷迁移能;kB为玻尔兹曼常量;C为与迁移熵相关的常量;T为热力学温度。
为研究缺陷迁移能分布及高温复合,采用等温退火方法对SiC在200~1450 ℃进行了退火处理,退火温度间隔100 ℃,退火时长范围5~275 min,退火时长间隔为5 min。为降低退火升温、降温时长影响,退火采用了专项研发的快速升降温装置,升温和降温时长均控制在2 min以内。为降低机械分割应力对晶胞参数及力学性能的影响,退火前辐照晶体被分割成为0.2 mm×0.2 mm×0.38 mm的微型晶粒。利用单晶X射线衍射多次测量取均值获得晶体的晶胞参数,单晶X射线测试在液氮低温条件下进行。
实验选取了400 ℃、900 ℃和1300 ℃等温退火后的样品,将晶胞体积按一级反应方程(1),利用最小二乘法对等温退火曲线进行线拟合。退火后的晶胞体积变化Δ=(lnV-lnV0)与退火时长t的对应关系如图4所示。400 ℃等温退火的Δ-t基本呈直线分布;和400 ℃等温退火不同,900 ℃和1300 ℃等温退火Δ-t曲线分别经历了两个变化时段,即t=0时刻起分别至t=20 min和t=25 min,Δ-t呈直线分布,直线斜率较大,代表晶胞体积收缩迅速;此后Δ-t曲线呈现直线性分布,直线斜率较前一时段有所减小,此阶段晶胞体积随退火时长持续收缩,但收缩速度较第一阶段有所降低。利用最小二乘法对400 ℃、900 ℃和1300 ℃等温退火所有数据点进行了线性拟合,拟合结果如图4中红线所示,拟合直线的相关系数R2分别为0.98、0.97和0.96。由一级反应方程(1)可知,拟合直线斜率k即为固定温度下点缺陷迁移概率,其中400 ℃等温退火k值最小,1300 ℃等温退火k值最大,这表明与时效的影响相比,温度对缺陷复合的影响更大、更显著。
实验完成了200~1450 ℃范围内间隔100 ℃温度点的等温退火处理,获得不同退火温度下Δ-t曲线,利用最小二乘法对获取曲线进行线性拟合,所有拟合曲线的相关系数R2均高于0.95。依据公式(2),按lnk值随温度分布,获取了Arrhenius方程曲线曲线,如图5所示。图5显示了缺陷迁移几率k值随退火温度变化的情况。k值随退火温度升高而增大,在600 ℃和1200 ℃处出现两次快速增长,1200 ℃处的增加更为迅速。以600 ℃和1200 ℃为界点,k值随退火温度变化分可为3个温度区间:200~500 ℃、600~1100 ℃和1200~1400 ℃。每个区间内k值随退火温度基本呈线性分布,但直线斜率不同,200~500 ℃区间斜率最小,1200~1400 ℃区间斜率最大。利用最小二乘法,对3个区间内的数值分别进行线拟合,利用Arrhenius方程计算获得晶胞体积回复过程中点缺陷的迁移能,其中200~500 ℃范围的点缺陷迁移能为0.16 eV;600~1100 ℃范围的点缺陷的迁移能为0.24 eV;1200~1400 ℃范围的点缺陷的迁移能为1.15 eV。
1.4 结果分析
高能粒子辐照SiC晶体产生的点缺陷是最基本缺陷。受辐照温度、粒子能量和辐照通量等物理因素影响,点缺陷可演化成为位错、空洞、间隙原子团簇等高等级缺陷,甚至出现非晶化现象,这将严重影响SiC的物理性能和晶体结构。Niu计算模拟了快中子(E>1.0 MeV)辐照3C-SiC非晶化的辐照通量0.27 dpa[7],这与Yano的实验结果吻合[8]。辐照通量在晶体非晶化过程中起关键作用,通过控制辐照通量,可避免SiC晶体非晶化发生,甚至产生辐照缺陷以点缺陷为主。本研究最大中子辐照通量为2.85×1024n/m2(其中快中子约占80%),较产生晶界、位错等线缺陷的通量值1.5×1026n/m2低2个数量级,由此判定辐照缺陷以点缺陷为主。(006)晶面衍射峰形和单晶X射线衍射测试结果说明了晶体结构的完整性。
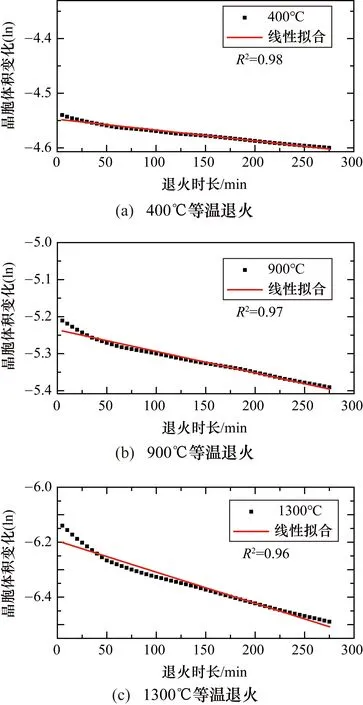
图4 400 ℃、900 ℃和1300 ℃等温退火6H-SiC晶胞体积(Δ=(lnV~lnV0))随退火温度变化及线性拟合图谱
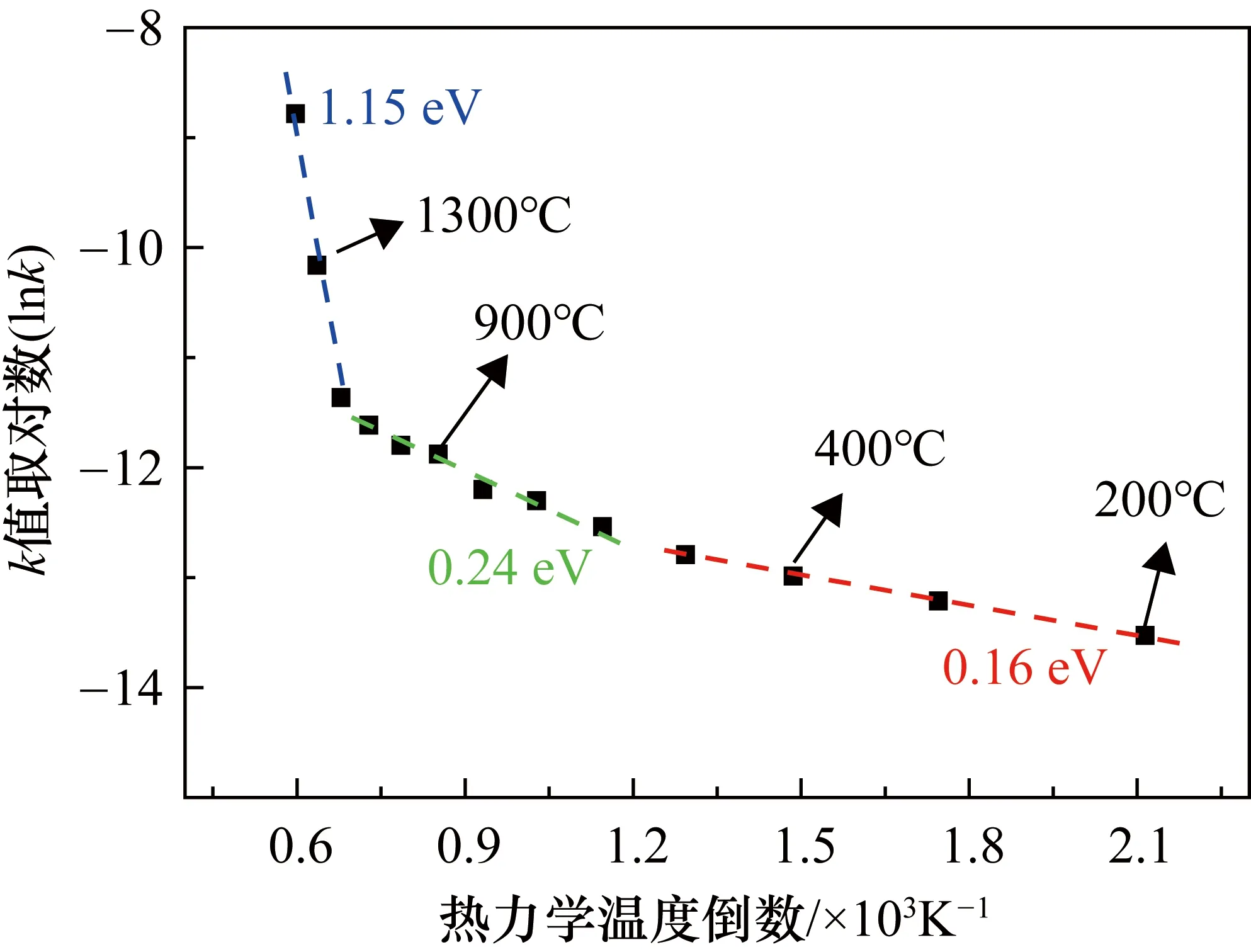
图5 6H-SiC晶胞体积回复速率随退火温度变化的Arrhenius曲线图
退火过程中点缺陷复合以Frenkel缺陷为主,空位及间隙原子复合亦有参与,缺陷复合过程对晶格肿胀的影响符合式(1)。C原子或Si原子被高能粒子轰击出晶格,形成的间隙原子可能停留在次近临原子壳层内,也可能停留在更远晶格位置。Frenkel缺陷间距影响缺陷迁移能,Son等[13-14]通过低温电子束辐照3C-SiC发现较远的Frenkel对稳定性比间距较近的Frenkel对大很多;Jiang等[15]对纳晶3C-SiC进行了重离子辐照非晶化实验研究,发现辐照退火过程中只有间距小于2a0(a0为3C-SiC的晶格常数,下同)的Frenkel对才会发生复合。立方结构(3C)与六方结构(4H、6H)SiC空间结构致密,两种结构中C原子的离位阈能较Si原子低,高能粒子辐照更容易将C原子撞击出格位,形成C原子Frenkel缺陷。Gao等[10-11]利用分子动力学理论计算分析了3C-SiC中Frenkel缺陷复合迁移能,计算显示Frenkel缺陷的空位和间隙原子之间的距离d值对缺陷迁移能大小影响显著。由于d值不连续,C原子Frenkel缺陷迁移能在0.14~1.60 eV取分立值,其中Si原子Frenkel缺陷迁移能分布在0.28~1.05 eV;C原子和Si原子的间隙原子的迁移能分别为0.74 eV和1.53 eV,而单纯C空位和Si空位缺陷的迁移能分别为4.10 eV和2.35 eV。Yano等[16]利用等温退火方法,通过测量辐照样品退火前后宏观尺寸的变化,实验研究了中、低通量(1023~1024n/m2量级)中子辐照3C-SiC和6H-SiC在200~1300 ℃退火过程中缺陷迁移能分布情况,实验结果基本与Weber计算结果吻合。
利用上述文献的研究结果,结合本文的实验内容,对中子辐照SiC晶体高温退火过程的缺陷复合和晶胞体积回复机理做如下分析。
辐照通量为2.85×1024n/m2(其中快中子约占80%),中子辐照SiC晶体产生的主要缺陷为点缺陷,高温退火使得点缺陷复合,晶胞体积逐步收缩至辐照前水平。实验采用等温退火方法,对辐照晶体进行间隔为100 ℃等温退火处理。根据一级反应方程(式(1))和Arrhenius方程(式(2)),计算了缺陷迁移能随温度的分布。

2 结束语
对6H-SiC晶体实施了中子辐照,对辐照通量为2.85×1024n/m2的SiC晶体开展高温退火研究,并得到以下主要结论。
① 中子辐照使得晶胞体积产生了1.28%的肿胀。从200 ℃开始,晶胞参数随退火温度升高而逐渐回复,1450 ℃退火275 min,晶胞参数回复至辐照前水平。
② 对晶体开展的等温退火实验,实验结果显示晶胞体积回复符合一级反应方程(式(1)),辐照缺陷主要为点缺陷。
③ 利用Arrhenius计算了不同温区间的缺陷迁移能分布:200~500 ℃范围的点缺陷迁移能为0.16 eV;600~1100 ℃范围的点缺陷的迁移能为0.24 eV;1200~1400 ℃范围的点缺陷的迁移能为1.15 eV。依据实验推测200~500 ℃温度区间主要是C的Frenkel缺陷复合;600~1100 ℃温度区间主要是Si的Frenkel缺陷复合;更高温度区间200~1400 ℃则对应C、Si间隙原子复合。
上述实验结论是由温度间隔为100 ℃的等温退火试验所得到的,Arrhenius方程曲线实验数据有限,温度间隔更为密集的等温退火尚未完全开展,缺陷迁移能随退火温度分布的数据及缺陷高温复合过程有待进一步细化分析。上述实验结论对SiC晶体温度传感器的工作原理进行了初步展示,对全面掌握晶体测温技术,提高测温精度具有一定的指导意义。
