一种具有低寿命区的阳极短路4H-SiC IGBT仿真研究
2021-01-07毛鸿凯苏芳文隋金池
毛鸿凯,苏芳文,林 茂,张 飞,隋金池
(杭州电子科技大学 电子信息学院,浙江 杭州 310018)
硅(Si)基器件的发展已达到了材料的极限,无法满足电力电子系统越来越多的要求。以SiC、GaN为代表的第三代宽禁带半导体材料逐渐取代Si材料进入了研究人员的视线中。SiC材料禁带宽度大,饱和电子漂移速度高,热导率高以及击穿电场强度大,被广泛应用在高温、高压及抗辐射等领域中[1-5]。
近几年,很多研究者都将研究焦点转移到了对器件的导通压降和击穿电压进行折中,而对于器件关断损耗的研究则相对较少[6-8]。目前主流的解决方法有3种:(1)合理设置器件的尺寸和参数,例如N+缓冲层的厚度及掺杂浓度;(2)设计具有特殊作用的新型IGBT器件,例如在器件内部引入载流子增强层、异质结以及透明阳极等[9-10];(3)尽可能开发出新型的器件制造工艺,例如在NO气氛中生长栅氧化层等。
为了在不影响器件其他特性的前提下进一步降低器件的关断损耗,文中提出了一种在P基区中引入低寿命区同时集电极做成阶梯型的LS-IGBT,通过控制注入到N-漂移区中的载流子数量来改善器件的电学特性。利用半导体器件仿真工具Silvaco Atlas对LS-IGBT进行电学特性的模拟仿真,然后分析器件的击穿电压、导通压降及关断损耗相对于传统结构发生的变化。最终在维持击穿电压不变及不牺牲正向特性的前提下,获得关断损耗大幅减小的LS-IGBT结构。
1 器件结构及参数
1.1 器件结构
图1分别是传统沟槽结构(C-IGBT)和文中所提含低寿命区及阶梯型集电极结构(LS-IGBT)的半元胞二维横截面示意图。从图中可以看出,所提结构相对于传统结构改变的只是P基区中引入了低寿命区,并且集电极电极做成了阶梯形状,除此之外,两个器件的其余部分参数完全一致,相关结构参数及掺杂参数如表1所示[11-12]。栅极侧墙和底部氧化层的厚度分别为50 nm和100 nm。N-漂移区中的载流子寿命为1 μs,N+缓冲层中的载流子寿命为0.1 μs。新结构中低寿命区域载流子寿命为1×10-10s,宽度为1.1 μm,P+集电区宽度为0.4 μm。

(a)

(b)图1 器件横截面示意图(a)C-IGBT (b)LS-IGBTFigure 1. Schematic cross-sections of the device(a) C-IGBT(b) LS-IGBT

表1 器件结构参数Table 1. Device structural parameters
由于此前没有进行过此结构的流片及相关测试工作,所以为了说明本文提出结构的实验可行性,下面给出了实现该结构的主要工艺步骤。具体工艺流程如下:(1)在N+衬底上依次生长N+缓冲层、N-漂移区、CSL电流扩展层、P-基区;(2)使用中子辐射形成低寿命区,同时进行干法刻蚀形成栅极沟槽区域[13-14];接着使用高能离子注入形成P+源区、N+源区以及P+屏蔽层[15];(3)在干氧气氛下生长栅极氧化层,并填充掺杂的多晶硅以形成栅电极;(4)将器件翻转,移除N+衬底,使用高能离子注入依次形成P+集电区和N+缓冲层;(5)使用金属进行填充,依次形成发射极和集电极[16]。
因为SiC材料硬度比较大,因此刻蚀难度较高,故可以使用SiO2作为掩膜,并利用含有SF6的感应耦合等离子体(ICP)刻蚀方法进行刻蚀。具体的刻蚀方案可以使用SF6/O2/Ar气体的组合,其流量分别是4.2/8.4/28 sccm;压强和温度分别为0.4 Pa和80 ℃;ICP功率选取500 W,偏压功率固定为15 W。在ICP刻蚀的过程中要时刻注意微型沟槽的形成,它可以引起电场集中效应,进而降低器件的击穿电压。刻蚀结束后沟槽表面难免会显得比较粗糙,可通过后续的高温退火过程加以改善。
1.2 工作原理
LS-IGBT器件主要用于在基本不影响击穿特性及导通特性的前提下进一步降低关断功率损耗。其主要原理是当栅极电压大于阈值电压,且集电极施加一定的正电压时,N+源区中的电子就会经由反型沟道注入到N-漂移区,同时集电区也会有空穴注入到漂移区,器件和传统结构处于导通模式。与传统结构不同的是,其集电区面积比较小,所以在同一个集电极偏置电压下,集电区注入的空穴数量就会少于传统结构。但是由于其在P-基区中引入了低寿命区,所以注入的空穴只有很小的一部分会经由P-基区而到达P+源区,最终经过两者的综合作用,就会使得器件在不影响正向导通特性的前提下拥有良好的关断特性。
2 电学特性仿真与分析
本次模拟仿真使用Silvaco Atlas仿真软件,数据分析使用Origin数据处理软件。在仿真中物理模型及相关参数的选取均是基于前人的研究。经过仿真的器件已经经过了流片验证[17-18],这些模型及参数被广泛用于仿真其他类型的4H-SiC IGBT。仿真中所使用的模型参数列于表2。仿真中主要使用的物理模型包括能带变窄模型(BGN)、平行电场依赖性模型(FLDMOB)、费米模型(Fermi Model)、浓度依赖性迁移率模型(CONMOB)和复合模型(Schockley-Read-Hall、AUGER)等[19]。

表2 仿真模型参数Table 2. Simulation model parameters
2.1 击穿特性
当器件的栅极和源极接地,集电极施加正向偏压时,其工作于正向阻断模式。当集电极电压达到15 kV时,器件刚好达到它的雪崩击穿电压。击穿时器件内部的二维电场分布如图2所示。从图中可以看出,击穿时传统结构和所提结构的最大电场都出现在沟槽下方的屏蔽层拐角处,并且最大电场分别为2.96 MV·cm-1和3.03 MV·cm-1。因为4H-SiC材料的临界击穿电场是3 MV·cm-1,所以在此处依据器件内部最大电场强度是否达到3 MV·cm-1来判断器件是否发生了雪崩击穿。

(a)
2.2 正向特性
图3所示是传统结构和所提结构的正向通态特性对比图。从图中可以看出,在集电极电流密度为100 A·cm-2时,C-IGBT和LS-IGBT的导通压降分别为10.88 V和9.98 V,新结构的通态压降相比于传统结构降低了8.3%。所提结构虽然集电区的空穴注入面积相对较小,但是其内部由于引入了低寿命区,这就使得绝大部分注入到N-漂移区中的空穴都参与了电导调制效应,提升了空穴载流子的利用率,改进结构的正向特性不但没有损失还有所提高。

图3 C-IGBT和LS-IGBT的正向I-V特性曲线图Figure 3. Forward I-V characteristic curves of C-IGBT and LS-IGBT
图4所示是器件正常导通时,位于X=1.45 μm处整个N-漂移区中的空穴浓度分布。从图中可以明显的看出,新结构在集电极一侧的空穴注入浓度小于传统结构。结合图3所示器件拥有优异的正向特性,这些结果证明了低寿命区在器件导通过程中所发挥的重要作用。

图4 整个漂移区中的空穴浓度分布 Figure 4. Hole concentration distribution in the entire drift region
2.3 关断特性
IGBT是基于电导调制效应工作的双极型器件,其正常导通时在N-漂移区中存储了大量的少数载流子,这就使得原来掺杂浓度较低、电阻较大的N-漂移区的通态电阻变的特别小,实现了较小的通态损耗。但是这对于器件的关断过程来说是非常不利的,存储在漂移区中的少数载流子泄放需要一定的时间,会形成较大的拖尾电流,进而产生不可忽略的关断功率损耗。
因为日常生活中开关器件的应用电路通常比较复杂,所以根据其应用范围抽象出简单的关断特性测试电路,测试电路如图5所示。其中母线电压Vbus设置为击穿电压的60%(9 000 V),栅极电阻的阻值为10 Ω,电流源的电流值为2.1×10-6A。同时选用频率为5 kHz,占空比为50%且电压变化范围从-5 V到20 V的电压源来控制器件的导通和关断。电路中的二极管D可以视为理想元件,器件横截面面积为0.021 cm2主要是为了使通过器件横截面的电流密度为100 A·cm-2。

图5 关断特性测试电路图Figure 5. Turn-off characteristic test circuit diagram
图6所示是传统结构和所提结构的关断特性曲线图。从图中可以很明显的看出,无论是关断时电压的上升速度还是电流的下降速度,新结构都有明显的优势。经过数据分析可以得出,传统结构和所提结构的关断损耗分别为7.77 mJ和1.2 mJ,新结构的关断损耗提升了84.5%。
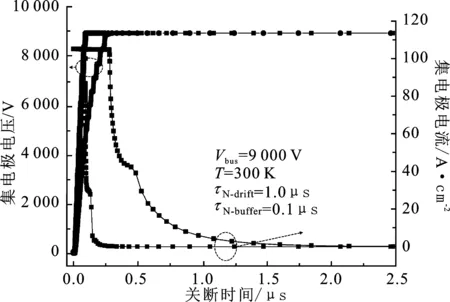
图6 C-IGBT和LS-IGBT的关断特性曲线Figure 6. Turn-off characteristic curves of C-IGBT and LS-IGBT
3 结束语
针对现有4H-SiC IGBT存在导通压降和关断损耗难以折中的问题,本文提出了含有低寿命区及阶梯型集电极的LS-IGBT结构。在基本不影响器件其他电学特性的前提下,进一步降低了器件的关断损耗。当器件处于正向导通工作模式时,其集电极一侧虽然相对于传统结构注入的空穴数量较少,但是因为其P-基区中存在低寿命区,就使得注入到N-漂移区中的空穴有很少的一部分可以通过P-基区到达P+源区,从而可实现较低的通态压降及关断损耗。本文通过使用半导体器件仿真工具Silvaco Atlas对改进结构和传统对照结构进行相关电学特性的对比仿真分析进一步验证了设计思想。仿真结果显示,在传统结构和改进结构击穿电压一致的前提下,改进结构的关断损耗和导通压降相对于传统结构分别提升了84.5%和8.3%。
