沟槽式FS?IGBT各部分对其性能的影响研究
2018-07-27张满红邹其峰
张满红 邹其峰
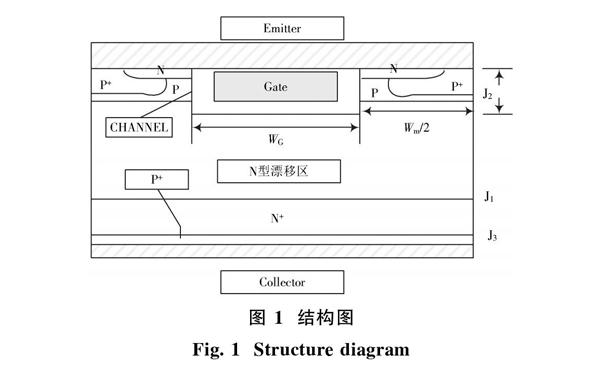
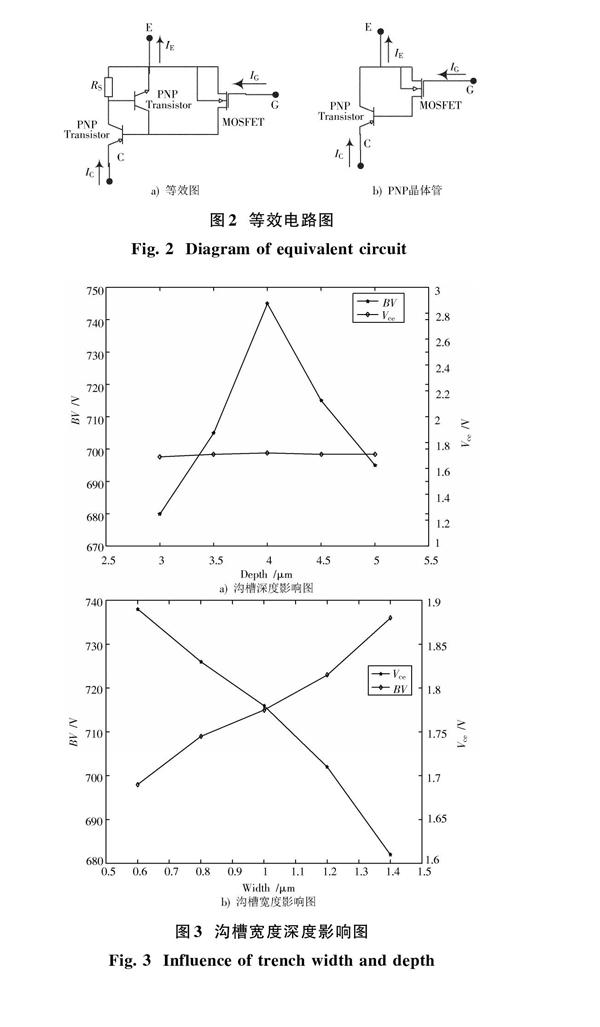

摘 要: 沟槽式FS?IGBT是当前IGBT中最为先进的结构,它结合PT?IGBT和NPT?IGBT各自的优点,具有较薄的N?区以及FS场截止层,能够使导通压降更低并且可以有效减少关断时间和关断损耗。主要通过仿真软件Sentaurus TCAD对FS?IGBT进行工艺与电学特性仿真,通过改变不同部分的参数,如栅极的长宽,N型漂移区的厚度,P?base区的注入剂量及能量等,研究对其性能的影响。结果表明栅极的长宽和漂移区厚度的增加会使BV变大,场截止层电阻率的增加会使导通电压变小,阈值电压会随着P?base区的注入剂量及能量的变大而变大。通过仿真结果得到了结构参数对器件性能的影响,为FS?IGBT的设计提供参考。
关键词: FS?IGBT; Sentaurus TCAD; 结构仿真; 电学特性; 性能影响; 导通电压
中图分类号: TN386?34 文献标识码: A 文章编号: 1004?373X(2018)14?0005?05
Research on influence of trench FS?IGBT′s each part on its performance
ZHANG Manhong, ZOU Qifeng
(Institute of Modern Electronic Science, North China Electric Power University, Beijing 102206, China)
Abstract: The trench FS?IGBT is currently the most advanced IGBT structure, which combines the advantages of PT?IGBT and NPT?IGBT, possesses a thin N?region and FS layer, can make the conductive voltage drop lower, and effectively decrease the turn?off time and turn?off loss. The technique and electrical feature of FS?IGBT is simulated by using the simulation software Sentaurus TCAD, during which the influence on FS?IGBT′s performance is researched by changing the parameters of different parts, such as grid length and width, thickness of N?type drift region, and injected dose and energy of P?base region. The results show that the BV becomes larger as the width and length of the grid, and the thickness of the drift region increase, the conductive voltage becomes lower as the resistivity of FS layer increases, and the threshold voltage becomes higher with the increase of the injected dose and energy of P?base region. The influence of structure parameters on device performance is obtained from the simulation results, which provides a reference for the design of FS?IGBT.
Keywords: FS?IGBT; Sentaurus TCAD; structure simulation; electrical feature; performance influence; conductive voltage
0 引 言
近年来世界能源消耗加剧以及电力需求的不断增加,大力开发新型电力电子器件已经变成了一项非常重要的任务。随着科技的不断进步,所有的电力电子器件都有了飞速的发展,而在这些电力电子器件中发展速度最快的无疑是IGBT。就现在的电力电子器件来看,IGBT是当前乃至将来小型化、低噪声、智能化、高性能电力电子装置的首选器件[1?2]。IGBT设计之初就是为了兼有MOS管和双极型晶体管的优点,所以它在结构上主要由两部分组成,一个是输入极的MOS部分,另一个是输出极的BJT部分。这样IGBT既能够在小驱动条件下快速开关,又具有较低的饱和压降。由于IGBT在大电流、高速、高压等方面性能优越,成为了最为理想的开关器件[3]。而在IGBT中,兼有Trench结构和FS结构优点的Trench?FS IGBT已经变成了主流,同时也是如今IGBT领域研究的新热点所在[4]。Trench?FS型IGBT将以往IGBT的优势技术相结合,具有比较低的导通损耗、较强的抗闩锁能力和极好的短路能力[5]。现在,国内的场截止IGBT结构还是以平面结构为主流,那些沟槽式的场截止IGBT大多是外国公司的产品。对于将沟槽式技术应用于场截止IGBT的方法还处于探索阶段。因此,本文借助仿真软件Sentaurus TCAD对Trench FS?IGBT的影响进行仿真研究,以期为沟槽式FS?IGBT的设计提供参考。
1 Trench FS?IGBT的结构
N沟道沟槽型FS?IGBT的结构图如图1所示,Trench?FS IGBT器件是三端器件,三个端分别是:栅电极(Gate)、集电极(Collector)以及发射极(Emitter)。本文主要研究P?base区、漂移区、FS层等结构参数对器件性能的影响。沟槽通常是采用反应离子刻蚀技术(RIE)在硅片刻出,再用多晶硅回填沟槽,形成栅电极[6]。为了在沟槽侧形成沟道,并且使其可以延伸到N漂移区,栅的深度要大于P?base的结深。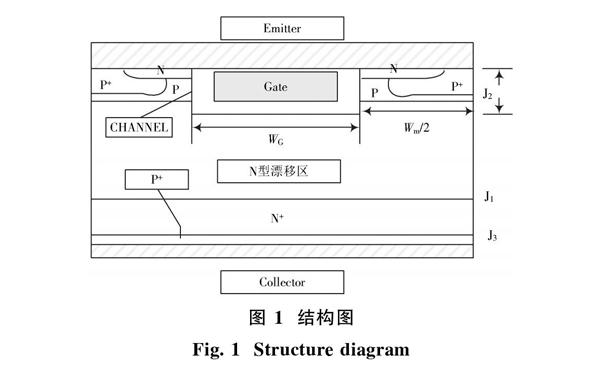
在器件中,N 型漂移区使用的是低掺杂,而在N漂移区的底部,紧跟着的是一层高掺杂的缓冲层,又把这个高掺杂缓冲层叫作电场截止层。顾名思义,场截止层的作用就是使电场在此终止,相同的条件下能够提高N?base的电阻率,这样就可以降低器件的导通压降,减少损耗。场截止层还有一个作用,就是可以避免NPT结构关断时的电磁干扰问题[7]。IGBT与VDMOS器件的差别在IGBT的最下层,它有一个P+集电极,于是其结构中存在一个N?P?N?P结构,这样的结构构成了一个晶闸管。
IGBT 可以被看作是MOS驱动的宽基区PNP和一个寄生的NPN的组合[8?10]。因为PNP晶体管拥有较宽的基区,这就导致它的电流增益也不大。虽然N+发射区与P?base 被发射极的金属材料区短接,但是当电流从PNP晶体管流向发射极时,还是会受到一个P?base电阻的影响。这个电阻的数值是有限的,可以用RS来表征。于是就能够得到Trench FS?IGBT 的等效电路图,见图2a)就是Trench FS?IGBT的等效电路图。P+区域的存在会使RS变得很小,因此有时可以将它忽略不计。这样Trench FS?IGBT结构中的NPN晶体管结构也就无法触发,那么等效电路就能够进行简化,如图2b)所示,其是一个由MOSFET驱动的PNP晶体管。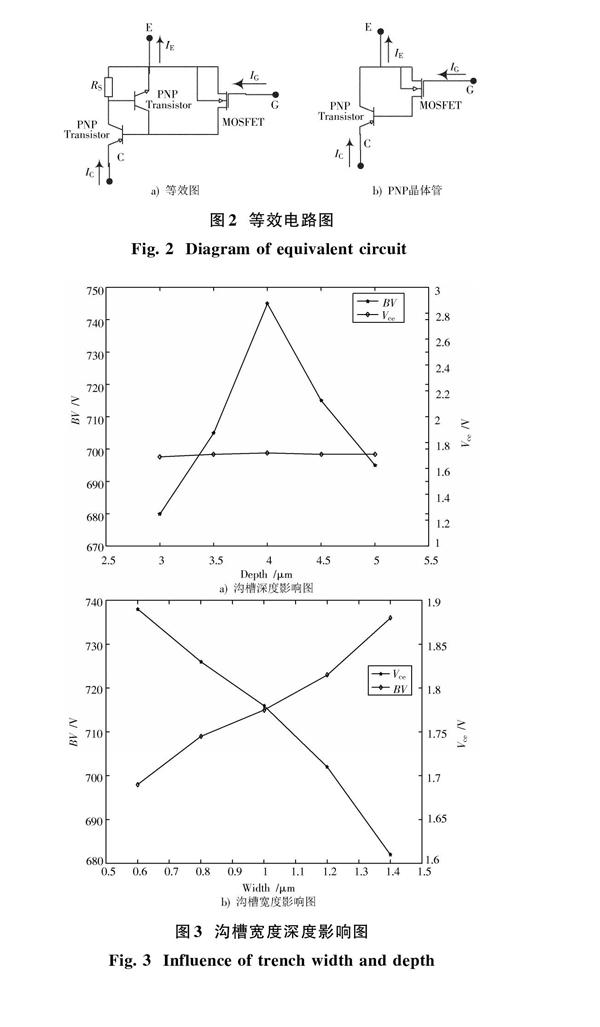
2 各部分影响分析
2.1 栅极对性能的影响
栅结构是IGBT一个比较重要的部分,发展至今有两种形式的栅结构:一种是平面栅;另一种是沟槽栅。槽栅结构较之平面栅有一定的优越性,它可以减少元胞尺寸,降低成本,同时去掉平面IGBT中占整体电阻较高的JFET区电阻,使得器件的导通压降得到降低[11]。本文主要研究槽栅的长度与宽度的影响。沟槽栅的宽度深度影响图如图3所示。
从图3a)可以看出,正向阻断电压BV随着深度的增加先变大再变小,在深度为4 μm时达到最大值,而导通压降基本不受深度的影响。当栅极上加正向偏压时,为了在沟槽侧形成沟道,并且使其可以延伸到N漂移区,栅的深度要大于P?base的结深。当然,Trench也不是越长越好,正向阻断状态下,沟槽两侧的P?base和N型漂移区会构成反偏的PN结,当槽栅相对较短时,两个反偏PN结的耗尽区会延展到一起,形成较为平坦的耗尽区,这样有助于提高器件耐压。
从图3b)中可以发现,器件的导通压降随着沟槽栅宽度的增加而降低,这是因为Trench所占的面积受一层栅氧层的影响并不能够为元胞提供电流。正向导通状态下,在Channel下方及Trench下方的電荷量分别为(ND++p-n)和(ND++p),后者的电荷为正且总量比前者要大,这样在两者之间会产生一个横向电场。在这个横向电场的作用下,带正电的空穴载流子会移动到沟道下方,进而会造成MOS沟道下方的载流子浓度变高,电阻率减小,这样器件的Vce就会降低。不过沟槽的宽度会受工艺技术的影响,不宜过大。太大的宽度会使得多晶硅回填沟槽时不能填满。
另外,随着沟槽栅宽度的增加,器件的耐压能力也在变大,这是因为较宽的栅结构有助于缓解槽底底角处的电场集中效应。
2.2 P?base区对器件性能的影响
IGBT的阈值电压可以表示为:
[Vth=?ms-QssCox+2?FB+2qNAεs?FBCox] (1)
[?FB=kTqlnNAni] (2)
式中:?ms为功函数差;Qss为栅氧层电荷面密度,它们都是确定值。从式(2)中可知衬底的费米势能?FB主要由P?base掺杂浓度NA决定,所以栅氧电容Cox以及P?base掺杂浓度NA成为影响Vth的重要因素。本文不讨论栅氧层的影响,只考虑掺杂浓度。决定P?base区掺杂浓度的是其注入能量和注入剂量,因此要对这两个参数进行仿真研究。
图4a)所示为 P?base 区注入剂量对BV的影响。从图中可知,器件的耐压能力虽然随着注入剂量的增加而增大,但是总体来说剂量对耐压能力的影响并不大,这是因为N漂移区与FS层才是影响BV的主要因素。图4b)所示为 P?base 区注入剂量对Vce和Vth的影响。注入的剂量大小会影响NA和沟道的电阻,后两者随前者的增加而变大。而NA和沟道的电阻与Vth和Vce有直接联系,所以Vth和Vce随着剂量的增加而变大。图 5a)与图5b)分别为 P?base 区注入能量对BV以及Vce和Vth的影响。P?base区的注入能量之所以能够影响器件是因为它改变了P?base区的结深。注入能量变大,硼离子被注入的深度随之变大,靠近结面的位置其浓度梯度不怎么改变,而较远处会有所下降,电场斜率会因此产生微小变化,这就是注入能量对耐压性能产生影响但是影响不大的原因。 此外,Vce和Vth会随着结深的增大以及梯度浓度的改变而有所增加。
2.3 外延层及P+集电极区对器件性能的影响
槽栅FS?IGBT所谓的外延层就是指N型漂移区和场截止层。对于外延层,主要研究的是掺杂浓度和它的厚度,这两者会对器件的BV与Vce产生影响。因为槽栅FS?IGBT 导通时,它的漂移区是大注入状态,所以导通压降很少受漂移区本身的掺杂浓度和厚度影响。在此主要分析漂移区对BV的影响,仿真中掺杂浓度用电阻率代替。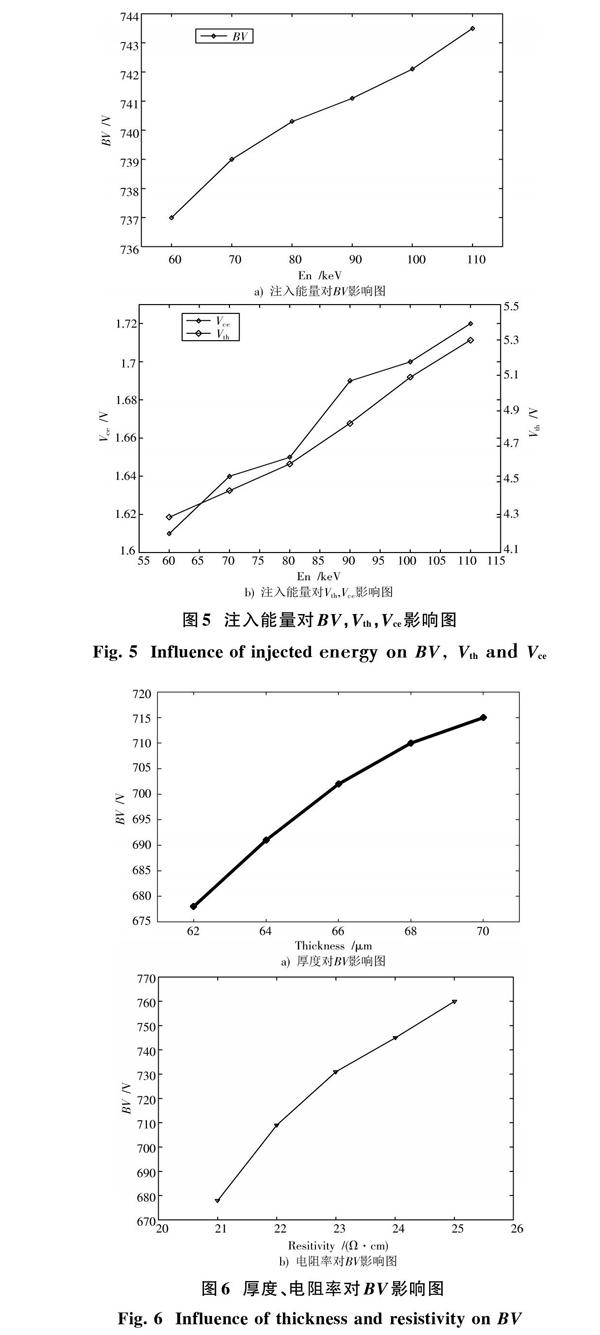
图6a),图6b)分别是漂移区厚度及电阻率对BV的影响。由图可知,漂移区的厚度和电阻率的增大都会使BV增大。这是由于阻断时,电阻率越大,就意味着掺杂浓度越小,也就导致电场斜率越小。
由于槽栅FS?IGBT 器件的漂移区较薄,漂移区厚度就相当于耗尽区厚度,电场围成面积的大小会随漂移区电阻率与厚度的变化而改变,所以电阻率与厚度的增加使得BV变大。
场截止层和P+集电极区也会对Vce和BV产生影响。产生影响的参数主要是P+集电极的注入剂量和FS层的电阻率。由图7a),图7b)可知,BV,Vce 都随两者的变大而减小。阻断时,背部PNP三极管开基区反偏,场截止层电阻率增大表示其掺杂浓度下降,那么基区未耗尽部分的宽度就会减小,输运以及电流放大系数变大,导致BV减小。
在集电极区,注入剂量的变大会使注入效率变强,而流放大系数又随着注入效率的变大而变大,从而让BV减小。Vce减小的原因有两个:一是FS层与P+集电区之间的PN 结导通压降降低;二是导通时,集电极变大的注入效率会让漂移区内的存储电荷增多、导通电阻减小。
3 结 论
本文对FS?IGBT的工艺结构进行了仿真,并通过改变栅极、P?base区、外延层的相关参数,利用Sentaurus TCAD对每次参数改变后的器件模型进行了电学测试与对比。借助仿真结果,在理论分析的基础上,说明了FS?IGBT各个重要结构的工艺参数对器件的正向阻断电压、导通电压、阈值电压的影响。FS?IGBT每个部分的工艺参数都与其他部分有或多或少的关联,优良性能的IGBT需要在各部分间取它们的良好折衷,实验得到的数据结果对FS?IGBT的研究有一定的参考价值。
注:本文通讯作者为邹其峰。
参考文献
[1] 叶立剑,邹勉,杨小慧.IGBT技术发展综述[J].半导体技术,2008,33(11):937?940.
YE Lijian, ZOU Mian, YANG Xiaohui. Review on development of IGBT technology [J]. Semiconductor technology, 2008, 33(11): 937?940.
[2] 钱照明.电力电子器件及其应用的现状和发展[J].变频器世界,2014(6):34?37.
QIAN Zhaoming. Current status and development of power electronic devices and their applications [J]. The world of inverters, 2014(6): 34?37.
[3] 陶建海.电力电子功率器件(IGBT)的发展[J].广西轻工业,2007,23(11):51.
TAO Jianhai. Development of power electronic device IGBT [J]. Guangxi journal of light industry, 2007, 23(11): 51.
[4] ALESSANDRIA A, FRAGAPANE L. A new top structure concept for a trench?gate emitter implant field?stop IGBT [C]// Proceedings of International Symposium on Power Electronics, Electrical Drives, Automation and Motion. Pisa: IEEE, 2010: 551?555.
[5] NAKAMURA K, HATORI K, HISAMOTO Y, et al. The next generation of HV?IGBTs with low loss and high SOA capability [C]// Proceedings of International Symposium on Power Semiconductor Devices and ICs. Orlando: IEEE, 2008: 145?148.
[6] ONOZAWA Y, OZAKI D, NAKANO H, et al. Development of the next generation 1700V trench?gate FS?IGBT [C]// Proceedings of the 23rd International Symposium on Power Semiconductor Devices and ICs. San Diego: IEEE, 2011: 52?55.
[7] 戚丽娜,张景超,刘利峰,等.IGBT器件的发展[J].电力电子技术,2012,46(12):34?38.
QI Lina, ZHANG Jingchao, LIU Lifeng, et al. The development of insulated gate bipolar transistor [J]. Power electronics, 2012, 46(12): 34?38.
[8] 赵起越.1 200 V TRENCH?FS型IGBT的设计[D].成都:电子科技大学,2013.
ZHAO Qiyue. The design of a 1200V TRENCH?FS IGBT device [D]. Chengdu: University of Electronic Science and Technology of China, 2013.
[9] 钱梦亮,李泽宏,张波,等.Trench gate IGBT structure with floating P region[J].半导体学报,2010,31(2):11?13.
QIAN Mengliang, LI Zehong, ZHANG Bo, et al. Trench gate IGBT structure with floating P region [J]. Journal of semiconductors, 2010, 31(2): 11?13.
[10] 游雪兰,吴郁,张彦飞.第六代1 200 V槽栅FS?IGBT模块[J].电力电子,2008(3):50?54.
YOU Xuelan, WU Yu, ZHANG Yanfei. The 6th generation 1200V trench FS?IGBT modules [J]. Power electronics ,2008(3): 50?54.
[11] 孔梓玮.一种1 200 V场截止型IGBT的优化设计与测试[D].成都:电子科技大学,2016.
KONG Ziwei. Optimum design and testing of a 1200V field?stop IGBT [D]. Chengdu: University of Electronic Science and Technology of China, 2016.
