基于加速寿命试验的SLD可靠性预计模型研究
2018-02-08周军连戴泽林
杨 云,任 艳,于 迪,周军连,戴泽林
基于加速寿命试验的SLD可靠性预计模型研究
杨 云,任 艳,于 迪,周军连,戴泽林
(工业和信息化部电子第五研究所,广东 广州 510610)
超辐射发光二极管(SLD)已广泛应用于航空、航天等多个领域,但其预计模型的缺失使得SLD的可靠性分析工作缺乏有效指导。本文基于SLD主要失效模式、失效机理以及典型诱发应力,构建SLD可靠性预计模型,开展加速寿命试验,利用性能退化可靠性评估技术、图估计、最优线性无偏估计等方法对试验数据进行分析处理,确定管芯预计模型参数,应用国内外已有耦合、热阻及制冷器可靠性预计技术,确定管芯耦合及组件预计模型系数的表征,从而完成SLD可靠性预计模型的建立,为SLD工程应用过程中的可靠性分析工作提供技术参考。
光学器件;超辐射发光二极管;可靠性;预计模型;加速寿命试验;性能退化
超辐射发光二极管(SLD)是一种自发辐射的单程光放大器件,集发光二极管(LED)和激光器(LD)二者优点于一体,具有输出功率高、光谱宽度宽、稳定性好、光束方向性好以及相干长度短等优势,作为一种重要的光源,广泛应用于光纤陀螺仪、光信息处理、光相干测试技术等领域,尤其是在光纤陀螺仪上SLD的应用最为广泛[1-4]。SLD作为一种新型、关键电子元器件,其可靠性在很大程度上影响了装备的可靠性水平,对其可靠指标、使用寿命的获知需求日益迫切。
Kashima等[5]基于其他光电器件失效模型,对SLD可靠性进行了研究,提出了退化性能与工作时间的关系模型。韦文生等[6]对SLD的失效机理进行研究,分析导致SLD失效的敏感应力,得到SLD输出光功率与结温间的关系。孙孟相等[7]自主研发了SLD寿命测试方法,对SLD的退化机理进行分析,提出了SLD的加速寿命测试的数学模型,并基于寿命分析数学模型外推出正常工作条件下的器件寿命。
虽然国内外针对SLD可靠性评价已开展了大量工作,但现有研究工作都未建立明确的SLD可靠性预计模型,无法快速、准确评价其真实可靠性水平。因此,本文将在分析研究SLD的主要失效模式及失效机理的基础上,利用寿命加速试验、建立退化寿命模型等方法,建立SLD可靠性预计模型,用以支撑SLD工程应用过程中可靠性评价工作的开展。
1 主要失效模式及失效机理
SLD失效按失效部位可分为管芯失效、耦合失效及组件失效三大类,SLD的主要失效模式及失效机理如表1所示[8-13]。

表1 SLD失效模式及机理
管芯有源区退化。管芯退化的直接原因是有源区内存在晶格缺陷以及这些晶格缺陷在持续工作过程中的逐渐扩大。退化过程中,开始有源区内存在某些暗点(即不发光的非均匀小区),最后成为一片暗区。伴随着缺陷的形成、生长和迁移以及p-n结的退化,注入效率将会降低,同时光化学反应会引起表面腐蚀、表面漏电和接触层退化,进而导致接触处金属的内扩散,在结晶及接触处污染或生长出须状物构成漏电通道等,这些综合因素最终会引起SLD管芯的退化,管芯有源区内缺陷的生成速度是决定SLD可靠性的重要因素。
耦合失效。耦合失效部位是管芯与尾纤的耦合处,SLD模块中尾纤与管芯间的耦合为亚微米量级的对准,耦合偏移将导致光源光功率逐渐减小直至失效,主要是由于焊料的退化引起的。对SLD来说,所用焊料主要有纯锡、金锡易熔合金以及金锗易熔合金等,应力较小,但老化期间易变质,焊料变质的原因是原子之间扩散并形成金属间化合物,这些化合物呈峰窝状的空隙结构,有相当高的热阻,进而造成器件应力增加、热阻增加,从而形成一个退化源,导致器件迅速退化。另外焊接引入的应力、管芯、焊料、热沉之间热膨胀系数匹配程度不佳等也会使器件快速退化。
组件失效。使用过程中内部组件包括热敏电阻和制冷器的失效也会导致SLD迅速老化,如热敏电阻主要是温循导致的阻值漂移、材料老化,电迁移导致电极有效面积减少,热-机械应力导致内部裂纹的蔓延与扩展等。
2 可靠性预计模型建立
结合上文分析,SLD失效的主要部位在于管芯、管芯耦合以及内部组件(制冷器与热敏电阻),基本没有因封装产生失效,所以模型的建立也集中在管芯、管芯耦合和组件三个方面,假定管芯失效、耦合失效和组件失效之间相互独立,SLD的可靠性预计模型可表征如下:

a)管芯失效率:

式中:b1为管芯基本失效率;T1为管芯温度系数。
b)耦合失效率:

式中:b2为光纤焊点耦合失效率。
c)制冷器失效率:

式中:b3为制冷器基本失效率。
d)热敏电阻失效率:

式中:b4为热敏电阻基本失效率;T4为热敏电阻温度系数。
3 管芯可靠性评估
作为SLD的关键部位,管芯的寿命是影响SLD寿命最重要的决定因素[7],本文将着重开展管芯可靠性研究。SLD管芯失效主要由热应力诱发,为此本文通过开展温度加速寿命试验来确定SLD管芯预计模型中的各模型系数。
3.1 Arrhenius方程
Arrhenius方程是最常用表征寿命与温度关系的模型[13],本文中亦将参照该方程来获取SLD管芯预计模型各系数:

式中:表示产品性能退化量;为常数且大于零;a激活能,单位eV;为玻尔兹曼常数,8.618×10–5eV/K;为管芯温度。
若元器件的失效是由初始状态的退化量为0累积到一定状态引起的,那么寿命就是反应累积到所需的时间,由Arrhenius方程两边积分取对数得:


公式(8)即加速寿命方程,产品的寿命的对数与加速应力温度的倒数之间满足线性关系。
Arrhenius方程的加速系数:

式中:s是加速温度;0是正常温度。
3.2 可靠性试验
常见的可靠性评估方法,是基于失效寿命数据,但对于高可靠长寿命产品,很难通过寿命试验或加速寿命试验得到失效寿命时间,可以利用产品性能退化过程中所包含的信息对产品可靠性进行评估[15]。对于SLD管芯而言,输出光功率是其最重要的性能参数[16-17],因此,选择输出光功率作为管芯的性能退化参数,开展管芯的加速寿命试验。
随机选取15只SLD管芯,共进行3组试验,每组5只试验样品,试验温度分别为70,85,100℃,在施加恒定电流下持续通电工作,每隔一定时间对管芯的输出功率进行测量,得到的加速寿命试验中各组试验样品输出功率随老化时间的变化数据如图1所示。
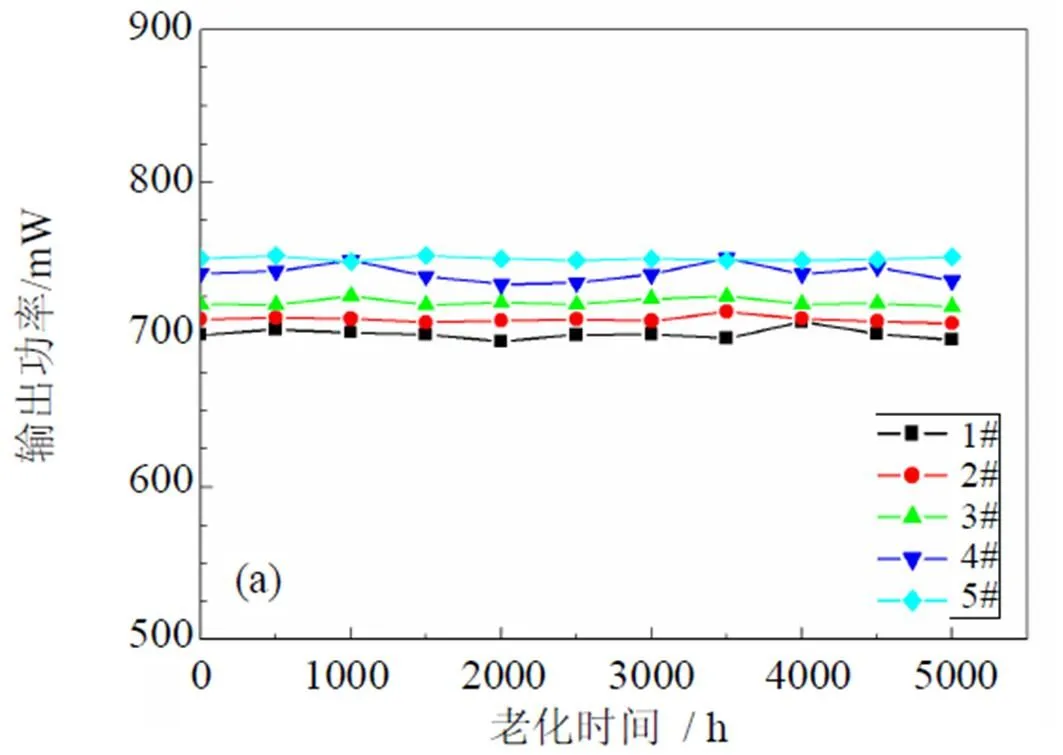
(a)1=70 ℃;(b)2=85 ℃;(c)3=100 ℃
图1 SLD管芯功率变化曲线
Fig.1 Changing curves of output power of SLD chip
3.3 可靠性试验数据处理
对管芯在三种高温应力下的数据进行分析后,发现管芯的性能退化轨迹呈现线性变化,选取=+作为退化轨迹方程拟合函数,利用最小二乘法对各组试验数据进行线性拟合后,得到管芯在三种高温应力条件下的拟合曲线如图2所示,拟合后得到的各组退化轨迹拟合函数参数,如表2所示。
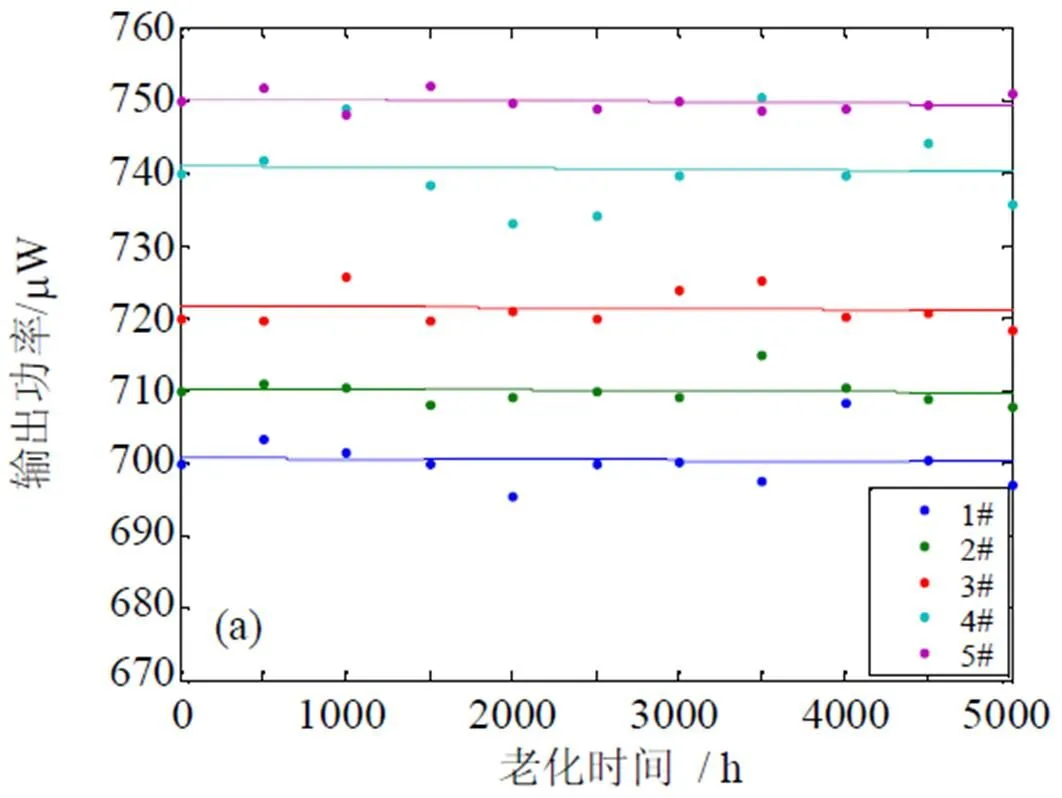
(a)1=70℃;(b)2=85℃;(c)3=100℃
图2 高温应力条件下的退化轨迹拟合曲线
Fig.2 The fitting curves of degradation trajectory under high temperature stress

表2 退化轨迹拟合函数参数
利用管芯的退化轨迹方程,以及拟合得到的参数,经过外推可以得到各组试验条件下管芯退化至失效(输出功率降至50%)时的时间,即伪失效寿命,不同高温应力条件下管芯的伪失效寿命如表3所示。

表3 不同高温应力条件下管芯的伪失效寿命
3.3.1 分布假设检验
研究表明半导体器件加速寿命试验中寿命基本符合威布尔分布,利用χ2检验来测验高温加速应力试验下管芯伪失效寿命是否服从威布尔分布:




伪失效寿命分布假设检验参数如表4所示。取显著水平=0.1,由此得2/2(–2)=0.3518、21–α/2(–2)=7.8147,由于0.35182/<7.8147,因此,可以认为在加速试验中,SLD管芯伪失效寿命服从威布尔分布。

表4 伪失效寿命分布假设检验参数
此外,由图3寿命分布函数的图估计结果可以看出,不同温度下SLD伪失效寿命数据点能够呈现较好的线性拟合,符合威布尔分布。因此针对上述可靠性试验数据,利用威布尔分布获取SLD管芯在几种高温应力下的寿命。
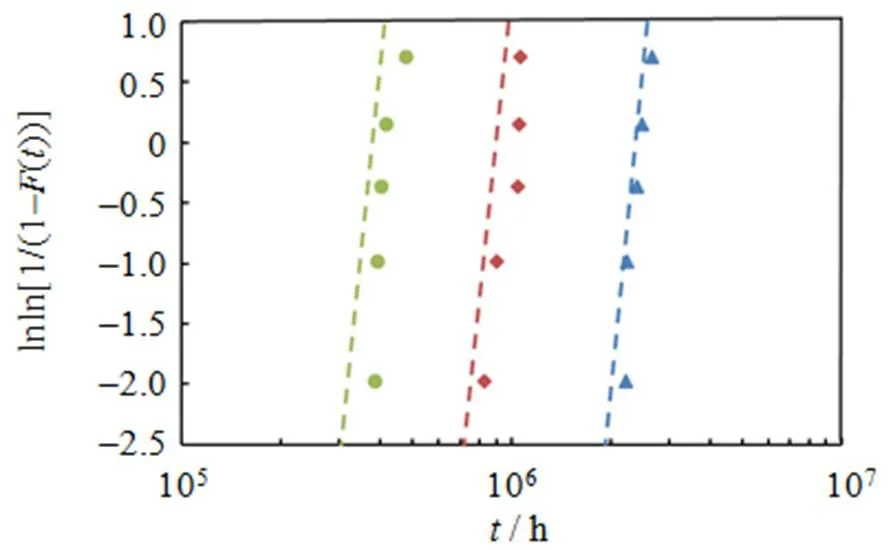
图3 威布尔分布图估计
3.3.2 威布尔分布
威布尔失效概率密度:

失效分布函数表达式为:

式中:是尺度参数;是形状参数。
可靠度函数()、平均寿命MTBF、失效率()表达式为:



由于直接求和估计比较困难,因此以和代替威布尔分布参数和,关系如下:

和的最优线性无偏估计为:


式中:为样品数;为失效数;为失效器件编号;(,,)称为的最优线性无偏估计系数;(,,)称为的最优线性无偏估计系数。由此可得和的近似无偏估计:


式中:g, n为的修偏系数。
对于恒定应力加速寿命试验中威布尔分布线性估计,根据下式可对整体形状参数进行估计:


3.3.3 模型参数估计


表5 最优线性无偏估计结果
Arrhenius方程作为寿命与温度的表征模型,需确定激活能。为此,依据公式(7)、(8)对各组试验温度及对应的管芯特征寿命进行处理,结果如表6所示。

表6 SLD管芯数据处理结果
利用最小二乘法对曲线拟合可以得到公式(8)中和估计值,拟合后的结果为:

则=–6.99,=7453,进而得到SLD管芯激活能a:

根据上述数据分析结果,采用SLD的激活能0.65 eV,可以计算得到70℃温度应力相对于25℃温度应力的加速系数为:
得到管芯室温条件下的特征寿命:

则室温下管芯的平均寿命为:
即SLD管芯在驱动电流为100 mA,室温25℃的工作条件下,平均寿命可以达到百万小时。
对室温下寿命期内器件失效率进行平均处理得到:

管芯温度系数为:
其中:a=0.65 eV。
4 管芯耦合及组件可靠性评估
管芯耦合。对于管芯耦合失效主要与焊点工艺相关,当前国内SLD耦合工艺基本一致,耦合失效率参照GJB/Z 299C《电子设备可靠性预计手册》中焊接点的失效率[18]。
制冷器。国内SLD中使用的热电制冷器均为进口电子元器件,温度和电应力对其失效率没有影响,制冷器的工作失效率预计模型参照SR-332《电子设备可靠性预计程序》,其失效率取值4.9×10–9/h[19]。
热敏电阻。关于热敏的工作失效率预计模型可参照GJB/Z 299C《电子设备可靠性预计手册》,其失效率取值为4.5×10–8/h[18]。
5 结论
本文针对新型、关键元器件SLD,开展可靠性预计建模技术研究,探寻新型预计建模方法,建立较为准确可靠性预计模型,基于性能退化可靠性评估技术,通过开展加速寿命试验确定了预计模型参数,保证建立的预计模型具有较好的准确性和实用性,从而支撑可靠性预计工作的顺利开展。
需要指出的是,本文建立的可靠性预计模型仅适用于为正常工作条件下的SLD可靠性分析评价工作提供支撑。此外,用户可利用积累的失效、现场使用等可靠性数据,对本模型建模进行修正,提高模型的适用性水平。
[1] 王佐才, 吕雪芹, 金鹏, 等. 超辐射发光二极管的应用 [J]. 红外技术, 2010, 32(5): 297-303.
[2] 唐雄, 范仁森, 马正飞, 等. 硅基片上光互连电路设计 [J]. 光电子, 2016, 6(2): 47-53.
[3] 韦文生, 张春熹, 马静, 等. 超辐射激光二极管的研究与应用 [J]. 激光与红外, 2003, 33(6): 409-411.
[4] 廖柯, 刘刚明, 周勇, 等. 850 nm超辐射发光二极管[J]. 半导体光电, 2004, 25(4): 257-261.
[5] KASHIMA Y, MATOBA A. Performance and reliability of InGaAsP superluminescent diode [J]. J Lightwave Technol, 1991, 11(10): 1644-1649.
[6] 韦文生, 张春熹, 马静, 等. 1.3 μm DH-SLD的性能与工作电流和温度的关系 [J]. 红外, 2004(4): 18-23.
[7] 孙孟相, 谭满清, 王鲁峰. 1300 nm超辐射发光二极管寿命测试 [J]. 光学学报, 2008, 28(10): 1994-1997.
[8] 晁代宏, 马静, 张春熹. 基于性能退化数据的超辐射发光二极管可靠性评估研究 [J]. 光学学报, 2010, 30(10): 3044-3048.
[9] 唐祖荣, 杨虹. 1.3 μm超辐射发光二极管模块功率稳定性研究 [J]. 半导体光电, 2004, 25(6): 430-432.
[10] 李辉, 王玉霞, 李梅, 等. 高功率850 nm宽光谱大光腔超辐射发光二极管 [J]. 中国激光, 2006, 33(5): 613-616.
[11] 高松信, 魏彬, 吕文强, 等. 高功率二极管激光器失效特性研究 [J]. 强激光与粒子束, 2005, 17(50): 97-99.
[12] 胡放荣, 熊显名, 张剑家. 高功率半导体激光器光纤耦合模块的可靠性研究 [J]. 激光与红外, 2006, 36(5): 358-360.
[13] 李岚. 薄膜荧光屏的制备和发光性能及超辐射发光二极管热分析研究[D]. 天津: 河北工业大学, 2006.
[14] 林震, 姜同敏, 程永生, 等. 阿伦尼斯模型研究 [J]. 电子产品可靠性与环境试验, 2005(6): 12-13.
[15] 邓爱民, 陈循, 张春华, 等. 基于性能退化数据的可靠性评估 [J]. 2006, 27(3): 546-552.
[16] LOBINTSOV P A, MAMEDOV D S, YAKUBOVICH S D. Lifetime tests of superluminescent diodes [J]. Quantum Electron, 2006, 32(2): 111-113.
[17] CHAO D H, MA J, LI X Y. Research on the reliability of SLD through accelerated life testing [C]// 8th International Conference on Reliability, Maintainability and Safety, Beijing, China: The Conference Organizer, 2009: 1263-1267.
[18] 中国人民解放军总装备部. GJB/Z 299C—2006电子设备可靠性预计手册[S]. 北京: 中国标准出版社, 2007.
[19] BELLCORE. Reliability prediction procedure for electronic equipment: Telcordia Technology Special Report SR-332 [R]. USA: [s.n], 2011.
(责任编辑:陈渝生)
Research on reliability prediction model for SLD based on accelerated lifetime test
YANG Yun, REN Yan, YU Di, ZHOU Junlian, DAI Zelin
(No.5 Electronic Institute, Ministry of Industry and Information Technology, Guangzhou 510610, China)
Superluminescent diode (SLD) is widely used in aviation, aerospace and other fields. Unfortunately, due to the absence of the prediction model for SLD, few effective guidance for reliability analysis is available. In this paper, the prediction model for SLD was established based on the main failure modes, mechanisms and typical induced stress of SLD. To quantitatively determine the reliability prediction model coefficients of SLD chip, the accelerated lifetime test was carried out, and the methods of reliability estimation based on performance degradation, figure estimation, optimal linear unbiased estimation and least square method were employed for data processing. Moreover, the coupling and internal components model coefficients were characterized on the basis of existing reliability prediction technology of coupling, thermistor and refrigerator. The result provides valuable technical information for reliability analysis of the engineering applications of SLD.
optical devices; superluminescent diode (SLD); reliability; prediction model; accelerated lifetime test; performance degradation
10.14106/j.cnki.1001-2028.2018.02.015
TN386
A
1001-2028(2018)02-0079-06
2017-11-26
杨云
杨云(1988-),女,黑龙江牡丹江人,工程师,硕士,研究方向为质量与可靠性;任艳(1983-),女,河南三门峡人,高级工程师,研究方向为质量与可靠性。
