二氧化硅/双马来酰亚胺半固化片流变特性及其制备的覆铜板性能
2017-08-08戴善凯黄荣辉季立富谌香秀
戴善凯, 黄荣辉, 季立富, 谌香秀
(苏州生益科技有限公司, 江苏 苏州 215024)
二氧化硅/双马来酰亚胺半固化片流变特性及其制备的覆铜板性能
戴善凯, 黄荣辉, 季立富, 谌香秀
(苏州生益科技有限公司, 江苏 苏州 215024)
研究经偶联剂KH550,KH560及KH570表面处理后的二氧化硅对双马来酰亚胺树脂体系流变特性的影响,通过DMA,TMA及TGA等测试手段表征所制备覆铜板的刚性、热膨胀系数及热稳定性。结果表明:采用KH560表面处理的二氧化硅/双马来酰亚胺树脂体系,较表面处理剂为KH550、KH570及未表面处理的二氧化硅/双马来酰亚胺树脂体系具有更好的流变特性和更低的熔融黏度;在树脂体系中引入二氧化硅,可以有效地提高覆铜板基材的综合性能,与未添加二氧化硅相比,具有更高的存储模量和更低的热膨胀系数;当二氧化硅质量分数为50%时,50 ℃时基材存储模量提高了83%,玻璃化转变温度以下的热膨胀系数α1降低了153%。
流变;热膨胀系数;刚性;双马来酰亚胺;覆铜板
在电子技术领域,随着印制电子电路的细线化、线路布局的高密度化、基板层数的增多化、封装线路的多引脚化,传统的覆铜板材料已经难以满足电子电路行业发展的需要,高耐热、低热膨胀系数等高可靠性的材料成为未来替代材料[1-3]。双马来酰亚胺树脂(BMI)是一种热固性反应型聚酰亚胺树脂,固化时无小分子物质放出,固化后的树脂具有高耐热性、优异的耐湿热性、良好的介电性能及低的热膨胀系数、长期耐热老化等特性,在电子覆铜板材料上展现了巨大的应用前景。然而,BMI树脂问世初期,因其熔融温度高、溶解性差、固化物脆性大等不足,一定程度上限制了其应用。烯丙基系列树脂增韧双马来酰亚胺树脂成功解决了上述问题,增韧后的树脂在保持良好耐热性的基础上,克服了上述溶解性及脆性大等问题,为其在覆铜板等复合材料领域的应用创造了有利条件[4-8]。二氧化硅微粉为一种覆铜板领域常用的无机填料,具有高热稳定性、低吸水率和低热膨胀系数,在覆铜板中引入二氧化硅微粉,可以有效降低材料的热膨胀系数,降低材料的吸水率,通过不同比例的搭配,有效改善其综合性能[9],但是树脂中二氧化硅微粉的引入,亦造成了体系的黏度增大,对半固化片热压过程的流动性造成一定的影响。
本工作在烯丙基改性双马来酰亚胺树脂中引入不同偶联剂处理的二氧化硅微粉,考察了偶联剂对二氧化硅的添加量及基体流变特性的影响,并通过偶联剂的选择和二氧化硅比例的调节,制备出了具有高耐热、高刚性及低热膨胀系数的覆铜板材料,有望在航空航天用电元器件领域得到应用。
1 实验材料及方法
1.1原材料
二苯甲烷型双马来酰亚胺(BDM)、二烯丙基双酚A(DBA),γ-氨丙基三乙氧基硅烷(KH550),γ-(2, 3环氧丙氧)丙基三甲氧基硅烷(KH560)、γ-甲基丙烯酰氧基丙基三甲氧基硅烷(KH570)、二氧化硅微粉(SiO2,D50为1μm),以上材料均为工业级。
1.2样品制备
按照SiO2与偶联剂的质量比100 ∶1,分别称取KH550,KH560和KH570,溶解于一定量的丙酮中,常温下搅拌3~4 h,再分别加入SiO2,使用均质剪切机搅拌2 h,倒入干净的托盘中,于110 ℃真空干燥箱中干燥24 h,得到表面处理过的SiO2,依次记为SiO2/KH550,SiO2/KH560与SiO2/KH570,取出待用。
称取质量比为60 ∶100的二烯丙基双酚A与二苯甲烷型双马来酰亚胺树脂在130 ℃的油浴锅中共聚100 min,冷却后得到改性双马来酰亚胺树脂预聚物,记为MBMI。
胶液的制备:将上述MBMI树脂溶解于丙酮中,依次加入占固体总量30%,40%,50%和60%SiO2,使用高速剪切机搅拌均匀,待用。
将裁切好的电子级玻璃纤维布浸入到上述混制好的胶液中,通过夹轴间隙的控制,得到一定胶含量的预浸料,并将其悬挂于165~170 ℃的鼓风干燥箱中,烘烤3~6 min,制得所需的半固化片;将上述制得的半固化片按照一定的叠构叠配而成,上下放置一张铜箔,置于真空压机中,按照如下程序140 ℃/1 h+160 ℃/1 h+200 ℃/2 h +220 ℃/4 h压合而成。
以上获得的胶液、半固化片及覆铜板,以MBMI/SiO2/S/N命名,其中S为偶联剂类别,N为SiO2在树脂基体中的含量,如MBMI/SiO2/KH550/30。
1.3测试与表征
取20 mg样品放置于171 ℃的热盘中,采用小刀法测试样品的凝胶化时间(gel time)。
将少量半固化片粉末,在N2气氛下,于差示热量扫描测试(DSC)仪器上测试其固化反应曲线,测试温度范围50~300 ℃,升温速率10 ℃/min。
进行流变测试时,升温速率3 ℃/min,温度范围80~160 ℃,振荡频率1Hz。
在动态热机械分析仪上,采用薄膜拉伸法进行动态力学分析(DMA)测试,测试频率 1 Hz,温度范围50~280 ℃,升温速率3 ℃/min,样品尺寸35 mm×10 mm×0.1 mm。
取少量样品,在N2气氛下,于TGA Q500热失重分析仪上进行热失重分析(TGA)测试,测试温度范围50~500 ℃,升温速率10 ℃/min,以样品失重5%时的温度定义为样品起始分解温度。
将样品置于NETZSCH,TMA热机械分析仪中进行热膨胀系数测试,温度范围30~300 ℃,升温速率10 ℃/min。
2 结果与讨论
2.1MBMI/SiO2/S/N体系反应性
2.1.1 MBMI/ SiO2/S/N体系胶水的凝胶化时间
图1为MBMI/ SiO2/S/N体系胶水在171 ℃下的凝胶时间-温度曲线,考察不同偶联剂处理SiO2对胶水凝胶时间(GT)的影响。从图1可以看出,在不添加偶联剂或偶联剂为KH560的情况下,随着SiO2在胶水中含量的增加,其GT值基本无大的变化,均在140~150 s之间波动,当偶联剂为KH550或KH570时,GT随着SiO2含量的增加而逐渐缩短,这主要归因于KH550中含有氨基基团,而氨基与双马来酰亚胺发生反应,有一定的促进作用[10];而KH570中的双键,与烯丙基及双马来酰亚胺中的双键反应[5-6],因此,胶水的凝胶时间略有缩短。

图1 MBMI/SiO2/S/N体系胶水在171 ℃下的凝胶时间-温度曲线 Fig.1 Gel time-temperature curves of MBMI/SiO2/S/N vanish at 171 ℃
2.1.2 MBMI/SiO2/S/N体系半固化片粉末DSC反应性
图2为MBMI和MBMI/SiO2/S/N体系半固化片粉末的DSC曲线,其中SiO2含量为30%。从图2可以看出,MBMI和MBMI/ SiO2/S/N的反应趋势完全一致,均存在两个反应峰,其中第一反应峰为BMI中的双键和烯丙基发生反应,第二反应峰为双烯加成反应[11]。加入KH550和KH570处理后的反应峰略有前移,但不明显。无机材料SiO2的加入,并不会明显影响双马来酰亚胺树脂的固化历程,虽然偶联剂中氨基、环氧基或乙烯基与双马来酰亚胺中的氨基具有一定的反应性,但偶联剂占整个树脂体系的量较少,对其反应的促进作用相对较弱,固在DSC反应峰上未有明显体现。
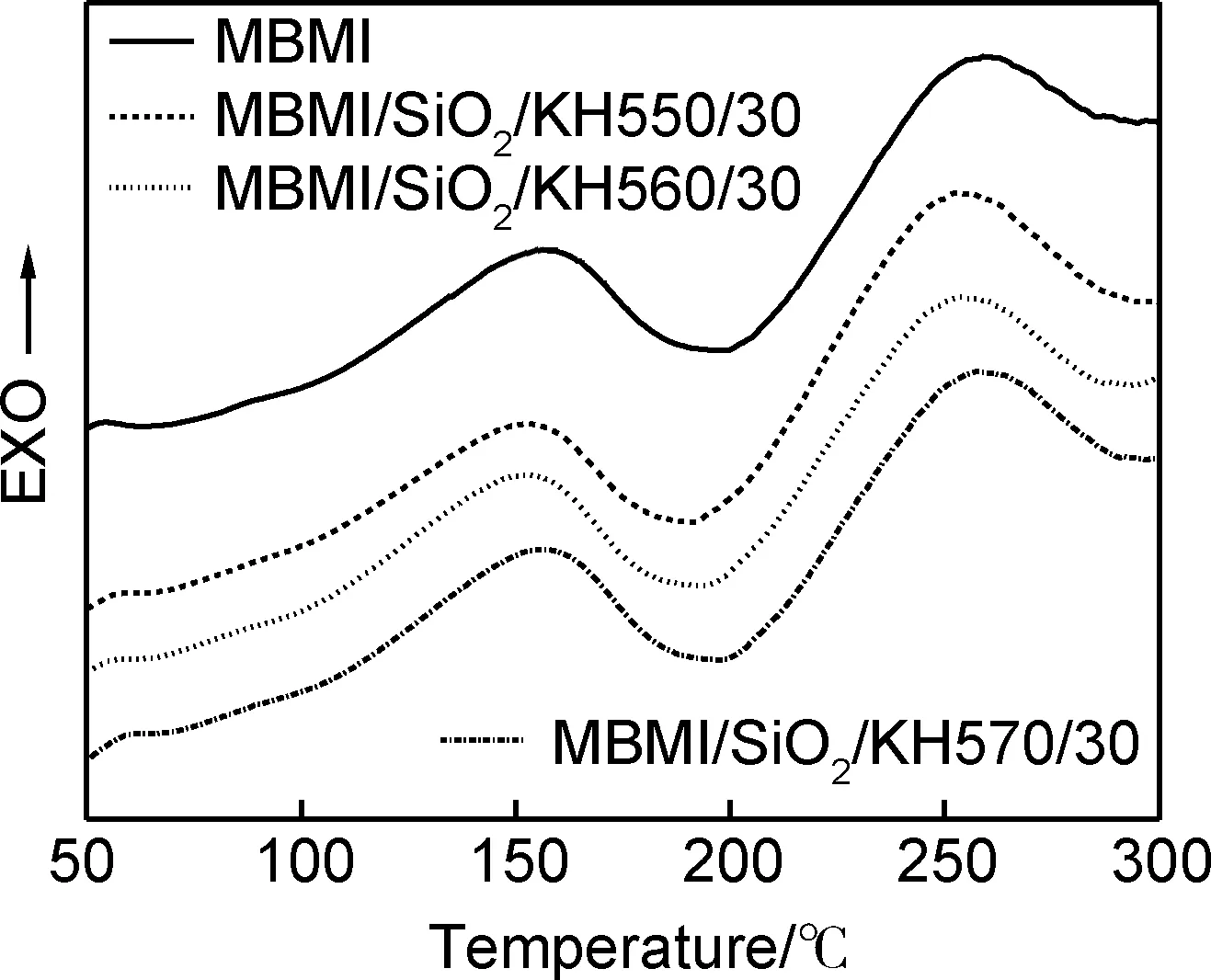
图2 MBMI/SiO2/S/N体系半固化片粉末DSC曲线Fig. 2 DSC curves of MBMI/SiO2/S/N prepregs’powder
2.2MBMI/SiO2/S/N体系半固化片粉末流变性能
图3为MBMI/ SiO2/S/N体系半固化片粉末的流变曲线图。从图3可以看出,所有流变曲线均呈现先下降后上升,或下降后呈现一定的平台期,这主要是因为在树脂固化初期,随着温度的升高,分子热运动加剧,分子间距增大,相互作用减小,使分子链段更易运动,黏度下降,温度越高,分子热运动越剧烈,黏度降低越明显。这一阶段,分子热运动活性增大占主导地位,分子固化及分子量的增大缓慢;在固化反应后期,达到一定的反应温度后,分子中交联结构的形成增多,分子量增大,树脂固化所引起的黏度增大逐渐占据主导地位[12],所以呈现先降低后升高的现象。表1为图3中流变曲线的典型数据,可以看出,当SiO2含量低于或等于30%时,所有体系的最低熔融黏度均较低;当SiO2含量为40%时,未采用偶联剂体系的最低熔融黏度显著升高,为2687 Pa·s,偶联剂为KH550和KH570时,则仍可获得相对低的最低熔融黏度,依次为635 Pa·s和779 Pa·s,偶联剂为KH560时,黏度变化依然较低,为274 Pa·s;当SiO2含量为50%时,仅偶联剂为KH560时,保持较低的最低熔融黏度,为558 Pa·s;其他黏度均较高,大于2000 Pa·s;无偶联剂时,则因为胶水黏度过高而难以制备半固化片。在覆铜板热压过程中,最低熔融黏度为关键指标之一,熔融黏度过高,易致板材压合过程中出现流动性问题,如树脂不流动,层间黏结力降低,或流动性不足带来树脂的二次浸胶不均,造成局部缺胶、干花、白纹等基材缺陷,严重影响其电气及机械性能,从而造成电子产品的失效[13-14]。

图3 MBMI/SiO2/S/N体系半固化片粉末流变曲线 (a)未表面处理的二氧化硅/树脂体系;(b)采用KH550表面处理的二氧化硅/树脂体系;(c)采用KH560表面处理的二氧化硅/树脂体系;(d)采用KH570表面处理的二氧化硅/树脂体系Fig.3 Rheology curves of MBMI/SiO2/S/N prepregs’ powder (a)resin system containing silica without treatment; (b)resin system containing silica treated by KH550;(c)resin system containing silica treated by KH560;(d)resin system containing silica treated by KH570

表1 图3中得出的流变曲线的典型数据
2.3MBMI/SiO2/KH560/N体系覆铜板性能
2.3.1 MBMI/SiO2/KH560/N体系基材的动态力学性能
动态力学分析(DMA)是表征高分子材料热机械性能的一种方式,通过动态力学分析可以有效测定出材料在一定条件下的刚性和阻尼特性,无机刚性粒子的加入,不仅可以影响材料的电气等方面性能,亦可以改变材料的刚性及阻尼特性。图4为MBMI/SiO2/KH560/N体系基材的存储模量-温度曲线。在一定温度条件下,存储模量数值越高,则材料的刚性越大,抗形变能力越强,从图4可以看出,随着SiO2含量在树脂体系中的增加,存储模量逐渐升高,50 ℃时,存储模量从MBMI为18.0 GPa,增加到MBMI/SiO2/KH-560/30,MBMI/SiO2/KH-560/40,MBMI/SiO2/KH-560/50和MBMI/SiO2/KH-560/60时的21.5 GPa,24.6 GPa,33.0 GPa和33.9 GPa,分别提高了19.4%,26.7%,83.3%和88.3%,这主要归因于SiO2自身具有较高的刚性,无机材料杂化在树脂基体中,有效限制了分子链的运动。当温度远远低于玻璃化转变温度(Tg)时,存储模量衰减缓慢。当温度越来越接近Tg时,其模量则迅速下降。这是因为材料中的双马来酰亚胺树脂在低于Tg时,呈高度交联结构,材料保持了较强的刚性,而随着温度的升高,接近或超过Tg时,分子链段出现了松弛,抗形变能力出现了较大的衰减,因此存储模量快速降低。
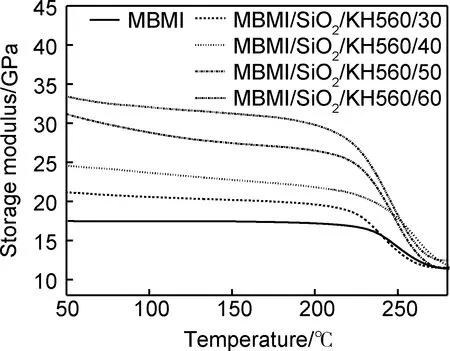
图4 MBMI/SiO2/KH560/N体系基材的存储模量-温度曲线Fig.4 Storage modulus-temperature curves of MBMI/SiO2/KH560/N boards
图5为MBMI/ SiO2/KH560/N体系基材的tanδ温度曲线,其中tanδ的峰顶温度定义为材料的Tg。如图5可以看出,MBMI/ SiO2/KH560/N体系基材的Tg不随着填料含量的变化而改变,其峰顶温度基本维持在260~270 ℃之间,依次为263.7 ℃,262.7 ℃,262.2 ℃,263.6 ℃和265.2 ℃,这主要是因为在MBMI树脂基体中除了引入1%的SiO2(质量分数)偶联剂,不存在其他与双马来酰亚胺发生反应的物质,故整个固化后树脂的交联结构并未发生变化,因此,其Tg亦未发生大的变化。

图5 MBMI/SiO2/KH-560/N体系基材的tan δ-温度曲线Fig.5 tan δ-temperature curves of MBMI/SiO2/KH560/Nboards
2.3.2 MBMI/SiO2/KH560/N体系基材的热膨胀系数
图6为MBMI/SiO2/KH560/N体系基材的Z轴热膨胀系数-温度曲线,从图6可以看出,随着体系中SiO2含量的增加,其热膨胀系数(CTE)曲线逐渐下移,经过测算,当SiO2含量从0增加到30%,40%,50%~60%时,其Tg下的线性热膨胀系数α1分别为43×10-6℃-1,34×10-6℃-1,22×10-6℃-1,17×10-6℃-1和14×10-6℃-1,与不含SiO2时相比,依次降低了26%,95%,153%和207%。这主要是因为,在树脂基体中加入的SiO2具有较低的CTE,仅为0.5×10-6℃-1[15],随着基体中SiO2体积比的增加,体系的CTE也逐渐降低。

图6 MBMI/ SiO2/KH560/N体系基材的Z轴热膨胀系数-温度曲线Fig.6 Z-axis coefficient of thermal expansion of MBMI/SiO2/KH560/N boards
2.3.3 MBMI/ SiO2/KH560/N体系基材的热稳定性
图7和图8为MBMI/SiO2/KH560/N体系基材的TGA曲线和DTG曲线。从图7中可以看出,在MBMI中引入SiO2后,其起始热分解温度(Td)有一定程度的提高,随SiO2添加量增加从MBMI时的414.6 ℃,逐步升高到426.3 ℃,426.8 ℃,428.7 ℃和430.7 ℃,在500 ℃时,随着SiO2添加量的增加,其残炭率逐渐增高。图8显示,随着MBMI中SiO2含量的增加,其最大分解速率峰峰值逐渐降低,说明分解速率依次减缓。以上主要归因于:树脂基体中引入的SiO2为一种无机填料,在高温下具有较高的热稳定性,因此,随着SiO2含量的增加,其起始热分解温度和残炭率均会有所提高,提高了材料的热稳定性。

图7 MBMI/SiO2/KH560/N体系基材的TGA曲线图Fig.7 TGA curves of MBMI/SiO2/KH560/N boards
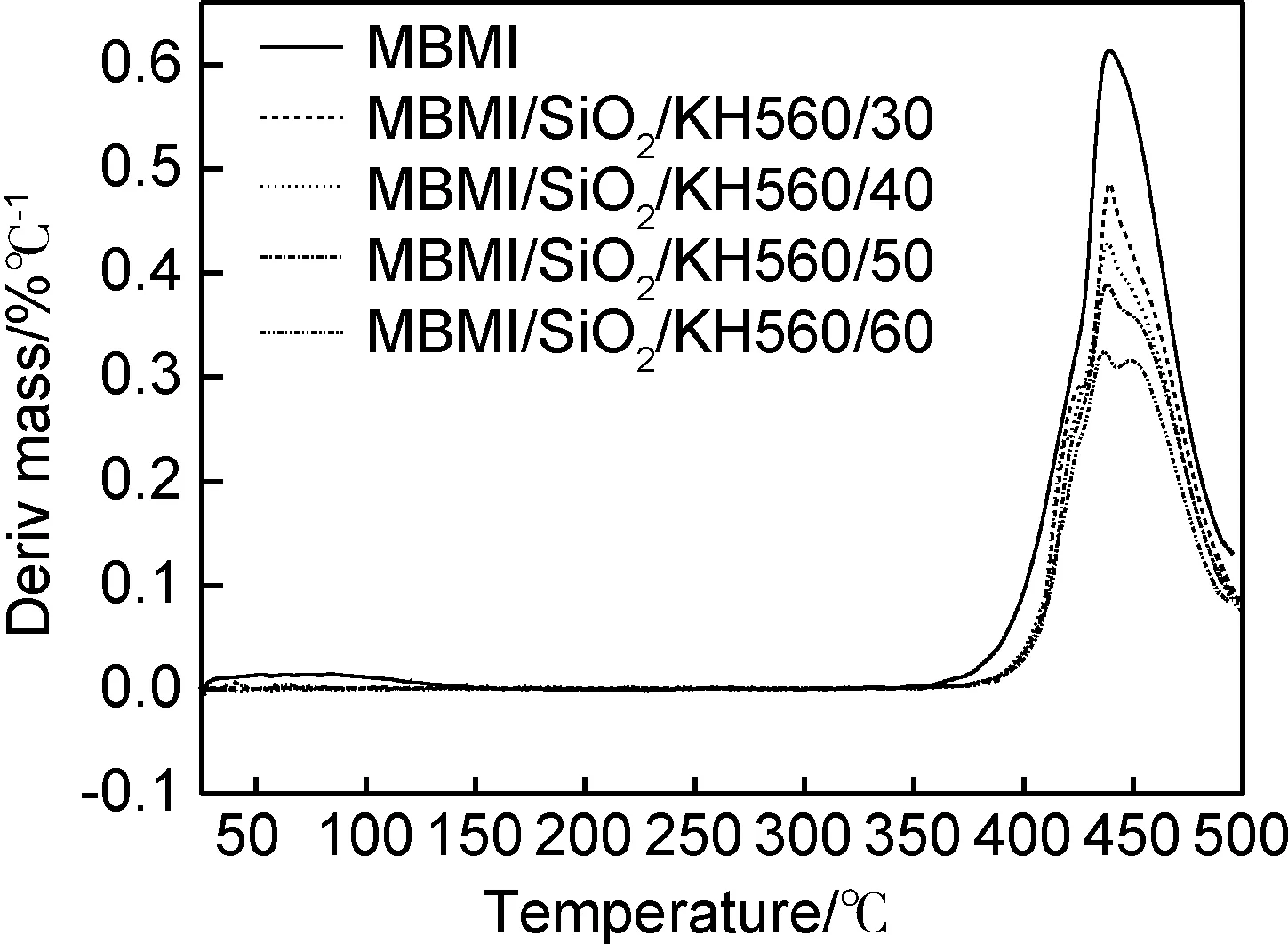
图8 MBMI/SiO2/KH560/N体系基材的DTG曲线图Fig.8 DTG curves of MBMI/SiO2/KH560/N boards
3 结论
(1) 在烯丙基改性双马来酰亚胺树脂基体中加入SiO2,可以有效地提高覆铜板基材的综合性能,与未添加SiO2相比,具有更高的存储模量、更低的热膨胀系数和更高的热稳定性。
(2) 采用KH560表面处理的SiO2/双马来酰亚胺树脂体系,较表面处理剂为KH550,KH570及未表面处理的SiO2/双马来酰亚胺树脂体系具有更好的流变特性,同一SiO2含量时体系具有更低的最低熔融黏度。
(3) 当SiO2含量为50%时,所制备的覆铜板基材具有优异的热机械性能,低的热膨胀系数和高的存储模量,其玻璃化转变温度以下的热膨胀系数α1仅为17 ×10-6℃,50℃时基材存储模量可达到33 GPa,相较于未添加二氧化硅时的43×10-6℃和18 GPa,分别降低了153%和提高了83%。
[1] 周文木,徐杰栋,吴梅珠,等. IC封装基板超高精细线路制造工艺进展[J].电子元件与材料,2014,33(2): 6-9.
(ZHOU W M,XU J D,WU M Z,etal. Develop of manufacture techniques of IC package substrate ultra-fine lines[J].Electronic Components and Materials, 2014,33(2): 6-9.)
[2] 王慧秀,何为,何波,等. 高密度互连(HDI) 印制电路板技术现状及发展前景[J].世界科技研究与发展,2006,28(4):14-18.
(WANG H X, HE W, HE B,etal. Present state and perspectives for print circuit board technology of high density interconnection[J]. World Sci-Tech R&D, 2006,28(4):14-18).
[3] 陈永生. 任意层互连印制板工艺发展路线[J].印制电路信息, 2013(4): 16-20.
(CHEN Y S. The technical development roadmap of any layer interconnection PCB[J]. Printed Circuit Information, 2013(4): 16-20.)
[4] 李全步,胡程耀,叶炜,等. 双马来酰亚胺改性酚醛型环氧树脂性能研究[J]. 航空材料学报,2008,28(2):82-86.
(LI Q B, HU C Y, YE W,etal. Study on properties of phenol type epoxy resin modified by bismaleimide[J]. Journal of Aeronautical Materials, 2008,28(4):82-86.)
[5] 梁丹,梁国正,王九成. 双马来酰亚胺树脂增韧改性研究新进展[J]. 材料导报,2007,21(9):77-79.
(LIANG D, LIANG G Z , WANG J C. A new review on toughening modification of bismaleimide resin[J].Material Review, 2007,21(9):77-79.)
[6] 孟涛,李玲,董风云.双马来酰亚胺树脂的增韧改性研究[J]. 化学与黏合,2005,27(1):43-45.
(MENG T, LI L,DONG F Y. Study on toughening and modifying of bismaleimide resin[J]. Chemistry and Adhesion, 2005,27(1):43-45.)
[7] 王敬锋, 苏民社, 孔凡旺,等. 双马来酰亚胺树脂体系在封装基板上的应用[J]. 绝缘材料, 2009, 42( 4):44-48.
(WANG J F, SU M S, KONG F W,etal. Application of modified bismaleimide resin in integrated circuits package substrate[J].Insulating Materials, 2009, 42(4):44-48.)
[8] 刘润山, 刘景民, 张雪平. 双马来酰亚胺/烯丙基苯基化合物/环氧化合物共聚树脂的研究与应用[J]. 绝缘材料, 2007 , 40(1):36-39.
(LIU R S, LIU J M , ZHANG X P. Preparation and application of the bismaleimide/ allylphenyl compound/ epoxide copolymers[J]. Insulating Materials, 2007, 40(1):36-39.)
[9] 祝大同.硅微粉填料在覆铜板中应用的研究进展[J]. 印制电路信息,2008(2):8-15.
(ZHU D T. Progress of research on micro silica filler for copper clad laminate[J]. Printed Circuit Information, 2008(2):8-15.)
[10]孟庆辉,顾嫒娟,梁国正,等. 超支化聚硅氧烷改性双马来酰亚胺树脂的研究[J]. 高分子学报,2010,10:1245-1250.
(MENG Q H,GU A J,LIANG G Zetal. Research on hyperbranched polysiloxane modified bismaleimide resin[J]. Acta Polymerica Sinica, 2010,10:1245-1250.)
[11]梁国正,蓝立文,王忠秀. 双马来酞亚胺树脂基体的改性[J]. 高分子材料科学与工程,1991(2):95-98.
(LIANG G Z, LAN L W, WANG Z X. Modification of bismaleimide resin system[J].Polymeric Materials Science and Engineering. 1991(2):95-98. )
[12]耿东兵,曾黎明,黎义,等,双马来酰亚胺树脂流变特性研究[J].润滑与密封,2007,32(1):149-151.
(GENG D B, ZENG L M, LI Y,etal. Studies on Rheological Behavior of Bismalemide Resin [J]. Lubrication Engineering, 2007,32(1):149-151.)
[13]曾光龙. FR-4覆铜板常见缺陷与解决方法[J]. 印制电路信息,2010(12):19-27.
(ZENG G L. Common defects & solutions of FR-4 copper clad laminate[J]. Printed Circuit Information, 2010(12):19-27.)
[14]陈晓东,李卫钢,林意敬. FR-4覆铜板产品次表面气泡成因探讨[J]. 印制电路信息,2007(12):38-41.
(CHEN X D, LI W G, LIN Y J. The research of cause about voids in subsurface of FR-4 CCL[J]. Printed Circuit Information, 2007(12):38-41.)
[15]杨艳,曾宪平. 二氧化硅在覆铜板中应用[J]. 印制电路信息,2004(7):18-22.
(YANG Y, ZENG X P. The silica using in copper clad laminate[J]. Printed Circuit Information,2004(7):18-22.)
(责任编辑:张 峥)
RheologyofPrepregandPropertiesofSilica/bismaleimideMatrixCopperCladLaminate
DAI Shankai, HUANG Ronghui, JI Lifu, CHEN Xiangxiu
(Shengyi Technology (Suzhou) Co., Ltd., Suzhou 215024, Jiangsu China)
The effects of the silica surface treated by coupling agents KH550, KH560 and KH570 on the rheological properties of bismaleimide (BMI) resin system were investigated. The rigidity, coefficient of thermal expansion (CTE) and thermal stability of the copper clad laminate (CCL) were studied by DMA, TMA and TGA. The resin system containing silica surface treated by KH-560, comparing to KH550, KH570 and without surface treatment resin system has better rheological properties and low melt viscosity. The comprehensive properties of the copper clad laminate can be effectively improved by the introduction of silica in the resin system, exhibiting higher storage modulus and lower CTE compare to no silica in the CCL. When the silica mass fraction is 50% , the storage modulus is increased by 83% at 50 ℃, and the CTE below the glass transition temperature is decreased by 153%.
rheological property;coefficient of thermal expansion;rigidity;BMI;CCL
2015-10-27;
2015-12-03
戴善凯(1983—),男,硕士,工程师,主要从事高性能树脂基覆铜板材料的研究,(E-mail)daisk@syst.com.cn。
10.11868/j.issn.1005-5053.2015.000209
TB332;TB331
: A
: 1005-5053(2017)04-0084-06
