大氢稀释逐层法制备纳米硅薄膜
2011-04-11王祥
王 祥
(韩山师范学院,广东潮州521041)
0 引言
硅颗粒根据其尺寸的大小不同可以分为多晶硅、微晶硅和纳米硅。多晶硅多用在大规模集成电路中作为栅极材料,微晶硅常用来作为制备高性能太阳能电池的原材料,而纳米硅则在现今广泛应用于各种纳米器件的研究,是纳米器件结构的核心部分。纳米硅晶粒的质量直接影响器件功能的实现和器件的性能,因而如何制备高密度、分布可控、尺寸一致的纳米硅量子点,是各种纳米器件研究中首先需要解决的问题。目前制备纳米硅结构的方法可以分为“自上而下”和“自下而上”两种类型。前者利用当今先进的超微加工技术,如光刻、电子束和聚焦离子束刻蚀等加工技术直接制备出纳米尺度的结构,后者则以原子和分子为单位,通过生长的方式来获得纳米尺度的量子点和量子线结构,如利用气相沉积或者分子束外延的方法,利用离子注入结合高温退火形成纳米晶粒和各种化学合成法。虽然这些技术都可以制备出纳米硅薄膜,但他们本身都存在缺点。“自上而下”方法需要借助精密仪器,像AFM(Atomic Force Microscopy)、SPM(Scanning Probe Microscopy)探头对原子分子进行直接搬运或控制,或者利用聚焦到几个纳米的电子束和离子束来“刻画”细微结构,故而仪器成本极为昂贵且操作条件苛刻,生产速度缓慢,无法满足大规模生产的需要,只能适用于小范围基础研究。离子注入技术得到的硅量子点的尺寸大小和分布不能很好地控制,化学合成的方法很难和现有的硅工艺兼容。
本文采用在PECVD系统中用大氢稀释逐层法(layer by layer)淀积技术在SiNx表面上自组装生长高密度、尺寸均匀的Si量子点结构。这种方法充分利用了氢气等离子体在薄膜淀积中诱导晶化作用(增强扩散和化学退火)和对非晶结构的选择刻蚀作用,能够在低衬底温度(小于300°C)的条件下,直接获得较为理想的自组装Si量子点结构(nc-Si:H薄膜)。更为重要的是,大氢稀释逐层法与大规模集成工艺的直接兼容,结合在PECVD系统中的原位生长可以获得良好的界面特性,为其在单电子器件中的应用奠定了重要基础。
1 大氢稀释逐层法制备纳米硅薄膜
等离子体增强化学气相沉积(Plasma enhanced chemical vapor deposition,PECVD)系统是一种广泛应用的生长系统,它利用射频功率源产生高频电磁场,使其中的各种反应气体分子获得足够的能量而电离分解,形成化学性质十分活跃的高能自由离子基团(或反应前驱体)。而这些高能自由离子基团在自建偏压或外加偏压驱动下撞击固体衬底表面,并通过化学吸附过程吸附在衬底表面。由于高能离子基团吸附过程中释放出大量热量而形成局部加热效应,反应基团与衬底表面之间或者吸附离子基团之间获得更高的反应活性,因而可以提高化学反应和淀积生长的速度。正是由于这样的反应机理,发生化学吸附淀积所需衬底域值温度可以大大降低。
在PECVD系统中,硅烷气体分子(SiH4)在高频射频源驱动下产生的高能电子的撞击下由气体分子电离成多种高能反应前驱体:H,SiH1,SiH2,SiH3等。电离产生各种前驱体所需能量如图1所示。其中SiH3前驱体所需要的电子能量最低,为8.75 eV。不同于其它前驱体,SiH3与SiH4的反应需要通过能量势垒较高的插入反应来完成,因此与SiH4的反应速率最小,在硅烷等离子体中是最主要的反应前驱体。
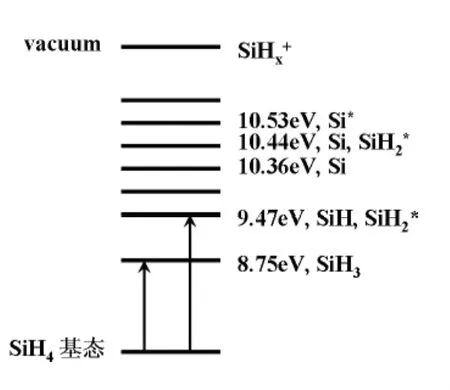
图1 PECVD系统中SiH4电离生成各种前驱体所需要的电子能量
Layer by layer生长技术是一种广泛应用的薄膜生长技术,它不同于常规的连续淀积薄膜的方法,它的生长过程是一个不连续的多周期生长过程。每个周期包括一个生长和一个刻蚀子周期,控制各子周期的生长时间,来平衡生长和刻蚀过程,获得理想的生长速度。用layer by layer生长技术制备nc-Si量子点的流程如图2所示。首先在PECVD系统中用大比例氢稀释的硅烷生长一层厚度仅为几个原子层的非晶层(a-Si)(T1时间段),其中含有一定的晶态硅成分;然后关闭硅烷气路,只通H2(T2时间段)。利用氢等离子体的剪裁作用来刻蚀掉一部分淀积的非晶硅;通H2刻蚀一段时间后,再通入硅烷气体,在经过氢等离子体刻蚀过的薄膜上继续生长包含有nc-Si的a-Si。重复以上的步骤几次,就可以获得含有nc-Si量子点的薄膜。

图2 大氢稀释LBL方法制备nc-Si量子点的工艺时间示意图
在本实验室以前系统研究该生长技术的基础上,我们经过多次试验,最后选用的参数是:先通入SiH4和H2混合气体生长T1=120s,获得一层超薄非晶硅层;然后关闭反应气体SiH4,继续通H2刻蚀T2=60s,利用氢等离子体的剪裁作用,在已生长的薄膜中形成纳米尺寸的硅晶粒。所用的功率为50W,总气压620 mttor,硅烷氢气流量比R=1/75,衬底温度250℃,重复10个周期。在该实验条件下,我们制备了厚度约5 nm的含有a-Si成分的nc-Si薄膜。
2 纳米硅薄膜结构表征
我们利用拉曼散射光谱研究了石英衬底上的样品,研究利用layer by layer生长技术制备的nc-Si薄膜的结晶情况和nc-Si量子点的情况,得到的谱线如图3所示。从图中可以看出在516.4cm-1波数处有一个明显的结晶峰,其来源于样品中nc-Si晶粒中的横向光学模(TO)的振动模式,这说明利用layer by layer生长技术生长的薄膜样品中的确存在nc-Si晶粒。在光谱的左侧还有一个小的抬起,它对应于nc-Si薄膜中残留的a-Si类横向光学模(TO-like)声子的散射。将拉曼光谱进行高斯分峰,可以得到单晶硅尖锐的晶化峰(520cm-1)和非晶硅弥散的非晶峰(480cm-1)。利用公式:

其中ρ0和ρm分别为拉曼散射光谱经高斯分峰得到的晶化峰和非晶化峰的面积,估算得到nc-Si薄膜的晶化比为40%。
此外,根据微观粒子的动量和位置的测不准关系,以及单晶硅的声子散射曲线,我们可以得到通过拉曼光谱来估算nc-Si晶粒平均尺寸的经验公式:

其中B=2.24 nm2/cm,Δω是晶化峰位置相对于单晶硅峰位的拉曼位移。将图3中的数据代入这个经验公式,可以估算薄膜中nc-Si晶粒的尺寸大约为5.1nm。
我们利用原子力显微镜(AFM)直接观测了不含上控制层的样品中nc-Si的形貌。图4为样品表面的AFM图片,图4(a)是清洗后的原始硅衬底表面图像,图4(b)为只淀积了氮化硅隧穿层和nc-Si层的样品的表面图像,它直接反映了nc-Si量子点的形貌。从图中我们可以看出,原始硅衬底的表面是平坦的。经过生长后,nc-Si量子点紧密地排列样品表面上,nc-Si形状基本上是球形的,尺寸分布也比较的均匀。这也说明了利用layer by layer生长技术生长的薄膜中成功制备出nc-Si量子点。通过处理,我们估算出nc-Si量子点的密度大约为2×1011cm-2,nc-Si晶粒的平均直径为15 nm。这比我们利用拉曼光谱估算的结果要大。有文献报道,利用AFM观测到的晶粒大小偏大,主要原因是AFM针尖的横向放大效应引起的,横向放大效应会使观测的结果偏大一倍以上。此外,nc-Si晶粒的表面还有可能有一些非晶成分的存在,这也会使AFM图像中nc-Si晶粒的尺寸偏大。

图4 样品表面AFM图片
我们所采用的大氢稀释逐层法在生长过程中一直保持很高的氢气稀释氛围,这主要是为了:
(1)充分利用氢等离子体的诱导晶化作用;
(2)增强氢等离子体的剪裁作用,尽量裁剪非晶硅中许多能量不稳定的结构。因为在SiH4和H2的混合气体生长的非晶硅(a-Si)层中存在许多能量不稳定的结构,主要是一些不稳定的非晶态成份和晶格缺陷(比如悬挂键等),活性的氢等离子体能够将这些不稳定的结构刻蚀掉,同时保留下那些能量稳定的结构(那些已经形成的晶态成份)。然而,为了实现淀积生长和氢等离子体的刻蚀作用(对晶态硅同样有一定的刻蚀作用)的平衡匹配,既不至于刻蚀太强,结构完全无法生长,也不至于生长太强获得太厚的非晶结构,以达到控制薄膜或纳米结构生长速度的目的,对于生长条件的参数控制尤为关键。在我们的实验中,除了对于衬底温度、反应气体压强和等离子体功率外,对生长/刻蚀子周期的时间比T1/T2,以及硅烷氢气流量比SiH4/H2的控制起到了关键作用。实验结果表明,在PECVD系统中,利用大氢稀释逐层法可以制备出高密度、尺寸分布较好的纳米硅薄膜。
[1]丁宏林,刘奎,王祥,等.控制氧化层对双势垒纳米硅浮栅存储器结构性能的影响[J].物理学报,2008(57):4482-4486.
[2]王久敏,陈坤基,宋捷,等.氮化硅介质中双层纳米硅薄膜的两级电荷存储[J].物理学报,2006(55):6080-6083.
[3]杨根,张丽伟,卢景霄,等.高气压下微晶薄膜的生长及微结构研究[J].人工晶体学报,2007(36):646-649.
[4]陈茂瑞,陈坤基.逐层法制备纳米硅薄膜及其特性[J].中国物理,1994(3):250 -254.
[5]左则文,闾锦,管文田,等.微晶硅薄膜的等离子增强化学气相沉积生长特征[J].南京大学学报:自然科学版,2008(44):392-400.
[6]郭学军,卢景霄,陈永生,等.甚高频高速沉积微晶硅薄膜的研究[J].物理学报,2008(57):6002-6006.
[7]郭维廉.硅-二氧化硅界面物理[M].北京:国防工业出版社,1989.
[8]程光煦.拉曼布里渊散射[M].北京:科学出版社,2001.
