投影光刻中相位光栅对准标记变形解决方案
2011-03-26殷履文盖玉喜
殷履文,盖玉喜
(中国电子科技集团公司第五十五研究所,南京210016)
相位光栅对准比较明场或暗场对准的方法,由于受不同工艺层的影响小,信噪比高,对准精度好等优点,广泛地被用于分步重复投影半导体光刻机中。世界上最大的投影光刻机制造商ASML在他们生产的投影光刻机中都运用了相位光栅对准的方法,但是传统的TTL(THROUGH THE LENS)同轴对准方式在对准标记发生变形时往往会产生对准偏差从而影响套刻(overlay)精度,而结合OA(OFF AXIS)离轴对准方式则可以有效解决这一缺陷。
1 对准标记变形原因分析
(1)随着半导体工艺技术的进步,圆片上的线条越来越细,已进入纳米级。所以在曝光工艺前涂在片子上的光刻胶的平整度应尽可能的好,这样在曝光时机器上的找平传感器(level sensor)才能正常工作。因此在涂胶之前圆片都要经过抛光处理。但是在抛光过程中往往会损坏圆片上的对准标记。
(2)有些半导体器件在生产过程中光刻工艺多达几十步,所以在刻蚀工艺中圆片上的对准标记也有可能被损坏。见图1。
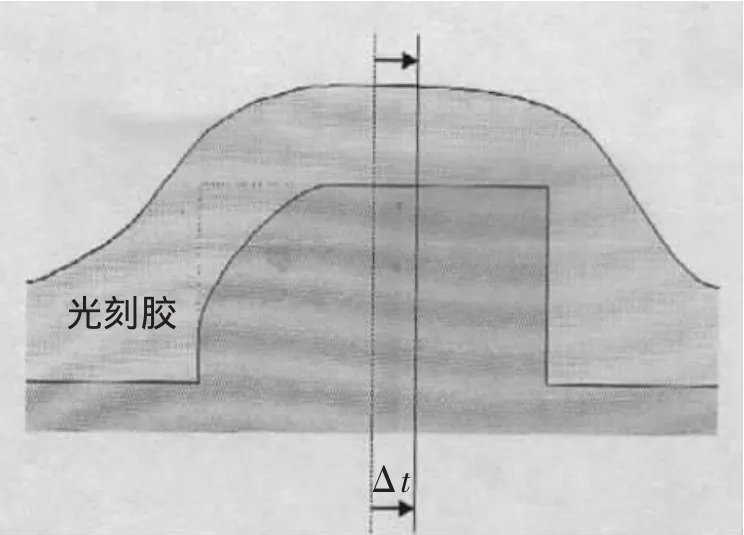
图1 变形的对准标记
2 与TTL对准模式比较
光学对准系统的主要功能是在套刻曝光前捕捉并对准掩模板-圆片的过零点,即测出圆片在机器坐标系中的坐标(X,Y,θ)和掩模板在机器坐标系中的坐标(X,Y,θ),并计算得到掩模板相对于圆片的位置,从而满足套刻的精度要求。在TTL对准模式中,在寻找对准位置的过程中扫描激光通过透镜折射回来的衍射光只有第一级次的信息被利用。当扫描激光入射到圆片上的对准标记时,由于光的衍射,折射效应,回到对准传感器的光分成很多级次。反映对准标记特征的衍射光只有第一级次回到掩模板的对准标记上,通过图2所描述的TTL扫描系统,我们能清楚地了解这种扫描方式的工作原理与过程。当机器作扫描对准时,圆片上的对准标记也随着曝光平台在移动,通过扫描监视器我们能看到明暗交替的光栅条纹。在机器的对准模块中专门有传感器(Quadcell)检测这一变化。其原理来自±1级衍射Fourier变换后的光强公式:

式中:I0为入射光强度,R为反射率,r为相位光栅上部线宽与下部线宽的比例,d为光栅深度,λ为对准激光波长。
由于片子上的对准标记在四个象限内都是8.0μm和8.8μm交替的光栅,所以在最终对准位置的±44μm范围内机器都能扫描到。扫描对准的精度因机器型号而一旦采用这种扫描方式一般都能控制在数十纳米以内。
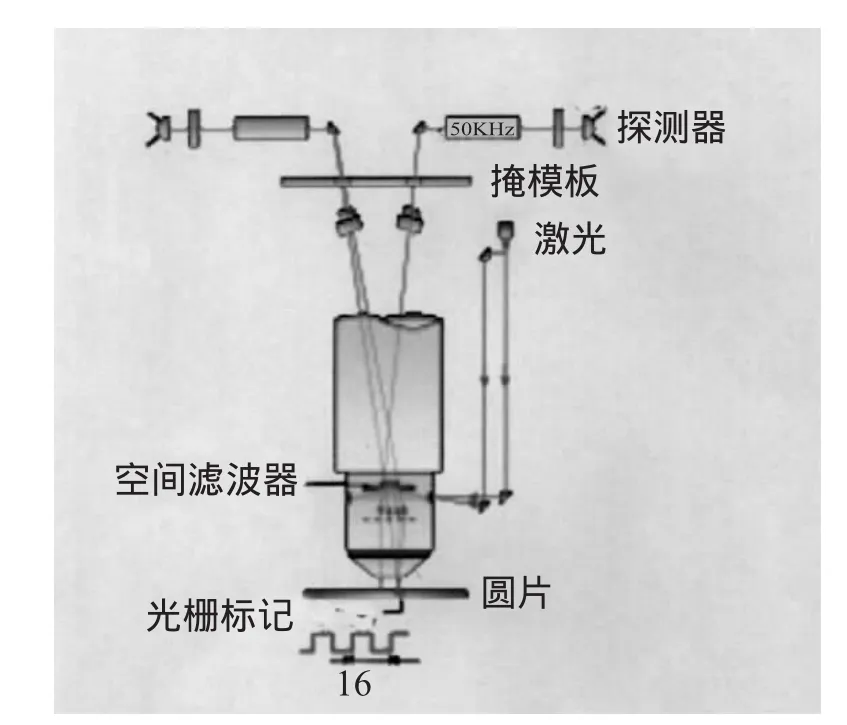
图2 TTL扫描系统示意图
如前文所述,当对准标记产生变形时变形的标记就会使TTL这种扫描方式错误计算对准位置,扫描激光入射到损坏的标记上通过光学透镜回到扫描传感器上的衍射光产生了偏移。而TTL扫描方式只利用了第一级次光的信息计算对准位置,所以最终的对准位置就会产生误差。这样就会使套刻精度产生更大的误差。
OA对准方式由于测量了更多级次的衍射光所以可以尽可能地修正这种误差。这种测量系统也叫ATHENA(advanced technology using high order enhancement of alignment)由于OA对准系统测量衍射光不经过成像透镜,所以它只能用来扫描圆片的位置,要扫描掩模板的位置还须利用其他的对准方式例如:TTL。
3 OA扫描系统分析
3.1 OA系统主要组成部分
◆光学部分
◆激光部分
◆控制部分
3.2 OA系统基本原理
OA系统利用两路不同波长的激光测量,激光的强度和片子上标记的深度和激光的波长有关,为了降低圆片上标记深度对扫描精度的影响,测量系统采用了两路激光,红光和绿光。相比于TTL扫描系统,OA扫描系统由于测量了更多级次的衍射光,从而得到了更多表现圆片标记特征的信息。当激光束入射到一个光栅上就马上会分成很多级次。根据光栅的刻线宽度和光栅间距(占空比),有一些级次的衍射光会消失。如果刻线宽度与光栅间距相等,那么就只有奇数级衍射光束存在。这跟Fourier发现的电场信号的情况相类似:它表现为一个电场信号可以按照谐波展开来进行分析。所有的谐波又可以重新合成出初始信号。类似的现象对光也适用。所有的+级和-级的的衍射光可以合成出原来的图像,圆片上的扫描标记可以看成是我们原来的图像。圆片扫描标记的光栅条具有50%的占空比,所以只有级数级次的衍射光是可见的(1,3,5……)
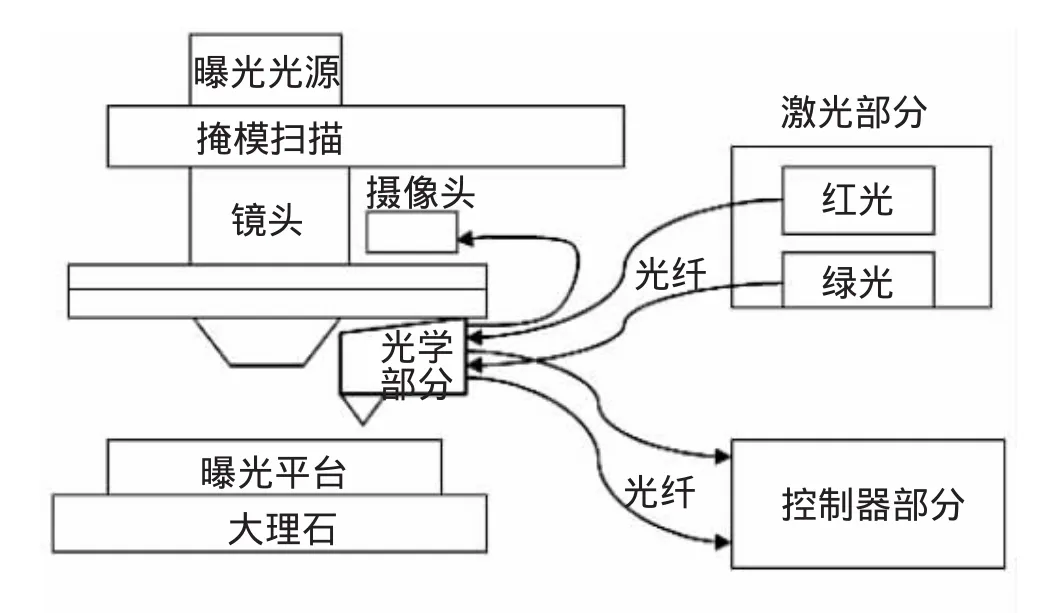
图3 OA扫描系统示意图
图4描述了扫描红、绿激光照射到对准标记后各级次衍射光到达参考光栅和探测器的简要光路。OA系统由于测量了更高级次的衍射光,可以修正机器扫描对准位置时产生的误差。在TTL对准系统中最终的对准位置是圆片上的标记与掩模板上的标记完全重合,在OA系统中,由于测量激光不经过成像透镜,所以它的最终对准位置是圆片上的标记与位于光学部件中的参考标记(如图5所示)完全重合。而采用两组光栅(8μm和8.8μm)可以扩大机器的扫描捕获范围。
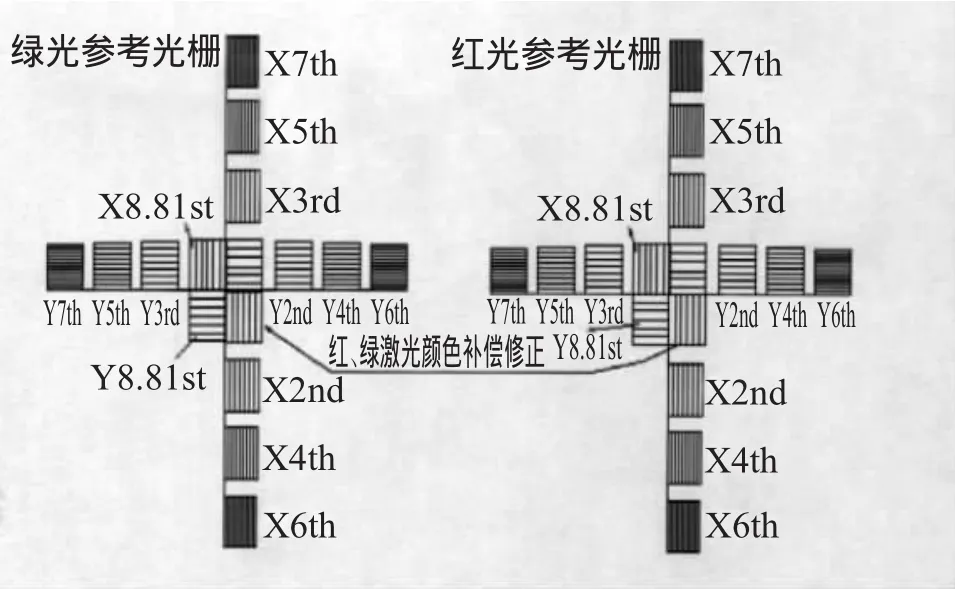
图5 参考对准标记
3.3 OA系统全扫描过程
很明显OA对准系统不能扫描掩模板的位置,所以当机器进行全扫描时用TTL系统扫描掩模板的位置,用OA系统扫描圆片的位置,由于这两种扫描系统都是独立工作的,所以在他们之间就要创建一种关联,如图6所示。
通过图6可以看到:机器做全扫描时,第一步是利用TTL系统扫描掩模板上的对准标记M1,M2和曝光平台上的对准标记F2得到掩模板的最终对准位置。第二步是通过F2在TTL系统和OA系统之间建立关联,F2的对准位置取决于OA系统光学部件中的参考对准标记。最后机器利用OA系统通过扫描圆片上的标记W1,W2得到圆片的最终对准位置。
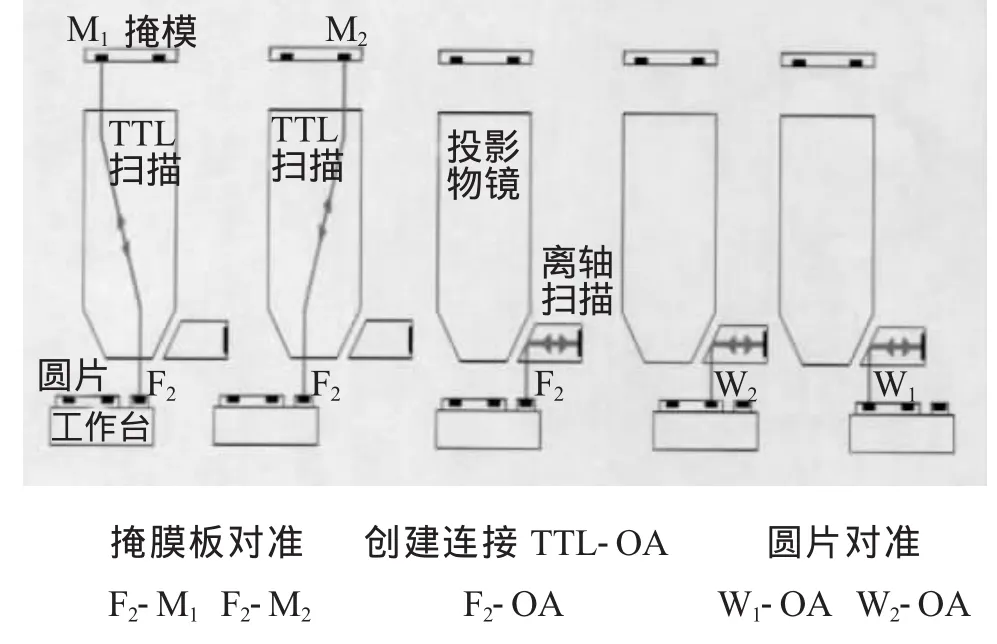
图6 OA系统全扫描方案
4 结 论
采用双波长激光光束照明对准标记,可以显著减小由于对准标记缺陷或多层掩模干涉对光学对准精度的影响。每一衍射级次的光信号采用单独的光电探测器进行探测,结合高功率激光器不仅可以保证对浅层掩模有足够的光强信号,而且可以更好地适应各种工艺条件对光学对准精度的影响。
[1]楼祺洪.激光在电子器件工业中的应用[J].电子器件,1999(1):1-4.
[2]梁友生,曹益平,邢廷文,光刻对准技术研究进展[J].电子工业专用设备,2004(10):30-34.
[3]陈伟明,胡松,刘业异等,光栅衍射式同轴对准系统中影响对准精度的因素分析[J].微细加工技术,2000(1):1-6
