场板结终端对金刚石SBD内部电场分布及击穿特性的影响
2016-10-10王进军王晓亮张景文
王进军,王晓亮,张景文,王 侠
(1.西安交通大学 陕西省信息光电子技术重点实验室,陕西 西安 710049;2.陕西科技大学 理学院,陕西 西安 710021;3.中国科学院半导体研究所 半导体材料科学重点实验室,北京 100083;4.西安科技大学 电气与控制工程学院,陕西 西安 710054)
场板结终端对金刚石SBD内部电场分布及击穿特性的影响
王进军1,2,王晓亮1,3*,张景文1,王侠4
(1.西安交通大学 陕西省信息光电子技术重点实验室,陕西 西安710049;2.陕西科技大学 理学院,陕西 西安710021;3.中国科学院半导体研究所 半导体材料科学重点实验室,北京100083;4.西安科技大学 电气与控制工程学院,陕西 西安710054)
建立了场板结终端对金刚石肖特基势垒二极管(SBD)的数值模拟模型,采用Silvaco软件中的器件仿真工具ATLAS模拟了场板长度L、绝缘层厚度TOX、衬底掺杂浓度NB、场板结构形状对器件内部电场分布以及击穿电压的影响,并对结果进行了物理分析和解释。结果表明:当TOX=0.4 μm、NB=1015cm-3、L在0~0.2 μm范围内时,击穿电压随着L的增加而增加;L>0.2 μm后,击穿电压开始下降。当L=0.2 μm、NB=1015cm-3、TOX在0.1~0.4 μm范围内时,击穿电压随着TOX的增加而增加;TOX>0.4 μm后,击穿电压开始下降。当L=0.2 μm、TOX=0.4 μm、NB=1015cm-3时,器件的击穿电压达到最大的1 873 kV。与普通场板结构相比,采用台阶场板可以更加有效地提高器件的击穿电压。
场板结终端; 金刚石SBD; 电场分布; 击穿电压
*Corresponding Author,E-mail:xlwang@semi.ac.cn
1 引 言
与传统半导体材料Si、Ge、GaAs相比,金刚石以其优良的电学和热学特性成为制造高温、大功率、高频微波及抗辐照电子器件的理想材料[1-2]。然而在平面工艺所制备的半导体器件中,结总是有限大小的,存在中断界面,并且在边角之处的结面近似于柱面或球面,而并非是理想的平面。正是由于结面在边角区域的曲率大的影响,其峰值电场尤其是表面区域的峰值电场比体内高,击穿通常发生在表面,导致器件的耐压常常由表面击穿所决定,实际的平面结的击穿电压要低于理想的平面结击穿电压[3-5]。为了提高器件的击穿电压,工程上常常采用一些特殊的表面造型(结终端)来增加曲率半径,使器件表面的峰值电场降低,其中最常见的一种结终端就是场板[6-7]。
本文采用Silvaco软件中的器件仿真工具ATLAS编辑了场板结终端金刚石肖特基势垒二极管(SBD)的器件结构,模拟了场板长度、绝缘层厚度、衬底掺杂浓度、场板结构形状对器件内部电场分布以及击穿电压的影响。研究结果对场板结终端金刚石SBD的优化设计提供了必要的指导。
2 场板结终端金刚石SBD数值模拟模型
由于肖特基二极管的二维结构左右是对称的,所以为了提高数值计算的速度和精度,仿真的结构取为实际结构的1/2。采用Silvaco的器件仿真工具Atlas编辑得到的场板金刚石肖特基二极管结构如图1所示。器件中金刚石选择用掺硼的P型金刚石薄膜,厚度为12 μm;肖特电极金属采用Au实现,厚度为2 μm;欧姆电极金属采用Ti实现,厚度为1 μm;绝缘层材料为SiO2[8-9]。 图1中通过将主结边缘SiO2层上肖特基电极的Au加以延伸形成金属场板。
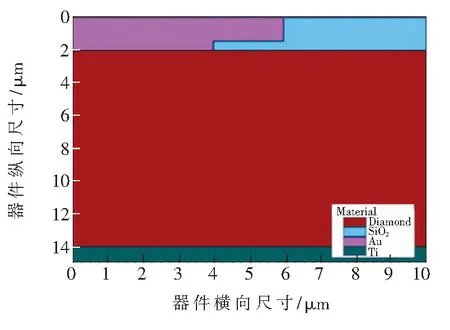
图1 场板结终端金刚石肖特基势垒二极管结构
Fig.1Structure of field plate terminal diamond Schottky barrier diode
3 场板结终端对金刚石SBD内部电场分布及击穿电压的影响
模拟金刚石肖特基势垒二极管的反向击穿电压时需要确定金刚石材料的碰撞电离系数。但目前对于金刚石材料的碰撞电离系数还没有统一、精确的数值[10]。在此次模拟中,电子碰撞电离系数αn=1.935×108,空穴碰撞电离系数αp=7.749×106。
3.1场板长度对器件内部电场分布及击穿电压的影响
当金刚石中硼掺杂浓度NB=1×1015cm-3、场板下SiO2绝缘层厚度TOX=0.4 μm、场板长度L分别为0.0 μm(即没有加金属场板)和1.0 μm时,器件内部电场分布的ATLAS数值模拟结果如图2所示。
从图2(a)中可以看出,没有加金属场板的器件中只有1个电场峰值,电场峰值位于器件主结边缘,即金刚石、SiO2和肖特基金属电极Ti的交点处。从图2(b)中可以看出,加有1.0 μm金属场板的器件中有2个电场峰值,一个位于器件主结边缘,另一个位于SiO2层中场板末端的拐角位置处。
图3分别给出了NB=1×1015cm-3、TOX=0.4 μm、场板长度L=0.0,1.0,2.2 μm时的器件内部电场的三维分布ATLAS数值模拟结果。从图3(a)中可以看出,没有加金属场板的器件主结边缘电场峰值约为1.4×105V/cm;从图3(b)中可以看出,加有1.0 μm金属场板的器件主结边缘电场峰值约为1.1×105V/cm,场板末端的拐角位置处电场峰值约为9.5×104V/cm;从图3(c)中可以看出,加有2.2 μm金属场板的器件主结边缘电场峰值和场板末端的拐角位置处电场峰值大致相等,约为1.0×105V/cm。

图2NB=1×1015cm-3、TOX=0.4 μm时,器件内部的电场分布。(a)L=0 μm;(b)L=1.0 μm。
Fig.2Distribution of the electric field inside the device when NB=1×1015cm-3,TOX=0.4 μm.(a)L=0 μm.(b)L=1.0 μm.
可见,加了金属场板后器件主结边缘电场峰值明显小于不加场板的常规器件。这主要是因为器件外加反向偏压后,金刚石表面的耗尽区向场板边缘扩展,使得器件表面耗尽层展宽,降低了耗尽层的曲率,扩大了电场线的空间分布,减小了电场线密度,缓解了电场集中效应,从而使得器件主结峰值电场降低。
器件击穿电压随场板长度变化的ATLAS模拟结果如图4所示。从图4中可以看出,击穿电压随着场板长度的增加而先变大后变小,当NB=1×1015cm-3、TOX=0.4 μm、L=0.2 μm时,肖特基二极管的击穿电压达到最大的1 873 kV。这主要是因为随着场板长度的增加,金刚石中的电场峰值逐渐减小,SiO2层中电场峰值逐渐增加。器件的击穿电压开始会随着金刚石中电场强度的减小而增大,但这种增大不能一直持续下去。随着SiO2层中电场强度达到其临界击穿电压,SiO2发生击穿,场板失去作用,导致器件击穿电压下降。可见设计器件时,场板的长度不能太长也不能太短,需要进行优化设计。

图3NB=1×1015cm-3、TOX=0.4 μm时,器件内部电场的三维分布。(a)L=0 μm;(b)L=1.0 μm;(c)L=2.2 μm。
Fig.33D distribution of the electric field inside the device when NB=1×1015cm-3,TOX=0.4 μm.(a)L=0 μm.(b)L=1.0 μm.(c)L=2.2 μm.

图4NB=1×1015cm-3、TOX=0.4 μm时,器件击穿电压随场板长度的变化。
Fig.4Breakdown voltage of device changes with the length of the field plate when NB=1×1015cm-3,TOX=0.4 μm.
3.2绝缘层厚度对器件内部电场分布及击穿电压的影响
当金刚石中硼掺杂浓度NB=1×1015cm-3、场板长度L=0.2 μm、金属场板下SiO2绝缘层厚度TOX分别为0.1 μm和1.0 μm时,器件内部电场的三维分布ATLAS模拟数值结果如图5所示。从图5可以看出,TOX较小时,SiO2层中的电场峰值比较大。这主要是因为加了肖特基Ti金属场板以后,在场板的延伸区由Ti、SiO2和金刚石形成了一个MIS电容,SiO2层充当电容层间绝缘介质。所以在施加相同电压时,TOX较小时的绝缘层内部电场强度较大。
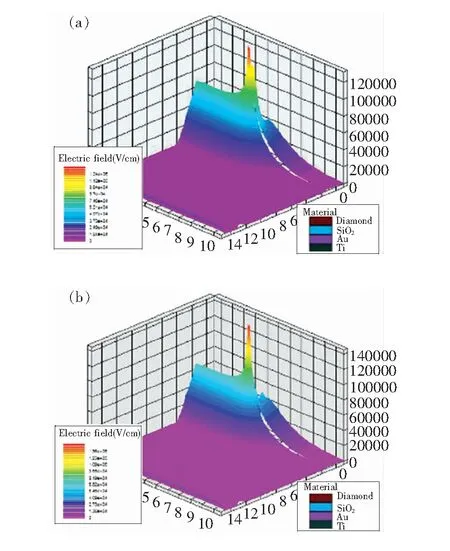
图5NB=1×1015cm-3、L=0.2 μm时,器件内部电场的三维分布。(a)TOX=0.1 μm;(b)TOX=1.0 μm。
Fig.53D distribution of the electric field inside the device when NB=1×1015cm-3,L=0.2 μm.(a)TOX=0.1 μm.(b)TOX=1.0 μm.
当NB=1×1015cm-3、场板长度L=0.2 μm时,器件击穿电压随金属场板下SiO2层厚度TOX的变化如图6所示。从图6中可以看出,击穿电压随着SiO2层厚度TOX的增加先增大后减小,在TOX=0.4 μm时达到最大。这主要是因为在施加相同电压时,SiO2层越厚则绝缘层内的电场强度越小,电场不足以使得金刚石表面耗尽,导致耗尽层变薄,器件击穿电压下降。因此,金属场板下SiO2层的厚度太厚或太薄都不利于击穿电压的提高,存在一个优化取值范围。

图6NB=1×1015cm-3、L=0.2 μm时,击穿电压随绝缘层厚度的变化。
Fig.6Breakdown voltage of device changes with the thickness of the insulating layer when NB=1×1015cm-3,L=0.2 μm.
3.3掺杂浓度对器件内部电场分布及击穿电压的影响
当场板长度L=0.2 μm、金属场板下SiO2绝缘层厚度TOX=0.4 μm、金刚石中硼掺杂浓度NB分别为5×1014cm-3和5×1015cm-3时,器件内部电场的三维分布ATLAS模拟数值结果如图7所示。从图7可以看出,NB较大时,器件主结的电场峰值比较大,近似为NB=5×1014cm-3时的2倍。这主要是因为金刚石中硼掺杂浓度越高,则主结下耗尽区越窄,耗尽区曲率半径越小,电场越集中,峰值电场越大,如图8所示。
当场板长度L=0.2 μm、金属场板下SiO2绝缘层厚度TOX=0.4 μm时,器件击穿电压随金刚石中硼掺杂浓度NB的变化如图9所示。从图9中可以看出,击穿电压随掺杂浓度的变化出现2个峰值,其中右边峰值对应主结附近击穿电压与掺杂浓度的变化关系,左边峰值对应场板末端拐角处击穿电压与掺杂浓度的变化关系。不管是主结还是场板末端拐角处,当掺杂浓度NB太低或者太高时,器件的击穿电压都比较低。这主要是因为NB越低,则耗尽区越宽,载流子加速时间越长,从电场获取能量越大,碰撞电离越显著,器件越容易发生雪崩击穿;NB浓度太高,则耗尽区越窄,此时隧道效应越显著,器件越容易发生齐纳击穿。可见制备器件时金刚石中硼掺杂浓度NB不能太高也不能太低,有一个优化取值范围。

图7TOX=0.4 μm、L=0.2 μm时,器件内部电场的三维分布。(a)NB=5×1014cm-3;(b)NB=5×1015cm-3。
Fig.73D distribution of the electric field inside the device when TOX=0.4 μm,L=0.2 μm.(a)NB=5×1014cm-3.(b)NB=5×1015cm-3.

图8TOX=0.4 μm、L=0.2 μm时,器件内部的电场分布。(a)NB=5×1014cm-3;(b)NB=5×1015cm-3。
Fig.8Distribution of the electric field inside the device when TOX=0.4 μm,L=0.2 μm.(a)NB=5×1014cm-3.(b)NB=5×1015cm-3.

图9TOX=0.4 μm、L=0.2 μm时,器件击穿电压随金刚石中硼掺杂浓度的变化。
Fig.9Breakdown voltage of device changes with the concentration of boron doping in diamond when TOX=0.4 μm,L=0.2 μm.
3.4场板形状对器件内部电场分布的影响
由于场板末端的绝缘层中电场峰值的影响,绝缘层很容易发生提前击穿,导致器件的击穿电压降低。为进一步提高器件击穿电压,本文中设计了一种台阶场板结构,如图10所示。与普通场板不同,台阶场板的金属和绝缘层的交界面不是竖直的,而是普通场板分成了5个台阶。因而绝缘中的电场峰值也不再是一个,在各个拐角位置都出现了电场峰值。

图10 台阶场板金刚石SBD
图11给出了台阶场板和普通场板金刚石SBD内部电场的三维分布。从图11(a)中可以看出,绝缘层中电场峰值数目与台阶的数目相同,电场峰值分别位于各个台阶的拐角处,台阶场板器件中主结电场峰值约为1×105V/cm;而在相同参数下,普通场板器件中的电场峰值约为1.2×105V/cm。结果表明,台阶场板的电场峰值比普通场板明显降低,降低的部分由台阶拐角处的电场峰值分担,采用台阶场板可以进一步提高金刚石SBD的击穿电压。

图11器件内部的电场三维分布。(a)台阶场板;(b)普通场板。
Fig.113D distribution of the electric field inside the device.(a)Steps field plate.(b)Ordinary field plate.
4 结 论
在建立了场板结终端对金刚石SBD的数值模拟模型的基础上,采用Silvaco软件中的器件仿真工具ATLAS模拟了场板长度L、绝缘层厚度TOX、衬底掺杂浓度NB、场板结构形状对器件内部电场分布以及击穿电压的影响,并对结果进行了物理分析和解释。结果表明:场板长度L、绝缘层厚度TOX、衬底掺杂浓度NB对器件内部电场分布以及击穿电压的影响规律基本一致。TOX=0.4 μm、NB=1015cm-3、L在0~0.2 μm范围内时,击穿电压随着L的增加而增加;L>0.2 μm后,击穿电压开始下降。L=0.2 μm、NB=1015cm-3、TOX在0.1~0.4 μm范围内时,击穿电压随着TOX的增加而增加;TOX>0.4 μm后,击穿电压开始下降。L=0.2 μm、TOX=0.4 um、NB=1015cm-3时,器件的击穿电压达到最大的1 873 kV。与普通场板结构相比,采用台阶场板可以更加有效地提高器件的击穿电压。以上研究结果对场板结终端金刚石SBD的优化设计提供了必要的指导。
[1] JAYANT BALIGA B.Fundamentals of Power Semiconductor Devices [M].New York:Springer,2008:112-188.
[2] CHOW T P,TYAGI R.Wide bandgap compound semiconductors for superior high-voltage unipolar power devices[J].IEEE Trans.Electron.Dev.,1994,41(8):1481-1483.
[3] NAWAWI A,TSENG K J,RUSLI G A J,et al..Design and optimization of planar mesa termination for diamond Schottky barrier diodes [J].Diam.Relat.Mater.,2013,36:51-57.
[4]BLANK V D,BORMASHOV V S,TARELKIN S A,et al..Power high-voltage and fast response Schottky barrier diamond diodes [J].Diam.Relat.Mater.,2015,57:32-36.
[5]FAGGIO G,MESSINA G,SANTANGELO S,et al..Raman scattering in boron-doped single-crystal diamond used to fabricate Schottky diode detectors [J].J.Quant.Spectrosc.Radiat.Trans.,2012,113(18):2476-2481.
[6]MURET P,VOLPE P N,TRAN-THI T N,et al..Schottky diode architectures on p-type diamond for fast switching,high forward current density and high breakdown field rectifiers [J].Diam.Relat.Mater.,2011,20(3):285-289.
[7] ACHARD J,ISSAOUI R,TALLAIRE A,et al..Freestanding CVD boron doped diamond single crystals:A substrate for vertical power electronic devices? [J].Phys.Stat.Sol.(a),2012,209(9):1651-1658.
[8] UMEZAWA H,NAGASE M,KATO Y,et al..Diamond vertical Schottky barrier diode with Al2O3field plate [J].Mater.Sci.Forum,2012,717-720:1319-1321.
[9] IKEDA K,UMEZAWA H,TATSUMI N,et al..Fabrication of a field plate structure for diamond Schottky barrier diodes [J].Diam.Relat.Mater.,2009,18(2-3):292-295.
[10] KONE S,DING H,SCHNEIDER H,et al..High performances CVD diamond Schottky barrier diode-Simulation and carrying out [C].Proceedings of The 13th European Conference on Power Electronics and Applications,Barcelona,Spain,2009:1-8.

王进军(1980-),男,陕西礼泉人,博士研究生,讲师,2007年于西北大学获得硕士学位,主要从事宽禁带半导体材料生长与器件制备的研究。
E-mail:wangjinjun6113@126.com

王晓亮(1963-),男,陕西渭南人,博士,研究员,1995年于中国科学院西安光学精密机械研究所获得博士学位,主要从事Ⅲ-Ⅴ族氮化物宽禁带半导体信息功能材料的外延生长、物理与器件制备以及材料生长关键设备MOCVD的研究。
E-mail:xlwang@semi.ac.cn
Influence of Field Plate Terminal on The Electric Field Distribution and Breakdown Characteristics of Diamond SBD
WANG Jin-jun1,2,WANG Xiao-liang1,3*,ZHANG Jing-wen1,WANG Xia4
(1.Shaanxi Key Laboratory of Photonics Technology for Information,Xi’an Jiaotong University,Xi’an 710049,China;2.College of Science,Shaanxi University of Science & Technology,Xi’an 710021,China;3.Key Laboratory of Semiconductor Materials Science,Institute of Semiconductors,Chinese Academy of Sciences,Beijing 100083,China;4.College of Electrical and Control Engineering,Xi’an University of Science & Technology,Xi’an 710054,China)
Numerical simulation model of field plate termination diamond Schottky barrier diode(SBD) was established in this paper,the influence of the field plate length L,insulating layer thickness TOX,substrate doping concentration NB,and the structure shape of the field plate on the electric field distribution inside the device and the influence of breakdown voltage of diamond SBD were numerical simulated by Silvaco device simulation tools ATLAS.The results of numerical simulation were analyzed and explained physically.The breakdown voltage increases with the increasing length of the field plate within the range of 0.0 to 0.2 μm when TOX=0.4 μm and NB=1015cm-3,and decreases when L>0.2 μm.The breakdown voltage increases with the increasing of insulating layer thickness TOXwithin the range of 0.1 to 0.4 μm when L=0.2 μm and NB=1015cm-3,and decreases when TOX>0.4 μm.The breakdown voltage of the device reaches its maximum 1 873 kV when L=0.2 μm,TOX=0.4 μm,and NB=1015cm-3.The steps field plate can effectively improve the breakdown voltage of the device,compared with the ordinary field plate structure.
field plate termination; diamond Schottky barrier diode; electric field distribution; breakdown voltage
2015-12-21;
2016-01-18
2015年陕西省教育厅专项科研计划(15JK1096)资助项目
1000-7032(2016)04-0432-07
TN383+.1
A
10.3788/fgxb20163704.0432
