Zn杂质诱导GaInP/AlGaInP红光半导体激光器量子阱混杂的研究
2024-01-29何天将刘素平李伟林楠熊聪马骁宇
何天将,刘素平,李伟,林楠,熊聪,马骁宇
(1 中国科学院半导体研究所 光电子器件国家工程研究中心,北京 100083)
(2 中国科学院大学 材料科学与光电技术学院,北京 100049)
0 引言
大功率红光半导体激光器发展迅速,凭借其体积小、功耗低、成本低廉、易于集成等优点而广泛应用于光盘存储、医疗、激光显示和泵浦源等方面[1]。随着大功率激光器的光电转换效率和输出功率不断提高,量子阱区的光功率密度已超过1010W/cm3,发生在激光器腔面处的光学灾变损伤(Catastrophe Optical Damage,COD)效应对激光器造成的影响日益严峻,为此,可通过量子阱混杂后处理工艺在腔面处制作非吸收窗口(Non-absorption Window,NAW)来提高COD 阈值以增大输出功率。量子阱混杂首先通过一定的技术手段对外延层表面做处理,然后在高温退火条件下,促使半导体激光器中量子阱和量子垒发生组分互扩散[2,3],从而改变量子阱区的组分组成,减少对输出光的吸收,形成对光的“透明”,使腔面处达到降低温度的目的。Zn 在GaAs 基半导体激光器中扩散较快,因此,Zn杂质诱导量子阱混杂(Quantum Well Intermixing,QWI)颇受人们青睐。此外,根据HALLIBURTON L E[4]对ZnO 的高温退火实验,可以推断出在高温退火过程中ZnO 中产生大量Zn 间隙原子Zni和O 空位OV,且高温条件下,Zn 原子扩散系数要远大于O 原子[5],这为ZnO 介质提供Zn 原子诱导QWI 提供理论基础。
在诱导红光半导体激光器量子阱混杂方面,早在1997年,日本三菱电机采用ZnO 薄膜作为Zn杂质诱导源,在630 ℃、4~9 h 退火条件下对638 nm 红光激光器制作NAW,实现1 W 以内的连续输出[6]。2008-2012年,林涛[7,8]先后对670 nm、650 nm 红光激光器进行Zn杂质诱导,采用气态源闭管扩散方式,在520~580 ℃、20~120 min 退火条件下进行一系列QWI 实验,光致发光(Photoluminescence,PL)谱最大蓝移量为53 nm,制得的器件超过常规的无窗口结构激光器最大输出功率的两倍。2018年,朱振[9,10]使用化学气相沉积(Chemical Vapor Deposition,CVD)方法在外延片表面生长ZnO,采用固态扩Zn 方式,分别对640 nm、660 nm 波段激光器制作NAW,窗口处蓝移43 nm,器件最大输出功率达到1.4 W。本文在前人工作的基础上,通过磁控溅射ZnO 薄膜的方式,进行复合介质层杂质诱导QWI 实验,简化操作并降低制作成本。
1 Zn杂质诱导原理及仿真计算
QWI 技术中出现最早的是杂质诱导量子阱混杂技术(Impurity Induced Disordering,IID),在1981年由LAIDING W D[11]等研究Zn 在GaAs/AlGaAs 超晶格中扩散时发现。其研究意义在于Zn 扩散促使Al、Ga 原子发生互扩散的温度可以比本征状态下发生互扩散时所需的温度低约300 ℃,制作NAW 需要在同一晶圆片上进行选择性区域诱导,有选择地使不同区域处量子阱结构组成成分、有效折射率、禁带宽度发生改变,而Zn 的扩散可以通过TiO2、Si3N4等介质膜进行掩蔽,为制作NAW 提供可能。此后,相关扩散实验和诱导原理逐步被开展和解释说明[12,13],但有关扩散诱导QWI 的原理还需补充和完善。
1.1 Zn 的扩散机制
对于GaAs 基半导体激光器,Zn 在GaAs 中扩散时,会以两种方式存在。一种是占据晶格位点成为替位原子Zns,另一种是在是在间隙位成为间隙原子Zni,而Zni扩散要远远快于Zns,所以,在Zn 原子的扩散中,Zni占据主导地位。此外尽管Zns数量上占据优势,但总体上以Zni的扩散为主。Zni在扩散时,通常以Longini 机制和Kick-out 机制进行,分别如图1(a)和(b)所示。

图1 Zn 在GaAs 中的扩散机制示意图Fig.1 Schematic diagram of Zn diffusion mechanism in GaAs
根据激光器外延层从上至下的p-i-n 掺杂类型,Zn 进入p 型掺杂GaAs 时,由于费米能级效应[14],Zn 原子极易失去两个电子成Zn2+,此时,上述两种扩散机制为可表示为
式中,VⅢ和IⅢ分别代表Ⅲ族空位和Ⅲ族填隙原子,h+代表空穴。描述为:在Longini 机制中,Zni在快速扩散时占据一个Ⅲ族空位,成为替位原子;而在Kick-out 机制中,Zni则是通过将Ⅲ族原子撞离出晶格位点而成为替位原子。
Zn 扩散过程中,材料中的掺杂类型、掺杂浓度和材料本身都会影响Zn 扩散的距离。对GaAs、InP 分别进行Mg 和Si 掺杂,使用Silvaco TCAD 模拟680 ℃、30 min 下Zn 在GaAs 和InP 中的扩散,气氛设置为N2,模拟结果如图2、3所示。从图2 和3 中可以观察出,对于Mg 杂质之类p 型掺杂,随着掺杂浓度的提升,Zn 在GaAs 或InP 中扩散得越快,在相同时间条件下,扩散深度越深。而对于Si 之类的n 型掺杂,掺杂浓度的提升会阻碍Zn 的扩散。对于扩散材料本身,Zn 在GaAs 基外延片中的扩散要大于InP 基。
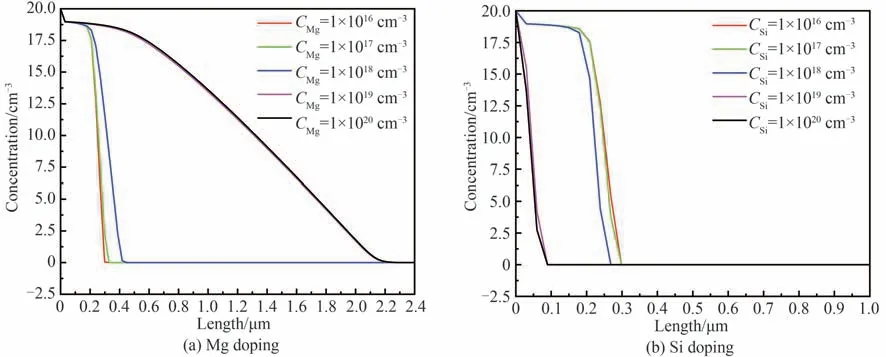
图2 680 ℃、30 min 条件下Zn 在GaAs 中的扩散Fig.2 Diffusion of Zn in GaAs under the condition of 680 ℃ and 30 min
1.2 介质层所施加的应变
采用ZnO 介质薄膜诱导QWI 主要分为两个过程,分别是杂质原子Zn 进入外延片表面源的过程,和Zn的高温推进扩散过程。热退火时,由于介质膜材料和外延片材料之间的热膨胀系数不同,会在不同材料之间产生热应力,而热应力过大会造成介质层破裂,对外延片引入大量缺陷和不容易去除介质层等问题。同时,热应力所产生的应变对Zn 扩散诱导QWI 也有重要影响,为此,可模拟在热退火环境下,介质层及外延片之间所产生的热应力。外延所用衬底为450 μm 厚的GaAs,整个外延层厚度约为2.8 μm,表层为200 nm 的GaAs 层。为了避免相对误差过大而导致模拟计算出现错[15],使用长度为100 μm,厚度为450 μm 的GaAs 来代替半导体激光器外延片,介质层厚度设置为100 nm。根据半导体材料GaAs、SiO2、Si3N4和ZnO 之间的杨氏模量、泊松比、密度及热膨胀系数等参数,使用COMSOL 模拟在630 ℃下ZnO 与GaAs 之间所产生的热应力,结果如图4所示。从图4 中可看出,此时在GaAs 表层产生张应力,而张应力的产生不利于GaAs 产生较多的Ga 空位缺陷[16]。那么对于QWI 进程来说,Zn 扩散进入GaAs 源中比较困难。另一方面,在外延片内部材料中,Zn、Ga、Al 原子的扩散程度也与空位间隙等点缺陷浓度有很强的正相关关系[17],为此,要较容易实现QWI,可采用复合介质层的方式来改变应力类型。由于SiO2、Si3N4材料热膨胀系数较小,可使用等离子增强化学气相沉积(Plasma Enhanced Chemical Vapor Deposition,PECVD)设备在ZnO 上层再生长一层SiO2或Si3N4。图5 模拟出复合介质层ZnO/SiO2和ZnO/Si3N4在630 ℃下在GaAs 上所产生的热应力。根据图示,可看出在复合介质层的作用下,ZnO 单一介质层所产生的张应力被抑制,在GaAs 表层产生了压应力。图6 为在模拟的基础上选取GaAs 表层处的应力数据。在只有单一介质层ZnO 的情况下,应力值约为0.56 MPa,在复合介质层ZnO/SiO2和ZnO/Si3N4的条件下,应力值分别为-0.47 MPa 和-2.51 MPa。而压应变则会有助于Ga 原子析出,从而留下大量Ga 空位,使QWI 过程得以更好地实现。

图4 带有ZnO 介质层的外延片退火时所产生的热应力Fig.4 Thermal stress generated during annealing of epitaxial wafers with ZnO dielectric layer
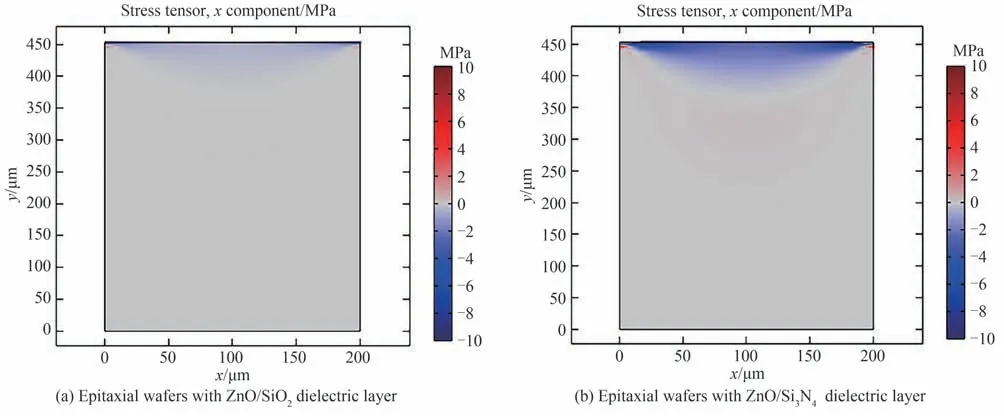
图5 带有ZnO/SiO2、ZnO/Si3N4介质层的外延片退火时所产生的热应力Fig.5 Thermal stress generated during annealing of epitaxial wafers with ZnO/SiO2 and ZnO/Si3N4 dielectric layers

图6 带有ZnO、ZnO/SiO2、ZnO/Si3N4介质层的外延片退火时所产生的热应力值Fig.6 Thermal stress values generated during annealing of epitaxial wafers with ZnO,ZnO/SiO2,and ZnO/Si3N4 dielectric layers
1.3 Zn 的缺陷形成能对扩散过程的影响
根据第一性原理模拟计算了Zn 在GaInP 和AlGaAs 中的缺陷形成能。使用投影缀加平面波(Projector Augmented Wave,PAW)计算,并在Vienna Ab-initio Simulation Package(VASP)模拟包中实现。交换相关泛函采用Perdew-Burke-Ernzehof 近似。将平面波基准的截止能量设置为400 eV,自洽计算直到能量变化小于1×10-6eV 才停止。缺陷形成能ΔHf计算公式为
式中,α代表缺陷种类,q代表缺陷带电量,Etot(α,q)和Etot(host)分别代表有缺陷和无缺陷的超胞总能量,εF代表参考到价带最大值(Valance Band Maximum,VBM)的电子库费米能级,且VBM 处能量为εVBM。Ei是相应元素形成最稳定固态或者气态时的单原子能量,μi为稳定固相或气相中的原子化学势,与原子能量Ei相关,ni表示形成缺陷时体系与原子库之间所交换的原子数,i表示第i个元素。缺陷形成过程中,能量为Ei+μi的ni原子与原子库交换,根据超胞的大小,采用2×2×2 Monkhorst-Pack 网格进行k点采样。所有原子都是松弛的,直到每个原子上的赫尔曼-费曼力小于0.2 eV/nm。Zn 扩散进入GaAs 后,要计算其缺陷形成能,首先是对扩散后GaAs 的n、p 型进行分析,一般来说,Zn 扩散完成后,GaAs 会形成p 型半导体,可首先考虑替位式掺杂,因为替代位杂质会使GaAs p 型增强,而间隙位杂质则会使GaAs n 型增强。对GaAs 进行建模,然后将Zn 原子分别替代Al、Ga、As 等原子。观察缺陷形成能量的变化,Zn 的缺陷形成能对于AlGaAs 和GaInP 三元化合物中Al、Ga、As 原子的占据,和Ga、In、P 原子的占据,数据见表1。

表1 在AlGaAs 和GaInP 材料中,Zn 取代各个原子时的缺陷形成能Table 1 The defect formation energy when Zn replaces each atom in AlGaAs and GaInP materials
根据表1 可知,对于欧姆接触层以下的限制层和波导层来说,为使Zn 较快扩散,可适当调节三元化合物中的原子组分,以增加量子阱混杂程度。同时这一过程也给出了量子阱混杂中主要参与扩散的原子。由于Zn 在取代V 族原子As 和P 过程中其缺陷形成能较大,所以参与扩散的原子主要是Ш 族原子Al 和Ga。扩散过程可以描述为:当Zn 原子扩散进入外延片材料中,大量Zn 原子进入间隙位迅速往下扩散,之后在Zn 原子的诱导下,Ga、Al 原子开始不断被Zn 取代,形成大量的Ga 间隙原子、Al 间隙原子、Ga 空位和Al 空位,这些间隙原子和空位继续往有源区扩散,最终使有源区量子阱GaInP 材料与量子垒AlGaInP 材料发生组分互扩散。
2 实验及结果分析
2.1 实验过程
实验所用样片由金属有机化学气相沉积(Metal Organic Chemical Vapor Deposition,MOCVD)设备制备的635 nm AlGaInP/GaInP 量子阱半导体激光器。外延结构从下至上分别为:200 nm 的GaInP 缓冲层,800 nm 的AlInP 下限制层,420 nm 的AlGaInP 下波导层,有源区(4.52 nm 的上下势垒层,12 nm 的GaInP 量子阱层),420 nm 的AlGaInP 上波导层,800 nm 的AlInP 上限制层以及200 nm 的GaAs 欧姆接触层。其中,p 型一侧采用Mg 掺杂,n 型一侧采用Si 掺杂。GaInP/AlGaInP 材料体系激光器采用张应变结构,在阈值电流和工作电流降低的同时效率也得到提高。此外,张应变的引入使价带能级发生分裂,宏观上表现为三谱峰。包含外延结构信息的半导体激光器器件结构示意图和原始外延片PL 光谱如图7所示。

图7 包含外延结构信息的半导体激光器器件结构示意图和原始外延片PL 光谱Fig.7 Schematic diagram of semiconductor laser device structure with epitaxial structure information and photoluminescence spectrum of the original epitaxial wafer
MOCVD 生长完样片后,在同一晶圆片上分别标记为样品1、样品2 和样品3。如图8所示,在样品1、样品2 和样品3 上首先使用磁控溅射设备生长100 nm 厚的ZnO,再进行光刻分区,去除增益发光区表面上的ZnO,对样品2 和样品3 再分别使用PECVD 分别生长100 nm 的Si3N4和100 nm SiO2的,再去除增益发光区表面上的ZnO、SiO2和Si3N4。将样品1、2 和3 分别截成6 mm×6 mm 的标准小块,使用快速退火设备(Rapid Thermal Processor,RTP)退火炉及管式炉分别进行热退火处理,随后对样片进行PL 谱测试。

图8 Zn 扩散制作非吸收窗口示意图Fig.8 Schematic diagram of Zn diffusion for the fabrication of non-absorbing window
2.2 结果及分析
使用RTP 设备对样品1 进行退火处理,退火时间设定为30 min,退火温度设定为580~680 ℃,ZnO 覆盖区域和未覆盖区域的PL 谱如图9所示。图10 为650 ℃ 30 min 退火条件下的PL 谱。
2.3 通气指标 两组患者PETCO2各个时间点比较,差异无统计学意义(P>0.05)。组间比较,B组Ppeak于T2-T5时明显高于A组,且差异有统计学意义(P<0.05); 同时间点,B 组 Pplat于 T2、T5时明显高于 A 组(P<0.05)。 见表 3。

图9 各个温度下ZnO 覆盖区和无ZnO 覆盖区的蓝移量Fig.9 Blue shift at various temperatures in ZnO-covered and ZnO-uncovered regions
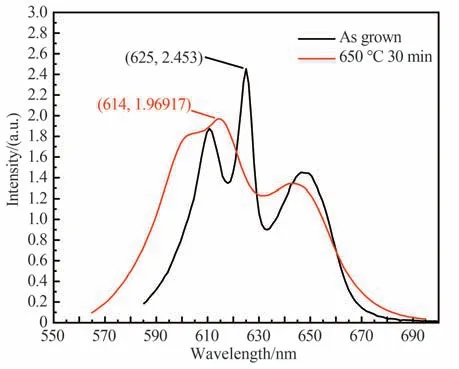
图10 样品在1 650 ℃、30 min 退火条件下PL 谱Fig.10 PL spectrum of sample under annealing conditions of 650 ℃ and 30 min
根据图9,可发现在ZnO 未覆盖区域,各个温度30 min 热处理条件下,样片PL 谱波峰基本无蓝移,PL 谱和图7(b)类似,这表明,仅通过在此温度范围下的热处理过程不会使样片发生明显变化。此外,在ZnO 所覆盖的窗口区域,波长有所蓝移,但蓝移范围最大值为11 nm,说明单一介质层ZnO 在诱导混杂过程中诱导程度较小。
根据Ga0.595In0.405P/Al0.313Ga0.277In0.41P 材料体系,当Zn 进入材料内部后,会对Al、Ga 原子进行替换,从而促使其组分进行相互扩散,最终使得有源区GaInP 逐渐向四元AlGaInP 过渡,使有源区禁带宽度变大,增益谱峰蓝移,对输出光形成透明窗口。
对样品2 进行热退火处理,实验结果如图11所示。实验发现,在ZnO/Si3N4介质层的作用下,蓝移量有所增加,在630 ℃、650 ℃ 30 min 条件下分别蓝移18.1 nm 和31.3 nm,在无ZnO/Si3N4介质层覆盖的区域下基本无蓝移。但由于Si3N4所施加的应力较大,在退火过程中出现介质膜皲裂的现象,如图12所示。介质膜的皲裂一方面会在材料内部引入过量缺陷,不利于器件性能的提升;另一方面,会对外延片表面形貌造成破坏。为此,在介质膜选取过程中,以选择ZnO/SiO2为主,即样品3。

图11 样品2 经不同温度处理后的PL 谱Fig.11 PL spectrums of sample after different temperature treatments

图12 应力过大导致的介质膜皲裂图Fig.12 Diagram of dielectric film cracking caused by excessive stress
对样品3 进行热退火处理,样品介质膜整体良好。各个温度下波峰值结果如图13所示。在620 ℃、650 ℃和680 ℃退火温度下,蓝移量分别达到10 nm、35 nm 和55 nm。温度过高不利于器件性能,为此可选择650 ℃。

图13 样品3 经不同温度处理后的峰值波长Fig.13 Peak wavelengths of sample 3 after different temperature treatments
为尽量减小高温退火对外延片性能质量的影响,采用循环退火处理的方案[18],采用620 ℃、30 min 的循环退火,循环次数为三次,结果如图14所示。在经过1~3 次循环退火后,蓝移量分别为10 nm、18.1 nm 和35.6 nm。在循环三次后,达到适宜的蓝移窗口(~30 nm)。从对样品2 和样品3 的退火结果来看,可以推测,Si3N4/SiO2所施加的应力促使Zn 粒子扩散进入GaAs 源中,以使材料内部Al、Ga 原子点缺陷发生互扩散,最终使量子阱量子垒材料混杂,达到非吸收窗口的效果。
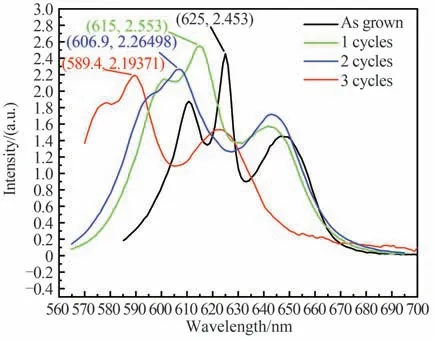
图14 样品3 在经过620 ℃、30 min 循环退火1~3 次后的PL 谱Fig.14 PL spectrums of sample 3 after 1~3 cycles of annealing at 620 ℃ in 30 min
在样片退火完成后,将样品1 和样品3 分别截成一块1 cm×1 cm 小块,将表面介质层去除,对外延片进行能谱仪(Energy Dispersive Spectrometer,EDS)测试,对样片材料中微区成分元素种类和含量进行分析,测试结果如图15所示。可以看出,测量后的样片中,除了外延样片本身所含有的元素外,还有一定量的Zn 元素,表明Zn 扩散进入外延片中。此外,可以观察到,样品3 的含Zn 量要大于样品1,表明在复合介质层ZnO/SiO2的退火过程中,更多的Zn 对Al、Ga 原子进行替位掺杂,QWI 程度整体要大于单一介质层ZnO。

图15 退火后样品1 和样品3 的EDS 图Fig.15 EDS maps of annealed sample 1 and sample 3
考虑在一维条件下,沿外延片生长方向为z方向,各组分原子浓度C随时间t变化遵从由质量守恒导出的Fick 第二定律[19],即
式中,D表示组分原子的扩散系数。
式中,Cb和Cw分别代表势垒区和势阱区中原子的组分浓度,h为量子阱宽度的一半。结合初始条件,根据Fick 第二定律,可推导出Al 原子在阱垒区中的分布式为

图16 Al 扩散不同距离后,量子阱内Al 元素的浓度Fig.16 Composition concentration of quantum well after Al diffusion at different distances
根据图16,Al 初始组分在量子垒中为0.313,在量子阱层中为0,随着Al 原子扩散长度的增加,阱垒区Al组分的浓度差逐渐减少。当Al 原子扩散长度为5 nm 时,量子阱区Al 组分浓度增加到0.124,量子阱中的GaInP 材料逐渐向四元AlGaInP 过渡。对量子阱量子垒材料GaInP/AlGaInP 进行增益谱峰模拟,其中量子阱材料由最初的Ga0.5In0.5P 逐渐变为Al0.15Ga0.35In0.5P,模拟结果如图17所示。从图17 中可以看出,当量子阱材料为GaInP 时,增益谱峰为619 nm 左右,随着热退火的进行,Al、Ga 原子发生互扩散现象,表现为量子垒中Al 原子逐渐向量子阱区扩散,当量子阱材料中Al 组分逐渐增加到0.15 时,材料的增益谱峰也逐渐蓝移到573 nm。

图17 材料增益谱峰随Al 组分的变化模拟结果Fig.17 Simulation results of the material gain spectral peaks with the changes of Al composition
为研究长时间(>9 h)低温条件下热退火对固态扩Zn 的影响,将样品3 各个标准小块放入常压管式炉中进行长时间低温退火,温度分别设置为520 ℃、550 ℃和580 ℃,时间设定为9 h。结果如表2所示。在三种温度下,蓝移量分别为0.9 nm、1.4 nm和24.8 nm,可以推测长时间低温热退火条件下,温度仍对量子阱混杂起着关键性作用。当把温度升高到620 ℃并把退火时间增加到14 h,此时蓝移量达到50 nm。经过实验和分析,在常压低温长时间退火处理条件下,可在580 ℃ 9 h 以上时间下制得NAW。

表2 长时间退火条件下的谱峰值和蓝移量Table 2 The peaks of PL spectrums and amount of blue shift under long-term annealing conditions
3 结论
研究了单一介质层ZnO 和复合介质层ZnO/Si3N4、ZnO/SiO2在635 nm GaInP/AlGaInP 半导体激光器量子阱混杂过程,发现ZnO/Si3N4和ZnO/SiO2复合介质层相比单一ZnO 介质层,具有更大的杂质诱导蓝移效果。在680 ℃ 30 min 的条件下,复合介质层ZnO/SiO2诱导的蓝移量达到了55 nm。此外,在扩散过程中,复合介质层ZnO/Si3N4和ZnO/SiO2能够改变单一介质层ZnO 所施加的应力类型,从而促进Zn 在激光器外延层中的扩散。Zn 在AlGaAs 和GaInP 中的缺陷形成能的计算结果表明Zn 更有利于占据AlGa 等Ⅲ族原子,对量子阱混杂的诱导原理进行了补充。探索出了使用ZnO/SiO2复合介质层在650 ℃ 30 min 条件下制备NAW 的适宜条件,为器件制作提供了理论和实验上的参考。这一研究不仅为半导体激光器性能的优化和制备提供了关键信息,还拓展了对复合介质层在量子阱混杂中作用机制的认识。
