CVD法无催化直接生长α-In2Se3纳米材料
2023-12-04苗瑞霞王业飞李田甜
苗瑞霞,杨 奔,王业飞,李田甜
(西安邮电大学 电子工程学院,陕西 西安 710121)
随着现代信息技术的高速发展,对光电信息的探测、识别、整合和输出显得尤为重要[1]。相变材料与硅光子技术的结合可以实现片上非易失性光存储,与其他类型存储器件相比,这类器件可以在设备没有外部能量提供的情况下持续保存数据信息[2-4]。在这些光存储材料中,硒化铟(In2Se3)受到了国内外研究者的高度重视。In2Se3是一类III-VI族半导体材料[5],其低的重组结构熵可以有效提高用于非易失性光子开关的能量效率和可擦写次数,因此,该材料在相变存储方面有着吸引力的发展前景[6-8]。除此以外,In2Se3由于具有优异的电学性能高响应速度以及适中且可调的直接带隙。In2Se3的电子迁移率约为104cm2V-1s-1,其可调的直接带隙为1.26 eV~2.7 eV[9-10],在例如太阳能电池、光电探测器、气体传感器和铁电场效应晶体管等[11-13]电子和光电子领域有着广泛的应用前景。
近些年来,研究人员在In2Se3样品的制备方面取得了丰富的研究成果,例如,机械剥离法[14]、脉冲激光沉积法[15]、分子束外延生长法[16]、物理气相沉积法[17]、磁控溅射法[18]和化学气相沉积(Chemical Vapor Deposition,CVD)法[19]等。利用机械剥离法所获得的二维In2Se3薄膜不仅表面平整,缺陷少,而且电子迁移率高,但是,这种方法存在制备效率低下、质量可控性较低以及容易引入杂质等问题[20-22]。利用分子束外延法在石墨烯上生长可获得高质量大面积α-In2Se3薄膜,然而,该方法生长时间长,大批量生长性能较差,对真空条件要求较高[23-25]。相对而言,CVD方法是一种可以实现工业化生产,并且能够实现大面积、均匀和高质量薄膜材料常用的制备方法。然而,目前CVD法制备In2Se3时常采用金、铜或镍作为催化剂,在低压条件生长,这无疑会引入大量的杂质,降低材料性能[26]。
为了避免引入非故意掺杂的杂质,提高In2Se3材料性能。本文拟采用无催化CVD法在SiO2/Si衬底上进行In2Se3纳米材料的直接生长。通过调整CVD生长过程中的工艺参数,研究常压无催化条件下生长温度、生长时间、气体流量对In2Se3纳米片的微观形貌和尺寸的影响。研究结果将为进一步制备高质量In2Se3纳米材料提供参考。
1 实验方法
使用CVD方法制备In2Se3纳米片。制备设备为郑州科佳电炉有限公司生产的CVD系统,该设备最高工作温度为1 200 ℃。原材料选用纯度为99.999%的硒(Se)粉,1 200 mg,纯度为99.999%的氧化铟(In2O3)粉末900 mg。衬底选择为SiO2/Si衬底。CVD方法的原理示意图如图1所示。

图1 CVD方法的原理示意图
首先对管式炉内进行洗气操作,为后续的生长提供一个纯净的环境。洗气完毕后,将Se粉末和In2O3粉末分别放置于图中所示的加热区1和加热区2,衬底放置在In2O3粉末后方4 cm ~5 cm。接着分别将两个区域从室温条件下加热到430 ℃和800 ℃,升温过程大约需要40 min。升温结束后,分别调整氩气(Ar)和氢气(H2)流量至15 sccm和45 sccm,开始在衬底上进行In2Se3材料的生长,生长持续45 min。生长结束后,停止对加热区域加热,关闭H2同时保持Ar流量不变。待自然冷却至室温,取出样品并关闭设备。
研究以参考文献[19]及Se粉和In2O3粉末熔点为依据设计实验,采用控制变量法研究实验参数对In2Se3的生长影响。变量因素包括前驱体Se粉和In2O3粉末区域温度、生长时间和气体流量。In2Se3制备实验参数如表1所示。

表1 In2Se3制备实验参数
采用EVO10型扫描电子显微镜(Scanning Electron Microscope,SEM)观察In2Se3纳米片的形貌。利用S-4800能量色散光谱(Energy Dispersive Spectrometer,EDS)对In2Se3纳米片的元素组成进行分析。使用SmartLab 9kW型X射线衍射(X-ray Diffractometer,XRD)仪分析样品的晶体结构,X射线发生器的灯丝为0.4 mm×8 mm,射线光源为Cu转靶9 kW,角度范围为5°~60°。利用Horiba scientific-LabRAM HR evolution型拉曼光谱(Raman Spectrometer,Raman)仪,以532 nm激光为激发光源,在50 cm-1~500 cm-1范围内获得拉曼光谱,记录微Raman散射光谱。
2 结果与讨论
2.1 温度对In2Se3纳米片的影响
2.1.1 Se粉区域温度对In2Se3纳米片的影响
在SiO2/Si衬底上,设置Se粉区域温度分别为400 ℃、430 ℃、460 ℃,保持In2O3粉末区域温度为850 ℃,样品生长时间为45min,H2流量为45 sccm,Ar流量为15 sccm进行生长。使用EVO10型SEM对In2Se3纳米片材料样品1、样品2和样品3进行测试,不同Se粉温度In2Se3的SEM图像如图2所示,其中,右上角插图为其EDS测试结果。

图2 不同Se粉温度In2Se3的SEM图像
图2(a)为Se粉温度为400 ℃时In2Se3样品的SEM图像,观察到衬底分布着白色生成物,分布较均匀,形貌不规则,根据右上角EDS测试结果可看出,样品1中不含有Se元素,只含有In元素。分析认为,由于Se粉区域温度过低,Se粉未热溶解挥发,而样品中的In元素是由于In2O3粉末区域沉积在衬底上导致。图2(b)和图2(c)分别为Se粉温度在430 ℃和460 ℃时样品2和样品3的SEM图像,右上角ESD图显示材料中含有Se元素和In元素。可以看出,样品2和样品3衬底生成物形貌与图2(a)有所不同,形貌为不规则多边形,尺寸相对较大,分布不均匀。图2(c)生成物数量相比图2(b)较多,密度较高,并且垂直方向堆叠严重,这种堆叠生长不利于材料的水平生长。因此,在In2Se3纳米片的制备中,Se粉区域温度较优参数为430 ℃。
2.1.2 In2O3区域温度对In2Se3纳米片的影响
作为反应源,In2O3粉末负责提供In2Se3制备的铟原子,因此,In2O3粉末所提供的铟原子浓度以及活性直接影响In2Se3纳米片的生长速度和质量。在SiO2/Si衬底上,Se粉区域温度为430 ℃,生长时间为45min,H2流量为45 sccm,Ar流量为15 sccm保持不变,In2O3区域温度分别设置为800 ℃、850 ℃和900 ℃进行生长。使用EVO10型SEM对In2Se3纳米片材料样品4、样品5和样品6进行测试,不同In2O3粉末温度In2Se3的SEM图像如图3所示。图中右上角插图为局部放大图像。

图3 不同In2O3温度In2Se3的SEM图像
观察图3可以发现,In2O3区域温度对In2Se3的密度和大小有显著的影响。在In2O3粉末温度为800 ℃条件下,制备的In2Se3样品尺寸较小,分布均匀,密度较高。当In2O3粉末温度升高到850 ℃时,制备的In2Se3样品尺寸变大,数量减少,密度较低。当In2O3粉末温度到达900 ℃时,不能明显观察到In2Se3纳米片。造成这种现象的原因是,由于In2Se3的熔点是900 ℃,当温度升高,到达900 ℃时,造成In2Se3原子不容易沉积在衬底上。因此,在In2O3粉末温度从800 ℃升高到900 ℃的过程中,制备得到的In2Se3纳米片的数量减少。
使用SmartLab 9kW型XRD仪对In2Se3纳米片材料样品4、样品5和样品6进行测试,在不同In2O3粉末温度条件下制备In2Se3样品的XRD图谱如图4所示。

图4 不同In2O3温度In2Se3的XRD图谱
从图4中可以看出,当In2O3温度为900 ℃时,In2Se3样品的XRD结果显示只有Si的峰值,其衍射角2θ=45.4°对应Si的(100)面。而在In2O3温度为800 ℃和850 ℃的XRD图谱中,既有Si峰,同时也含有α-In2Se3的峰值,其特征峰2θ分别为18.4°、27.8°和37.4°对应α- In2Se3的(004)面、(006)面和(008)面。因此,在In2Se3纳米片的制备中,In2O3区域温度较优参数为800 ℃。
2.2 生长时间对In2Se3纳米片的影响
在SiO2/Si衬底上,保持Se粉区域温度为430 ℃,In2O3区域温度为800 ℃,H2流量为45 sccm,Ar流量为15 sccm,设置生长时间分别为15 min、30 min和45 min进行生长。使用EVO10型SEM对In2Se3纳米片材料样品7、样品8和样品9进行测试,不同生长时间In2Se3的SEM图像如图5所示。图5右上角插图为局部放大图像。

图5 不同生长时间下In2Se3的SEM图像
从图5中可以看出,随着生长时间不断增加,在不同生长时间条件下,制备的In2Se3样品的形貌有所不同。当生长时间为15 min时,In2Se3呈现球形颗粒状,而当生长时间为30 min和45 min时,其形貌为不规则的多边形和规则的六边形。实验结果表明,随着生长时间的增加,In2Se3纳米结构的尺寸也逐渐增加,并且其形状也发生了改变,在45 min时达到了稳定的六边形状态。因此,在In2Se3纳米片的制备中,应选择较优生长时间为45 min。
2.3 气体流量对In2Se3纳米片的影响
前驱体和辅助气体的比例在生长过程中对In2Se3的形貌和质量有显著影响。作为反应源,H2在反应中为还原性气体,对In2Se3的生成起着关键性的作用。Ar作为惰性气体,在反应中作为保护性载气使用。在SiO2/Si衬底上,保持Se粉区域温度为430 ℃,In2O3区域温度为800 ℃,生长时间为45 min,Ar流量为15 sccm,H2流量分别为30 sccm、45 sccm和60 sccm进行生长。使用EVO10型SEM对In2Se3纳米片材料样品10、样品11和样品12进行测试,不同气体流量In2Se3的SEM图像如图6所示。图6中右上角插图为局部放大图像。

图6 不同H2流量下In2Se3的SEM图像
观察图6可以看出,随着H2流量的增加,得到样品的含量呈现出先增加后减少的变化趋势。当H2流量为60 sccm时,观察到只有少量的生成物在衬底上附着,这是由于气体流速过快导致,生成物无法在衬底上良好的附着。因此,在In2Se3纳米片的制备中,较优的气体流速参数为H2流量为45 sccm,Ar流量为15 sccm。
利用Horiba scientific-LabRAM HR evolution型Raman光谱仪对最优参数条件下制备得到的In2Se3纳米片材料进行测试。图7为最优参数条件下制备的样品在532 nm激光激发下室温Raman光谱。从图7可以看出,制备的样品在104 cm-1、176 cm-1处发现两个特征峰,这两个峰分别属于α-In2Se3的A1(LO+TO)和A1(TO)模式。254 cm-1的峰值表示与非晶态Se相关的振动模式。在90 cm-1处有较小的E模式对称拉曼峰表示α-In2Se3具有2H-α相的晶体结构,它的空间群为P63/mmc(NO.194),具有R3m对称的菱形晶体结构。

图7 In2Se3纳米片的Raman光谱
利用SmartLab 9kW型XRD仪对最优参数条件下制备得到的In2Se3纳米片材料进行测试。最优参数条件下制备的In2Se3纳米片材料的XRD谱图如图8所示。
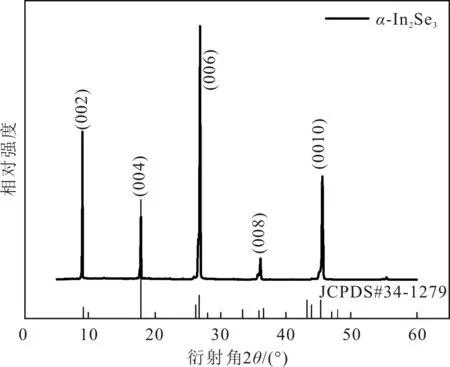
图8 In2Se3纳米片的XRD谱
从图8可以看出,所制备的In2Se3纳米片材料的单晶质量较高。其衍射角2θ分别为9.2°、18.4°、27.8°、37.4°和47.2°,分别对应(002)面、(004)面、(006)面、(008)面和(0010)面。其中,(006)晶面衍射峰最高,表明制备的In2Se3纳米片沿(006)晶面择优生长,与六方α-In2Se3标准谱(ICDD/JCPDS#34-1279)一致。
3 结语
利用常压无催化CVD方法在SiO2/Si衬底成功制备了α-In2Se3纳米片材料。研究了生长温度、生长时间、气体流量比对In2Se3纳米片形貌及分布的影响。研究发现,Se粉和In2O3粉末区域的温度对In2Se3纳米片能否生长起决定性作用,In2Se3纳米片的形貌受到生长时间的影响。采用SEM、Raman、XRD对其进行表征分析,生长的In2Se3纳米片形貌为规格六边形,分布较均匀,具有2H-α相的晶体结构,沿(006)晶面有较强取向性。得到的最佳工艺参数为Se粉区域温度为430 ℃,In2O3粉末区域温度为800 ℃,生长时间为45 min,H2流量为45 sccm,Ar流量为15 sccm。取得的研究成果将会对无催化CVD法制备高质量In2Se3薄膜提供了一定的参考。
