MEMS晶圆PCM应力表征结构设计与试验验证*
2023-03-22苏亚慧周六辉
刘 艳,苏亚慧,丁 一,喻 磊,周六辉,凤 瑞
(华东光电集成器件研究所·苏州·215163)
0 引 言
应力是制约MEMS(Micro Electro Mechani-cal System)器件性能提升的一个重要因素。高性能的MEMS加速度计、MEMS陀螺仪、MEMS压力传感器在设计和制造时均需要采用特殊方法降低应力对器件性能的影响。MEMS器件的应力来源大致可以分为两个方面。一方面是MEMS晶圆在工艺制造过程中产生的应力,这包括绝缘衬底上的硅(Silicon-on-Insulator,SOI)晶圆等材料自身的应力,以及刻蚀、键合、氧化等加工工艺产生的应力。另一方面是MEMS器件封装产生的应力,这是由于MEMS器件封装采用了异质材料,而异质材料的热膨胀系数不同,当环境温度发生变化时,异质材料间将产生热应力。通过优化设计[1-5]和改进工艺[6-10]等方法可以降低热应力的产生或降低传递到MEMS结构上的应力。
MEMS工艺制造过程中产生的应力对MEMS芯片的成品率有着直接影响,MEMS微加工过程中较大的应力甚至会造成晶圆发生破裂。因此降低加工应力是MEMS工艺制造的一项核心技术。为了客观评价MEMS晶圆在制造过程中产生的应力大小和应力分布,需要设计MEMS晶圆PCM应力表征结构用于准确评价MEMS晶圆的应力,为优化MEMS工艺实现低应力制造提供可靠试验数据。20世纪90年代MEMS惯性器件大多采用MEMS表面工艺。MEMS表面工艺加工的结构层较薄,且大多是沉积方式生成,应力较大。为了测量MEMS表面工艺加工出的微结构应力,研究人员提出了多种MEMS晶圆应力表征结构,有悬臂梁式、双端固支梁式、圆环式、推杆式等[11-13]。随着MEMS体硅工艺的成熟,目前大多数MEMS惯性器件采用基于SOI晶圆的体硅工艺制造。虽然设计了微谐振器结构,利用谐振器模态频率随应力变化可以实现晶圆应力的评价,但刻蚀导致的结构尺寸误差,即使零应力情况下,晶圆上不同位置的谐振器固有频率也会不同,因此单从谐振器固有频率值难以将结构尺寸误差与晶圆应力分离,且谐振器结构测试需要通过探针台上的探针进行电信号连接,会额外引入应力。因此需要设计一种非电学的MEMS晶圆原位应力测量方案。本文针对MEMS惯性器件性能受应力影响显著的问题,开展微加工应力测试研究,提出采用一种推拉差分式MEMS晶圆应力表征结构来实现非接触式的晶圆应力测量。
1 推拉差分式MEMS晶圆PCM应力表征结构设计
1.1 推拉差分式结构设计
设计了推拉式MEMS应力表征结构,如图1所示。应力表征结构的两组支撑梁设计成不共线的反对称结构。这使得当MEMS晶圆存在应力时,应力将通过MEMS结构的锚点传递到表征结构上。若晶圆上该位置存在拉应力,则图1中左指针杆结构将向上运动,同时右指针杆结构将向下运动。而当该位置存在压应力时,左指针杆结构将向下运动,同时右指针杆结构将向上运动。左指针杆和右指针杆的端部均设计有用于表征位移量的梳齿结构。梳齿结构在应力作用下形成差分运动,通过测量梳齿结构的差分运动位移可以表征出结构锚点应力大小和方向。
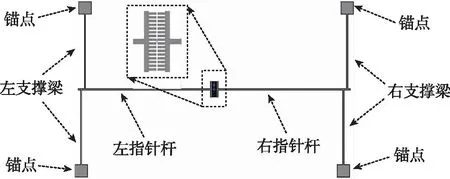
图1 推拉差分式MEMS应力表征图形结构示意图Fig.1 The schematic diagram of push-pull differential MEMS stress characterization structure
推拉差分式MEMS晶圆应力表征结构的单侧结构可以抽象成如图2所示的模型。应力σ与结构尺寸以及结构运动位移δ的关系可近似表示为[12]

图2 推拉差分式MEMS晶圆应力表征结构简化模型Fig.2 The simplified model of push-pull differential MEMS stress characterization structure

(1)
其中,σ为通过结构锚点施加在表征结构上的应力,δ为表征结构水平杆顶端的运动位移,E为材料杨氏模量,ν为泊松比,LA和LB分别为两个推拉杆的长度,O为两个推拉杆的垂直方向间距,LC为水平杆的长度。借助式(1)可以近似估算出应力表征结构实际位移对应的近似应力值,采用有限元仿真可以准确仿真出结构运动位移对应的应力值。
1.2 推拉差分式结构优化仿真
MEMS体硅工艺制造过程中产生的应力主要来源于高温的硅硅晶圆键合。建立的推拉差分式MEMS应力表征结构仿真模型,如图3所示。对高温硅硅晶圆键合后的应力表征结构进行了仿真。

图3 MEMS应力表征结构仿真模型Fig.3 The simulation model of MEMS stress characterization structure
MEMS应力表征结构的结构层厚度为50μm,二氧化硅绝缘层厚度为1μm。单晶硅和二氧化硅材料参数见表1。当结构层晶圆在键合温度为1000℃条件下与衬底层晶圆键合后,冷却到室温时,键合形成的硅-二氧化硅-硅结构由于材料的热膨胀系数不同而产生热应力。

表1 MEMS应力表征结构材料物理特性表Tab.1 The material physical properties table of MEMS stress characterization structural
仿真计算得出的推拉差分式应力表征结构在晶圆键合冷却后,热应力产生的位移如图4所示。数值仿真计算显示应力表征结构单边产生了约6μm的位移变化。

图4 推拉差分式MEMS应力表征结构仿真结果Fig.4 The simulation results of push-pull differential MEMS stress characterization structure
2 应力表征结构版图设计及制作工艺
为验证推拉差分式MEMS应力表征结构,开展MEMS应力表征结构的流片。首先设计应力表征结构版图,将应力表征结构沿(100)晶向和(110)晶向布置,形成双轴应力表征结构。图5为应力表征结构的单芯片版图,芯片中央为应力指针结构固定不动,中央梳齿指针上下和左右两侧分别设计有1对推拉差分式应力表征结构。芯片结构的总体尺寸为5000μm×5000μm。
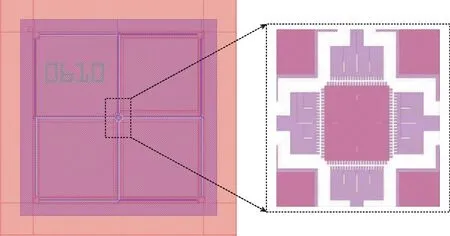
图5 设计的推拉差分式MEMS应力表征结构版图Fig.5 The layout of the designed push-pull differential MEMS stress characterization structure
测试结构仅需两层硅片,设计的加工工艺流程如图6所示。采用的加工流程为:

(b)

(c)

(d)

(e)

(f)

(g)图6 推拉差分式MEMS应力表征结构加工工艺流程图Fig.6 The fabrication process of the push-pull differential MEMS stress characterization structure
(a) 选用6寸(100)晶圆片;
(b) 高温氧化,形成1μm厚二氧化硅绝缘层;
(c) 在二氧化硅绝缘层上刻蚀出图形;
(d) 继续在二氧化硅图形基础上,刻蚀一定深度的底层硅;
(e) 选取另一片50μm结构层厚的SOI晶圆片,键合到上述(100)晶圆片上;
(f) 化学机械抛光(Chemical Mechanical Polishing,CMP)去除SOI晶圆片的底层硅以及二氧化硅绝缘层;
(g) 采用深反应离子刻蚀(Deep Reactive Ion Etching,DRIE)刻蚀50μm结构层,形成所需测试图形结构。
3 应力表征结构试验测试结果
推拉差分式应力表征结构加工流片完成后,在光学显微镜下观察和测量应力表征结构中梳齿位移情况。图7为实际流片加工出的应力表征结构晶圆照片。图8为该晶圆上一个应力表征结构在应力作用下发生位移的显微镜照片,可见沿晶圆(100)晶向和(110)晶向均存在拉应力,仿真优化后的推拉差分式应力表征结构可以实现晶圆应力的非接触式测量。

图7 应力表征结构晶圆局部照片Fig.7 The photo of the stress characterization structure wafer
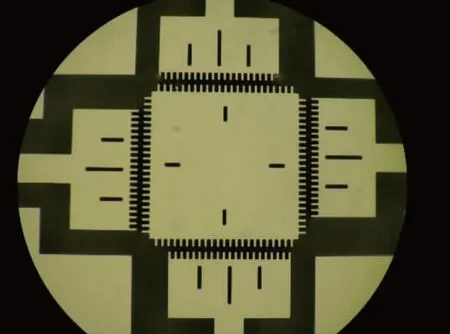
图8 实际加工出的应力表征结构在应力作用下变形情况照片Fig.8 The photo of the deformation of the actual processed stress characterization structure
将拉应力产生的结构运动位移记为正值,压应力产生的结构运动位移记为负值,上下和左右两侧2组推拉差分结构的运动位移之和记为该位置沿(100)晶向和(110)晶向的应力表征值。经光学显微镜测量梳齿结构运动位移,图8所示应力测量结构所在位置存在(100)晶向4.3μm和(110)晶向5.1μm的应力表征位移。
依次测量晶圆每个芯片位置的应力表征结构的梳齿结构运动位移,可以绘制出整个晶圆的应力分布图。(100)晶向应力分布的Map图如图9所示,(110)晶向应力分布的Map图如图10所示。可见加工出的MEMS晶圆整体上以拉应力为主,呈现一种中心挤压变形,而外围拉伸变形的状态。设计的MEMS晶圆PCM应力表征结构很好地表征了MEMS晶圆不同位置、不同轴向对的应力大小、方向以及应力分布情况。沿(100)晶向的最大拉应力在表征结构上产生了18.9μm位移,最大压应力产生了-34.2μm位移;沿(110)晶向的最大拉应力在表征结构上产生了15.0μm位移,最大压应力产生了-57.8μm位移。

图9 沿(100)晶向应力在应力表征结构上产生的位移Map图Fig.9 Displacement map generated by stress along the (100) crystal direction
图9和图10也反映出晶圆局部相邻两个芯片位置的应力存在方向不一致的问题,即晶圆上少数位置存在相邻芯片相同轴向的应力一个为拉应力,另一个为压应力的现象。这可能是由于在MEMS晶圆实际键合过程中局部芯片的锚点键合锚定时间存在差异造成的,后续需要开展进一步的研究。
4 结 论
为表征MEMS晶圆的应力,给MEMS加工工艺优化提供有效的晶圆级应力评价测量手段,设计了推拉差分式MEMS晶圆应力表征结构。仿真计算了所设计的应力表征结构在晶圆键合工艺后产生的热应力以及热应力产生的结构变形量。采用6英寸晶圆,加工了推拉差分式MEMS晶圆应力表征结构,推拉差分式MEMS晶圆应力表征结构表征出了MEMS晶圆的应力,借助光学显微镜实现了对应力导致的结构运动位移的非接触式精确测量,测试结果揭示了MEMS晶圆整体应力水平和应力分布情况,为后续优化MEMS低应力加工工艺提供了准确的应力评价依据。试验结果也发现,晶圆少部分位置相邻两个测试结构的应力存在方向性差异,这可能是在MEMS晶圆实际键合过程中局部芯片的锚点键合锚定时间存在差异造成的,后续需要开展进一步的研究。
