SiO2/CeF3 复合薄膜的电致发光
2022-02-06李贝贝王小平王丽军
李贝贝,王小平,王丽军,包 建
(上海理工大学 理学院,上海 200093)
1 前 言
半导体材料的光电性能一直是人们研究的热点[1-11],其中硅作为微电子工业中重要的半导体材料,由于其固有的间接带隙结构,发光效率极低,不适合作为发光材料,这严重限制了硅基集成电路的发展。为了利用成熟的硅基集成技术实现低成本的硅基光互联,人们研究了大量的硅基发光器件[7-11]。近年来,硅基稀土掺杂绝缘体或宽禁带半导体的电致发光器件引起了广泛关注[12-13]。孙甲明等[14]采用离子注入技术将三价稀土离子(RE3+)注入到SiO2薄膜中,制备出硅基SiO2:RE3+的MOS结构电致发光器件,实现了与稀土能级相关的高效特征光发射。
一直以来,蓝区薄膜电致发光器件备受人们关注[15-16]。稀土Ce3+因其独特的电子构型及快速的5d→4f蓝光发射,受到了人们的青睐。Ce3+是由Ce原子失去外层两个6s电子和一个5d电子后形成的,其中存在快速的5d→4f电偶极允许跃迁。由于Ce3+5d能级容易受基体材料的影响,导致5d→4f电子能级跃迁引起的光发射可从可见光区延伸到紫外区。这为制备含稀土Ce3+的蓝区薄膜电致发光器件提供了可能[17-22]。
SiO2薄膜具有优良的物理化学性能,比如介电常数低(3.8)、带隙宽(9.0 e V)、硬度高、耐磨耐腐蚀等,更重要的是与硅集成技术兼容,作为钝化层和绝缘层被广泛应用于硅基集成电路中[23-25]。此外,SiO2薄膜在薄膜电致发光器件中作为电子加速层已被许多研究证实[26-28]。
虽然上述硅基三价稀土离子掺杂SiO2薄膜的电致发光器件发光效率较高,但离子注入技术成本高,而且注入过程很容易造成离子损伤,掺杂不均匀,容易在基体材料中引入缺陷[29]。如果能在硅片上制备SiO2薄膜使其作为电子加速层加速电子,被加速后的高能电子再有效地激发Ce3+发光,则有可能实现低成本的蓝光发射器件。为此,本实验采用真空电子束蒸发气相沉积(EBVD)系统制备了硅基SiO2/CeF3复合薄膜电致发光器件,并研究了其电致发光特性。
2 实 验
采用单面抛光的重掺杂n型硅片作为器件的衬底和电极,在SiO2薄膜沉积之前,先采用DL-720 型智能超声波清洗器对硅衬底进行超声清洗。首先将硅片放入盛有质量分数为99.7%的无水乙醇烧杯中,然后将烧杯放入超声清洗槽中,70 W 功率超声清洗10 min,用吹风机将硅片吹干;换用去离子水重复上述操作去除衬底表面吸附的离子;采用DZS500a型EBVD系统,以纯度为99.99%的SiO2颗粒为靶材,在硅衬底上沉积一层SiO2薄膜,沉积参数如表1所示。
由于EBVD 法直接蒸镀的SiO2薄膜一般疏松多孔[30],为了改善SiO2薄膜的质量使其更致密,将已沉积的SiO2薄膜样品再放置于SX2-410型马弗炉中进行700℃,1 h的退火。在升温过程中,保持升温速率约10℃/min,以尽量避免因SiO2薄膜和衬底Si的热膨胀系数不同使SiO2薄膜发生龟裂。退火后,利用EBVD系统,以纯度为99.99%的CeF3颗粒为靶材,在SiO2薄膜上沉积一层CeF3薄膜。最后,仍采用EBVD 技术在CeF3薄膜上再沉积一层氧化铟锡(ITO)透明导电薄膜作为电极。CeF3薄膜和ITO 薄膜的沉积参数如表1所示。

表1 EBVD制备SiO2 薄膜,CeF3 薄膜和ITO薄膜的实验参数Table 1 Parameters for the EBVD process of SiO2 film,CeF3 film and ITO film layers
分别采用Quanta FEG 450场发射扫描电子显微镜(FE-SEM)、Y-2000 型X 射 线 衍 射 仪(XRD)和EDAX GENESIS型能谱仪(EDS)对器件中各膜层的表面形貌、微观结构和成分进行分析。在室温下,采用DW-P501-200AODE高压直流电源给器件施加外加电场,检测器件的I-V 特性,同时采用PR655型光谱仪对器件的电致发光光谱进行检测。
3 结果与讨论
3.1 复合薄膜器件的表征
在FE-SEM 较高放大倍数下仍难以分辨SiO2薄膜表面形貌细节。从图1可见,CeF3薄膜的晶粒尺度约7~8 nm,且均匀覆盖SiO2薄膜;ITO 薄膜由大量的棒状ITO 晶体组成且成膜均匀,CeF3薄膜被ITO薄膜完全覆盖。

图1 制备ITO 薄膜后器件中CeF3 薄膜(a)和ITO 薄膜(b)表面形貌FE-SEM 图像Fig.1 SEM images of CeF3 film(a)and ITO film(b)in the device after the deposition of ITO films
图2显示三个明显的CeF3衍射峰,分别对应于CeF3的(002)、(111)、(113)晶面。此外,XRD 图谱中也出现了Si和In2O3(ITO 的主要成分)的衍射峰,说明器件的确存在CeF3晶体和ITO 晶体。通常情况下SiO2薄膜为稳定的非晶态[31-32],这应该是导致XRD图谱中没有出现SiO2晶体衍射峰的原因。

图2 制备ITO 薄膜后器件的XRD图谱Fig.2 XRD patterns of the device after the deposition of ITO films
从图3EDS图谱可以看到,出现了Ce、F、O、Si、In元素的特征衍射峰。Ce和F 特征峰的存在间接证明了样品中存在CeF3,Si、O 特征峰的存在间接证明了样品中存在SiO2,由于使用了Si作为衬底,故图中显示出一个很强的Si特征峰。O、In特征峰的存在则间接证明了样品中存在In2O3(ITO 的主要成分)。这与XRD 的检测结果相互印证。

图3 制备ITO 薄膜后器件的EDS谱图Fig.3 EDS spectrum of the device after the deposition of ITO film
3.2 复合薄膜器件的I-V特性和电致发光特性
如图4所示,对复合薄膜器件的电致发光性能检测发现:器件在正接时,电流随外加电压的增加而增大,当外加电压达到5 V 时,肉眼可观测到器件的可见光发射,即ITO 透明电极上出现若干个肉眼可见的发光点。随外加电压继续增加电流也继续增大,ITO 电极上发光点越来越多,器件相应的发光亮度也越来越亮,直到外加电压达到30 V 时器件被击穿;器件在反接时,开始时电流随外加电压的增加而增大,但当外加电压达到12 V 时,电流却突然减小,此时ITO 表面出现了肉眼可观测到的蓝色可见光发射,且整个ITO 透明电极发光成面且发光均匀。随着外加电压继续增加电流变化很小,然而器件的发光亮度却越来越亮,直到外加电压达到27 V 时器件被击穿。

图4 器件的I-V 特性曲线Fig.4 I-V characteristics curve of the device
在相同测试环境下,利用光谱仪测试了器件正反接时的电致发光谱图,电致发光照片如图5所示。从图可见,m 器件正接时的电致发光光谱峰位位于504 nm(绿光区)和680 nm(红光区)两处,且680 nm处红光峰的强度强于504 nm 处绿光峰的强度。

图5 器件正接时的电致发光光谱及相应器件的电致发光照片Fig.5 EL spectrum and the corresponding EL photograph of the device when the device is in forward connection
从图6可以看到:器件反接时的电致发光光谱中除了有一个位于684 nm(红光区)处的较弱发光峰之外,在434 nm(蓝光区)处还出现了一个很强的发光宽峰。

图6 器件反接时的电致发光光谱及相应器件的电致发光照片Fig.6 EL spectra and the corresponding EL photograph of the device when the device is in reverse connection
3.3 分析与讨论
3.3.1 复合薄膜器件电致发光光谱 在利用EBVD 系统沉积SiO2薄膜的过程中,SiO2化学计量比可能会发生偏差,从而会导致SiO2薄膜中形成一些缺陷,实验表明,SiO2薄膜中存在一种较为常见的缺陷发光中心:非桥接氧空位(NBOHC,≡Si—O·),非桥接氧空位对应的能级位于SiO2价带顶上方约1.9 e V 处,电子从价带被激发到这个能级,需要1.9~5 eV 的能量,被激发到此能级上的电子与价带空穴复合发光,发射的光子能量约为1.9 e V[33-36]。因此,SiO2/CeF3结构复合薄膜电致发光器件正接时其电致发光谱中680 nm(1.83 e V)处的红光发射可归结为是由非桥接氧空位引起的。与SiO2薄膜中缺陷发光中心相关的绿光发射也多有报道[23-24,31,33,35-36],Robertson等[35-36]认为478~518 nm(2.4~2.6 e V)的光发射与SiO2薄膜中Si悬键缺陷态有关。SiO2膜层与Si衬底界面间最容易存在这种Si悬键,相应的该种复合薄膜结构器件正接时电致发光谱中504 nm(2.46 e V)处的绿光发射应该是由于SiO2膜层与Si衬底界面间的Si悬键缺陷引起。
该种复合膜结构器件反接时电致发光谱中684 nm 处的红区发光峰与正接时电致发光谱中680 nm 处的红区发光峰起源相同,均是由SiO2薄膜中的非桥接氧空位引起的。而位于434 nm 处很强的蓝区发光宽峰,经Origin软件进行高斯拟合,可拟合成429和468 nm两个峰,这两个峰的波数差约为1 942.5 cm-1,基本对应于Ce3+基态4f(2F5/2)和4f(2F7/2)的波数差(2 000 cm-1)。因此,429和468 nm处的光发射应归因于Ce3+分立发光中心,分别对应于CeF3薄膜中Ce3+5d→4f(2F5/2)和5d→4f(2F7/2)的电子跃迁发光。Ce3+5d→4f电子能级跃迁,如图7所示。
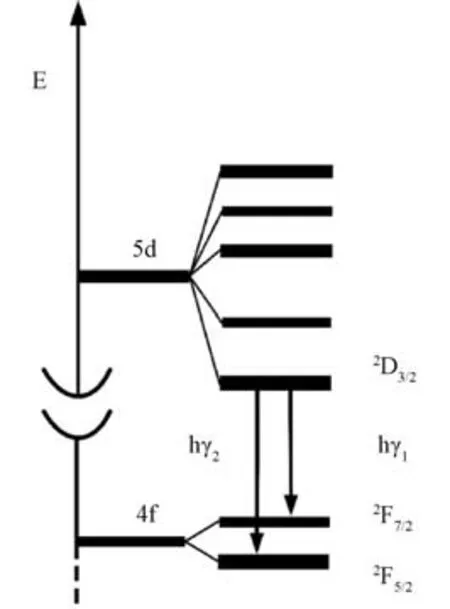
图7 Ce3+的能级跃迁图Fig.7 Diagram of Ce3+energy level transition
3.3.2 复合薄膜器件电致发光I-V 特性 器件正接时,电子从上电极ITO 直接注入到CeF3膜层,此时电子的能量不够高,因此还不足以有效碰撞激发Ce3+发光中心,于是电子通过CeF3膜层进入SiO2膜层并在SiO2中加速运动。作为介电层的SiO2膜层电阻较大,其分压作用也较大,加之由于SiO2具有较低的介电常数,因此在相同电压下SiO2膜层内部电场会较强。随着外加电压增加,SiO2膜层内部的平均电场强度越来越强,于是电子在SiO2膜层内被加速获得更高的能量,这些高能电子与SiO2层内的缺陷中心发生碰撞会使载流子的数量逐渐增加,相应的电流也会逐渐增大。同时大量的高能电子碰撞离化SiO2薄膜中的缺陷发光中心从而也将产生更强的光发射,因此,随着外加电压的增加器件的发光强度也会相应地增强。
器件反接时,n型Si衬底导带的大量电子可以通过内场发射效应直接隧穿至SiO2的导带,并在SiO2的导带中被加速,然后再注入到CeF3膜层,最后到达ITO 电极层。随着外加电压增加,电子的输运速度随之增大,因此,器件中的电流也逐渐增大。当外加电压达到某一值时,电子在SiO2膜层中已被有效地加速到具有足够高的能量,从而成为“过热电子”。这些高能量的过热电子进入CeF3膜层中可以有效地碰撞激发Ce3+4f基态电子到更高的5d能态,随后5d高能态的电子又跃迁回4f基态,于是会产生Ce3+分立发光中心蓝区的光发射。由于大量的过热电子在有效碰撞激发Ce3+发光中心并引起发光的过程中,其能量会减小,因此电子的输运速度会有所下降,这可以解释为什么器件在外加电压约为12 V 时电流突然下降,同时伴随着肉眼可见的较强蓝区光发射现象。此后随外加电压继续增加,过热电子碰撞激发CeF3薄膜中Ce3+分立发光中心和SiO2薄膜中缺陷发光中心的效率都有所提高,相应地,器件的发光强度也不断增强。
4 结 论
利用SiO2薄膜作为电子加速层,制备的结构简单的硅基SiO2/CeF3复合薄膜电致发光器件正反接时都可以发出可见光。
器件正接时,电致发光光谱峰位位于504(绿光区)和680 nm(红光区)两处,分别来源于SiO2膜层与Si衬底界面处的Si悬键缺陷和SiO2膜层中非桥接氧空位缺陷发光中心;器件反接时,电致发光光谱除了有一个位于684 nm(红光区)较弱的发光峰之外,在蓝光区434 nm 处还有一个很强的发光宽峰,肉眼观察器件发光呈蓝色。其中684 nm 处的发光峰来源于SiO2薄膜中非桥接氧空位缺陷发光中心,而434 nm 处的发光峰来源于CeF3层中Ce3+分立发光中心。
器件正反接时的电致发光光谱存在明显差异是由于器件在不同方向偏压下发光中心发光不完全相同所致。
