忆阻器阻变机制及其材料研究进展*
2022-01-24邓亚峰魏子健
邓亚峰,魏子健,王 栋
(河南农业大学机电工程学院,河南 郑州 450002)
1 引言
忆阻器作为一种新兴的非线性电子元件(区别于电阻、电容和电感),具有非易失特性,其内部状态取决于曾经流过的电荷量,即在电源突然关闭后,仍然能够保持原有状态不变[1]。早在1971年蔡少棠教授就根据电流I、电压V、电荷Q和磁通φ之间的关系,利用数学逻辑推理,成功预测出了忆阻器的存在[2],在之后的许多年里,具有阻变现象的器件经常被研究,但并没有研究人员建立其与忆阻器之间的内在联系。直到2008年惠普实验室成功制备了基于氧化钛薄膜的阻变器件,并首次将其与忆阻器联系起来,同时对该器件阻变现象进行了详细研究。至此,电感、电容、电阻和忆阻器共同构成了4种完整的无源基本电路元件集[3]。
一项新技术能否被很好地应用,取决于其与现有技术对比的优势,忆阻器作为一种电阻开关,它的尺寸可以缩小到2 nm以下,开关速度可以控制在1 ns以内[4],开关次数可以在2×107以上[1],此外还具有相比于现有电子元件更低的运行功耗[5]。这必然会给集成电路带来一次大的变革,意味着在有限的电路空间内可以实现更高的存储密度,同时也有更快的读写速度、更长的使用寿命和更简单的结构。
2 忆阻器的基本概念
忆阻器通常是一种以半导体材料为基础的电子器件,一般是由顶电极、绝缘介质层和底电极组成的三明治结构,其表达公式为dφ=M(q)dq,其中M(q)为忆阻值,表示磁通量(φ)随累积电荷(q)的变化率,与电阻有相同的量纲[2]。不同点是普通电阻的内部物理状态不发生变化,其阻值通常保持不变,而忆阻器的内部物理状态(缺陷填充或离子移动)受外界激励(如电场)的调控,阻值不仅随流经电荷量的变化而非易失性地变化,而且与外部所施加电场的极性和频率也有一定的关系[6]。忆阻器可以在外电场作用下实现在高阻态(ROFF)、低阻态(RON)和多电阻状态之间的转变[7]。在初始状态下,首次施加的较高电压将会使忆阻器经历一个电铸(forming)过程,用于形成导电通道或缺陷。当在较低电压作用下,忆阻器从高阻到低阻状态的转变为置位(SET)过程,从低阻到高阻状态的转变为复位(RESET)过程[3]。当SET过程和RESET过程所施加电压极性相同时,称之为单极性阻变行为,当SET过程和RESET过程所施加电压极性不同时,称之为双极性阻变行为,如图1[8]所示。
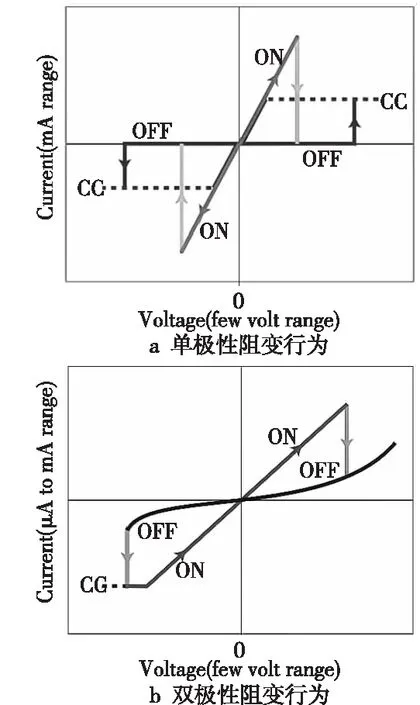
Figure 1 Unipolar resistance switching behavior and Bipolar resistance switching behavior图1 单极性阻变行为与双极性阻变行为
3 阻变机制
对阻变机制的探究一直是忆阻器研究工作的重点,基于不同阻变机制的忆阻器在结构和性能上有较大的差异。随着科研人员对忆阻器研究的深入,越来越多的阻变机制被提出,本文结合以往研究的内容,将忆阻机制主要概括为3类,即阴离子迁移机制、阳离子迁移机制和纯电子机制,同时对一些其他机制也进行了简单的论述,表1为不同阻变机制忆阻器的典型性能参数对比。
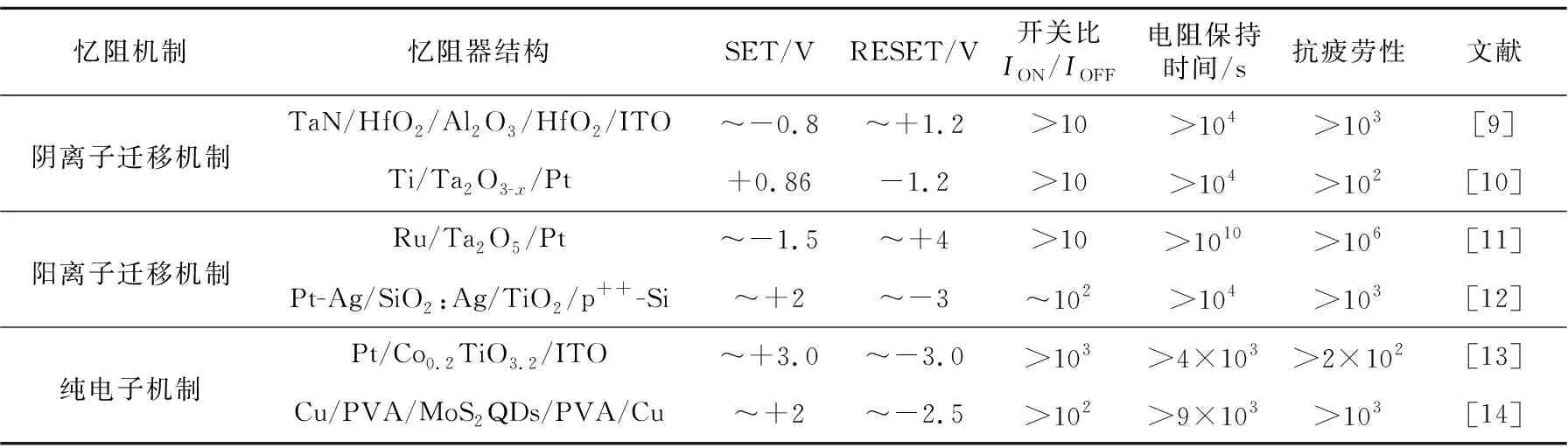
Table 1 Typical performance comparison of memristors with different resistive switching mechanisms.
3.1 阴离子迁移机制
适用于忆阻器阴离子迁移机制的介质层材料一般为绝缘氧化物,如二元氧化物、多元氧化物和钙钛矿氧化物等,其电极材料一般为惰性金属,如Pt、Au等。在该类型的忆阻器件中,由于电极材料为惰性金属,故其很难参与氧化还原反应,在介质层材料中不会出现惰性金属离子的迁移[7],其导电机制主要依赖在电场作用下,氧化物介质层材料中的氧离子发生迁移而形成的氧空位导电通道[15]。在初始状态下,介质层材料中原有的缺陷或晶界的扩散能较低,可以作为氧离子的迁移通道。随着激活电压以及焦耳热的不断增加,氧离子的移动速度加快,并与晶格碰撞产生更多的氧离子和氧空位[16],氧空位沿着晶界由阴极向阳极生长,当生长至阳极时就形成了连接2电极的导电通道,该通道电阻率远低于其他介质,完成了忆阻器的电阻状态由高阻到低阻的转变。当施加反向电压时,在电场与焦耳热的共同作用下,存储在电极处的氧离子再次发生迁移,并与氧空位复合,致使导电通道断开,完成忆阻器由低阻到高阻的转变[3]。
在氧化物忆阻器件中,导电通道模型并不适用于所有的阴离子迁移机制,已经被研究发现的还有边界迁移模型等理论。最早在2008年,惠普公司Strukov团队[17]在世界顶级期刊“nature”上发表了论文“The missing memristor found”,提出了基于氧离子或氧空位的边界迁移模型,如图2[17]所示。

Figure 2 HP boundary migration model 图2 惠普边界迁移模型
在2金属电极之间存在TiOx介质层,介质层由2部分组成,其中一部分为掺杂氧空位的TiO2-x,表现为低阻态(RON),另一部分为未掺杂氧空位的TiO2,表现为高阻态(ROFF)。假设介质层的全部厚度为D,其中掺杂氧空位的TiO2-x厚度为W,掺杂区与未掺杂区的边界位于介质层中央。当对该器件施加正向电场时,氧空位在电场作用下由TiO2-x层向TiO2层移动,即可以表示为二者的边界向TiO2层移动,W厚度增大,并且随着外加正向电压的不断增大,W厚度持续增大,忆阻器件的电阻不断减小,最终表现为低阻态。当施加反向电场时,氧空位在电场作用下由TiO2层向TiO2-x层移动,即二者边界向TiO2-x层移动,W厚度减小,最终表现为高阻态。而且,在该忆阻器件工作过程中,不论二者边界迁移到任何位置,在突然断电的情况下,器件能保持当前的电阻状态不变,表现为其特有的“记忆”特性。
3.2 阳离子迁移机制
阳离子迁移机制又被称为电化学金属化ECM(ElectroChemical Metallization)反应[15],其忆阻器介质层材料具有较高的金属离子迁移率,一般为固态电解质,同时2电极材料具有不同的电化学活性,一般由活性金属(Ag、Cu、Ru等)和惰性金属(Ta、Pt、Au 等)组成。在基于阳离子迁移机制的忆阻器件的工作过程中,活性金属作为阳极,惰性金属作为阴极,当施加正向电场时,活性金属在阳极被氧化,失电子后以金属离子的形式进入介质层,并在电场作用下向阴极移动[16]。在阴极,迁移过来的金属离子得到从电极注入的电子被还原成金属态[3]。随着氧化还原反应的不断进行,在阴极被还原成金属态的金属离子越来越多,并以金属导电细丝的形式向阳极生长,当生长至阳极时,忆阻器即完成了由高阻到低阻的转变。当施加反向电场时,在惰性电极处沉积的金属原子再次被氧化为金属离子,在电场作用下向活性金属电极迁移并再次被还原为金属态。随着电压的不断增大,金属导电细丝在氧化还原反应以及焦耳热效应的共同作用下被熔断,忆阻器再次回到高阻状态[7]。

Figure 3 Model of Ag metal conductive filament图3 Ag金属导电细丝模型
Yang等[18]利用溅射二氧化硅作为阻变层材料,Ag作为活性金属电极,Pt作为惰性金属电极,通过原位TEM(Transmission Electron Microscope)的方法观察到Ag金属导电细丝的形成,如图3[18]所示。当对Ag电极施加正向偏压的情况下,在开始的一段时间内,随着电压的增大,忆阻器保持极小的电流不变,直到运行到26 s时,器件达到SET开启电压,Ag导电细丝形成并连接上下2电极,电流突然增加,忆阻器处于低阻状态。当施加反向偏压时,随着电压的增加,忆阻器保持低阻状态不变,直到达到RESET关闭电压时,Ag导电细丝断开,电流急剧减小,忆阻器处于高阻状态。在此过程中,Ag导电细丝的形成与断裂依赖于电场作用下Ag的氧化还原反应,在此过程中,还涉及到焦耳热效应。值得注意的是,从图3中可以很明显看出,在此过程中形成的导电细丝具有典型锥形特征,这与已经被研究的金属导电细丝形状基本一致。Waser等[19]发现锥形导电细丝薄弱位置位于活性电极处,这也是被人们所熟知并接受的锥形结构,然而图3中所示的导电细丝薄弱位置反而位于惰性电极Pt处,再对介质层中未完全形成的导电细丝进行观察也有类似结构,这种反锥形结构表明,在一些忆阻器件的工作过程中,介质/惰性电极的工作界面可能比介质/活性电极的工作界面更重要[18]。此外,Yoon等[11]在对Ru作为活性电极的研究中也发现了类似的反锥形Ru金属导电细丝。
3.3 纯电子机制
纯电子机制与阴/阳离子迁移机制有着本质的区别,其主要表现为阴/阳离子迁移机制是基于离子的迁移,在过程中涉及到化学氧化还原反应以及物理热效应;而纯电子机制只涉及到物理层面的电子转移,其通常基于电子的捕获与释放来实现器件高低阻间的转变[16],与之相关的忆阻行为主要有电子自旋阻塞效应和空间电荷限制效应SCLC(Space Charge Limited Current)等。
在基于电子自旋阻塞效应工作的忆阻器件中,其结构一般为半导体/半金属结构,半导体中有自旋向上和自旋向下2种方向的电子,半金属只捕获自旋方向与其极化方向相适应的电子,这必然会导致向上和向下2种自旋方向不同的电子密度产生差异,电流也因此发生变化,随着外加电场的增大,这种密度差异必将进一步扩大,当外加电场增加到某临界点后,可以被半金属捕获的电子密度非常小,此时半导体/半金属界面处的电流也不再增大并保持下去[20],器件表现为低阻状态。Pershin等[21]通过对半导体/半金属器件的研究,已成功设计出了基于电子自旋阻塞效应的忆阻器。
与电子阻塞效应不同,空间电荷限制导电效应(SCLC)是基于介质层中的缺陷对电子的捕获与释放来实现对忆阻器件高低阻态的调节,此过程中电子充当载流子。在初始状态下,当施加外部电压时,介质中的缺陷会捕获由电场注入的电子,导致介质层中电子的密度很低,器件表现为高阻态[16]。随着电压的不断增大,注入的电子也越来越多,当介质层中的缺陷被电子完全填充时,多余的电子即成为可以自由流动的载流子,电流快速增加,器件表现为低阻态。Bai等[22]在对Al/MoS2&PVP/ITO/PET复合材料结构忆阻器件的研究中发现,伴随着电压的不断增大,该器件高阻态的形成受SCLC阻变机制的影响,值得注意的是,SCLC阻变机制的形成是由于MoS2和PVP之间存在功函数差的关系。
3.4 其他机制
从理论而言,在一定条件下,若一个电子器件可以实现具有非易失性的高低阻状态之间的转变,并且具有可逆的电滞回窗口,则其可以被纳入忆阻系统,因此一些基于铁电[23,24]或铁磁[25,26]效应的忆阻模型也逐渐被提出,其忆阻行为通常与电场调控下自发极化或自发磁化所表现出的电或磁滞回特性有关。此外,除了上述机制外,适用于忆阻系统的阻变机制还包括相变机制和热化学机制等, 相变机制通常是指在一定条件刺激下,忆阻器材料将发生物相的改变,相变前后,器件具有不同的电阻状态。影响相变的因素有许多种,其中电致相变[27,28]和热致相变[29,30]得到了足够多的关注。
热化学机制通常是指随着温度的改变,忆阻器的电阻也发生相应的变化,其工作机理一般是由于温度改变诱发离子发生离散运动,进而形成或熔断连接上下2电极的导电通道,导致阻变现象的发生,导电通道可以是具有金属性质的氧化物,也可以是金属原子。因为反应过程依赖的是焦耳热效应,故通常表现为和电极极性无关的无极性阻变行为[31]。Jung等[32]在NiO器件中发现了具有温度依赖性的电阻转变行为,紧接着Park等[33]证实了温度的变化将影响基于NiOx器件的电阻状态,并解释此现象的发生是由于器件内部形成Ni原子金属导电通道。Kwon等[34]在研究中证明了由温度改变诱发TiO2中氧离子的运动,进而在2电极间形成了具有类金属性质的TinO2n -1通道,导致器件高低阻的转变,TinO2n -1从阴极向阳极生长,最薄的部分靠近阳极。Chen等[35]在ZnO器件中同样发现温度诱导下的氧离子迁移,这将导致器件内形成缺氧多锌具有金属性质的ZnO1-x导电通道,并通过透射电镜实时观察到导电通道的形成和断裂过程,同时也发现该导电通道最薄弱的地方位于阳极附近。
4 忆阻材料
忆阻材料的选择是构建忆阻器件极为重要的一步,其材料体系通常包括介质层材料和电极材料,二者的不同组合搭配可使忆阻器具有不同的阻变机制和性能。自从惠普实验室提出基于TiO2的忆阻器模型后[17],越来越多的新材料被发现适用于忆阻器,主要包括有机材料、氧化物材料、硫系化合物材料以及具有不同活性的电极材料。表2为基于不同材料忆阻器的典型性能参数对比。
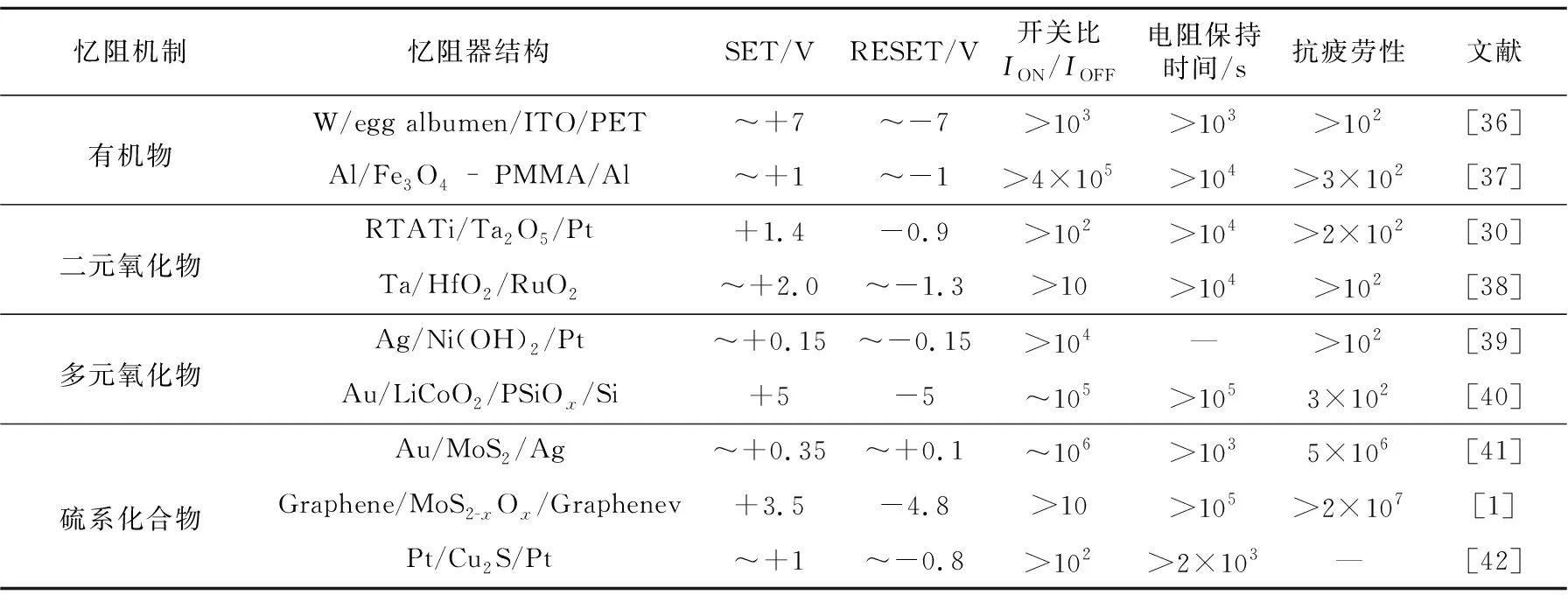
Table 2 Typical performance comparison of memristors with different materials
4.1 介质层材料
4.1.1 有机材料
在对忆阻器材料的研究中,有机材料因其较好的柔韧性、较简单的成膜机制、较低的成本、较高的生物兼容性,近年来被越来越多的人重视[7]。目前,常用于忆阻器的有机材料包括受生物启发的有机材料鸡蛋蛋白、丝素蛋白和牛血清白蛋白等;有机小分子材料TPP(TetraPhenylPorphyrin)、花生酸、索烃和轮烷等;有机高分子材料PMMA(PolyMethy1 MethAcrylate)、PVP(PolyViny1 Pyrrolidone)、PANI(PolyANIline)和MEH-PPV等。有研究表明,在基于不同有机材料的忆阻器中,阴离子迁移机制[43]、阳离子迁移机制[36]和纯电子机制[37]都有可能发生。Yan等[36]制备了基于鸡蛋蛋白膜的忆阻器,研究发现该“三明治”结构的器件不仅具有较好的柔韧性,而且可以实现对突触行为的模拟。李腾飞[43]构建了基于ZnTPP的有机二极管忆阻器,与无机材料忆阻器对比发现,该器件可通过氧离子和锌离子配位键的形成与断开实现对载流子迁移的精准调控,从而实现了平滑稳定的阻变行为,并成功构建了基于有机二极管的多功能忆阻器。
单一的有机材料并不能体现其在忆阻器应用方面的优势,近年来,有研究人员发现,通过将有机材料与无机材料结合,可以制备出性能更加优异的忆阻器。Lin等[37]通过复合Fe3O4与PMMA薄膜,发现其可以用于制备柔韧性更高的忆阻器。李新月等[44]进一步对PMMA薄膜研究发现,基于ZnO/PMMA复合材料的忆阻器件Pt/ZnO-PMMA/Al(如图4所示)[44]具有良好的柔韧性,并发现这一性能与ZnO/PMMA复合后高的机械耐受性和低的杨氏模量有关,证实了PMMA薄膜在柔性忆阻器中良好的应用前景。
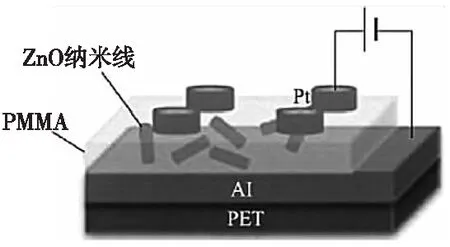
Figure 4 Pt/ZnO-PMMA/Al memristor图4 Pt/ZnO-PMMA/Al忆阻器模型
值得注意的是,有机材料在高温下呈现出的热敏感性,对忆阻器的稳定性有较大影响,而且为了适用于大规模集成电路,其与CMOS技术的兼容性仍需进一步提高,相比较之下,无机材料在忆阻器方面的应用更为广泛,尽管如此,仍不能忽视有机材料在忆阻器某些特定层面的应用价值。
4.1.2 二元氧化物材料
在忆阻器的发展历史中,二元氧化物材料一直扮演着一个重要的角色,基于二元氧化物材料的忆阻器拥有相对稳定的性能、较大的存储密度和较快的开关速度,而且与互补金属氧化物半导体(CMOS)具有良好的兼容性,适用于当前大规模集成电路。目前已经被用于忆阻器研究的二元氧化物材料有HfOx、TaOx、WOx、TiOx、ZnOx、AlOx、MnOx、ZrOx、NiOx、SiOx、MoOx、FeOx、CoOx、SnOx、SbOx和GaOx等,其中对HfOx、TaOx、TiOx和SiOx的研究更为活跃,这些二元氧化物忆阻器通常以基于氧空位的阴离子迁移机制为主[10,30,38,45]。此外,有一部分的二元氧化物材料可能涉及到基于陷阱捕捉的纯电子机制[46],同时一些基于活性电极的二元氧化物忆阻器还可能出现阳离子迁移机制和阴离子迁移机制共存的现象[47]。
在上述二元氧化物中,x代表金属原子与氧原子的比值,其x值的大小对忆阻器的性能有较大的影响,因此对x值的探究就变得格外重要。Wei等[45]在对基于TaOx忆阻器的研究中发现,氧化层的电阻率随该层氧浓度的增加呈现出指数增长。Baek等[48]通过改变TaOx层中O/Ta的比率,证明了该比率值的大小将影响忆阻器的电阻开关能力以及高低阻的电阻比。Voronkovskii团队[49]制备了基于HfOx的忆阻器件,其中x代表Hf/O的比值,并详细研究了x值的大小对忆阻器性能的影响。通过在硅衬底上沉积不同氧浓度的HfOx薄膜,可获得氧分压与x之间的关系,如图5a所示。利用这个相关性可以研究实验中每个样本的x值。此外,在对HfOx薄膜的研究中发现,HfOx薄膜中存在3种相,分别为:Hf;Hf4O7;HfO2,参数x的大小将会影响这些相在薄膜中存在的比例。如图5b所示,在成形过程后,对样品I-V曲线的测量表明,只有x值在1.78~1.81非常窄的范围内,才能实现重复电阻切换。如图5c所示,当氧化铪薄膜中的氧浓度从最高的样品6降低到最低的样品1时,HfOx的电导率迅速增加了近10个数量级。尽管基于HfOx的忆阻器在参数x不同的情况下,其性能差别较大,但是其薄膜内部所形成的导电细丝化学成分和尺寸几乎相同,而且导电细丝可能不具有金属性质,而表现为半导体性质。
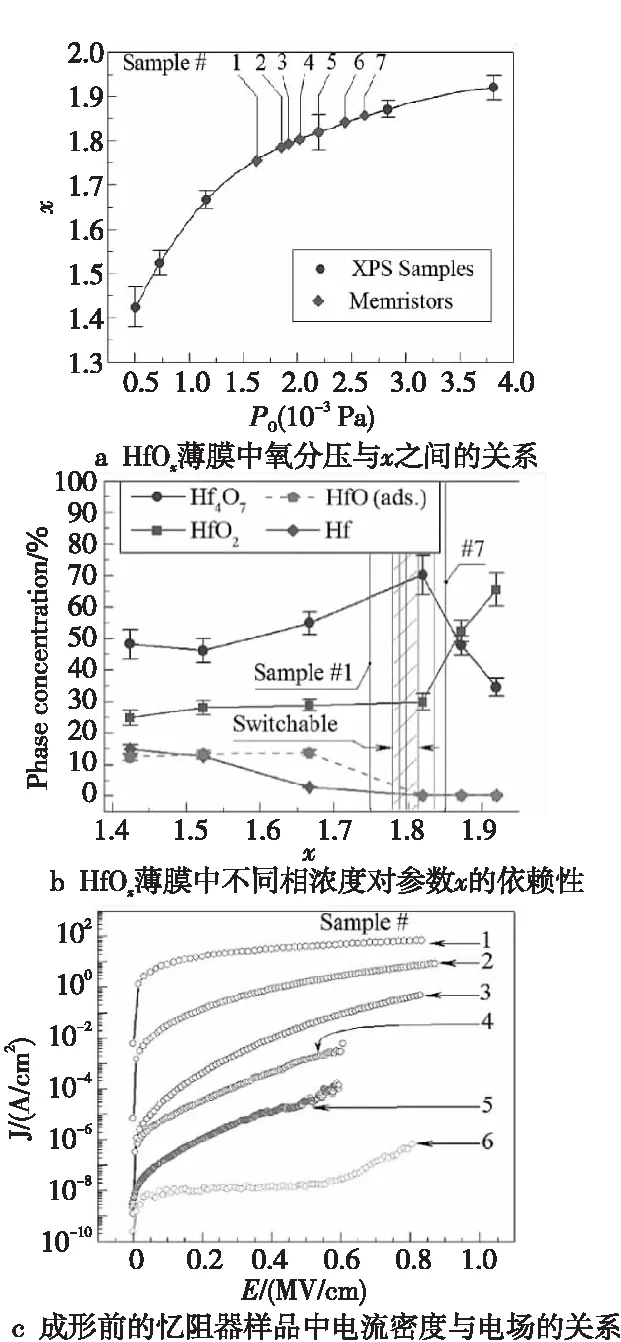
Figure 5 Effect of the Hf/O concentration ratio x on HfOx-based memristor electrical characteristics图5 Hf/O浓度比值的大小对HfOx基忆阻器电学性质的影响
4.1.3 多元氧化物材料
多元氧化物是多种金属组成的氧化物材料,与二元氧化物类似,在不同的多元氧化物基忆阻器中,阴离子迁移机制、阳离子迁移机制和纯电子机制也都有可能发生[13,39,50]。目前已经应用于忆阻器研究的多元氧化物有PryLa0.625-yCa0.375MnO3等五元氧化物,(LaSr)MnO3、La0.33Sr0.67FeO3、Pr0.7Ca0.3MnO3等四元氧化物,LiCoO2、SrZrO3、SrRuO3等三元氧化物。相比于二元氧化物,其成分组成较为复杂,所形成的晶体形状难以精确控制,而且与CMOS兼容性不好,这些限制了其在忆阻器方面的应用。但是,必须要承认的是多种金属离子的组合也可能为忆阻器的性能带来一个大的提升。由于Li离子优异的电化学特性,近年来在存储方面得到广泛的应用,其在忆阻器方面的应用也被越来越多的研究人员重视。Mai等[51]研究了基于LiCoO2的Pt/LiCoO2/Si结构的忆阻器,在该忆阻器中,Pt和Si分别用作锂离子存储器的正负极材料,并且其电导率受Li离子浓度的影响。研究发现,由于锂离子在运输中势垒较低,使忆阻器具有较低的阈值电压,故可用于多状态存储,同时发现基于LiCoO2的忆阻器具有稳定的电阻状态。为了调节锂离子的扩散,防止电极之间短路,并增强器件的保持力,Hu等[52]在LiCoO2基忆阻器中引入了缓冲层SiO2,研究发现SiO2可以在没有外部电场的情况下捕获Li离子,改善了LiCoO2基存储器的性能。在此基础上,Gao等[40]研究了具有多孔结构的忆阻器Au/LiCoO2/PSiOx/Si,结果表明该忆阻器具有高达105的通断比以及大于105s的忆阻保持时间,并可以将Li离子保存在多孔结构中,提高了器件的稳定性和重复性。有研究发现拥有多层多孔结构的忆阻器在模拟神经网络计算方面,具有很高的应用价值。
4.1.4 硫系化合物材料
硫系化合物的内部拥有大量的缺陷,非常有利于离子运输。基于硫系化合物的忆阻器通常以阳离子迁移机制为主[16,41],此外,当硫系化合物和有机物结合使用时,可能会导致基于电荷俘获与释放的纯电子机制[14],当硫系化合物被氧化时,可能会导致基于氧空位的阴离子迁移机制[1]。其活性电极材料主要为Ag、Cu等活性较高的金属。目前已经应用于忆阻器研究的硫系化合物有MoS2、Cu2S、GexSx、As2S3、GexSey、GexTey、GeSbTe等。研究表明,硫系化合物可以作为制备高速以及多值电子器件的候选者之一[16,22,41,42],高速特性可以满足人们对读写速度的要求,多值特性可以应用于忆阻器的高密度存储以及模拟神经网络计算。值得注意的是,在硫系化合物中,金属或新型材料的掺杂可能对硫系化合物的物理化学性质带来很大的改变。以GeTe材料为例,单纯的GeTe材料内部有2种结构:一种为四面体结构,难以被晶化;一种为八面体结构,容易被晶化,而掺杂Ag以后将引导GeTe材料内部的八面体结构向四面体结构转化,提高了稳定性。此外,陈建文[16]通过对基于AgGeTe材料的忆阻器研究发现,当限制电流较小时,在介质层内部形成了游离的金属团簇,此时以电子跃迁导电机制为主,随着限制电流的增大,其内部的局域状态也在发生改变,直到形成完整的导电细丝。在这个过程中,忆阻器在不同的局域状态下,其内部存储属性是不同的,对外则表现为多值特性。在基于MoS2的忆阻器件中,研究人员同样发现了该器件具有多值特性。Bai等[22]通过将新型材料PVP与MoS2复合制备了Al/MoS2&PVP/ITO/PET忆阻器,如图6[22]所示。该器件在原始高阻状态下,其内部存在3种不同的晶界,并在电场作用下随机形成3种不同的导电细丝,即有3种不同的阻变状态,在存储方面则变现为多值特性,进一步可延伸为在单个忆阻器中实现多级存储。
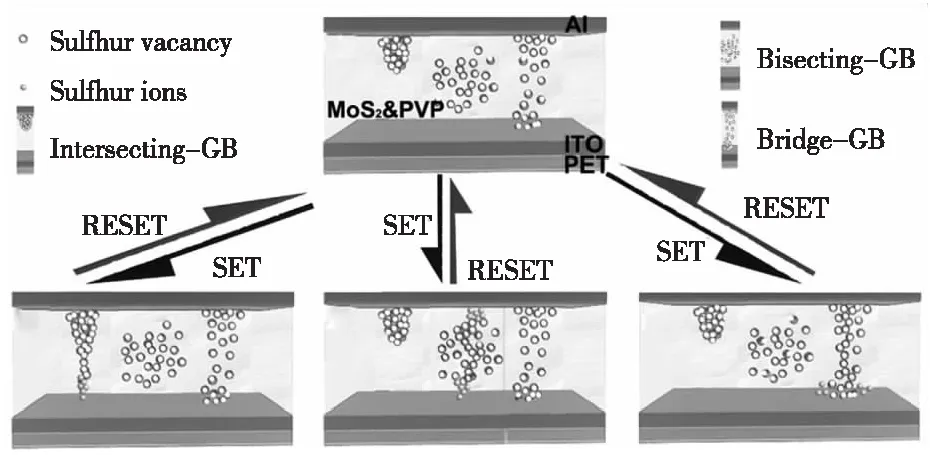
Figure 6 Three switching mechanisms of Al/MoS2&PVP/ITO/PET memristor图6 Al/MoS2&PVP/ITO/PET忆阻器的3种开关机制
4.2 电极材料
目前被人们所熟知可以用作忆阻器电极材料的金属主要分为2类:一类为金属材料,包括活性金属Cu、Ag、Ru等,惰性金属Pt、Pd、Au、W等;另一类为化合物材料,包括氧化物SrRuO3、LaAlO3、ITO、IZO等,氮化物TaN、TiN等。基于不同电极材料组装成的忆阻器,其阻变机制以及电化学性能往往都是不同的。例如,以活性金属/介质层/惰性金属组装的忆阻器,其阻变机制以阳离子迁移机制为主,而以惰性金属/介质层/惰性金属组装成的忆阻器,其阻变机制通常情况下为阴离子迁移机制,类似的组装还有很多。但是,值得注意的是,每一次电极材料的改变可能都是一个新忆阻器的诞生。
阻变机制是基于活性金属Ag或Cu离子迁移的忆阻器通常开关电流较低,而且记忆保持能力较差,但同为活性金属电极材料的Ru却可以在实现低开关电流的同时又表现出高的可靠性。如图7[11]所示,Yoon团队[11]在对Ru作为顶电极的忆阻器件Ru/Ta2O5/Pt研究中发现,该器件在不同阻态时具有不同的传导机制。在器件处于原始高阻态时,是基于氧空位的热激活电子跃迁传导机制;处于高阻与低阻的中间态时,也是属于电子跃迁传导机制的范畴,但与原始高阻态不同的是,这个过程是以Ta2O5纳米团簇以及分散的Ru或RuO作为跳跃位点;处于初始低阻态时,器件并没有形成连续的Ru金属导电丝,而是形成了不连续的导电细丝和分散的纳米团簇,并基于纳米团簇的隧穿传导机制进行电子传导;处于低阻态完成时,该器件最终形成了基于Ru金属导电细丝的传导机制。这种独特的传导机制表明基于金属电极Ru的忆阻器具有广阔的应用前景。

Figure 7 Models of Ru/Ta2O5/Pt memristor in different resistance states and I-V curves at different temperatures图7 Ru/Ta2O5/Pt忆阻器在不同阻态的模型图及不同温度下的I-V曲线
在基于化合物电极材料忆阻器的研究中,Yoon等[53]制备了Pt/TiO2/SrRuO3忆阻器件,并观察到基于阳离子迁移机制的双极性电阻转变行为;Liu等[54]制备了W/WO3-x/ITO忆阻器件,详细研究了欧姆或整流的W/WO3-x结对忆阻器件的影响,结果发现只有欧姆型的W/WO3-x结才会使忆阻器表现出典型的突触特性;Yakopcic等[55]研究了2电极均为TiN的TiN/TaOx/Ta/TiN 结构忆阻器;紧接着Solan等[56]研究了类似的TiN/Ti/HfO2/TiN结构忆阻器,这2种器件均具有基于氧空位迁移的双极性开关行为,并可以应用于神经形态计算。Mahata等[9]制备了顶电极为TaN、底电极为ITO的TaN/HfO2/Al2O3/HfO2/ITO复合结构忆阻器,如图8[9]所示,发现电场作用下氧离子的迁移导致在2种不同介质中形成了非对称的导电通道,导电通道的最薄弱环节出现在2种介质层的界面处,同时观察到该器件具有大于103的抗疲劳性,大于104s的电阻保持时间以及电场改变时表现出的多电导行为。
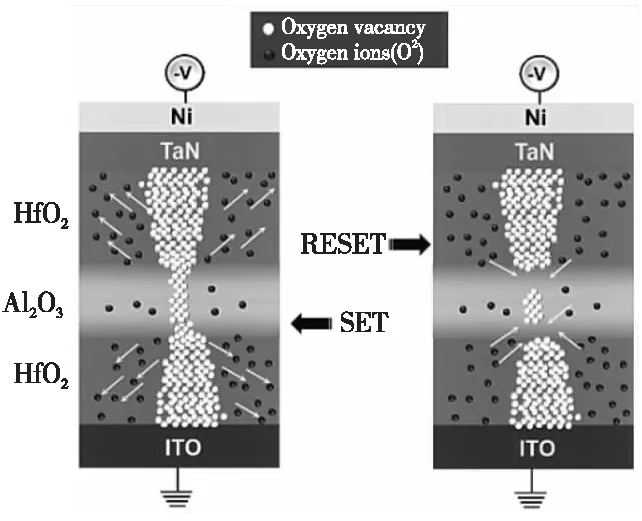
Figure 8 Schematic of resistive switching mechanism of the TaN/HfO2/Al2O3/HfO2/ITO图8 TaN/HfO2/Al2O3/HfO2/ITO忆阻开关机制
除上述材料外,石墨烯作为一种高电导率材料,因其独特的二维碳纳米结构逐渐成为忆阻器电极材料研究的热点。Wang等[1]利用射频磁控溅射的方法制备了graphene/TiOx/Ti/Pt复合结构的忆阻器,石墨烯作为底电极,通过与铂作为底电极的忆阻器件Pt/TiOx/Ti/Pt对比发现,底电极材料为石墨烯的忆阻器不仅具有较小的功率,而且还可以保持高低阻态长时间不变。Arashloo等[57]在基于氧化石墨烯忆阻器的研究中也证明了石墨烯的引入确实可以降低忆阻器的功率。随着研究的深入,石墨烯有潜力作为一种良好的材料被越来越多地应用于忆阻器的研究。
5 忆阻器的应用
随着互联网的不断发展,数据量呈现指数增长,人们对以数据为中心的任务能效和处理速度有了更高的要求。传统的基于冯·诺依曼架构的硬件平台存储和计算是分离的,信息处理和存储单元之间不断的数据转移显著限制了速度和能源效率,这被称为“冯·诺依曼瓶颈”,此外,2个单元之间的性能不匹配会导致冯·诺依曼架构出现相当长的延迟。这些传统计算机的缺点限制了当今互联网的发展,忆阻器能够将信息存储和逻辑计算整合到一个电子元件上,故可以作为解决这些问题的一种有效途径。近年来,关于忆阻器在计算方面的应用,主要包括数字型的布尔逻辑计算和模拟型的神经形态计算。
5.1 基于忆阻器的布尔逻辑计算
区别于传统上通过高低电压来表示的逻辑“0”和“1”,基于忆阻器的布尔逻辑通过忆阻器的高低阻态来执行逻辑“0”和“1”,同时其还可以利用忆阻器的阻态来保存逻辑运算信息,即使在突然断电后信息也不会丢失,这展示了忆阻器在存内计算的广阔应用前景,因此越来越多的研究致力于基于忆阻器的布尔逻辑函数实现。
惠普实验室Borghetti等[58]通过由Pt/Ti/TiO2/Pt 忆阻器搭建的电路首次在物理上实现了蕴含逻辑,通过执行蕴含逻辑和清零可以实现全部16种布尔逻辑运算。Li等[59]基于一个通用的逻辑表达式,在忆阻交叉杆结构中,通过Ag/ AgGeTe/Ta忆阻器分2步实现了完整的16个布尔逻辑中的任意逻辑,同时演示了具有代表性的功能完整的与非门逻辑。Xu等[60]制备了TiN/Ta2O5/SiO2/Ta2O5/TiN结构的忆阻器,可以在少于3个步骤的情况下,在单个设备中实现所有16种可能的布尔逻辑,同时基于该忆阻器演示了一种高效率的硬件加密系统,其中加密和解密过程均由基于忆阻器的XOR逻辑执行,加密密钥由随机的电阻开关效应提供。Yuan等[61]制备的Pt/Ta/Ta2O5/Pt/Ti结构的忆阻器不仅在同样条件下实现了所有16种可能的布尔逻辑,而且其过程不需要初始化,同时通过提高效率的1位全加器和2位乘法器展示了存内计算功能。Zhou等[62]设计了一种具有三端Pt/SiO2/Pt/Ag/GeTe/Ta结构的非易失性数字逻辑系统,通过实验实现了可编程的非易失性布尔逻辑门,同时演示了一种包括D锁存器和D触发器在内的时序逻辑块。Yadav等[63]使用MAGIC(Memristro Aided loGIC)设计风格将NOT和NOR门映射到忆阻器交叉开关阵列,在忆阻器阵列中实现了存内计算,通过与以往研究工作进行比较发现,基于该结构的忆阻器数量、延迟时间、忆阻交叉开关大小和能量利用均得到了一定的改善。
5.2 基于忆阻器的神经形态计算
神经形态计算一般是指从大脑的拓扑结构中汲取灵感,以构建由物理神经元组成的电路,这些神经元由物理突触相互连接,并以非易失性方式在原位实现存储,从而显著削减了需要在电路周围移动的数据,并在速度和能源效率方面获得可观的收益[64]。如果仅使用当今CMOS技术实现此步骤,往往需要数十个晶体管来模拟每个神经元,并且还需要额外的外部存储器来实现突触,很难实现神经元之间的高度互连,同时受芯片面积的限制,必然会造成芯片的密度损失。因此,迫切需要开发具有低能耗和高耐久性的可以模仿神经元和突触的纳米级设备。忆阻器可以很好地在物理上实现突触的功能,外部神经元可以由数字或模拟的CMOS来实现,搭建CMOS/忆阻器混合系统是实现神经形态计算的一种有效途径[5]。
图9是用于进行形态计算的忆阻交叉开关模型图。左边圆形代表输入神经元,其输入为电压信号,下边圆形代表输出神经元,其输出为电流信号,每个交叉点都是一个忆阻器,流经电流都是输入电压和忆阻器电导的乘积,遵循欧姆定律,从阵列底部的每个电极流出的电流实际上是施加在阵列的每一行上的输入电压经过忆阻器电导加权后的总和[65]。忆阻器通过基尔霍夫定律直接实现乘法与累加运算,其满足公式:
其中,Vi代表第i行输入电压,Gij代表第i行第j列忆阻器的电导,Ij代表第i行的所有电压经过忆阻器电导Gij加权后的总和。

Figure 9 Model of memristive crossbar array图9 忆阻交叉阵列模型
在该模型中,流经网络的信息是电流,为了调节信息流,突触应充当电流的阀,这样的阀可以用忆阻器来实现,同时可以通过施加的电压对忆阻器突触的电导状态进行调节。忆阻器的电导状态具有非易失性,可以实现信息的原位存储,同时可以在全模拟状态下进行信息处理,过程中不涉及模数转换,故基于忆阻器的神经形态计算系统可以实现高效率、低功耗的信息存储与处理。Lu等[66]制备了具有阈值开关特性的忆阻器Ag/TiN/HfAlOx/Pt,研究结果表明,构造神经形态系统的必要条件是获得具有低功耗、高速度的开关器件;Wang等[67]将1T1R忆阻交叉阵列与视网膜形态传感器连接,实现的神经形态视觉系统支持快速的字母识别和物体跟踪,表明了其在全模拟状态下的图像传感、处理和识别能力。
尽管忆阻器在类脑神经形态中拥有出色的表现,但是我们也不得忽视其应用中可能存在的一些尖锐问题,例如忆阻器开关过程的随机性,权重调整的精度,电压改变时引起的非需要权重变化,在构建大规模忆阻阵列时难以完全避免的潜行路径信号以及导线电阻等,如果这些问题得不到解决,将在一定程度上阻碍忆阻器的进一步发展。
6 结束语
尽管对忆阻器的研究集中在追求其忆阻性能的提高,然而在这个过程中仍不能忽视其与当前CMOS电路的兼容性,这将决定忆阻器能否迅速被市场接受并大规模应用。因此,对忆阻器材料的探究就显得格外重要,同时这个过程也离不开对不同材料阻变机制的研究,准确清晰地认识阻变机制可以逆向调控材料的阻变性能。相比专注于对忆阻材料化学性质改变的探究,近年来对材料物理性质的调控也逐渐被重视,二维材料因其尺寸小、密度高、易于调控,被越来越多地应用到忆阻器中。此外,忆阻器因具有与神经突触非线性传输类似的性质,在模拟神经网络并应用于人工智能方面也成为当今世界研究的热点。
目前,在忆阻器研究中还存在一些问题未被完全解决,如何精确调控忆阻器中电学参数的离散性,如何更好地降低串生电流对忆阻器阵列工作的影响,如何在提高忆阻器阻变性能的同时兼顾其与CMOS电路的兼容性等,都是研究人员必须要面对的,伴随着这些问题的解决,忆阻器的发展也必将进入一个全新的时代。
