Be, Si 掺杂调控GaAs 纳米线结构相变及光学特性*
2021-12-23亢玉彬唐吉龙李科学李想侯效兵楚学影林逢源王晓华魏志鹏
亢玉彬 唐吉龙† 李科学‡ 李想 侯效兵楚学影 林逢源 王晓华 魏志鹏
1) (长春理工大学, 高功率半导体激光国家重点实验室, 长春 130022)
2) (长春理工大学理学院, 长春 130022)
(2021 年4 月23 日收到; 2021 年5 月25 日收到修改稿)
1 引 言
GaAs 材料具有直接带隙、高电子迁移率等优良属性, 被广泛应用在场效应晶体管[1]、激光器[2]、光电探测器[3]和光伏器件[4]等领域. GaAs 纳米线因在光子集成器件中前景广阔而备受关注, 高质量GaAs 纳米线的可控制备是器件实用化的前提,过去的几十年里, GaAs 基纳米线的生长机制得到了广泛的研究, 通常GaAs 薄膜材料为立方闪锌矿(zinc blende, ZB)结构, 但随着尺寸的减小, 一维纳米材料中出现了六方纤锌矿(wurtzite, WZ)相[5]. WZ/ZB 混合相的存在对纳米线的电学和光学性能产生了严重的影响, 显著降低了纳米线中载流子迁移率和辐射复合效率[6-8]. 2009 年, Parkinson等[6]观察到堆垛层错密度的增加使GaAs 纳米线的载流子迁移率从2250 降低到1200 cm2/(V·s).Thelander 等[7]在InAs 纳米线中观察到了WZ/ZB混合相比单一相高2 个数量级的电阻率. 2013 年,Woo 等[8]对生长的InP 纳米线室温光致发光光谱测试, 发现无缺陷纯相ZB 结构纳米线发射强度是具有孪晶缺陷或混相结构纳米线发射强度的7 倍.WZ 结构和ZB 结构之间的多型晶界作为电子和声子的散射中心, 对电子和声子输运产生不良影响.因此消除WZ/ZB 混相结构及降低纳米线的缺陷对提高载流子传输和器件性能具有决定性作用.
近几年, 大量研究工作致力于开发将WZ/ZB混相结构转变为纯相ZB 或者WZ 结构生长工艺.主要是通过控制纳米线的生长条件和表面能(生长温度[9], V/III 比率[10]和液滴的形状[11,12], 引入Sb合金[13,14], 掺杂[15-17]等)实现单一相. 大多数报道局限在纳米线的结构控制, 对其光学特性研究相对较少. 尤其是对通过不同杂质掺杂GaAs 纳米线的发光来源有待深入研究.
本文采用超高真空分子束外延(molecular beam epitaxy, MBE)结合自催化的生长方式制备了本征、Si 掺杂和Be 掺杂GaAs 纳米线, 对其结构和光学特性进行分析. Raman 光谱显示本征GaAs 纳米线存在一个明显的WZ 结构特有的E2 模式峰, 掺杂GaAs 纳米线的E2 模式峰明显减弱甚至消失. GaAs 纳米线的高分辨透射电镜(highresolution transmission electron microscope,HRTEM)及选区电子衍射(selected area electron diffraction, SAED)显示掺杂可以明显降低WZ 结构的密度, 使得WZ/ZB(本征GaAs 纳米线)混相结构转变为ZB(掺杂GaAs 纳米线)结构. 在此基础上对其光学特性研究, 光致发光(photoluminescence, PL)光谱发现本征、Si 掺杂和Be 掺杂GaAs纳米线都存在两个主要的发光峰. 本征GaAs 纳米线发光源于自由激子发光和II-型结构的发光, Si掺杂GaAs 纳米线发光来源为导带到受主的发光及施主受主对的发光, Be 掺杂GaAs 纳米线发光来源为自由激子及导带到受主的发光. 低温PL 光谱对比显示, 光谱成分由掺杂前WZ/ZB 混相结构的发光转变为以掺杂后杂质缺陷相关的发光为主导.
2 实 验
实验采用超高真空MBE 系统(DCA P600)在Si(111)衬底上制备了本征, Si 掺杂和Be 掺杂GaAs 纳米线. 本征GaAs 纳米线的生长温度为620 ℃, Ga 束流为8.26 × 10–6Pa, V/III 比率为25.8.Si 掺杂和Be 掺杂GaAs 纳米线的生长条件和本征GaAs 纳米线相同, 在生长GaAs 纳米线的过程中打开Si 源或者Be 源, Si 源的温度为1240 ℃,Be 源的温度为835 ℃. 所有样品在As 束流的保护下结束生长, 冷却至300 ℃以下. 待样品自然冷却到室温下取出样品.
用场发射扫描电镜(scanning electron microscopy, SEM, 日立FE-S4800)对生长的样品的形貌进行表征, 获得GaAs 纳米线的形貌. 采用Lab-RAM HR Evolution, HORIBA 光谱仪获得GaAs纳米线的Raman 光谱, 通过WZ 结构的特征模式峰E2 来确定GaAs 纳米线结构[18-21], 其中激光器波长为532 nm. 通过高分辨透射电镜(HRTEM,FEI Tecnai G2-F20)及配套的选区电子衍射(SAED)进一步确定GaAs 纳米线的晶体结构. 采用HORIBA iHR550 光谱仪进行低温变功率PL 光谱测试, 使用655 nm 半导体二极管激光器作为激发源,光斑大小约为0.4 cm2.
3 结果与讨论
图1(a)—(c)所示为自催化生长获得的本征、Si掺杂和Be 掺杂的GaAs 纳米线的SEM 侧视图.其中本征和Si 掺杂纳米线呈现不规则杂乱分布,Be 掺杂的纳米线与衬底垂直分布且一致性较好,表明Be 掺杂纳米线具有较高的结晶质量. 为了确定掺杂前后GaAs 纳米线中晶体结构的情况, 进行了Raman 光谱测试, 通过WZ 结构中特有的E2 模式峰来确定纳米线的结构. 对于GaAs 纳米线, 对应的Raman 光谱通常存在三种模式的峰,分别是横光学模TO (~267.2 cm–1), 表面光学声子SO (~286 cm–1)和纵光学模LO (~291.2 cm–1)[19-21].而对于存在WZ 结构的GaAs 纳米线, 除了存在以上三种模式的峰之外, 还存在一个WZ 结构对应的模式峰, 对应的峰位~259 cm–1[19-21]. Raman 光谱如图2(a)所示, 本征GaAs 纳米线存在E2, TO和LO 模式峰, 而Si 掺杂和Be 掺杂并没有发现明显的E2 模式峰. 为了更好地说明掺杂之后GaAs 纳米线的结构的变化, 进行多洛伦兹拟合, 如图2(b)—(d)所示. 图2(b)显示明显的GaAs E2 模式峰, 证实本征GaAs 纳米线的结构为WZ/ZB 混相结构.图2(c)显示Si 掺杂GaAs 纳米线存在微弱的GaAs E2 模式峰, 证实Si 掺杂GaAs 纳米线的晶体结构主要为ZB 结构. 图2(d)显示Be 掺杂GaAs 纳米线没有GaAs E2 模式峰, 因此Be 掺杂GaAs 纳米线为ZB 结构. 根据GaAs 纳米线多洛伦兹拟合的结果, 掺杂GaAs 纳米线中LO 半高全宽(full width at half maximum, FWHM)展宽, 同时LO 与TO强度的比值下降, 因此再次说明了Si 和Be 的有效掺杂[22,23].

图1 GaAs 纳米线SEM 侧视图(a)本征GaAs 纳米线; (b) Si 掺杂GaAs 纳米线; (c) Be 掺杂GaAs 纳米线Fig. 1. The side-view SEM images of GaAs NWs: (a) Intrinsic GaAs NWs; (b) Si-doped GaAs NWs; (c) Be-doped GaAs NWs.
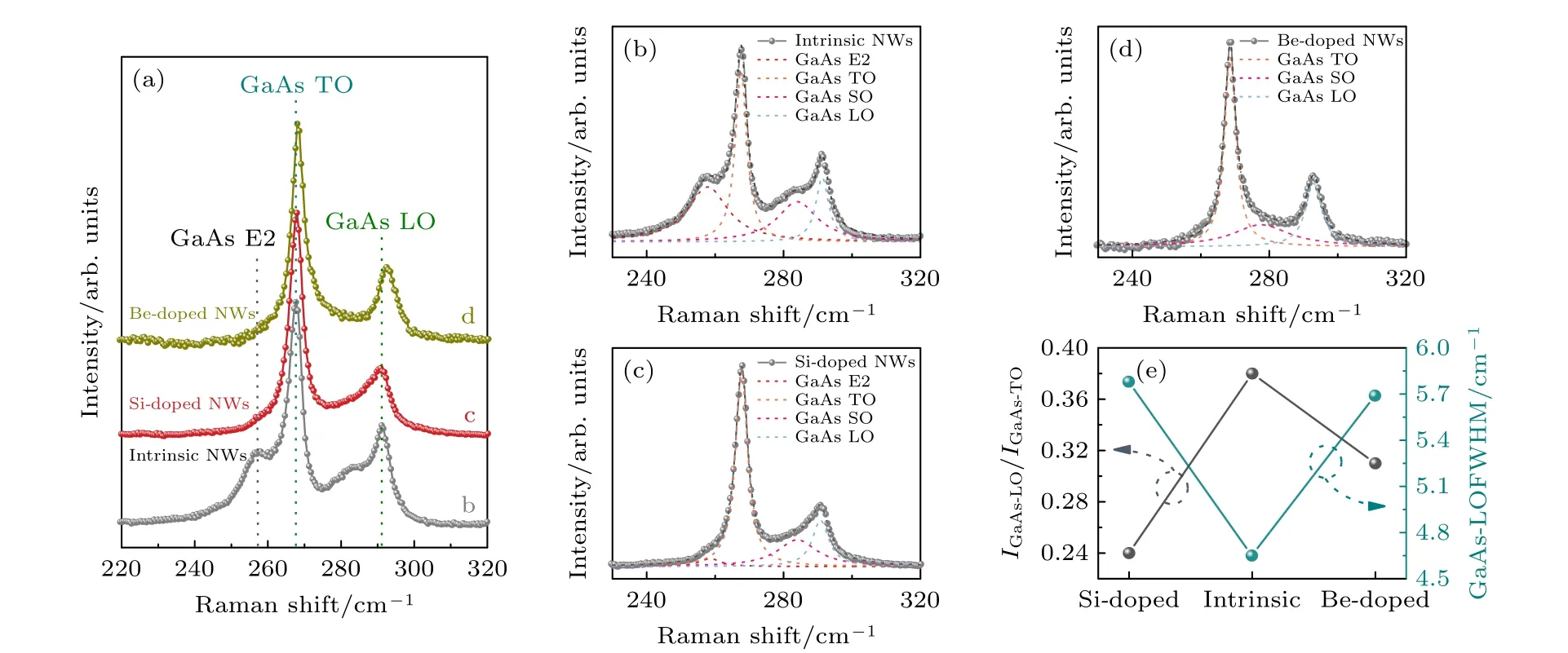
图2 (a)本征, Si 掺杂及Be 掺杂GaAs 纳米线的Raman 光谱; (b)本征, (c) Si 掺杂和(d) Be 掺杂GaAs 纳米线的多洛伦兹拟合图; (e)所有GaAs 纳米线的GaAs LO 与GaAs TO 强度比值及GaAs LO 的FWHM 图Fig. 2. (a) The Raman spectra of intrinsic, Si-doped and Be-doped GaAs NWs; (b) intrinsic, (c) Si-doped, and (d) Be-doped GaAs NWs are fitted by multi-Lorentzian functions; (e) intensity ratio of ILO/ITO and FWHM of GaAs LO for intrinsic, Si-doped and Bedoped GaAs NWs.
为了更清楚地阐明本征、Si 掺杂和Be 掺杂GaAs 纳米线的晶体结构, 对其进行TEM 测试,如图3 所示. 图3(a)—(c)是本征GaAs 纳米线的低分辨TEM、高分辨TEM 及对应的选区电子衍射图样. 本征GaAs 纳米线的选区电子衍射图样存在三套衍射斑, 两套来自于ZB 结构, 一套来自于WZ 结构. ZB 结构的衍射斑通过蓝色和红色虚线标记, 而WZ 结构的衍射斑通过黄色虚线标记. 因此可以得到本征GaAs 纳米线为WZ/ZB 混相结构且存在大量的缺陷. 通过低分辨TEM、高分辨TEM及对应选区电子衍射图样表征Si 掺杂GaAs 纳米线的晶体结构, 如图3(d)—(f)所示. 图3(e)显示Si 掺杂GaAs 纳米线为ZB 结构, 且存在多个孪晶面(twin planes, TP), 通过白色箭头标记. 图3(f)显示了两套ZB 结构对应电子衍射斑, 分别被蓝色和红色虚线标记, 因此可以得到Si 掺杂GaAs 纳米线为纯相ZB 结构. 通过低分辨TEM, HRTEM和选区电子衍射图样对Be 掺杂GaAs 纳米线的晶体结构进行表征, 如图3(g)—(i)所示. HRTEM 及选区电子衍射图样显示Be 掺杂GaAs 纳米线为ZB结构. 因此, 掺杂实现了GaAs 纳米线的相控制,这与Raman 光谱测试结果一致.

图3 GaAs 纳米线的TEM 和选区电子衍射图. 本征GaAs纳米线 (a)低分辨TEM, (b)高分辨TEM 及(c)对应的选区电子衍射图样; Si 掺杂GaAs 纳米线(d)低分辨TEM,(e)高分辨TEM 及(f)对应的选区电子衍射图样; Be 掺杂GaAs 纳米线(g)低分辨TEM, (h)高分辨TEM 及(i)对应的选区电子衍射图样Fig. 3. TEM and SAED of GaAs NWs: (a) Low-TEM, (b)HRTEM and (c) SAED of intrinsic GaAs NW; (d) low-TEM, (e) HRTEM and (f) SAED of Si-doped GaAs NW;(g) low-TEM, (h) HRTEM and (i) SAED of Be-doped GaAs NW.
在此基础上, 研究掺杂对GaAs 纳米线光学特性的影响. 图4 显示了本征、Si 掺杂和Be 掺杂GaAs纳米线的低温(10 K)光致发光光谱. 本征GaAs纳米线的PL 光谱显示两个主要的发光峰, 标记为A和B, 对应的波长(能量)分别为818.4 nm (1.515 eV)和831.1 nm (1.492 eV). 立方相ZB 结构的GaAs 体材料激子跃迁峰位(能量)约为816.3 nm (1.519 eV).Si 掺杂GaAs 纳米线的PL 光谱显示明显的展宽峰, 且包含两个主要的发光峰, 标记为C 和D, 对应的波长(能量)分别是828.8 nm (1.496 eV)和848.7 nm (1.461 eV). 另外, Be 掺杂GaAs 纳米线的PL 光谱也显示两个明显的发光峰, 标记为E 和F, 对应的峰位分别是816.4 nm (1.519 eV)和828.3 nm (1.497 eV).
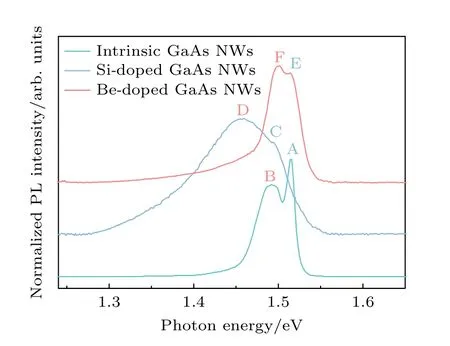
图4 本征, Si 掺杂和Be 掺杂GaAs 纳米线的低温(at 10 K)下光致发光光谱, 激发光源的功率密度为300 mW/cm2Fig. 4. The PL spectra of intrinsic, Si-doped and Be-doped GaAs NWs at low temperature (10 K). The power density of the excitation light source is 300 mW/cm2.
为了确定本征GaAs 纳米线的发光来源, 本文进行低温变功率光谱测试(图5). 图5(a)显示随着功率密度的增加, 峰P(A)的峰位没有变化, 而峰P(B)的峰位随着功率密度的增加存在小幅度的蓝移, 该现象是由II-型能带弯曲效应所引起[24,25].峰P(A)和P(B)的积分强度与激发功率密度之间的关系如(1)式所示[25,26]:

其中,I0为激光辐射功率,η为辐射效率, 指数α被用来判断辐射复合机制.α的值在1 和2 之间, 发光源于激子复合;α的值约2 时, 为导带-价带之间的发光;α的值小于1 时, 发光来源为缺陷或者杂质相关的发光. 本征GaAs 纳米线的峰P(A)和峰P(B)对应的α值分别为1.58 和0.86, 如图5(b)所示, 因此可以确定峰P(A)为自由激子发光, 峰P(B)为缺陷或者杂质之间的发光. 对于本征GaAs 纳米线由于没有引入掺杂, 所以可以确定峰P(B)源于缺陷的发光. 在这里, 构建功率的1/3 次方(P1/3)与峰位之间的关系, 如图5(c)所示, 发现峰P(B)的峰位与P1/3呈现线性关系, 即E ∝P1/3[26,27], 对应的发光源于WZ/ZB II-型结构的特性.

图5 本征GaAs 纳米线光谱图(a)本征GaAs 纳米线在不同功率密度下的PL 光谱曲线; (b)本征GaAs 纳米线中峰P(A)和峰P(B)强度随功率密度的关系曲线; (c) P(A)和P(B)峰位和功率1/3(P1/3)的关系曲线Fig. 5. The PL spectra of intrinsic GaAs NWs: (a) The PL spectral curves of intrinsic GaAs NWs at different power density; (b) the relationship between peak P (A) and P (B) intensity with power density in intrinsic GaAs NWs; (c) the relationship between P(A)and P(B) peaks and P1/3.
对GaAs 纳米线进行掺杂, 对应的发光峰出现明显的变化, Si 掺杂和Be 掺杂GaAs 纳米线低温(at 10 K)下变功率测试结果如图6 所示. 从图6(a)中可以看到Si 掺杂GaAs 纳米线的强度随着功率密度的增加而增加, 但对应的峰形没有出现明显的变化. 为了更好地确定对应的两个峰P(C)和P(D)的发光来源, 对其变功率光谱进行高斯拟合, 同时建立功率密度与积分强度之间的关系((1)式), 对应的α值分别为0.72 和0.65, 如图6(b)所示, 因此可以确定峰P(C)和峰P(D)为缺陷或者杂质之间的发光. Arab 等[28]报道的Si 掺杂GaAs 纳米线的发光峰对应的峰位为1.496, 1.488, 1.469 和1.460 eV, 这些峰源于Si 杂质相关的发光. 本文中Si 掺杂GaAs 纳米线低温PL 光谱对应的峰位为1.496 eV 和1.461 eV, 因此Si 掺杂GaAs 纳米线的发光峰源于Si 杂质缺陷. 为了更进一步确定其发光来源, 构建功率密度与两个发光峰峰位之间的关系, 如图6(c)所示. 从图中可以发现, 峰P(C)随着激发功率密度的增加, 峰位轻微的蓝移, 峰P(C)为导带到受主的发光[29,30]. 同时随着功率密度的增加, 1.461 eV 发光峰位出现明显的蓝移现象, 这种现象与施主-受主对(DAP)辐射复合发光相似. DAP辐射复合的峰位可以被描述[29,31-33]为
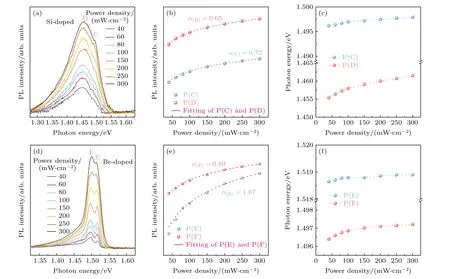
图6 掺杂GaAs 纳米线的光谱图(a)不同功率密度下Si 掺杂GaAs 纳米线的PL 光谱曲线; Si 掺杂GaAs 纳米线中P(C)和P(D)积分强度(b)和峰位(c)随功率密度的关系曲线; (d)不同功率密度下Be 掺杂GaAs 纳米线的PL 光谱曲线; Be 掺杂GaAs 纳米线中P(E)和P(F)峰积分强度(e)和峰位(f)随功率密度的关系曲线Fig. 6. The PL spectra of doped GaAs NWs: (a) The PL spectral curves of Si-doped GaAs NWs at different power density; the relationship between P (C) and P (D) integral intensity (b) and peak positions (c) with power density in Si-doped GaAs NWs; (d) the PL spectral curves of Be-doped GaAs NWs at different power density; The relationship between P (E) and P (F) peak integral intensity (e) and peak positions (f) with power density in Be-doped GaAs NWs.

其中,Eg是GaAs 带隙,ED和EA分别是施主和受主束缚能,r是施主与受主之间的距离,e是电子电荷,ε是介电常数. 对于DAP 峰位的变化, 随着激发功率的增加, 被占的施主和受主中心的浓度也会增加, 减少了施主-受主之间的平均距离, 导致DAP向更高的能量转移. 因此, 峰P(D)是施主-受主对的辐射复合发光.
对于Be 掺杂GaAs 纳米线的低温PL 光谱测试, 图6(d)显示峰P(E)和P(F)的积分强度随着功率密度的增加而增加, 而峰位没有明显的变化.为了进一步确定两个峰的发光来源, 对其进行高斯拟合. 功率密度与P(E)和P(F)两个峰积分强度之间的关系被构建, 通过(1)式进行拟合, 可以得到Be 掺杂对应两个峰的α值分别为1.67 和0.89,如图6(e)所示. 因此可以得到峰位P(E)的发光来源是自由激子复合发光, 而P(F)的发光来源可能是缺陷或者Be 杂质之间的发光. 图6(f)可以进一步确定其发光来源, 功率密度与两个峰之间的关系, 随着激发功率密度的增加, 峰位E 没有明显的移动, 而峰位F 有轻微的蓝移, 因此可以确定峰P(E)是自由激子的发光, 峰P(F)是导带到受主的发光. 另外, Scott 等[34]报道了低温6.5 K 下Be 掺杂GaAs 材料中导带到受主对应的峰位为1.493 eV,这与本文低温10 K 下Be 掺杂GaAs 纳米线导带到受主对应的峰位1.497 eV 基本吻合. 因此, 掺杂之后GaAs 纳米线的发光来源发生明显的改变,WZ/ZB II-型结构发光消失, 转变为杂质缺陷相关的发光.
4 结 论
本文利用分子束外延系统制备了本征、Si 掺杂和Be 掺杂GaAs 纳米线, Raman 光谱, 透射电子显微镜及PL 光谱研究了掺杂对GaAs 纳米线结构相变调控和光学特性研究. Raman 光谱测量结果表明Si 掺杂会使得本征GaAs 纳米线WZ 结构特有的E2 模式峰减弱, Be 掺杂使得E2 模式峰消失. HRTEM 和SAED 图样直观的观察到本征GaAs纳米线为WZ/ZB 混相结构且伴有缺陷存在, Si 掺杂GaAs 纳米线结构为ZB 结构且存在少量孪晶,Be 掺杂GaAs 纳米线为单一ZB 结构. PL 光谱测量表明掺杂改变了GaAs 纳米线发光来源, 本征GaAs 纳米线的两个峰源于自由激子和WZ/ZB II-型结构发光, Si 掺杂GaAs 纳米线的发光源于导带到受主的发光和施主受主对的发光, Be 掺杂GaAs 纳米线的发光源于自由激子和导带到受主的发光. GaAs 纳米线的掺杂不仅实现了纳米线结构相变的调控, 同时也实现光学特性的调节, 尤其是Be 掺杂可以实现单一闪锌矿结构GaAs 纳米线,对III-V 纳米材料掺杂实现相变调控具有重要的指导意义.
