Sn-3.0Ag-0.5Cu/ENEPIG焊点界面反应及剪切性能的尺寸效应
2021-09-01于凤云杜彦凤
于凤云,刘 浩,杜彦凤
(大连理工大学材料科学与工程学院,大连 116024)
0 引 言
随着科学技术的进步,电子消费产品要求具有更好的性能、更多的功能、更小的尺寸,这使得微电子工业逐步进入集成电路(Integrated Circuit,IC)的后摩尔定律时代,而三维(3D)IC封装成为解决超大规模IC物理极限的重要方案之一,并获得了极大的发展[1]。3D IC封装广泛采用微凸点(Micro-Bump)和硅通孔(Through-Silicon-Vias,TSV)实现芯片互连,这在促进封装密度不断提高的同时,也使得焊点尺寸大大减小,从而导致焊点界面反应、组织演化以及焊点力学性能表现出明显的尺寸(体积)效应[2-5]。互连焊点常常因热失配、装配外力等原因发生剪切失效,因此具有良好剪切性能的焊点是电子产品高可靠性的重要保障。但在尺寸效应的作用下,焊点界面金属间化合物(IMC)体积在焊点中的比例增加,微小尺度互连的可靠性问题变得更加严重[6-7]。
化学镍/钯/金(ENEPIG)表面处理层具有良好的钎焊润湿性、缓慢的界面金属间化合物生长速率和较低的成本等特性,且能够满足多种封装工艺要求,因而受到了广泛的重视。ENEPIG在化学镍金(ENIG)的基础上引入钯层,较好地解决了ENIG因镍(磷)层腐蚀而在其表面形成镍氧化物(黑盘,Black-pad),进而导致焊点可靠性下降的问题[8]。此外,ENEPIG还可抑制电迁移引起的镍(磷)层消耗和焊点界面金属间化合物的溶解和扩散,使其表现出良好的抗电迁移特性[9]。
HO等[10]在研究不同尺寸Sn-3.0Ag-0.5Cu/Ni焊点的钎焊界面反应时,发现在大尺寸焊点界面处只生成了一层(Cu,Ni)6Sn5金属间化合物,而小尺寸焊点界面上却生成了一层(Ni,Cu)3Sn4和一层(Cu,Ni)6Sn5金属间化合物,并且出现(Cu,Ni)6Sn5金属间化合物层大量脱落的现象,认为小尺寸焊点界面反应消耗铜的速率比大尺寸焊点的快,致使焊点贫铜,从而表现出明显的尺寸效应。ISLAM等[2]对比研究了2种尺寸的钎料球与铜焊盘的钎焊界面反应,发现大体积钎料球消耗了更多的铜焊盘,但形成的界面化合物却更薄。LI等[11]研究了不同间距焊点的剪切性能,发现随着焊点间距的减小,金属间化合物体积占焊点比例变大,剪切强度增大。TIAN等[12]研究发现,随焊点尺寸的减小,回流及时效后Sn-3.0Ag-0.5Cu/Cu焊点的剪切强度增大,这是因为小尺寸焊点中细小的Ag3Sn颗粒增大了其剪切强度,大尺寸焊点中枝晶状和羽毛状的Ag3Sn导致了焊点脆性的增大。
目前,国内外学者对焊点钎焊界面反应和剪切性能的尺寸效应进行了深入研究,但基于ENEPIG的界面反应和剪切性能的尺寸效应研究尚不多见;而相关研究对ENEPIG的应用及其钎焊焊点的可靠性评估具有积极意义。作者研究了不同尺寸Sn-3.0Ag-0.5Cu/ENEPIG焊点的界面反应和剪切性能,对比分析了焊点经多次钎焊回流和时效处理后的界面金属间化合物层厚度及焊点剪切强度,阐述了尺寸效应对焊点界面金属间化合物生长、转变和剪切断裂的影响。
1 试样制备与试验方法
试验用钎料焊球成分(质量分数)为Sn-3.0%Ag-0.5%Cu,直径分别为200,300,400 μm。基板铜焊盘表面处理层为ENEPIG镀层,由镍(磷)层、钯层和金层组成,其中镍(磷)层厚度为5 μm,焊球与焊盘的尺寸参数列于表1中。将焊球置于涂覆中性活性助焊剂的焊盘上,并放入TYR108N-C型台式回流焊机中进行回流。回流峰值温度为250 ℃,液相线(217 ℃)以上停留时间为45 s,分别回流1,3,5,7次。将部分回流3次的焊点试样放入恒温箱中进行等温时效处理,时效温度分别为75,100,125 ℃,时效时间为200 h。

表1 焊球与焊盘的尺寸参数
采用Dage4000型键合强度测试仪对焊点进行剪切试验,剪切试验原理如图1所示,推刀端面到基板表面的距离为10 μm,剪切速度为50 μm·s-1。在测试过程中,当剪切力下降至最大剪切力的75%时,推刀迅速将焊球推断,若焊盘不被剥离,即视为1次有效测试值。对于不同条件下的焊点,取15个有效值的平均值作为试验结果。

图1 焊点剪切试验原理图Fig.1 Schematic of solder joint shear test principle
将不同条件下的焊点用环氧树脂密封后,用200#砂纸沿垂直于基板法线方向对焊点最大横截面处进行磨制,然后依次使用2000#砂纸和粒径0.5 μm金刚石抛光膏对该截面进行磨抛,再用体积分数5%硝酸酒精溶液腐蚀5 s后,用SUPARR 55型场发射扫描电子显微镜(SEM)观察焊点界面组织与形貌,并通过SEM附带的INCA+CH5型能谱仪(EDS)分析界面金属间化合物的成分和类型。
2 试验结果与讨论
2.1 回流后焊点的界面组织及剪切性能
由图2可以看出,随着焊球直径的增大,焊点界面金属间化合物层的厚度及其晶粒尺寸均减小,表现出明显的尺寸效应。同时,由EDS分析结果可知,直径200 μm焊球与镀层回流后焊点的界面产物均为(Ni,Cu)3Sn4,由Ni3Sn4相固溶少量铜原子形成;直径400 μm焊球与镀层回流后焊点的界面产物为(Cu,Ni)6Sn5,由Cu6Sn5相固溶少量镍原子形成;而直径300 μm焊球与镀层回流后焊点的界面产物则由靠近基板侧的(Cu,Ni)6Sn5和靠近钎料侧的(Ni,Cu)3Sn4两种金属间化合物组成。焊点中未发现由钯或金形成的独立金属间化合物,也未发现其存在于界面金属间化合物中,推断较薄的钯层和金层在钎焊初期迅速溶解到钎料中,钎焊结束后钯和金以固溶的形式存在于锡基体中。随着SnAgCu钎料中铜质量分数从1.0%降低至0.2%,SnAgCu/Ni界面产物先由单一相(Cu,Ni)6Sn5向复相(Cu,Ni)6Sn5和(Ni,Cu)3Sn4转变,再转变为单相(Ni,Cu)3Sn4[13]。焊球直径较小(200 μm)的焊点中铜的绝对含量低,不足以形成(Cu,Ni)6Sn5,因此只能形成消耗铜较少的(Ni,Cu)3Sn4;而焊球直径较大(400 μm)的焊点中铜的绝对含量高,足以供界面反应形成(Cu,Ni)6Sn5;对于焊球直径介于二者之间(300 μm)的焊点,反应初期钎料中的铜含量较高,界面处形成(Cu,Ni)6Sn5,随着反应的进行钎料中逐渐贫铜,界面产物转变为(Ni,Cu)3Sn4。随着焊球直径的增大,焊点界面金属间化合物层厚度及晶粒尺寸随回流次数增加而增大的趋势减弱。这是由于:一方面,随着焊球直径的增大,镍向液态钎料中溶解的速率较慢,因此界面金属间化合物的生长速率也相应较慢;另一方面,随着焊球直径的增加,焊球体积与焊盘面积的比值增大,更多溶解的镍原子扩散到钎料中以满足溶解度需求,使得参与界面反应的原子通量降低,导致焊点中界面金属间化合物生长速率下降。
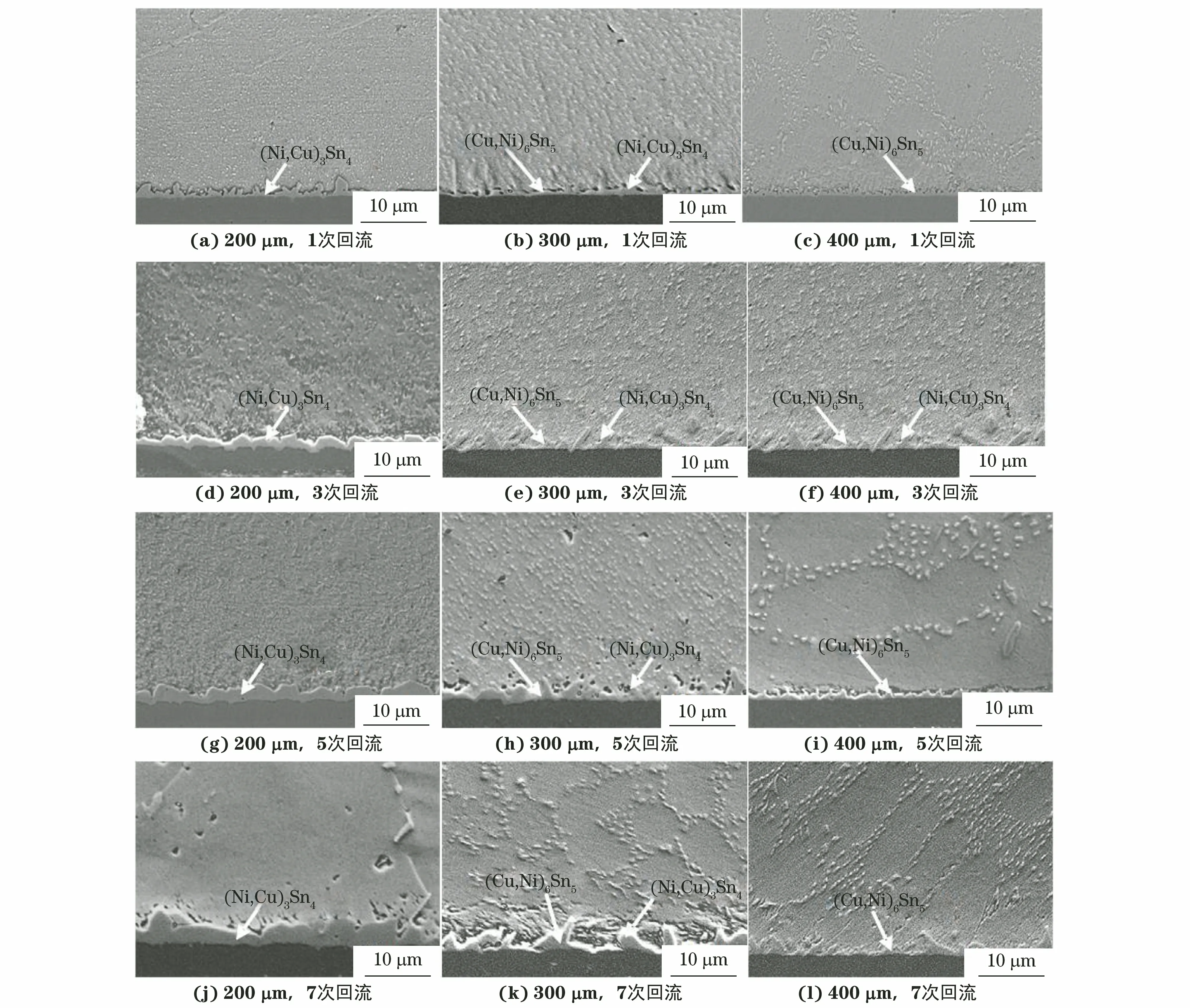
图2 不同直径Sn-3.0Ag-0.5Cu焊球与ENEPIG镀层回流不同次数后焊点的截面SEM形貌Fig.2 Cross section SEM morphology of solder joints by reflow of Sn-3.0Ag-0.5Cu solder balls with different diameters and ENEPIG cladding for different times: (a-c) reflow for time; (d-f) reflow for 3 times; (g-i) reflow for 5 times and (j-l) reflow for 7 times
由图3可知:当焊球直径从200 μm增加到300 μm时,焊点剪切强度下降明显,回流1次时的剪切强度下降程度最大,由87 MPa下降到68 MPa,下降幅度为21.53%;焊球直径从300 μm增至400 μm时,焊点剪切强度下降幅度较小,回流1次时的剪切强度下降程度最大,由68 MPa下降到60 MPa,下降幅度仅为5.54%。可见,相同回流次数下,焊点的剪切强度随焊球尺寸的增大而降低,表现出尺寸效应,这与LI等[11]的研究结果相吻合。对于相同焊球尺寸的焊点,随着回流次数的增加,焊点的剪切强度下降,这可能是由于焊点经多次回流后,钎料晶粒粗化导致的[12]。对比发现,直径200 μm焊球与镀层经7次回流后焊点的剪切强度比经1次回流后的下降了22.74%,而直径400 μm焊球与镀层经7次回流后焊点的剪切强度比经1次回流后的下降了6.72%,说明回流次数对焊点剪切强度下降的影响程度随着焊球直径的增大而减弱。
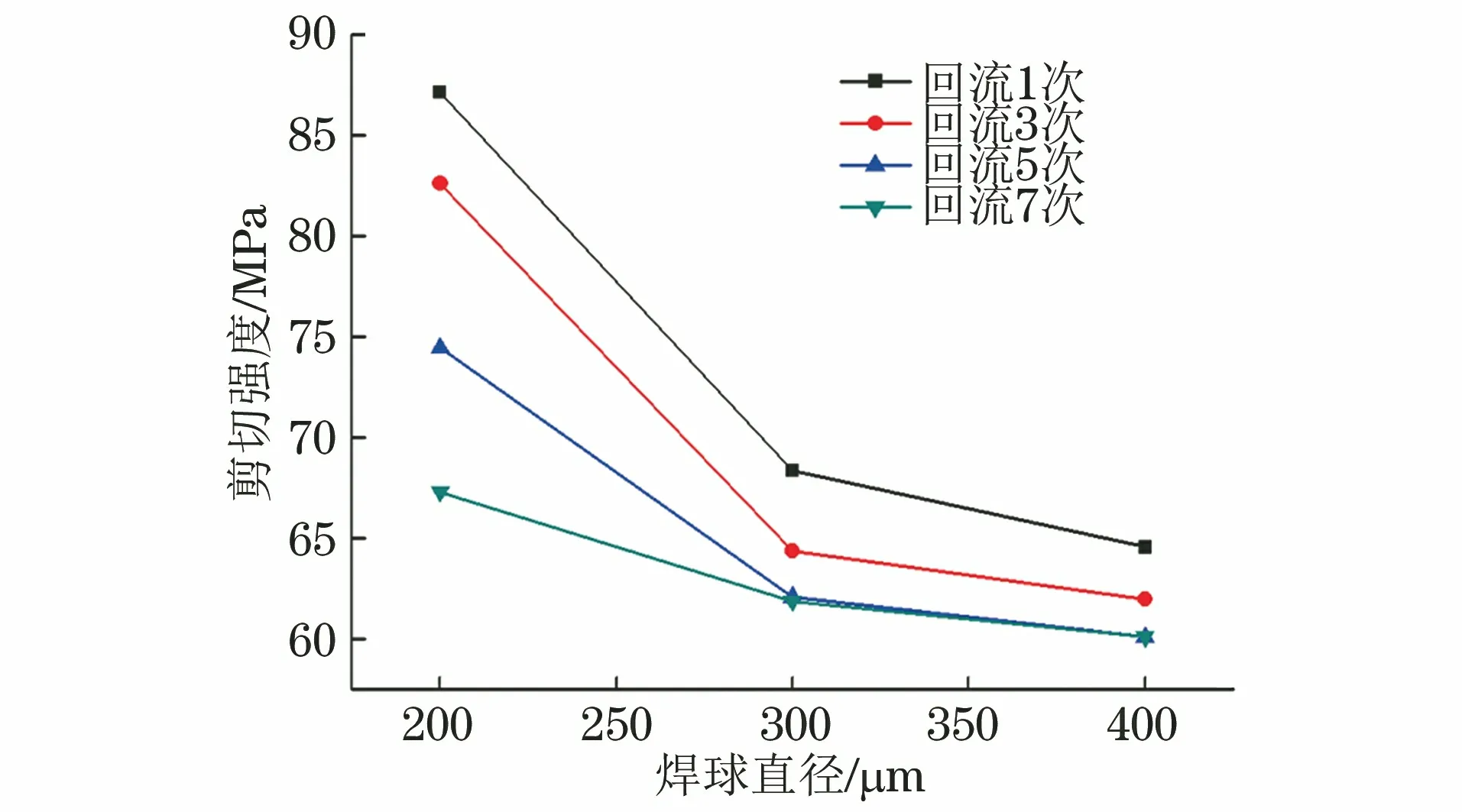
图3 Sn-3.0Ag-0.5Cu焊球与ENEPIG镀层回流不同次数后焊点剪切强度随焊球直径的变化曲线Fig.3 Curves of shear strength of solder joints by reflow of Sn-3.0Ag-0.5Cu solder balls and ENEPIG cladding for different times vs diameter of solder ball
由图4可以看出,在剪切力作用下,焊点先发生塑性变形后发生撕裂,最后发生断裂失效。焊点断口主要由劈刀切开区和撕裂区组成,直径200 μm焊球与镀层回流后焊点的劈刀切开区的面积明显大于其撕裂区的面积,而直径400 μm焊球与镀层回流后焊点的撕裂区相对面积明显比直径200 μm焊球与镀层回流后的大。焊球直径较大焊点的劈刀切开区面积相对较大,说明其塑性较好,可知焊点的断口形貌也表现出明显的尺寸效应。
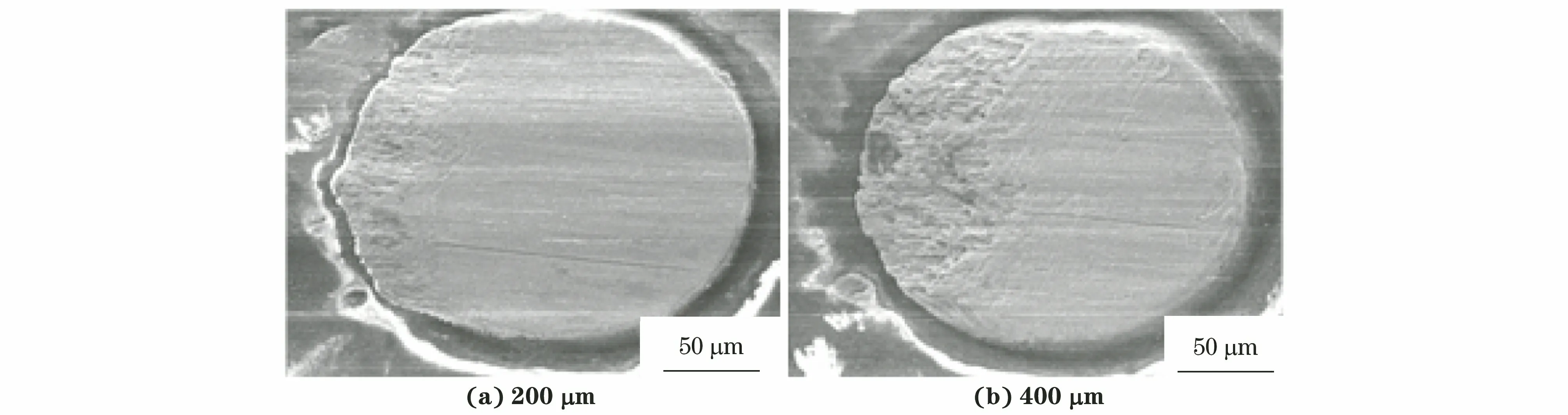
图4 不同直径Sn-3.0Ag-0.5Cu焊球与ENEPIG镀层回流1次后焊点的剪切断口形貌Fig.4 Shear fracture morphology of solder joints by reflow of Sn-3.0Ag-0.5Cu solder balls with different diameters and ENEPIG cladding for 1 time
2.2 回流3次与时效后焊点界面组织及剪切性能
参考实际工艺,选择了回流3次并时效后的焊点截面组织与剪切性能进行研究。由图5可知,相同时效温度下,焊点界面金属间化合物层厚度及晶粒尺寸均随焊球直径的增大而减小,其变化趋势与时效前的相一致。与时效前的焊点相比,时效后焊点界面金属间化合物层厚度明显增加,且其形貌变得更为光滑、平坦。随着时效温度的升高,焊点界面金属间化合物发生明显粗化。由EDS分析可知,时效处理后所有焊点界面的金属间化合物均为(Cu,Ni)6Sn5,说明在时效过程中钎料中的铜原子不断向界面迁移,一方面促进了金属间化合物的生长,另一方面促使焊球直径为300 μm焊点中界面金属间化合物类型转变。
由图6可知,随着焊球直径的增大,时效后焊点的剪切强度均呈下降趋势,且当焊球直径从200 μm增加到300 μm时,剪切强度下降趋势明显,与时效前的结果相吻合,但下降幅度较时效前的均有所降低。随着时效温度的升高,焊点的剪切强度降低,当时效温度为125 ℃时,剪切强度最小。时效后焊点的剪切强度整体低于时效前的,这可能是由于时效后焊点内锡晶粒及金属间化合物颗粒发生粗化,且界面金属间化合物层在增厚的同时也变得更加平坦导致的。

图6 Sn-3.0Ag-0.5Cu焊球与ENEPIG镀层回流3次的焊点在不同温度下时效200 h后的剪切强度随焊球直径的变化曲线Fig.6 Curves of shear strength vs solder ball diameter of solder joints by reflow of Sn-3.0Ag-0.5Cu solder balls and ENEPIG cladding for 3 times after aging at different temperatures for 200 h
3 结 论
(1) Sn-3.0Ag-0.5Cu焊球与ENEPIG镀层回流不同次数后,焊点界面金属间化合物层的厚度以及焊点的剪切强度均随焊球直径的增大而降低,表现出明显尺寸效应;焊球直径为200,300,400 μm的焊点中,钎焊界面金属间化合物分别为(Ni,Cu)3Sn4、(Ni,Cu)3Sn4和(Cu,Ni)6Sn5、(Cu,Ni)6Sn5;焊球直径较大焊点的劈刀切开区面积相对较大,说明其塑性较好,焊点的剪切断口形貌表现出尺寸效应;回流次数的增加导致焊点界面金属间化合物层厚度增加,焊点剪切强度下降,且焊球直径较小的焊点剪切强度的下降程度大于焊球直径较大的焊点。
(2) Sn-3.0Ag-0.5Cu焊球与ENEPIG镀层回流3次的焊点经时效后的界面金属间化合物层的厚度以及焊点的剪切强度均随焊球直径的增大而降低,表现出明显的尺寸效应;时效温度升高导致界面金属间化合物层厚度增加,焊点剪切强度降低;在不同温度下时效200 h后,所有焊点界面金属间化合物均为(Cu,Ni)6Sn5,且时效后焊点的剪切强度均低于时效前的。
