等离子体增强技术在镀铜玻璃衬底上低温制备GaN薄膜
2020-05-21李昱材苏媛媛宋世巍刘嘉欣
李昱材,苏媛媛,赵 琰,宋世巍,王 健,王 刚,唐 坚,刘嘉欣,张 东
(沈阳工程学院 a. 新能源学院,b. 辽宁省新能源光电材料制备与分析工程研究中心,辽宁 沈阳 110136)
氮化镓(GaN)以其优异的光学和电学性能而备受关注,这些特性使得它在光电器件、短波长光学器件、高功率和高频电子器件中具有其广泛的应用前景[1-7],如半导体发光二极管(LED)、激光二极管(LD)和紫外(UV)光电探测器等。目前,GaN基LED已经进入市场并且应用于各个方面,主要应用在照明、全彩色屏幕显示、液晶背光显示和白光LED灯等。近年来,随着荧光灯的更替,高效率的白光LED引起了学术和商业界的广泛关注和研究。GaN基LED通常生长在蓝宝石衬底上,原因是蓝宝石衬底具有相对较低的成本、较高的温度稳定性和较好的化学稳定性,但是,蓝宝石衬底的导电率和导热率较小,严重影响了GaN基LED的性能、寿命和效率[8-9]。
采用金属作为LED的衬底具有蓝宝石衬底无法比拟的优点,如导电和导热性能好、尺寸大和反光率高等,因此,可以有效地解决GaN基LED的散热问题,延长了LED器件的使用寿命。此外,一种导电基板也能满足电极下面金属的使用要求。到目前为止,研究者们已经采取了一系列方法来提高GaN基LED的散热效率,例如,采用晶片键合技术和激光剥离技术(LLO)将蓝宝石衬底上预制的GaN薄膜转移到金属衬底上[10-12]; 但是制造工艺过程复杂,而且会给器件带来一些不利因素,直接影响设备性能,因此有必要开发研制一种在金属衬底上直接外延生长GaN的技术。目前,已经有少量的关于直接在金属衬底上沉积GaN薄膜的报道,例如以单晶铜(Cu)、银(Ag)作为衬底和多晶钨(W)、钽(Ta)、铌(Nb)、钼(MO)金属作为衬底。主要的制备方法有金属有机物化学气相沉积(MOCVD)、脉冲激光沉积(PLD)和分子束外延(MBE)。除了单晶金属衬底的成本相对较高外,MOCVD和MBE设备的沉积温度也较高,会导致GaN薄膜与金属衬底产生有害的界面反应,并且极有可能增大GaN薄膜与金属衬底之间因热膨胀系数不同而产生的热应力。
本文中采用自主研制组装的电子回旋共振等离子体增强金属有机化学气相沉积(ECR-PEMOCVD)技术在镀铜玻璃衬底上沉积制备GaN薄膜材料。ECR-PEMOCVD是一种结合MBE和MOCVD先进特点的新型薄膜低温沉积技术,系统采用腔式微波电子回旋共振(ECR)等离子体源,可产生高能电子、低能量离子和大面积均匀高密度非平衡低温等离子体,显著提高氮气的反应活性,这是低温下GaN薄膜形成的关键技术[13-15]。在各种金属中,铜具有优异的导电性和导热性(导热率为400 W/(m·K)),是高功率和高温衬底的颇具前景的优选材料。与单晶金属相比,镀铜玻璃衬底的制造成本较低,而且尺寸大,方便大面积加工。近年来,在金属衬底上沉积高质量GaN薄膜的研究相对较少,而且Cu衬底的卓越性能直接提高了GaN基LED的效率,因此,本文中通过ECR-PEMOCVD系统在低温下制备高质量的GaN薄膜,并系统地研究TMGa流量对GaN薄膜性能的影响。
1 实验
在玻璃衬底上,在系统工作气压为0.4 Pa的氩等离子体中,采用射频磁控溅射技术溅射铜靶(纯度为99.999%,质量分数)制备铜薄膜,沉积得到的铜薄膜是(111)晶面择优取向的多晶薄膜,沉积的铜薄膜厚度约为400 nm。在铜薄膜制备之前,玻璃衬底依次浸入到丙酮、乙醇和去离子水中分别超声清洗10 min,冲洗干净后用高纯度氮气(N2)干燥并随后进行射频磁控溅射反应。采用自行研制组装ECR-PEMOCVD系统在镀铜玻璃衬底上制备GaN薄膜,引入三甲基镓(TMGa)和高纯N2作为Ga源和N源反应源。用恒温器将TMGa的温度保持在-14.1 ℃,并通过氢气(H2)带入反应室。
在室温下,向反应室通入体积流量为80 mL/min的氢气,用氢等离子体清洗铜膜表面3 min,去除表面氧化层和附着物。下一步是用等离子体对衬底进行氮化处理,氮化处理的条件是: 室温,氮气体积流量为80 mL/min,氮化时间为20 min。氮化处理可以增强GaN薄膜与金属衬底之间的附着力,从而得到良好的沉积模板。氮化后,继续在铜衬底上沉积GaN缓冲层,缓冲层的生长参数是,室温,TMGa和氮气的体积流量分别为0.5、80 mL/min,沉积时间为30 min。在外延层生长开始之前,缓冲层的插入被认为是减小铜衬底与GaN外延薄膜之间晶格失配和热失配的一种方法,也被用来为成核中心提供与衬底相同的晶体取向,提高GaN外延薄膜的结晶质量[16-17]。最后,采用流量控制器将氮气体积流量控制在100 mL/min,TMGa体积流量控制在1.0~1.8 mL/min,在400 ℃条件下沉积180 min生成GaN薄膜材料,研究TMGa流量对生长GaN薄膜结构和性能的影响。随后,为了减少冷却过程中产生的热应力,沉积温度缓慢地降低到室温。通过台阶仪测试,薄膜厚度为200 nm。
利用原位反射高能电子衍射(RHEED)仪对GaN薄膜的生长进行实时监测;对GaN薄膜的晶体结构进行X射线衍射(XRD)分析,管电压为40 kV,管电流为40 mA,辐射波长为0.154 056 nm;采用原子力显微镜(AFM)测试分析GaN薄膜的表面形貌;采用室温光致发光(PL)技术研究GaN薄膜的光学特性。
2 结果与讨论
2.1 结构特性
2.1.1 GaN薄膜结晶质量
图1是在不同的TMGa流量下,铜衬底上沉积得到的GaN薄膜的RHEED图像。由图可以看出,当TMGa体积流量为1.0 mL/min时,多晶环模糊、不明显。随着TMGa体积流量从1.0 mL/min增加到1.2 mL/min,RHEED的图像逐渐清晰,在多晶条纹上呈现出断开的趋势。进一步地,当TMGa体积流量从1.2 mL/min增加到1.4 mL/min时,多晶环更亮,断开趋势越来越明显,表明在铜衬底上沉积的GaN薄膜具有高度的c轴择优取向。RHEED结果表明,TMGa流量对GaN薄膜的结晶质量影响很大,当TMGa体积流量为1.4 mL/min时,所制备的GaN薄膜具有较好的c轴择优取向。其原因是,当TMGa流量较小时,体系中氮原子含量较高,在富氮条件下,镓原子表面扩散长度有限,薄膜中氮原子含量过高会限制薄膜的流动,氮原子过量时就会产生大量镓空位,不利于提高薄膜结晶质量,然而,在富镓条件下,即TMGa流量较大时会导致镓金属液滴的富集和薄膜缺陷密度的增加,不利于提高GaN薄膜的结晶质量。

图1 三甲基镓流量不同时沉积的GaN薄膜的原位反射高能电子衍射图谱
2.1.2 物相分析
为了研究GaN薄膜的晶体质量和结构性能,对GaN薄膜进行了XRD分析,结果如图2所示。XRD分析表明,GaN(002)晶面在衍射角2θ=34.56°产生最强衍射峰,并且所有样品的XRD图谱在2θ为43.44°、50.82°附近出现铜薄膜(111)、(200)晶面的衍射峰。此外,在GaN薄膜图谱上没有观察到合金相,但在2θ为32.38°、36.85°、63.45°和69.10°处观察到4个强度较低的GaN薄膜(100)、(101)、(103)和(112)晶面的衍射峰。反应源TMGa的化学式为Ga(CH3)3,其熔点很低,在370 ℃温度下就能与氢原子发生化学反应脱去甲基,把镓原子分离出来,然后镓原子与微波条件作用下氮气分解的氮原子反应,制备出GaN薄膜样品。
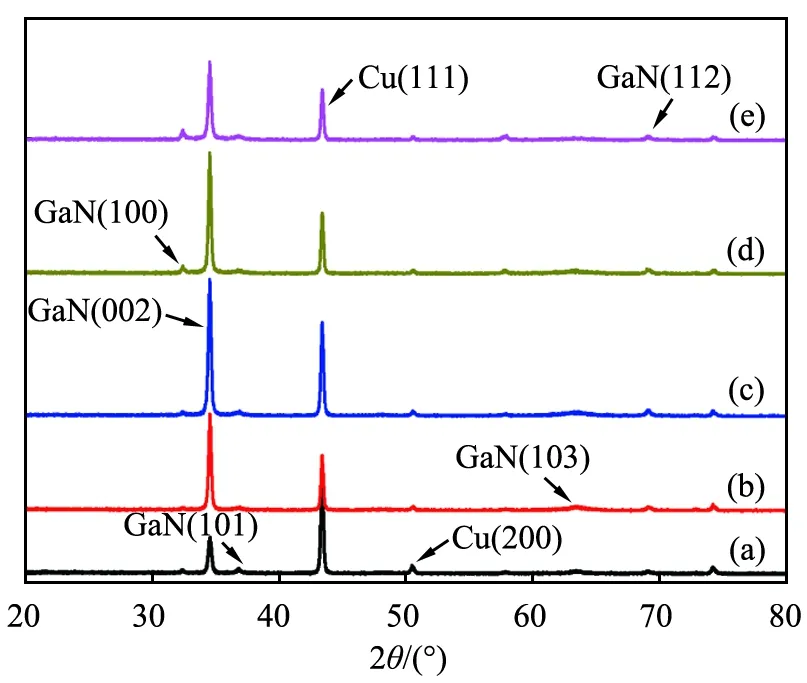
(a)体积流量1.0 mL/min,(b)体积流量1.2 mL/min,(c)体积流量1.4 mL/min,(d)体积流量1.6 mL/min,(e)体积流量1.8 mL/min。图2 三甲基镓流量不同时沉积的GaN薄膜的X射线衍射谱图
其化学反应式如下:
Ga(g)+N(g)=GaN(s)。
XRD分析结果表明,所制备的GaN薄膜在2θ为34.56°附近均出现较强的衍射峰,对应于GaN的(002)晶面,没有出现其他的峰,说明样品具有良好的c轴择优取向。为了分析GaN薄膜的结晶质量,表1列出了TMGa流量、GaN(002)晶面衍射峰峰位、半高宽(FWHM)、c轴方向晶格参数和晶粒尺寸,并且用Scherrer公式D=kλ/(βcosθ)计算GaN的平均晶粒尺寸。

表1 三甲基镓流量不同时沉积的GaN(002)晶面衍射峰位置、半高宽、c轴方向晶格参数和晶粒尺寸
从表1中可以看出,随着TMGa体积流量从1.0 mL/min增加到1.4 mL/min,半高宽变小,峰衍射强度变强,c轴方向晶格常数增大,晶粒尺寸逐渐增大。当TMGa体积流量为1.4 mL/min时,所制备的GaN薄膜的c轴方向晶格常数为0.518 6 nm,与理论值(0.518 5 nm)非常接近。当TMGa体积流量从1.4 mL/min增大到1.8 mL/min时,半高宽变大,衍射峰强度变弱,c轴方向晶格常数减小,晶粒尺寸逐渐变小。衍射强度的增加和半高宽的减小可以说明结晶质量的提高,因此,TMGa体积流量为1.4 mL/min时,沉积的GaN薄膜的结晶质量最好,XRD分析与RHEED观测结果一致。结果表明,只有在合适的沉积条件下,所制备的薄膜才能具有较好的结晶质量。由此可以看出,TMGa流量对GaN薄膜结晶质量的影响十分显著。
2.1.3 GaN薄膜的表面形貌
图3所示为TMGa体积流量分别为1.2、1.4、1.6 mL/min时制备的GaN薄膜的AFM图像。由图可以看出,TMGa体积流量在1.4 mL/min时制备的GaN薄膜样品的表面均方根平整度为纳米数量级,而且制备的GaN外延薄膜表面光滑,晶粒较大且均匀,致密度很好。适当的TMGa流量会增加表面原子的迁移,使Ga、N原子加入晶格中,但是,当TMGa体积流量达到1.6 mL/min时,GaN薄膜的表面粗糙度增大,晶粒尺寸不均匀。这种现象可以解释为过量的氮原子或镓原子不利于生长的衬底表面的镓、氮原子迁移,影响GaN薄膜的结晶。上述结果表明,TMGa体积流量为1.4 mL/min是最佳制备参数。在此条件下,所制备的GaN薄膜具有较大的晶粒尺寸和较好的晶粒取向,薄膜的表面均方根平整度为17.7 nm,金属衬底上的GaN薄膜的相对均方根值较大,这是由实验中所用铜衬底表面粗糙所致。
2.2 光学性能
为了研究沉积制备的GaN薄膜的光学性能,在室温条件下,采用激发波长280 nm对TMGa体积流量为1.4 mL/min时制备的GaN薄膜进行PL谱测试,结果如图4所示。从图中可以看出,影响GaN薄膜样品的光致发光因素主要是氮空位缺陷、错位等深能级的本征缺陷、杂质、薄膜的张应力以及因薄膜晶粒小而引起的量子尺寸效应。GaN薄膜样品的发光光谱在波长为354 nm(带隙为3.50 eV)处有一个较强的发射峰,该发射峰为GaN的近波段边缘(NBE)辐射相对应的紫外PL发射峰。与GaN单晶体光学带隙(3.4 eV)相比,薄膜在光学带隙中表现出蓝移现象,这与薄膜的张应力以及因薄膜晶粒小而引起的量子尺寸效应有关,而且氮空位缺陷也使薄膜样品的发光峰出现了蓝移。另外,在波长为520 nm附件处还观察到弱而宽的黄光发射峰,这是由GaN薄膜中存在氮空位或错位等深能级的本征缺陷所致,这些缺陷可以用作非辐射复合中心和俘获激子[17]。结果表明,在铜衬底上生长的GaN薄膜的强紫外PL发射和弱黄光发射的观察发现,生长的薄膜在LED器件中可以应用。
3 结论
采用ECR-PEMOCVD技术,在镀铜玻璃衬底上成功地制备了c轴择优取向的GaN薄膜样品;通过对不同TMGa流量时制备的薄膜性质的研究,探索出合适的GaN薄膜生长条件;系统地研究TMGa流量对GaN薄膜性能的影响,在最优TMGa体积流量(1.4 mL/min)的条件下,GaN薄膜具有较强的c轴择优取向和较大的晶粒尺寸,表明TMGa流量对GaN薄膜的沉积制备影响很大。室温PL谱显示GaN薄膜具有较强的紫外近波段边缘发射和弱的黄光发射,对GaN基LED的应用具有重要意义。研究的GaN-Cu结构对于提高GaN基LED的性能和效率,延长使用寿命,改善大功率GaN基LED器件的功率极限具有很好的参考价值。

(a)体积流量1.2 mL/min

(b)体积流量1.4 mL/min

(c)体积流量1.6 mL/min图3 三甲基镓流量不同时制备的GaN薄膜的原子力显微镜图像

图4 三甲基镓体积流量为1.4 mL/min时制备的GaN薄膜的光致发光谱
