CMOS APS光电器件单粒子效应电荷收集特性仿真分析
2017-07-17杨生胜苗育君薛玉雄张晨光
安 恒 杨生胜 苗育君 薛玉雄 曹 洲 王 俊 张晨光
(兰州空间技术物理研究所 真空技术与物理重点实验室 兰州 730000)
CMOS APS光电器件单粒子效应电荷收集特性仿真分析
安 恒 杨生胜 苗育君 薛玉雄 曹 洲 王 俊 张晨光
(兰州空间技术物理研究所 真空技术与物理重点实验室 兰州 730000)
卫星在轨飞行期间,星载电子器件将不可避免地遭受空间带电粒子的辐射,随着半导体技术的不断进步,电子器件的单粒子效应敏感性越来越高,已经成为一个影响其可靠性的重要因素。互补金属氧化物半导体(Complementary Metal Oxide Semiconductor Active Pixel Sensor, CMOS APS)光电器件因其低功耗、小体积和微重量的优点已成为遥感卫星成像的重要发展方向。为获取CMOS APS光电器件在遭受带电粒子辐射后性能变化的特征,在分析SOI MOSFET (Silicon on Insulator Metal-Oxide-Semiconductor Field-Effect Transistor)结构和特性的基础上,通过理论分析和数值模拟,分析了重离子在CMOS APS光电器件中引起的辐射损伤,分析晶体管和光电二极管的电荷收集机理。通过TCAD (Technology Computer Aided Design)模拟了电荷收集过程,分析了影响漏电流变化的直接因素,获得了重离子LET (Linear Energy Transition)值、入射位置以及器件偏置电压与漏电流的相互关系,为后续CMOS APS的重离子模拟试验以及抗辐射加固设计提供了理论支撑。
互补金属氧化物半导体,单粒子效应,电荷收集,TCAD仿真
随着对地观测卫星、侦察卫星对高分辨率需求的不断提高,以及微型卫星的不断发展,空间成像系统越来越多地使用高集成度的新型有源像素传感器(Active Pixel Sensor, APS)[1-3]。互补金属氧化物半导体(Complementary Metal Oxide Semiconductor, CMOS) APS光电器件因其低功耗、小体积和微重量等特点而被重点研究,成为卫星成像的新型器件。
然而,APS光电器件也有不足之处,最典型的就是空间辐射环境下出现的不同程度的损伤,其中,严重的会直接影响卫星成像系统,尤其是遭受粒子撞击时,卫星的姿态控制、遥感成像等会受到直接的影响。
随着CMOS工艺的不断完善,APS图像传感器在系统功耗、体积、重量、成本、功能性、抗辐射性能以及可靠性等方面所具有的优势更加突出,使得其作为成像及探测器件在卫星光通信、空间遥感以及天文观测等领域的应用越来越广泛。我国未来遥感卫星、侦察卫星以及高分辨率对地观测卫星将大量应用集成度高的APS图像传感器。这些新型光电器件的大量使用使空间辐射效应的影响更加突出,特别地,这些光电器件有着集成度高、特征尺寸小且工作电压低的特点,所以它们对单粒子效应会非常敏感,这会严重影响卫星的成像性能[4-5]。随着后续卫星寿命的普遍延长,对于星载成像系统来说,单粒子效应引起的危害已成为光电器件抗辐射研究的重点方向之一。
1 CMOS APS光电器件特性及单粒子效应分析
1.1 CMOS APS光电器件特性
晶体管和光电二极管是CMOS APS的基本组成单元。CMOS APS的典型结构框如图1所示。图1中,不同功能模块均由上述两种基本单元所组成。

图1 典型CMOS APS光电器件内部结构框图Fig.1 Structure diagram of CMOS APS.
其中,由APS阵列实现图像感知,将光信号转换成电信号;外围电路由模拟信号处理、控制寄存器以及模数转换器(Analog-to-Digital Converter, ADC)构成,它们用来实现对光电器件的控制和模数信号的处理。在试验中,选用典型的高分辨率、低功耗、体积小的Micro MT9T001C12STC CMOS APS光电器件,该器件具有2048×1536个像素点、10 bit分辨率。
1.2 CMOS APS光电器件单粒子效应分析
在重离子辐照环境下,CMOS APS的电学特性将会受到影响。对于晶体管,重离子辐照会引起其氧化层和硅层的电离。其中,氧化层的电离能产生电子-空穴对,这会使沟道的漏电流增大。同样地,硅层中的电离也会产生电子-空穴对,这些电子-空穴对会被敏感节点捕获而引起节点逻辑状态的改变。对于光电二极管来说,硅层中电离所产生的电子-空穴对会导致CMOS APS暗电流显著增大。如此单个晶体管和光电二极管电学和光学性能的变化将会影响像素点的电学性能和光学特性,且对应于单个像素点变化的不断累积,CMOS APS的输出会表现出单粒子效应现象[6-8]。
可知,CMOS APS光电器件单粒子效应主要包括光敏像元阵列的单粒子瞬态(Single Event Transient, SET)、单粒子翻转(Single Event Upset, SEU)和单粒子锁定(Single Event Latch, SEL)效应,且像素阵列的单粒子瞬态经外围电路传播后,在器件数据端口也表现为逻辑状态的变化。
2 重离子辐射模型
为进一步分析APS光电器件单粒子效应规律的特点,利用TCAD (Technology Computer Aided Design)模拟仿真的手段分析了单粒子效应对APS光电器件晶体管瞬态电流的影响[9-11]。
模拟仿真采用TCAD工艺及器件仿真软件进行。整个流程仿真的过程:首先用MDRAW工具绘制APS器件晶体管的三维结构形状,并优化器件网格和离子掺杂浓度。对高电流密度、高电场以及高电荷密度的区域要逐步进行细化。然后在DESSIS中根据器件结构设置需要的物理模型和参数并对器件的电学特性进行仿真。仿真过程中,首先忽略产生、复合项,求出稳态解;在此基础上引入单粒子效应求得瞬态解,从而得到粒子注入后的电流脉冲及电压随时间的变化趋势;最后利用Tecplot给出仿真结果,并直观显示其电学特性的变化。
重离子的入射过程可以用图2所示的模型来表示,图2中,将重离子入射的过程抽象为以粒子入射径迹为轴的等离子圆柱体。

图2 重离子入射仿真模型Fig.2 Simulation model of incidence for heavy ions.
利用ISE (Integrated System Enginerring)仿真粒子入射效应时采用DESSIS中的HeavyIon模块。粒子入射过程中,过剩载流子的产生率为:

如果lmax>1(lmax是入射粒子的径迹长度),则G(l,w,t)=0;LET (Linear Energy Transition)为采用每单位长度上的电荷沉积量,pC·μm-1。
如果lmax≤1,R(w,l)是产生率的空间变量;T(t)是产生率的时间变量;GLET(l)是线性能量传输产生密度,它决定于粒子的类型、能量、射程。R(w,l)采用高斯分布[12],公式如下:

式中:w表示粒子轰击到器件上入射轨迹的半径大小;wt(l)表示半径的特征值。
仿真时假设粒子轰击到器件后的入射轨迹是等离子圆柱体,以模仿粒子的入射情况。对于单粒子效应产生的电子空穴,它们遵从高斯径向载流子分布,且在时间上也遵从高斯分布[12],其表达式如下:

式中:tp是出现脉冲峰值的时间;Shi表示入射粒子的脉冲宽度,erf为高斯误差函数。
3 电荷收集特性仿真结果分析
仿真过程中,结合器件结构特点,沟道长度0.18μm,栅极氧化层厚度4 nm,多晶硅厚度150nm。重离子辐照光电器件时,重离子LET值、粒子入射位置以及器件的偏置电压会影响瞬态电流的变化,因此,在仿真分析中,从重离子LET值、粒子入射位置以及器件的偏置电压三个方面分析其对漏电流的影响。
3.1 LET值对晶体管漏电流的影响
试验中,设高能粒子垂直注入到NMOS (N-Metal-Oxide-Semiconductor)场效应管的漏区点(0.8,0),粒子注入后,入射轨迹上所产生的电离电荷在空间特征半径为0.1 μm的高斯分布,在时间上则为10 ps的高斯分布。采用图3(a)的电路连接方式,其中,外接电压值为2 V。
试验中,假设高能粒子垂直入射到NMOS场效应管的漏区。注入后,在其轨迹上产生的电离电荷,在空间分布上满足特征半径0.1 μm的高斯分布。仿真时采用图3所示的连接方式,外接电压2 V。在不同LET值粒子入射情况下,漏电流随时间变化的仿真结果如图4所示。不同LET值所对应着不同的峰值电流。LET值越大,峰值电流也就越大,但不同LET值所对应的电流的曲线形状是一致的。具体在粒子开始入射时漏电流迅速增大,这由入射粒子在轨迹上所产生的电子空穴对增多而引起,且LET值越大,产生的电子空穴对就越多。这些电子空穴对一部分被漏极收集产生了急剧上升的电流。随后,由于双极放大效应和自身的扩散作用,电流开始缓慢下降。

图3 重离子入射时的仿真电路连接方式 (a) 栅极接地,(b) 栅极、源极接地,(c) 漏极接电阻Fig.3 Circuits of simulation of incidence for heavy ions. (a) Gate to ground, (b) Gate and source to ground, (c) Drain to resistance
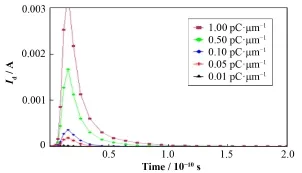
图4 不同LET值下漏电流随时间变化Fig.4 Leakage current variation with time under different LET.
3.2 入射位置对晶体管漏电流的影响
粒子入射的位置不同,它产生电流的峰值和脉宽就不同,这是因为对于不同的入射位置,在总的收集到的电荷中,由漂移和扩散所得到的电荷的比例不同。试验中,设高能粒子垂直入射到NMOS中,入射能量为0.1 pC·m-1,粒子注入后,入射轨迹上产生的电离电荷空间上为特征半径为0.1 μm的高斯分布,时间上为10 ps的高斯分布。采用图3(a)的电路连接方式,外接电压值为2 V。对于高能粒子入射不同的位置,即从源极到漏极,仿真得到的漏电流随时间的变化关系如图5所示。

图5 不同入射位置漏电流变化趋势Fig.5 Leakage current variation with time under different incidence positions.
可以看出,当高能粒子入射到漏结(对应的入射位置远离源极而靠近漏极,为0.75-0.85 μm)时,峰值电流较大,这是由于在外加电场的作用下,漏极耗尽层电场强度较大,对应的漂移作用强而引起的,此时器件的敏感区集中在漏结位置。相反当粒子入射到其他位置时,电场强度较弱,扩散电流是主要作用,呈现出电流较弱的趋势。
3.3 电压对晶体管漏电流的影响
在不同的外接电压值下,单粒子瞬态(Single Event Transient, SET)产生的电流的峰值和脉冲宽度可能会不同。为了探究外加电压值对SET的影响,实验中,设高能粒子垂直入射到NMOS场效应管中,入射能量为0.1 pC·m-1,粒子注入后,入射轨迹上产生的电离电荷空间上为特征半径为0.1 μm的高斯分布,时间上为10 ps的高斯分布。采用图3(a)的电路连接方式,试验中实验将外接电压从1 V增加到4 V。对于不同的外接电压,仿真得到漏极电流随时间的变化关系如图6所示。
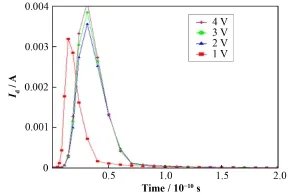
图6 外接电压不同时漏电流随时间变化曲线Fig.6 Leakage current variation with time under different voltages.
从图6可看出,当外接电压较小时,收集的电荷就较少,对应漏电流峰值也较小,反之,外接电压较大会引起漏电流峰值较大,这是由于耗尽层的宽度会因外接电压的增大而加宽。当耗尽层被中和以后,加在其上的电压就会被转移到体区。由于漏斗效应的作用,电场越强时,收集的电荷就会越多,从而导致电流越大。
4 结语
从仿真分析结果可看出,重离子入射时,起初电流迅速增大,这由入射粒子在轨迹上所产生的电子空穴对增多而引起;随后电流的缓慢下降则来源于载流子的扩散作用。入射粒子LET值越大,导致漏电流脉冲的峰值和脉宽也越大;同时粒子入射位置不同会影响漏电流的大小。另外,偏置电压也会影响漏电流大小。通过仿真分析得到的APS光电器件单粒子效应规律特点,为后续建立CMOS APS光电器件的单粒子效应测试方法提供了理论依据,也为CMOS APS光电器件的抗辐射加固设计提供了理论支持。
1 Virmontois C, Toulemont A, Rolland G, et al. Radiation-induced dose and single event effects in digital CMOS image sensors[J]. IEEE Transactions on Nuclear Science, 2014, 6(61): 3331-3340. DOI: 10.1109/TNS. 2014.2369436.
2 曹洲, 把得东, 薛玉雄, 等. 图像传感器单粒子效应脉冲激光实验研究[J]. 真空与低温, 2014, 2(3): 132-135. DOI: 10.3969/j.issn.1006-7086.2014.03.002. CAO Zhou, BA Dedong, XUE Yuxiong, et al. Experimental research on single event effects of CMOS APS image sensor[J]. Vacuum and Cryogenics, 2014, 2(3): 132-135. DOI: 10.3969/j.issn.1006-7086.2014.03.002.
3 Bogaerts J, Dierickx B, Meynants G, et al. Total dose and displacement damage effects in a radiation-hardened CMOS APS[J]. Transactions Electron Devices, 2003, 50(1): 84-90. DOI: 10.1109/TED.2002.807251.
4 Rao P R, Wang X, Theuwissen A J P. Degradation of CMOS image sensors in deep-submicron technology due to irradiation[J]. Solid-State Electron, 2008, 52(9): 1407-1413. DOI: 10.1016/j.sse.2008.04.023.
5 马毅超, 朱纳, 党宏斌, 等. LED电子束辐照试验在线监测系统[J]. 核技术, 2016, 39(5): 050401. DOI: 10.11889/j.0253-3219.2016.hjs.39.050401. MA Yichao, ZHU Na, DANG Hongbin, et al. Online monitor system of LED electron beam irradiation experiment[J]. Nuclear Techniques, 2016, 39(5): 050401. DOI: 10.11889/j.0253-3219.2016.hjs.39.050401.
6 Goiffon V, Estribeau M, Marcelot O, et al. Radiation effects in pinned photodiode CMOS image sensors: pixel performance degradation due to total ionizing dose[J]. IEEE Transactions on Nuclear Science, 2012, 59(6): 2878-2887. DOI: 10.1109/TNS.2012.2222927.
7 Dodd P E, Shaneyfelt M R, Schwank J R, et al. Current and future challenges in radiation effects on CMOS electronics[J]. IEEE Transactions on Nuclear Science, 2010, 57(4): 1747-1763. DOI: 10.1109/TNS.2010. 2042613.
8 Hopkinson G, Mohammadzadeh A, Harboe-Sorensen R. Radiation effects on a radiation-tolerant CMOS active pixel sensor[J]. IEEE Transactions on Nuclear Science, 2004, 51(5): 2753-2762. DOI: 10.1109/TNS.2004. 835108.
9 王军, 李国宏. CMOS图像传感器在航天遥感中的应用[J].航天返回与遥感, 2008, 29(2): 42-47. DOI: 10.3969/ j.issn.1009-8518.2008.02.008. WANG Jun, LI Guohong. The application of CMOS image sensor in space remote sensing[J]. Spacecraft Recovery & Remote Sensing, 2008, 29(2): 42-47. DOI: 10.3969/j.issn.1009-8518.2008.02.008.
10 孟祥提, 康爱国, 黄强. γ射线辐照对数字型彩色CMOS图像传感器输出特性的影响[J]. 原子能科学技术, 2004, 38(增1): 231-215. DOI: 10.3969/j.issn.1000-6931.2004.z1.054. MENG Xiangti, KANG Aiguo, HUANG Qiang. Effect of gamma-ray irradiation on output characteristic of color CMOS digital image sensors[J]. Atomic Energy Science and Technology, 2004, 38(z1): 231-215. DOI: 10.3969/j.issn.1000-6931.2004.z1.054.
11 周彦平, 王晓明, 常国龙, 等. CMOS图像传感器的辐射实验[J]. 红外与激光工程, 2011, 40(7): 1270-1273. DOI: 10.3969/j.issn.1007-2276.2011.07.016. ZHOU Yanping, WANG Xiaoming, CHANG Guolong, et al. Radiation experiment of CMOS image sensor[J]. Infrared and Laser Engineering, 2011, 40(7): 1270-1273. DOI: 10.3969/j.issn.1007-2276.2011.07.016.
12 杜明, 邹黎, 李晓辉, 等. Buffer单元单粒子效应及其若干影响因素研究[J]. 电子器件, 2014, 37(2): 186-198. DOI: 10.3969/j.issn.1005-9490.2014.02.004. DU Ming, ZOU Li, LI Xiaohui, et al. A research in the Buffer cell single event effects and some of its influencing factors[J]. Electronics Device, 2014, 37(2): 186-198. DOI: 10.3969/j.issn.1005-9490.2014.02.004.
Simulation of characteristic of charge collecting for CMOS APS with single event effects
AN Heng YANG Shengsheng MIAO Yujun XUE Yuxiong CAO Zhou WANG Jun ZHANG Chenguang
(Science and Technology on Vacuum Technology and Physics Laboratory, Lanzhou Institute of Physics, Lanzhou 730000, China)
Background: Complementary metal oxide semiconductor active pixel sensor (CMOS APS) with less energy consumption, small volume and less weight is already a major development direction of imaging for remote sensing satellites. During the satellites flying on orbit, electron devices are exposed in space radiation, and degraded by space charged particles. Along with the improvement of semiconductor technology, sensibility of single event effect is more obvious, and is a key factor of reliability. Purpose:This study aims to obtain the characteristics of CMOS APS subjected to charged particles. Methods: Based on analysis of structure and characteristic of silicon on insulator metal-oxide-semiconductor field-effect transistor (SOI MOSFET), radiation damage of CMOS APS irradiated by heavy ions is discussed using the method of theoretical analysis and numerical simulation. And charge collect mechanism of the transistor and photodiode is also analyzed. Results: The procedure of charge collecting is simulated by technology computer aided design (TCAD), and obtained the relationship between the leakage current and linear energy transition (LET), incidence position of heavy ion, offset voltage. Conclusion: The result could beused for CMOS APS’s single event effect and also provide theoretical guide for the design of radiation hardening.
AN Heng, male, born in 1982, graduated from Shandong University with a master’s degree in 2010, focusing on space radiation effect and
date: 2017-02-21, accepted date: 2017-04-11
CMOS APS, Single event effects, Charge collection, TCAD simulation
TL99
10.11889/j.0253-3219.2017.hjs.40.070502
国家自然科学基金(No.11375078)资助
安恒,男,1982年出生,2010年于山东大学获硕士学位,研究领域为空间辐射效应及新型有效载荷技术
2017-02-21,
2017-04-11
Supported by National Natural Science Foundation of China (No.11375078)
payload
