底部填充式BGA封装热机械可靠性浅析
2016-08-24杨建生
杨建生
(天水华天科技股份有限公司,甘肃天水741000)
底部填充式BGA封装热机械可靠性浅析
杨建生
(天水华天科技股份有限公司,甘肃天水741000)
探讨了在超级球阵列封装(SBGA)中,底部填充对各种热机械可靠性问题的影响;针对加工诱发的各种残余应力,研讨有底部填充和没有底部填充的非线性有限元模型;把焊料作为时间和相关温度建模,其他材料酌情按照温度和相关方向建模,分析由于热循环在封装中出现的应力/应变状况;对于焊料球中有关时间的塑性应变、蠕变应变和整个非弹性应变的大小和位置,分析底部填充的影响和铜芯对焊料球应变的影响;凭借定性的界面应力分析,探讨插件与底部填充界面以及基板与底部填充界面处发生剥离的可能性;有关SBGA封装结果表明,底部填充并不总是提高BGA可靠性,底部填充的特性,在BGA封装整体可靠性方面,效果是显著的;与现有试验数据相比,焊点疲劳热循环的预测数量类似于没有底部填充的BGA封装。
球阵列封装;剥离;可靠性;焊点疲劳;底部填充
随着电子封装对高性能、小尺寸和高管脚数产品需求的增长,球栅阵列(BGA)和芯片规模(CSP)封装在很多方面的应用急剧增长。探研底部填充式陶瓷BGA封装的基板级可靠性,在板上倒装芯片(FCOB)组装中,采用底部填充提高焊点可靠性;在BGAs和CSPs封装,完成底部填充,提高可靠性,保护焊球周围环境。
超级球栅阵列封装(SBGATM)是为更高的热、电特性研发的一种BGA封装,应用于军用航空。在军用航空应用中采用SBGA封装,第二级焊球常采用底部填充进行密封,防止焊球周围可能的湿气凝结。使用底部填充达到了环境保护目的,但没有探讨SBGA封装底部填充对热机械可靠性的影响。本文采用计算机模型,弄清有各种底部填充SBGA封装的可靠性问题。依次使用累积非弹性应变和各种界面应力作为损害参数,探讨在有各种底部填充状况下的焊点可靠性和剥离敏感性。通过把焊点疲劳失效热循环数与试验数据进行比较,确定用于SBGA封装研发的有限元模型。

图1 铜芯FR4板上装配底部填充SBGA封装原理图
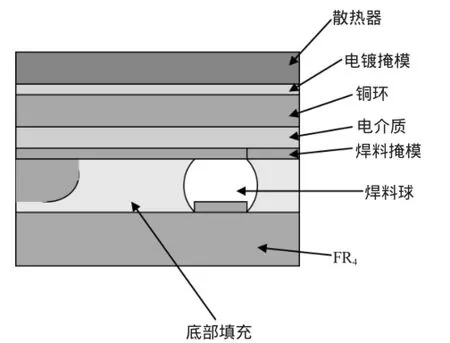
图2 封装几何结构
1 几何图形与材料建模
建模的SBGA封装是一种层压式的、把微通孔有机BT基板粘贴到薄型镀镍铜背面板的封装。图1示出了装配到约束铜芯FR4板上的底部填充SBGA封装原理图。把封装中线作为有限元模型的对称面,图1示出了x-y坐标系。图2示出了各种封装子部件,表1说明了相关的各种材料。
散热器、电介质、芯片、密封剂和粘片的材料特性由供应商提供。对CTE电介质作为正交各向异性进行模拟,对机械特性,作为各向同性、线弹性和相关温度进行模拟。散热器、芯片、密封剂和粘片材料作为线弹性和有相关温度特性的各向同性进行模拟。FR4建模为正交各向异性、相关温度及弹性。焊料为共熔63/37锡/铅合金。焊料的蠕变特性采用二次蠕变方程进行模拟。二次或稳态蠕变可认为焊料疲劳损坏蠕变机制最重要的情况,与在二次蠕变机制中花费的时间相比,一次和三次蠕变发生相对时间较短。二次(稳态)蠕变已广泛应用于描述热循环情况下焊料的非弹性、相关时间特性特征。
稳态(二次)蠕变应变率由下式计算:


表1 SBGA的主要元件和相关材料
这里εc为稳态蠕变应变率,σ为当前应力,A被近似地确定为等于1.84×10-4(MPa)-n(-s)-1的常数,n也被近似地确定为5.2,Q为等于50 J·K/mol蠕变的活化能,RG为等于8.314×10-3KJ/mol-K的通用气体常数,T为焊料球开氏温度。焊料的多线性相关时间塑料特性。
检测了三个下填充物,下填充物A为低CTE、高模量材料,而下填充物C为高CTE、低模量材料。下填充物A代表一种填充的环氧树脂,而填充物C代表一种非填充的环氧树脂,下填充物B具有中间特性。下填充物A、B、C为市场上可买到的下填充物,其特性如表2~表6所示。

表2 下填充物A特性

表3 下填充物B机械特性

表4 下填充物B CTE

表5 下填充物C机械特性

表6 下填充物C CTE
2 下填充物对焊料球应变的影响
为了调查不同下填充物对焊料应变的影响,图3示出了模拟的热剖面图。对有下填充物的装配而言,无应力温度假设为下填充物固化温度165℃。对没有下填充物的装配而言,无应力状况假定为焊料回流温度183℃。装配后,结构假定冷却到室温20℃超过60 min,在-55℃~125℃的热循环之前,停留60 min。循环的上升和下降率阶段为18℃/min,每个高温和低温停留20 min,如图3所示的10个热循环完成模拟。
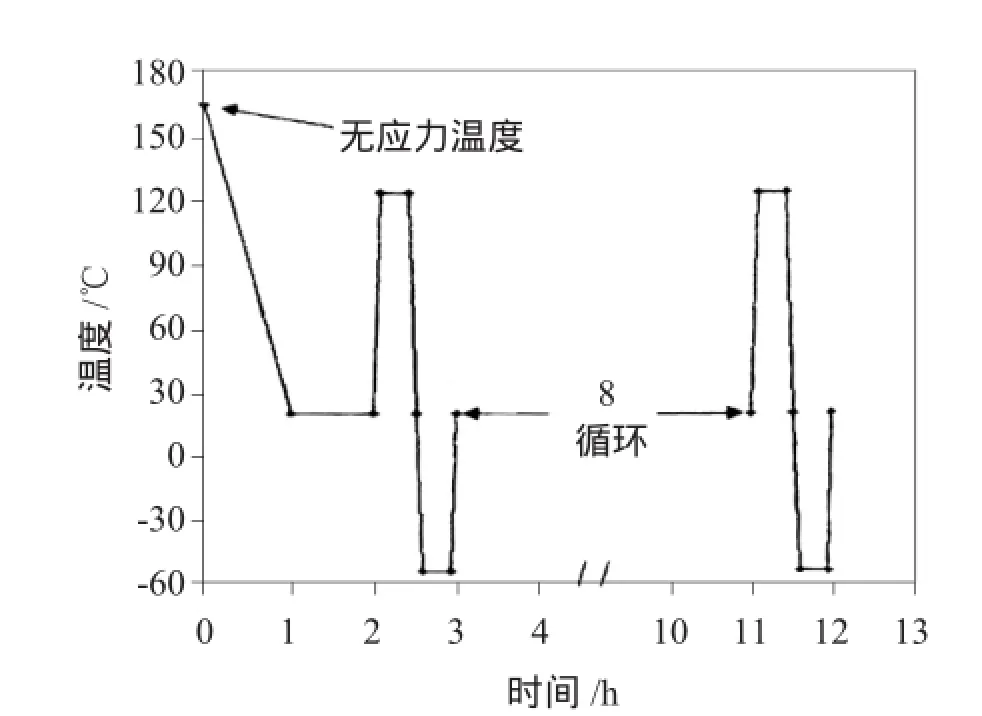
图3 无应力状况的温度循环
选择累积的非弹性应变作为损坏指标,研讨各类下填充物对焊料球热机械可靠性的影响。观察到对研讨的不同下填充物,最大累积非弹性应变点围绕图4所示的3个点之间。图4所示的每个焊料球包含148个元件,且铜焊盘有6个元件。焊料中有限单元网格对所有的模拟是相同的。累积的等效非弹性应变,如图4中的区域Ⅰ、区域Ⅱ和区域Ш,平均超过围绕最大值点元件区域,以便降低提出应变结果的网格依赖性。表7中示出了对最后稳定周期而言,获得的非弹性应变累计百分比。无下填充物情况(表7中表示为“无”)被认为是比较下填充物A、B、C对焊料应变影响的基线。对无下填充物和下填充物C的状况而言,累积非弹性应变最大值位于区域Ⅰ,对下填充物B而言,位于区域Ⅱ,对下填充物C而言,位于区域Ш。通常,与无下填充物SBGA相比,低CTE下填充物A趋于降低累积非弹性应变,然而与无下填充物状况相比,更高CTE的下填充物B和C趋于增大累积应变值。对陶瓷球栅阵列封装(CBGA)而言,观察到随着下填充物CTE的增大,焊料应变以同样的趋势增大。

表7 有铜芯,每个循环非弹性应变累计百分比%

图4 累积等效非弹性应变最大值位置
对刚性和军用传热,在封装中使用铜芯,但理解焊料球可靠性方面铜芯的作用是必要的。没有铜芯的FR4板上SBGA焊球可靠性,如图5所示。
表8示出了无铜芯FR4板上SBGA封装焊球中等效非弹性应变累积百分比,表9对无下填充物、下填充物A和下填充物C的有芯和无芯等效非弹性应变值累积百分比,进行了比较。可看出把封装置于更柔性的无铜芯板上,会使焊料应变更低。累积等效非弹性应变值下降小,但是板硬度、下填充物材料和使用温度不恰当的组合,会把疲劳寿命降低到不能接受值。

图5 没有铜芯的FR4板上封装

表8 无铜芯每个循环累积等效非弹性应变百分比%

表9 每个循环累积等效非弹性应变百分比%
3 下填充物对界面各种应力的影响
剥离现象就是相邻各层间的剥离或分离。在自由边缘产生的界面应力,是初始剥离现象的主要驱动因素。虽然没有建立准则来预测初始剥离,但是确定界面剪切和剥离应力,并与相应的界面剪切和剥离强度进行比较是一种方法。剥离现象是依据位置的一种嵌入式剥离或边缘剥落现象,采用如图6所示的3个界面处(水平1、水平2和垂直1)的定性变化,来理解各种下填充物对有铜芯板SBGA封装的剥离现象敏感性影响。
剥落和剪切应力,如图6所示在水平1和水平2界面处,作为从各自路径起源的路径距离的函数,绘制了研讨的3个下填充物。路径水平1为SBGA的BT板与下填充物之间的界面,路径水平2为下填充物和板间的界面,路径垂直1为如图6所示的下填充物圆角与SBGA封装的BT基底边缘之间的界面。
对下填充物C而言,在125℃,-55℃和室温20℃,沿水平2界面的剥落和剪切应力。剥落和剪切应力的大小向自由边缘增加,可观察到两个界面的剥落和剪切应力在-55℃最高,此温度离无应力下填充物固化温度(165℃)最远。
高CTE下填充物(下填充物C),当冷却时,趋向于从板收缩和伸缩,造成沿水平2路径向自由边的高开口或拉伸剥离应力。对考虑的下填充物而言,与下填充物A的低CTE和高模数相比,下填充物C由于增大的CTE和较低的模数,剥离应力的大小近似地增大2到4倍。
在水平1界面状况下,界面各种应力在起始路径的大小方面相对较高,高CTE低模数下填充物C造成高剥离应力。然而,在下填充物圆角区域,下填充物的收缩,似乎是防止路径水平1末端高界面剥离应力发生的可能性。事实上,在下填充物圆角区域,下填充物的收缩造成了沿SBGA BT基板(路径垂直1)侧面的压缩应力。注意到,应采用各种界面应力变化,来比较趋势和相对大小。绝对值,特别是接近自由边的绝对值受奇异点和网格密度的影响。
为了理解沿垂直1的抗压应力,图7示出了下填充物C在低温时x方向的应变。沿路径垂直1的x方向应变为负,因此,对下填充物C而言,抗压剥离应力较大。由于剥离应力,与其他两个研讨的界面相比较,负剥离应力表明垂直1界面不至于老是剥离失效。对下填充物A而言,如图8所示,沿路径垂直1的x方向的应变大小,小于下填充物C的x方向的应变。下填充物A的抗压影响较弱,允许此区域部分剥离应力为正。

图6 典型界面位置图

图7 x方向应变,下填充物C

图8 x方向应变,下填充物A
下填充物的收缩,导致了在所有界面处的高剪切应力。当下填充物从A到C变化时,剪切应力粗略地增大2到5倍。因此封装上高CTE、低模量下填充物(下填充物C)最可能造成的影响,就是增大沿路径水平1和水平2剥离的可能性。通常,当下填充物CTE增大且模数下降时,剥离初始驱动力增大。为了研讨剥离确实为初始和传播,不仅需要测量剥离和剪切强度,而且伴随着合适的模态混合度,测量不同下填充物各种界面的界面断裂韧性。
4 模型验证与寿命预测
从公布的可靠性数据选取352 SBGA封装,来验证提供的有限元模型。研讨的腔体向下封装与本文中的SBGA封装具有相同类型的结构。FR4板上352 BGA经受采用三区域室进行的热循环,温度范围为-55℃~125℃。在高温和低温滞留时间约20 min,总循环时间约68 min。测试期间就地测量实际升温速率,测定的加热与冷却率是非线性的,范围为±10到15℃/min,平均升降率为12.9℃/min。SBGA封装的建模几何图形如图9所示,注意到研发的BGAs没有进行下填充。由于滞留时间为20 min,循环时间为68 min,上升和下降率为12.9℃/min,采用焊料回流温度183℃作为锁定轨温,总共模拟10个热循环。假定材料特性与在研讨的SBGA封装中使用的一样。
表10示出了采用模型预测的焊料疲劳失效的循环数量,寿命预测模型的相关公式概括为:

式中,C为等于890%的试验确定常数,Δγmc为蠕变剪切应变范围。

式中,Δγp为塑料剪切应变范围,a为等于0.51的试验确定常数,θ为等于1.14的试验确定常数。

式中,Nt为由于非弹性应变、循环的总寿命,Np为由于塑性应变、循环的总寿命,Ncr为由于蠕变应变、循环的总寿命。
各种封装热循环结果如图10所示,352 SBGA第一次失效为近似于2 600个循环,平均失效为3 300个循环,90%失效为3 900个循环。焊点的预测寿命为与表10所示的90%的累计失效百分比的范围一样。

表10 寿命预测比较

图9 研讨的SBGA模型示意图

图10 研讨的失效循环
5 结束语
研讨了在SBGA封装中,下填充物对发生剥离现象的焊料应变及可靠性的影响。结果表明下填充物不总是增大SBGA的可靠性,但是下填充物的特性在整个SBGA封装可靠性方面起着重要的作用。与无下填充物的封装相比,具有高CTE和低模数的下填充物能够增大下填充SBGA封装的焊料应变,因此能够降低焊点的整个疲劳寿命。观察到在热循环期间,特别是在自由端,高CTE和低模数下填充物对剥离失效更敏感。可看出低CTE、高模数下填充物降低了焊料应变,并且沿着大部分界面产生较低的界面应力。再者,可观察到没有铜芯将降低焊料应变,增大焊料疲劳寿命。然而,当SBGA封装具有接近板的累积CTE,对所有状况而言,焊点中的应变具有低量级。
由于低焊料应变,焊点很可能持续3 000多个循环,且焊点疲劳很可能在很多应用中不涉及。但是板硬度、下填充物特性和/或非优化过程步骤的不恰当结合,会导致下填充式BGAs中早期疲劳失效。
[1] James Pyland,Raghuram V.Pucha,Member,IEEE,andSuresh K.Sitaraman.Thermomechanical Reliability of BGA Packages[J].IEEE TRANSACTIONS ON ELECTRONICS PACKAGING MANUFACTUREING.APRIL 2002,VOLUME 25,NUMBER 2:100-106.
[2] Y.Sawada,A.Yamaguchi,S.Oka,and H.Fujioka.Reliability of Plastic Ball Grid Array Package[J].IEEE TRANSACTIONS ON COMPONENTS AND PACKAGING TECHNOLOGIES,MARCH 2002,VOLUME 25,NUMBER1:73-78.
[3] 中国电子学会封装专业委员会,电子封装丛书编委会.微电子封装手册[M].第1版.北京:电子工业出版社,2001.145-152.
[4] 电子封装技术丛书编委会编.集成电路封装试验手册[M].北京:电子工业出版社,1998.39-51.
Simple Analysis for Thermomechanical Reliability of Underfilled BGA Packages
YANG Jiansheng
(Tianshui Huatian Technology Co.,Ltd.,Tianshui 741000,China)
The effect of underfill on various thermo-mechanical reliability issues in super ball grid array(SBGA)packages is studied in this paper.Nonlinear finite element models with underfill and no underfill are developed taking into consideration the process-induced residual stresses.In this study,the solder is modeled as time and temperature-dependent,while other materials are modeled temperature and direction-dependent,as appropriate.The stress/strain variations in the package due to thermal cycling are analyzed.The effect of underfill is studied with respect to magnitude and location of time-independent plastic strain,time-dependent creep strain and total inelastic strain in solder balls. The effect of copper core on the solder ball strains is presented.The possibility of delamination at the interposer-underfill interface as well as substrate-underfill interface is studied with the help of
Super ball grid array(BGA);Delamination;Reliability;Solder joint fatigue;Underfill
TN305.94
B
1004-4507(2016)08-0009-07
2016-07-14qualitative interfacial stress analysis.Results on SBGA packages indicate that the underfill does not always enhance BGA reliability,and that the properties of the underfill have a significant role in the overall reliability of the BGA packages.The predicted number of thermal cycles to solder joint fatigue are compared with the existing experimental data on similar nonunderfilled BGA packages.
杨建生(1964-),男,现为天水华天科技股份有限公司工程师,主要从事半导体集成电路项目管理和科技情报信息工作,已发表半导体集成电路封测工艺技术论文数十篇。
