系统级封装中焊点失效分析技术
2016-05-19潘书山
潘书山,陈 颖,季 斌
(驻三乐电子信息产业集团有限公司军事代表室,南京210016)
系统级封装中焊点失效分析技术
潘书山,陈颖,季斌
(驻三乐电子信息产业集团有限公司军事代表室,南京210016)
摘要:针对系统级封装(SiP)结构中的互连可靠性检测,提出了叠层封装中焊点失效分析的原则和程序。对采用3D X-ray和金相技术的焊点缺陷分析方法进行了对比,验证了3D X-ray分析复杂SiP封装焊点和互连缺陷的可行性。讨论了失效的模式和失效机理,并从设计和工艺角度提出降低各种失效机理的改进措施。
关键词:系统级封装;失效分析;焊点;缺陷;X光;金相分析
1 引言
系统级封装(SiP)是将多个具有不同功能的有源芯片、无源器件、MEMS器件、光学器件等组装成一个多功能的标准封装体,并形成系统或子系统[1,2]的封装方式,如图1所示。SiP产品具有设计灵活、上市周期短、工艺兼容性好、研发成本低等优点,引起了业界制造商以及学术界的高度重视,成为弥补多芯片模块(MCM)和系统级芯片(SoC)封装的一种理想可行的封装技术。
当系统级封装向着更小、更轻、功能更强大的方向发展时,越来越多的芯片集成到封装体中,对产品的设计、装配过程提出了更高的要求,而日趋复杂的结构也为失效分析带来了更大的难度[3,4]。SiP产品复杂的结构常常限制了部分分析仪器的应用,如何利用有效分析手段确定失效诱因,对设计工艺、操作方法、加工环境等方面提出纠正措施,就要求充分了解SiP封装系统内部芯片、互连失效的可能因素。
本文针对SiP叠层封装结构中的互连可靠性检测,分析了系统级封装中焊点失效分析的难点,制定了失效分析的原则和程序,采用3D X-ray和金相技术分析了焊点的缺陷,并对这两种分析技术进行了对比,验证了3D X-ray分析复杂SiP封装焊点和互连缺陷的可行性,讨论了失效模式和失效机理,并从设计和工艺角度提出降低各种失效机理的改进措施,作为SiP组件可靠设计和生产的参考。
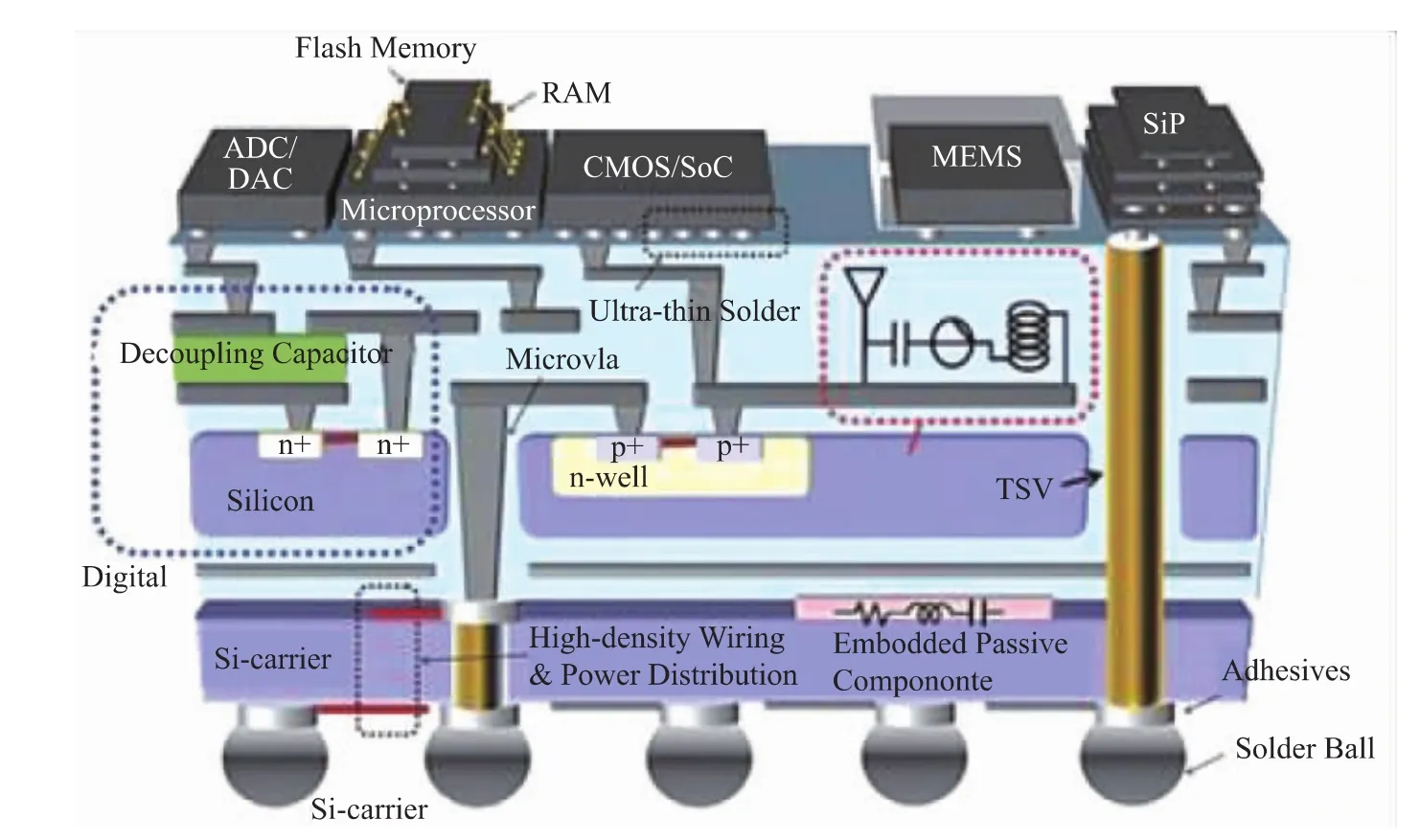
图1 系统级封装(SiP)示意图
2 SiP封装中焊点失效分析的难点
如图1所示,系统级封装中BGA焊球是SiP与PCB载板之间的重要接口,随着系统级封装集成度、I/O接口数量和密度越来越高,系统级封装以及与PCB基板的互连可靠性面临着越来越大的挑战。目前影响SiP与PCB焊点互连可靠性的因素有以下几点。
2.1高密度布线的影响
目前高密度集成的SiP的I/O接口数量在几百到几千的数量级,PCB板的布线需要极其微小的特征尺寸,要求几十微米量级的线宽和通孔焊盘直径,4~8层的互连金属层。微通孔基板技术在印刷电路板行业中扮演着越来越重要的角色,同时高密度互连封装对基板的平整度提出很高要求,要求0.65 mm厚的基板每英寸的翘曲在5~10 μm之内。基板翘曲对于焊点的互连有着至关重要的影响。
2.2复杂机械应力的影响
由于SiP集成了不同工艺、功能的芯片和器件,不同元器件在热处理过程中CTE(热膨胀系数)的不同将导致SiP的热机械应力可靠性问题。这些热机械应变将导致焊点的低周疲劳失效、焊料凸点的分层以及封装系统的开裂,从而导致封装体的失效。使用底部填充料可以有效减少焊料凸点处的热应力,提高可靠性,然而未来的互连更窄,间隙更小,使得底部填充料的分配愈发复杂。
2.3低k(介电常数)介质材料对铜的低吸附问题
高频SiP系统中常使用LCP、BCB等低k材料,具有良好的微波传输特性,具有低损耗、介电常数稳定的优点。然而与SiO2相比,低k材料更软,容易延展,与其他物质粘附能力较弱,容易出现分层现象,从而影响封装内部以及与基板之间互连的可靠性。
在这些因素的影响下,系统级封装中焊点失效分析比单芯片倒装时焊点数量规模更大,焊点失效分析相比更复杂。SiP各类新材料的引入引发的各种新的可靠性问题,特别是目前受到广泛重视的新的、越来越复杂与多样化的界面以及新的力学特性,必然引入新的失效机理与失效模式,失效分析技术的基础研究工作很重要。随着电子产品向小型化、轻量化和多功能化的方向发展,传统的失效分析方法不能适应当前发展的需要,失效分析技术必须向高空间分辨率、高灵敏度和高频率的方向发展,需要采用先进的仪器进行分析。
3 SiP封装焊点失效分析方法
3.1 SiP焊点失效分析流程
失效分析的原则是先调查了解与失效有关的情况(线路、应力、失效现象等),后分析失效元器件;先进行外部分析,后进行内部分析;先进行非破坏性分析,后进行破坏性分析,具体失效分析流程如图2所示。失效分析流程中最关键的3步分别为电测、缺陷定位和物理分析。
3.1.1电测
电子元器件失效分析的电测指对被测系统的连接性、电参数和功能进行测试,以初步确定其失效缺陷。连接性测试用以确定失效模式,比如开路、短路、漏电以及电阻值变化等。电参数测试主要用于封装系统具体指标测试,包括指标一致性等。电参数失效的主要表现形式有参数不稳定和数值超出规定范围等。功能测试主要用于集成电路,通过在元器件输入端加载信号,测量输出信号。
3.1.2缺陷定位
电测之后基本发现了被测器件的缺陷,要采用相关手段进行缺陷或故障定位。首先采用无破坏性的定位手段进行失效器件的缺陷诊断,即先保持封装完整。3D X-ray缺陷检测技术、同步热发射(LIT)分析技术和磁显微缺陷定位技术适用于3D SiP封装结构的非破坏性缺陷检测及定位。而光发射显微术(PEM)、液晶热点检测技术等都是常用的破坏性缺陷检测技术,因其需要开封器件。
3.1.3物理分析
物理分析指的是破坏性的内部分析,包括开封、去层、FIB(聚焦式离子束显微镜)制样等。引起失效的缺陷常常存在于表面和界面,在此情况下电介质和金属连线必须去除。为了确定失效机理通常需要对缺陷位置进行截面分析,FIB缺陷分析技术是常用的技术。

图2 系统级封装(SiP)失效分析流程图
3.2 SiP焊点失效分析方法
对焊点进行失效分析,需采用一些先进的分析测试技术和仪器。不同的失效分析技术有不同的目的和适用范围,熟悉并熟练运用各种分析技术是失效分析人员必备的条件。
(1)实体显微镜、旋转式光学显微镜、金相显微镜可直接用来进行检查分析,是非破坏性的失效分析方法。各种显微镜的使用范围和使用场合各不相同。实体显微镜放大倍数为10~60倍,通过目镜直接观察物体,如焊点的润湿及熔融状况,染色实验的焊点断裂状况。可旋转式光学显微镜放大倍数为50~400倍,能进行360°旋转,从物体的侧面观察,并可以通过软件保存观察到的图像。金相显微镜的放大倍率为50×,100×,200×,500×,1 000×,能通过软件保存观察到的图像,最主要用于微切片的观察和分析,如焊点的润湿状况,焊点的IMC层厚度的测量,焊点中的气泡状况,焊点锡裂情形。一般来说,把这3种显微镜结合使用可以对焊点的润湿角、失效部位、焊点表面颜色进行失效定位和失效模式初判。
(2)X-ray检测采用穿透式非破坏性检测原理,即由于物体由不同元素构成以及其密度和厚度存在差异,造成对X光的吸收率和透射率不同,待检测物体经X射线穿透后,高感光仪器可以将到达感光层的X光转换成可见光,并利用CCD成像,成为可供分析的灰阶影像。所有的X-ray检查系统根据成像空间分为2D(二维)、3D(三维)检查系统。X射线透视仪一般用于检测电子元器件及多层印制电路板的内部结构、内引线开路或短路、粘接缺陷、焊点缺陷、封装裂纹、空洞、桥连、立碑等缺陷。在失效分析中,经常用它进行失效定位和失效模式的判定。
(3)金相切片分析是一种破坏性的物理分析方法,也是检验和分析焊点焊接质量的一种重要方法。金相试样一般要经过取样、镶嵌、切片、磨制、抛光、腐蚀、观察的过程。焊点在不同深度水平上切割,可以获得整个焊点截面上的成分分布。焊点也可以根据需要在任何不同的角度切割,以便暴露特殊焊点的细节。因此,经过金相切片分析可以获得焊点界面结构信息和观察焊点的焊接状态。
(4)扫描电子显微镜( SEM)及X射线能谱仪(EDS)随着组装工艺的更新发展,新的材料在组装工艺中的使用,微结构观察和金属合金分析是考察组装可靠度不可缺少的方法。然而普通的光学显微镜受到景深、分辨率、放大倍数、观察角等条件的限制已经不能满足上述工作的需要,扫描电子显微镜扮演了重要的角色。扫描电子显微镜的基本原理是:由阴极所发射的电子束经阳极加速,由磁透射镜汇聚后形成一束直径为几百纳米的电子束流,这束高能电子束轰击到样品表面上会激发出各种信息,这些激发出来的信息分别经收集、放大,就能从显示屏上得到相应的图像。如最常用作形貌观察的二次电子像(SE),可反映化学成分分布差异的背散射电子像(BS),反映半导体芯片表面电位高低及分布的电压衬度像(VC)等。扫描电子显微镜在失效分析中主要用于失效定位和缺陷分析。对于焊点的失效分析来说,可以用它进行焊点金相组织观察、金属间化合物与锡须观察、可焊性镀层分析等。此外,扫描电子显微镜都配有X射线能谱仪(EDS),用来将样品发出的特征X射线进行化学成分分析。通过EDS获得的X射线图谱,在评定焊点成分的化学结构时特别有用,此外也可以进行可焊性不良的焊盘与引脚表面污染物的元素分析。
4 SiP封装堆叠焊点失效现象
焊点可靠性影响到器件的整体可靠性,焊点失效将造成整个器件失效。SiP器件倾向于应用复杂的封装结构,如多层裸芯片堆叠封装、封装堆叠(PoP,如图3所示)等,这些新型封装不仅增加了大量的焊点,而且对焊点的要求比简单封装更加严格。这些变化无疑都加大了焊点失效的几率,也使得SiP器件的焊点检测更有必要。封装堆叠常见的失效模式除了封装体翘曲外,焊点失效也是PoP器件的典型失效模式,有焊点开裂、漏焊、空洞、桥连、润湿不良等。

图3 封装叠层(Package on Package,PoP)
采用无破坏性的定位手段进行失效器件的缺陷诊断,无需打开或移除封装。除了图2提及的3种先进的无损技术,3D X-ray缺陷检测技术、同步热发射(LIT)分析技术和磁显微缺陷定位技术适用于3D SiP封装结构的缺陷检测及定位。无破坏性内部分析常用的技术还包括(2D)X-ray检测、发射式声学扫描(C-SAM)。其中C-SAM是检测塑封器件是否有分层、裂纹及空洞的有效手段。
本文针对3D X-ray缺陷定位技术在3D SiP缺陷检测方面的应用,对检测结果中两种典型的焊点缺陷空洞和枕头效应进行分析。
4.1 PoP焊点失效的3D X-ray检测
实验采用的样品将两个BGA封装体垂直堆叠形成两层封装叠层器件,其中顶层封装体含有两片芯片,底层封装体含有一片芯片,内部结构如图3所示。在BGA焊球的放大照片中,可以清晰地发现BGA焊点存在空洞和焊点假接触(枕头效应)的现象,通过3D X-ray可以清晰定位缺陷位置。说明在焊接过程中焊料挥发产生气体存在残留,同时回流不充分也可能导致焊点假接触,从而导致互连失效。

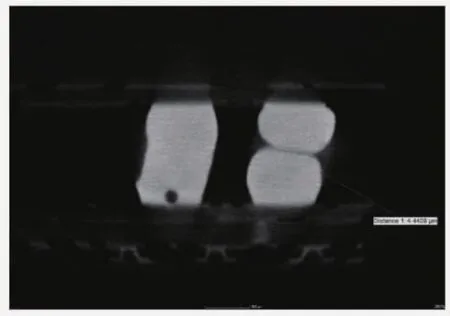
图4 封装叠层器件的3D-X ray照片
4.2金相切片分析
将两层PoP样品进行固封、研磨、抛光,通过金相显微镜观察每一排焊点的形貌,并拍照记录。部分焊点的显微观察如图5所示。可以发现,BGA焊点中确实存在空洞和枕头现象,与X光照片相符。
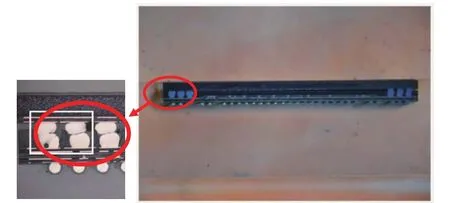
图5 叠层封装金相切片分析照片
5 结果分析与讨论
5.1空洞
空洞是BGA焊点中最常见的一类工艺缺陷。焊点的空洞都是由于内部气体在焊球固化前没有得到彻底释放所致。两层叠层封装的BGA焊球中出现的焊点空洞如图6所示。


图6 BGA焊球的空洞效应
焊点空洞形成的原因有多方面,例如锡膏中助焊剂比例偏大,难以在焊点凝固之前完全挥发;焊接时间过短,气体全部逸出的时间不够;焊球沾染有机物或被氧化;焊膏对BGA焊球的润湿能力不足;回流曲线设置不当与焊膏性能不匹配;焊料不良,金属颗粒尺寸大,还有其他原因等[5]。
BGA焊点空洞对封装系统的可靠性有双重影响:(1)适当的空洞能够有效释放焊点内部的应力;(2)空洞附近的应力相比于其他地方大,容易产生裂纹。总结业界公司的相关标准:空洞比例(面积比)在15%~25%可以接受。另外,BGA空洞在焊点中的位置对可靠性的影响不同,位于界面附近的空洞影响焊点整体可靠性的程度比远离界面的空洞更强烈。
对于空洞不达标的焊点,必须采取有效措施进行改善,可参考以下措施:(1)设置最佳回流曲线,控制好预热温度和时间,让气体在固化前完全挥发;(2)焊接时间不宜过长,以防止焊盘、焊料被氧化;(3)保证焊盘可焊性良好;(5)锡膏中助焊剂的比例适当。
5.2枕头效应
枕头效应(Head-In-Pillow, HIP)是近年来频繁发生于BGA封装焊点中的一种缺陷[6]。枕头效应主要表现为在靠近焊接处出现凹面,与正常焊点有很大的不同,或形成部分熔合挤压的凹形,或呈没有接触、分离的两部分,如图7所示。

图7 BGA焊球的枕头效应
BGA器件受热变形、焊球大小不均衡、锡膏与焊接工艺不匹配、锡膏活性不够、焊球污染、锡膏氧化和回流不足等原因都可能引起枕头效应。存在枕头效应的焊点表现为部分或是假连接(不连接),在前期的在线测试中难以发现,却在后期易于出现问题,所以在前期就要控制枕头效应的发生率。可从来料和工艺方面着手:
(1)来料控制:使用合适的锡膏、BGA器件和基板材料,目的是降低材料之间的热膨胀系数差异,有效控制回流中的BGA变形;
(2)工艺控制:设置焊接工艺参数与锡膏匹配,避免回流不良;BGA与焊盘贴装匹配,避免偏位造成电气连接失效;缩短焊接时间,避免焊球被氧化和沾污。
6 总结
本文针对SiP封装中BGA焊点的缺陷进行了实效分析,对比了3D X-ray技术的检测结果与金相切片分析结果,验证了3D X-ray技术是检测BGA焊点的有效手段。本文论述了焊点空洞和枕头效应对于SiP集成封装系统的影响,从材料性能、工艺、结构等多方面对缺陷形成进行了分析,并对提高SiP封装可靠性提出了相关建议。
参考文献:
[1]龙乐.系统封装技术及发展[J].电子与封装,2004,4(2): 2.
[2]胡杨,蔡坚,曹立强,等.系统级封装(SiP)技术研究现状与发展趋势[J].电子工业专用设备, 2012, 41(11): 1-6.
[3] Oppermann M , Zerna T , Wolter K J. X-ray computed tomography on miniaturized solder joints for nano packaging [C]. 11th IEEE Electronics Packaging Technology Conference. 2009: 70-75.
[4] Krause M, Altmann F, Schmidt C, et al. Characterization and failure analysis of TSV interconnects: From non-destructive defect localization to material analysis with nanometer resolution[C]. 2011 IEEE 61st Electronic Components and Technology Conference (ECTC), 2011: 1452-1458.
[5]王文利,梁永生. BGA空洞形成的机理及对焊点可靠性的影响[J].电子工艺技术, 2007, 28(3): 157-159.
[6]贺光辉,罗道军. BGA“枕头效应”焊接失效原因[J].电子工艺技术, 2011, 32(4): 202-204.

潘书山(1973—),男,江西进贤人,博士研究生,从事微电子质量方面研究。
Failure Analysis of Solder Joint in SiP Modules
PAN Shushan, CHEN Ying, JI Bin
(The Military Representative Office in Nanjing Sanle Electroinic Information Industry Group Co.,Ltd, Nanjing 210016, China)
Abstract:The paper reports a failure analysis technology for solder joint defects in SiP modules. The experiments results of 3D X-ray and metallographic analysis are compared, which verified the method of 3D X-ray analysis. The detailed mechanism and mode of the solder joint failure are explained, and suggestions are given for improving the performance of solder joint.
Keywords:system in package(SiP); failure analysis; solder joints; defects; X-ray; metallographic analysis
作者简介:
收稿日期:2016-1-12
中图分类号:TN305.94
文献标识码:A
文章编号:1681-1070(2016)04-0004-05
