氮流量对热丝制备富硅-氮化硅薄膜的结构及性质影响
2016-02-07高爱明周炳卿张林睿乌仁图雅
高爱明 周炳卿 张林睿 乌仁图雅
(内蒙古师范大学物理与电子信息学院功能材料物理与化学自治区重点实验室 内蒙古 呼和浩特 010022)
氮流量对热丝制备富硅-氮化硅薄膜的结构及性质影响
高爱明 周炳卿 张林睿 乌仁图雅
(内蒙古师范大学物理与电子信息学院功能材料物理与化学自治区重点实验室 内蒙古 呼和浩特 010022)
采用热丝化学气相沉积法,以SiH4、NH3、N2作为反应气源,通过改变氮气流量来制备富硅-氮化硅薄膜材料。通过傅里叶红外变换谱、紫外-可见光吸收谱、光致发光谱、扫描电镜分别对薄膜的结构、带隙宽度、发光特性及表面形貌进行表征与分析。实验结果表明,随着氮气流量增加,薄膜中N原子含量减少,镶嵌在氮化硅母质中的硅团簇增大,Si-N键的键密度逐渐减少,薄膜的光学带隙Eg和带尾能EU呈现减小的趋势,薄膜有序度增加,且由氮悬挂键所引起的缺陷态发光峰增强。当氮气流量为30sccm时,Si-N键的非对称伸缩模式和Si-H键伸缩振动模发生了蓝移,当[N2]/[NH3]流量比小于5:1时,氮气流量对薄膜中氮含量的影响非常明显,适当地降低氮流量有利于制备出富硅-氮化硅薄膜。
热丝化学气相沉淀法;富硅-氮化硅;微结构;发光特性
引言
随着太阳能电池材料研究的不断深入,含有硅纳米颗粒的富硅-氧化硅和富硅-氮化硅薄膜由于具有带隙可调的优势,被用于制备新型太阳能电池并逐渐成为新型太阳能电池研究的热点之一[1]。对于含有硅纳米颗粒的薄膜介质,目前以富硅-氧化硅研究为主,但由于氧化硅禁带宽度较高不利于载流子的注入,因此许多研究者开始将目光转向禁带宽度较低的富硅-氮化硅薄膜来替代氧化硅作为镶嵌的基体材料并有效地提高载流子的注入效率,但由于富硅-氮化硅作为基体材料引入更多的缺陷,从而使富硅-氮化硅薄膜的发光性质较富硅氧化硅薄膜更加复杂[2]。因此,在将富硅-氮化硅薄膜用于实际新型太阳能电池之前必须对其制备方法以及基本特性进行深入的研究。
不少研究组[3,4]采用等离子化学气相沉积法(PECVD)或同时加以退火处理制备不同硅含量的富硅-氮化硅材料,对其光致发光进行了研究。然而,利用PECVD制备富硅-氮化硅存在的问题:离子的轰击容易导致薄膜受到损伤;沉积速率比较缓慢不利于薄膜的晶化。相对PECVD而言,采用热丝化学气相沉积法(HWCVD)制备富硅-氮化硅薄膜是一种新颖的制备技术。热丝在高温下能够充分地分解气体,分解的基元直接经过热丝的催化作用发生气相反应,在空中或到达衬底表面快速地形成硅纳米颗粒而形成富硅-氮化硅薄膜,同时能够提供大量高能氢原子可使网络充分弛豫,有利于形成镶嵌在氮化硅母质中的硅晶粒[5]。依据此,本实验采用HWCVD技术通过调节氮气流量来控制镶嵌在非晶氮化硅基质中的硅晶粒大小,制备出含有硅晶粒的富硅-氮化硅薄膜。测试中我们选择P型(100)的单晶硅片和Corning7059玻璃片作为衬底,在制备条件完全相同的情况下,当薄膜沉积到一定厚度时,两种衬底上沉积的薄膜的信息可认为几乎一致,单晶硅片的薄膜被用于PL、FTIR谱[6-10]和扫描电镜的测试,玻璃衬底的薄膜用于紫外可见光谱的测试。通过红外傅里叶转换吸收(FTIR)光谱、紫外可见光(UV-UIS)光谱、光致发光(PL)光谱和扫描电镜(SEM)研究了沉积工艺对薄膜的结构和发光特性的影响,为下一步制备镶嵌在非晶氮化硅母质中的硅量子点薄膜材料打下基础。
1 实验方法
实验使用热丝化学气相沉积设备制备富硅-氮化硅薄膜。1.单晶硅片的清洗:(1)用去离子水煮沸5分钟;(2)用丙酮超声波10分钟;(3)用无水乙醇超声波10分钟;(4)使用2%FH酸溶液处理5s;(5)用氮气烘干。2.玻璃衬底的清洗:(1)用去离子水煮沸5分钟;(2)用浓硫酸与双氧水1∶1混合液煮沸5分钟;(3)用丙酮超声波清洗10分钟;(4)再用无水乙醇超声波清洗10分钟;(5)用氮气烘干。将清洗好的单晶硅片和玻璃放入背景真空度为4.0×10-5Pa的反应室。热丝为钨丝,热丝直径0.50mm、长160mm,间距为350mm ,平行布置在距气口350mm 处。在保持热丝温度1600℃,衬底温度200℃,沉积气压30pa,热丝与衬底间距5.50cm,SiH4流量1sccm,NH3流量10sccm不变的条件下,改变氮气流量(0-200sccm),在P型(100)的单晶硅片和Corning7059玻璃片上分别沉积富硅-氮化硅薄膜,所有样品的沉积时间均为30min。
热丝温度通过红外测温仪测定。采用Lambda750型紫外-可见光分光光度计测量玻璃衬底上沉积的氮化硅薄膜材料的透射光谱,并由此计算出薄膜的带隙宽度。使用Nicolet 6700型傅里叶变换红外吸收光谱仪测定单晶硅片衬底上沉积的薄膜材料红外吸收光谱,了解薄膜材料的键合以及相关键结构的演化情况。采用F-4600型荧光光谱仪测量单晶硅片衬底上沉积的薄膜的发光光谱,了解薄膜材料缺陷态的发光特性。通过SU8010型扫描电镜分析单晶硅片衬底薄膜样品的表面形貌。
2 实验结果与分析
2.1 FTIR谱及其键合情况
通过样品的FTIR光谱,能够很好的了解SiNx 薄膜中相关的化学成分和化学键结构的变化情况。图1为氮气流量分别是0、30、50、100、200sccm时,在单晶硅片上制备的五个样品的FTIR光谱。由红外光谱各吸收峰强度随氮气流量的变化可以清晰地看到各个键合作用的变化情况,不同的吸收峰位对应于不同的红外振动模式。其中476cm-1吸收峰对应Si-N键的对称伸缩模式,640cm-1的吸收峰对应Si-H键的摇摆振动模式,830-870cm-1附近出现的吸收峰对应Si-N键的非对称伸缩模式,2000-2210cm-1附近出现的吸收峰对应Si-H 键伸缩振动模式,这些吸收峰的分布位置与公认的光谱分布结果一致[11]。薄膜中N主要以Si-N,N-H键存在,而Si-N键主要影响富硅-氮化硅薄膜的特性。从图中可以看到随着氮气的减少Si-N的含量逐渐增多。
根据Lanford和Rand的方法,薄膜中各种键合结构的密度Cx可由对应伸展振动模的积分强度 确定[12]:

其中x表示Si-N键合模式, A、 和 分别为校正因子、吸收系数和波数,Si-N键密度的校正因子A近似为6.3×1018 cm-2。
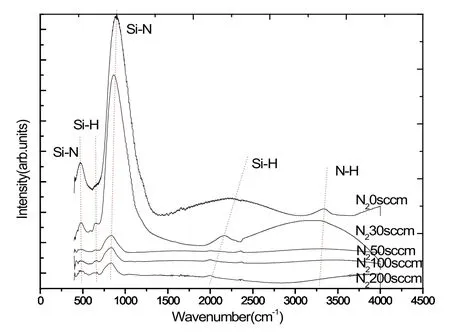
图1 不同氮气流量的SiNx薄膜的FTIR谱Fig 1 FTIR spectrum of the SiNx film at different nitrogen flows
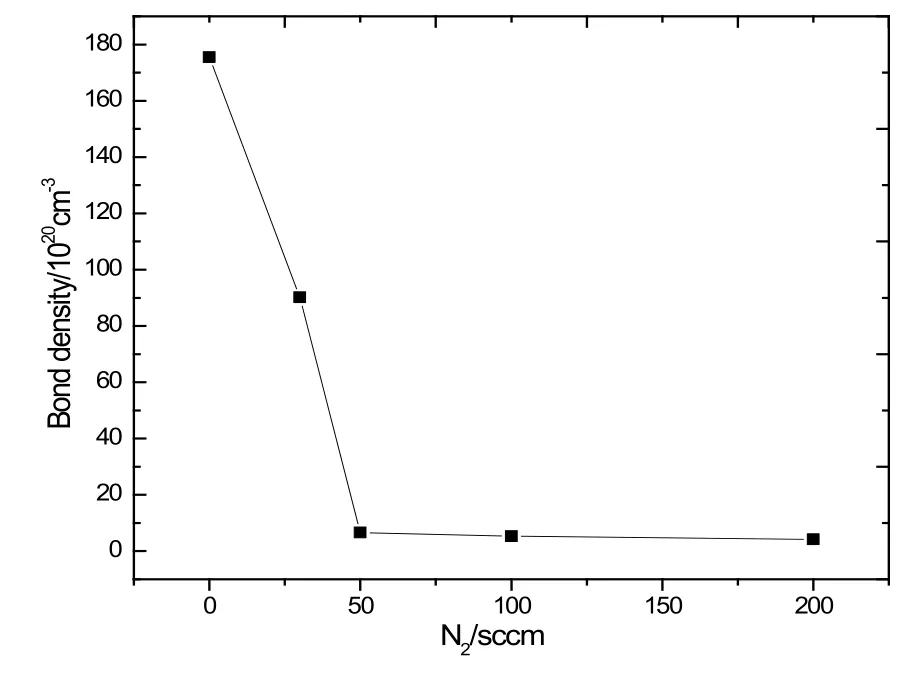
图2 Si-N键密度随N2 流量的变化Fig 2 Si-N Bond density varies with the flow rate of N2
由图2所示,我们计算的Si-N键的密度随N2流量的增加从1.75×1022.cm-3到4.2×1020. cm-3逐渐减小,表明进入薄膜中的氮原子逐渐减少。图1所示:当氮气流量小于50sccm时,Si-N键的非对称伸缩模式向高波方向移动,这说明随着氮气流量的减少, 氮原子掺杂特性消失,与一个 Si原子结合的N原子数目增多,逐渐靠近了近Si3N4相[11],由于氮原子具有较高的电负性使得Si-N键的非对称伸缩模式发生了蓝移。同时,随氮气流量的减少,Si-H键的摇摆振动模式逐渐减弱,当氮气流量为30sccm时Si-H消失,说明析出更多的硅原子与氮原子结合形成Si-N。当氮气流量为30sccm时,Si-H 键伸缩振动模式展宽也发生了蓝移,这是因为进入薄膜中的氮原子与硅原子趋向形成H2SiNSi, H2SiN2和HSiN3键[12],使得Si-H 键伸缩振动模式更加复杂。以上结果表明,随着氮气流量的增加进入薄膜中的氮原子反而减少。
2.2 薄膜的光学吸收谱
光吸收主要是电子从基态跃迁到激发态所导致,而这种跃迁与能带结构有关,所以通过研究其光学吸收谱可以更好地了解薄膜的能带结构。对在玻璃片上所沉淀氮化硅薄膜材料的透射谱进行了测试,所选的透射光谱波长λ测量范围为200-1400nm,通过连续振动相干的波峰来估算出薄膜的厚度d,得出了透射系数 ,将其转换成(αhυ)1/2 与hυ之间的关系。然后通过Tauc公式[13]计算出光学带隙Eg:

其中α为吸收系数,h为普朗克常量,υ为光子频率,B与带尾态密度相关参数,计算得出a-SiNx:H的光学带隙Eg如图3所示。图中可以看到氮气流量分别为50,100,200sccm时,带隙宽度的变化很小,可见氮气流量为50sccm时,进入薄膜中的氮原子几乎达到饱和,这与上文中的FTIR光谱所计算Si-N键密度的变化保持一致。氮气流量变为30sccm时,带隙宽度为2.11ev,不加氮气时,带隙宽度变为3.56ev。薄膜光学带隙的展宽可归咎于Si-N键反键态与N孤对能级[14]的引入。
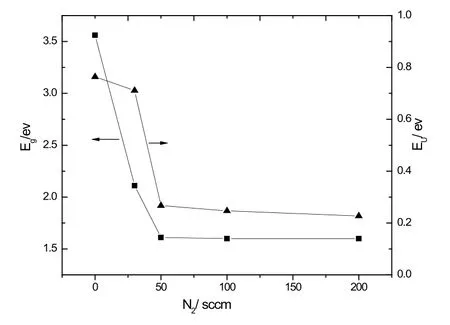
图3 不同氮气流量对薄膜Eg和EU的影响Fig 3 The effects on the film Eg and the EU with different nitrogen flow rates
薄膜微观结构无序度会引起光吸收的吸收边变化, 对应Urbach能参量EU和光学吸收系数关系表示为[12]

其中对应薄膜光学带边处的光学吸收系数,E0对应该处光子能量。 通过(3)式得出了样品的EU值。图3是不同氮气流量下制备的薄膜对应的光学带隙Eg和EU的能值,从图中可看到,当氮气流量为零时,所制备的薄膜的光学带隙为3.56ev,但小于理想的Si3N4的光学带隙(4.6ev)[15]。随着氮气流量的增加,薄膜的EU呈逐渐减小的趋势,该结果说明随着氮气的增加,所制备薄膜结构的有序度进一步增加。随着氮气流量的减少使薄膜结构的无序程度增加,使得价带和导带的间距变大[12],薄膜带尾吸收边变窄也会导致光学带隙增大。
2.3 PL谱
PL光谱常被用来探究薄膜中是否存在硅纳米颗粒,通过对样品PL光谱研究也能够更好的了解薄膜的缺陷态和硅量子点的生长情况。图4为室温条件下用氙灯325nm波长激发测得在单晶硅片上沉积的薄膜的PL谱,其波长范围350-600nm。图中,三个样品的PL谱在靠近350nm处的曲线,为氙灯325nm波长激发光的峰位展宽引起的,这里不予考虑。当氮气流量为100sccm时,没有明显的荧光发光现象,当氮气流量为30sccm时,薄膜只在波长418nm(2.97ev)和438nm(2.83ev)附近出现了荧光发光现象,未见其它缺陷态发光,表明制备的薄膜为氢含量较高的氮化硅薄膜,氢原子对薄膜起到钝化作用。对于2.97ev发光峰是由于氮悬键所引起的[14], 随着氮气流量的减少由氮悬键所引起发光峰位增强,其原因归咎于样品中氮原子含量的增加所引起的。随着通入氮气流量的减少进入薄膜中的氮原子含量增加取代了样品中一些硅原子的位置,使得薄膜结构发生了变化,导致了缺陷态发光峰位的增强。 对于2.8eV的发光峰,被认为来自≡Si0→≡Si-Si≡所产生的辐射复合发光[16],由≡Si0→≡Si-Si≡所产生的辐射复合发光峰位减弱,这是因为薄膜中硅团簇的集聚导致硅悬键减少。图中并没有出现与硅团簇有关的发光峰,说明所沉淀的样品中并没有形成较小的硅团簇或者硅量子点的分布[17],而是形成了较大的硅晶粒,通过下面的SEM图可以看到。
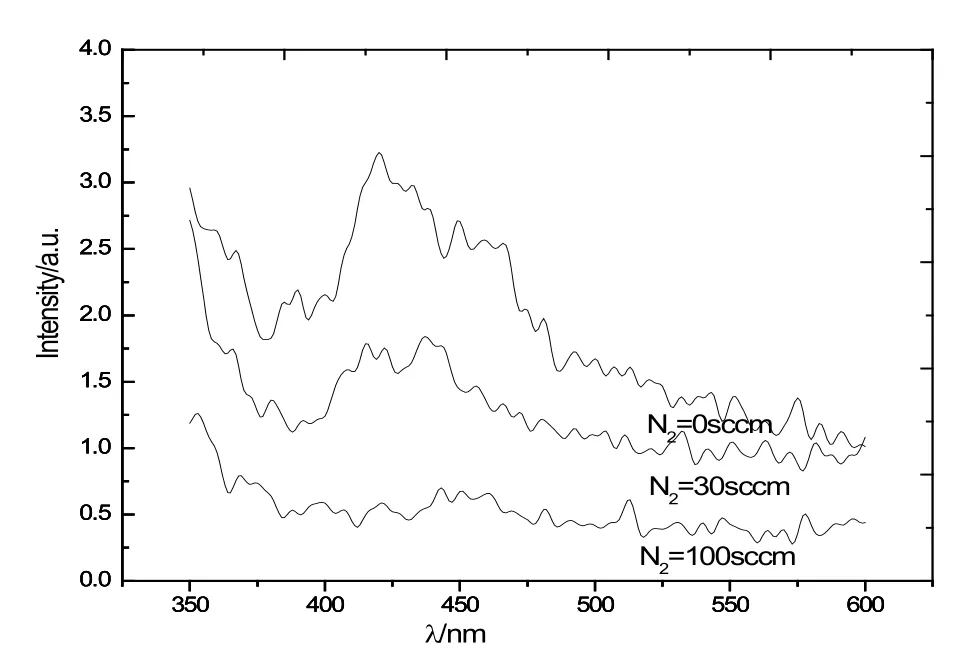
图4 氮化硅薄膜的室温PL谱Fig 4 Room temperature PL spectra of silicon nitride films
2.4 薄膜的SEM图

图5 氮化硅薄膜的SEM照片(a∶ N2=0sccm)Fig 5 SEM photograph of silicon nitride film (a ∶N2 = 0sccm)

图6 氮化硅薄膜的SEM照片(b,c∶ N2=50sccm)Fig 6 SEM photograph of silicon nitride film (b,c∶ N2 = 50sccm)
单晶硅片上所沉积的富硅-氮化硅薄膜可以通过扫描电镜清晰的观察在其表面的结构。图5a是氮气流量为0sccm的SEM图片,由图可以看到大部分晶粒尺寸接近于400nm,少量晶粒大于400nm,且晶粒分布不均匀,薄膜的表面较平整。同时可以观察到晶粒是镶嵌于基质之中,而非浮在样品表面,可以排除是杂质的干扰。图6b,c是氮气流量为50sccm的SEM图片,图b是放大倍数为30um拍摄的照片,从图可以观察到大部分晶粒尺寸在2000nm左右,晶粒分布密度较大且均匀,晶粒以某个晶核为中心不断增大。图c是放大倍数为2um拍摄的照片,可以看到所沉积的颗粒是有规则的,是由于硅团簇聚集形成的,而不是由于单晶硅片上的杂质引起的。通过扫描电镜观察可以知道随着氮气流量的增加更有利于硅团簇的集聚,造成薄膜的有序度局部的增加,形成了硅硅团簇和氮化硅的两相结构,与上面随着氮气流量的增加EU减小薄膜的有序度增加相一致。氮气流量的增加促进了硅团簇晶粒的增大,从侧面也能反映了随着氮气流量的增加进入薄膜中的氮原子减少,与前面红外透射光谱测试随着氮气的增加Si-N键密度减少相一致。
3 结论
用热丝化学气相法制备富硅-氮化硅薄膜,以SiH4、NH3、和N2为反应气体,在优化了其它参数的条件下,通过改变氮气流量在P型(100)的单晶硅片和Corning7059玻璃片上制备氮化硅薄膜。结果表明:随着氮气流量的减少,进入薄膜中的氮原子增加,Si-N 键键密度增加,氮气流量为30sccm非对称伸缩模式发生蓝移,但氮气流量大于30sccm时,Si-N 键的键密度变化不大。通过紫外-可见(UV-VIS)光吸收谱计算出薄膜的带隙宽度Eg和带尾能EU,当着氮气流量为50、100、200sccms时薄膜的带隙变宽Eg和EU变化很小,随着氮气流量继续减小,则薄膜的带隙展宽、有序度降低。用扫描电镜也可以观察到随着氮气增加更有利于晶粒的长大,使得薄膜的有序度局部的增加。观察氮气流量为0、30、100sccm薄膜样品的PL谱,发现随着氮气的减少由氮悬键所引起发光峰位增强,由≡Si0→≡Si-Si≡所产生的辐射复合发光峰位减弱,没有出现与硅团簇有关的发光峰。当[N2]/[NH3]比例小于5∶1,氮气对薄膜中的氮原子影响较为明显,适当地降低氮气流量可以制备出镶嵌较小硅晶粒的富硅-氮化硅薄膜材料。这有助于进一步制备出以非晶氮化硅为母质的硅量子点薄膜材料。
[1]曾友华,郭亨群,王启明.富硅氮化硅薄膜的制备及其发光特性[J]. 半导体光电,2007,28(2):209-212.
[2]林 娟,杨培志,化麒麟. 富硅氮化硅薄膜的制备及其光学带隙研究[J]. 发光学报,2012,,33(6):596-600.
[3]王 颖, 申德振, 张吉英.退火对富硅氮化硅薄膜的结构和发光的影响[J]. 液晶与显示, 2005 , 209(1):18-20.
[4]KIM T W , CHO C H , KIM B H , et al . Quantum confinement effect in crystalline silicon quantum dots in silicon nitride grown using SiH4 and NH3[J]. Appl Phys Lett,2006 ,88(12) :123 102-123 104 .
[5]刘丰珍,朱美芳,冯 勇.等离子体-热丝CVD技术制备多晶硅薄膜[J]. 半导体学报,2003,24(5) :499-503
[6]陈 国,朱美芳,孙景兰,等.用热丝法制备优质稳定非晶硅薄膜的研究[J]. 太阳能学报,1997,18(3):269-272.
[7]于 威,侯海虹,何 杰,等.HWP-CVD氮化硅薄膜的结构和光学特性[J]. 无机材料学报,2004,19(4):907-911.
[8]于 威,李亚超,丁文革,等.氮化硅薄膜中纳米非晶硅颗粒的建合结构及光致发光[J]. 物理学报,2008,57(6):3661-3665.
[9]高玉伟,周炳卿,张林睿,等.热丝化学气相沉积微晶硅薄膜结构及性质研究[J]. 人工晶体学报,2014,43(10):2761-2766.
[10]姜礼华,曾祥斌,张笑,等.SiNx薄膜中硅纳米颗粒子的制备及表征[J]. 无机材料学报,2011,26(8):802-806
[11]廖武刚,曾祥斌,文国知,等. 包含硅量子点的富硅SiNx薄膜结构与发光特性[J]. 物理学报,2013,62(12):126 801-126 806.
[12]于 威, 孟令海, 耿春.a-SiN:H 薄膜的对靶溅射沉积及微结构特性研究[J]. 科学通报,2010,55(18):1799-1804.
[13]LI T, JERZY K, KONG W, et al. Interference fringefree transmission spectroscopy of amorphous thin films[J]. J Appl Phys, 2000, 88(10): 5764—5771
[14]WANG M H, LI D S, YUAN Z Z.Photoluminescence of Si-rich silicon nitride: Defect-related states and silicon nanoclusters[J]. Appl Phys Lett, 2007,90(13):131901-131903.
[15]孙科沸,李子全,李 鑫.衬底温度对射频磁控溅射制备氮化硅薄膜的影响[J]. 工艺技术与材料,2007,32(6):516-519
[16]HAO H L,WU L K, SHEN W Z. Origin of visible luminescence in hydrogenated amorphous silicon nitride[J]. Appl Phys Lett, 2007, 91(20): 201922-201924.
[17]张广英.氮化硅薄膜的制备及相关特性研究[D]. 大连,大连理工大学硕士论文,2009
Effect of Nitrogen Flow Rates on The Structures And Properties of Silicon-rich Silicon Nitride Thin Films Prepared By Hot Wire Method
GAO Ai-ming, ZHOU Bing-qing, ZHANG Lin-rui, WU REN Tuya
(College of Physics and Electron Information of Inner Mongolia Normal University, Key Lab of Physics and Chemistry for Functional Material, Huhhot 010022, China)
Silicon-rich silicon nitride thin films were deposited by hot wire chemical vapor deposition method based SiH4, NH3, N2 as reaction gas source with changing nitrogen flow rates. The structure, band gap width, lightemitting performance and surface morphology of thin films were characterized and analyzed by Fourier transform infrared absorption spectroscopy, ultraviolet-visible spectra, photoluminescence spectra and SEM etc, respectively. The results showed that nitrogen content in the films decreases, silicon cluster grain buried in silicon nitride matrix grow up, Si-N bond density gradually decreases, optical band gap width Eg and the band tail energy EU tend to decrease, atomic order degree in the films increase, with increase of nitrogen flow rates . And photoluminescence peak cited by nitrogen dangling bond defect states enhance. When nitrogen flow rate is 30sccm, Si-N bond of asymmetric stretching mode and Si-H bond of stretching vibration mode show a blue shift. When [N2] / [NH3] ratio is less than 5: 1, influence of nitrogen flow rate on nitrogen content in films is more obvious. Therefore, properly reducing nitrogen flow rate helps to prepare a rich silicon nitride thin film materials.
Hot filament chemical vapor deposition method; Silicon-rich silicon nitride; microstructure; Emission characteristics
TQ12
A
1009-5624-(2016)01-0053-06
国家自然科学基金资助项目(项目编号:51262022)
