电子束光刻胶成膜树脂研究进展
2016-02-07虎刘敬成徐文佳穆启道郑祥飞纪昌玮刘仁刘晓亚
李 虎刘敬成徐文佳穆启道郑祥飞纪昌玮刘 仁刘晓亚*
(1.江南大学化学与材料工程学院 江苏 无锡 214122)
(2.苏州瑞红电子化学品有限公司 江苏 苏州 215124)
电子束光刻胶成膜树脂研究进展
李 虎1刘敬成1徐文佳1穆启道2郑祥飞2纪昌玮2刘 仁1刘晓亚1*
(1.江南大学化学与材料工程学院 江苏 无锡 214122)
(2.苏州瑞红电子化学品有限公司 江苏 苏州 215124)
电子束光刻作为下一代光刻技术(Next Generation Lithography, NGL),以其分辨率高和性能稳定被认为是在22nm节点最具有发展前景的光刻技术之一。本文归纳了电子束光刻胶用成膜树脂,主要分为聚甲基丙烯酸甲酯及其衍生物、树枝状聚合物、分子玻璃、有机硅及碳材料等应用于电子束光刻的成膜树脂类型,综述了其研究进展,最后对电子束光刻胶未来的发展前景和方向进行了展望。
电子束;光刻胶;成膜树脂;研究进展
1 引言
微电子产业的飞速发展要求半导体器件的特征尺寸越来越小,器件特征尺寸的减小一方面依赖于曝光工具,另一方面也与光刻胶的选择密切相关。目前集成电路的最小特征尺寸已从微米级、亚微米级进入纳米水平,曝光光源也经历了从早期的近紫外G线(436nm)和I线(365nm),到深紫外(248nm和193nm)、真空紫外(157nm),再到极紫外、电子束、纳米压印、扫描探针等下一代光刻技术。而光刻技术的发展与光刻材料的发展是密不可分的,光刻材料的发展水平在一定程度上决定了光刻技术的发展与应用。近年来,虽然光刻技术已逐渐接近物理极限,但在细微加工过程中,光刻技术仍然显示出具有强大的生命力。
电子束作为下一代光刻技术要求所对应的光刻胶具有高的灵敏度、对比度以及抗干法蚀刻选择性。目前,国际上的电子束光刻胶供应商主要有美国道康宁、DOW(陶氏),日本的Tokuyama,TOK(东京应化)、ShinEtsu Chemical(信越化学)、Fujifilm Electronic Materials(富士电子材料)、和韩国的Dongjin(东进),他们控制着国际光刻胶市场 80%以上的份额,而我国光刻胶生产与研发水平与国际相比差距较大,高端电子束光刻胶均需依赖进口,因此,开发出国内电子束光刻胶势在必行,本文总结了近年来电子束光刻胶用成膜树脂的发展历程,对今后电子束光刻胶国产化提供有益的参考。
2 电子束光刻胶成膜树脂体系
2.1 聚(甲基)丙烯酸甲酯及其衍生物体系
电子束光刻要求抗蚀剂具有高的灵敏度、对比度以及抗干法蚀刻选择性,由于电子束光刻不存在紫外吸收问题,因而对材料的选择比较广泛。最早开发的用于电子束光刻胶体系为聚甲基丙烯酸甲酯(polymethyl methacrylate,PMMA),此类光刻胶具有优异的分辨率、稳定性和低成本,在电子束曝光条件下,PMMA主链发生断裂形成低分子量聚合物片段,如图1所示,但主链断裂需要的曝光能量较高,因此它的感光度比较低,在2keV的曝光能量下感光度为10μC/ cm-2,当曝光能量提高到20keV是感光度为90μC/cm-2[1],在10keV的曝光能量下感光度为1μC/cm-2,当曝光能量提高到10倍以上时,PMMA发生交联形成负光刻胶,最高分辨率可达到10nm。

图1 PMMA电子束光刻胶成像机理示意图Fig.1 Schematic diagram of the mechanism of PMMA photoresists
PMMA虽然具有较高的分辨率,附着力强并且工艺简单成熟,但缺点是耐蚀刻性差和感光度比较低,而化学增幅型技术应用在电子束曝光体系中在很大程度上弥补了PMMA的不足,使它具有较高的感光灵敏度,有利于提高电子束曝光的效率,为提高该体系的感光度,通过对PMMA的结构进行改性,引入吸电子基团制备PMMA衍生物类光刻胶,化学增幅型技术应用于电子束光刻中也成为研究热点,化学增幅型光刻胶(chemically amplified resist, CAR)最早是由IBM公司的Ito、Willson和Fréchet提出[2],他们在研究中发现将产酸剂(photo acid generator,PAG)加入到树脂中,产酸剂经过曝光后产生少量的酸(+H),在加热条件下酸可以催化曝光区域的聚合物发生分解(正型光刻胶)或交联(负型光刻胶),使其在显影液中的溶解性能发生变化,并且产酸剂不被消耗,这样就可以有效降低曝光能量。化学增幅技术广泛应用在深紫外光刻领域,研究表明将其应用于电子束曝光领域同样具有高灵敏度、高对比度和高分辨率。Gonsalves[3]通过对羟基苯乙烯,2-乙基-2-金刚烷基甲基丙烯酸酯和阴离子产酸剂以摩尔比为35∶6∶5进行共聚,合成产酸剂接枝型共聚物,将产酸剂接枝在高分子主链上能降低有效的PAG与树脂的不相容性、相分离和产酸剂的迁移等问题,此类型化学增幅型光刻胶应用于电子束曝光,曝光能量为100kev,线条分辨率最高可达到45nm。

图2 产酸剂接枝型化学增幅性光刻胶Fig.2 PAG bonded chemically amplified photoresist
Vikram Singh[4]等报道了一种新型的基于化学增幅型电子束光刻胶,由(4-(甲基丙烯酰氧基)苯基)二甲基硫鎓三氟甲烷磺酸盐与甲基丙烯酸甲酯以摩尔比为75∶25共聚得到,如图3所示,由于主链挂具有光敏感基团,这种共聚物对电子束具有敏感性,在20kev的曝光下,经过四甲基氢氧化铵显影可以得到20nm分辨率的孤立图形,感光度为2.06μc/cm-2,LER介于1.8 ± 0.3 to 2.3±0.4 nm之间。Carlos Angulo Barrios[5]通过甲基丙烯酸羟乙酯(HEMA)和甲基丙烯酸2-氨基乙基酯(AEM)合成共聚物,再以N-丙烯酰氧基琥珀酰亚胺(MAOS)与氨基反应得到电子束光刻胶,此光刻胶具有非常高的敏感性,最低曝光能量为0.5μc/cm-2,对比度为1.2,此类光刻胶也可应用于3D成像。

图3 (a)化学增幅性电子束光刻胶(b)非化学增幅性电子束光刻胶Fig.3 (a) Chemically amplified electron beam photoresist (b) Non-chemically amplified electron beam photoresist
2.2 树枝状聚合物体系
此类电子束光刻胶主要是由树枝状聚合物和光产酸剂组成,其聚合物是基于三苯基的骨架通过化学键连接其他苯基的树枝状物质,当电子束曝光时,产酸剂产酸,经后烘脱去保护基团,在碱溶液显影中形成正型图形,但T型(T-top)现象严重,在有机溶剂中显影可以成为负型图形,此种类型的光刻胶最小可以获得100nm的线条分辨率。Tully[6]等合成了叔丁基羰基(t-BOC)保护的超支化光刻胶,应用于化学增幅型负型电子束光刻,在50kev的曝光能量下,以苯甲醚为显影液得到100nm的线宽分辨率,由于超支化聚合物具有较低的玻璃化温度,因此降低后烘温度降低为60℃可以减少图像模糊。

图4 典型的树枝状电子束光刻胶Fig.4 Typical dendritic photoresist for electron beam lithography
2.3 分子玻璃体系
由于高分子抗蚀剂材料分子量大及分子量分布较宽,并且分子链之间的缠结,因而在显影过程中容易造成线条边缘粗糙度较大,细微光刻技术的要求,针对高分子材料的不足,在光刻材料的研究中已开发出了分子玻璃类(molecular glass)光刻胶新型材料,分子玻璃为无定形的有机小分子化合物,具有明确的分子结构,较小的分子尺寸和单一的分子量分布,因此,在高分辨率和低的线条边缘粗糙度的要求下,分子玻璃比高分子材料具有更显著的优势[7-8]。目前,分子玻璃光刻胶材料已被广泛应用在极紫外(EUV)和电子束(EB)等光刻技术中,并获得了较高的分辨率和较低的线条边缘粗糙度。早期的分子玻璃抗蚀剂是基于树枝状的联苯体系,因为联苯体系分子玻璃材料是热稳定性好的非平面、刚性较强的分子,具有较高的抗蚀刻性,因此成为分子玻璃光刻胶材料的首选,如1,3,5-(α-萘)苯,1,3,5-三烷基-2-吡唑啉等。由叔丁氧基羰基(t-BOC)保护的分子玻璃,在产酸剂存在的条件下,通过电子束成像形成图像,通过运用化学增幅技术,分子玻璃抗蚀剂具有较高的感光度可与高聚物抗蚀剂相媲美。Shirota[9]研究小组首次报道了树枝状的联苯和基于三苯基胺结构的分子玻璃抗蚀剂,应用于电子束成像体系,但是这种体系所需的电子束曝光能量是传统抗蚀剂的103倍才能使产酸剂分解,Shirota[10]研究小组又开发出了一种基于叔丁氧基羰基(t-BOC)保护的1,3,5-三对羟基苯基苯的化学增幅型分子玻璃抗蚀剂体系。
基于聚4-羟基乙烯苯结构的树枝状的酚类化合物作为电子束成像体系中潜在的分子玻璃抗蚀剂的候选者,已被学术界和工业界广泛地研究。酚的加入可提供高的玻璃化温度(Tg)、抗蚀刻能力和碱溶性,这是由于羟基的存在可以提高在显影液的溶解性能,基于对联苯衍生物设计的理念,体积庞大和密集的酚类化合物已得到发展[11-12]。

图5 酚类分子玻璃抗蚀剂Fig.5 Phenolic molecular glass photoresist
此外,将环氧基团引入分子玻璃光刻胶中也是近年来研究者研究的热点,Henderson[13]通过阳离子聚合合成了双官能度的环氧分子玻璃,如图6所示,此类型分子玻璃抗蚀剂具有较好的分辨率,感光度和低的LER。

图6 双官能团的环氧分子玻璃Fig.6Bifunctional epoxy molecular glass photoresist
Hiroki Yamamoto[14]等通过在环状低聚物,诸如杯芳烃二聚物、环糊精和柱[5]芳烃,引入金刚烷基酯和环己基-2-丙基酯合成正性化学增幅型分子玻璃光刻胶,如表1所示,研究了不同分子构架对光敏性的影响,在75 kev的曝光能量下,具有相同分子构架的两种不同保护基团,含有金刚烷基酯的分子玻璃具有较高的分辨率,而具有相同保护基团的不同分子构架的分子玻璃,内核结构大的具有较高的分辨率。
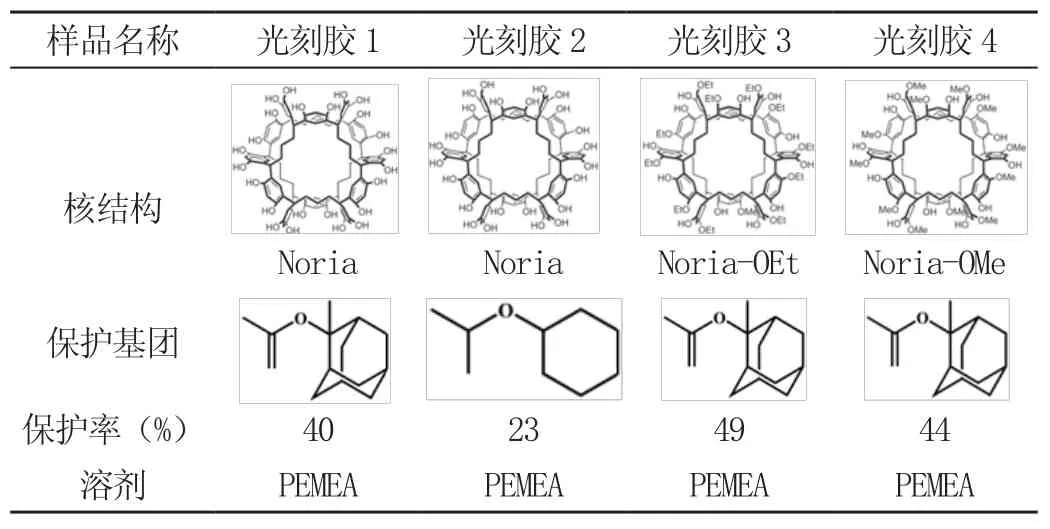
表1 基于Noria化学增幅性光刻胶Table 1 Resist materials based on noria.

表2 基于杯芳烃二聚体,三环绕[14]芳烃,β-环糊精和柱[5]芳烃Table 2 Resist materials based on calixarene dimer, tripleringed[14]arene, cyclodextrin, and pillar[5]arene.
T. Tada[15]等合成三苯基衍生物分子玻璃电子束光刻胶,此类光刻胶可以通过不同的曝光剂量来用于正型或负型图案,当曝光量为1×10-4C/ cm-2~3×10-3C/cm-2,在戊醇中显影,曝光区域溶解成为正型图形,当提高曝光剂量在氯苯中显影成为负型图形,分辨率均可达到200nm,

图7 三苯基衍生物类分子玻璃Fig. 7Triphenyl derivatives molecular glass
YasuhikoShirota[16]则是设计了一种基于化学增幅型的分子玻璃光刻胶,1,3,5-三[4-(2-叔丁氧基羰基)苯基]苯,在产酸剂的存在下经电子束曝光,最高可达到30nm的分辨率。

图8 化学增幅性分子玻璃Fig.8Chemically amplified molecular glass photoresist
2.4 有机硅及碳材料体系
在聚合物结构中引入具有低吸收的元素,如硅、硼等,得到有机-无机杂化聚合物光致抗蚀剂,不仅可以减少高吸收的氧元素的含量以提高透明性,而且还可增强体系的抗蚀刻性,在众多的无机材料中,富勒烯由于具有独特的结构和物理、化学性质,使得富勒烯在光刻胶领域的应用得到了长足发展。Tad和Kanayama[17]首次将富勒烯及其衍生物应用在负型电子束光刻胶领域,之后Robinson[18-21]课题组在富勒烯改性用于电子束光刻胶材料也做了大量工作,他们将功能基团引入富勒烯C60能显著提高电子束光刻胶的抗蚀刻性能,而基于富勒烯衍生物的化学增幅性光刻胶能够提高其光敏性,此课题组合成了一系列基于化学增幅型含有酚类结构的富勒烯衍生物分子玻璃光刻胶IM-MFPT12-2、IM-MFPT12-8和IM-MFP12-3,如图9所示,其中前两种在产酸剂的作用下脱去保护基团用于正胶,而IMMFP12-3在环氧交联剂的作用下成为负胶,其中IM-MFPT12-8由于具有较长的烷基链,相比于IM-MFPT12-2具有较好的感光性能,原因是烷基链越长有利于降低空间位阻进而提高酸扩散,三种类型的光刻胶均能与商品化的显影液匹配,曝光后能达到50nm以下的分辨率。

图9 富勒烯衍生物类抗蚀剂Fig. 9 Fullerene derivatives photoresist
Hsin-Chiang You[22]等将富勒烯C60和C70掺杂于商品化电子束正型抗蚀剂DSE-1010,将纳米级富勒烯分散于抗蚀剂中用于电子束曝光可以提高热稳定性和刻蚀性,此外,将富勒烯添加在抗蚀剂空隙中具有更高的电子亲和性进而降低曝光时间。

图10 富勒烯掺杂型聚合物抗蚀剂Fig.10 Fullerenes doped polymer photoresist
Haruyuki Okamura[23]通过氮氧稳定自由基活性聚合合成一系列具有窄分子量分布的对叔丁氧基苯酚和对氯亚甲基苯乙烯聚合物,在电子束曝光下可以达到50nm分辨率的负型图像。

图11 具有窄分子量分布的富勒烯衍生物类抗蚀剂Fig.11 Fullerenes derivatives photoresist with narrow molecular weight distribution
以有机硅材料为基础的电子束光刻胶由于可以提高与基材的附着力,因而也成为人们研究的热点,此类型材料主要以负型光刻胶为主,其中包括聚硅氧烷体系和聚氢硅烷[24-25]体系,聚氢硅烷体系经电子束曝光后,体系中Si-H键断裂,形成自由基,因此,曝光区的聚氢硅烷会交联形成三维的网状结构,在显影液中不溶。其中氢倍半硅氧烷(HSQ)作为一种新型的六面体笼状结构的无机化合物越来越多的应用于电子束抗蚀剂中,其结构如图所示[26],由于HSQ的分子尺寸较小,并且含有大量的Si原子,因此与基材具有较高的附着力,且显影时不会发生溶胀,具有极高的分辨率和较小的LER,HSQ应用于负型电子束光刻胶最小分辨率可达到10nm。

图12 氢倍半硅氧烷化合物结构学结构∶笼型(a)和网络型(b)Fig.12 Chemical structures of HSQ∶ cage form (a) and network form (b)
Haiwon Lee[27]等合成了一种化学增幅型光刻胶树脂应用在电子束领域,此类光刻胶侧链含有硅原子,能够增加与基材的附着力,并且在产酸剂的存在下脱去保护基团,形成正型图形。

图13 含硅化学增幅性抗蚀剂Fig.13 Chemicall amplified photoresist containing Si
2.5 其他体系
2.5.1 聚(烯烃-砜)体系
聚(烯烃-砜)是一类高敏感度,高分辨率的用于电子束正型光刻胶成膜树脂,其结构如图14所示,其中主链中的C-S键键能比较弱,所以在电子束曝光下易发生断裂,引起聚(烯烃-砜)主链的分解,使得分子量变小,选择适当的显影液,被曝光的低分子量部分溶解掉,未曝光的高分子量部分得以保留,形成正型图形,聚(烯烃-砜)相比于PMMA具有更高的感光度和分辨率,最早是由Brown[28]等研究人员发现,其分解机理如图所示,但此体系的批次的合成稳定性比较差,之后由Bell实验室Bowden[29]等改进并商业化应用于电子束曝光。

图14 聚(烯烃-砜)结构式Fig 14. Chemical structure of poly(olefin sulfone)
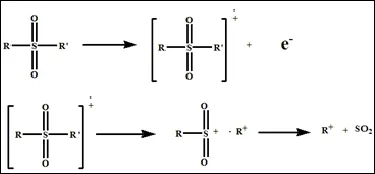
图15 基于聚(烯烃-砜)商品化电子束光刻胶成像原理Fig 15 Mechanism of commoditized e-beam resist based on poly(olefin sulfone)
2.5.2 环氧体系
环氧基树脂由于分子链含有环氧活性基团,因此很容易通过环氧阳离子开环聚合反应产生交联,形成三维网状结构,曝光区域在显影液中不溶,从而形成负型光刻胶,这类型负胶又称为环氧基负胶。环氧基负胶的分子结构如图16所示,在电子束曝光后,环氧基开环率较高,灵敏度也较高,商品化的环氧基电子束光刻胶最早是由贝尔实验室开发,被称为COP负胶[30](甲基丙烯酸缩水甘油酯和丙烯酸乙酯共聚物),它的灵敏度可达4×10-7C/cm2,COP负胶在受电子束曝光时产生活性氧中心,此中心再攻击相邻环氧基团,形成共价键产生交联。

图16 商品化COP负胶化学结构Fig 16 Chemical structure of COP e-beam resist
2.5.3 酚醛树脂体系
线性酚醛树脂最早是应用在近紫外曝光中,但由于具有较好的耐热性和抗干法刻蚀,也成为优良的电子束光刻材料,其中正性光刻胶矩阵聚合物主要有酚醛树脂、部分被保护的对羟基苯乙烯和对羟基苯乙烯的共聚物,以及乙烯基醚共聚物,在电子束照射下,感光剂产酸使阻溶剂发生化学变化由阻溶变为可溶或促溶,或者光产酸剂发生的酸直接催化矩阵树脂发生降解而使曝光区变得在碱溶液中可溶,从而制得负型和正型图形。
2.5.4 聚碳酸酯体系
聚碳酸酯类非化学增幅正型光刻胶,又被称为断链型光刻胶(Chain-secission Resist),这种光刻胶的主链上含有易解离的碳酸酯基团,在电子束曝光下聚合物分解成CO2和很多低分子量片段,能够增加在显影液中溶解性能,显影时被除去。Bo Cui[31]等将双酚A聚碳酸酯为电子束抗蚀剂材料,双酚A聚碳酸酯相比于传统的聚甲基丙烯酸甲酯(PMMA)具有更高的耐化学和热稳定性,其耐刻蚀性也优于PMMA,将双酚A聚碳酸酯应用于电子束光刻,分析了不同显影液,如环己酮、二甲苯、乙酸戊酯和丙二醇甲醚醋酸酯对显影性能的影响。

图17 聚碳酸酯电子束光刻胶成膜树脂Fig.17 Polycarbonate photoresist for electron beam lithography
3 总结及展望
随着微纳米制造产业技术的进步和发展,光刻技术覆盖了微细图形的传递、加工、形成的全部过程,下一代光刻技术(NGL)中电子束作为22nm节点最具有潜力的技术,目前国外已经规模化生产,随着未来集成电路最小特征尺寸继续向20nm以内发展,电子束光刻技术将逐渐发展成熟,相应的,开发同时具有高分辨率、高灵敏度和低LER的新型光致抗蚀剂体系将是今后电子束光致抗蚀剂的主要发展方向。
4 致谢
本研究得到江苏省产学研前瞻性联合研究项目(No.BY2015019-14)和国家重大科技专项( No.2010ZX02304)和江苏省普通高校学术学位研究生科研创新计划(No.KYLX_1127)的资助。
[1] S. Matsuda, S. Tsuchiya.Thermallyreacted poly(methacrylamide) as a positive electron beam resist[J].Polymer Engineering and Science,1977,17(6):410-413.
[2] Hiroshi Ito.Chemical Amplification Resists for Microlithography[J].Advanced Polymer Science. 2005,172,37-245.
[3] Kenneth E. Gonsalves,MingxingWang,Cheng-TsungLee. Novel chemically ampli-ed resists incorporating anionic photoacid generator functional groups for sub-50-nm halfpitch lithography[J].Journal of Material Chemistry. 2009, 19(18): 2797-2802.
[4]Vikram Singh, V. S. V. Satyanarayana, Satinder K et al.Towards novel non-chemically ampli-ed (n-CARS) negative resists for electron beam lithography applications[J]. Journal of Material Chemistry. C. 2014, 2(12): 2118-2122.
[5]V-ctorCanalejasTejero,Sergio Carrasco, Fernando Navarro-Villoslada et al.Ultrasensitive non-chemically ampli-ed low-contrast negative electron beam lithography resist with dual-tone behavior[J]. Journal of Material Chemistry. C, 2013, 1(7): 1392-1398.
[6] David C. Tully, Alexander R. Trimble, Jean M. J. Frechet. Dendrimers with Thermally Labile End Groups: An Alternative Approach to Chemically Amplified Resist Materials Designed for Sub-100 nm Lithography[J]. Advanced Material. 2000, 12(15): 1118-1122.
[7] Jinxing Yu, Na Xu,Liyuan Wang et al.Novel One-Component Positive-Tone Chemically Ampli-ed I-Line Molecular Glass Photoresists[J].ACS Applied Material Interfaces.2012, 4(5):2591-2596.
[8] Da Yang, SeungWook Chang and Christopher K. Ober. Molecular glass photoresists for advanced lithography[J]. Journal of Material Chemistry. 2006, 16:1693-1696.
[9]MotokoYoshiiwa, Hiroshi Kageyama, Yasuhiko Shirotaet al. Novel class of low molecular-weight organicresists for nanometer lithography[J]. Applied Physics Letter.1996,69(17): 2605-2607.
[10] T. Kadota, H. Kageyama, F.Wakayaet al. Novel electron-beam molecular resists with high resolution and highsensitivity for nanometer lithography[J].Chemistry Letter.2004,33(7): 706-707.
[11]Anuja De Silva,Jin-Kyun Lee. Study of the Structure-Properties Relationship of PhenolicMolecular Glass Resists for Next Generation Photolithography[J].Chemistry Material. 2008, 20(4): 1606-1613.
[12]Junyan Dai, SeungWook Chang, AlyssandreaHamadb et al. Molecular Glass Resists for High-Resolution Patterning[J].Chemistry Material. 2006, 18(15): 3404-3411
[13] Richard A. Lawson, Cheng-Tsung Lee, Laren M. Tolbert et al. High resolution negative tone molecular resist based on di-functionalepoxidepolymerization[J]. Microelectronic Engineering.2009,86(4):734-737.
[14] Hiroki Yamamoto, HirotoKudo, Takahiro Kozawa.Study on resist performance of chemically ampli-ed molecular resists based on cyclic oligomers[J].Microelectronic Engineering.2015, 133:16-22.
[15] T. Tada, T. Kanayama. A Triphenylene Derivative as a Novel Negative/positive Tone Resist of 10 Nanometer Resolution[J]. Microelectronic Engineeri ng.2000,53(14):425-428.
[16] Toshiaki Kadota, Hiroshi Kageyama, FujioWakayaet al.Amorphous Molecular Materials: Development of a Novel Positive Electron-beam molecular resist[J].Journal of Photopolymer Science and Technology. 1999,12(2):375-376.
[17] Tada, T., Kanayama, T.Nanolithography using fullerene films as an electron beam resist[J].Japan Journal of Applied. Physics.19998,35(1A): 63-65.
[18] D. X. Yang, A. Frommhold, A. P. G. Robinson et al. Chemically ampli-ed phenolic fullerene electron beam resist[J]. Journal of Material Chemistry C. 2014, 2, 1505-1512.
[19] F.P. Gibbons, J. Manyam, S. Diegoli, A.P.G. Robinson et al. Chemically ampli-ed molecular resists for e-beam lithography[J]. Microelectronic Engineeri ng.2008,85(56):764-767.
[20] A.P.G. Robinson, H.M. Zaid, F.P. Gibbonset al.Chemically ampli-ed molecular resists for electron beam lithography[J].Microelectronic Engineering.2006, 83(49):1115-1118.
[21] Francis Gibbons, Hasnah M. Zaid, Alex P. G. Robinson.A Chemically Amplified Fullerene-Derivative MolecularElectron-Beam Resist[J].Small 2007, 3(12):2076-2080.
[22]Hsin-Chiang You, Fu-Hsiang Ko, Tan-Fu Lei.Fullereneincorporation for enhancing the electron beam resist performance for contact hole patterning and filling[J]. Thin Solid Films.2006,500(1): 214-218.
[23]Haruyuki Okamura, Drew C. Forman,Christopher K. Ober. C60-containing polymers for electron beam lithography[J]. PolymerBulletin. 2014,71(9): 2395-2405.
[24]Jung Wuk Kim, Jens Bolten, Christian Moormann et al. Realization of ultra-thin HSQ resist layer for high resolution electronbeam lithography using liquid splitting process[J].Microelectronic Engineering.2014, 123,62-64.
[25]Joel K. W. Yang, Bryan Cord, HuigaoDuan et al.Understanding of hydrogen silsesquioxane electron resistfor sub-5-nm-half-pitch lithography[J].Journal of Vacuum Science and Technology B.2009, 27(6):2622-2627.
[26]Jiao Zhou,HongkaiJi,Junbing Yan, Investigation of the Hydrogen Silsesquioxane (HSQ) ElectronResist as Insulating Material in Phase Change Memory Devices[J],Journal of electronic materials.2015,Vol. 44(1):235-243.
[27]YoungminChoi,Sang-Wook Park, YongilKim et al.ChemicallyAmplified Photoresist for Electron Beam Lithography[J].Journal of Photopolymer Science and Technology.2003, 16(3): 451-454.
[28] J. R. Brown, J. H. O'Donnell. The Degradation ofPoly(butene-1 sulfone) during γIrradiatiori[J]. Macromolecules. 1970, 3(2): 265-267.
[29] M. J. Bowden and L. F. Thompson. Electron irradiation of poly(olefin sulfones). Application toelectron beam resists[J]. Journal of Applied Polymer Science.1973, 17(10):3211-3221.
[30] L. F. Thompson, E. D. FeitandR. D. Heidenreich. Lithography and radiation chemistry of epoxy containing negative electron resists[J]. Polymer Engineering & Science.1974, 14: 529-533.
[31]Arwa Saud Abbas , Mustafa Yavuz, Bo Cui. Polycarbonate electron beam resist using solvent developer[J]. Microelectronic Engineering.2014, 113(1):140-142.
Research Progress of Matrix Resin for Electron Beam Lithography Photoresist
LI Hu1, LIU Jing-cheng1, XU Wen-jia1, MU Qi-dao2, ZHENG Xiang-fei2, JI Chang-we2, LIU Ren1, LIU Xiao-ya1*
(1.School of Chemical and Material Engineering, Jiangnan University, Wuxi 214122 China; 2.Suzhou Rui Hong Electronic Chemicals Co., Ltd., Suzhou 215124 China)
As the next generation lithography, electron beam lithography has been considered one of the most promising lithography technologies in 22nm node due to its high resolution and stable properties. This paper reviewed the matrix resins for electron beam lithography, mainly consist of poly (methyl methacrylate) and derivatives, dendritic resist, molecular glass, organic silicon and carbon, and other system resist, summarized the research progress, in addition, the research prospect and direction of electron beam photoresist in the future are briefly discussed.
Electron beam lithography; Photoresist; Matrix resin; Research progress
TQ32
A
1009-5624-(2016)01-0001-09
