氨气流量对富硅氮化硅薄膜键态的分析
2016-02-07部芯芯周炳卿乌仁图雅高爱明丁德松
部芯芯 周炳卿 乌仁图雅 高爱明 丁德松
(内蒙古师范大学物理与电子信息学院功能材料物理与化学自治区重点实验室 内蒙古 呼和浩特 010022)
氨气流量对富硅氮化硅薄膜键态的分析
部芯芯 周炳卿 乌仁图雅 高爱明 丁德松
(内蒙古师范大学物理与电子信息学院功能材料物理与化学自治区重点实验室 内蒙古 呼和浩特 010022)
采用等离子体增强化学气相沉积(PECVD)技术在低压力的条件下,以SiH4、NH3和H2为反应气体,通过改变氨气流量来研究富硅氮化硅薄膜材料。通过Fourier变换红外吸收(FTIR)光谱检测样品中各键的键合结构演变,发现Si-N键和N-H键随着氨气流量改变向高波数方向移动,说明逐渐形成氮化硅薄膜。通过紫外-可见光透射光谱测量薄膜材料的透射光谱,计算得出薄膜相应的带隙宽度以及带尾能量,发现氨气流量的增加,光学带隙明显展宽,确定形成的薄膜为富硅氮化硅薄膜。
富硅氮化硅薄膜;化学气相沉积;键合结构
1.引言
早期,Pei等人采用PECVD法在ITO玻璃上生长富硅氮化硅,并在薄膜上蒸镀Al电极,制作关于富硅氮化硅薄膜器件,操作简单,容易在表面及体内产生杂质和缺陷。目前采用等离子体增强化学气相沉积(PECVD)法制备的富硅氮化硅薄膜性能好,制作温度要求不高、台阶覆盖性能好,这样能加强对器件的钝化保护作用[1]。
本文使用沈阳科学仪器有限公司制造的PECVD-400型射频等离子体化学气相沉积技术制备氮化硅薄膜材料,使用Nicolet 6700型傅里叶变换红外光谱仪、Lambda750型紫外可见光谱仪对样品进行了表征,并分析富硅-氮化硅薄膜随氨气流量变化时,其化学键结构、成分、光学带隙及发光特性的变化。
2.实验
实验采用平板电容耦合方式的等离子体增强化学气相沉积(PECVD)技术制备氮化硅薄膜材料。在衬底温度为200℃,电极间距2.0cm,反应腔体气压维持在80Pa,电极面积为132.665cm的情况下,设定射频功率为10W,硅烷流量为1sccm,氢气流量为10sccm,硅烷浓度为(SC=[SiH4]/ [SiH4+H2]=0.9%),氨气流量分别为4,7,10,14,18sccm来制备样品。衬底为Corning7059玻璃片和经过了2%浓度的HF酸腐蚀了10秒钟的双面抛光单晶硅片。
3.结果与讨论
3.1 FTIR光谱结果分析
红外光谱法是鉴别物质和分析物质结构的有效手段,广泛用于各种物质的定性鉴定和定量分析,并在研究分子间和分子内部的相互作用发挥重要作用[2]。图1中显示在改变NH3流量下的不同吸收峰对应不同的红外活性振动模式。氮化硅薄膜对红外光的吸收主要集中在843~855cm-1,2105~2146cm-1和3336~3347 cm-1范围内,分别对应Si-N键的非对称伸缩振动模式,Si-H键伸缩振动模式以及N-H键伸缩振动模式,这些吸收峰的分布位置与公认的红外光谱分布结果一致[8,3]。
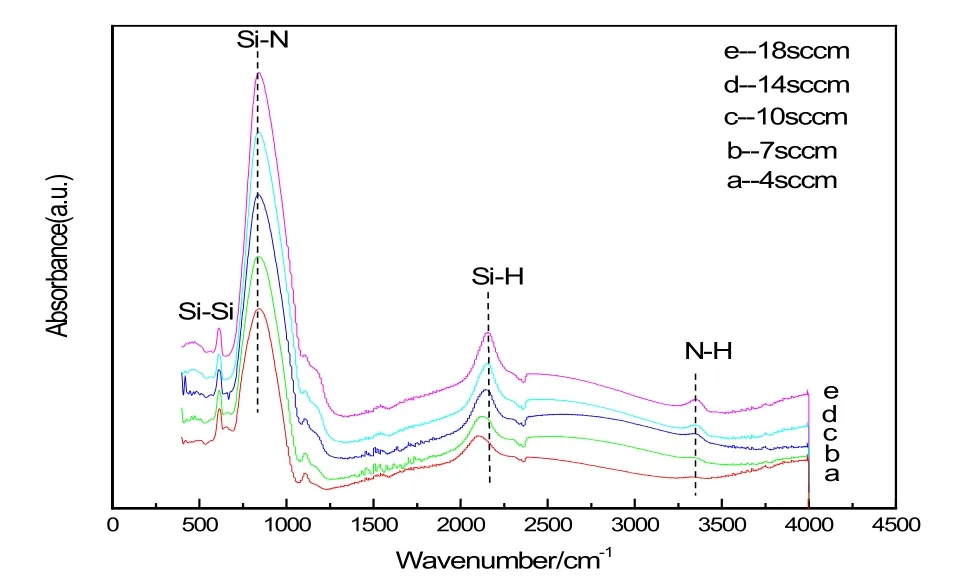
图1 不同NH3 含量样品的FTIR谱Fig.1 FTIR spectra of different ammonia content of the sample
除此之外,在所有薄膜的傅里叶变换光谱中处在611cm-1均出现吸收峰,对应Si-Si键特征吸收频带。
将FTIR图1的N-H(图2左)和Si-H(图2右)吸收峰提取,比较分析发现随着氨气流量的提高,N-H键和Si-H键振动强度逐渐增强,说明N含量较高的情况下,形成饱和的N的悬挂键。同时,高电负性的N影响Si-H键电子云的分布在2105~2146cm-1处往高波数方向发生了一定的蓝移。

图2 N-H键(左)和Si-H键(右)随NH3 流量变化的吸收图Fig.2 Evolution map of N-H bond and Si-H bond change with ammonia flow rate
3.2 紫外-可见光透射谱分析
紫外可见吸收谱广泛用于半导体能带结构及其他能量结构的研究。根据UV-Vis的测量,可得出相应薄膜的光学特性。当光与薄膜材料发生相互作用时,光强度的衰减遵循Bouguer-Lambert定律:

其中x是从固体边界沿光线在所研究的距离,I0为入射光强度,α是吸收系数,再结合下式

其中A为直接测得的吸收光谱的纵坐标吸收光度,d为薄膜厚度。利用紫外可见光吸收光谱,并根据Tauc方程[4]:

做出Tauc曲线[(αhv)1/2~hv],便可以得到薄膜的光学带隙宽度Eopt。其中B是与材料性质有关的常数,SiNx薄膜n取2。
在图3(a)带隙图观察,随着氨气流量的增加,其光谱的吸收边出现了蓝移,高能量的光波不能够完全吸收,体现出了良好的透光性,对薄膜的表面起着钝化与[5]保护的作用。而光学带隙关联于薄膜中的缺陷态密度,缺陷越多,光学带隙越宽。在图3(b)带隙图观察,氨气由4sccm增至7sccm,带隙剧烈变化,当7sccm增至14sccm,带隙缓慢变化,说明氨气流量对氮化硅薄膜的光学带隙明显增大。这是由于SiH4和NH3受到低能离子的轰击,裂解成高活性粒子Si+、H+、SiH+、等,更易与N原子联合成Si-N键,这与公式(1)和红外光谱移动结果相吻合。

图3 不同氨气流量的带隙图及光学带隙变化图Fig.3 Bandgap diagram of different ammonia content of the sample and optical bandgap change map
根据Lanford和Rand的方法[9], 计算薄膜中各种键合结构的密度Cx,由对应伸展振动模的积分强度I(ω)确定[10,6]∶

其中 x 表示 Si-N, Si-H 和 N-H 的键合模式,A、α(ω)和ω分别为校正因子、吸收系数和波数。Si-N键、N-H键和Si-H键密度的校正因子分别近似为6.3×1018 cm-2、2.8×1020 cm-2和4.0×1020cm-2。据此薄膜中H、N和Si原子浓度按如下式子分别计算:

计算薄膜中主要原子间的键密度及原子含量变化规律在图4和图5所示,随着氨气流量的增加,各化学键密度和各原子密度均有单调递增的现象。通过使用[Si-H]/[N-H]计算Si/N原子比例,公式[7]为∶

计算结果发现,N/Si原子比近似为1,说明制备的薄膜为富硅氮化硅材料。
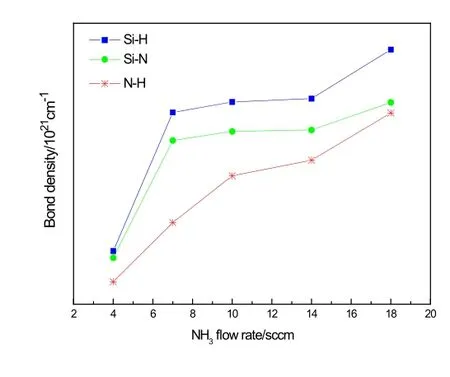
图4 各键密度随氨气流量的变化图Fig.4 Each bond density change with ammonia flow rate
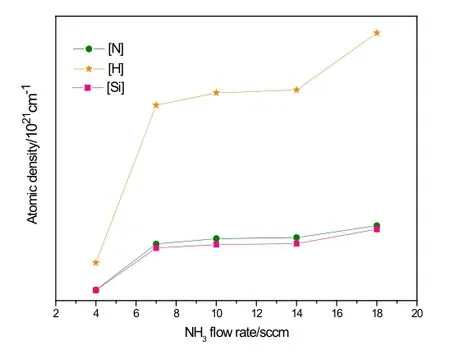
图5 各原子密度随氨气流量的变化图Fig.5 Each atomic density change with ammonia flow rate
4 总结
采用射频等离子体化学气相(RF-PECVD)沉积技术,在反应气体中掺入不同流量的氨气来制备了富硅氮化硅薄膜。傅里叶红外透射谱、紫外-可见光谱的分析结果表明:所制备薄膜中含有较高的H原子,随着氨气流量的增加,Si-H键、Si-N键、N-H键等单调递增,光学带隙逐渐展宽。Si/N原子比接近1,实现制备了富硅氮化硅薄膜。结合以上分析发现,适当地增加NH3流量,可以提高反应过程中N离子与Si悬挂键的键合几率,从而起到钝化薄膜悬键的作用。
[1] 王颖,申德振,张吉英等.退火对富硅氮化硅薄膜的结构和发光的影响[J].液晶与显示,2005,20(1):18-21.
[2] 翁秀兰,王宇龙,陈永新,李士引.红外光谱在高分子材料研究中的应用[J].红外,2011(32)9:43-46.
[3] Panchal A K, Solanki C S. Post deposition annealing temperature effect on silicon quantum dots embedded in silicon nitride dielec-tric multilayer prepared by hotwire chemical vapor deposition[J]. Thin Solid Films,2009, 517(2): 3488-3491.
[4]J. Tauc. Amorphous and liquid semieonduetors, London, NewYork, Plenum: SPringer, 1974.
[5]于威,孟令海,丁文革.氢对非晶氮化硅薄膜键合结构和光学吸收特性的影响[J].信息记录材料,2010,11(1):8-11.
[6] 于威,孟令海,耿春玲.a-SiN:H 薄膜的对靶溅射沉积及微结构特性研究[J].科学通报,2010,55(18):1799-1804.
[7] Mackel H,Ludemann R.Detailed study of the composition of hydrogenated SiNx layers for high-quality silicon surface passivation[J]. J Appl Phys, 2002,92(5):2602-2609.
[8] 谬武刚,曾祥斌,文国知. 包含硅量子点的富硅SiNx薄膜结构域发光特性[J]. 物理学报,2013,62:126801-3.
[9] Lanford W A, Rand M J. The hydrogen content of plasma-deposited silicon nitride[J]. J Appl Phys, 1978, 49: 2473-2477.
[10] Molinari M, Rinnert H, Vergnat M. Improvement of the photoluminescence properties in a-SiNx films by introduction of hydrogen[J]. Appl Phys Lett, 2001, 79: 2172-2174.基金项目:国家自然科学基金资助项目(项目编号:51262022)。
Analysis of Ammonia Flow Rates on Bond States of Silicon-rich Nitride Films
BU Xinxin,ZHOU Bing-qing,WUREN tu-ya,GAO Ai-ming,DING De-song (College of Physics and Electron Information of Inner Mongolia Normal University,Key Lab of Physics and Chemistry for Functional Material,Huhhot 010022,China)
Silicon-rich nitride thin film were deposited by the plasma enhanced chemical vapor deposition (PECVD) using NH3, H2 and SiH4 as the reaction gas source with changing of ammonia flow rates at low pressure. Bond structure evolution of materials is detected by Fourier transform infrared absorption (FTIR) spectroscopy, find that Si-N and N-H bonds are moved to the high wave number with the change of ammonia flow. By ultraviolet-visible transmission spectra, the optical band gap width and the energy of the band were calculated. With ammonia flow rates increase,leading to the optical band gap is obviously broadening, silicon-rich nitride thin film is formed.
Silicon-rich nitride thin film; Plasma enhanced chemical vapor deposition; Bonding structure;
TQ12
A
1009-5624-(2016)01-0047-03
