0.18 μm MOS差分对管总剂量失配效应研究
2014-08-07张兴尧
吴 雪,陆 妩,王 信,郭 旗,张兴尧,于 新
(1.中国科学院 特殊环境功能材料与器件重点实验室,新疆理化技术研究所,新疆 乌鲁木齐 830011;2.新疆电子信息材料与器件重点实验室,新疆 乌鲁木齐 830011;3.中国科学院大学,北京 100049)
随着半导体制造工艺技术的发展,器件特征尺寸逐渐向超深亚微米、纳米尺寸发展,在实际制造工艺中,由于每一道工序的不确定性,设计标称相同的器件也会存在有限的失配,而器件特征尺寸的减小则使晶体管间的失配性能越来越差[1]。在高精度模拟电路设计中,晶体管之间的匹配性能非常关键,其对模拟电路的失调电压、电流等均会带来一定的影响[2-5]。因此小尺寸模拟电路的性能受其影响日趋严重。中国科学院上海微系统与信息技术研究所、新疆理化技术研究所等对深亚微米MOS晶体管均进行了总剂量辐照试验,结果表明:与微米工艺(0.5 μm以上)相比,深亚微米工艺MOS晶体管阈值电压不再是辐射敏感参数,而辐射感生漏电流仍是其薄弱环节,其主要原因为隔离氧化层在辐照过程中引入了大量的陷阱电荷[6]。国外针对更小尺寸(100 nm以下)CMOS晶体管电离辐射效应进行了研究,结果表明:尺寸越小,其抗总剂量能力越强,且阈值电压变化越小[7-8]。任迪远等[4-5]对CMOS工艺运算放大器进行了60Co γ辐照、质子辐照及室温退火效应的研究,结果表明:辐照引起运算放大器中差分对管的匹配性能恶化是导致失调电压、电源电压抑制比等参数退化的主要原因。国内外对半导体制造工艺引起的晶体管失配、失配模型及其对集成电路带来的影响进行了研究[9-11],但关于电离辐射环境下差分对管失配特性的研究鲜有报道,因此,本文以0.18 μm MOS差分对管为研究对象,对样品辐照前后转移特征曲线、阈值电压、栅极电流等进行测试、分析,研究深亚微米器件的失配特性,为进一步了解深亚微米MOS差分对管失配随辐照总剂量的变化情况及其对模拟电路带来的影响奠定基础。
1 总剂量辐照试验
试验样品为同一批次国产标准工艺线0.18 μm NMOS、PMOS差分对管。样品的宽度、长度分别为100 μm、0.18 μm,采用STI隔离技术,最大工作电压为1.8 V。辐照试验在中国科学院新疆理化技术研究所60Co γ源上进行,剂量率为0.510 4 Gy(Si)/s。辐照过程中,NMOS器件偏置条件为:VG=VD=1.8 V,VS=0 V;PMOS器件偏置条件为:VG=VD=0 V,VS=1.8 V。每次辐照完成后,对辐照样品进行转移特征曲线测试,测试过程中同时对栅极电流进行测试,确保试验样品在辐照及测试过程中未发生栅极击穿现象。曲线测试在KEITHLEY4200半导体综合参数分析仪上进行,每次测试过程不超过20 min,以减小测试所带来的退火效应。
2 试验结果与分析
2.1 栅极电流
图1为NMOS及PMOS差分对管辐照前后栅极电流的变化(Ig1、Ig2分别为差分对管中第一、二只晶体管栅极电流)。辐照前,NMOS晶体管的栅极电流约为4×10-12A,且差分对管中两只晶体管失配很小;当辐照2 000 Gy(Si)时,栅极电流增大到约4×10-11A,但栅极电流失配增大,且栅极电压越大,晶体管失配越大。PMOS差分对管的辐照变化和NMOS一致。
本试验样品栅氧化层厚度约为4 nm,尽管电离总剂量辐照会在栅氧化层中产生陷阱电荷,但由于栅氧化层足够小,使栅极或Si/SiO2界面的电子会隧穿至栅氧化层中,这样辐照产生的栅氧化层陷阱电荷会被中和,这也是栅极电流对总剂量辐照不敏感的原因。由于差分对管中不同晶体管在工艺制造过程中的差异,使辐照产生的栅氧化层陷阱电荷数量及隧穿过来的电子数量可能不同,从而导致CMOS差分对管的栅极电流匹配性能变差。尽管MOS差分对管的栅极电流失配随辐照总剂量的增加而增大,但由于栅极电流变化很小,辐照到2 000 Gy(Si)后仅为10-11A,其变化在模拟电路应用中基本可忽略,不会对高精度模拟电路造成影响[1]。
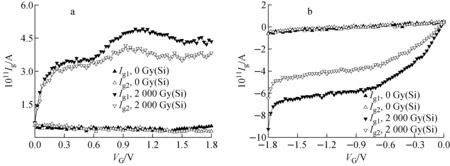
图1 辐照前后NMOS(a)及PMOS(b)差分对管的栅极电流变化曲线
2.2 漏极电流
图2为NMOS及PMOS差分对管的转移特征曲线随辐照总剂量的变化情况。从图2可看出,辐照前,NMOS和PMOS差分对管的转移特性曲线匹配性能均较辐照后的好,PMOS差分对管漏极电流ID几乎未变化,匹配性能仍较好。对NMOS差分对管,当辐照至600 Gy(Si)时,两只晶体管截止区漏级电流均增大,其失配亦增大,且随辐照总剂量的增加截止区漏级电流持续增大并逐渐呈现饱和趋势。从图2还可看出,随辐照总剂量的增加,NMOS差分对管中两只晶体管截止区漏极电流的失配从截止区逐渐向饱和区过渡。这是因为,当辐照总剂量较小时,其感生漏极电流较小,与亚阈区、饱和区的漏极电流相比可忽略,故截止区先出现漏极电流失配;随着辐照总剂量的增加,截止区漏极电流增大的幅度趋于饱和,而亚阈区和饱和区的漏极电流变化远未达到饱和,因此漏极电流的失配从截止区逐渐向饱和区过渡。
对于深亚微米MOS晶体管,虽栅氧化层厚度减小至几nm,但隔离氧化层厚度仍有几百nm,且隔离氧化层的质量远不及栅氧化层,所以隔离氧化层是其辐照敏感区域。电离辐射会在隔离氧化层中产生大量电子空穴对,电子被电场迅速扫出氧化层,留下带正电的空穴,空穴被晶体管边缘的STI隔离氧化层的陷阱捕获,形成正氧化物陷阱电荷。随着氧化物陷阱电荷的积累,最终在隔离氧化层形成一较大的电场。当电场强度达到一定值时,NMOS晶体管的隔离氧化层下P型衬底表面反型,源漏之间两侧寄生晶体管开启,形成漏电通道,从而导致漏电流的增加[12-13];而对于PMOS晶体管,由于其源、漏区均在N阱(N-Well)中,正氧化物陷阱电荷无法形成漏电通道,故其对总剂量辐照不敏感。在制作隔离氧化层时,工艺步骤中刻蚀、氧化等出现的不均匀、不一致均会导致两只晶体管隔离氧化层中的缺陷浓度、能级分布等的不同,从而导致缺陷在捕获辐照产生的空穴形成氧化物陷阱电荷的不同,造成漏电流的失配在电离辐射环境下恶化。在模拟集成电路中,电流失配的增加会影响电流源、比例电流分配精度等,为消除这种影响,必须使过驱动电压达到最大。但当过驱动电压增大时,负载电阻失配及晶体管尺寸失配对失调的影响将增大,这对高精度模拟集成电路是不利的[1,9,14]。

图2 NMOS(a)及PMOS(b)差分对管的转移特性曲线随辐照总剂量的变化
2.3 阈值电压
传统的恒流法提取阈值电压对深亚微米晶体管已不再适用,本文根据MOS晶体管饱和区漏极电流的公式可得出饱和区漏电流和阈值电压呈平方关系,对饱和区转移特征曲线进行线性拟合,提取样品不同总剂量下的阈值电压值。图3为NMOS及PMOS差分对管的阈值电压失配随辐照总剂量的变化情况。由图3可看出,辐照前NMOS两只晶体管的阈值电压差为0.94 mV,失配为0.2%(晶体管阈值电压约为0.46 V),两只晶体管匹配性较好,随辐照总剂量的增加,阈值电压差增大,辐照结束时,两只晶体管的阈值电压差达50.17 mV,失配达10.9%。而PMOS差分对管的两只晶体管失配在0.5%之内,最大阈值电压差为2 mV,可见PMOS差分对管的失配对总剂量辐照不敏感。
阈值电压VT可表示为:
式中:φMS为金属半导体功函数差;QOX为氧化层中电荷数量;QA为沟道耗尽区电荷数量;φFP为衬底费米势;COX为氧化层电容。
根据阈值电压的定义,总剂量辐照前阈值电压的失配与掺杂程度、栅氧化层及耗尽区电荷有关,而这些参数在同一工艺制作的晶体管中存在误差,进而造成器件电参数的失配。总剂量辐照对沟道区及栅极中掺杂程度无影响,而是在栅氧化层中产生电子空穴对,空穴会被氧化层中工艺造成的缺陷捕获,进而形成氧化物陷阱电荷及界面陷阱电荷;或被隔离氧化层中存在的缺陷捕获,形成陷阱电荷,进一步影响耗尽区电荷,上述两种情况均会导致阈值电压变化。在辐射环境中,由于不同晶体管工艺中存在的缺陷数量、能级的不同,导致捕获辐射产生的空穴数量不同,从而使得晶体管失配增大。当沟道长度较小时,总剂量辐照亦会导致晶体管有效沟道长度变化,从而会引起饱和区漏电流的变化,进一步造成漏电流的失配增加。在高精度模拟电路设计中,失配会引起集成电路的较大的直流失调、有限偶次失真及更低的共模抑制,且MOS晶体管阈值电压的失配与沟道电容互相制约、互相对换。在0.6 μm工艺制作的晶体管中,1 mV的阈值电压失配相当于增大300 fF的沟道电容。若差动对并联较多(如在A/D转换器中),则输入电容变得过高,会严重降低速度且要求前级有较高的功耗,这均不利于集成电路的设计及应用。根据文献[6,12-13],深亚微米MOS晶体管阈值电压的漂移量不会影响晶体管的导通和截止状态,从而不会影响数字集成电路;但在高精度模拟集成电路中,失调电压和差分对管中晶体管阈值电压差呈正比,故辐射环境下阈值电压的失配增大对高精度模拟电路的影响较严重。
3 结论
通过对0.18 μm MOS差分对管的总剂量效应研究,可得出以下结论:1) 可通过阈值电压、漏极电流来表征电离辐射环境下MOS差分对管失配特性;2) 辐照会引起NMOS差分对管阈值电压、漏极电流失配增加;3) PMOS差分对管对总剂量辐照不敏感,辐照后阈值电压和漏极电流均无明显引起失配增加现象的出现;4) 电离辐射环境下小尺寸MOS晶体管阈值电压的变化在差分对管中不可忽略,在高精度模拟集成电路中,其关联着电路参数及性能的变化。
参考文献:
[1] RAZAVI B. Design of analog CMOS integrated circuits[M]. New York: The McGraw-Hill Press, 2001.
[2] 刘帘曦,杨银堂,朱樟明. 基于MOSFET失配分析的低压高精度CMOS带隙基准源[J]. 西安电子科技大学学报:自然科学版,2005,32(3):348-352.
LIU Lianxi, YANG Yintang, ZHU Zhangming. A low voltage and high accuracy CMOS bandgap reference by considering mismatch of MOSFETs[J]. Journal of Xidian University:Natural Science Edition, 2005, 32(3): 348-352(in Chinese).
[3] 赵光永. MOSFET失配的研究及应用——高性能CMOS电荷泵的设计[D]. 南京:东南大学电子工程学院,2005.
[4] 任迪远,陆妩,郭旗,等. CMOS运算放大器的辐照和退火行为[J]. 半导体学报,2004,26(6):731-734.
REN Diyuan, LU Wu, GUO Qi, et al. Radiating and annealing on CMOS operation amplifier[J]. Chinese Journal of Semiconductors, 2004, 26(6): 731-734(in Chinese).
[5] 任迪远,陆妩,郭旗,等. CMOS运算放大器的质子和γ辐照效应[J]. 核电子学与探测技术,1997,17(5):370-373.
REN Diyuan, LU Wu, GUO Qi, et al. Radiation effects of protons and60Co γ rays on CMOS operation amplifier[J]. Nuclear Electronics & Detection Technology, 1997, 17(5): 370-373(in Chinese).
[6] 刘张李,胡志远,张正选,等. 0.18 μm MOSFET器件的总剂量辐照效应[J]. 物理学报,2011,60(11):116103.
LIU Zhangli, HU Zhiyuan, ZHANG Zheng-xuan, et al. Total ionizing dose effect of 0.18 μm MOSFETs[J]. Acta Phys Sin, 2011, 60(11): 116103(in Chinese).
[7] McLAIN M, BARNABY H J, HOLBERT K E, et al. Enhanced TID susceptibility in sub-100 nm bulk CMOS I/O transistors and circuits[J]. IEEE Transactions on Nuclear Science, 2007, 54(6): 2 210-2 217.
[8] GONELLA L, FACCIO F, SILVESTRI M, et al. Total ionizing dose effects in 130 nm commercial CMOS technologies for HEP experiments[J]. Nuclear Instruments and Methods in Physics Research A, 2007, 582: 750-754.
[9] 罗岚,赵光永,吴建辉,等. MOSFET失配的研究现状与进展[J]. 电子器件,2004,27(4):767-771.
LUO Lan, ZHAO Guangyong, WU Jianhui, et al. Status and recent progress of research on MOSFET mismatch[J]. Chinese Journal of Electron Devices, 2004, 27(4): 767-771(in Chinese).
[10] 龚俊平,冯全源. MOS晶体管失配模型研究及应用[J]. 微电子学与计算机,2009,26(11):47-50.
GONG Junping, FENG Quanyuan. Research and application on the mismatch model of MOS transistor[J]. Microelectronics & Computer, 2009, 26(11): 47-50(in Chinese).
[11] DIFRENZA R, LLINARES P, GHIBAUDO G. The impact of short channel and quantum effects on the MOS transistor mismatch[J].Solid-State Electronics, 2003, 47: 1 161-1 165.
[12] BARNABY H J. Total-ionizing-dose effects in modern CMOS technologies[J]. IEEE Transactions on Nuclear Science, 2006, 53(6): 3 103-3 121.
[13] JOHNSTON A H, SWIMM R T, ALLEN G R, et al. Total dose effects in CMOS trench isolation regions[J]. IEEE Transactions on Nuclear Science, 2009, 56(4): 1 941-1 949.
[14] DRENNAN P G, McANDREW C C. Understanding MOSFET mismatch for analog design[J]. Solid-State Circuits, 2003, 38(3): 450-456.
