动态应力下功率n-LDMOS器件热载流子退化恢复效应
2013-12-29张春伟刘斯扬王永平孙伟锋
徐 申 张春伟 刘斯扬 王永平 孙伟锋
(东南大学国家专用集成电路系统工程技术研究中心,南京 210096)
横向双扩散场效应晶体管(lateral diffused metal-oxide-semiconductor,LDMOS)能与普通CMOS工艺完全兼容,因而在功率集成电路领域得到了迅速发展和广泛应用[1-2].然而,LDMOS器件经常应用在高温、高压、大电流环境中,面临着非常严重的热载流子退化问题.同时,为了实现高耐压,其器件结构相对于普通的CMOS器件更加复杂,因此其热载流子退化效应出现了新的退化机理.关于LDMOS器件的退化机理已经得到了研究者们的密切关注[3-5].
目前,关于LDMOS器件热载流子效应的研究主要是在直流应力条件下进行的.在高栅压低漏压的应力条件下,LDMOS器件的热载流子效应主要表现为源端栅氧化层的电荷注入导致器件的阈值电压Vth发生漂移[6];在低栅压高漏压的应力条件下,则主要表现为2种竞争的退化机制(即鸟嘴区域的热空穴注入和沟道区域的界面态产生),使得器件的导通电阻Ron随着应力时间的增加呈先减小后增加的趋势[7].然而,作为功率开关器件,LDMOS器件实际工作在交流应力状态下,故交流应力下的热载流子退化研究更具有实际意义.交流应力与直流应力的区别在于,交流应力下器件经常处于应力变化的状态.
本文将实验和计算机辅助设计(technology computer aided design,TCAD)相结合,从宏观参数退化和微观机理分析2个角度对n-LDMOS器件的恢复现象进行研究,并针对热载流子退化的2种主要机理分别进行了详细分析,为工业中n-LDMOS器件的热载流子寿命考核和动态应力下寿命模型的建立提供了一定的理论指导.
1 器件结构
本文所研究的n-LDMOS器件剖面结构图见图1,该器件采用0.5μm SOI-CMOS工艺制作.器件的主要参数如下:漂移区长度为12μm,沟道区长度为2.5μm,栅氧化层厚度为25 nm.该器件的阈值电压为1.2V,关态击穿电压为220 V.工作时最高的栅源电压Vgs和漏源电压Vds分别为10和150V.

图1 n-LDMOS器件剖面结构图
2 实验与讨论
2.1 动态应力中的恢复现象
器件在交流应力下的退化是各种不同直流应力下退化的复杂结合及综合体现.为了较真切地模拟交流动态工作环境,突出影响器件退化恢复的最重要因素,同时使退化更明显以便看出退化趋势,实验条件选择如下:源漏电压Vds=160V,栅极输入为方波脉冲,栅极方波脉冲的低电平电压Vglow设置为0V,高电平电压设置为器件产生最大衬底电流Isubmax时对应的栅极电压Vghigh,此处Vghigh=1.5V.同时,为了消除栅极脉冲瞬态效应的影响,将脉冲上升时间tr和下降时间tf均设置为1ms,脉冲周期T设置为4s,故脉冲的上升、下降时间对于整个周期而言是可以忽略的.脉冲的高电平时间为P.这3种应力的栅脉冲占空比分别为25%,50%,75%,并将3种情况下的总应力时间分别设置为14400,7200,4800s,以保持有效应力时间(高电平时间)相等,均为3600s.Vgs=5V,Vds=0.1V时,3种不同动态应力条件下n-LDMOS器件导通电阻Ron的退化结果见图2.

图2 器件导通电阻Ron的退化曲线
由图2可知,占空比越高,器件的退化程度越严重.由于其高电平时间相同,且上升下降沿可以忽略,因此,退化量的差别来自于低电平期间的退化恢复效应.由此表明,该器件在动态应力下的热载流子退化具有严重的恢复现象,对退化量有不可忽略的作用.
2.2 注入空穴退陷阱效应引起的恢复
n-LDMOS器件在由关态向开态变换的过程中,主要处于低栅压高漏压及高栅压低漏压2种应力条件下.当应力为低栅压高漏压时,器件鸟嘴区表面纵向电场是有利于热空穴注入的(见图3,图中负值表示电场方向由器件体内指向表面).在纵向电场作用下,鸟嘴区热空穴会注入氧化层,引起热载流子退化[8].而当器件工作在高栅压低漏压情况时,鸟嘴区的纵向电场变为正值,阻碍热空穴的注入,而有利于热电子的注入.这时注入的热电子会复合氧化层中注入的空穴,同时,注入的空穴在电场作用下也会退出氧化层,导致注入空穴量减少,这种现象称之为退陷阱效应.显然,这种退陷阱效应会引起n-LDMOS器件退化的恢复.
为了进一步证实退陷阱效应,进行了如下实验:n-LDMOS器件先在Vgs=1.5V,Vds=150V的

图3 器件表面纵向电场分布
条件下进行第1阶段的退化,持续3600s后,再在Vgs=10V,Vds=7V的条件下进行第2阶段的退化,同样持续3600s.器件导通电阻Ron的退化结果见图4.同时,在应力时间t=0,3600,7200s时分别进行固定振幅改变基础电压Vbase的电荷泵(charge pumping,CP)实验[9],测试结果见图5.
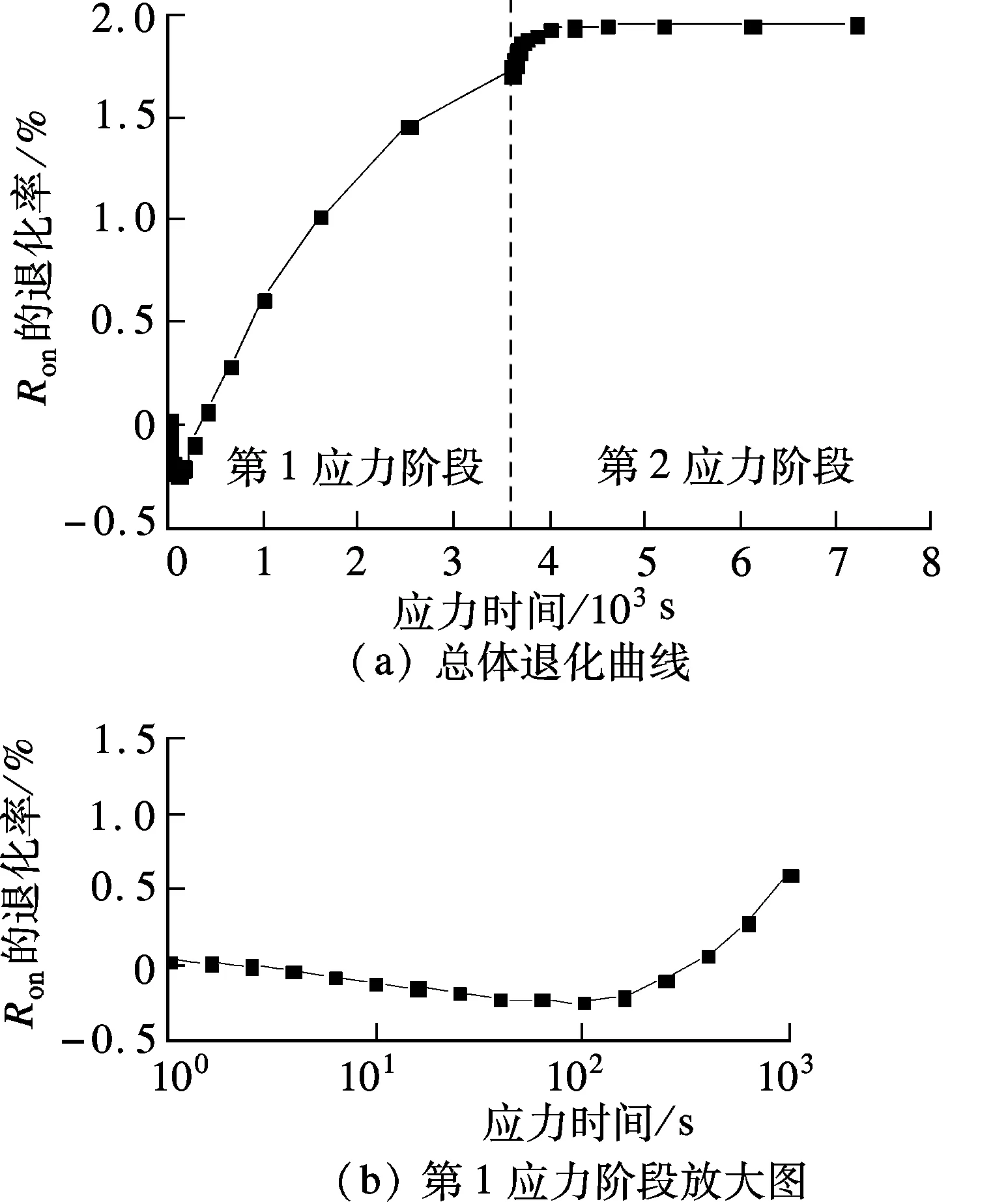
图4 不同应力阶段Ron的退化曲线
由图4可知,在应力初始阶段,导通电阻降低,这是因为鸟嘴区有热空穴注入,注入的热空穴会在鸟嘴区下方感应出电子,增加了该处的有效电子浓度,导致导通电阻下降.该结论也可从CP测试结果中得到证实.由图5可知,t=3600s时的CP测试曲线与t=0时的CP曲线相比,鸟嘴区的CP曲线明显左移,说明鸟嘴区有热空穴注入,使该处的平带电压下降.另外,还可以发现,t=3600s时CP曲线明显较t=0s时CP曲线的电流值大,说明栅氧下的界面态数量明显增加,这是引起图4中Ron的退化率后来增加的主要原因.
由图4还可以看出,第2应力阶段开始时导通电阻的退化速率明显加快,而后很快趋于饱和.这是因为随着应力的变化,器件的退化点从鸟嘴区转移到沟道区(见图6).观察图5中对应的第2应力阶段前后CP曲线的变化发现,对器件施加应力后 CP曲线的沟道区电流增大,说明在第2应力阶段中,沟道区内产生了新的界面态,这与图4所示的电阻增加结果相符.同时,观察t=3600,7200s时的CP曲线发现,鸟嘴区的CP曲线右移,但仍在t=0s时刻鸟嘴区CP曲线的左边,说明鸟嘴区注入的热空穴量减少,即发生了退陷阱效应.此外,第2应力阶段后沟道区的CP曲线右移,说明此过程中栅氧化层内存在热电子注入,使器件阈值增加,这与实际测试结果相吻合.由此可知,器件应力变换期间确实发生了热空穴的退陷阱效应,器件出现了退化恢复现象.
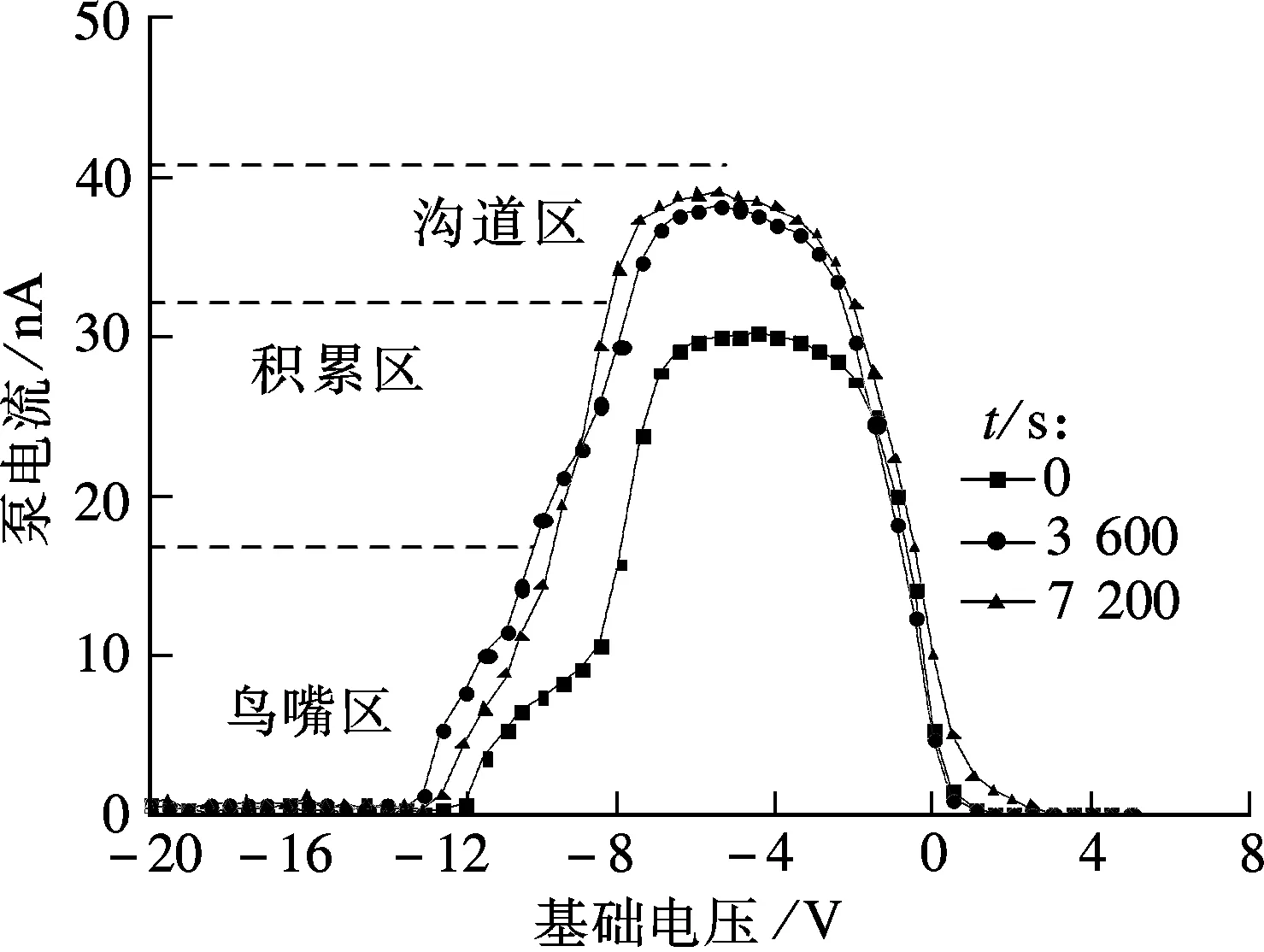
图5 不同应力阶段前后的CP曲线对比
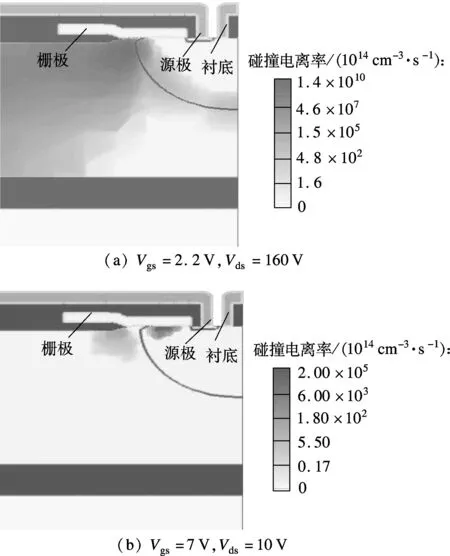
图6 不同应力条件时的碰撞电离分布图
2.3 界面态复合引起的恢复
为了研究n-LDMOS器件在关态应力下的退化恢复现象,进行了应力实验.实验中对器件施加3个阶段连续应力:第1阶段为关态应力,即Vgs=0V,Vds=150V;第2阶段为产生最大衬底电流Isubmax条件下的应力,即Vgs=1.5V,Vds=150V;第3阶段仍为关态应力,即Vgs=0V,Vds=150V.图7为Ron在整个应力过程中的退化结果.由图可知,在第1阶段,关态应力下器件基本没有退化.第2阶段是器件的正常退化过程,即开始时的退化由鸟嘴区的热空穴注入占主导,器件导通电阻下降;随着应力时间的增加,热空穴的注入逐渐达到饱和,退化由界面态的产生机制占主导,导通电阻逐渐增加,并最终趋于饱和.根据第1阶段的实验结果可知,关态应力下器件是没有退化的,故第3阶段中导通电阻的变化来自于退化的恢复效应[10].
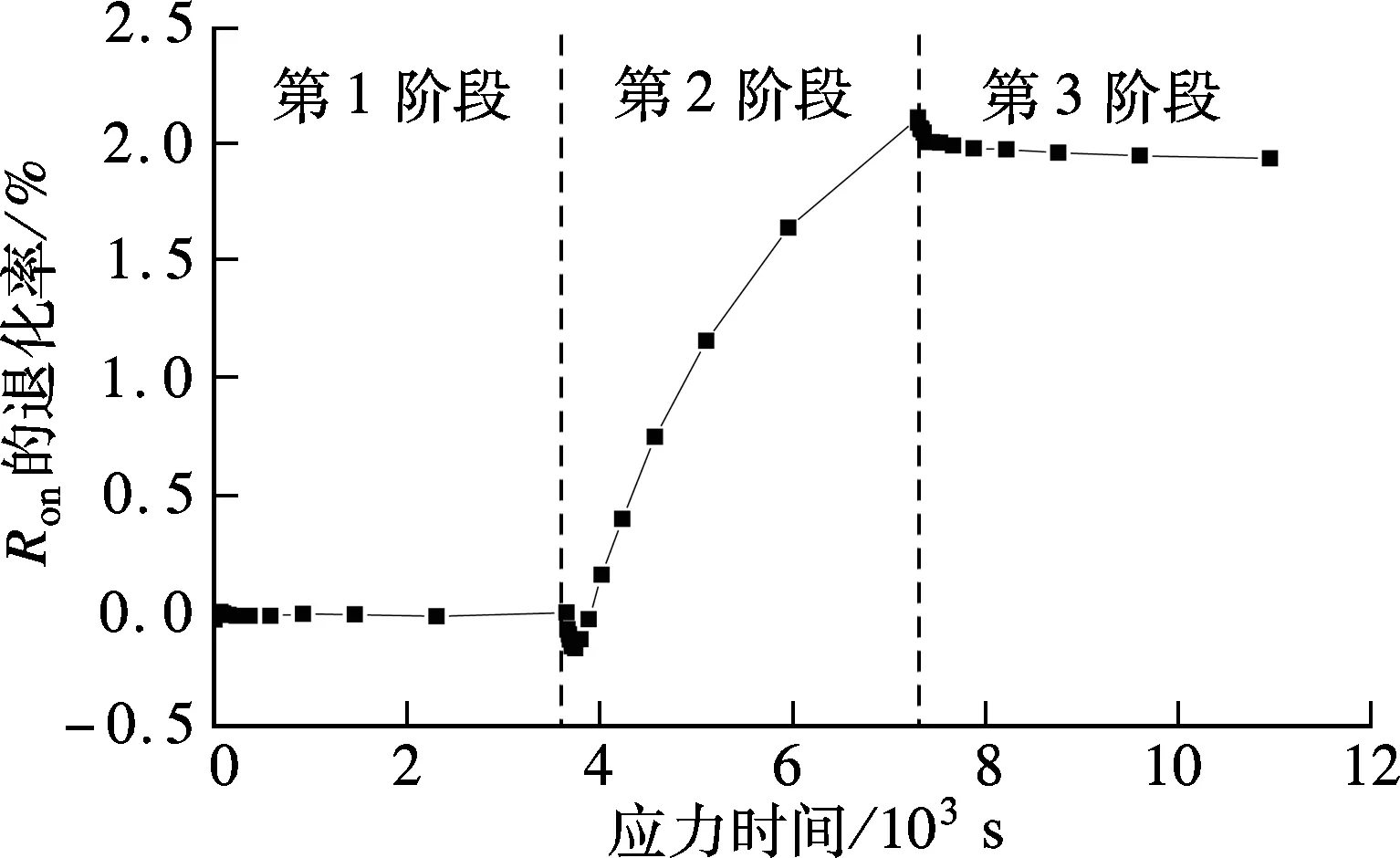
图7 3个阶段连续应力条件下的Ron退化曲线
图8为器件在3个连续应力过程中不同阶段应力前后的CP测试结果.由图可知,t=0,3600s时的CP曲线完全重合,说明在此期间器件完全没有退化.相比之下,t=7200s时CP曲线的电流值明显增大,且鸟嘴区和积累区的左边界均左移,说明该阶段有大量的界面态产生,并且在积累区和鸟嘴区有热空穴注入.对比t=10800,7200s时的CP曲线可以看出,各区域的电流都存在一定程度的下降,说明各处界面态的数量均减少.因此,在动态应力作用下,当器件处于关断阶段时,器件已产生的界面态存在一定程度的复合,导致器件退化恢复.
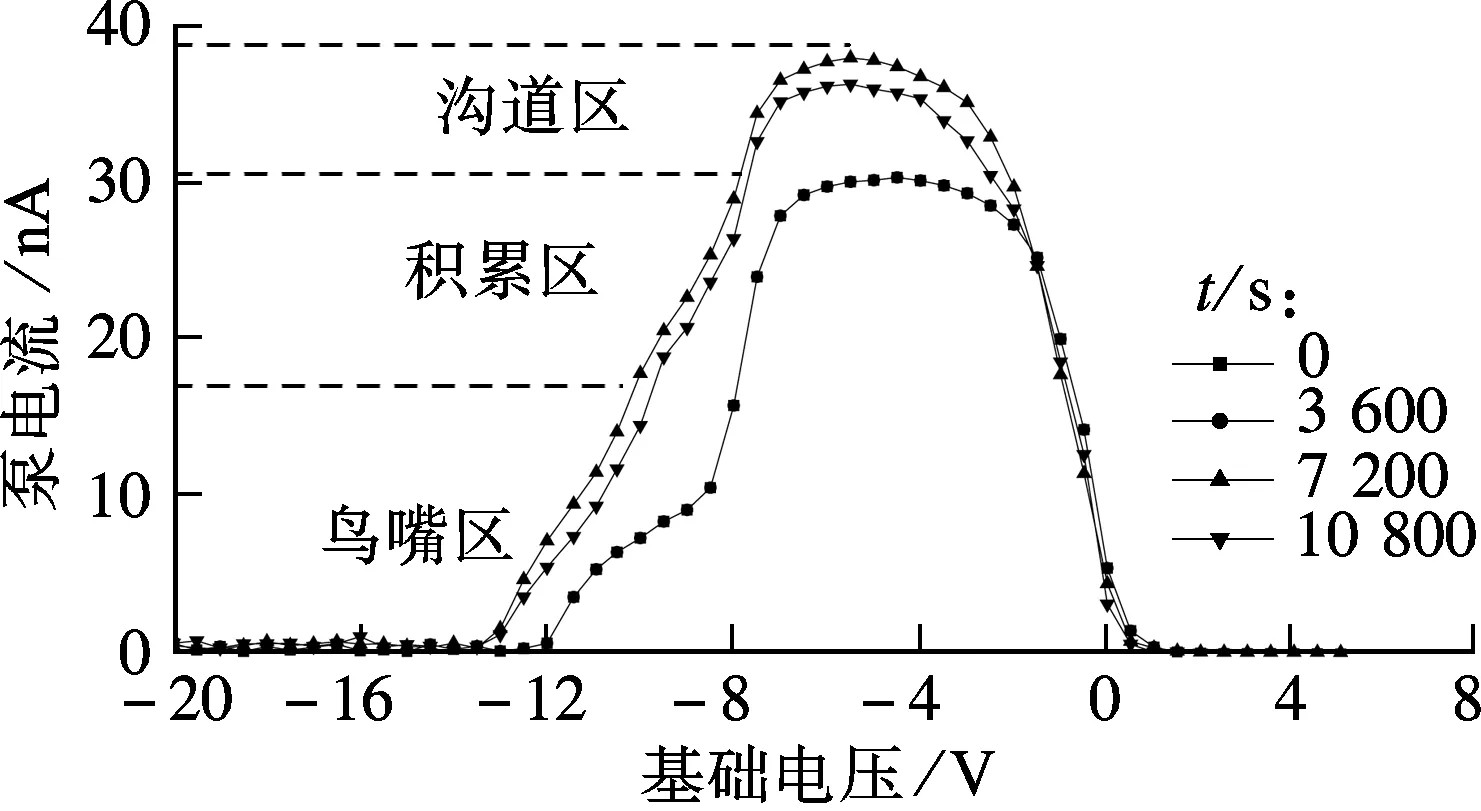
图8 3个连续应力过程中的CP曲线对比
3 结语
本文通过不同动态应力条件下n-LDMOS器件的热载流子退化实验,证实其热载流子退化具有严重的恢复效应.对器件施加不同应力,根据不同应力阶段的器件退化机理来研究退化恢复现象.研究结果表明,n-LDMOS器件热载流子效应中的2种机理都存在明显的退化恢复现象.在器件由关态向开态变换的过程中,器件会由低栅压高漏压状态向高栅压低漏压状态转换,此时鸟嘴区注入的热空穴会产生退陷阱效应,引起退化恢复.当器件处于关断状态时,退化产生的界面态复合,导致退化恢复.该研究对工业应用中n-LDMOS器件热载流子寿命考核和动态应力下寿命模型的建立具有一定的指导意义.
)
[1] Gruner D,Sorge R,Bengtsson O,et al. Analysis,design,and evaluation of LDMOS FETs for RF power applications up to 6 GHz[J].IEEETransactionsonMicrowaveTheoryandTechniques,2010,58(12): 4022-4030.
[2] Faccio F,Allongue B,Blanchot G,et al. TID and displacement damage effects in vertical and lateral power MOSFETs for integrated DC-DC converters[J].IEEETransactionsonNuclearScience,2010,57(4): 1790-1797.
[3] Chevaux N,Souza D. Comparative analysis of VDMOS/LDMOS power transistors for RF amplifiers[J].IEEETransactionsonMicrowaveTheoryandTechniques,2009,57(11):2643-2651.
[4] Chen J F,Tian K S,Chen S Y.Mechanisms of hot-carrier-induced threshold-voltage shift in high-voltage P-type LDMOS transistor[J].IEEETransactionsonElectronDevices,2009,56(12): 3203-3205.
[5] Hu C,Tam S C,Hsu F C,et al. Hot-electron-induced MOSFET degradation model,monitor and improvement[J].IEEETransactionsonElectronDevice,1985,32(5): 375-384.
[6] Moens P,Mertens J,Bauwens F,et al.A comprehensive model for hot-carrier degradation in LDMOS transistors[C]//Proceedingsofthe45thIEEEAnnualInternationalReliabilityPhysicsSymposium. Phoenix,Arizona,USA,2007:492-497.
[7] Sun Weifeng,Wu Hong,Shi Longxing,et al,On-resistance degradations for different stress conditions in high-voltage pLEDMOS transistor with thick gate oxide[J].IEEEElectronDeviceLetters,2007,28(7): 631-634.
[8] Moens P,van den Bosch G,Tack M. Hole trapping and de-trapping effects in LDMOS devices under dynamic stress [C]//Proceedingsof2006InternationalElectronDevicesMeeting. San Francisco,CA,USA,2006:1-4.
[9] Chang C C,Lin J F,Wang T,et al. Physics and characterization of various hot-carrier degradation modes in LDMOS by using a three-region charge-pumping technique [J].IEEETransactionsonElectronDeviceandMaterialsReliability,2006,6(3): 358-363.
[10] Chen J F,Wu K M,Lin K W,et al. Hot-carrier reliability in submicrometer 40V LDMOS transistors with thick gate oxide[C]//Proceedingsofthe43rdIEEEAnnualInternationalReliabilityPhysicsSymposium. Phoenix,Arizona,USA,2005: 560-564.
