电解去溢料工序参数对IC封装体第二焊线区分层的影响
2013-09-26叶德洪王津生
叶德洪,王津生
(飞思卡尔半导体(中国)有限公司,天津 300385)
引 言
塑封集成电路(IC)是通过热固型环氧树脂把铜合金引线框架和芯片组合包封起来的一种封装形式。铜合金引线框架提供芯片的安装平台,通过键合金线连接芯片和引线框架。为了使键合金线和引线框架能可靠焊接,引线框架通常在引线键合指的端部上局部区域镀银,称为第二焊线区。对于模塑成型后再进行电沉积锡或锡合金镀层的生产线,模塑成型完成后,会有少量的树脂留在封装体外的引线框架上,称为溢料,如果不能去除,它所覆盖的引线框架将不能被金属镀覆,影响产品的焊接可靠性,造成产品电性断路和虚焊等问题。目前封装行业中常用的有两种去溢料方法:碱性电解法和化学浸泡加高压水刀冲洗法。碱性电解法具有处理时间短、费用省,适用于高速电镀线等优点,但可能会影响一些小塑封体大载体封装的分层[1-2];化学浸泡法则需要较高的温度和时间,因而在去除能力及效率上较电解法更具有优势,但却耗费更多的时间和能源且废液处理存在许多环保问题。
文献[2]和[3]也曾报道过在QFN器件的封装过程中,第二焊线区的分层与电镀工艺中的电解去溢料工序有关,但只是指出了电解去溢料工序会导致器件的第二焊线区分层,并没有进一步探讨或研究电解去溢料方法中影响器件分层的因素。本文通过对QFP封装产品在高速电镀线上各个工序的分析,确定了电镀工艺中的电解去溢料工序是影响第二焊线区分层的原因,并通过超声波扫描显微镜(SAM)对分层进行检测,探讨了该工序中电解去溢料溶液的pH、电极极性等主要参数对QFP封装体第二焊线区在封装后(T0)时出现分层的影响。
1 IC封装体电镀生产线工艺流程
IC封装体引脚电镀一般采用高速电镀线,它满足了半导体封装器件对于产量的要求,其线速至少为8m/min,通常以不锈钢带为载料工具循环进行,上料后,进行电镀,完成后,末端下料,然后褪去钢带上的锡层,再恢复到起始的上料位。图1为高速电镀生产线流程示意图。
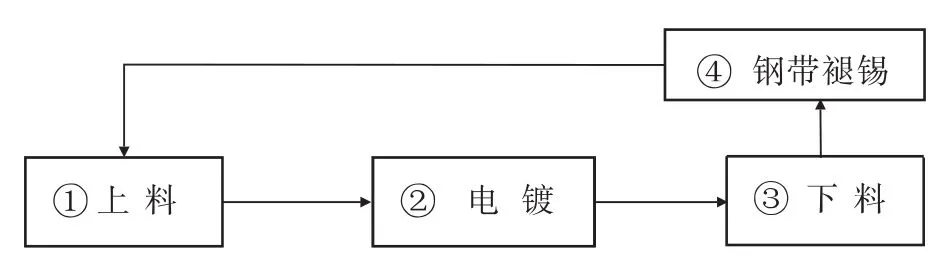
图1 高速电镀生产线流程示意图
电镀工艺是利用电沉积技术在塑封体外部的引线框架的引脚上沉积上一层可焊性好的金属或合金,增强IC器件与PCB焊点之间的可靠性连接。通常沉积的金属或合金为锡或锡合金。电镀工艺流程为:阴极电解→冲洗→高压水刀→冲洗→化学刻蚀→冲洗→预浸→电镀→冲洗→热水冲洗→干燥。
工艺流程中的阴极电解和高压水刀冲洗两道工位合起来称作电解去溢料工序,它属于电镀工艺的前处理。电解去溢料是电镀前去除引线框架的有机污染物、溢料和清洁待镀金属表面。工业上一般使用碱性较强且不易结晶的氢氧化钾溶液,在阴极电解的过程中产生大量氢气,电压越高反应越剧烈,产生的气泡就越多,随着气泡的迅速增大并不断破裂产生的机械作用力,溢料在引线框架上不断松动或剥离,然后在高压水刀作用下将溢料从框架上彻底清理下来。其机理如图2所示。
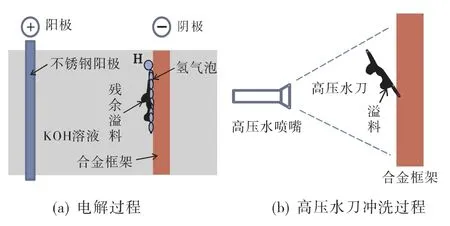
图2 电解去溢料示意图
2 实验
2.1 镀前处理对第二焊线区分层的影响
实验器件为QFP10×10,64管脚的封装体,框架为A194铜合金,框架设计类型编号为L100,第二焊线区为银镀层。所使用检测器件内部分层的仪器为SONIX SAT,扫描范围为第二焊线区,模式为C扫描。在经过贴片、焊线和塑封及塑封固化后(PMC),经超声波(C-SCAN)正面检测,如图3(a)所示,没有发现任何分层;经过电镀后,再用超声波做C-SCAN正面检测,如图3(b)所示,在第二焊线区镀银层位置发现明显的分层,断定是电镀生产中某个因素的影响。
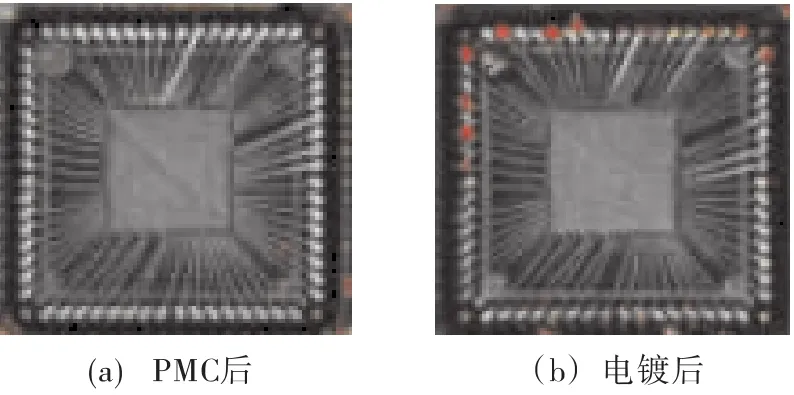
图3 超声波C-SCAN检测图片
为确定电镀生产过程中对第二焊线区分层产生影响的工序,对前处理工序进行排查,每个排查条件先后两次实验,如表1所示。

表1 镀前处理工序排查检测结果
从表1结果来看,对以L001为引线框架的QFP产品来说,凡是经过阴极碱性电解后第二焊线区都有不同程度的分层,而单独使用高压水刀或前处理中的化学刻蚀对第二焊线区分层都没有产生作用,因而认定去溢料工序中的电解作用对第二焊线区分层有影响。
2.2 电解作用中的影响因素
影响电解去溢料工序有许多因素,主要包括电解电压、电解质溶液组分、电解质的pH和电极极性。以下实验分别对这些因素进行分析。
2.2.1 电解电压和电解溶液组分的影响
分别考虑这两个因素对第二焊线区分层产生影响,实验中的因子水平及第二焊线区分层检测结果如表2和表3所示。
由表2可知,随着电解电压的减小,第二焊线区分层的样品数量也在减小,当U降到2.0V时,没有发现第二焊线区分层,此时,观察到在阴极上没有氢气析出且电解电流为零,阴极电化学反应已经停止。去溢料U为2.0V时,电镀后的产品如图4所示,未被清除的残余溢料会影响到镀层的外观质量。

表2 阴极电解电压的影响
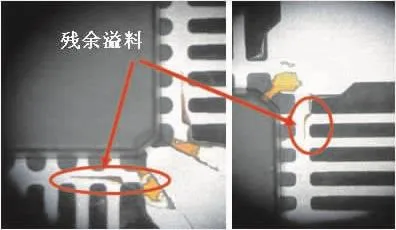
图4 去溢料后的电镀效果

表3 电解液组分的影响
表3 结果显示,当ρ(KOH)降到工艺要求下限10g/L时,第二焊线区分层虽然有所减少但仍然无法完全消除,可见电解液中KOH的组分不是影响分层的主要因素。实验结果发现,阴极电解电压是影响分层的关键因素。
2.2.2 电解液 pH
虽然电解去溢料溶液使用的是KOH溶液,但在电解过程中,阴阳极上得失电子的是H+和OH-,电极反应实际是电解水的反应,因此可以使用中性或酸性的电解液去除残余溢料,并评估其对第二焊线区分层的影响。
表4 列出了不同pH的电解液,其中NNL10是某公司的电解去溢料产品。

表4 电解液pH对去溢料的影响
超声扫描的结果显示,即使在pH为7.0的中性电解质溶液中电解去溢料,仍然会造成第二焊线区分层,虽然阴极电流较10g/L的KOH溶液高,但其去溢料效果却比KOH溶液差;当pH小于7.0溶液呈酸性时,在NNL10和甲磺酸电解液中分别进行电解去溢料,电镀后经C-SCAN检验,没有发现第二焊线区分层,但其去溢料效果远不如KOH碱性溶液。实验证明在电解去溢料过程中,溶液的pH对第二焊线区分层有着明显的影响,同时也显著影响去溢料的效果,随着pH的降低,虽然可以改善器件的分层问题,但去溢料的作用也随着减弱。
2.2.3 电极极性
电解去溢料采用直流,在碱性溶液中将工件作为阴极,不锈钢板作为阳极进行电解。为验证电极的影响,实验中把电极反接,带有IC塑封体引线框架作为阳极,不锈钢板作为阴极,在同样的KOH溶液中进行电解。选取了LQFP10×10和LQFP7×7两种封装体类型进行实验,结果列于表5。

表5 电解极性的影响
从表5中可以看出,LQFP10X10和LQFP7X7封装体,在30g/L的KOH电解液中,经阳极电解去溢料后,第二焊线区没有发现分层,但阳极电解法去溢料的效果大大低于阴极法。一方面,由于消耗同样的电量,析出的氧气只有氢气体积的一半,气体数量少,相同时间内阳极去溢料效率不如阴极去溢料效率高;另一方面,氢气的渗透性比氧气好,更容易使溢料从金属表面剥离。
2.3 引线框架内管脚长度的影响
在对所有QFP封装形式进行电解去溢料和电镀后的超声波检查发现,即使采用相同的阴极电解去溢料参数,并非所有的QFP产品都会产生第二焊线区的分层。分层的产品集中在使用引线框架的内管脚较短的封装体上,也就是说集中在芯片尺寸较大的封装体上。图6展示了使用三种不同引线框架的QFP7X7封装体在经过相同的电解去溢料后超声波C扫描的探测结果。图6(a)和图6(b)中的芯片大小相同,引线框架不同,其内管脚长度分别为1.3和0.8mm,图6(c)中的芯片尺寸是此封装类型中最大的,其引线框架的内管脚长度仅为0.7mm。
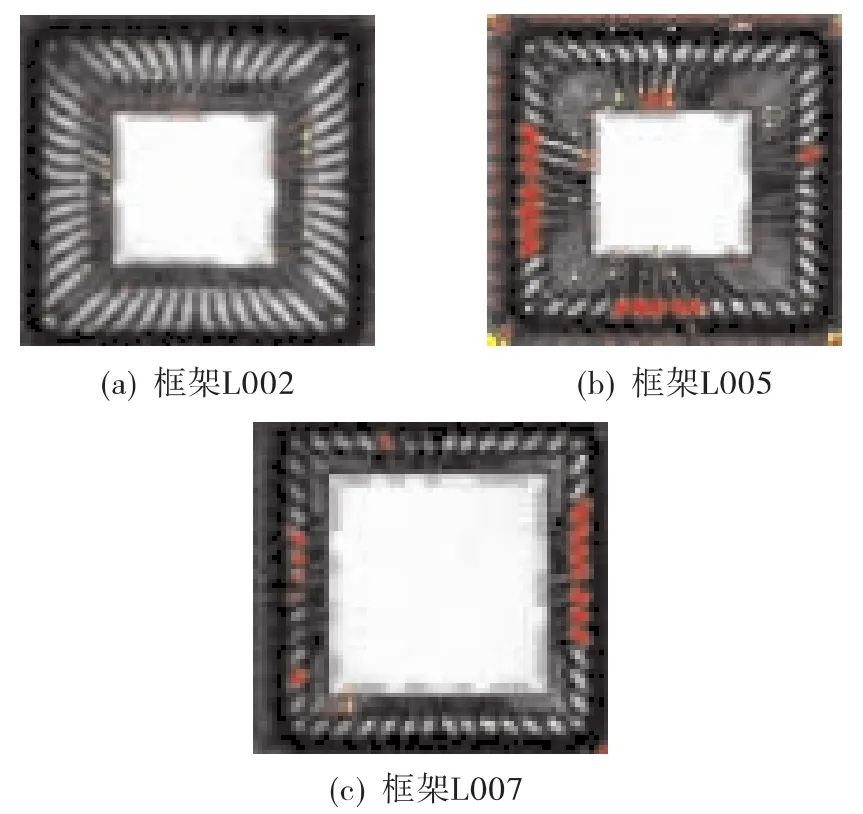
图6 电镀后C-SCAN图片
经过阴极电解后,使用框架L002的封装体,没有发现第二焊线区的分层,而使用另外两种框架的封装体则有不同程度的分层。可见在电解去溢料工序中,引线框架内管脚的长短对封装体的第二焊线区的分层有着显著的影响。
3 结论
从以上实验来看,这种大载荷小封装的IC封装体,对电解去溢料法非常敏感,高速电镀线上的电解去溢料工序虽然只有10s左右的处理时间,但却会导致这种具有较短内管脚的IC封装体在第二焊线区出现分层。电压是电解去溢料工序中影响分层的关键控制参数,降低阴极电压,减小了阴极电流,改善了第二焊线区的分层,而去溢料的功能也随之变弱。虽然通过改变其他参数,如电解电极极性和电解液的pH也可以减小和消除第二焊线区分层,但同时都减弱了去溢料的功能,影响镀层质量。对于这种IC封装体,一些半导体封装生产厂商采用化学去溢料法去除溢料,取得了满意的效果[3]。也有使用激光技术去除封装体外的残余溢料[4-5],此方法使得封装体不接触化学药剂,因而不会受到化学品的侵蚀,处理后的产品可靠性可能会更好。
[1]慕蔚,周朝峰,孟红卫,等.集成电路封装溢料问题探讨[J].电子与封装,2009,9(7):13-16.
[2]Tong T S,Kumar J,Kanan M D.A Study and Investigation on Processes Inducing Delamination in QFN Package Using Statistical Analysis[C]//Electronics Manufacturing and Technology,31st International Conference on.Petaling Jaya,Malaysia:IEEE,2006:381-389.
[3]Chen-Hung Lee,Lu-Fu Lin,Tsung-Han Ho,et al.Study on paddle delamination for quad flat no leads package[C]//Microsystems Packaging Assembly and Circuits Technology,Conference(IMPACT),5th International,Taipei:IEEE,2010:1-4.
[4]Deng Bin,Shao Peng,Wang Yue.Breakthrough of Laser Deflash System To Improve Productivity[C]//Electronic Manufacturing Technology Symposium,33rd IEEE/CPMT International,Penang,Malaysia:IEEE,2008:1-5.
[5]Hongyu Zheng,Qiong Chen,Tan J L,et al.Laser Removal of Molded Flashes From a Leadframe Heatsink Surface[J].Electronics Packaging Manufacturing,2005,28(2):158-162.
