硅各向异性腐蚀技术研究
2012-09-11李湘君
李 倩,崔 鑫,李湘君
(中国电子科技集团公司第四十七研究所,沈阳 110032)
1 前言
湿法腐蚀是微传感器制造工艺中常用的MEMS后处理工艺,利用Si在KOH、TMAH等碱性溶液中的各向异性腐蚀特性实现传感器的腔、槽、台面等结构。但是在进行Si(100)台面腐蚀时,由于硅的各向异性腐蚀特性,凸角处严重出现切削现象因而导致器件性能改变。
2 各向异性湿法腐蚀技术
硅的各向异性腐蚀,是指腐蚀液对硅的不同晶面具有不同的腐蚀速率[1],基于这种腐蚀特性,可在硅衬底上加工出各种微结构。单晶硅片在其不同方向上对某些腐蚀液具有各向异性,常用的有R(100)>R(110)> R(111)[2]。在制造硅杯或台面等结构时,常选用(100)面。
2.1 单晶硅湿法异向腐蚀原理
单晶硅在有机腐蚀剂和无机腐蚀剂中具有非常类似的腐蚀现象,由此可推出OH-离子是此反应的主要参与者。
早在1967年,Finne和Klein就根据对反应产物以及在反应过程中放出的H2与Si的近似化学计量比的分析,第一次提出了由OH-,H2O与硅反应的各向异性腐蚀反应过程的氧化还原方程式:

2.2 单晶硅湿法异向腐蚀常用腐蚀剂
各向异性腐蚀剂一般分为两类,一类是有机腐蚀剂,包括 EPW(乙二胺,邻苯二酚和水)、TMAH(四甲基氢氧化铵)等,另一类是无机腐蚀剂,包括KOH、NaOH和NH4OH等,这两类腐蚀剂具有非常类似的腐蚀现象。现在比较常用的腐蚀液是KOH和TMAH腐蚀液[3]。本次实验所用腐蚀液为浓度39%的KOH。
3 凸角补偿
在KOH腐蚀液中,Offerins等人发现高速率腐蚀面是(410)面[4]。因此针对这种削角补偿的研究越来越多,如在凸角上补偿方形、三角形、<110>条形及<100>条形掩膜等,其目的都是为了得到完整的凸角结构。通过实验采用正方形及正方形拓展补偿图形掩膜,研究要在KOH腐蚀液中将厚度为390μm厚的硅片腐蚀出完整的台面凸角结构需要补偿多大尺寸的掩膜,得出补偿图形尺寸与腐蚀深度的关系。
3.1 边角补偿的掩膜设计
在方型掩膜的边角上添加补偿条或补偿块,使(410)快腐蚀面在腐蚀过程中,刚好来不及削角。下面只介绍方形补偿及在方形补偿基础上拓展的双正方形补偿。
很多文献中都提到方形补偿(如图1)[5]效果不错,而且有很多经验值如 a=H、a=1.414H、a=0.912H等,方形补偿设计取a=H。若方形补偿凸角处依然出现削角,那么在这个正方形的基础上叠加一个正方形使台面的(100)面和(410)面均加大面积(如图2)。双正方形补偿设计取a=0.91H。

图1 方形补偿
图1设计尺寸:第一单元:a=100μm;第二单元:a=200μm;第三单元:a=270μm;第四单元:a=350μm。

图2 方形补偿扩展
图2设计尺寸:第一单元a=91μm;第二单元a=182μm;第三单元 a=245μm;第四单元 a=318μm。
3.2 版图设计
用L-Edit工具完成版图设计并制成掩膜版。如图3、图4(图形正中间的正方形为最终想得到的台面1mm×1mm):


3.3 实验装置
实验用n型单晶硅片,实验装置为DF-Ⅱ集热式磁力搅拌器,可得到稳定的实验温度;STM-6奥林巴斯显微镜,可测硅片的腐蚀深度,采集照片等。腐蚀液是浓度为39%的KOH溶液。调节控制面板,设定所需温度(80℃),当溶液温度与水浴锅里的温度一致,并达到设定温度时,将硅片放入。在腐蚀过程中,搅拌子不断搅拌,使溶液保持流动,防止出现局部溶液浓度过低的现象。
3.4 实验结果及分析
由于设计的实验数值较多,得到准确的补偿尺寸与腐蚀深度的关系需采用效果最好的照片。取第四单元实验结果,双正方形的补偿效果最好。根据a=xh,已知 a=318μm,h=353μm,得 a=0.898h。
取方形补偿,双正方形补偿,无任何补偿的腐蚀台面高度均达353μm时的显微照片(见图5-图7)。

图5 方形补偿
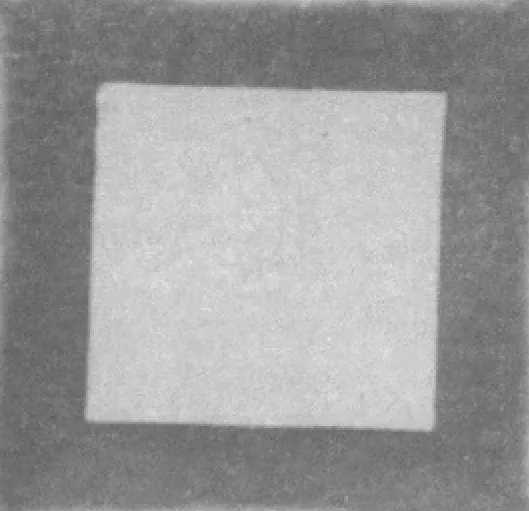
图6 双正方形补偿
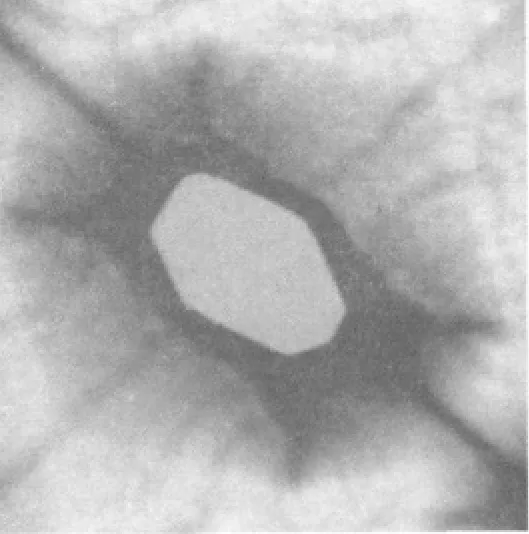
图7 无任何补偿
由图5看出方形补偿的效果并不好,凸角处已经出现了严重的削角现象;图6的补偿效果非常好,得到了完整的台面结构;由图7明显看出当台面结构没有进行凸角补偿时,随硅片腐蚀深度的加深台面凸角处的削角现象越来越严重,而经过补偿设计图形凸角处的削角很小或不削角。
4 结束语
当腐蚀有台面结构的图形时,制版时必须对其凸角结构进行补偿,重点实验的双正方形补偿可以得到理想的凸角结构,但是由于补偿面积较大,比较适用浅度补偿或台面间距不受限制的深度补偿。这种方法操作简单,能得到完整的凸角结构,因此可以在硅微机械加工技术中广泛使用。
[1]GT A Kovacs,N I Maluf,K E P etersen.Bulk Micromachining of Silicon[J].Proceedings of the IEEE,1998(8):1536-1551.
[2]王涓.MEMS中单晶硅的湿法异向腐蚀特性的研究[D].江苏:东南大学,2000.
[3]沈桂芬,吴春瑜,姚朋军,等.各向异性腐蚀技术研究与分析[J].传感技术学报,2001(2):140-142.
[4]H.L.Offereins,K.Kuhi,and H.Sandmaier[J].Sensors and Act.1991,10(2):25 -27.
[5]黄庆安.硅微机械加工技术[M].北京:科学出版社,1996.
