亚波长微纳光学的前沿研究 (一)*
2012-08-21庄松林朱亦鸣张大伟
庄松林 王 琦 朱亦鸣 耿 滔 张大伟
①中国工程院院士,②博士,③⑤教授,④副教授,教育部光学仪器与系统工程研究中心;上海市现代光学系统重点实验室;上海理工大学光电信息与计算机工程学院,上海200093*上海市重点学科项目第三期项目(S30502);上海市超精密光学加工与检测服务平台建设(11DZ2290301)
亚波长微纳光学的前沿研究 (一)*
庄松林①王 琦②朱亦鸣③耿 滔④张大伟⑤
①中国工程院院士,②博士,③⑤教授,④副教授,教育部光学仪器与系统工程研究中心;上海市现代光学系统重点实验室;上海理工大学光电信息与计算机工程学院,上海200093
*上海市重点学科项目第三期项目(S30502);上海市超精密光学加工与检测服务平台建设(11DZ2290301)
负折射 反常多普勒效应 黑硅
材料与结构在微纳米尺度展现了许多不同于宏观尺度的新特征,微纳加工技术已经成为当前科学研究与工业开发的热门领域之一。笔者简要介绍了负折射材料和黑硅这两种微纳光学材料的制备及其特性,展示了微纳光学材料在新技术中的广阔前景和科技创新中的重要作用。
1 概述
微纳光学是指微纳米尺度下的光学现象。随着光学器件和光学系统不断的微型化,其光学特性也会发生变化,当特征尺寸达到微纳米量级时,会出现很多宏观条件下没有的新现象。负折射材料的出现,为人们提供控制光和电磁波行为的全新手段;而利用飞秒激光脉冲与硅材料相互作用获得的黑硅材料,在太阳能电池等应用研究领域有着广泛的应用前景。笔者简要介绍其所在研究小组在特殊的光学材料——负折射材料和黑硅材料制备和特性研究方面的相关进展。
2 负折射材料及研究现状
在自然界中,物质的电磁性质可以使用介电常数ε和磁导率μ来描述。根据麦克斯韦方程可知,平面电磁波的波矢k,电场强度E和磁场强度H三者两两垂直,遵守右手定则k=E×H。电磁波的能量传播方向由坡印廷矢量S决定,在一般电磁介质中,坡印廷矢量S的方向和波矢k的方向相同。那么,是否存在一种特殊的介质,当平面电磁波在其中传播时,波矢k,电场强度E和磁场强度H三者不再遵守右手定则k=E×H,而是遵守左手定则k=-E×H,使得坡印廷矢量S的方向和波矢k的方向相反?苏联物理学家Veselago[1]最早对这一问题进行了研究,他假想了一种具有负的介电常数ε和负的磁导率μ的双负材料,来实现这一构想。由于这种材料遵守左手定则k=-E×H,因此这种材料被称为“左手材料”(left-handed material,LHM)。Veselago发现当平面电磁波从一般的右手材料入射到左手材料中时,在左手材料内部会发生入射光线和折射光线位于法线同侧的现象。此时,如果将Snell定律做一下推广,认为左手材料的折射率为负值,这样使得这种情形也满足Snell定律的形式;因此,左手材料又称为“负折射率材料”(negative index material,NIM)。
尽管负折射率材料体现出诸多的奇特性质,但由于人们没有在自然界中发现介电常数ε和磁导率μ同时为负值的材料,所以,Veselago的研究成果并没有引起当时学术界的重视。直到20世纪末,英国物理学家Pendry重新开启了这方面的工作。他在理论上仔细研究了导线阵列[2]和有缺口的环形共振器[3](split-ring resonator,SRR)阵列的电磁特性,极大地推动了这一领域的发展。其后,Pendry又提出了“完美透镜”(perfect lens)的概念[4],即利用介电常数和磁导率同时为-1的负折射率平板,不仅可以聚焦光场的传播场部分,更重要的是可以恢复光场的倏逝场部分,突破瑞利衍射极限成像,这一无可比拟的特性引起学术界极大的兴趣和重视[5-10]。
在实验上,美国物理学家Smith等[11]走出了关键的一步,他们把导线阵列和有缺口的环形共振器这两种结构做在一起,在微波段实现了在同一材料中介电常数ε和磁导率μ同时为负值。接下来,他们改进阵列结构,并首次在实验中观察到负折射现象[12]。2003年,研究者对Smith等人的实验进行了改进[13-14],证明在远场也能观察到负折射现象,且不同入射角下测量到的负折射率是一致的,完全符合Snell定律。这一系列的实验工作使负折射率是否真的存在这一争论暂时告一段落,并被Science杂志评为当年十大科学进展之一。当然,由于实际的材料必然存在色散和吸收,理想的完美透镜并不存在;但利用负折射率平板成像,仍然能够突破传统的衍射极限。因此,光波段的负折射率材料的应用会对高分辨率成像、光通讯、高密度光存储、超大规模集成电路的光刻技术以及集成光学等领域产生深远的影响。另外,负折射率的LC网络可应用于耦合器、谐振器、天线和导波方面,能极大地改善这些器件的性能。总之,负折射率材料的出现,为人们提供了控制光和电磁波行为的全新手段。
在一般材料中,当波源和观察者发生相对移动时,会发生多普勒效应:两者相背而行,观察者接收到的频率低于波源频率,如图1(a)所示。但在负折率材料中,情况正好相反。如前所述,群速的方向(即能流传播的方向)和相速的方向(即相位传播的方向)相反,所以如果波源和观察者相背而行,观察者接收到的频率会升高,发生反常多普勒效应,如图1(b)所示。由于在实验上很难将探测器放在人造的负折射率材料内部测量频移,所以大部分研究者都采用理论研究和数值模拟、仿真相结合的方法[15-18]。到目前为止,只有在音频波段[19]和GHz波段[20]的间接测量报道,但一些科学家对实验工作提出了不同看法[21-23]。因为多普勒效应现象早已被广泛应用于工农业生产、医疗卫生、科技国防等等社会生活的许多方面,可以预见,反常多普勒效应的存在将会给这些应用领域带来根本性的影响。另一方面,目前虽然在很多人工合成材料中观察到了负折射现象,但这并不能作为评判材料折射率为负的依据。因为发生负折射现象不代表材料的折射率为负,例如全息光栅的衍射、光子晶体等频面形状的内凹[24-25]等原因都会发生负折射现象,但该材料折射率并不为负。因此,反过来,反常多普勒效应的实验测量将有力地证明负折射率材料的存在性,验证相关理论的正确性,为后续工作铺平道路。为此,我们搭建了自主设计的实验装置,利用自制的实验平台,在国际上首次观测到了光频段的反常多普勒现象[26]。
我们实际制备了负折射光子晶体棱镜,Si介质柱的截面半径r=0.2a,其中晶格常数a=5μm。为了接近理想的二维光子晶体,在当前工艺许可的条件下,尽量增加介质柱的高度,使得高度h=50μm。为了测试光路的需要,光子晶体棱镜样品制作成菱形,顶角为60°,棱边长5 mm,Si介质柱分布在高度为550μm的Si衬底上。图2(a)和2(b)分别给出实际样品的俯视图和侧视图。接下来对样品的负折射效应做了实验验证,实验入射光源选择E偏振的CO2激光器,工作波长10.6 μm。实验结果表明,所有具有相同晶格结构的不同样品(超过10块样品)都体现出明显的负折射特性。在这里需要注意的是,根据实验测量结果,样品的等效折射率在-0.524~-0.376之间变化,绝对值小于-0.7的理论绝对值,我们认为这是由于Si柱的有限高度造成的。另外,我们制备的样品下覆层材料为Si,没有上覆层,Si柱暴露在空气中,因此光子晶体平板上下覆层材料的不对称,也会对光子晶体的能带结构产生影响[27-28]。
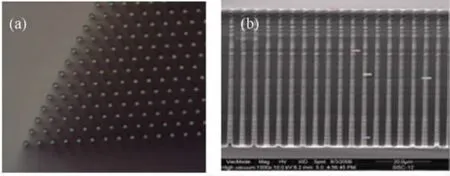
图2 负折射光子晶体棱镜的扫描电镜图(a)俯视图;(b)侧视图
反常多普勒效应的测量有两大困难:①探测器不能置于光子晶体介质内部,且相对于光子晶体介质运动;②需要找到一个明确的判据来判断所测频移的正、负,以区分正常和反常多普勒效应。我们设计如图3的实验光路,CO2激光光束垂直于光子晶体棱镜的第一个棱边入射,即沿ΓM方向。光子晶体棱镜固定在一个平移台上,平移台可沿x方向匀速运动。通过计算分析可知探测器所测拍频为

其中f0为光源频率;f′2为探测器接受到的参考光频率;f1为测量光束经过光子晶体棱镜,到达棱镜第二条棱边时,棱镜在界面上接受到的光波频率;k为略小于1的正常量。式(1)中第一项f′2-f0k的值在同一次实验过程中是一个常量,且与光子晶体棱镜的等效折射率无关,给定平移速度后可以很容易算出。当实验参数θ=-26°,β=45°,平移速率为0.012 3 mm/s,0.024 5 mm/s,0.048 8 mm/s和0.073 2 mm/s时,f′2-f0k均为正值,其值分别等于1.90 Hz,3.77 Hz,7.51 Hz和11.27 Hz。注意到参量k恒为正值,那么当测量到的拍频Δf<f′2-f0k时,f1-f0能且只能为正,即f1>f0;也就是说,当光程在光子晶体棱镜中增加时,在光子晶体棱镜第二个界面上接受到的光波频率大于CO2激光器的光源频率,即在光子晶体棱镜中发生的多普勒效应为反常。

图3 实验光路示意图

图4 实验测量的频差Δf与f′2-f0k值在不同平移速度下的对比
图4中的插图给出了在上述四个平移速度下,探测器测得的信号。通过快速傅立叶变换得到拍频Δf分别为0.89 Hz,1.83 Hz,3.65 Hz和5.14 Hz,实验测量值与理论值符合得很好,实验值与理论值的误差小于5%。将实验测量值Δf与f′2-f0k值相比较,如图4所示,实际测量的频差Δf均小于f′2-f0k,这一结果清楚无误地证明实验观测到了反常多普勒效应。使用具有相同晶格结构的不同光子晶体棱镜样品,我们多次重复了上述实验,实验结果类似。将光子晶体棱镜替换为普通的ZnSe棱镜,做了同样的实验,实验结果表明,ZnSe棱镜中的多普勒效应是正常的,实验测量值与理论值吻合得很好,误差小于3%。这一验证性实验证明我们的实验系统可以很好地区分正常和反常多普勒效应,且实验结果可信,与理论值符合得很好。
3 黑硅材料的研究进展
近年来,利用飞秒激光在一定气压的气体环境里照射硅材料表面,可以生成一种新型的“黑硅”材料。这些微结构可以显著改变硅材料的属性[29-30],特别是在很宽的波长范围内(0.2~2.5μm),光吸收效率可被显著提高到90%以上[31-32]。因此这一特性可被广泛应用于太阳能电池[33]、太赫兹辐射[34]、传感器和光电探测器[35-38]的研究。为获得更大的光电吸收系数,科学家们不断致力于不同表面微结构形貌的硅材料的研究,包括激光通量、脉 冲 宽 度[39-40]、偏 振 方 向[41]、脉 冲 数[42]、气 体 种类[43]、气体压力[44]等。然而,由于很多参数的研究范围不够大,有些特殊的现象未被发现。我们注意到,不同波长的激光脉冲在硅表面上可以形成不同的波纹图案,且对相同材料的穿透深度也不同,所以最后形成的表面微观结构也应有所不同。然而,不同波长飞秒激光脉冲蚀刻的微结构的具体区别至今没有完善的研究结果。我们研究小组详细研究并讨论了在两种不同波长的飞秒激光脉冲的驱动下,通过改变实验条件,包括激光功率、脉冲数,以及在相同的激光通量下它们之间的比例关系,硅表面微观结构变化的差异。
3.1 黑硅材料的实验装置

图5 实验装置图
制备表面微结构硅材料的实验装置如图5所示。由钛宝石再生放大系统输出飞秒光源,其输出脉冲的中心波长为800 nm,重复频率1 kHz,脉冲宽度为45 fs,激光光斑的空间分布为近高斯形。激光脉冲经过焦距为f=1 m的聚焦透镜会聚到真空腔中,真空腔的入射窗口为厚度0.4 mm的窗片,腔内充入气压可调的SF6气体,真空腔被固定在一个三轴移动平台上,实现三维精密调节。一个可翻转的反射镜则用于两种不同光源之间的转换,使其分别与样品相互作用:首先,当该反射镜向上翻转,800 nm波长的激光束将直接入射到样品上;将该反射镜向下翻转,800 nm波长的激光束先入射到0.2 mm厚的BBO倍频晶体上,可以得到波长为400nm的飞秒激光脉冲。晶向为100的硅片垂直于光源的入射方向放置于真空腔内,且位于光源焦点前方,以避免激光过强损伤窗片。硅片表面的激光光斑大小通过光学成像CCD来监测确定。通过控制硅片和激光焦点之间的距离,始终保持样品表面处光斑的直径大小约为300 μm。为实现激光功率和脉冲数的可调性,在腔前还放置了可调衰减片和脉冲计数器。
3.2 实验结果及讨论
在背景气体SF6气压为500 Torr(注:1 Torr=1 mmHg=133.322 Pa)时,我们研究了随800 nm和400 nm激光功率的变化,激光强度、脉冲数以及它们的比例关系与产生的不同表面形貌硅的依赖关系。对应的硅表面上形成的平均尖峰高度的变化如图6所示。
3.2.1 激光功率与激光波长的关系

图6 波长(a)800 nm和(b)400 nm的激光光源蚀刻硅材料表面:(a1和b1)分别给出当脉冲数固定为1 000时,硅的平均峰高与激光功率之间的关系;(a2和b2)分别给出当800 nm与400 nm激光光源的功率分别为400 mW和200 mW时,平均峰高与脉冲数之间的关系;(a3和b3)给出在相同的激光通量2.8 kJ/m2下,激光功率与脉冲数的不同比例关系与微结构硅的平均尖峰高度之间的关系
在实验中,脉冲数均固定为1 000,改变激光功率观测微结构平均峰值高度的变化。从图6(a1)和6(b1)我们可以看到,800 nm和400 nm激光脉冲所蚀刻的硅微观结构在峰高上有类似的变化趋势,即尖峰高度随脉冲能量的升高而先升高后降低。已经知道,微观结构形成的整个过程可以分为三个阶段[45]:首先,入射光和初始类似镜面的硅表面的反射光之间的干涉,导致能量在硅表面的不均匀沉积。当入射能量超过硅材料烧蚀和熔化的阈值,将在非均匀的深度产生烧蚀和熔化,由此产生以激光波长为周期的张力波;其次,随着烧蚀和熔化时间的增加,这些张力波逐渐成为波纹图样,然后变为准周期阵列的水滴状;最后,水滴边缘的物质继续烧蚀,形成锥形的微观结构。因此,通过适当增加激光的能量,可促进水滴边缘材料的烧蚀,继而形成更高的锥形结构。
此外,从另一个角度可以看到,激光照射在硅表面,如果每个脉冲的能量均被样品有效吸收,那么硅表面的能量密度将为最大,然后逐渐向深层降低。该密度分布导致顶层烧蚀剥离以及下面的材料熔化。在这个过程中,脉冲数代表激光与硅之间的反应时间,这就决定了能量能够导入到材料内部的深度,而激光功率决定了硅表面材料的烧蚀和挥发程度。因此,对于固定的脉冲数,单位时间内转移到材料内部的能量是固定的。如果激光的能量非常大,激光能量无法全部导入到硅材料的深层,有一部分能量可能会累积在硅表面。当积累的能量达到阈值时,表面材料会烧蚀过度变成液态硅。从而导致在初始的几百个脉冲阶段,不能有效形成水滴状结构。但是随着时间的增加,能量逐渐导入材料内部,那么后期的激光脉冲可以再次产生锥形结构。纵观整个过程,前一部分脉冲对尖峰结构的形成并无贡献,也就意味着形成尖峰的有效脉冲个数减少了。因此,当脉冲数固定时,随着激光功率的增加,可以在尖峰高度随激光功率的变化曲线上观察到一个转折点。此外,当激光功率超过脉冲数的能量传输限制时,激光功率越高,能量来不及传导而导致的熔化效果会越明显,有效的脉冲数越少,平均峰高也就越低。图7为相应的扫描电子显微镜(SEM)照片。
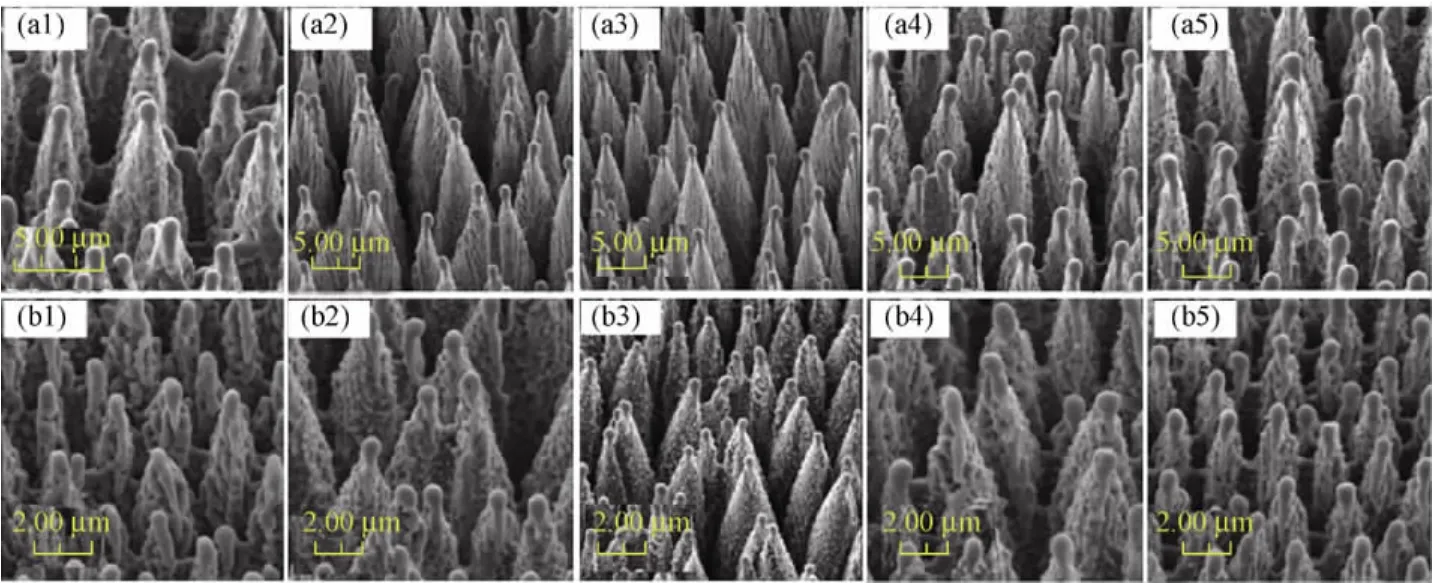
图7 脉冲数为1 000,波长为(a)800 nm 和(b)400 nm 的激光脉冲在不同激光功率(a1)400,(a2)1 000,(a3)1 400,(a4)1 800,(a5)2 000,(b1)50,(b2)125,(b3)175,(b4)275和(b5)325 mW 下,所形成的微结构硅材料的扫描电子显微镜图像。观察角度均为倾斜45°
通过比较由800 nm和400 nm的激光脉冲形成的两种微结构硅材料,如图6(a1)和6(b1),我们发现,在入射激光波长、激光功率和形成的峰高之间存在一个特殊关系:当800 nm的激光脉冲的能量是400 nm激光脉冲的8倍时,其形成的微结构硅材料的平均峰高为400 nm激光脉冲形成的3倍。我们认为这个有趣的现象也可以通过微结构形成的过程来分析。能量沉积不均匀形成以激光波长为周期的张力波,接着形成波纹图样、水滴的准周期阵列,以及随后形成锥形结构。在这些过程中,可以发现,圆锥尖峰形是由于波纹点间的微小空间的烧蚀和熔化产生的。根据激光辐照能量密度分布[46],每个小空间可以近似为一个圆锥体,则这些圆锥体的单位体积的能量可以写成:


另一方面,对于相同的硅材料形成的微结构,其烧蚀和熔化阈值应该是相同的。因此,对于两个波长不同的激光脉冲(JVλ=JVλ),当其单位体积的能量相同,并
12且超过烧蚀熔化阈值时,硅表面可以同时形成微结构。则式(1)可以写成:

这个方程式表明,如果不考虑其他因素影响,对于一定波长和吸收效率的激光脉冲,在辐射激光能量与形成峰高之间有一个比例关系。利用这个确定的比例关系,可以预测不同波长下的激光脉冲形成的峰高。实验中,我们用800 nm和400 nm激光脉冲来形成微结构的硅材料。因此,通过代入参数,A800≈60%,A400≈40%[39],R800=2R400,则式(2)可以写成:

其中,J800和J400分别表示800 nm 和400 nm 激光脉冲的入射能量,d800和d400分别表示800 nm和400 nm激光脉冲的穿透深度。由式(3)可证明,当800 nm激光脉冲的能量是400 nm激光脉冲能量的8倍时,所形成的平均峰高将为400 nm的3倍。此数值分析与我们的实验结果非常吻合[49]。
3.2.2 脉冲数与激光波长的关系
用800 nm和400 nm激光脉冲在硅材料表面蚀刻,所形成的峰高变化的平均值与脉冲数也将构成一个函数关系,如图6(a2)和图6(b2)所示。我们可以看到,800 nm激光脉冲所形成的平均峰高随着脉冲数的增加而单调增加,这是由硅表面微结构的形成机制决定的。我们知道,随着脉冲数的增加,激光和硅材料的相互作用时间也增加,并且更多的能量导入到材料内部,这会导致表面以下的材料熔化,促进形成锥形尖峰[46]。因此,峰高随着脉冲数的增加而单调增加。对于400 nm激光脉冲,不同的是,其形成峰高与脉冲数之间构成一个非线性关系。通过对比800 nm的激光脉冲,400 nm激光脉冲蚀刻尖峰的形成过程可以分为两阶段:当脉冲数小于1 000时,峰高的增长速度更快些;当脉冲数大于1 000时,其增长速度将更慢些。
至于使用400 nm激光脉冲形成尖峰的第一阶段,我们推测其原因是在硅材料内入射激光脉冲单位体积的能量与激光波长成反比关系[式(2)]。当激光脉冲入射到硅材料表面,能量被硅材料吸收并聚集在一个锥形区域。对于波长较短的激光脉冲,其锥形区域更小,因此更容易达到烧蚀和熔化阈值并且形成尖峰微观结构的速度越快。
至于第二阶段,我们通常认为,当光照射到锥形微结构上时,光被尖峰斜边和顶上的球反射进尖峰之间的峰谷,提高了入射光通量和烧蚀速率[46];然后,尖峰可变得更加锐利,并且尖峰高度也相应地增加。正如在第一部分所讨论的,分布能量的体积与激光波长的三次方成反比[式(2)],因此,400 nm激光脉冲蚀刻得到的微结构硅材料的谷间烧蚀速度会比800 nm激光脉冲的慢。当尖峰有效形成之后,400 nm激光脉冲的峰高增长的速率将比800 nm的激光脉冲的慢,与我们实验中所用的脉冲数超过1 000时的情况相吻合。
3.3.3 相同激光通量下激光功率和脉冲数的比例关系与激光波长的关系
激光通量Φ的表达式可以写为Φ=(P·t)/S=(P·m)/(f·S),其中,P为激光平均功率,t为激光脉冲的作用时间,S为照射在硅表面的激光光斑面积,m为入射到硅表面的脉冲数目,f为激光的重复频率,即激光通量的数值正比于功率和脉冲数两者的乘积。此式表明激光通量与激光功率和脉冲数成正比。此外,根据上面的讨论,我们知道,无论激光功率还是脉冲数,都可以有效地影响硅表面微结构的形成。然而,决定硅材料的表面形貌和吸收属性的主要因素是激光功率还是脉冲数,仍然不能确定。因此,我们在相同的激光通量2.8 kJ/m2下,按照不同激光功率和脉冲数的组合蚀刻硅表面,测量和分析结果如图6(a3)和图6(b3),相应的硅表面微结构SEM图见图8。显然可以看出,当激光功率在不超过600 mW的情况下,随着激光功率增加,脉冲数减少,尖峰高度和尖峰间隔逐渐增加。当激光功率超过800 mW时,在激光脉冲刻蚀区域的中央部分出现了一个平坦的区域[图8(a2)]。当增大激光功率并且进一步降低脉冲数时,平坦的区域范围逐渐增大,然后在激光功率为1 200 mW,脉冲数为167时平坦区域达到最大[图8(a3)]。有趣的是,在相同的激光通量下,当激光功率大于1 200 mW,并且脉冲数小于167时,平坦区域范围逐步缩小并最终在激光功率为1 800 mW和脉冲数为111时消失[图8(a4)]。
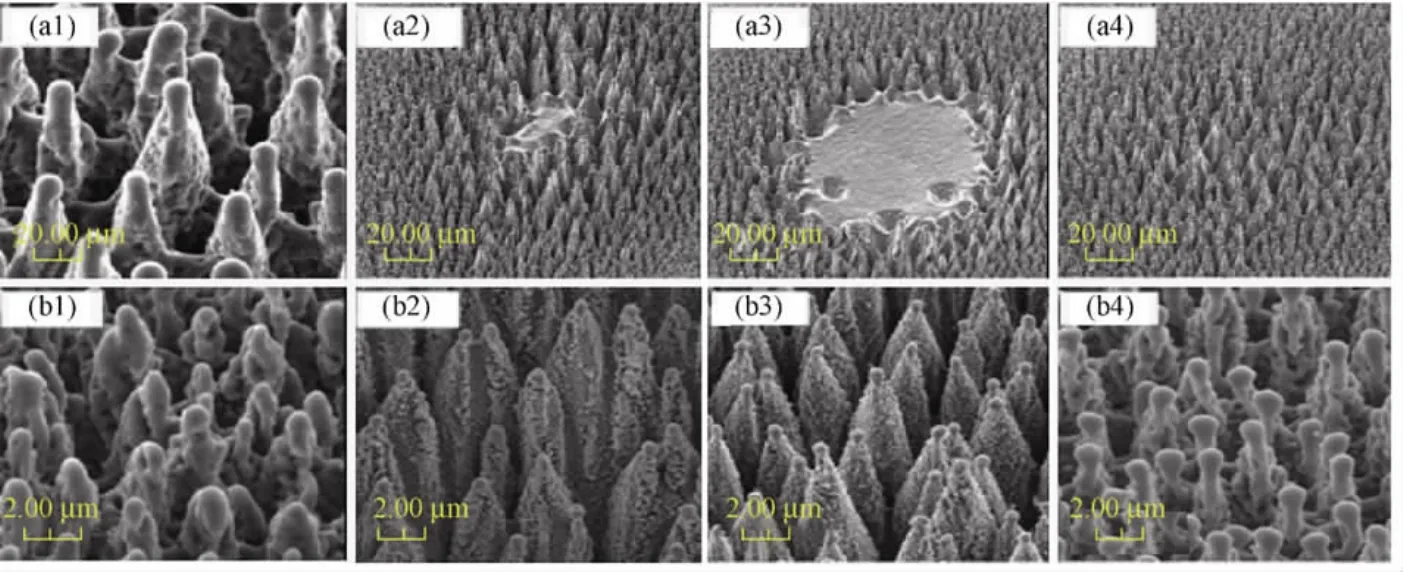
图8 波长(a)800 nm 和(b)400 nm 的激光光源蚀刻硅表面,在相同激光通量下(2.8 kJ/m2);SEM 所观察到的硅表面微结构图。观察角度均为倾斜45°。(a1)功率400 mW,脉冲数500;(a2)功率800 mW,脉冲数250;(a3)功率1 200 mW,脉冲数167;(a4)功率1 800 mW,脉冲数111;(b1)功率50 mW,脉冲数4 000;(b2)功率100 mW,脉冲数2 000;(b3)功率200 mW,脉冲数1 000;(b4)功率300 mW,脉冲数667
从硅表面微结构的形成过程中,我们知道,脉冲数表征激光和硅材料相互反应的时间,这就决定了能量能够转移到材料内部的深度;而激光功率决定了硅表面材料的烧蚀度和挥发度。只有合适的烧蚀和足够的相互作用时间才可以形成高尖峰的微结构。因此,在相同的激光通量下,我们在实验中观察到的现象可以从两个方面理解:第一,脉冲的数量足够大时,激光能量可以及时转移到硅材料内部;因此,在对表面材料的激光烧蚀和挥发作用下,可以有效形成尖峰,并且尖峰高度可以随着激光功率的增加而增加。第二,如果脉冲数不足,则难以将所有的能量导入硅材料内部,部分能量将积累在表面上;由于积累的能量仍然可以熔化表面附近的材料,则在硅表面上也能观察到一些平坦的区域。当脉冲数减少到一定值,熔化的量很少,则平坦的区域将再次消失。同时,脉冲数的下降也引起尖峰高度的下降。
在如图8的实验中,根据上述的讨论,只有在激光功率不变的情况下只增加脉冲数,积聚在硅表面的能量才能被很好地导入到材料内部,从而平坦区域消失并且尖峰高度比相同的激光功率下脉冲数较少时蚀刻的尖峰高度高。如果激光功率很高并且脉冲数过多,则材料可能因过度烧蚀而挥发,这可能会在蚀刻区域形成一个大洞。为了证明这一点,我们做了相应的实验,结果如图9所示。在800 nm激光脉冲的情况下,以激光功率为1 000 mW 为例:当脉冲数从167增加到1 000的过程中,平坦的区域完全消失[图9(a1)和9(a2)]。这直接证明了脉冲数影响能量转移的深度,进而决定了硅表面上形成微结构的形态。另一方面,当脉冲数增加到4 000,超过了可以转移到材料内部的最大能量,高的激光功率导致材料表面的不断烧蚀和挥发,最终在蚀刻区域形成一个洞[图9(a3)]。作为对比,对于400 nm的激光脉冲,激光功率选200 mW,当脉冲数从1 000增加到2 000的过程中,平均尖峰高度增加。当脉冲数增加至6 000时,由于过度烧蚀和挥发,类似的孔再次出现。考虑所有这些实验的结果,可以得出这样的结论,在激光功率和脉冲数之间存在着一种最理想的比例关系,以形成微结构表面的硅材料[50]。

图9 波长(a)800 nm 和(b)400 nm 的激光光源,对应的激光功率分别为1 000 mW 和200 mW,在不同脉冲数(a1)167,(a2)1 000,(3)4 000,(b1)1 000,(b2)2 000,(b3)6 000下蚀刻硅材料,用SEM所观察到的硅表面微结构图。观察角度均为倾斜45°
为证明脉冲激光功率和脉冲数的比例关系对于硅微结构的光吸收能力的影响,我们测量了在各种激光功率和脉冲数的不同组合下蚀刻的样品的吸收率(Lambda 750S,PerkinElmer)[51],如图10所示。可以看到,由激光功率与脉冲数的不同组合所制备的微结构硅材料,其光吸收能力也有所不同,其中平均峰值最高的材料对应的吸收效率也最高。这一结果进一步证明在相同激光通量下,恰当地选择激光功率和脉冲数能有效形成表面具有较高峰值高度的微结构硅,从而有利于高吸收效率的微结构硅材料的获得[52]。
总的来说,本文通过实验,研究了两个波长800 nm和400 nm的激光脉冲在一系列的形成条件的变化范围内,包括激光功率、脉冲数和在相同激光通量下它们的比例关系,分别蚀刻出不同微结构的硅材料。实验证明:脉冲数表征激光与硅之间的作用时间长短,即能量传递到材料内部的深浅度;而激光功率表征硅表面材料的蚀刻烧蚀程度。此外,不同波长的激光脉冲有不同的能量沉积结构并且能量穿透的深度也不相同。基于这些,利用波长为800 nm和400 nm的激光脉冲蚀刻硅材料,在保持相同的激光通量下,分别通过改变激光功率、脉冲数以及它们的比例关系,所形成的微结构硅材料有类似的变化趋势,但是其微结构密度和平均尖峰高度都不相同。

图10 波长为(a)800 nm 和(b)400 nm 的入射飞秒激光脉冲,保持相同的激光通量,在激光功率和脉冲数的比例不同的组合下,形成的微结构硅材料的吸收效率曲线图
4 小结
光波段的负折射材料的应用会对高分辨成像、光通讯、高密度光存储、超大规模集成电路的光刻技术以及集成光学等领域产生深远的影响。负折射材料的出现,为人们提供控制光和电磁波行为的全新手段。利用飞秒激光脉冲分别与硅材料相互作用可以获得在宽光谱范围内均具有高吸收效率的黑硅材料,这一结果对表面微结构材料的有效制备、表面形态控制,及其相应的光电属性等都有着重要的意义,在太阳能电池等应用研究领域有着广泛的应用前景。
(2012年3月26日收到)
[1]VESELAGO V G.The electrodynamics of substances with simultaneously negative values of permittivity and permeability[J].Sov Phys Usp,1968,10:509-514.
[2]PENDRY J B,HOLDEN A J,STEWART W J,et al.Extremely low frequency plasmons in metallic mesostructures[J].Phys Rev Lett,1996,76:4773.
[3]PENDRY J B,HOLDEN A J,ROBBINS D J,et al.Magnetism from conductors and enhanced nonlinear phenomena[J].IEEE Transactions on Microwave Theory and Techniques,1999,47:2075-2084.
[4]PENDRY J B.Negative refraction makes a perfect lens[J].Phys Rev Lett,2000,85:3966-3969.
[5]WILLIAMS J M.Some problems with negative refraction[J].Phys Rev Lett,2001,87:249703(4).
[6]GARCIA N,NIETO-VESPERINAS M.Left-handed materials do not make a perfect lens[J].Phys Rev Lett,2002,88:207403(4).
[7]SHEN J T,PLATZMAN P M.Near field imaging with negative dielectric constant lenses[J].Appl Phys Lett,2002,80:3286-3288.
[8]YE Z.Optical transmission and reflection of perfect lenses by left handed materials[J].Phys Rev B,2003,67:193106.
[9]TAUBNERT,KOROBKIN D,URZHUMOV Y,et al.Nearfield microscopy through a SiC superlens[J].Science,2006,313:1595.
[10]LARKIN I A,STOCKMAN M I.Imperfect perfect lens[J].Nano Lett,2005,5:339-343.
[11]SMITH D R,PADILLA W J,VIER D C,et al.Composite medium with simultaneously negative permeability and permittivity[J].Phys Rev Lett,2000,84:4184-4187.
[12]SHELBY R A,SMITH D R,SCHULTZ S.Experimental verification of a negative index of refraction [J].Science,2001,292:77-79.
[13]PARAZZOLI C G,GREEGOR R B,LI K,et al.Experimental verification and simulation of negative index of refraction using Snell’s law [J].Phys Rev Lett,2003,90:107401(4).
[14]HOUCK A A,BROCK J B,CHUANG I L.Experimental observations of a left-handed material that obeys Snell’s law[J].Phys Rev Lett,2003,90(13):137401(4).
[15]LEONG K M K H,LAI A,ITOH T.Demonstration of reverse Doppler effect using a left-handed transmission line[J].Micro Optic Tech Lett,2006,48(3):545-547.
[16]KOZYREV A B,VAN DER WEIDE D W.Explanation of the inverse Doppler effect observed in nonlinear transmission lines[J].Phys Rev Lett,2005,94:203902.
[17]LUO C,IBANESCU M,REED E J,et al.Doppler radiation emitted by an oscillating dipole moving inside a photonic band-Gap crystal[J].Phys Rev Lett,2006,96:043903
[18]KATS A V,SAVEL’EV S,YAMPOL’SKII V A,et al.Lefthanded interfaces for electromagnetic surface waves [J].Phys Rev Lett,2007,98:073901.
[19]SEDDON N,BEARPARK T.Observation of the inverse Doppler effect[J].Science,2003,302:1537-1540.
[20]HU X,HANG Z,LI J,et al.Anomalous Doppler effects in photonic band gaps[J].Phys Rev E,2006,73:015602.
[21]REED E J,SOLJACIC M,IBANESCU M,et al.Comment on“Observation of the inverse Doppler effect”[J].Science,2004,305:778b.
[22]KOZYREV A B,VAN DER WEIDE D W.Explanation of the inverse Doppler effect observed in nonlinear transmission lines[J].Phys Rev Lett,2005,94:203902.
[23]REED E J,SOLJACIC M,JOANNOPOULOS J D.Comment on“Explanation of the inverse Doppler effect observed in nonlinear transmission lines”[J].Phys Rev Lett,2006,96:069402.
[24]NOTOMI M.Theory of light propagation in strongly modulated photonic crystals:refractionlike behavior in the vicinity of the photonic band gap[J].Phys Rev B,2000,62:10696-10705.
[25]LUO C,JOHNSON S G,JOANNOPOULOS J D,et al.Allangle negative refraction without negative effective index[J].Phys Rev B,2002,65:201104(4).
[26]CHEN J B,WANG Y,JIA B H,et al.Observation of the inverse Doppler effect in negative-index materials at optical frequencies[J].Nature Photonics,2011,5:239-245.
[27]JOHNSON S G,FAN S H,VILLENEUVE P R,et al.Guided modes in photonic crystal slabs [J].Phys Rev B,1999,60:5751-5758.
[28]SФNDERGAARD T,BJARKLEV A,KRISTENSEN M,et al.Designing finite-height two-dimensional photonic crystal waveguides[J].App Phys Lett,2000,77(6):785-787.
[29]HER T,FINLAY R J,WU C,et al.Microstructuring of silicon with femtosecond laser pulses[J].Appl Phys Lett,1998,73(12):1673-1675.
[30]STUBENRAUCH M,FISCHER M,KREMIN C,et al.Black silicon—new functionalities in microsystems[J].J Micromech Microeng,2006,16,S82-S87.
[31]SERPENGÜZEL A,KURT A,INANÇI,et al.Luminescence of black silicon[J].Journal of Nanophotonics,2008,2:021770.
[32]YOUNKIN R,CAREY J E,MAZUR E,et al.Infrared absorption by conical silicon microstructures made in a variety of background gases using femtosecond-laser pulses [J].J Appl Phys,2003,93(5):2626-2629.
[33]YUAN H,YOST V E,PAGE M R,et al.Efficient black silicon solar cell with a density-graded nanoporous surface:optical properties,performance limitations,and design rules[J].Appl Phys Lett,2009,95(12):123501.
[34]HOYER P,THEUER M,BEIGANG R,et al.Terahertz emission from black silicon[J].Appl Phys Lett,2008,93(9):091106.
[35]HUANG Z,CAREY J E,LIU M,et al.Microstructured silicon photodetector[J].Appl Phys Lett,2006,89(3):033506.
[36]BRANZ H M,YOST V E,WARD S,et al.Nanostructured black silicon and the optical reflectance of graded-density surfaces[J].Appl Phys Lett,2009,94(23):231121.
[37]MALONEY P G,SMITH P,KING V,et al.Emissivity of microstructured silicon [J].Appl Opt,2010,49(7):1065-1068.
[38]MYERS R A,FARRELL R,KARGER A M,et al.Enhancing near-infrared avalanche photodiode performance by femtosecond laser microstructuring [J].Appl Opt,2006,45(35):8825-8831.
[39]CROUCH C H,CAREY J E,SHEN M,et al.Infrared absorption by sulfur-doped silicon formed by femtosecond laser irradiation[J].Appl Phys A,2004,79(7):1635-1641.
[40]PENG Y,WEN Y,ZHANG D S,et al.Optimal proportional relation between laser power and pulse number for the fabrication of surface-microstructured silicon [J].Appl Opt,2011,50(24):4765-4768.
[41]CROUCH C H,CAREY J E,WARRENDER J M,et al.Comparison of structure and properties of femtosecond and nanosecond laser-structured silicon [J].Appl Phys Lett,2004,84(11):1850-1852.
[42]ZORBA V,BOUKOS N,ZERGIOTI I,et al.Ultraviolet femtosecond,picosecond and nanosecond laser microstructuring of silicon:structural and optical properties [J].Appl Opt,2008,47(11):1846-1850.
[43]ZHU J,SHEN Y,LI W,et al.Effect of polarization on femtosecond laser pulses structuring silicon surface[J].Appl Surf Sci,2006,252:2752-2756.
[44]FOWLKES J D,PEDRAZA A J,LOWNDES D H.Microstructural evolution of laser-exposed silicon targets in SF6 atmospheres[J].Appl Phys Lett,2000,77(11):1629-1631.
[45]SHEN M Y,CROUCH C H,CAREY J E,et al.Femtosecond laser-induced formation of submicrometer spikes on silicon in water[J].Appl Phys Lett,2004,85(23):5694-5696.
[46]SHEEHY M A,WINSTON L,CAREY J E,et al.Role of the background gas in the morphology and optical properties of laser-microstructured silicon [J].Chem Mater,2005,17(14):3582-3586.
[47]TULL B R,CAREY J E,MAZUR E,et al.Silicon surface morphologies after femtosecond laser irradiation [J].Mrs Bulletin,2006,31:626-633.
[48]DASH W C,NEWMAN R.Surface barrier analysis for metals by means of Schottky deviations[J].Phys Rev,1955,99(4):1151-1160.
[49]SARITAS M,MCKELL H D.Absorption coefficient of Si in the wavelength region between 0.80-1.16μm [J].J Appl Phys,2001,61(10):4923-4925.
[50]PENG Y,ZHANG D S,CHEN H Y,et al.Optimal proportional relation between laser power and pulse number for the fabrication of surface-microstructured silicon[J].Appl Opt,2012,51(5):635-639.
[51]WU C,CROUCH C H,ZHAO L,et al.Near-unity belowband-gap absorption by microstructured silicon [J].Appl Phys Lett,2001,78(13):1850-1852.
[52]彭滟,温雅,张冬生,等.飞秒激光功率与脉冲数的比例关系对制备硅表面微结构的影响 [J].中国激光,2011,38(12):1203005.
Research on Subwavelength Micro-nano Optics(Ⅰ)
ZHUANG Song-lin①, WANG Qi②,ZHU Yiming③,GENG Tao④,ZHANG Da-wei⑤
①CAEMember,②Ph.D.,③⑤Professor,④AssociateProfessor,EngineeringResearchCenterofOpticalInstrumentandSystem,Ministry ofEducation;ShanghaiKeyLabofModernOpticalSystem;Schoolof Optical-ElectricalandComputerEngineering,UniversityofShanghaifor ScienceandTechnology,Shanghai200093,China
Materials and structures in micro and nano scale present many new characteristics different from the macroscopic scale.Micro-nano processing technology has been one of the most popular fields in the current scientific research and industrial development.The preparation and special characteristics of negative refractive material and black silicon are introduced.Micro-nano optical devices play important role in new technology and broad prospects of science and technology innovation.
negative refractive,inverse Doppler effect,black silicon
10.3969/j.issn.0253-9608.2012.04.001
(编辑:沈美芳)
