0.5μm有源区腐蚀工艺的正交优化
2010-09-05秦永伟赵金茹王春栋
秦永伟,赵金茹,王春栋,李 俊
(中国电子科技集团公司第58研究所,江苏 无锡 214035)
0.5μm有源区腐蚀工艺的正交优化
秦永伟,赵金茹,王春栋,李 俊
(中国电子科技集团公司第58研究所,江苏 无锡 214035)
文章基于Precision 5000等离子刻蚀技术,运用正交优化实验法,控制由LPCVD制备的Si3N4膜层对SiO2的选择比,对0.5 μm有源区腐蚀工艺进行优化。运用minitab软件获得选择比的主效应图、效应的Pareto图、正态概率图,并讨论O2、Ar、CHF3气体对选择比的影响,最终获得各气体成分的最佳配比。实验结果表明有源区腐蚀中通过提高过腐蚀中Si3N4对SiO2的选择比来减少SiO2的损失,可以成功地将SiO2的损失控制在合理范围内,且腐蚀后平面、剖面形貌等各种参数符合产品要求。
选择比;有源区腐蚀;正交优化实验法
1 引言
随着器件尺寸的不断缩小,对等离子体刻蚀技术提出了更高的挑战。本文采用Precision 5000设备腐蚀有源区,主腐蚀步(ME)采用终点检测系统来控制Si3N4腐蚀过程,当Si3N4下面一层材料SiO2刚好露出来时,Si3N4便停止腐蚀。理想情况下,要腐蚀的薄膜厚度和腐蚀速率均是完全均匀的,并不需要过腐蚀步(OE),所以相对于衬底的选择比也就不用考虑了。实际工艺中这种理想状态是不存在的,并且当各向异性腐蚀遇到台阶形貌时,过腐蚀步总是需要的,但是有源区过腐蚀中Si3N4相对于SiO2的选择比必须足够大,从而避免底层的氧化物被完全刻蚀,避免Si衬底受到实质性刻蚀。因为过度的刻蚀硅衬底,将会影响整个器件的性能。本文针对有源区腐蚀后剩余SiO2一直为零的问题,运用正交优化实验法对Si3N4腐蚀的过腐工艺进行优化,使Si3N4下层材料SiO2损失控制在15nm以内,且剖面形貌合格(α>75°),如图1。
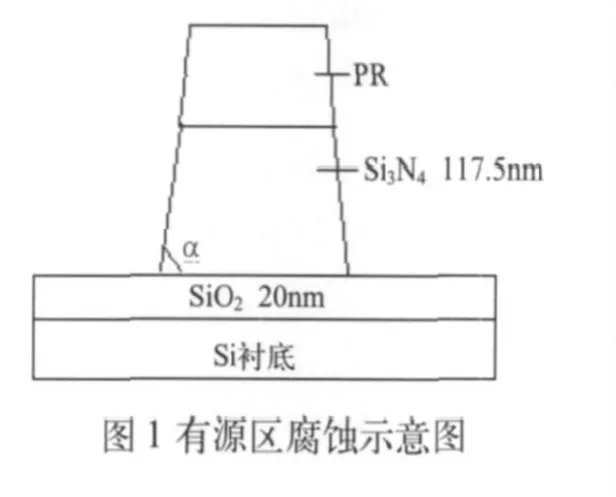
2 反应离子刻蚀(RIE)原理
Si3N4是一种优质的电介质材料,通常以LPCVD或PECVD制得,作为氧化隔离介质或铝钝化层。刻蚀Si3N4的气体很多,通常能产生F、CL活性机的气体都可以刻蚀Si3N4。主要以CF4或CHF3作为典型的F离子源。同时F离子也是刻蚀SiO2的主要气体成分,因此以F离子源刻蚀Si3N4的选择比通常比较低。表1列举了由这些气体产生的等离子体进行刻蚀时有代表性的气体及材料。

本文主要研究以CHF3作为F的等离子体气体源来刻蚀Si3N4膜层,其中Ar主要用于溅射刻蚀(即通过碰撞产生刻蚀作用),Ar同时也起到气体稀释、增加碰撞几率的作用。本实验通过调节O2、Ar、CHF3的气体比例,来控制由LPCVD制备的Si3N4膜层对SiO2的选择比, 刻蚀机理反应方程式如下:

其中O2和SiO2分解出来的氧等离子体在高压下与基团反应,生成CO↑、CO2↑、H2O↑、OF↑等多种挥发性气体,从而完成表面刻蚀。
3 实验过程
本实验在原来过腐蚀(OE)菜单基础上进行优化,主腐蚀步骤不做改变,仍然采用终点检测系统自动找终点。
原来过腐蚀(OE)菜单为:
Press:60 mtorr;RF:250 W;CHF3:12 sccm;Ar:45 sccm;O2:5 sccm。
Si3N4速率为109.4nm/min,SiO2速率为63.06nm/min,故Si3N4对SiO2的选择比为1.73。其中压力和功率不做改变,通过正交优化试验,拉偏过腐蚀步(OE)中的Ar、CHF3、O2配比,提高Si3N4对SiO2的选择比。
现在采用Minitab软件进行实验设计,本文中采用的3因子2水平的正交实验,共进行4次试验,考察Ar、CHF3、O2的流量对选择比的贡献(本实验中所指选择比都是指Si3N4对SiO2选择比),如表2所示。根据Minitab给出的实验设计进行实验,实验数据结果见表3。

由Minitab工具进行数据分析,选择比作为反应值,得出选择比的主效应图、效应的Pareto图、正态概率图,最后由Minitab生成最优条件筛选图。
图2为选择比的主效应图,其中纵坐标为输出力矩,横坐标为所设计实验的各因子水平,其中倾斜度越大表示符合水准的效果越大。从图2中可以明显看出,氧气的流量从5sccm升高到10sccm时,氮化硅对二氧化硅的选择比迅速上升;当氩气流量增加时,选择比增加较为平缓;而当三氟甲烷流量增加时,选择比反而降低。
图3为效应的pareto图,Pareto图可同时看到效果的大小与重要性。超过指针线(即图中虚线)的C因子为有影响,即氧气的流量对选择比影响最大。
图4为正态概率图,离直线远离的因子可认为信号因子,从图中可以看出C因子O2对选择比有较大的影响,而其他因子对选择比影响较小。

图5为最优条件筛选图,由Minitab软件自动筛选的最优条件为:Ar:45sccm;CHF3:12sccm;O2:10sccm。这里的最优条件主要以选择比作为标准。

以图5获得的选择比最优条件作为实验条件,获得实验结果为:二氧化硅腐蚀速率48.64nm/min;氮化硅腐蚀速率130.24nm/min;氮化硅对二氧化硅的选择比为2.68。
最优化实验结果与原菜单工艺结果相比,选择比由原来的1.73提高到2.68,按照优化后的工艺进行正片工艺验证,OE时间定为8s,重复做4片,损失的二氧化硅平均值为8nm,符合二氧化硅损失要求(<15nm)。

CD loss=0.6028-0.5764=0.026nm,CD Loss合格。
图6、7为采用最优化条件进行实验的SEM平面及剖面图,采用优化实验做出的有源区条平面图形光滑无锯齿状,剖面形貌正常,角度为85.2°,无倒角。

4 结论
本文采用DOE实验,用最少的实验次数获得了最多的信息量。实验结果表明,Si3N4对SiO2的选择比受O2的流量影响最大。同时运用MINTIB软件获得最优化条件,得到了Ar、CHF3、O2的最佳配比。实验验证结果良好,选择比得到较大的提高,有源区腐蚀中SiO2损失可以控制在合理范围内,且平面、剖面形貌等各种参数符合产品要求。这对以后半导体产品良率的提升具有一定的参考价值。
[1]Wang Chundong, Teng Baohua , Zhang Xianjun, et al. Investigation of the seeding-layer effect for a ferroelectric thin film with the transverse Ising model [J]. Physica A,2009, 388∶ 1472-1478.
[2]Michael Quirk, Julian Serda. 韩郑生等译. 半导体制造技术[M].北京:电子工业出版社,2004.
[3]施敏. 半导体期间物理与工艺[M].苏州:苏州大学出版社,2002.
[4]崔铮. 微纳米加工技术及其应用[M].北京:高等教育出版社,2005.
Study of the Etching Technology in 0.5 Micro-island with Orthogonal Optimization Method
QING Yong-wei, ZHAO Jing-ru, WANG Chun-dong, LI Jun
(China Electronic Technology Group Corporation No.58Research Institute,Wuxi214035,China)
Based on the plasma etching technology in Precision 5000, by controlling the selecitivity between Si3N4(which was prepared by LPCVD) and SiO2, the etching technology in 0.5 micro-island was optimized with the help of the orthogonal optimization method. Using the software of Mintab,the main effect figure, the Pareto effect figure and the normal-probability effect figure were got. Meanwhile the influence of O2,Ar,CHF3to the selecitivity was investigated. The most suitable proportion of all the gases was found. The results show that the loss of SiO2can be sucessful controlled by improving the selecitivity between Si3N4and SiO2. In addition, the plane and the profile of Si3N4are all accord with the standard.
selecitivity; etching of island; orthogonal optimization method
TN305.7
A
1681-1070(2010)09-0038-03
2010-07-12

秦永伟(1981-),男,河北唐山人,2004年毕业于杭州电子科技大学,现为中国电子科技集团第58研究所二部设备维修工程师,主要从事设备维修和协助工艺研究及开发工作;
赵金茹(1983-),女,辽宁海城人,2006年毕业于辽宁大学,现为中国电子科技集团第58研究所二部腐蚀组工艺工程师,主要从事腐蚀工艺研究开发工作。
