倒装焊器件的密封技术
2010-09-05李欣燕李秀林丁荣峥
李欣燕,李秀林,丁荣峥
(无锡中微高科电子有限公司,江苏 无锡 214035)
倒装焊器件的密封技术
李欣燕,李秀林,丁荣峥
(无锡中微高科电子有限公司,江苏 无锡 214035)
倒装焊的底部填充属非气密性封装,并且受倒装焊凸点焊料熔点、底部填充有机材料耐温限制,使得倒装焊器件的密封结构设计和工艺设计受限。文章结合气密性器件使用要求,设计了两种不改变现行倒装焊器件制造工艺、器件总体结构[3]的密封技术,经过分析论证以及工艺实验,确认其是可行的。密封的器件能够满足MIL-883G中有关气密性、内部水汽含量、耐腐蚀(盐雾)、耐湿以及机械试验等[6~7],密封结构、密封工艺均是在现有封装工艺条件基础上进行,具有非常强的可行性。
倒装焊;气密性;陶瓷外壳;平行缝焊;合金焊料熔封;可靠性
1 前言
随着器件向多功能、高性能、薄型化、小型化、轻量化的方向发展,器件I/O端数增加的同时也向更高密度封装发展。倒装焊是其中的重要关键技术之一,特别是在硅通孔(TSV)工艺成熟前是大家最愿意采用的封装工艺技术,包括叠层倒装焊,参见图1[1,2,4,5]。现见到报道的倒装焊陶瓷封装工艺均采用非气密性的,如Power PC系列电路,参见图2。底部填充材料具有一定的吸湿性,具有与塑料封装中TBGA等相似的“爆米花”失效现象,另外底部填充材料并不能有效阻挡离子等的扩散,这就使倒装焊器件与现采用的气密性陶瓷封装器件在耐恶劣环境方面存在一定的差距,为了满足器件耐恶劣环境并具备长寿命的要求,必须开发气密性封装的倒装焊密封技术。
由于无铅化焊料凸点熔点较低(通常在230℃左右),即使是Sn5Pb95焊料也仅在310℃左右,加上倒装焊底部填充料玻璃转化温度低且在高温度下易分解,以及芯片硅材料的热膨胀系数(常温400℃,~3.6×10-6/℃)与HTCC / LTCC陶瓷的热膨胀系数存在较大的差异(90%Al2O3陶瓷,常温400℃,~6.8×10-6/℃;LTCC则从5.4~12.3×10-6/℃均有),要求密封工艺使倒装焊器件的温升要尽可能地低,现行在陶瓷封装中采用的玻璃熔封、Au80Sn20合金焊料熔封等密封工艺就不能直接使用,因为倒装焊底部填充材料的玻璃转化温度Tg低且材料在熔封过程中将产生热分解等,会导致倒装焊互连接触电阻增大甚至失效。
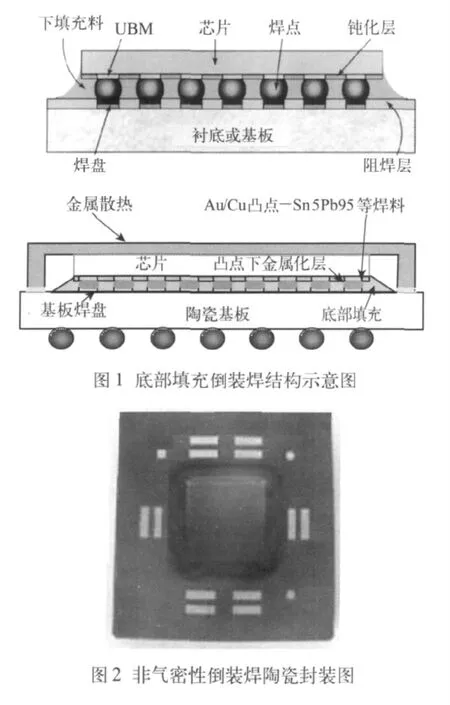
2 密封工艺技术
气密性电子元器件通常是空封的,气密性封口就是通过某种方式——如贮能焊、平行缝焊、激光焊、加热熔封(如合金焊料、玻璃)以及冷挤压等——将用于组装的开口密封起来的过程。采用有机胶等粘封的封口虽能通过气密性检查(测试参数合格),但其与塑料封装电路一样是非气密性封装,离子、水汽等可以通过界面、有机分子间的间隙进行扩散渗透。气密性封装是指使用对气、水等抗渗透性强的金属、陶瓷、玻璃作结构材料,将需要保护的器件密封在一个受控的环境中。气密性封装的器件所能适应的使用环境更广,常用于工作环境恶劣、可靠性要求高的器件以及器件性能受环境(如气压)影响大的器件的封装。气密性封帽是指气密性封装的最后一道封口工序,是气密性封装的关键工序。高可靠电子元器件气密性封帽工艺常采用低温合金焊料熔封、平行缝焊、低温玻璃熔封、贮能焊、激光焊或冷挤压,密封结构、密封温度能与倒装焊器件相适应的是低温合金焊料熔封和平行缝焊;低温玻璃在高温下熔融并融合而形成密封,且密封温度远高于Au80Sn20等合金焊料,显然不适用。
常用的低温合金焊料有Au80Sn20共晶焊料和锡-银-铜等。封帽时通过对焊料加热使之熔化,熔化焊料将盖板/帽与外壳密封口融合密闭起来。Au80Sn20共晶焊料的熔点为280℃,封帽峰值温度在320℃左右,峰值温度保持时间在1min~2min。锡-银-铜等因内部气氛不佳使用受到一定的限制。
平行缝焊属电阻熔焊。它利用脉冲大电流通过焊接处高接触电阻所产生的热量,将盖板与焊环相接触的小区域熔接起来,局部熔接的温度在1000℃~1500℃,平行缝焊仅局部有温升,不需要对电子元器件进行整体加热,可防止某些电子元器件受高温后参数容易漂移甚至损坏、内部受到热冲击等,但平行缝焊过程中会使焊缝处镀层等受到破坏,焊缝处的抗盐雾耐腐蚀能力变弱。
3 倒装焊工艺
典型的倒装焊气密性封装工艺流程见图3。
倒装焊的基板材料有陶瓷、高质量多层树脂板和柔性基板,柔性基板主要应用于手机、显示器等方面,高质量多层树脂板则主要应用在FPGA、DSP等高引出端数的IC中,而陶瓷基板则主要应用在通讯基站等大型设备仪器中,以保证系统的可靠性。陶瓷基板具有更高热性能、更高的强度以及更强的耐受恶劣环境的能力,特别在受潮后的温度变化中表现出杰出的长期稳定性和高互连可靠性。
即使是陶瓷基板、硅芯片材料可以有非常好的气密性[8],但底部填充剂留下的细缝还是给潮气、离子等的扩散和迁移带来器件的质量隐患,使器件并不能适应海上、南方高温潮湿天气等恶劣条件下的长寿命(如10年)以及通讯卫星等使用的真空环境下(因气压低而导致材料膨胀使互连可靠性降低甚至失效),这就需要对使用在恶劣环境中的倒装焊封装进行气密性封装。

4 倒装焊器件的密封设计
气密性封装的密封腔或包裹,必须是气密性的金属-陶瓷-玻璃类材料,这些材料之间必须是原子连结,而不能采用任何有机材料进行粘接。
在进行气密性结构设计时,除需要考虑电性能之外,还需要考虑芯片的散热问题。倒装焊芯片(结)的热导出如图4所示。芯片(结)产生的热主要由三个途径散出:(1)通过芯片焊料凸点和底部填充剂向外壳、再由外壳并主要通过外壳上的焊球,再通过系统板向周围环境散热;(2)通过芯片向芯片衬底,传导到热沉或芯片底面,然后再向环境散热;(3)有热沉的,部分热还通过热沉向外壳传导,再由外壳向低温区散热。
对于功率密度或功率相对较大的器件,芯片背面的导热是必须的,芯片背面必须与热沉、散热片或冷板等接触,同时还需要保证倒装焊芯片的底部填充胶缝口被密封起来,我们设计了如图5所示的结构。对于功率不是很大同时又要保证有密封腔的,且在密封过程中不产生器件损伤、不引起底部填充的有机材料发生热分解、退化等问题,设计了图6和图7带腔的密封结构,分别采用了平行缝焊密封工艺和Au80Sn20焊料局部加热的密封工艺。前者对外壳制造要求多增加一道金属框钎焊工艺,后者则需要使用价格较高的Au80Sn20焊料,在生产成本上较高。
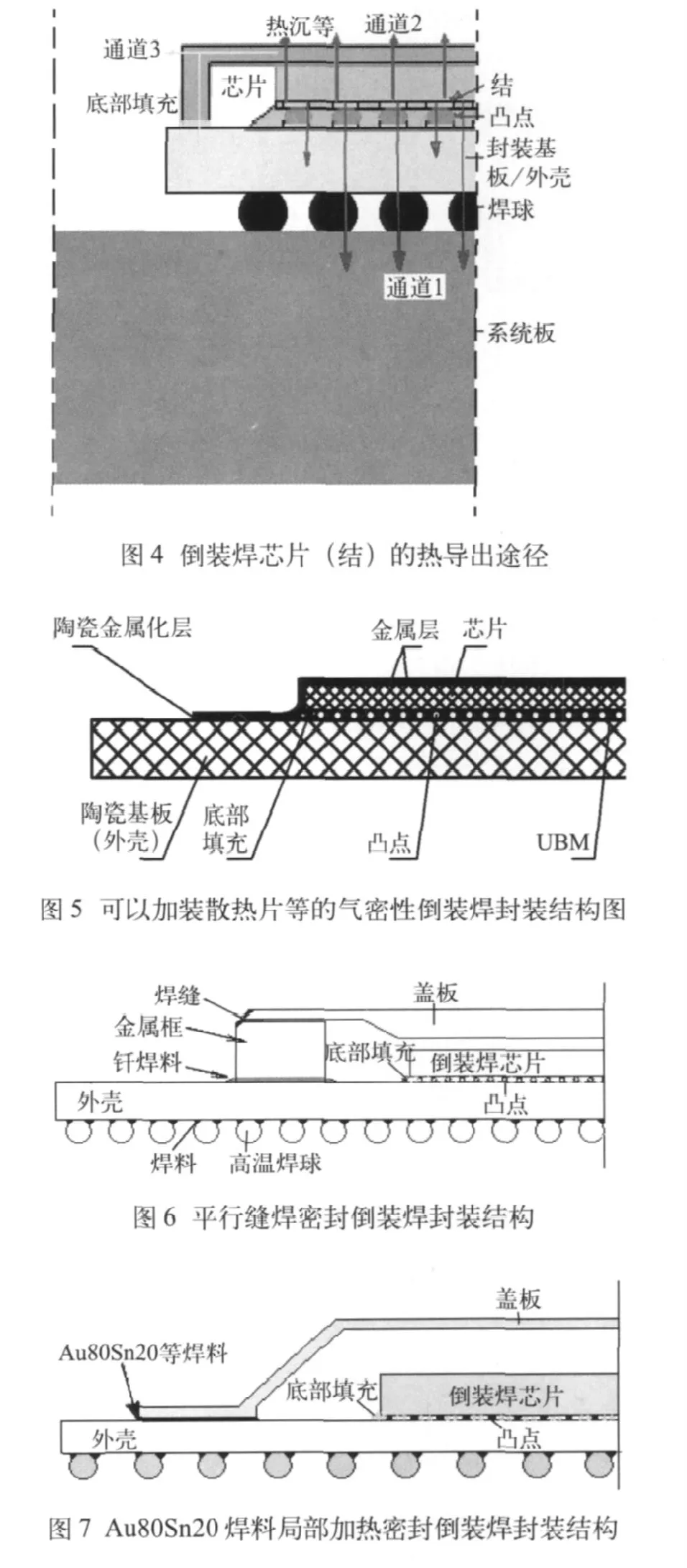
5 倒装焊密封器件气密性及成品率
根据设计,我们制作了平行缝焊、合金焊料熔封、金属直接覆盖密封3种倒装焊芯片密封的产品,见图8。3种产品均能通过依据MIL-883G 方法1014.12[6]、GJB548B方法1014.1[7]的氦质谱检漏、粗检漏。
将样品与常规的CDIP、CLCC、CSOP、CSOJ、CQFP、CQFJ、CPGA、CBGA等引线键合的气密性封装(平行缝焊、Au80Sn20合金熔封等)进行比测,其指标均与之相当。
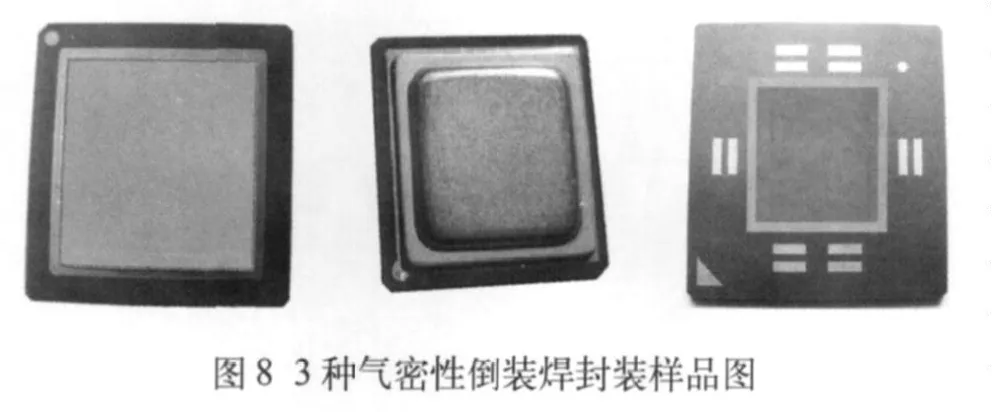
6 结束语
本文设计了两种气密性封装方案(三种工艺方式)均可行,且制作出合格产品,在进行具体IC封装设计时需要根据IC产品具体要求并结合IC使用做出合理选择,以使封装电路达到最优化。
气密性倒装焊将大幅度提升封装电路抗潮汽、离子渗透腐蚀等的能力,提升器件的可靠性,对海上潮湿等恶劣环境下使用的系统具有重要意义。气密性倒装焊封装还可用于空间通讯卫星、医疗等方面使用的IC封装,帮助其降低体积的同时提升器件的可靠性。
[1]李福泉,王青春,张晓东.倒装芯片凸点制作方法[J].电子工艺技术,2003,2(24):62-66.
[2]罗驰,练东.电镀技术在凸点制备工艺中的应用[J].微电子学,2006,4(36):467-472.
[3]任春岭,鲁凯.倒装焊技术及应用[J].电子与封装, 2009,4(5):13-15.
[4]Inagaki M.Solder bumping technology for flip chip application[Z].SECAP,2001.
[5]郭志扬,金娜,等.倒装焊凸点材料及焊盘金属化[J].微处理机,2002,2:20-22.
[6]MIL-STD-883G.Test methods and procedures for microelectronics[S].28 FEBRUARY 2006.
[7]GJB548B-2005.微电子器件试验方法和程序[S].中国人民解放军总装备部.
[8]Rao R. Tummala,等. 微电子封装手册(第二版)[M].北京:电子工业出版社,2001.
Hermetically Sealed Construction and Technology of Flip-chip Device
LI Xin-yan, LI Xiu-lin, DING Rong-zheng
(Wuxi Zhongwei High-tech Electronics Co., Ltd.,Wuxi 214035,China)
Flip-chip packaging of underfill was non-hermetic packaging. By the limit of organic material’s temperature resistance of underfill and bump material’s melting, flip-chip hermetic structure design and technology were restricted. In this paper, in base of hermetic device’s demand and existing flip-chip technology and structure,two types structure was designed. The structure was feasible by the process test and analysis. The hermetic packaging device satisfied the standard MIL-883G of air-tightness, water vapor content, corrosion (salt atmosphere), moisture resistance and mechanical test. Hermetic device and hermetic technology were feasible in the base of existing packaging technology.
flip chip; air-tightness; ceramic package; parallel seam welding; solder sealing; reliability
TN305.94
A
1681-1070(2010)09-0001-04
2010-06-18

李欣燕(1976-),女,助理工程师,现在无锡中微高科电子有限公司从事IC封装设计工作。
