基于CD-SEM的线距标准样片测量
2019-04-09冯亚南赵琳李锁印韩志国许晓青中国电子科技集团公司第十三研究所
冯亚南 赵琳 李锁印 韩志国 许晓青/中国电子科技集团公司第十三研究所
0 引言
在半导体、微电子和纳米制造领域中,线宽尺寸是衡量工艺水平的重要参数,在器件制作工艺过程中,线间距的使用非常广泛。并且随着器件特征尺寸的日益缩减,线条宽度变得越来越窄[1-2]。对各种线条宽度参数的精确、快速测定和控制,是保证器件质量、提高生产效率的重要手段。
微纳米线间距尺寸测量类仪器应用最广泛的是原子力显微镜(AFM)和扫描电镜(SEM)。AFM和SEM所获得图像的横向分辨力相近。AFM可真实地得到样品表面的形貌结构图像,图像是真正的三维图像,并能测量样品的三维信息。SEM只能提供二维图像,但其图像有很大的景深,视野较大[3]。实际使用时可根据测量需求选择合适仪器。扫描电镜(CD-SEM)是具有自动定位并测量线条功能的扫描电镜,广泛应用在半导体生产线,用于线条宽度的监控。
1 CD-SEM的测量原理
CD-SEM测量原理为:在高真空的环境下,通过电子枪加热产生热电子束,通过由电磁透镜所组成的电子光学系统,电子束会聚后在样品表面聚焦。在末级透镜上的扫描线圈作用下,电子束在样品表面进行扫描。高能电子束与样品相互作用产生二次电子置换,背反射电子,X射线等信号。这些信号分别被不同的接收器接收,经放大后用来调制荧光屏的亮度。电子束打到样品上一点时,在荧光屏上就有一亮点与之对应,其亮度与激发后的电子能量成正比。SEM是采用逐点成像的图像分解法进行的,光点成像的顺序是从左上方开始到右下方,直到最后一行右下方的像元扫描完毕就算完成一幅图像。来自样品表层(数纳米)的信号的二次电子(能量)较小,只有数十电子伏以下,它是SEM检测出的主要信号。图像被称为二次电子图像,它准确地反映样品表面的形貌(凹凸)特征,具有立体感的图像[3]。通过专业量测软件对需要量测的线条进行测量。测量原理如图1所示。该设备含有样片自动传输系统、自动调焦、图形自动对准、自动定点测量、量测数据自动保存并上传等先进功能。

图1 CD-SEM测量原理图
2 线距标准样片尺寸测量
本文采用扫描电镜(CD-SEM)对VLSI线距标准样片的线间距尺寸进行测量。实验选择样品为VLSI购买的线距标准样片[4],样片信息如表1所示。

表1 VLSI标准样片信息
2.1 测量实验

图2 一维光栅测量图片
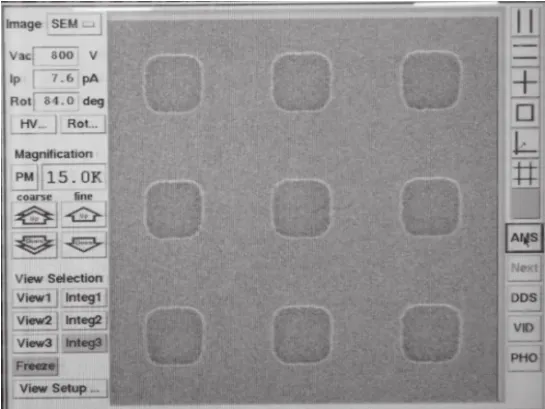
图3 二维格栅测量图片
参照JJF(军工)103-2015《纳米级形貌样板校准规范》中节距间距的算法使用自带测量软件对样片规定的有效测量区域内中心位置的多个周期线间距进行测量,重复测量10次,并对测量结果求平均值作为该样片尺寸的结果[5]。测量时使用仪器的自动对焦和自动扫描图像功能,避免人为调节图像引入的影响。测量结果如表2所示。

表2 CD-SEM测量结果
2.2 测量结果的不确定度评定
使用CD-SEM测量线距标准样片线间距尺寸的不确定度分量主要包括[6]:图像测量标尺标定引入的不确定度;线距标准样片均匀性引入的不确定度;测量结果的重复性引入的不确定度;温度变化引入的不确定度。
下面逐次逐项分析。
1)图像测量标尺标定引入的不确定度
CD-SEM测量是电子束轰击样品表面产生二次电子置换,再由光电信号转换成像方式,测量软件对所拍图片的线间距进行测量。标定软件测量标尺的两个标准件不确定度分别为U= 0.6 nm(k= 2)和U= 6.0 nm(k= 2),两个标准件分别对CD-SEM的不同倍率进行标定。则该不确定度分量为:

2)线距标准样片均匀性引入的不确定度
“过去,老上海人有过‘南翔小笼馒头配湖心亭茶’的传统。当时,因为当地人爱去茶馆,吴翔升便把馒头做小,放在小型竹笼格里蒸,作为茶点送到茶馆。长兴馆在九曲桥畔开业后,一水之隔的湖心亭茶客,自然成了南翔小笼馒头的拥趸。一笼一茶的搭配,可以说是老上海生活方式的最佳体现。”在作家沈嘉禄的记忆中有着这样一段豫园往事。
样片均匀性是指在样片测量范围内,线间距尺寸的变化。该值以9条测量线上线间距的实验标准偏差进行表征。经测量,标称尺寸100 nm线间距的均匀性为0.4 nm、标称尺寸3 μm线间距的均匀性为6.5 nm、标称尺寸10 μm 线间距的均匀性为10.7 nm,则该不确定度分量为
100 nm:u3=0.4 nm
3 μm:u3=6.5 nm
10 μm:u3=10.7 nm
3)测量结果的重复性引入的不确定度
定标结果是以10次测量的平均值表示,以平均值的实验标准偏差作为重复测量引入的不确定度,用10次重复安装样块后的测量值计算实验标准偏差。标称尺寸100 nm线间距的重复性为0.2 nm、标称尺寸3 μm线间距的重复性为5.2 nm、标称尺寸10 μm线间距的重复性为8.8 nm,对样片不同标称尺寸的线间距进行重复测量实验,分别计算实验标准偏差。

4)温度变化引入的不确定度
测量时温度的变化将导致样块的几何尺寸发生变化,样片线间距宽度为p,硅材料的膨胀系数 2.5×10-6℃-1,测量时温度变化范围控制在±3 ℃,按均匀分布估计,则该不确定度分量为

5)测量不确定度
扩展不确定度k取2,U=2×uc
100 nm:U= 1.9 nm
3 μm:U= 0.02 μm
10 μm:U= 0.03 μm
2.3 测量结果比对
使用CD-SEM测量VLSI线距标准样片的测量结果与样片证书给出的标准值相比,100 nm线间距偏差为0.3 nm、3 μm线间距偏差为-0.02 μm、10 μm线间距偏差为-0.04 μm,测量不确定度相当。比对结果如表3所示。
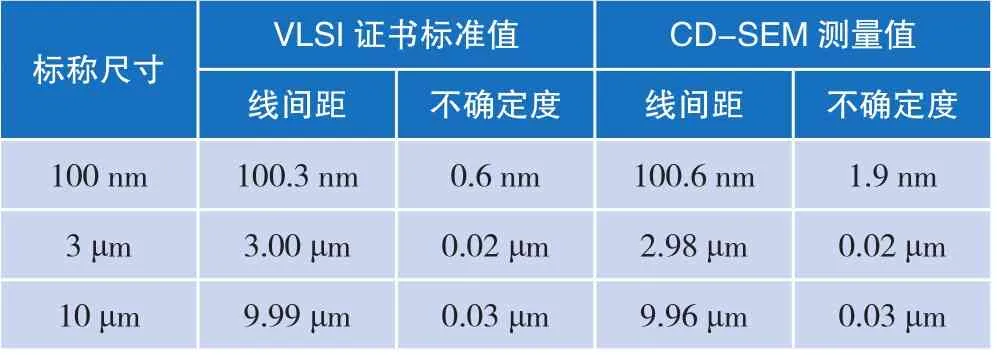
表3 CD-SEM测量结果与VLSI证书标准值比对
通过比对结果的En值能有效说明比对结果的相互认可度[7],En值计算公式如式(1)所示:

式中:x1——CD-SEM测量结果;
x2——VLSI证书给出的测量结果;
U1——CD-SEM测量结果的扩展不确定度;
U2——VLSI证书给出测量结果的扩展不确定度
当|En|≤1时,比对结果满意,实验室之间的数据认可通过。按照式(3)计算CD-SEM和VLSI证书给出测量结果的En值,结果列入表4中。

表4 En值计算结果
CD-SEM测量结果与VLSI测量结果的En值最大为-0.7,测量结果的一致性很高,由此可证明CD-SEM测量线间距的准确度很高。
3 结语
CD-SEM具有高景深、非接触、速度快等优点。本文使用CD-SEM对VLSI线距标准样片的线间距进行测量,测量结果与样片证书给出的标准值相比,100 nm线宽偏差为0.3 nm、3 μm线间距偏差为-0.02 μm、10 μm线间距偏差为-0.04 μm,测量不确定度相当。该测量结果与VLSI测量结果的En值最大为-0.7,由此表明CD-SEM测量线间距是可行的,并且在100 nm~10 μm范围内的测量准确度也是很高的。
