碲锌镉晶体化学机械抛光液的研究
2017-03-26敖孟寒朱丽慧孙士文
敖孟寒,朱丽慧,孙士文
碲锌镉晶体化学机械抛光液的研究
敖孟寒1,2,朱丽慧1,孙士文2
(1. 上海大学材料科学与工程学院,上海 200072;2.中国科学院红外成像材料与器件重点实验室,上海 200083)
本文以硅溶胶为磨料颗粒、次氯酸钠(NaClO)为氧化剂制备适用于CZT晶片的化学机械抛光液。采用XPS能谱分析CZT表面元素化学态,研究CZT化学机械抛光过程中抛光液的化学作用机理,使用激光干涉仪、原子力显微镜研究抛光液中NaClO含量对晶片抛光速率、晶片表面PV值及表面粗糙度Ra的影响。结果表明,硅溶胶-次氯酸钠抛光液通过与CZT晶体中Te单质或CdTe发生化学反应,生成TeO2。随后在一定压力下,抛光盘与CZT晶片发生相对运动,并在硅溶胶磨料颗粒的辅助作用下去除反应物。当NaClO含量在2%~10%时,随着NaClO含量的增加,晶片表面PV值和粗糙度Ra值先降低后升高,去除速率则随着NaClO含量的增加而增加。NaClO含量为6%时,PV值和Ra值最低,得到的晶片表面质量最好。
化学机械抛光;CZT晶体;粗糙度;平整度
0 引言
碲锌镉(CZT)晶体常作为HgCdTe生长的衬底材料以及生产核辐射探测器的理想材料[1]。CZT晶片的表面粗糙层、划痕等缺陷会严重影响所生长材料和探测器的质量,所以获得高质量的CZT抛光表面非常重要。
国内对CZT晶体表面处理使用较多的工艺是机械研磨、机械抛光和化学腐蚀[2]。国外文献曾提及化学机械抛光技术可用于CZT晶体的表面处理,但对抛光液配方及抛光参数保密[3]。有关CZT化学机械抛光液的研究主要集中在酸性抛光液。李岩、康仁科[4]等人使用硅溶胶作为磨粒,分别选取硝酸、溴水、过氧化氢作为氧化剂制备化学机械抛光液,对CZT进行化学机械抛光。结果显示当使用硝酸作为氧化剂时得到的抛光表面最好,但是硝酸不稳定,很容易分解出NO,污染环境。张振宇[5]等使用双氧水和硅溶胶制备CZT晶体的化学机械抛光液,加工的精度虽提高,但双氧水易分解而失效。酸性抛光液的腐蚀性大,且易使抛光表面富Te。相比于酸性抛光液,碱性抛光液腐蚀性适中,在CZT晶体的化学机械抛光中更具优势[6-7]。因此,有必要研制适合CZT晶体的碱性抛光液。
用于CZT晶体化学机械抛光液的磨料颗粒主要有Al2O3和硅溶胶。Al2O3硬度较大,易团聚,易划伤晶片表面。硅溶胶粒子硬度适中,对抛光工件表面损伤较小,能有效提高被抛光工件的表面质量。并且硅溶胶分散性好,不易产生分层、沉淀等现象[8]。硅溶胶的生产工艺成熟、粒径可控,因此制备抛光液更具优势。次氯酸钠(NaClO)是一种高效氧化剂[9],它的氧化能力强、作用快、效果好、对环境污染小。因此,本文选择硅溶胶作为磨料颗粒,NaClO作为氧化剂制备抛光液。研究抛光过程中的化学机械抛光特性以及抛光液中氧化剂含量的变化对晶片的抛光速率、晶片表面PV值及晶片表面粗糙度Ra的影响。
1 实验
1.1 实验材料及试剂
本文采用上海技术物理研究所提供的CZT(111)面单晶试样,其尺寸为15mm×20mm×1mm。浓度为30%的硅溶胶,pH约为10,粒径约0.1mm;次氯酸钠,化学式NaClO,化学纯,活性氯不少于5%;乙酸,化学纯。
1.2 实验内容
1)抛光液制备
使用乙酸调节次氯酸钠的pH到8.0,按照2%~10%的比例将调节好的NaClO溶液加入到浓度为30%的硅溶胶中,并利用乙酸将抛光液的pH值调到8~9之间。
2)抛光实验
本文使用英国进口的LOGTECH-PM5精密抛光机对经过机械研磨的晶片进行化学机械抛光。抛光盘直径为300mm,抛光液流量10mL/min,抛光盘转速50r/min,抛光压力为10N。
3)性能测试
使用Zygo-GPIXP/D4激光干涉仪测量晶片表面全貌图,得到晶片表面平整度PV值。使用Multi Mode 8原子力显微镜测量抛光后晶片表面(5mm×5mm)的粗糙度Ra值。晶片抛光前后的厚度由OLYMPUS- STM6显微镜测量,根据公式(1)计算晶片的抛光速率:
=(1-2)/(1)
式中:1为抛光前晶片厚度;2为抛光后晶片厚度;为抛光时间。
为研究硅溶胶-次氯酸钠抛光液对晶片的作用机理,将经过机械研磨的CZT晶片放入抛光液中浸泡30min。使用HITACHI SU-1500 扫描电镜对其表面进行观察,采用Thermo Scientific ESCALAB 250Xi 型XPS 能谱分析仪对晶片表面进行元素化合态的分析。
2 结果与讨论
2.1 抛光液对晶片的化学机械作用
图1(a)为经过机械研磨的CZT晶片的SEM图,CZT晶片表面无嵌入颗粒,无划痕,晶片表面材料分布均匀致密。图1(b)为CZT晶片经过硅溶胶-次氯酸钠浸泡后的SEM图,可以观察到晶片表面产生一层疏松多孔的物质。说明硅溶胶-次氯酸钠抛光液对CZT晶片具有化学氧化作用。
当使用纯硅溶胶对CZT晶片进行抛光时,发现抛光30min后,晶片厚度基本不变,去除速率很低。硅溶胶中加入次氯酸钠配制成化学机械抛光液,对晶片抛光5min时,晶片表面厚度减小了8mm,CZT晶片表面变得光滑,如图1(c)所示。结合图1(a)(b)(c)可以说明,在CZT晶片的抛光过程中,由硅溶胶-次氯酸钠化学机械抛光液对CZT晶片提供化学氧化作用,通过抛光盘与CZT晶片的相对运动下,去除晶片表面的氧化层,从而达到抛光晶片表面的目的。
为了进一步研究抛光液对CZT晶片的化学作用过程,实验中采用XPS对浸泡前后的CZT晶片进行表面元素化合态分析。图2所示为CZT晶体表面经抛光液浸泡前后的XPS全谱图,浸泡前后Cd3d峰、Te3d峰均较强,经过抛光液浸泡后增加了O1s峰。
为了观察抛光液浸泡前后各元素是否发生价态变化,对CZT晶体的主要组成成分Cd与Te分别做单谱分析。图3为抛光液浸泡前后CZT晶片表面Cd的XPS单谱图,经抛光液浸泡后,Cd3d峰发生小角度偏移且出现宽化现象。经抛光液浸泡后CZT晶体表面Cd可能以CdTeO3、CdO和Cd(OH)2的形式存在,他们的Cd3d5/2的结合能分别为405.0~405.5eV、403.7~404.6eV、404.7~405.2eV,Cd3d3/2的结合能分别为412.8~413.2eV、411.5~412.5eV和411.3~411.7eV。峰位会随着表面产物的量的变化在一定角度发生偏移,且各种产物峰的叠加会使得峰发生宽化现象。由于不同化合态的Cd3d峰其结合能相差不多,不能通过图谱很清晰地判断出生成何种Cd化合物。据文献报道[10-11],在溶液反应体系中,CdO还原电势比Cd(OH)2更高,稳定性较低。因此推断在硅溶胶-次氯酸钠抛光液反应体系中Cd主要以Cd(OH)2的形式存在。

图1 不同方式处理后的CZT晶片表面SEM图

图2 抛光液浸泡前后CZT晶片表面XPS能谱图
图4为抛光液浸泡前后CZT晶片表面Te的XPS单谱图,抛光液浸泡前在582.58eV和572.18eV处存在两个强峰,分别是单质Te或CdTe的Te03d3/2峰和Te03d5/2峰,说明此时CZT晶体中Te主要以CdTe或Te单质存在。经过抛光液浸泡后,又在586.68eV和576.28eV处出现两个强峰,分别是TeO2的Te4+3d3/2峰和Te4+3d5/2峰,说明经抛光液浸泡后CZT晶片表面的Te主要以TeO2和Te单质的形式存在,这与文献[10-11]研究结果一致。582.58eV和572.18eV处的峰变弱,说明低价的Te单质或CdTe减少了。在反应体系中由于TeO2的还原电势高于H2TeO3,因此,在硅溶胶-次氯酸钠反应体系中TeO2以H2TeO3的形式存在。可认为在化学机械抛光过程中,硅溶胶-次氯酸钠化学机械抛光液与CZT晶片表面可能发生如下反应:
Cd0.96Zn0.04Te+NaClO+H2O=0.96Cd(OH)2+
0.04Zn(OH)2+NaCl (2)
Te+2NaClO+H2O=H2TeO3+2NaCl (3)
硅溶胶-次氯酸钠抛光液中的氧化剂主要通过与CZT晶体中的Te单质或CdTe发生化学反应生成高价态的Te化合物,在CZT晶片表面生成氧化层。随后在抛光液中硅溶胶磨料颗粒帮助下,晶片表面氧化层通过机械抛光过程去除,从而达到抛光CZT晶片表面的目的。
2.2 硅溶胶-次氯酸钠体系抛光液抛光性能
图5为CZT晶片抛光速率随着NaClO含量的变化曲线图。随着NaClO含量的增加,抛光速率增加。在CZT的化学机械抛光过程中,NaClO的作用是与CZT表面发生化学反应,在CZT晶片表面生成一层氧化层,通过抛光液中的硅溶胶磨料颗粒的辅助作用去除表面的生成物,从而达到抛光CZT晶片表面的目的。当抛光液中的NaClO含量增加时,抛光液中的NaClO与碲锌镉晶片表面化学反应速率增加,因此抛光过程中能带走的氧化产物增多,抛光液的抛光速率上升。

图3 抛光液浸泡前后CZT晶片表面 Cd3d XPS能谱图
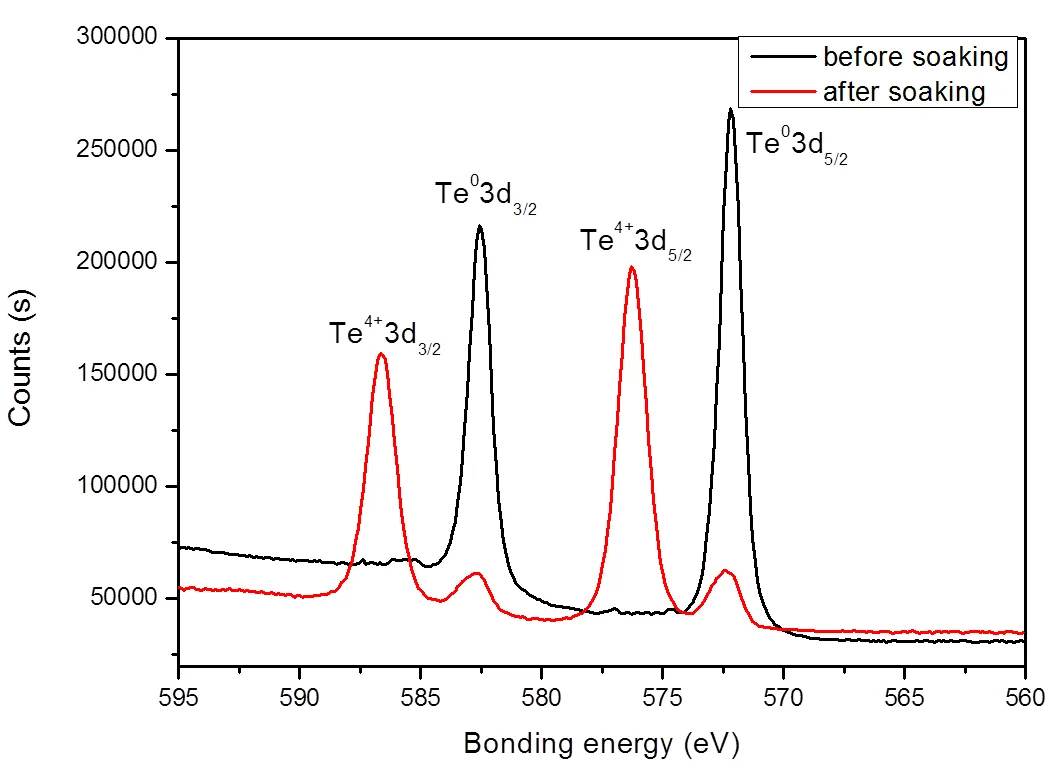
图4 抛光液浸泡前后CZT晶片表面Te3d XPS能谱图
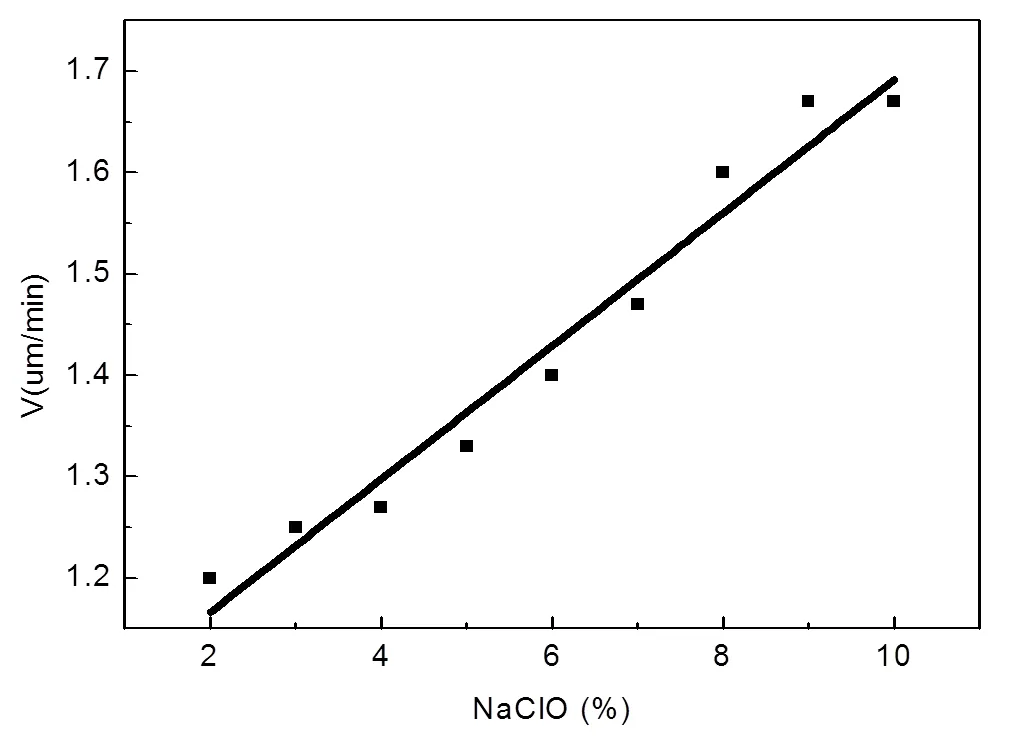
图5 抛光速率随NaClO含量的变化关系图
图6为硅溶胶晶片表面平整度PV值随NaClO含量的变化图。随着NaClO含量的增加,晶片表面PV值先降低后增加,当NaClO含量为6%时PV值最低。晶片表面粗糙度Ra随NaClO含量的变化规律与晶片表面PV值变化规律类似,并且当NaClO含量为6%时表面粗糙度Ra值也最低,如图7所示。

图6 晶片表面平整度PV值随NaClO含量的变化
在化学机械抛光中,只有当化学作用与机械作用相匹配时,才能得到表面质量较好的晶片。当氧化剂含量较低时,化学反应速率低,导致材料去除效率低,不能有效地去除由机械研磨留下的晶片表面损伤层,而且很容易造成晶片表面的划伤,因此晶片表面平整度较差,表面粗糙度较大。当氧化剂含量为6%时,抛光过程中机械作用与化学作用可能达到平衡,因此可以有效去除晶片表面损伤层时又不至于划伤晶片表面,更容易得到表面平整度PV值和粗糙度Ra值较小的晶片。氧化剂含量进一步增加,抛光过程中化学作用占主导地位,也不利于得到表面粗糙度较小的平整的晶片。这是因为当化学作用增强时,晶片表面粗糙,晶片Ra值增大。而且晶片边缘与抛光液最先接触,腐蚀较快,很容易产生塌边,因此导致晶片表面PV值上升。

图7 晶片表面粗糙度随NaClO含量的变化
综上所述,化学机械抛光过程中,无论是机械作用占主导地位还是化学作用占主导地位,都不利于提高抛光后晶片表面质量。当抛光压力为10N,抛光盘转速为50r/min,抛光液流量为10mL/min,硅溶胶为30%,NaClO含量为6%时,化学作用与机械作用达到平衡,抛光速率为1.4mm/min。晶片表面PV值为2.493mm,粗糙度为1.42nm,得到的晶片表面质量最好。
3 结论
硅溶胶-次氯酸钠化学机械抛光液主要通过与CZT晶体中低价的Te发生化学反应生成TeO2,在晶片表面生成一层氧化膜。在抛光液中硅溶胶磨料颗粒的帮助下,晶片表面氧化物通过机械抛光过程去除,从而达到抛光CZT晶片表面的目的。随NaClO含量的增加,晶片去除速率增加。晶片表面PV值和粗糙度Ra则随NaClO含量的增加先减小后增加。当抛光压力为10N,抛光盘转速为50r/min,抛光液流量为10mL/min,硅溶胶为30%,NaClO含量为6%时,化学作用与机械作用达到平衡,抛光速率为1.4mm/min。晶片表面PV值为2.493mm,粗糙度为1.42nm,得到的晶片表面质量最好。
[1] Reddy M, Lofgreen D D, Jones K A, et al. Cross-Sectional Study of Macrodefects in MBE Dual-Band HgCdTe on CdZnTe[J]., 2013, 42(11): 3114-3118.
[2] 李岩. 碲锌镉晶体研磨与磨削的实验研究[D]. 大连: 大连理工大学, 2008.
LI Yan. Experimental Studies on Lapping and Grinding of CdZnTe Crystal[D]. Dalian: Dalian University fo Technology, 2008.
[3] Singh R, Velicu S, Crocco J, et al. Molecular beam epitaxy growth of high-quality HgCdTe LWIR layers on polished and repolished CdZnTe substrates[J]., 2005, 34(6):885-890.
[4] 李岩, 康仁科, 高航, 等. 碲锌镉晶体高效低损伤CMP工艺研究[J]. 人工晶体学报, 2009, 38(2): 416-424.
LI Yan, Kang Renke, GAO Hang, et al. High-efficiency and Low-damage chemical mechanical polishing process of CdZnTe Crystals[J]., 2009, 38(2): 416-424.
[5] 张振宇, 宋亚星, 徐朝阁. 新型环保抛光液的制备及其对软脆碲锌镉晶片的化学机械抛光[J]. 中国机械工程, 2014, 25(22): 3008-3012.
ZHANG Zhenyu, SONG Yaxing, XU Chaoge. Chemical mechanical polishing of soft-brittle CdZnTe wafers using a developed environment-friendly solution[J]., 2014, 25(22): 3008-3012.
[6] LIU Yuling, ZHANG Kailiang, WANG Fang, et al. Investigation on the final polishing slurry and technique of silicon substrate in ULSI[J]., 2003, 66: 438-444.
[7] 彭进, 夏琳, 邹文俊. 化学机械抛光液的发展现状与研究方向[J]. 表面技术, 2012, 41(4): 95-99.
PENG Jin, XIA Lin, ZOU Wenjun. Research status and prospect of chemical mechanical polishing slurry[J]. Surface Technology, 2012, 41(4): 95-99.
[8] Lok P. Singh, Sriman K. Bhattacharyya, Rahul Kumar, etal. Sol-Gel processing of silica nanoparticles and their applications[J]., 2014, 214: 17-37.
[9] R. M. Clarkson, A. J. Moule, H. M. Podlich. The Shelf-life of Sodium Hypochlorite Irrigating Solutions[J]., 2001.
[10] S. Babar, P. J. Sellin, J. F. Watts, et al. An XPS study of bromine in methanol etching and hydrogen peroxide passivation treatments for cadmium zinc telluride radiation detectors[J]., 2013, 264: 681-686.
[11] A. V. Rybka, S. A. Leonov, I. M. Prokhoretz, et al. Influence of detector surface processing on detector performance[J]., 2001, A458: 248-253.
Research on Chemical-mechanical Polishing Slurry for CdZnTe Crystal
AO Menghan1,2,ZHU Lihui1,SUN Shiwen2
(1.,,200072,; 2.,,200083,)
In this paper, silica solution and NaClO were chosen as raw materials to prepare chemical-mechanical polishing slurry for CdZnTe crystal. The mechanism of chemical-mechanical polishing slurry to CZT was researched by analyzing the elemental state of the CZT surface with X-ray Photoelectron Spectrometer (XPS). Laser Interferometer and Atomic Force Microscope (AFM) were used to investigate the effect of NaClO content on polishing rate, surface flatness and roughness. The results show that the chemical-mechanical polishing slurry mainly reacts with Te or CdTe, and TeO2is obtained. Then at a certain pressure, there is relative motion between polishing discs and CZT wafer, and the reaction film is removed under a supporting role of SiO2particles, which make the surface become smooth. When the NaClO content ranges from 2% to 10%, with the increase of NaClO, the PV value and roughness of CZT surface decrease at first and then increase, while the polishing rate increases all the time. When the NaClO content is 6%, the PV value and roughness reach the minimum, and the polishing surface of CdZnTe with high quality is obtained.
chemical-mechanical polishing,CZT crystal,roughness,flatness
TN304
A
1001-8891(2017)01-0022-05
2015-11-03;
2016-11-14.
敖孟寒(1990-),女,贵州六盘水人,硕士,主要从事CZT表面处理研究。E-mail:13651818246@163.com。
朱丽慧(1971-),女,浙江上虞人,教授,博士生导师,主要从事材料方面研究。E-mail:lhzhu@mail.shu.edu.cn。
红外成像与器件重点实验室开放基金项目。
