选择性化学机械抛光制作微拱形结构*
2013-10-22杨增涛曾德平赵纯亮
杨增涛,王 华,曾德平,陈 俊,赵纯亮
(1.重庆医科大学生物医学工程学院省部共建超声医学工程国家重点实验室超声医学工程重庆市市级重点实验室,重庆 400016;2.模拟集成电路国家重点实验室中国电子科技集团公司第二十四研究所,重庆 400060)
0 引言
拱形结构是MEMS器件里的一种常用结构,广泛用于制作传感器[1,2]、微型压电驱动器[3]、薄膜体声波谐振器及滤波器等[4,5]。拱形结构与平面结构相比,具有自释放残余应力、面内应变向径向应变转化、跨度大及刚度大等优势[2,6]。现有关于制作拱形结构方法主要有以下几类:1)球模具法[6,7]:优点是能够准确控制所制作出拱形结构的曲率和直径;缺点是毫米级的平面尺寸无法适应MEMS器件的要求,不适合批量生产。2)平面牺牲层法[4]:优点是工艺简单、可量产,且拱形尺寸可精确控制;缺点是在释放微米级牺牲层时容易粘附,在刻蚀牺牲层时会形成较陡直台阶状的边缘,易导致其上拱形结构发生断裂或能量泄漏而造成器件失效[8]。3)应力控制成拱[5]:优点是整个结构为平滑的曲面,避免了在拱形结构边缘处形成应力集中;缺点是成拱的压缩应力薄膜镀膜工艺复杂,成拱曲率难以控制,且薄膜内应力过大会引起器件失效[8]。4)各向同性腐蚀法[2]:优点是制作的拱形结构无残余应力,结构稳定性好;缺点是腐蚀出的凹球形沟槽尺寸为毫米级,同批次之间尺寸差异性达到4%[9]。
针对以上不足,本文提出一种选择性化学机械抛光技术制作微拱形结构的制作方法,此方法在化学机械抛光硅片过程中,通过选择能较快抛去硅材料但对SiO2材料的抛光速度却极慢的抛光液,抛光后在硅片上形成一系列SiO2材料的微拱形凸起,最后在拱形凸起的基片上制作出MEMS微拱形结构。此微拱形结构尺寸为微米级,表面光滑且为连续的曲面,改进了平面牺牲层工艺制作出的微拱结构出现非连续的台阶状边缘和无法制作出一定曲率微拱的缺点,增强器件结构的稳定性和可靠性,可为制作MEMS传感器、微型压电驱动器、薄膜体声波谐振器及滤波器等的微拱形结构提供参考。
1 工艺步骤
微拱形结构采用工艺流程见图1,所对应的工艺步骤如下:
1)选用P型〈100〉晶向衬底硅片,在硅片表面热氧化形成一层SiO2薄膜(几个到几十纳米),以此SiO2薄膜为掩模层,用四甲基氢氧化铵(TMAH)对衬底硅片进行腐蚀[10],在衬底硅片上形成图1(a)所示的沟槽,其中,沟槽深度为几个微米,长度和宽度各为几十到几百个微米。
2)采用等离子体增强化学气相沉积(PECVD)法在图1(a)上表面镀SiO2牺牲层,牺牲层厚度超过沟槽深度,填充后的沟槽结构见图1(b)所示。
3)选用氧化铈(CeO2)抛光液,用化学机械抛光(CMP)设备对步骤(2)制备的SiO2牺牲层进行抛光,形成图1(c)所示的结构,此时硅片上表面SiO2牺牲层全部被去除,沟槽内填充的SiO2牺牲层与硅片表面为同一水平面。
4)用CMP设备对图1(c)上表面进行抛光,抛光过程中选用对硅材料抛光速度较快,但对于SiO2材料抛光速度极慢的硅抛光液,抛光后在SiO2处形成凸起,在硅和SiO2交接处尖锐部分由于局部压应力的剧增,剧烈的机械摩擦和化学反应引起尖锐部分消除,因此,在硅和SiO2的交界处形成了连续且平滑的过渡,而在远离硅和SiO2交界面处,硅抛光速度比SiO2快,形成了如图1(d)所示的凸起曲面,凸起处为SiO2牺牲层,硅与SiO2交界处连续且平滑。
5)在图1(d)有凸起面上根据设计镀各种功能薄膜,由于整个表面平滑连续,因此,其上形成的薄膜也平滑连续、无台阶。
6)在图1(d)上光刻出腐蚀窗口,采用SiO2腐蚀剂(根据实际情况,并考虑交叉腐蚀情况)释放SiO2牺牲层,由于下方硅基片上有沟槽,增加了腐蚀断面面积,加快了牺牲层释放速度[11],牺牲层释放完毕后,形成如图1(f)所示的微拱形结构,其支撑边缘平滑无台阶,下面为一空腔。
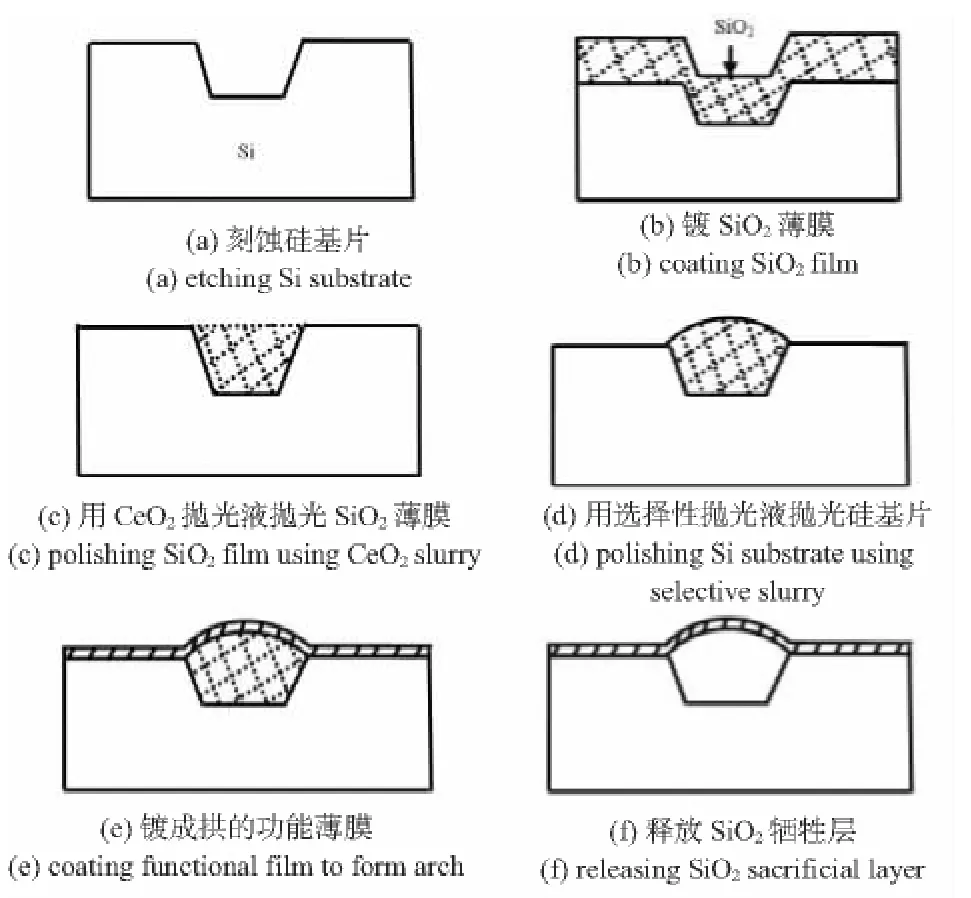
图1 工艺步骤示意图Fig 1 Schematic diagram of fabrication process
2 实验结果
在图1(e)上表面用低压化学气相沉积(LPCVD)设备沉积一层厚度为3 μm的Si3N4薄膜用于制作拱形梁结构,所制作微拱梁用扫描电镜(SEM)(LEO公司,德国)观察,扫描结果见图2,从图2中可以看出:整个梁体上表面光滑平整,硅片与牺牲层过渡处未见台阶。
采用缓冲氢氟酸(BHF)腐蚀液释放图1(e)中的SiO2牺牲层,用表面粗糙度三维形貌轮廓仪(FRT公司,德国)对微拱梁三维形貌进行扫描,所测结果见图3所示,微拱梁上表面为光滑的曲面,梁体中间拱起,拱起高度约为3.5 μm,跨度大于100 μm,两支撑端与硅平面实现了平滑过渡,此种支撑结构无台阶、稳定性好、且不宜发生断裂,同时,采用MEMS工艺制作,其尺寸适应MEMS器件的要求。
3 结论
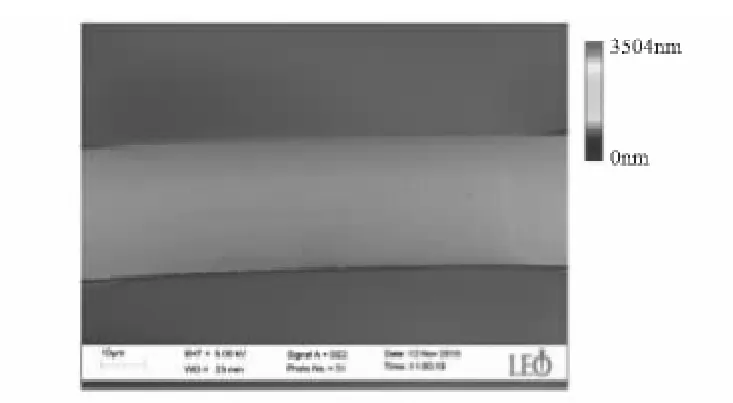
图2 微拱梁SEM图Fig 2 SEM diagram of miro-dome-shaped beam

图3 微拱梁三维轮廓图Fig 3 3D contour profile of miro-dome-shaped beam
本文提出一种基于选择性化学机械抛光技术制作微拱形结构的制作方法,此方法在CMP过程中加入选择性抛光液,利用硅片上牺牲层部分抛光速度与硅部分抛光速度的差异,在牺牲层和硅材料的边界处利用滑动摩擦过程中的物理和化学作用,在硅片SiO2牺牲层处形成一系列SiO2材料的微拱形凸起,这些凸起表面光滑,SiO2牺牲层与硅片接触面平滑无台阶,最后在拱形结构的基片上镀膜并释放牺牲层制作出MEMS微拱形结构。实验结果表明:所制微拱形结构有一定的曲率,拱起高度约为3.5 μm,跨度大于100 μm,微拱形表面光滑且为连续的曲面,改进了现有制拱方式在尺寸、结构稳定性和可靠性等方面的不足。用这种方法制作出的拱形结构无残余应力,结构稳定性好,此方法可应用于制作MEMS传感器、微型压电驱动器、薄膜体声波谐振器及滤波器的可动结构或悬浮结构等,但此方法制作出的拱形结构拱起高度很小,如何增大拱形结构的曲率还需进一步研究。
[1] 宁 瑾,刘忠立,刘焕章,等.用氧化多孔硅作牺牲层制备悬空微结构[J].功能材料与器件学报,2003,9(3):319 -322.
[2] Han C H,Kim E S.Micromachined piezoelectric ultrasonic transducers on dome-shaped-diaphragm in silicon substrate[C]∥Proceedings of 1999 IEEE,Ultrasonics Symposium,1999:1167 -1172.
[3] Buchanan R C,Park E,Surana R,et al.High piezoelectric actuation response in graded Nd2O3and ZrO2doped BaTiO3structures[J].J Electroceram,2011,26:116 -121.
[4] Satoh H,Ebata Y,Suzuki H,et al.An air-gap type piezoelectric composite thin film resonator[C]∥Proc of 39th Annual Symp on Frequency Control,1985:361 -366.
[5] Taniguchi S,Yokoyama T,Iwaki M,et al.An air-gap type FBAR filter fabricated using a thin sacrificed layer on a flat substrate[C]∥2007 IEEE Ultrasonics Symposium,2007:600 -603.
[6] Feng G H,Kim E S.Piezoelectrically actuated dome-shaped diaphragm micropump[J].Journal of Microelectromechanical Systems,2005,14(2):192 -199.
[7] Feng G H,Sharp C C,Zhou Q F,et al.Fabrication of MEMS ZnO dome-shaped-diaphragm transducers for high frequency ultrasonic imaging[C]∥2004 IEEE International Ultrasonics,Ferroelectrics,and Frequency Control Joint 50th Anniversary Conference,2004:1950-1953.
[8] Dubois M A.Thin film bulk acoustic wave resonators:A technology overview[C]∥MEMSWAVE 03,Toulouse,France,2003.
[9] Han C H,Kim E S.Fabrication of dome-shaped diaphragm with circular clamped boundary on silicon substrate[C]∥Proceedings of the IEEE Conference on MEMS,Orlando,USA,1999:505 -510.
[10]杨增涛,冷俊林,梅 勇,等.硅各向异性浅槽腐蚀实验研究[J].压电与声光,2011,33(4):513 -516,519.
[11] Hara M,Kuypers J,Abe T,et al.Aluminum nitride based thin film bulk acoustic resonator using germanium sacrificial layer etching[C]∥12th International Conference on Transducers,Solid-State Sensors,Actuators and Microsystems,2003:1780 -1783.
[12]刘瑞鸿.二氧化硅介质层 CMP抛光液研制及其性能研究[D].大连:大连理工大学,2009.
