多通道器件过电应力失效问题分析研究
2023-11-07金元石
金元石
(中国电子科技集团公司第四十七研究所,沈阳 110000)
1 引 言
在集成电路板级应用过程中,当外界电应力超过器件可承受的最大规范条件时,器件会性能减弱甚至损坏。外界电应力主要分为ESD(Electro-Static Discharge)和EOS(Electrical Overstress)两大类。ESD是瞬间的高电压(大于1kV)、大电流(1~10A)效应,能量达到微焦耳量级。而EOS 通常为长时间的低电压(小于100V,持续时间1~100ms)、电流适中(0.1~1 A)的作用,其持续时间的长短和能量大小决定了对电路施加应力的高低。长时间、大电流的过电应力会产生大量的热量,形成局部高温,造成金属布线融化或氧化层退化[1-2]。因此,集成电路板级应用设计时应尽量避免过电应力的产生。
2 问题出现与初步排查
在实例中,有CD54HC245 型八双向总线发送器/接收器在整机试验阶段发生失效。失效发生时间为开机瞬间,失效现象为B6 端口输出恒高。该产品采用DIP20 封装,电源、地和控制端外含有8 路具有相同结构的总线发送器/接收器,用户使用其中7路,未被使用的A7、B7 端口均接地。失效电路的开盖照片如图1 所示。

图1 故障器件开盖分析
由图中可见,地线分支区域出现两处较为明显的烧损点。经分析,位于左上方的失效点为A6→B6方向上GND 总线与A6 引脚间的金属布线地线分支烧损,导致电流无泄放通路,因此B6 端口输出恒高,电路功能失效。同时,右下方的失效点为GND总线与B7 引脚间的金属布线地线分支烧损,由于该金属地线是多个并联NMOS 管的地线之一,烧损点未完全破坏该路输出功能,功能测试正常。两处烧损点均为GND PAD 临近位置,故障定位于器件地线支路烧毁。
3 失效分析
3.1 失效原因排查
失效电路为采用CMOS 工艺制造的单芯片电路,对静电和异常电应力干扰较为敏感。器件受到异常电应力,即ESD 脉冲[3]、系统异常脉冲[4]和开关机浪涌电流[5]等,都可能对器件造成冲击损坏器件。
3.1.1 ESD 脉冲
集成电路器件在运输、装配过程中可能由于HBM(Human Body Model)、MM(Machine Model)、CDM(Charged Device Model)等静电类型造成器件损伤、烧毁。HBM 为人体静电模型,器件搬运过程中带电人体接触器件可能造成过电应力进入器件;MM 为机器静电模型,装配、运输过程中可能在器件内部积累电荷,系统通电瞬间形成泄放通路,器件内部积累的电荷瞬间对地泄放形成的瞬时大电流可能造成器件烧毁;CDM 为充电模型,器件运输、装配过程中可能因壳体摩擦使壳体带静电,系统通电瞬间形成泄放通路,壳体将通过芯片和引出端对地放电。
ESD 失效发生时,通常因为瞬时热量集中,PN结被熔毁,造成产品漏电。在产品ESD 结构设计未出现问题的情况下,不会出现金属熔断的情况。
3.1.2 系统异常脉冲
根据失效电路使用环境,在8 路双向总线发送器/接收器中,用户使用其中7 路,未使用的A7、B7端口均接地。当外围环境电压出现波动时,接地端口与电源端之间可能出现负向压差,电流会由接地端口倒灌入器件。电流泄放路径上金属布线较细时,确实可能由于热集中造成金属熔毁。
3.1.3 开关机浪涌电流
大型设备都具有大感性和容性负载。设备开关机时,由于感性和容性负载的瞬时充放电过程会产生较大的干扰尖脉冲,高压干扰电压会从公共的地线串扰到整机系统中,若地线隔离不好或接地方式不合适,都会导致尖脉冲高压对敏感元器件形成干扰,严重时会烧毁器件。此类现象可通过对工作环境进行监测排查。本电路通过对试验板和试验环境进行排查,未发现此类过电应力。
3.2 仿真研究
失效电路损伤位置为地线分支,由失效现象分析,这是由于地端与电源端产生负向压差,倒灌入地端的电流在金属连线上形成热集中,造成金属连线烧损所导致的。针对失效现象,对电路8 路通道中的一路通道进行仿真试验。
图2为A6、B6 端口电路图。图中标识A 为芯片试验后金属连线熔断点。经过仿真,与A 点有关的两路晶体管PM0、NM0 和PM1、NM1 在上电时电流流向如图2 中I1、I2所示。

图2 A6、B6 端口芯片电路图
图3为仿真波形图,从上至下依次为电源电压(VDD)、第一路两个晶体管的漏极电流(NM0.d、PM0.d)、第二路两个晶体管的漏极电流(NM1.d、PM1.d)等五种情况。其中,电源电压激励先为零电压,再转为负电压情况。从图中可以看到,当电源电压为负电压时,第一路存在大约为199mA 的电流I1,而第二路存在约为414mA 的电流I2。从版图上看,连接两个NMOS 管(NM0 和NM1)的金属线线宽为6μm,而流过该金属线的电流约为I1+I2=613mA。正常情况下,线宽为6μm 的金属布线只能允许6mA的电流流过,600mA 电流将会造成金属连线熔断。

图3 A6、B6 端口金属熔丝熔断仿真波形
进一步分析,此熔断原因为:当电源电压为负电压时,其CMOS 反相器的NMOS 管和PMOS 管构成正向偏置P-N 结,形成了从高电压经过两个P-N结导向低电压的电流通路[6-7],如图4 所示。
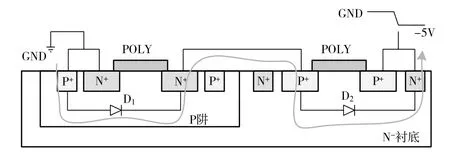
图4 CMOS 反相器加入负电压后的直流通路示意图
图中,GND 电压高于VDD 电压(负电压),NMOS管P 阱到N+有源区形成第一个正向偏置二极管D1,PMOS 管从P+有源区到N 衬底形成第二个正向偏置二极管D2。如果电源电压为负压,则形成GND→D1→D2→VDD 的直流大电流通路,熔断金属连线(金属线越细的地方越容易熔断,图2 所示的A 点即为这条地线中最细的地方)。
图5为A7、B7 端口电路图。图中标识B 点处为芯片试验后金属连线熔断点,其金属连线熔断原因与上述A6、B6 基本相同。

图5 A7、B7 端口芯片电路图
3.3 失效现象复现
为了进一步验证分析结果,采用与仿真试验相同的条件进行地端加压试验,取指标合格的产品一只,采用如图6 所示的连接方式进行试验。

图6 复现试验连接方式
从电源端引入-5V 电压后,A7 引脚与地之间的NMOS 器件出现损伤。损伤位置如图7 所示。
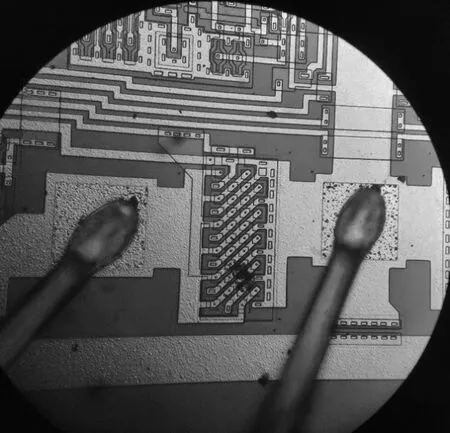
图7 L54HCT245 复现试验失效点
复现试验失效点电路如图8 所示。在复现试验中,A7、B7 端口的金属连线熔断原因与用户原失效电路基本相同,均为从端口引入负向压差形成的闩锁效应造成的。根据仿真结果,地端与电源端引入负向压差会造成电流由接地端流向电源端,低压差长时间的电流集中或高压差短时间的瞬时大电流集中的位置均会造成金属烧损。CD54HC245 产品板级应用时,将A7、B7 端口连接至地端,产品上电瞬间产生的负向脉冲从A7、B7 端口进入电路内部,形成由A7、B7 端口流向电源端的电流。数字电路的I/O端口在引入负向电压时会由于PNPN 结构引发闩锁效应,形成的大电流造成了故障电路的金属烧损。烧损位置由电流路径上的金属台阶高度和金属宽度有关,金属台阶越高,台阶上覆盖的金属厚度越薄。金属厚度薄、宽度窄的区域在电流集中时更容易烧损[8],而台阶厚度和宽度受工艺波动影响,每只电路存在差异,因此,复现试验烧损的位置与故障电路不同。

图8 复现试验失效点电路图
通过复现试验验证,未使用I/O 引脚与地线引脚短接,接地的I/O 引脚与电源端引入负向压差时,引发端口电路闩锁,造成厚度薄、宽度窄的金属布线烧损,与失效电路故障现象相符。
4 结 束 语
以某CD54HC245 器件在产品使用过程中出现的过电应力损伤为案例,以原理分析、镜检与仿真试验相结合的方法,逐一排查失效源,完成失效分析。镜检与仿真分析等手段能够提供数据支撑,结合实际使用方法,最终定位问题所在,经过试验使问题再次复现,验证了分析的正确性。该方法也可为未来多通道电路使用过程中出现同类问题时进行失效分析提供基础保障。
