Zn扩散对InGaAs/InP单光子雪崩光电二极管雪崩击穿概率的影响
2023-07-12郭可飞尹飞刘立宇乔凯李鸣汪韬房梦岩吉超屈有山田进寿王兴
郭可飞 ,尹飞 ,刘立宇 ,乔凯 ,李鸣 ,汪韬 ,房梦岩 ,吉超 ,屈有山 ,田进寿 ,王兴
(1 中国科学院西安光学精密机械研究所 超快诊断技术重点实验室,西安 710119)
(2 中国科学院大学 材料与光电研究中心,北京 100049)
0 引言
单光子探测技术是一种能够检测单个光子能量的超高灵敏度光电探测技术,是激光测距、量子通信、高分辨率光谱检测、激光雷达三维成像等领域广泛应用的微弱信号检测技术[1-5]。目前,主要的单光子探测器件有光电倍增管、超导单光子探测器、单光子雪崩光电二极管(Single Photon Avalanche Diodes, SPAD)等。SPAD一般工作电压大于击穿电压,即工作在盖革模式下,盖革模式下工作电压与击穿电压的差值称为过偏压。光子探测效率(Photon Detection Efficiency,PDE)指一个光子入射到器件后转化为能够被检测到的宏观信号的概率,是衡量SPAD探测能力的重要参数。InGaAs/InP单光子雪崩光电二极管可工作于近红外波段(900 nm~1 700 nm),具有高的光子探测效率(>30%)和良好的时间抖动(<100 ps)等特点,此外还有体积小、稳定性高、抗辐射性能优、可实现大面阵成像等优点,成为最具有应用前景的近红外单光子探测器件之一[6-10]。
当前,InGaAs/InP SPAD主流结构为吸收渐变电荷倍增分离(Separate Absorption Grading Charge Multiplication,SAGCM)结构,其特点是将吸收区与倍增区分离,吸收层用In0.53Ga0.47As(常温下Eg=0.75 eV)材料吸收近红外光子,倍增层选取具有高碰撞电离系数比的InP(常温下Eg=1.35 eV)材料。在InP帽层中,P+有源区与N区形成的空间电荷区作为器件的倍增区,其中本文研究的P+有源区由两次Zn扩散形成[11-12]。两次Zn扩散结构首先由第一次掩膜形成深度较深、浓度较高的深扩散结构,随后利用第二次掩膜形成深度较浅、浓度较低的浅扩散结构。两次Zn扩散结构可以将器件雪崩击穿所需的大电场集中在深扩散下方倍增区,从而产生可以被检测到的宏观信号,使光生载流子能被有效探测。浅扩散可以有效降低倍增区边缘的尖峰电场,避免倍增区发生过早的边缘击穿现象,从而提升相同过偏压下倍增区中心的雪崩击穿概率,且可以在不使用额外保护环结构的条件下来减小像素的间距,有利于制造大规模SPAD阵列。设计合理的两次Zn扩散的结构参数对器件的性能,尤其是雪崩击穿概率有着至关重要的影响,是决定器件光子探测效率进而实现单光子探测能力的重要参数[13-14]。
2003年,WANG S等使用MCINTYRE的电离模型得出相比于倍增区较薄的器件,倍增区较厚的器件在过偏压下具有更尖锐的雪崩击穿概率曲线[15]。2007年,TAN S L等在此基础上,用一个简单的随机电离路径长度模型研究了单光子雪崩二极管的雪崩击穿概率,模拟结果表明,增加倍增区厚度并不一定会增加同一过偏压下的雪崩击穿概率。雪崩击穿概率对一定的电离阈值能敏感,高于该阈值能级时,死空间效应更为明显,而低于该阈值能级时碰撞电离系数比k*成为控制因素。所以在较高的电离能下,在薄倍增区中死空间占主导地位,减小倍增区宽度将导致雪崩击穿概率在过偏压下发生更尖锐的转变[16]。
上述文献报道的器件都是通过传统的外延生长形成P+区,而非使用两次Zn扩散形成P+有源区。两次Zn扩散参数对InGaAs/InP SPAD器件雪崩击穿概率影响的相关研究还比较匮乏。本文研究了两次Zn扩散深度差、Zn扩散横向扩散因子、Zn掺杂浓度、温度参数对器件雪崩击穿概率的影响,给出了实现最佳光子探测效率的Zn扩散结构参数。本文工作对从理论设计到工艺优化上实现高性能InGaAs/InP SPAD器件具有重要的指导意义。
1 器件结构设计
本文设计的InGaAs/InP SPAD器件采用平面背照式结构[17],器件的基本架构如图1所示,为SAGCM结构,像素直径为15 μm,器件具体结构参数如表1所示。首先在n型重掺杂InP缓冲层上生长一层与其晶格匹配的In0.53Ga0.47As(后文均称为InGaAs)材料作为吸收层,可以有效地吸收波长范围在900 nm~1 700 nm的光子并产生相应的光生载流子。随后生长n型重掺杂InP作为电荷层,通过改变该层厚度与掺杂浓度可以有效地控制器件的电场分布[18],使得倍增区电场强度足够大以实现雪崩击穿,并且将吸收区电场强度限定在一定范围内,使其不会产生过大的隧穿电流。为了防止载流子在InP和InGaAs之间的异质界面处累积,在吸收层与电荷层之间生长本征InGaAsP渐变层以改善价带不连续的现象[19]。最后在电荷层上生长本征InP帽层,并通过两次扩散Zn元素,形成了器件的P+有源区。其中Tshallow为浅扩散深度,W1为浅扩散横向扩散长度,Tdeep为深扩散深度。其中深扩散区域通过第一次掩模形成,深度Tdeep为2.3 μm,Zn掺杂浓度为5×1018cm-3。再通过第二次掩膜形成浅扩散区域,深度Tshallow为1.7 μm,Zn掺杂浓度为3×1018cm-3。Zn扩散的横向扩散因子(W1/Tshallow)为0.8。深扩散将击穿所需的大电场集中在倍增区,而浅扩散的加入可以避免深扩散区域过早的边缘击穿,从而在不使用保护环结构的条件下使得像素更加紧凑,有助于提高SPAD阵列的集成度。
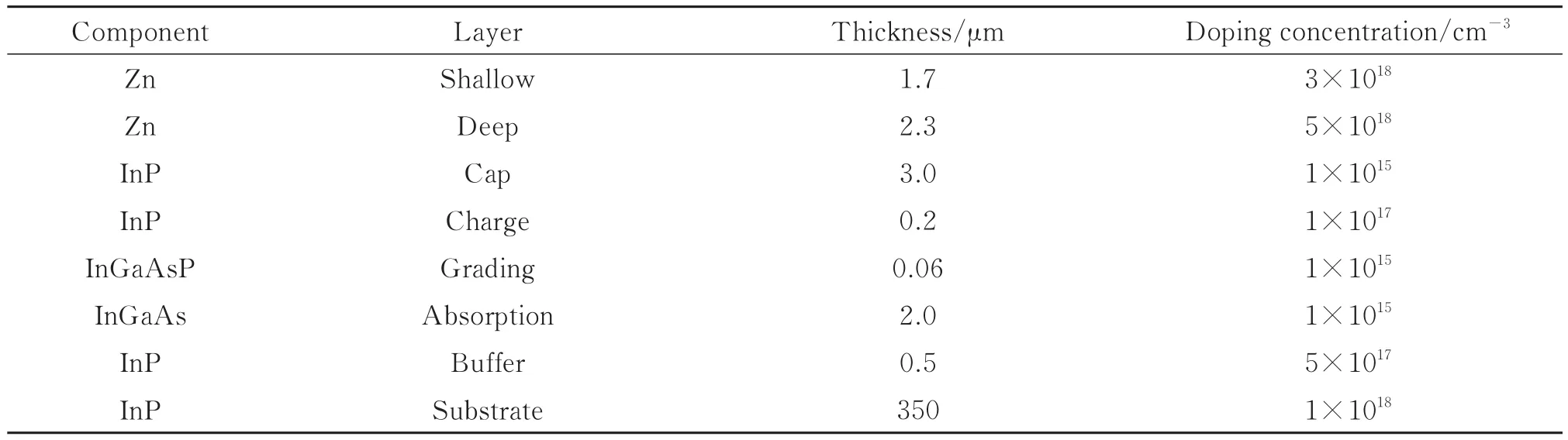
表1 器件结构参数Table 1 Device structure parameters
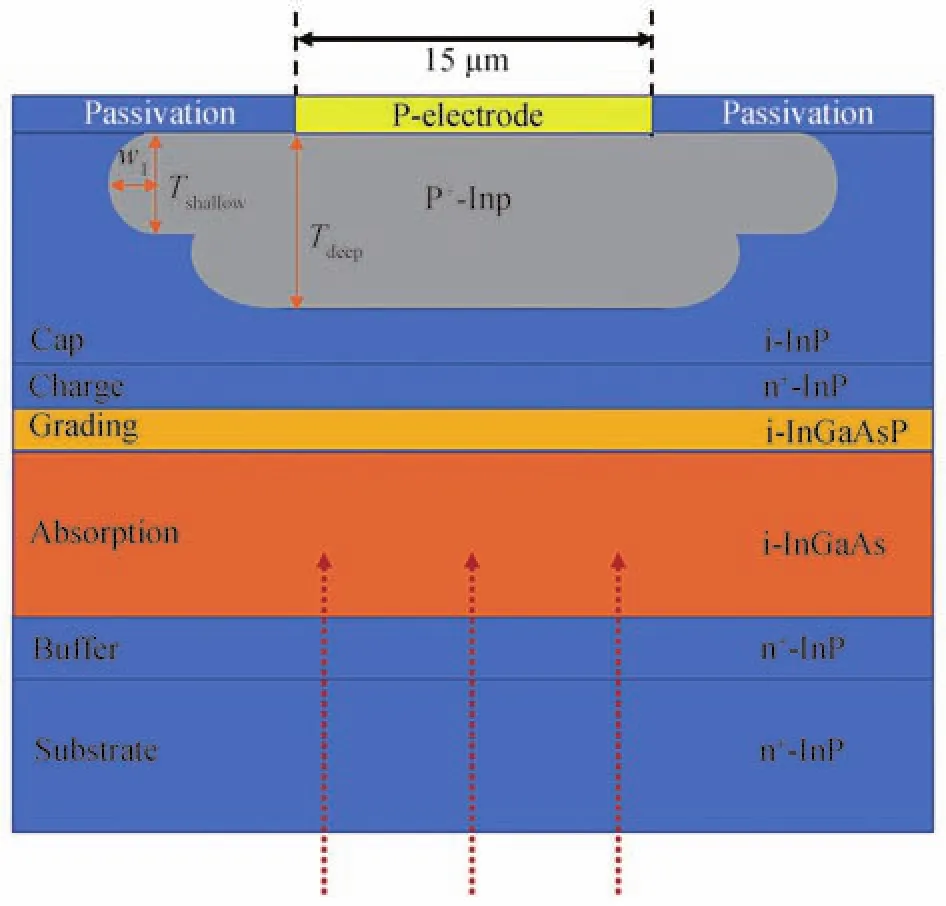
图1 背照式InGaAs/InP SPAD内部结构Fig.1 Internal structure of back-illuminated InGaAs/InP SPAD
2 器件仿真结果
2.1 物理模型
器件的电学模拟,主要选用了漂移-扩散模型、热电子发射模型、SRH复合模型、俄歇复合模型、辐射复合模型、击穿模型等[20]。因为器件是在InP材料区域发生雪崩倍增,所以对InP材料选取合适的碰撞电离系数模型成为正确预测雪崩击穿参数的关键。本文使用与温度和电场相关的van Overstraeten模型[21],模型中碰撞电离系数β及参数因子γ的表达式如式(1)和式(2)所示,我们将文献[22-23]中报道的模型拟合到TCAD环境中,选取的InP碰撞电离系数模型参数如表2所示。

表2 InP材料van Overstraeten模型的参数Table 2 Parameters of the van Overstraeten model for InP materials
式中,β为碰撞电离系数,Fava为电场驱动力,当电场强度小于E0时,系数选择alow与blow,反之则选择ahigh与bhigh。因子γ由光学声子能量ℏωop与温度T共同决定。
对于器件的光学特性仿真,通过指定入射光的入射角、波长、强度、偏振等信息,为光学求解器提供光学激发参数。由于入射光的吸收主要发生在InGaAs层,所以对InGaAs材料的吸收系数α选取的准确性是非常重要的。模型中对吸收参数α的定义如式(3)所示,基于文献[24-25]我们选取了合适的参数以使仿真结果更加匹配实际情况。
2.2 电场分布
首先,对所设计器件的电场分布进行仿真,如图2(a)所示为器件工作在击穿电压下的电场分布,工作温度为255 K。从图2中可以看出,高电场分布区域主要集中在第一次Zn扩散的深扩散区域下方,而第二次Zn扩散的浅扩散区域周围电场较低。因此,这种结构可以很好地将雪崩倍增限制在深扩散区域下方,不仅有助于提高雪崩击穿概率,而且可以有效地避免边缘场强较高导致过早边缘击穿。图2(b)是平行于Y轴沿中心随着器件厚度增加的电场强度分布,可以看出,电场强度从1.4 μm处开始增大,在2.3 μm处达到最大值,高电场集中分布在2.1 μm~3 μm之间区域,电场强度在大于InP帽层厚度3.0 μm之后迅速下降。通过对电荷层掺杂浓度以及厚度的合理设计,吸收区电场强度控制在理想的范围内(小于100 kV/cm),不会产生过大的隧穿电流。

图2 电场模拟与垂直方向分布Fig.2 Electric field simulation diagram and vertical distribution
2.3 I-V与PDE特性
器件在255 K的温度下有光照与无光照的I-V特性曲线如图3(a)所示,其中光照条件下采用的是1 550 nm波长的光源,光照强度为0.1 W/cm2。InP对该波长是透明的,光子不会被吸收,所以光电流产生即代表InGaAs吸收层被耗尽。穿通电压(耗尽区扩散至吸收层时器件两端的电压)为47.3 V,击穿电压(电流达到10 μA时的电压)为69.5 V。在光照条件下,器件的电流明显增大,表明其对该波段光子具有良好的吸收能力。图3(b)为器件在5 V过偏压时PDE与波长的关系。在950 nm~1 650 nm的宽光谱区域探测效率均大于25%,其中常用的通讯波段1 550 nm处的探测效率为27%,该结果证明了器件在近红外区域单光子探测的有效性。PDE与器件量子效率、雪崩击穿概率以及填充因子等因素有关。本文设计的器件采用背照式结构,光子从背面入射,可以保证器件有接近100%的填充因子。因此,提高PDE的一个主要途径就是提高载流子在倍增区的雪崩击穿概率。

图3 I-V特性与PDEFig.3 I-V characteristics and PDE
2.4 雪崩击穿概率
雪崩击穿概率指的是单个载流子或电子空穴对触发自持雪崩的概率。与雪崩击穿电压不同,雪崩击穿概率是指在雪崩击穿电压之上(盖革模式),雪崩事件发生的概率随过偏压、电场强度及温度变化的函数。表达式为[26]
式中,PA(0)为吸收区向倍增区注入载流子的雪崩击穿概率,PA(x)为位于x处的雪崩击穿概率。其中x=0对应于电荷层的开始,x=W=WCha+WAva+W(PWCha是电荷层厚度,WAva是倍增区厚度,WP是P+区域中耗尽区的宽度)对应于P+区域耗尽区的边缘。α(x)和β(x)分别为电子和空穴位于x处的碰撞电离系数。
如图4(a)所示,在仿真中通过选取van Overstraeten模型,计算了器件在T=255 K,过偏压Vex=5 V时,耗尽区光生载流子可能触发自持雪崩的概率,图4(b)是沿平行于x轴截取的雪崩击穿概率分布曲线。结果表明,通过采用两次Zn扩散结构,并设置合理的掺杂浓度、扩散深度以及横向扩散尺寸,击穿区域被很好的限制在了深扩散下方倍增区,倍增区中心的雪崩击穿概率接近30%,同时也避免了过早边缘击穿的发生。因为存在曲率效应,倍增区边缘电场强度较大,所以边缘处的雪崩击穿概率会大于中心区域。

图4 雪崩击穿概率模拟图与水平方向分布Fig.4 Avalanche breakdown probability simulation diagram and horizontal distribution
雪崩击穿概率与两次Zn扩散深度差(Tdeep-Tshallow)、Zn扩散的横向扩散因子(W1/Tshallow)、Zn掺杂浓度、温度等参数密切相关,下文将对这几种情况下的雪崩击穿概率进行深入具体地研究。
3 Zn扩散对器件雪崩击穿概率特性影响
3.1 两次Zn扩散深度差对雪崩击穿概率的影响
在深扩散深度(Tdeep)固定不变的情况下,研究了温度为255 K,过偏压为5 V时不同浅扩散深度(Tshallow)器件雪崩击穿概率的变化情况,其中深扩散深度为2.3 μm,浅扩散深度由1.2 μm到2.1 μm变化。图5(a)是沿平行于x轴方向截取的器件雪崩击穿概率分布曲线。由图中可以看出,浅扩散深度越深,器件雪崩击穿概率越大。当浅扩散深度为1.2 μm时,倍增区中心雪崩击穿概率仅为18%左右,而当浅扩散深度为2.1 μm时,雪崩击穿概率最大可以达到36%,增长了将近一倍。图5(b)是沿平行于x轴方向不同Tshallow在同一过偏压下的电场强度分布。可以看出,雪崩击穿概率变化的主要原因是倍增区电场强度发生了变化。浅扩散深度越深,倍增区的电场强度也越大,所以载流子的碰撞电离率也会相应增大,从而引起雪崩击穿概率的提高。同时,较高的电场强度也有利于光生载流子的漂移运动,可以提高器件的时间响应。

图5 Vex=5 V时不同Tshallow雪崩击穿概率与水平电场分布Fig.5 Different Tshallow avalanche breakdown probability and horizontal electric field distribution at Vex =5 V
另一方面,由图5(a)可以看出,当浅扩散深度大于一定值时,器件还会在倍增区以外的区域发生击穿,这是器件设计中应该避免的。为研究产生该现象的原因,从图5(b)电场分布曲线可以看出,由于浅扩散深度的不断增加,器件倍增区外的电场强度也随之不断提高,当浅扩散深度大于1.8 μm时,倍增区外的电场强度已经大于InP材料的临界击穿电场强度,导致倍增区以外出现了明显的非理想击穿现象。为了寻找浅扩散深度的最佳目标值,进一步研究了Tshallow等于1.6 μm、1.7 μm时的雪崩击穿概率,1.5 μm到1.7 μm的雪崩击穿概率曲线如图5(c)所示。结果表明,当Tshallow小于1.7 μm时,击穿能够很好地限制在深扩散区域以下的倍增区。
因此,当深扩散的深度设计为2.3 μm时,浅扩散深度的最佳目标值为1.7 μm。所以在设计时为了保证器件具有良好的单光子响应性能,应尽可能将深扩散与浅扩散的深度差控制在合理的范围内,使得器件不会在倍增区外发生非理想击穿,同时也要兼顾电场强度的分布,因为电场强度也影响到器件的时间响应等特性。
3.2 Zn扩散横向扩散因子对雪崩击穿概率的影响
在半导体制造过程中,通过掩膜版进行扩散形成PN结时,由于杂质扩散为各向异性,热过程中杂质会形成横向扩散。通过改变工艺参数与条件,可以对扩散形貌进行一定的控制。在仿真中定义杂质的扩散轮廓类型为高斯分布,并通过选择横向扩散因子(Factor)来定义横向展宽参数,横向扩散因子表达式为
在浅扩散其余条件固定不变的情况下,研究了器件在温度为255 K,过偏压为5 V条件下,深扩散采用不同横向扩散因子时的雪崩击穿概率,图6是沿平行于x轴方向截取的器件雪崩击穿概率分布曲线。结果表明,当横向扩散因子从0.6增加到1.2时,器件倍增区中心部分雪崩击穿概率逐渐增大,而倍增区边缘的雪崩击穿概率逐渐减小。因此增加横向扩散因子,可以有效降低PN结边缘的曲率效应,从而降低边缘的局部电场。考虑到实际工艺中的可操作性,应尽量将横向扩散因子控制在0.7~0.8之间[27],以降低边缘击穿概率与中心区域的差值,从而避免过早的边缘击穿。

图6 Vex=5 V时不同横向扩散因子的雪崩击穿概率Fig.6 Avalanche breakdown probability of different lateral diffusion factor at Vex=5 V
3.3 深扩散与浅扩散Zn掺杂浓度对雪崩击穿概率的影响
在浅扩散Zn掺杂浓度为3×1018cm-3不变,温度为255 K,过偏压为5 V的条件下,分别研究了深扩散Zn掺杂浓度为 5×1018cm-3、7×1018cm-3、1×1019cm-3、1.2×1019cm-3时雪崩击穿概率曲线的变化情况,图7(a)和(b)分别是是沿平行于x轴方向截取的不同深扩散Zn掺杂浓度的器件雪崩击穿概率曲线和电场分布曲线。结果表明,同一扩散深度下,随着深扩散Zn掺杂浓度的升高,相同过偏压条件下雪崩击穿概率会逐渐降低。AHMED J等的研究结果指出,随着耗尽区宽度的增加,相同过偏压下的工作电场会降低,但空穴与电子的碰撞电离系数比β/α会上升,较大的β/α值会使得雪崩击穿概率在过偏压下增长的更快[28-29]。所以出现该结果的原因可以解释为,当深扩散深度不变时,深扩散掺杂浓度的增加,会使P+区域的耗尽区宽度随掺杂浓度的增加而减小,式(4)中能够发生有效倍增的W厚度也随深扩散掺杂浓度的增加而减小,因此导致工作电场增大且β/α值降低,引起相同过偏压下雪崩击穿概率的降低。图7(c)是提取的不同深扩散掺杂浓度相同过偏压下电场强度与β/α的值。可以看出,掺杂浓度增大引起耗尽区变薄,电场强度变大,且β/α的值也变小,该变化趋势与上述报道结果一致。

图7 Vex=5 V时不同深扩散Zn掺杂浓度的雪崩击穿概率、水平电场分布与碰撞电离系数比Fig. 7 Avalanche breakdown probability, horizontal electric field distribution and collision ionization coefficient ratio of different deep diffusion Zn doping concentrations at Vex=5 V
同样的,当固定深扩散Zn掺杂浓度为1.2×1019cm-3时,分别研究了浅扩散Zn掺杂浓度为5×1018cm-3、7×1018cm-3、9×1018cm-3、1.1×1019cm-3时雪崩击穿概率曲线的变化情况。结果表明,不同浅扩散Zn掺杂浓度器件倍增区的电场强度基本一致,且相应的碰撞电离系数无明显影响,故雪崩击穿概率也不会发生明显变化。因此,在实际器件研制中,考虑到Zn扩散工艺的成熟度,可降低对浅扩散的工艺要求,严格控制深扩散的掺杂浓度。
3.4 温度对雪崩击穿概率的影响
由碰撞电离理论可知,温度越高,晶格振动越剧烈,发生碰撞电离就需要更高的电场,也就需要更高的电压,所以InGaAs/InP SPAD器件的雪崩击穿电压与工作温度呈正相关。因此,需要首先确定器件在不同温度下的击穿电压,图8(a)是器件工作在不同温度时的I-V特性仿真结果。从图中可以看出,当温度为255 K时,击穿电压为69.5 V;当温度为300 K时,击穿电压升为77.1 V。结果表明,雪崩击穿电压随工作温度变化的趋势与理论一致。图8(b)研究了不同温度下过偏压为5 V时的雪崩击穿概率,结果表明,器件的温度越低,雪崩击穿概率也就越大。图9为雪崩击穿概率、雪崩击穿电压与器件工作温度的关系。从图中可以看出,击穿电压随着温度的升高而线性升高,相应的,雪崩击穿概率随温度的升高而降低,当温度为255 K时,雪崩击穿概率接近30%,而在300 K时,雪崩击穿概率降至23%。所以在使用InGaAs/InP SPAD时,需要尽可能将探测器进行制冷以提高PDE同时降低暗噪声。并且较低的温度也可以降低击穿电压,使器件更容易小型化、集成化。
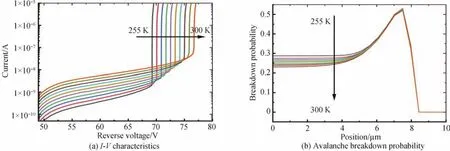
图8 不同温度下的I-V特性与雪崩击穿概率Fig.8 I-V characteristics and avalanche breakdown probability at different temperatures

图9 击穿电压与雪崩击穿概率随温度的变化曲线Fig.9 Variation curve of breakdown voltage and avalanche breakdown probability with temperature
4 结论
本文针对InGaAs/InP SPAD进行了器件结构设计与数值仿真,得到了相应的电学与光学参数。研究了不同Zn扩散参数对器件雪崩击穿概率的影响。研究表明,在深扩散深度一定的情况下,浅扩散深度存在最佳目标值。浅扩散深度越深,相同过偏压条件下器件倍增区中心的电场强度越大,雪崩击穿概率也越大。与此同时,为了防止在倍增区外发生不必要的击穿,还应控制浅扩散与深扩散的深度差。通过Zn扩散不同横向扩散因子对雪崩击穿概率的影响研究发现,横向扩散因子越大,器件倍增区中心雪崩击穿概率越高,而倍增区边缘雪崩击穿概率随横向扩散因子增大而降低。考虑到实际工艺中的可操作性,应尽可能将横向扩散因子控制在0.7~0.8之间以避免过早的边缘击穿。此外,在扩散深度不变的情况下,随着深扩散Zn掺杂浓度的升高,相同过偏压条件下雪崩击穿概率会逐渐降低。而浅扩散Zn掺杂浓度对雪崩击穿概率基本没有影响。最后研究了不同温度对雪崩击穿概率的影响,温度越高,击穿电压越大,相同过偏压下的雪崩击穿概率越低,所以器件应尽可能制冷工作。
本文研究结果可以更好地指导InGaAs/InP SPAD器件设计、提高器件探测效率、降低暗计数。此外,相关研究工作也可为器件工作点的选择提供参考,保证器件工作在最佳状态,实现器件的最优化应用。
