氧化硅层厚度对Si/SiO2界面电子态结构与光学性质的影响
2023-03-06王安琛黄忠梅黄伟其张茜刘淳王梓霖王可刘世荣
王安琛,黄忠梅,4,黄伟其,,张茜,刘淳,王梓霖,王可,刘世荣
(1 贵州大学 材料与冶金学院 纳米光子物理研究所,贵阳 550025)
(2 海南师范大学 物理与电子工程学院,海口 571158)
(3 中国科学院地球化学研究所 环境化学国家重点实验室,贵阳 550003)
(4 复旦大学 表面物理国家重点实验室 微纳光子结构教育部重点实验室,上海 200433)
0 引言
很多氧化硅的能带结构是直接带隙结构,但带隙较宽,晶体氧化硅的能带带隙在5 eV 以上,非晶氧化硅的能带带隙在8 eV 以上,均不利于发光和光伏应用[1-2]。氧化硅上硅晶薄膜是在氧化硅衬底上生长的纳米硅晶,氧化硅上的硅纳米晶一般指厚度在几个纳米以内的硅晶体薄膜[3-4]。由于量子限制效应(Quantum Confinement Effect,QCE),在氧化硅上生长硅纳米晶薄膜可以构建边缘电子态,有效降低能带带隙[5-6]。氧化硅上硅纳米结构材料是一种具有复杂结构形态的低维小量子体系[7-8],一般来说具有三层结构,即Si 纳米晶层、嵌入在SiO2或SiOx薄膜中的Si 纳米晶界面和SiO2层[9-10]。氧化硅上硅晶薄膜界面处电子会在特定能量处出现空间局域场,使边界产生边缘电子态[11-12],在氧化硅上硅晶薄膜中,氧化硅层起到势垒层的作用,可以限制载流子在纳米硅表面的作用[13-14],并且氧化硅的稳定性和可靠性好,在Si/SiO2界面能够降低纳米硅晶表面的悬挂键,能够很好地控制界面陷阱和固定电荷[15-16]。PAVESI L 等[17]研究发现通过将负离子注入到超纯石英衬底或在Si 衬底上热生长二氧化硅,所制备的氧化硅上硅纳米结构会产生良好的发光,这是因为氧化硅上生长硅纳米结构产生了直接带隙,该研究提供了一种新的能带工程研究路径,即在氧化硅上生成硅晶薄膜[18-19]。对氧化硅上硅纳米结构光致发光的研究表明,在量子尺寸内,通过改变Si/SiO2结构中的Si 层的厚度,可以实现能带带隙的调控[20-21]。氧化硅上硅纳米结构的带隙随着Si 层厚度的降低而增大,这是由于量子限制效应,费米能级附近的电子能级由连续态分裂成离散的能级[22-23]。WAGNER J M 等[24]通过第一性原理计算结合实验中光致发光分析,研究了Si 层厚度和界面结构对Si/SiO2超晶格能带带隙的影响,从光致发光测量中得出Si 层厚度下降带隙变大的线性变化与第一性原理计算Si/SiO2界面的能带带隙变化一致,Si/SiO2界面存在电子能带带隙的量子限制效应。根据量子限制效应模型,当硅纳米晶尺寸减小时,氧化硅上硅纳米材料的带隙会变大,并在导带和价带中产生量子能级。2020 年,NESTOKLON M O 等[25]通过第一性原理,使用分子动力学改性后的β-方石英作为氧化硅上的硅纳米结构的SiO2层,改性后的β-方石英为直接带隙材料,其能带带隙为7.38 eV,与非晶石英能带近似,导带底和价带顶的极值点位于Γ点。之后计算了氧化硅上的硅纳米结构的吸收光谱,结果与实验数据吻合,并发现氧化硅上的硅纳米结构的高能吸收主要是由氧化硅上硅纳米晶体内部的空穴和SiO2层中的电子传输速率增强所引起的。
如果氧化硅上的硅纳米材料能够实现高效稳定的光致发光和电致发光,它们就有可能在摩尔定律逐渐失效的集成电路制造行业引发一场新的信息革命[26-27]。目前第一性原理计算方法已成为在微观方面研究Si/SiO2界面材料物理性质的一种可靠的理论研究方法[28-29]。本文采用密度泛函理论通过第一性原理研究块体α-方石英、不同厚度的薄膜α-方石英和不同氧化硅层厚度的Si/SiO2界面模型,得出氧化硅层厚度对Si/SiO2界面的电子态结构和光学性质的影响。研究结果显示,块体α-方石英、不同厚度的薄膜α-方石英和不同氧化硅层厚度的Si/SiO2界面均为直接带隙半导体;调控薄膜α-方石英厚度和Si/SiO2界面氧化硅层厚度可以引进边缘电子态,调控Si/SiO2界面带隙进入1~2 eV 区间,这将在发光和光伏领域有广阔的应用前景。
1 理论模型与计算方法
1.1 理论模型
本文构建的α-方石英(α-cristobalite)和Si/SiO2界面为纳米晶体结构。首先是α-方石英模型的建立,先沿[100]切割α-cristobalite 晶胞,得到α-cristobalite 纳米薄膜,通过改变模型的长度得到1.047~2.887 nm 的5组α-cristobalite 结构模型。Si 的晶格常数为5.431,α-cristobalite 的晶格常数为4.978,Si 与α-cristobalite 的晶格失配度为8.3%,在界面材料模拟计算的允许范围内。Si/SiO2界面模型的建立,沿[100]切割Si 晶胞,建立厚度为4 层Si(Si 厚度约为0.54 nm)的Si 纳米薄膜。分别将Si 纳米薄膜和之前建立的α-cristobalite 纳米薄膜使用分层建模构建在一个模型中,α-cristobalite 薄膜表面与Si 薄膜表面采用双键模型(Double Bond Model,DBM),通过一个O 原子连接次表面层中的两个Si 原子,并使之成键饱和,之后用Si-O 键连接硅层和氧化硅层构建Si/SiO2界面结构。给所建立的Si/SiO2界面模型添加2 nm 的真空层,即真空层表面距离薄膜最外层原子的距离为2 nm,在这个距离下可以忽略Si/SiO2界面周期性边界条件的影响。最后,在构建好的Si/SiO2界面两端采用H 原子饱和钝化,这样弛豫优化可以得到Si/SiO2界面的最小能量值,保证构建的Si/SiO2界面结构稳定。
1.2 计算方法
块体α-方石英、薄膜α-方石英和Si/SiO2界面模型的建立使用构建超晶胞结构的方法,通过第一性原理采用密度泛函理论,并使用周期性边界条件,计算研究氧化硅厚度对Si/SiO2界面电子态结构和光学性质的影响。基于密度泛函理论的第一性原理计算实质是求解Kohn-Sham 方程,电子和离子间的相互作用采用超软赝势,交换关联能使用广义梯度近似(Generalized Gradient Approximation/Perdew Burke Ernzerhof,GGA/PBE)。选择对称正定迭代矩阵算法(Broyden Fletcher Goldfarb Shanno,BFGS)对模型块体α-方石英、薄膜α-方石英和Si/SiO2界面进行几何结构优化,弛豫优化块体α-方石英、薄膜α-方石英和Si/SiO2界面计算其电子能带结构与光学性质,计算Si/SiO2界面光学性质时,K点网格数设置为5×5×1。在计算精度上设置块体α-方石英、薄膜α-方石英和Si/SiO2界面模型原子间的相互作用力最大值为0.05 eV/Å(1 Å=0.1 nm)晶体内应力收敛标准为0.1 GPa,自洽场(Self Consistent Field,SCF)收敛精度设置为2×10−6eV/atom。
2 块体α-方石英、薄膜α-方石英和Si/SiO2界面的电子态结构
2.1 块体α-方石英的电子态结构
α-方石英属于四方晶系,密度约为2.22 g/cm3。晶胞大小为a=b=0.497 8 nm,c=0.694 8 nm。α-方石英在473℃~548℃下会通过相变转变为β-方石英。
在图1 块体α-方石英的能带结构图中,禁带宽度Eg=5.666 eV。能带导带底和价带顶都对应G点,是直接带隙半导体。

图1 块体α-方石英的能带结构Fig.1 Energy band structure of block α-cristobalite
态密度作为能带的可视化结果,从图2 块体α-方石英的总态密度和分波电子态密度图中可以得出块体α-方石英的总的电子态密度的具体构成。块体α-方石英的总态密度对应的能量本征值区间分别在−20~−17 eV、−10~−4.5 eV 和−3~0 eV,在费米面的两侧,块体α-方石英的电子分布变化相对比较平缓,在−17 eV 附近有一个非常陡峭的峰,由块体α-方石英分波电子态密度图可知,这个峰主要来自于氧原子2s 态电子的贡献,同时也说明α-方石英中氧原子的2s 态电子的能量比硅原子3s 态电子能量高。块体α-方石英的分波电子态密度中,氧原子的2s 态电子的能量本征值主要分布区间分别在−20~−17 eV,2p 态电子的能量本征值主要分布区间分别在−10~−4.5 eV 和−3~0 V;硅原子的3s 态电子的能量本征值主要分布区间分别在−19~−17 eV 和−9~−5 eV,3p 态电子的能量本征值主要分布区间分别在−18~−17 eV、−8~−5 eV 和−3~0 eV。块体α-方石英在能量本征值区间−10~−4.5 eV 的电子态密度主要来自于氧原子2p态电子的贡献,当然还有硅原子3p 态电子和硅原子3s 态电子的贡献,块体α-方石英在能量本征值区间−3~0 eV 的电子态密度主要来自于氧原子2p 态的贡献和硅原子3p 态。

图2 块体α-方石英的总态密度和分波电子态密度Fig.2 Total density of states and partial electron density of bulk α-cristobalite
2.2 薄膜α-方石英的电子态结构
图3 为五种不同厚度的薄膜α-方石英界面的结构,薄膜α-方石英厚度分别为1.047、1.394、1.842、2.438、2.887 nm。图4 为不同厚度时薄膜α-方石英的能带结构。从图中可以看出,在5 种不同厚度下,薄膜α-方石英均为直接带隙的半导体材料,随着薄膜α-方石英厚度的降低,α-方石英的导带底不断向高能级方向移动,能带结构中的价带和导带显得更加稀疏。图5 描述了α-方石英的带隙与α-方石英厚度之间的关系,随着α-方石英厚度从2.887 nm 降低到1.047 nm,薄膜α-方石英带隙从5.233 eV 升高到了5.927 eV,表现出明显的量子限制效应。

图3 不同厚度的薄膜α-方石英结构Fig.3 Structure of α-cristobalite film with different thickness.

图4 不同α-方石英厚度时薄膜α-方石英的能带结构Fig.4 Energy band structure of α-cristobalite film with different α-cristobalite thickness

图5 薄膜α-方石英的能带带隙与α-方石英厚度的关系Fig.5 Relationship between the band gap of α-cristobalite and the thickness of α-cristobalite in thin films
2.3 Si/SiO2界面的电子态结构
图6 为五种不同氧化硅层厚度时的Si/SiO2界面的结构,这五种Si/SiO2界面结构硅层厚度均为4 层(约0.54 nm),氧化硅层厚度分别为1.047、1.394、1.842、2.438、2.887 nm(氧化硅层厚度与5 种不同厚度的薄膜α-方石英分别相等)。图7 为不同氧化硅层厚度时Si/SiO2界面的能带结构图。从图中可以看出,在1.047~2.887 nm 的氧化硅层厚度范围内,Si/SiO2界面的能带结构导带形态均为高对称点F和Q高,G点低。能带结构价带形态均为高对称点F和Q低,G点高。能带形态总体变化不大,且Si/SiO2界面能带的价带顶和导带底均在高对称点G,因此Si/SiO2界面属于直接带隙的半导体材料,可以应用制作良好的发光器件。图8给出了Si/SiO2界面的带隙与氧化硅层厚度之间的关系,随着氧化硅厚度从2.887 nm 减小到1.047 nm,Si/SiO2界面能带带隙从1.62 eV 升高到1.782 eV。Si/SiO2界面氧化硅层厚度的减小,量子限制效应表现突出,能带带隙逐渐增大。Si/SiO2界面导带底随着氧化硅层厚度降低向高能级方向移动。氧化硅层厚度变化引起的Si/SiO2界面电子态结构变化与薄膜α-方石厚度改变引起的电子态结构变化相似。

图6 不同氧化硅层厚度的Si/SiO2界面结构Fig.6 Structure of Si/SiO2 interface with different thickness of silicon oxide layer

图7 不同氧化硅层厚度时Si/SiO2界面的能带结构Fig.7 Energy band structure of Si/SiO2 interface with different thickness of silicon oxide layer
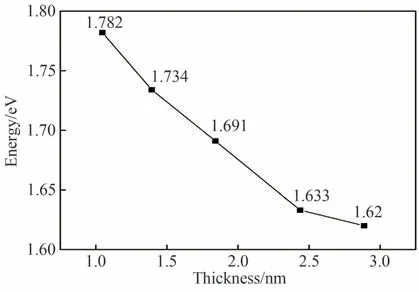
图8 Si/SiO2界面的能带带隙与氧化硅层厚度的关系Fig.8 Relationship between energy band gap of Si/SiO2 interface and thickness of silicon oxide layer
图9 为氧化硅层厚度1.047 nm 和2.887 nm 的Si/SiO2界面的总态密度和分波电子态密度图。氧化硅层厚度1.047 nm 的Si/SiO2界面态密度和分波态密度均整体低于氧化硅层厚度2.887 nm 的Si/SiO2界面,态密度降低的原因是氧化硅层厚度降低,由量子限制效应导致能带带隙增大,电子的重叠杂化减弱。氧化硅层厚度1.047 nm 的Si/SiO2界面总态密度对应的能量本征值区间在−22.5~−19.5 eV 和−12.5~0 eV,氧化硅层厚度2.887 nm 的Si/SiO2界面总态密度对应的能量本征值区间在−21.5~−19 eV 和−11.5~0 eV。氧化硅层厚度2.887 nm 的Si/SiO2界面在−20 eV 有一个陡峭的峰,氧化硅层厚度降低后,这个峰向右移动了0.5 eV。氧化硅层厚度1.047 nm 的Si/SiO2界面在−19.5 eV 有一个非常陡峭的峰,由图2 块体α-方石英的总态密度和分波电子态密度图可知,这个峰主要来自于Si/SiO2界面氧化硅层氧原子2s 态电子的贡献,这是因为氧化硅层中氧原子的2s 态电子的能量比硅的3s 态电子的能量值高。在费米面以下附近,Si/SiO2界面电子态密度主要来自于氧原子2p 态的贡献。

图9 氧化硅层厚度为1.047 nm 和2.887 nm 的Si/SiO2界面的总态密度和分波电子态密度Fig.9 The total density of states and the density of partial wave electrons at the Si/SiO2 interface with the thickness of the silicon oxide layer of 1.047 nm and 2.887 nm
3 Si/SiO2界面的光学性质
Si/SiO2界面的光学性质使用光学常数的物理量介电函数虚部和吸收系数来描述。在光学性质的计算中基于第一性原理探究氧化硅层厚度改变引起Si/SiO2界面介电函数虚部和吸收系数的变化。Si/SiO2界面介电函数能够很好地反映出电子在能带间跃迁的微观物理过程。在线性响应范围内,固体的光学性质通常由介电函数描述:ε(ω)=ε1(ω)+iε2(ω)。其中ω是光子频率,ε1(ω)为介电函数实部,ε2(ω)为介电函数虚部,Si/SiO2界面的介电函数可以表征电子的占有态与非占有态之间的跃迁。
3.1 氧化硅层厚度对介电函数虚部的影响
Si/SiO2界面介电函数的虚部ε2表示Si/SiO2界面内部形成电偶极子时所消耗的能量,决定Si/SiO2界面在较小波矢下对光的线性响应。图10 是1.047~2.887 nm 氧化硅层厚度下,Si/SiO2界面的介电函数虚部ε2的变化曲线。在1.047~2.887 nm 的氧化硅层厚度范围内,Si/SiO2界面的介电函数虚部ε2在4.5 eV 附近存在一个介电峰,并且随着光子能量的增大,Si/SiO2界面的介电函数虚部ε2不断减小,最终在15 eV 趋近于0。随着氧化硅层厚度的减小,Si/SiO2界面的介电峰向右略微移动,并且这个介电峰的峰值不断升高。这是由Si/SiO2中氧化硅层厚度降低,Si/SiO2界面的能带带隙升高引起的。氧化硅层厚度降低,Si/SiO2界面态密度在费米面左侧附近减小,电子的重叠杂化减弱,因此内部形成电偶极子时所消耗的能量增大。

图10 Si/SiO2界面介电函数虚部随氧化硅层厚度的变化关系Fig.10 Relationship between imaginary part of dielectric function of Si/SiO2 interface and thickness of silicon oxide layer
3.2 氧化硅层厚度对吸收系数的影响
图11 是1.047~2.887 nm 氧化硅层厚度下,Si/SiO2界面吸收系数随氧化硅层厚度的变化曲线。由图可知,在低于1.5 eV 的范围内,Si/SiO2界面对光能量的吸收几乎为0。Si/SiO2界面对光能量的吸收主要集中在1.5~13.5 eV,因此Si/SiO2界面主要吸收紫外线和可见光。Si/SiO2界面在6 eV 附近存在一个吸收峰,Si/SiO2界面吸收峰的峰值和峰位与SiO2层厚度密切相关,Si/SiO2界面吸收系数的吸收峰的峰值也随氧化硅层厚度减小而显著增大,且峰位向高能量方向进行移动,产生了蓝移。

图11 Si/SiO2界面吸收系数随氧化硅层厚度的变化关系Fig.11 Relationship between absorption coefficient of Si/SiO2 interface and thickness of silicon oxide layer
3.3 氧化硅层厚度对折射率的影响
图12 是Si/SiO2界面折射率随氧化硅层厚度的变化关系。Si/SiO2界面折射率在低能级区域出现了一个较大峰值。在6 eV 附近,Si/SiO2界面折射率的变化趋势出现拐点。氧化硅层厚度减小,在6 eV 以下折射率升高,在6 eV 以上折射率下降,随着光子能量的增大,不同厚度的Si/SiO2界面折射率均逐渐平稳接近于1,说明在高能量下Si/SiO2界面保持着透明性。

图12 Si/SiO2界面折射率随氧化硅层厚度的变化关系Fig.12 Relationship between the refractive index of Si/SiO2 interface and the thickness of silicon oxide layer
4 Si/SiO2界面的制备与光致发光测量
在计算研究的基础上,采用纳秒脉冲激光沉积(Pulsed Laser Deposition,PLD)方法来制备氧化硅及其硅晶薄膜,并在1 000℃高温下作吹氧退火处理,通过控制退火时间来改变膜层的生长厚度。在PLD 制备过程中,采用纳秒脉冲Nd:YAG 激光的三次谐波355 nm 的激光束来在氧化硅上沉积硅晶纳米层,纳秒脉冲激光烧蚀单晶硅靶,一部分激光能量被硅的核外电子吸收,使电子的动能迅速增加,电子温度远远高于硅的晶格温度,整个单晶硅靶表面处于非平衡态,然后硅纳米晶粒在密闭的真空腔体内沉积到氧化硅衬底上形成氧化硅及其硅晶薄膜结构,由此构建边缘电子态。图13 为氧化硅上硅纳米晶薄膜结构的光学显微像。制备得到的Si/SiO2界面样品的氧化硅及其硅晶薄膜结构可以由透射电子显微镜检测与表征。

图13 制备的Si/SiO2界面氧化硅表面光学显微像Fig.13 Optical microscope image of the prepared Si/SiO2 interface
Si/SiO2界面样品的光致发光(Photoluminescence,PL)光谱如图14,可以清楚地观察到Si/SiO2界面样品上的边缘电子态在670 nm(1.85 eV)处的强发光峰,在620 nm 和800 nm 处有凸起,表明存在一定量氧空位缺陷,除此之外未观察到其他波段的发光峰,表明制备的氧化硅上硅晶薄膜的纳米线缺陷较少,结晶质量较高。在532 nm 激光的激发下,Si/SiO2界面电子从价带激发到导带,进入边缘电子态后形成较强的准受激发光峰。实验结果验证了能带计算的结果:在氧化硅上生长硅晶薄膜可以形成边缘电子态从而有效降低其能带带隙,并保持其直接带隙的特征;其边缘电子态中的电子还可以输运到较低的局域态中,在近红外波段形成发光带。氧化硅上硅晶薄膜结构样品的光致发光PL 谱检测结果验证了计算研究的结果,样品上的边缘电子态将氧化硅的宽直接带隙调窄到1~2 eV,其发光峰的位置覆盖可见光和近红外波段。

图14 Si/SiO2界面上的PL 光谱Fig.14 PL spectrum on Si/SiO2 interface
5 结论
本文通过理论研究得出,块体α-方石英、不同厚度的薄膜α-方石英和不同氧化硅层厚度的Si/SiO2界面均为直接带隙半导体。α-方石英厚度从2.887 nm 降低到1.047 nm,薄膜α-方石英带隙从5.233 eV 升高到了5.927 eV。氧化硅厚度从2.887 nm 减小到1.047 nm,Si/SiO2界面能带带隙从1.62 eV 升高到1.782 eV。氧化硅层厚度变化引起的Si/SiO2界面电子态结构变化与薄膜α-方石厚度改变引起的电子态结构变化相似。且氧化硅上生长纳米硅薄膜降低了氧化硅的带隙,利于发光和光伏应用。Si/SiO2界面介电函数虚部在4.5 eV 附近存在介电峰,随着Si/SiO2界面氧化硅层厚度降低,介电峰向高能量方向略微移动,且介电峰的峰值不断升高。在6 eV 附近,Si/SiO2界面折射率的变化趋势出现了拐点,并在高能量下保持透明性。Si/SiO2界面在6 eV 附近存在一个吸收峰,Si/SiO2界面吸收系数的吸收峰的峰值也随氧化硅层厚度降低而显著升高,且峰位向高能量方向进行移动,产生了蓝移。可以通过控制Si/SiO2界面氧化硅层厚度有效地调控Si/SiO2界面的电子态结构和光学性质,通过引进边缘电子态,调控其带隙进入1~2 eV 区间。在计算研究的基础上,采用纳秒脉冲激光PLD 方法制备了氧化硅上硅晶薄膜结构样品,常温下用532 nm 激光激发对样品进行PL 发光谱测量,在670 nm(1.85 eV)处观察到边缘电子态的强发光峰,在近红外波段发现电子局域态的发光。这些研究结果将在发光和光伏领域有很好的应用。