HgCdTe多层异质结红外探测材料与器件研究进展
2022-09-26陈正超唐利斌王善力庄继胜孔金丞左文彬姬荣斌
陈正超,唐利斌,郝 群,王善力,庄继胜,孔金丞,左文彬,姬荣斌
〈综述与评论〉
HgCdTe多层异质结红外探测材料与器件研究进展
陈正超1,2,唐利斌2,3,郝 群1,王善力2,庄继胜2,孔金丞2,左文彬2,3,姬荣斌2
(1. 北京理工大学 光电学院,北京 100081;2. 昆明物理研究所,云南 昆明 650223;3. 云南省先进光电材料与器件重点实验室,云南 昆明 650223)
HgCdTe多层异质结技术是未来主流红外探测器发展的重要技术方向,在高工作温度、双/多色和雪崩光电管等高性能红外探测器中扮演着重要的角色。近年来基于多层异质结构的HgCdTe高工作温度红外探测器得到了快速发展,尤其是以势垒阻挡型和非平衡工作P+-π(ν)-N+结构为主的器件受到了广泛的研究。本文系统介绍了势垒阻挡型和非平衡工作P+-π(ν)-N+结构HgCdTe红外探测器的暗电流抑制机理,分析了制约两种器件结构发展的关键问题,并对国内外的研究进展进行了综述。对多层异质结构HgCdTe红外探测器的发展进行了总结与展望。
碲镉汞;多层异质结;势垒;非平衡工作;焦平面器件
0 引言
碲镉汞(Hg1-CdTe)是红外光子型探测器中最重要的一种材料,材料的禁带宽度可随组分的变化在0~1.6 eV范围内连续调节,从而实现对整个红外波段的探测,且具有高量子效率的优势,因此在高性能制冷型红外探测器中占有重要的地位[1-3]。
基于窄禁带半导体的光电二极管中产生暗电流的主要机制有4种[4]:①耗尽区与产生-复合(Shockley-Read-Hall,SRH)过程相关的电流;②器件准中性区的扩散电流;③与界面陷阱相关的表面漏电流;④隧穿电流:带间隧穿和陷阱辅助隧道电流。红外探测器的最高工作温度通常由其暗电流决定,它随温度呈指数增长[5-7]。探测器工作时,暗电流的任何波动都直接转化为探测器中的噪声,从而限制了可实现的探测能力。虽然通过制冷使HgCdTe探测器工作于接近液氮温度的低温下可以提高探测器的信噪比,但是对制冷技术的依赖限制了HgCdTe探测器的广泛应用[8-9]。
和同质结相比,异质结具有更高的注入效率[10],且异质结两侧材料禁带宽度以及其他特性的不同,使得基于异质结的器件可以实现某些同质结不具有的功能[11]。随着金属有机气相沉积(Metal Organic Chemical Vapor Deposition,MOCVD)和分子束外延(Molecular Beam Epitaxy,MBE)制备技术水平的提升,基于多层复杂异质结构的红外探测器得到了极大的发展。当前主流的红外探测器产品为第三代探测器[12],并已出现第四代探测器的概念[13]。第三代探测器产品中[14],雪崩探测、高工作温度探测和多色探测等技术的发展均依赖于组分异质结构的多层外延材料和器件技术。在不降低器件性能的前提下,提高探测器的工作温度,实现小尺寸、低重量、低功耗、高性能和低价格(Size, Weight, and Power, Performance and Price,SWaP3)成为制造新一代红外探测器的主要目标[13,15-16]。最近几十年来,为实现高工作温度(High Operating Temperature,HOT)器件,研究人员提出了不同的策略,主要包括:采用光学浸没以提高探测器光学面积[17],提升材料制备质量以降低探测器中的漏电流[16],非平衡Auger抑制结构的探测器设计[17],势垒结构探测器[18-19],超晶格探测器[17],红外量子级联探测器[17,20],以及光子陷阱探测器[17,21]等。
随着多层异质结构材料和器件的发展,高工作温度探测技术得到了长足的发展。在高工作温度探测技术中,针对准中性区的扩散电流分量和空间电荷区的SRH电流分量,分别发展了基于非平衡工作(Non-Equilibrium Operating)模式的P+-π(ν)-N+结构[22](其中π为p型轻掺杂,ν为n型轻掺杂)和基于势垒阻挡结构[9,23]的多层异质结红外探测器。
1 势垒型HgCdTe红外探测器
1.1 势垒型探测器的工作原理
1983年,White[24]第一次提出了作为高阻抗光电导器件的势垒探测器。该器件中,一个薄的宽带隙半导体两端耦合n型窄带隙半导体,并假设在整个异质结构中存在导带偏移(Conduction Band Offset,CBO)Dc,而几乎无价带偏移(Valence Band Offset,VBO)DE,这样只允许少数载流子在光导体中流动,从而构成单极势垒阻挡(Unipolar Barrier),即只能阻挡一种载流子(电子或空穴)但允许另一种载流子畅通无阻的势垒。2003年,以色列Semiconductor Device(SCD)公司的Klipstein[25]提出了一种新型的异质结器件结构,其特点是窄带隙吸收层中不存在耗尽区,从而抑制SRH电流与噪声。美国纽约罗彻斯特大学的Maimon和Wicks[18]在2006年也提出了类似的器件结构,并给出了nBn的名称,其中n表示窄间隙半导体中的掺杂,B表示宽带隙势垒阻挡层。nBn器件类似于典型的p-n结型光电二极管,不同之处为结区(空间电荷区)被势垒阻挡层B所取代,p接触层被n接触层所取代,从而形成单极势垒红外探测器(Unipolar Barrier Infrared Detector,UBIRD)。随后,Klipstein进一步将无耗尽的新型异质结器件结构命名为XBn[5],且根据吸收层掺杂类型的不同可分为XBn和XBp[19],其中,如果接触层所用的材料与光子吸收层所用的材料有不同的带隙,则X代表p或n,下标表示接触层的掺杂类型;如果X型接触层和光子吸收层中都使用相同的材料,则X表示p或n。
上述所有器件结构中,其中的一种窄带隙半导体作为器件的偏置接触层,另一种窄带隙半导体为吸收层(有源层),其厚度兼容光的吸收长度,通常为几个μm[26-28]。nBn器件的能带结构[28]如图1(a)所示。理想条件下,器件结构中不存在耗尽区域,且势垒层采用宽带隙的半导体材料,从而抑制了SRH过程对暗电流的贡献。转换温度c[28](Crossover Temperature)定义为扩散电流分量和SRH电流分量相等的温度,如图1(b)所示。探测器工作温度高于转换温度时,扩散暗电流起主导作用;低于转换温度c时,SRH暗电流起主导作用。由此,当探测器的工作温度低于转换温度c时,单极势垒器件结构具有两方面优势[17]:①在相同工作温度下,和常规p-n结光电探测器相比,其具有更低的暗电流;②在相同的暗电流水平下,其具有更高的工作温度,从而降低对制冷条件的需求。
表面漏电流是常规窄带隙p-n结光电探测器中暗电流的重要来源,而单极势垒型器件结构对表面漏电流也会产生重要影响[29-31],如图1(c)~(e)所示。通常,表面漏电流对温度的依赖不显著,因而无法通过对探测器的制冷来抑制其对器件性能的影响[29],需要采用钝化处理等以抑制表面漏电流。单极势垒阻挡器件结构为抑制表面漏电流提供了一种解决方法,即通过选择性的刻蚀保留宽带隙的势垒层,从而使势垒层同时也是钝化层,无需额外的钝化处理,从而简化制备工艺[18]。如图1(f)所示为nBn焦平面器件阵列结构图[32]。在红外探测器中,半导体表面杂散电场引起的能带弯曲和表面费米能级钉扎效应均会引入表面漏电流[33]。根据半导体材料表面导电类型的不同,器件结构可采用不同的结构形式。对于HgCdTe[34]和InAs[33,35]等探测器,由于表面的费米能级钉扎于禁带或者导带中形成n型导电类型,故采用nBn结构可抑制表面漏电流;而表面导电类型为p型时,则可采用pBp结构[27,36]。

图1 单极势垒型红外探测器:(a)~(e)分别为nBn器件的能带结构[28]、Arrhenius曲线特性[28]、暗电流抑制特性[30]、体能带结构与表面能带结构对比[31]和表面漏电流通道的阻挡[31];(f) nBn焦平面器件阵列结构[32]
1.2 HgCdTe势垒型红外探测器的发展
对于HgCdTe材料,nBn结构与典型的p-n结型光电探测器相比具有显著的优势,它消除了通过离子注入或MBE原位p型可控掺杂的相关问题[37-38],并消除了p型掺杂激活所需的处理步骤[39],因而促进了HgCdTe nBn器件的研究。
2011年,美国密歇根大学Itsuno等首次将nBn型势垒阻挡器件结构应用于HgCdTe材料体系,采用数值分析的方法对比了长波红外(Long Wavelength Infrared,LWIR)HgCdTe的nBn和p-n结器件结构在50~300 K范围的响应特性[40]。分析结果表明,在50~95K的温度范围内,nBn HgCdTe器件的暗电流、响应率和探测率等特性参数与p-n结相当。随后,该研究团队采用MBE系统在CdZnTe(2 1 1)B衬底上制备了In掺杂的nBn器件[39],并采用ZnS作为器件表面的钝化层。在高于180 K时,总暗电流受材料内部的Auger过程主导;而低于180 K时,总暗电流趋于饱和,这归因于通过表面陷阱复合产生的漏电流,如图2(a)和2(b)所示。该HgCdTe nBn探测器的开启电压为bias≈-0.8V,和“07规则”相比,其暗电流大几个数量级。
针对nBn HgCdTe器件结构存在暗电流较大的问题,Itsuno等[41-42]进一步提出了NBνN器件结构,如图2(c)和2(d)所示。在nBn器件中,和势垒层B相对应,n型吸收层的另一端耦合宽带隙的N型层形成排斥结(Exclusion Junction),从而构成空穴势垒。NBνN器件结合了nBn和非平衡工作Auger抑制器件的优点,即抑制耗尽区的SRH和准中性区的Auger过程。分析结果表明,和常规nBn和双层平面异质结(Double Layer Planner Heterojunction,DLPH)器件相比,暗电流有数量级的降低。NBνN结构集成了空穴势垒和电子势垒,该结构与美国喷气推进实验室(Jet Propulsion Laboratory,JPL)Ting等[43]提出的互补势垒红外探测器(Complementary Barrier Infrared Device,CBIRD)相类似。2013年,波兰军事技术大学的Martyniuk等[44-45]对电子势垒和空穴势垒层均为n型掺杂的HgCdTe nBnN/CBIRD器件分析表明,势垒层B的掺杂浓度和组分对器件的性能影响显著,通过调控掺杂浓度和组分可调节Dc和Dv的高度。同时,势垒层N应重掺杂(D>1016cm-3)以获得良好的探测性能。

图2 HgCdTe势垒型探测器:(a)和(b)分别为nBn探测器的能带结构和暗电流的Arrhenius曲线[39-40];(c)和(d)分别为互补势垒探测器NBνN的能带结构和暗电流的Arrhenius曲线[41];(e)和(f)分别为p型掺杂势垒的能带结构和J-V特性曲线[48]
和III-V族红外材料不同,HgCdTe材料的I型能带配置结构在宽带隙的势垒层和窄带隙的吸收层界面存在较大的Dv,限制了器件的性能,是制约势垒阻挡器件结构在HgCdTe材料体系中应用的关键问题[4,23,37,46]。Dv的存在引入的问题包括[26]:①低温工作时,由于光吸收产生的低能量少子空穴无法克服能量势垒,器件表现出较差的响应和探测性能;②为了将Dv限制在合理的水平,Dc的高度受到限制,导致高温工作时多数载流子形成暗电流,从而降低响应率;③为了有效收集光生载流子,需降低或者消除Dv,根据器件的工作波长,需要施加大于带隙能量的反向偏压,常规的nBn器件工作时需施加小的反向偏置[28],而当施加过高的反向偏置电压会使界面上的耗尽区延伸至窄带隙吸收层中,从而引入与耗尽区相关的暗电流[47]。
2014年,波兰军事技术大学Kopytko对HgCdTe n+BnN+器件结构的分析表明,p型掺杂的势垒层Bp可降低Dv而提升Dc,从而优化器件性能[48],如图2(e)和2(f)所示。文献[49]分析指出,和nBnn结构相比,具有p型盖接触层(cap contact layer)的pBnn结构可实现低工作偏置电压的要求。结合pBnn结构和p型势垒层Bp,并针对=0.36(230K,cut-off=3.6mm)时掺杂类型不同吸收层,Kopytko[6,50-51]等分析了不同盖层/势垒层(cap/barrier,p+Bp、n+Bp和nBp)结构和吸收层掺杂的影响形式。其中底面接触层(Bottom Contact Layer)均为重掺杂的N+。材料的制备采用MOCVD技术,从而可以避免非原位退火产生的问题[52]。分析表明:①近室温时,n型吸收层受Auger过程相关的扩散电流主导,p型吸收层则为产生-复合电流机制;②盖层/势垒层p+Bp结构可实现价带对齐,实现零偏置或低反向偏置工作条件;③和P+p同型异质结相比,p+Bpp具有更优的排斥效应;④p+BpnN+可获得低于“07规则”一个数量级的暗电流;⑤p+BppN+的p-n结空间电荷区位于pN+结,势垒层Bp没有取代空间电荷区,该结构类似于Savich等提出的单极势垒光电二极管(Unipolar Barrier Photodiode,UBP)。和p+BpnN+相比,p+BppN+结构对Auger过程的抑制更显著,在高温时暗电流更低,提升材料的质量可进一步提升器件的性能,而在低温工作时,p+BpnN+器件表现出更好的性能。然而,当进一步将截止波长拓展至6mm(230 K)时,两种结构的暗电流均增大2~3个数量级,其值略高于“07规则”预测的值,且在较低的偏压(bias≈-0.2V)下即表现出显著的隧穿电流[26]。
当前,HgCdTe势垒阻挡型探测器的发展策略是降低甚至消除势垒层/吸收层异质结界面上的Dv,以实现更低的反向偏置、更低的暗电流以及更高温度下的工作能力[46]。针对HgCdTe势垒型探测器,相关研究人员已提出了基于带隙工程的消除Dv的方法。
对势垒层进行p型掺杂后,将在n型吸收层和势垒层B的界面上引入p-n结,从而增强与耗尽区相关的暗电流[53-54]。采用HgTe/HgCdTe超晶格结构作为势垒层,可实现价带的对齐,且无需采用p型掺杂的势垒层[55],见图3(a)和3(b)所示。同年,西澳大利亚大学的Akhavan等[56]提出了依靠掺杂调制技术,同时对势垒层两端的组分和n型/p型掺杂浓度进行梯度调控,从而实现价带对齐,见图3(c)和3(d)所示。该方法同样引入了p型掺杂带来的问题,且n型和p型掺杂的梯度调控将增加工艺的复杂性。2018年,该研究团队[57]对势垒层两端进行δ掺杂,并结合组分的梯度调控,以实现降低Δv。计算结果表明,采用δ掺杂调控的方法,可使Δv低于20 meV,且Δc仍高于1eV,见图3(e)和3(f)所示。由于无需对n型和p型掺杂进行梯度调控,该方法在MBE生长工艺中更容易实施[53]。
表1列举了几种势垒阻挡结构的HgCdTe多层异质结探测器的主要性能指标。由于制备单极势垒阻挡的HgCdTe多层异质结构器件的技术路线过于复杂,基于能带调控技术降低Dv的技术不成熟,研究内容仍然聚焦于Dv的降低或者消除,因此,当前仍未有焦平面器件见诸报道。

表1 势垒阻挡型HgCdTe红外探测器的结构及性能对比

图3 HgCdTe势垒型探测器降低DEv的方法:(a)和(b)分别为HgTe/CdTe能带对准示意图和超晶格势垒能带结构图[55];(c)和(d)分别为势垒层两端的x组分梯度和n型/p型掺杂梯度[56];(e)和(f)分别为势垒层两端δ掺杂调控结构和能带结构[57]
2 非平衡工作模式HgCdTe红外探测器
2.1 非平衡工作载流子耗尽原理
高质量窄带隙半导体中,如室温下的HgCdTe,Auger机理对产生-复合过程起着主要作用[61]。一个由Auger-1复合过程限制的理想的p-on-n光电探测器的暗电流密度可描述为[13,62]:

式中:为单位电荷;为电子浓度;为吸收区的厚度;i为本征载流子浓度;A为Auger-1寿命。在n型HgCdTe材料中,Auger-1寿命和空穴、电子和本征载流子浓度以及本征Auger-1寿命Ai等参数相关。其表达式如下所示[62-63]:

式中:为空穴浓度。将Auger-1寿命A表达式带入暗电流密度Auger后,暗电流密度Auger可在两种极限条件下进行计算。对于本征或者高工作温度限时,有≈=i,从而可得[63]:

而在非本征或者低工作温度限时,有<<≈d,式中:d是吸收层的掺杂水平,从而可得到[63]:

对于这两种情况,可以观察到Auger限暗电流密度与本征Auger-1寿命成反比。在近室温工作条件下,HgCdTe红外探测器中的暗电流是由Auger过程主导的扩散限电流,此时高浓度的本征载流子在降低少数载流子寿命中起主导作用,电流密度与掺杂无关。在非本征工作区,暗电流密度与掺杂密度成正比,这对HgCdTe来说可以做得很低。对于Auger限探测器,较大的本征Auger-1寿命允许在稍高的温度下工作;但与暗电流随温度升高呈指数增长相比,影响相对较小[63]。通常,采用制冷的方式使探测器工作于低温下是抑制Auger产生-复合暗电流和噪声的有效方法[61]。
1985年,英国科学家Ashley和Elliott[22]提出了利用探测器的非平衡工作模式来降低本征载流子浓度,使自由载流子浓度降低到其平衡值以下,从而达到抑制Auger产生-复合过程的目的,降低Auger产生-复合过程对器件性能的不利影响。非平衡工作的器件结构及载流子浓度变化[64]见图4(a)所示。该方法建立在Auger产生-复合过程与自由载流子浓度存在依赖关系的基础上。基于非平衡工作的载流子抑制策略提供了抑制暗电流的有效方法,该方法在本征工作温度范围尤其有效,因此得到了广泛的研究。
最简单的非平衡Auger产生-复合过程抑制探测器结构为三层异质结构P+-π(ν)-N+。反型异质结P+-ν和N+-π为抽取结(extracting junction),同型异质结N+-ν和P+-π作为排斥结(excluding junction)。在反偏电压下,器件准中性区电子和空穴准费米能级产生差异,反型异质结的p-n结中多数载流子的扩散和少数载流子的漂移动态平衡过程被破坏,少数载流子的漂移得到加强,而多数载流子的扩散受到抑制。同型异质结阻挡少数载流子流入π或ν准中性区。随着反偏电压的上升,抽取结从附近的准中性区π或ν中抽取少数载流子的作用增强,在排斥结的作用下,准中性区域少数载流子得不到补充,从而使其浓度低于热平衡值,为使准中性区保持电中性条件,该区域中的多数载流子浓度将下降到热平衡值以下,且在非本征掺杂浓度水平饱和,从而实现载流子浓度的非平衡耗尽[61]。在强耗尽时,准中性区域中多数载流子的浓度可降低几个数量级。
在具有非平衡Auger抑制的探测器中,其显著的特点是特性曲线上,随着反偏电压的上升,暗电流存在明显的负差分阻抗(negative differential resistance,NDR)区域。对于P+-π-N+结构,暗电流最小值遵循下式[61]:

式中:为单位电荷;g为禁带宽度,单位为eV;B为玻尔兹曼常数;为温度。上式表明min是截止波长的函数。当波长>6mm时,对Auger效应有显著的抑制。通常,非平衡抑制的效果以暗电流的峰谷值之比(max/min)来表征[64],见图4(b)所示。
2.2 非平衡工作单元器件的发展
基于HgCdTe的室温或者近室温工作的中波和长波红外探测器是红外技术的研究热点之一[65]。最近20年来,波兰的Vigo System S. A.公司对快速响应和高灵敏的非制冷或者热电制冷HgCdTe红外探测器进行了广泛的研究[66-69]。
近室温或室温工作时,由于高的热激发载流子浓度,p-n结的动态电阻很低,同时吸收区的少子扩散长度小且对入射辐射吸收弱,从而显著降低了量子效率[17]。只有在距离结的长度小于扩散长度的光生电荷载流子才能被收集[70]。因此,只有有限部分的光生电荷对量子效率有贡献。长波红外(>5mm)的吸收深度大于扩散长度[62]。对波长为10.6mm的非制冷长波光电二极管的计算表明,双极扩散长度小于2mm,而吸收深度为13mm。这将一次辐射通过探测器的量子效率降低到~15%[17]。而在电子和空穴的迁移率之比较高的材料中,双极性效应会进一步降低电阻。

图4 HgCdTe P+-π-N+单元红外探测器:(a)和(b)为非平衡工作器件结构及暗电流曲线[64];(c)-(f)分别为零偏及反偏时的能带结构[71]、反偏时的频率响应特性[70]、多层异质单元器件结构和器件封装形式[52]
此类器件和前置放大器耦合时,前置放大器噪声和寄生电阻噪声甚至可能超过器件本身的热产生-复合噪声,从而严重劣化器件的性能,通常不具有实际应用意义[69]。解决以上问题的策略是采用多层异质结光伏器件结构[71],见图4(c)所示。基于Auger抑制的P+-π-N+多层异质结构,波兰Vigo Systems S. A.公司提出了集成光学、探测和电子功能的单片三维HgCdTe光电探测器概念,这类器件在没有低温制冷或者热电制冷的情况下获得了很好的性能[17,52]。
p型掺杂的HgCdTe表现出很高的双极迁移率(e/h≈100),这对于通过漂移和/或扩散传输过程快速和有效地收集载流子至关重要,因此吸收层p型掺杂的HgCdTe是快速响应器件的优选材料[70,72]。同时,通过将掺杂浓度调控至A≈3i,可实现Auger过程的抑制[73]。
制备多层异质结器件时,波兰Vigo Systems S. A.公司采用MOCVD技术。MOCVD技术制备工艺温度高(350℃~360℃),由于互扩散多层工艺(inter-diffused multilayer process,IMP)的影响,生长的异质结界面上存在显著的组分梯度和掺杂浓度梯度层[46,72,74]。于是,制备后的器件结构通常可表示为P+-G-π-G-N+(G表示梯度层)[75]。在P+-G-π-G-N+器件结构中,吸收层的掺杂浓度、厚度和载流子寿命等对器件的性能起着重要作用[76]。作为排斥层,N+层起到红外传输窗口的作用,允许能量低于带隙的光子入射到吸收层。N+层应足够厚,以使反向偏压时接触注入的任何载流子既不能扩散也不能漂移到排斥结,同时其禁带宽度足够宽,以抑制电子-空穴对的生成,尽量减少Auger生成和少子空穴的浓度[76]。重掺杂的宽带隙N+和P+层阻挡少子注入吸收层,并保护器件不受表面暗电流产生的影响。此外,重掺杂可获得低的接触电阻[17]π型吸收层的厚度对探测器暗电流、光吸收和响应时间起着决定性的作用[77]。通常,吸收层的厚度是高吸收率、低热激发以及快速响应要求之间的折中[65,78]。2013年,Kopytko等[72]对P+-G-π-G-N+结构吸收层π的掺杂浓度和厚度的分析表明,在非平衡工作模式时,随着反向偏压的升高,时间常数减小,电流响应率提升。在0.8V的反向偏压时,为获得0.1ns的时间常数,掺杂浓度为8.0×1015cm-3的吸收区的厚度应小于5mm。同时,轻掺杂的吸收层在反向偏压下完全被耗尽,从而使载流子的传输时间取决于漂移时间(dr)。然而,吸收层的p型掺杂浓度应实现对材料施主背景浓度的过度补偿,避免吸收区的掺杂类型转变为n型。
除了吸收层参数外,异质结界面梯度层对器件性能的影响同样起着重要作用。2016年,Martyniuk等[77]对N+-π-P+-p+-n+器件中N+-π异质结与暗电流的影响形式进行了分析,结果表明,为抑制与隧穿机制相关的暗电流,需降低异质结界面上的电场。通过组分梯度和掺杂浓度梯度的调控,可降低N+-π界面陷阱辅助隧穿机制对暗电流的影响,从而在低的反向偏置(bias≈200 mV)时获得~150 ps的时间常数。
无偏压工作时,探测器的时间常数通常为几个ns[74]。和反向偏置时相比,时间常数高约一个数量级[70],见图4(d)所示。然而反向偏置工作时,器件的相对较高的偏置电流要求和过量的1/噪声降低了偏置探测器的性能,1/噪声室温拐点频率从1 MHz左右(5mm截止波长)到100 MHz(10mm截止波长)不等[64],因此促进了对无偏压工作探测器时间常数改进的研究[79]。
零偏压时,除N+-π和π-P+异质结界面附近存在较强电场外,吸收层π的大部分处于无电场状态,能带没有产生弯曲,为准中性区域。因此,探测器的时间常数主要受载流子从产生位置处向空间电荷区的扩散时间[74]和RC时间常数的限制[70]。在零偏压的平衡条件下,轻掺杂HgCdTe材料(A=3×1016cm-3)具有低的双极性迁移率和扩散系数,导致载流子输运缓慢。同时,受Auger过程的影响,载流子的复合时间相当短,从而很大一部分载流子会在到达接触层之前复合。因此,零偏置器件也受到低响应率的影响[70]。通常,工作于零偏压探测器的性能可以通过适当的器件结构设计、吸收层掺杂到A≈3i水平、使用最佳吸收层厚度以及降低寄生电容和电阻来提高[70]。

和反向偏置时相比,无偏压工作时探测器的探测率*要低几个数量级,但此时探测器处于热平衡状态,探测率*受热Johnson-Nyquist噪声的限制[80],可忽略1/噪声的影响,从而在包括低频响应在内的较宽工作频率范围内可获得良好的性能。且通过实施光学浸没,可进一步提升探测器的响应率[80-81]。光学浸没结构及封装形式[52]见图4(e)和4(f)所示。在超快响应频率需求的应用领域,探测器则需采用反向偏压时的非平衡工作模式,以获得约数十至数百ps的时间常数。表2列举了HgCdTe多层异质结快速响应器件的主要性能指标。

表2 HgCdTe多层异质结快速响应单元红外探测器性能对比
2.3 非平衡工作焦平面器件的发展
使用宽带隙P接触层是一种消除p型区域有害热激发的直接方法。真正实现这类器件需要成熟的多层外延生长技术,这样才能生长具有复杂带隙和掺杂剖面的高质量异质结构。
由于LPE不适合生长多层掺杂的异质结构,且需采用晶格匹配的CdZnTe衬底,其价格昂贵,因而在MBE掺杂问题得到解决以前,英国Selex公司选择金属有机气相外延(metal-organic vapour phase epitaxy,MOVPE)技术来生长HgCdTe多层异质结构,且MOVPE可以在多种不同的衬底上生长HgCdTe[82-83]。为了使台面结构像元顶端的接触层保持良好的欧姆接触,该公司采用n-on-p结构[17,82],见图5(a)~(b)所示。焦平面阵列结构[17]如图5(c)所示。
2003年,英国Hipwood等[84]采用MOVPE在GaAs衬底上生长P+-P-p-N-N+多层HgCdTe异质外延层,利用台面刻蚀技术制作可变台面尺寸的像元结构,采用CdTe进行钝化,与CMOS读出电路采用In柱倒装互连,从而形成320×256(30mm)尺寸规格的焦平面阵列,其截止波长为4.0mm。对于#2.0的视场和20℃的黑体背景,器件实现接近背景限性能(background limit infrared performance,BLIP)的温度可达180K,噪声等效温差(noise equivalent temperature difference,NETD)中值优于12 mK。随着温度的升高,器件仍能正常工作,但噪声像素数目呈指数增长,且中值NETD比散粒噪声预测的下降更快。这种行为与在较高温度下增加的低频1/噪声相一致[85],见图5(d)所示。
2006年,Gordon等[86]进一步的分析结果表明,当探测器与周围环境处于热平衡时,对其施加零偏压后,器件中不存在低频噪声。因此,使探测器工作于零偏压时,器件可以在更高的温度下获得更好的性能。对P+-p-N+器件性能的理论分析表明,在零偏压下工作时,仅考虑Johnson噪声和背景噪声,而忽略1/噪声,器件实现BLIP的温度可达200K,且在200~240K的温度范围内,仍然可以预测有用的性能。然而,对320×256(30mm)焦平面阵列施加一致的零偏压后,210K时器件的中值NETD的测量值为50 mK,高于理论预测的21mK。分析认为[87],在焦平面阵列中,不同像元的最优偏置电压在0V附近存在差异。对每个像元施加最优偏置后,可进一步提升器件的性能。然而,这使器件的结构更加复杂。同时,施加零偏置时,器件处于热平衡工作状态,p-n结中多子的扩散过程和少子的漂移过程处于平衡状态,p-n结不具有对少子的抽取作用,因而无法抑制高温下由Auger过程产生的扩散电流。
随后,基于P+-p-N+器件结构,Selex发展了MWIR和LWIR探测器[88-89]。2011年,对标准产品(5.5mm,F/4)的测量表明[85],工作温度升至150~160K时,中值NETD仍然保持不变,继续升至185 K时,中值NETD翻倍,图5(e)所示为210K时的成像效果图。考虑到截止波长的拓展,和前述测试结果相比,MOVPE器件制备技术得到了提升。然而,限制器件在更高温度下工作的因素仍然为过量的散粒噪声[90]。针对后续的产品,该公司主要集中于台面像元结构、像元尺寸和MOVPE制备技术的优化[91-92]。2015年,该公司推出了SuperHawk探测器(MW,1280×1024,8mm),当工作温度高于150K时,其NETD仍然受过量噪声的限制[92],如图5(f)所示为该产品实物图[91]。

图5 P/p(π)/N结构焦平面红外探测器:(a)和(b)分别为P+-p-N+探测器的像元结构[17]和掺杂以及组分变化曲线[82];(c)-(f)分别为P+-p-N+焦平面探测器的焦平面阵列结构[17]、NETD曲线[85]、210 K时的成像效果图[85]和探测器组件产品图[91]
文献[93]研究表明,HgCdTe光电二极管中出现的1/噪声与表面电荷隧穿进入和离开钝化界面有关。2016年,文献[63]报道美国了Teledyne Imaging Sensors(TIS)公司聚焦于全耗尽P--N结构焦平面器件的研发,以实现器件工作温度的提高。和英国Selex公司采用P-p-N台面结构不同,TIS公司采用P--N平面结构。其通过将耗尽区的边界约束在宽带隙的盖层和接触层,从而降低与耗尽区边缘扩散和产生-复合电流调制相关的1/噪声[63,94],见图6(a)~(c)所示。同时,宽带隙的盖层可作为钝化层,从而简化制备工艺,是类似于pBn器件结构的一种成本更低、重复性更强的工艺,且完全耗尽的P--N结构兼容小像元焦平面结构,满足低串扰的要求[62]。
对于P--N结构的器件,当施加反向偏压时,在理想的Auger抑制下,电子浓度与非本征掺杂浓度相等,Auger寿命Auger随本征和非本征载流子浓度之比的平方而增加。器件在高温条件工作时,由于本征载流子浓度i远大于非本征掺杂浓度d,且随着温度的升高和非本征掺杂浓度的降低,i和d的差异增大,从而Auger抑制在低掺杂和高温时更显著。在Auger抑制时,随着非本征掺杂浓度d的降低,Auger暗电流密度线性减小[63],见图6(d)所示。与残余杂质和固有缺陷有关的SRH机制决定了轻掺杂n型和p型HgCdTe的载流子寿命[61-62]。因此,为获得BLIP,器件的SRH暗电流GR需足够低[63]。

式中:dep为耗尽区宽度;SRH为SRH过程少子寿命。当SRH寿命大于某一确定的最小SRH寿命时,全耗尽的P--N探测器将受到背景辐射光电流的影响。最小SRH寿命的计算条件为背景辐射光电流等于耗尽区产生-复合电流:GR=BLIP。300K时,吸收层为5mm厚的全耗尽P--N探测器,对于SWIR、MWIR和LWIR,BLIP所需的最小SRH寿命分别为15ms、150ms和28ms[62]。TIS公司证实了所制备的高质量的耗尽层限制的P--N探测器,其SRH复合中心的载流子寿命在0.5~10 ms[94],表明SRH电流不再成为探测器暗电流的限制因素。由此,探测器的性能受到外部背景辐射机制的限制。由于背景辐射限性能是基本的限制机制,因此Lee等[94]建议用“19定律(Law 19)”代替“07规则(Rule 07)”。“07规则”是对掺杂浓度为1×1015cm-3的TIS公司高性能p-on-n器件暗电流的半经验拟合,它反映了该掺杂浓度下对Auger抑制的效果。因此,在本征区域内,“07规则”的性能明显优于Auger限。
在实际工艺中,要想获得足够低的非本征掺杂水平存在较大的困难,当前可获得的低掺杂水平主要为1014~1015cm-3[61,95-96]。TIS公司采用MBE技术可重复性地制备出1013cm-3量级低掺杂浓度的HgCdTe材料[62]。和采用外延薄膜制备技术实现重复获得的低掺杂水平相比,实现非常低的载流子浓度的最简单方法是对器件施加足够高的反向偏压来将吸收体完全耗尽[13],如图6(e)所示。吸收体完全耗尽后,可消除自由载流子和Auger复合。与传统探测器相比,全耗尽探测器的优点随着波长和温度的增加而增加。
器件结构中,盖层和部分底面接触层也被低掺杂,使得耗尽区终止于宽禁带材料。底面接触层掺杂N+作为n型导电公共欧姆接触层。p-n结利用As注入来形成,结之间的间隙须足够小,以确保反向偏压工作条件时允许探测器的侧向完全耗尽。该结构与TIS公司早期发展的常规DLPH非常相似,区别是吸收层的厚度减小和掺杂浓度降低以实现完全耗尽。
2018年,TIS公司已经在128×128、1280×480和640×512等焦平面规格上测试了全耗尽的P--N探测器,其中波器件工作温度可达250 K,和“07规则”预测的暗电流相比,减小了10倍;长波器件工作温度可达160K,暗电流减小了100倍,见图6(f)所示[97]。美国TIS公司在非平衡工作P-ν-N焦平面器件研究领域的进展显示了此类器件的巨大优势,这将极大地促进基于HgCdTe的高工作温度探测技术的发展,为实现高性能HgCdTe红外探测器的近室温工作并获得BLIP提供了解决方案。表3列举了几种HgCdTe多层异质结焦平面器件的主要性能指标。

图6 P-ν-N结构焦平面红外探测器:(a)和(b)分别为吸收层Auger抑制高于“07规则”和完全耗尽时的能带结构图[94];(c) P-ν-N焦平面结构及其特征[63];(d) ν吸收区的暗电流密度随着多子(电子)浓度降低而降低并直达BLIP[63];(e) ν吸收层掺杂水平对全耗尽时所需反向偏压的影响[13];(f)不同波长时全耗尽HgCdTe P-ν-N焦平面探测器工作温度的提升[97]
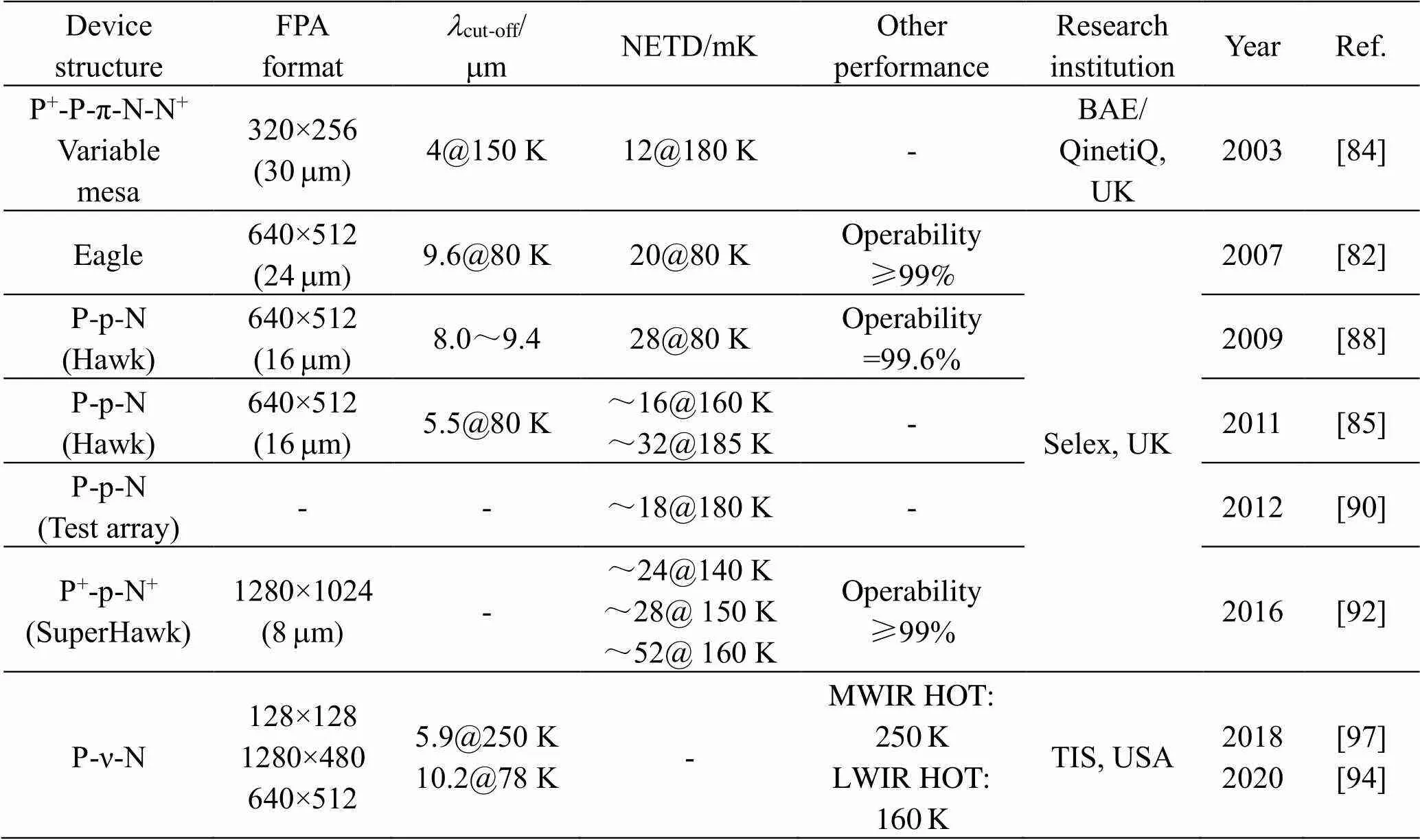
表3 HgCdTe多层异质结焦平面红外探测器性能对比
3 小结与展望
当前,HgCdTe是高性能主流红外探测器的重要材料。HgCdTe多层异质结技术是未来主流红外探测器发展的重要技术方向,在高工作温度、双/多色和雪崩探测等高性能红外探测器中扮演着重要的角色。
势垒阻挡型和非平衡工作HgCdTe红外探测器的发展历程见图7所示。制约势垒阻挡型HgCdTe红外探测器发展的因素是异质结界面上的Dv。虽然已发展基于能带调控的降低或消除Dv的方法,但是技术复杂,且不成熟。和势垒阻挡型器件结构相比,对于本征或高温工作的探测器,载流子的非平衡耗尽更显著,从而极大地抑制扩散电流分量,预期可使探测器工作于更高的温度。同时,非平衡工作器件结构无需对异质结界面上的Δc和Δv进行折中,从而降低了设计和制备的难度。然而,当前基于多层异质结构的HgCdTe红外探测器的发展仍然受到诸多限制,为实现器件的实用化,需解决的问题包括:①提升HgCdTe外延材料制备技术,实现可控的非本征低浓度(<1014cm-3)掺杂水平,采用MBE技术精确调控多层复杂异质结构;②构建新的焦平面器件结构,降低寄生暗电流和噪声,改善器件性能;③研究新的多层复杂异质结构,实现暗电流的抑制,持续提升器件的高温工作性能。

图7 势垒阻挡型和非平衡工作HgCdTe红外探测器的进展
[1] 宋林伟, 孔金丞, 李东升, 等. 金掺杂碲镉汞红外探测材料及器件技术[J]. 红外技术, 2021, 43(2): 97-103.
SONG Linwei, KONG Jincheng, LI Dongsheng, et al. Au-doped HgCdTe infrared material and device technology[J]., 2021, 43(2): 97-103.
[2] 覃钢, 吉凤强, 夏丽昆, 等. 碲镉汞高工作温度红外探测器[J]. 红外与激光工程, 2021, 50(4): 20200328.
QIN Gang, JI Fengqiang, XIA Likun, et al. HgCdTe high operation temperature infrared detectors[J]., 2021, 50(4): 20200328.
[3] 覃钢, 夏菲, 周笑峰, 等. 基于nBn势垒阻挡结构的碲镉汞高温器件[J].红外技术, 2018, 40(9): 853-862.
QIN Gang, XIA Fei, ZHOU Xiaofeng, et al. HgCdTe HOT infrared devices based on nBn barrier impeded structure[J]., 2018, 40(9): 853-862.
[4] Akhavan N D, Jolley G, Umana-Membreno G A, et al. Performance modeling of bandgap engineered HgCdTe-based nBn infrared detectors[J]., 2014, 61(11): 3691-3698.
[5] Klipstein P. “XBn” barrier photodetectors for high sensitivity and high operating temperature infrared sensors[C]//., 2008, 6940: 69402U.
[6] Kopytko M, Keblowski A, Gawron W, et al. MOCVD grown HgCdTe barrier detectors for MWIR high-operating temperature operation[J]., 2015, 54(10): 105105.
[7] Klipstein P, Klin O, Grossman S, et al. XBn barrier detectors for high operating temperatures[C]//, 2010, 7608: 76081V.
[8] Martyniuk P, Rogalski A. Theoretical modelling of MWIR thermoelectrically cooled nBn HgCdTe detector[J]., 2013, 61(1): 211-220.
[9] YE Z H, CHEN Y Y, ZHANG P, et al. Modeling of LWIR nBn HgCdTe photodetector[C]//, 2014, 9070: 90701L.
[10] 刘恩科, 朱秉升, 罗晋生. 半导体物理学[M]. 7版, 北京: 电子工业出版社, 2008.
LIU Enke, ZHU Bingsheng, LUO Jinsheng.[M]. 7th Edition, Beijing: Publishing House of Electronics Industry, 2009.
[11] 王忆锋, 唐利斌. 碲镉汞近年来的研究进展[J]. 红外技术, 2009, 31(8): 435-442.
WANG Yifeng, TANG Libin. Developments of mercury cadmium telluride in recent years[J]., 2009, 31(8): 435-442.
[12] 丁瑞军, 杨建荣, 何力, 等. 碲镉汞红外焦平面器件技术进展[J]. 红外与激光工程, 2020, 49(1): 93-99.
DING Ruijun, YANG Jianrong, HE Li, et al. Development of technologies for HgCdTe IRFPA[J]., 2020, 49(1): 93-99.
[13] Rogalski A, Kopytko M, Martyniuk P, et al. Comparison of performance limits of the HOT HgCdTe photodiodes with colloidal quantum dot infrared detectors[J]., 2020, 68(4): 845-855.
[14] 杨建荣. 碲镉汞材料物理与技术[M]. 北京: 国防工业出版社, 2012.
YANG Jianrong.[M]. Beijing: National Defense Industry Press, 2012.
[15] Lutz H, Breiter R, Figgemeier H, et al. Improved high operating temperature MCT MWIR modules[C]//, 2014, 9070: 90701D.
[16] 周连军, 韩福忠, 白丕绩, 等. 高温碲镉汞中波红外探测器的国内外进展[J]. 红外技术, 2017, 39(2): 116-124.
ZHOU Lianjun, HAN Fuzhong, BAI Piji, et al. Review of HOT MW infrared detector using MCT technology[J]., 2017, 39(2): 116-124.
[17] Martyniuk P, Rogalski A. HOT infrared photodetectors[J]., 2013, 21(2): 1955.
[18] Maimon S, Wicks G W. nBn detector, an infrared detector with reduced dark current and higher operating temperature[J]., 2006, 89(15): 151109.
[19] Klipstein P, Aronov D, Berkowicz E, et al. Reducing the cooling requirements of mid-wave IR detector arrays[J]., 2011, Doi: 10.1117/2.1201111.003919.
[20] LEI L, LI L, YEH, et al. Long wavelength interband cascade infrared photodetectors operating at high temperatures[J]., 2016, 120(19): 193102.
[21] Rabiee Golgir H, Ghandiparsi S, Devine E P, et al. Ultra-thin super absorbing photon trapping materials for high-performance infrared detection[C]//, 2019, 11002: 110020T.
[22] Ashley T, Elliott C T, White A M. Non-equilibrium devices for infrared detection[C]//, 1985, 572: 123.
[23] Kopytko M, Kębłowski A, Gawron W, et al. High-operating temperature MWIR nBn HgCdTe detector grown by MOCVD[J]., 2013, 21(4): 151109.
[24] White A. Infrared Detectors [P]. U.S.: Patent 4,679,063, [1983-09-22].
[25] Klipstein P. Depletion-less Photodiode with Suppressed Dark Current and Method for Producing the Same [P]. U.S.: Patent 7,795,640 B2, [2004-06-28].
[26] Kopytko M, Rogalski A. HgCdTe barrier infrared detectors[J]., 2016, 47(12): 1-18.
[27] Martyniuk P, Kopytko M, Rogalski A. Barrier infrared detectors[J]., 2014, 22(2): 1624.
[28] Rogalski A, Martyniuk P. Mid-wavelength Infrared nBn for HOT Detectors[J]., 2014, 43(8): 2963-2969.
[29] Pedrazzani J R, Maimon S, Wicks G W. Use of nBn structures to suppress surface leakage currents in unpassivated InAs infrared photodetectors[J]., 2008, 44(25): 1487.
[30] Savich G R, Pedrazzani J R, Sidor D E, et al. Benefits and limitations of unipolar barriers in infrared photodetectors[J]., 2013, 59: 152-155.
[31] Sidor D E, Savich G R, Wicks G W. Surface leakage mechanisms in III-V infrared barrier detectors[J]., 2016, 45(9): 4663-4667.
[32] Rogalski A. Next decade in infrared detectors[C]//, 2017, 10433: 104330L.
[33] Savich G R, Pedrazzani J R, Maimon S, et al. Use of epitaxial unipolar barriers to block surface leakage currents in photodetectors[J]., 2010, 7(10): 2540-2543.
[34] Kopytko M, Gomółka E, Michalczewski K, et al. Investigation of surface leakage current in MWIR HgCdTe and InAsSb barrier detectors[J]., 2018, 33(12): 125010.
[35] DU X, Savich G R, Marozas B T, et al. Suppression of lateral diffusion and surface leakage currents in nBn photodetectors using an inverted design[J]., 2018, 47(2): 1038-1044.
[36] Martyniuk P, Antoszewski J, Martyniuk M, et al. New concepts in infrared photodetector designs[J]., 2014, 1(4): 41102.
[37] Kopytko M, Jóźwikowski K. Numerical analysis of current–voltage characteristics of LWIR nBn and p-on-n HgCdTe photodetectors[J]., 2013, 42(11): 3211-3216.
[38] 田震, 肖昕, 宋淑芳, 等. 低暗电流高温工作碲镉汞红外探测器制备技术[J]. 激光与红外, 2019, 49(7): 861-865.
TIAN Zhen, XIAO Xin, SONG Shufang, et al. Low-dark current HOT infrared focal plane arrays using MCT technology[J]., 2019, 49(7): 861-865.
[39] Itsuno A M, Phillips J D, Velicu S. Mid-wave infrared HgCdTe nBn photodetector[J]., 2012, 100(16): 161102.
[40] Itsuno A M, Phillips J D, Velicu S. Design and modeling of HgCdTe nBn detectors[J]., 2011, 40(8): 1624-1629.
[41] Itsuno A M, Phillips J D, Velicu S. Design of an auger-suppressed unipolar HgCdTe NBνN photodetector[J]., 2012, 41(10): 2886-2892.
[42] Itsuno A M, Phillips J D, Gilmore A S, et al. Calculated performance of an auger-suppressed unipolar HgCdTe photodetector for high temperature operation[C]//, 2011, 8155: 81550J.
[43] Ting D Z-Y, Hill C J, Soibel A, et al. A high-performance long wavelength superlattice complementary barrier infrared detector[J]., 2009, 95(2): 23508.
[44] Martyniuk P, Rogalski A. Modelling of MWIR HgCdTe complementary barrier HOT detector[J]., 2013, 80: 96-104.
[45] Martyniuk P, Gawron W, Rogalski A. Theoretical modeling of HOT HgCdTe barrier detectors for the mid-wave infrared range[J]., 2013, 42(11): 3309-3319.
[46] Kopytko M, Jozwikowski K. Generation-recombination effect in MWIR HgCdTe barrier detectors for high-temperature operation[J]., 2015, 62(7): 2278-2284.
[47] Kopytko M, Keblowski A, Gawron W, et al. MOCVD grown HgCdTe barrier structures for HOT conditions[J]., 2014, 61(11): 3803-3807.
[48] Kopytko M. Design and modelling of high-operating temperature MWIR HgCdTe nBn detector with n- and p-type barriers[J]., 2014, 64(15): 47-55.
[49] Klem J F, Kim J K, Cich M J, et al. Comparison of nBn and nBp mid-wave barrier infrared photodetectors[C]//, 2010, 7608: 76081P.
[50] Kopytko M, Kębłowski A, Gawron W, et al. Different cap-barrier design for MOCVD grown HOT HgCdTe barrier detectors[J]., 2015, 23(2): 143-148.
[51] Kopytko M, Kębłowski A, Gawron W, et al. MOCVD grown HgCdTe p+BnN+barrier detector for MWIR HOT operation[C]//, 2015, 9451: 945117.
[52] Gawron W, Sobieski J, Manyk T, et al. MOCVD grown HgCdTe heterostructures for medium wave infrared detectors[J]., 2021, 11(5): 611.
[53] Uzgur F, Kocaman S. Barrier engineering for HgCdTe unipolar detectors on alternative substrates[J]., 2019, 97(3): 123-128.
[54] Kopytko M, Jóźwikowski K, Rogalski A. Fundamental limits of MWIR HgCdTe barrier detectors operating under non-equilibrium mode[J]., 2014, 100(1): 20-26.
[55] Kopytko M, Wróbel J, Jóźwikowski K, et al. Engineering the bandgap of unipolar HgCdTe-based nBn infrared photodetectors[J]., 2015, 44(1): 158-166.
[56] Akhavan N D, Umana-Membreno G A, Jolley G, et al. A method of removing the valence band discontinuity in HgCdTe-based nBn detectors[J]., 2014, 105(12): 121110.
[57] Akhavan N D, Umana-Membreno G A, Gu R, et al. Delta doping in HgCdTe-Based unipolar barrier photodetectors[J]., 2018, 65(10): 4340-4345.
[58] QIU W C, JIANG T, CHENG X A. A bandgap-engineered HgCdTe PBπn long-wavelength infrared detector[J]., 2015, 118(12): 124504.
[59] Kopytko M, Kębłowski A, Gawron W, et al. LWIR HgCdTe barrier photodiode with auger-suppression[J]., 2016, 31(3): 35025.
[60] HE J, WANG P, LI Q, et al. Enhanced performance of HgCdTe long-wavelength infrared photodetectors with nBn design[J]., 2020, 67(5): 2001-2007.
[61] 安东尼×罗格尔斯基. 红外探测器[M]. 2版, 北京: 机械工业出版社, 2014.
Rogalski Antoni.[M]. Second Edition, Beijing: China Machine Press, 2014.
[62] Rogalski A, Martyniuk P, Kopytko M, et al. Trends in performance limits of the HOT infrared photodetectors[J]., 2021, 11(2): 501.
[63] Lee D, Carmody M, Piquette E, et al. High-operating temperature HgCdTe: a vision for the near future[J]., 2016, 45(9): 4587-4595.
[64] Capper P, Garland J.:,, a[M]. Oxford: Wiley-Blackwell, 2011: 474-476.
[65] Piotrowski A, Kłos K, Gawron W, et al. Uncooled or minimally cooled 10 μm photodetectors with subnanosecond response time[C]//, 2007, 6542: 65421B.
[66] Madejczyk P, Gawron W, Kębłowski A, et al. Response time study in unbiased long wavelength HgCdTe detectors[J]., 2017, 56(8): 087103.1-087103.8.
[67] Pawluczyk J, Piotrowski J, Pusz W, et al. Complex behavior of time response of HgCdTe HOT photodetectors[J]., 2015, 44(9): 3163-3173.
[68] Grodecki K, Martyniuk P, Kopytko M, et al. Fast response hot (1 1 1) HGCDTE MWIR Detectors[J]., 2017, 24(3): 509-514.
[69] Piotrowski A, Madejczyk P, Gawron W, et al. Progress in MOCVD growth of HgCdTe heterostructures for uncooled infrared photodetectors[J]., 2007, 49(3): 173-182.
[70] Kopytko M, Kębłowski A, Madejczyk P, et al. Optimization of a HOT LWIR HgCdTe photodiode for fast response and high detectivity in zero-bias operation mode[J]., 2017, 46(10): 6045-6055.
[71] Madejczyk P, Gawron W, Martyniuk P, et al. Engineering steps for optimizing high temperature LWIR HgCdTe photodiodes[J]., 2017, 81(10): 276-281.
[72] Kopytko M, Jóźwikowski K, Madejczyk P, et al. Analysis of the response time in high-temperature LWIR HgCdTe photodiodes operating in non-equilibrium mode[J]., 2013, 61: 162-166.
[73] Piotrowski J F, Rogalski A.[M]. Bellingham, Washington: SPIE Press, 2007
[74] Kopytko M, Martyniuk P, Madejczyk P, et al. High frequency response of LWIR HgCdTe photodiodes operated under zero-bias mode[J]., 2018, 50(2): 451.
[75] Madejczyk P, Gawron W, Kębłowski A, et al. Higher operating temperature IR detectors of the MOCVD grown HgCdTe heterostructures[J]., 2020, 49(11): 6908-6917.
[76] Martyniuk P, Gawron W, Stępień D, et al. Status of long-wave Auger suppressed HgCdTe detectors operating>200 K[J]., 2015, 23(4): 151109.
[77] Martyniuk P, Kopytko M, Keblowski A, et al. Interface influence on the long-wave Auger suppressed multilayer N+π P+p+n+HgCdTe HOT detector performance[J]., 2017, 17(3): 674-678.
[78] Madejczyk P, Gawron W, Martyniuk P, et al. MOCVD grown HgCdTe device structure for ambient temperature LWIR detectors[J]., 2013, 28(10): 105017.
[79] Madejczyk P, Gawron W, Kębłowski A, et al. Response time improvement of LWIR HOT MCT detectors[C]//, 2017, 10177: 1017719.
[80] Martyniuk P, Kopytko M, Madejczyk P, et al. Theoretical simulation of a room temperature HgCdTe long-wave detector for fast response−operating under zero bias conditions[J]., 2017, 24(4): 729-738.
[81] Kopytko M, Sobieski J, Gawron W, et al. Minority carrier lifetime in HgCdTe (1 0 0) epilayers and their potential application to background radiation limited MWIR photodiodes[J]., 2021, 36(5): 55003.
[82] Hipwood L G, Jones C L, Walker D, et al. Affordable high-performance LW IRFPAs made from HgCdTe grown by MOVPE[C]//, 2007, 6542: 65420I.
[83] Jones C L, Hipwood L G, Shaw C J, et al. High-performance MW and LW IRFPAs made from HgCdTe grown by MOVPE[C]//, 2006, 6206: 620610.
[84] Hipwood L G, Gordon N T, Jones C L, et al. 4μm cut-off MOVPE Hg1-xCdTe hybrid arrays with near BLIP performance at 180K[C]//, 2003, 5074: 185.
[85] Knowles P, Hipwood L, Pillans L, et al. MCT FPAs at high operating temperatures[C]//, 2011, 8185: 818505.
[86] Gordon N T, Lees D J, Bowen G, et al. HgCdTe detectors operating above 200K[J]., 2006, 35(6): 1140-1144.
[87] Bowen G J, Blenkinsop I D, Catchpole R, et al. HOTEYE: a novel thermal camera using higher operating temperature infrared detectors[C]//, 2005, 5783: 392.
[88] Hipwood L G, Jones C L, Price J, et al. LW Hawk: a 16μm pitch full-TV LW IRFPA made from HgCdTe grown by MOVPE[C]//, 2009, 7298: 729820.
[89] Abbott P, Thorne P M, Arthurs C P. Latest detector developments with HgCdTe grown by MOVPE on GaAs substrates[C]//, 2011, 8012: 801236.
[90] Knowles P, Hipwood L, Shorrocks N, et al. Mercury cadmium telluride detectors achieve high operating temperatures[J]., 2012. Doi: 10.1117/2.1201211.004535.
[91] McEwen R K, Jeckells D, Bains S, et al. Developments in reduced pixel geometries with MOVPE grown MCT arrays[C]//, 2015, 9451: 94512D.
[92] Jeckells D, McEwen R K, Bains S, et al. Further developments of 8 μm pitch MCT pixels at Finmeccanica (formerly Selex ES)[C]//, 2016, 9819: 98191X.
[93] Kinch M A, Wan C-F, Schaake H, et al. Universal 1/f noise model for reverse biased diodes[J]., 2009, 94(19): 193508.
[94] Lee D L, Dreiske P, Ellsworth J, et al. Law 19: the ultimate photodiode performance metric[C]//, 2020, 11407: 114070X.
[95] 孔金丞, 李艳辉, 杨春章, 等. 昆明物理研究所分子束外延碲镉汞薄膜技术进展[J]. 人工晶体学报, 2020, 49(12): 2221-2229.
KONG Jincheng, LI Yanhui, YANG Chunzhang, et al. Progress in MBE Growth of HgCdTe at Kunming Institute of Physics[J]., 2020, 49(12): 2221-2229.
[96] Knowles P, Hipwood L, Shorrocks N, et al. Status of IR detectors for high operating temperature produced by MOVPE growth of MCT on GaAs substrates[C]//, 2012, 8541: 854108.
[97] Jerram P, Beletic J. Teledyne’s high performance infrared detectors for Space missions[C]//, 2018, 11180: 111803D-2.
Research Progress on Infrared Detection Materials and Devices of HgCdTe Multilayer Heterojunction
CHEN Zhengchao1,2,TANG Libin2,3,HAO Qun1,WANG Shanli2,ZHUANG Jisheng2,KONG Jincheng2,ZUO Wenbin2,3,JI Rongbin2
(1.,,100081,;2.,650223,;3,650223,)
The HgCdTe multilayer heterojunction technology is an important direction for the development of mainstream infrared detectors in the future, playing an important role in high-performance infrared detectors, such as high operating temperature (HOT) detectors, dual/multicolor detectors, and avalanche photodiodes (APDs). Recently, HgCdTe HOT infrared detectors based on multilayer heterojunction technology have been developed, particularly devices based on the barrier and non-equilibrium operating P+-π(ν)-N+ structure have been widely studied. In this review, the dark current suppression mechanisms of P+-π(ν)-N+ structure HgCdTe infrared detectors with barrier and non-equilibrium operations were systematically introduced, the key problems that restrict the development of these two types of devices were analyzed, and the relevant research progress was reviewed. We summarized and assessed the prospects of the development of multilayer heterojunction HgCdTe infrared detectors.
HgCdTe, multilayer heterojunction, barrier, non-equilibrium operating, focal plane arrays device
TN304.054
A
1001-8891(2022)09-0889-15
2022-06-14;
2022-08-30.
陈正超(1987-),男,博士研究生,研究方向为光电探测材料与器件。
唐利斌(1978-),男,正高级工程师,博士生导师,主要从事光电材料与器件的研究。E-mail: scitang@163.com。
郝 群(1968-),女,教授,博士生导师,主要从事光学精密测试与计量。E-mail: qhao@bit.edu.cn。
国家重点研发计划(2019YFB2203404);云南省创新团队项目(2018HC020)。
