具有阻挡层的H 等离子体处理增强型p-GaN栅AlGaN/GaN HEMT 研究*
2022-06-04黄兴杰邢艳辉于国浩宋亮黄荣黄增立韩军张宝顺范亚明3
黄兴杰 邢艳辉† 于国浩 宋亮 黄荣 黄增立 韩军 张宝顺‡ 范亚明3)
1) (北京工业大学信息学部,光电子技术教育部重点实验室,北京 100124)
2) (中国科学院苏州纳米技术与纳米仿生研究所,纳米器件与应用重点实验室,苏州 215123)
3) (江西省纳米技术研究院,纳米器件与工艺研究部暨南昌市先进封测重点实验室,南昌 330200)
采用H 等离子体处理p-GaN 盖帽层来制备p-GaN 栅AlGaN/GaN 高电子迁移率晶体管(HEMT).在p-GaN层表面上先沉积2 nm 的Al2O3 薄膜,以减少H 等离子体注入p-GaN 时对表面造成的损伤.经研究表明沉积Al2O3 阻挡层的器件栅极反向泄漏电流降低了一个数量级,开关比提高了约3 倍.由于栅极泄露电流的减小,关态击穿电压从410 V 提高到780 V.针对栅极反向泄漏减小的现象,进行了变温IG-VG 测试,验证了栅极反向泄漏电流的主导机制是二维变程跳跃(Two-dimensional variable range hopping,2D-VRH)模型.分析了减小栅极反向电流的原因是由于Al2O3 阻挡层改变了HR-GaN 的表面态,使陷阱能级的活化能升高.此外,器件动态特性也表现出更稳定的趋势,这是Al2O3 薄膜阻挡过多的H 等离子体的注入,使AlGaN 势垒和沟道陷阱态数量减少,电流崩塌效应减弱.
1 引言
近年来,GaN 半导体材料在高迁移率、高击穿电压、低导通电阻、低功耗方面都体现了巨大的潜力,在微电子领域占据了非常重要的地位.由于AlGaN/GaN 异质结材料具有极强的极化效应,采用AlGaN/GaN 异质结构制备的高电子迁移率晶体管(HEMT)器件,在材料交界面产生了高密度的二维电子气(2-DEG),同时,异质结在交界面产生的量子阱结构也提供了高电子迁移率通道[1−3].传统AlGaN/GaN HEMT 为耗尽型器件,而功率器件需要采用增强型器件,且GaN 单芯片集成也需要增强型器件和耗尽型器件结合组成逻辑电路,因此增强型AlGaN/GaN HEMT 的研究越来越受到重视[4].制备增强型AlGaN/GaN HEMT 的方法主要有p-GaN 栅结构[5,6]、在栅下注入F 离子[7,8]和凹槽栅结构[9].其中p-GaN 栅结构对阈值电压的控制更为精确,其原理是利用栅下的p-n 结的内置电场将GaN 导带提高到费米能级以上,阻断栅下二维电子气通道[10−12].通过在AlGaN 势垒层上生长较薄的p-GaN 层,然后选择性刻蚀栅源和栅漏之间的p-GaN 层来制备p-GaN 栅结构[13].在刻蚀工艺中,无论是残余的p-GaN 层或者过度刻蚀的情况都可能会对二维电子气通道产生严重影响.为避免上述情况的发生,2016 年Hao 等[14,15]以空穴补偿机制为理论基础采用H 等离子体处理p-GaN 层,使p-GaN 层转变为高阻的GaN 盖帽层(HRCL-GaN),成功制备出了p-GaN 栅HRCLHEMT.并且研究发现随着H 等离子体注入功率的增大,栅极反向泄漏电流也随之增大[16,17].而栅极反向泄漏电流的增大会引发器件关态性能下降和引起可靠性问题[17,18].2018 年Xu 等[19]研究发现HRCL-HEMT 器件的栅极反向泄漏电流传输机制主要是二维变程跳跃(Two-dimensional variable range hopping,2D-VRH)模型,并且栅极反向泄漏电流的途径主要在p-GaN 层的表面.由此推测p-GaN 层表面可能受到了严重的H 等离子体注入损伤,并且注入损伤随着H 等离子体的注入功率增大而增大.
因此,本文采用等离子体增强原子层沉积(PEALD)技术在p-GaN 表面沉积2 nm 的Al2O3薄膜作为H 等离子处理p-GaN 的保护层.由此使栅极反向泄漏电流减小了一个数量级,关态击穿电压从410 V 增至780 V.此外,器件的动态特性也表现出更稳定的趋势.
2 器件制备
图1 所示为本实验所制备器件的横截面示意图,器件的外延结构是利用金属有机化合物化学气相沉积(MOCVD)生长在2-inch p-Si(111)衬底上,由下到上层次结构依次为GaN/AlN/AlGaN/p-GaN(4.35 µm/1 nm/18 nm/70 nm).采用F 离子注入进行台面隔离,然后电子束蒸发沉积厚度依次为20/30/50/150 nm 的Ti/Al/Ni/Au 作为漏源电极,接着在氮气氛围下经875 ℃退火30 s 形成欧姆接触,然后沉积厚度依次为50/150 nm 的Ni/Au 作为栅极金属.器件栅源之间的距离(LGS)为4 µm,栅漏之间的距离(LGD)为7 µm,栅长(LG)为4 µm,栅宽(WG)为100 µm.H 等离子体处理过程采用自对准工艺,设备采用Oxford Plasmalab System 100 ICP 180,电感耦合等离子体机ICP功率为300 W,RF 功率为2 W,腔内压强为8 mTorr(1 mTorr=100 Pa).器件A 沉积栅极金属之后进行原位H 等离子体处理,器件B 先沉积2 nm Al2O3薄膜,然后再经H 等离子体处理.接着两个样品均在350 °C 退火5 min 来修复等离子体损伤.

图1 器件横截面示意图 (a)器件A;(b)器件BFig.1.Diagram of depicts schematic cross-sections of the devices:(a) Device A;(b) device B.
3 结果和讨论
图2(a)显示了所制备器件的转移特性.测试时,源极接地.当漏极电流(ID)为10 µA/mm 时,器件A 和器件B 的阈值电压(VTH)均为1.42 V.当(VG)为8 V 时,器件A 和器件B 的最大漏极饱和电流(IDmax)分别为313 mA/mm 和345 mA/mm.在漏极电压(VD)为10 V,栅极电压(VG)为–3 V下,器件A 和B 的栅极反向泄漏电流分别为IG=1.92×10−4mA/mm,IG= 2.26×10−5mA/mm,由此看出器件B 的栅极反向泄漏电流比器件A 的降低了一个数量级.器件B 的开关比(VG=–3 V,IOFF= 5.93×10−5mA/mm,IDmax/IOFF=5.82×106mA/mm)比器件A 的(VG=–3 V,IOFF=2.13×10−4mA/mm,IDmax/IOFF= 1.46×106mA/mm)提高了约3 倍.由此看出Al2O3阻挡层不仅使栅极反向电流降低了一个数量级,同时使关态漏极电流下降,因此器件B 的开关比增大.这说明Al2O3阻挡层起到降低p-GaN 表面损伤的作用.图2(b)显示了器件的输出特性,当VG为8 V,VD为1 V 时,从输出特性曲线中提取器件A 和器件B 的导通电阻RON分别为14.1 Ω·mm 和12.5 Ω·mm.沟道界面态对器件的导通电阻和漏极饱和电流产生影响,器件B 的导通电阻减小和漏极饱和电流增大可能是Al2O3阻挡层阻止了部分H 等离子体进入2-DEG 沟道,使沟道界面受到的损伤减少.

图2 器件的I-V 特性 (a)器件的转移特性;(b) 器件的输出特征Fig.2.I-V characteristics of all devices:(a) Transfer characteristics;(b) output characteristics.
为了研究Al2O3阻挡层对器件的影响,对器件进行了变温IG-VG测试,测试温度为323—498 K,每次升高25 K,源极电压接地,漏极电压设置为0 V.测试结果如图3 所示,器件A 和器件B 的栅极反向泄漏电流都随着温度的升高而升高.当温度高达498 K,VG为–10 V 时,器件A 的栅极泄漏电流达到 1.74×10−5A/mm,器件B 的栅极泄漏电流为 7.38×10−6A/mm.由此看出,在相同温度下,器件B 的栅极反向泄漏电流明显小于器件A 的栅极反向泄露电流.考虑H 等离子体制备的p-GaN 栅HEMT 主要的栅极反向泄漏电流机制主要为2DVRH 模型[19],因此使用2D-VRH 漏电模型进行计算.2D-VRH 的数学模型表示为σ ∝exp[−(T0/T)1/3],T0是特征温度,σ为电导率,其计算公式为σ=I/V,T的温度范围为323—498 K.图4(a)和4(b)是实验数据通过2D-VRH 模型计算得到的 l nσ与(1000/T)1/3的函数关系结果,可以看出在不同反向栅压下,对于器件A 和器件B 的 l nσ与(1000/T)1/3成线性比例,这表明了2D-VRH 漏电模型是器件A 和器件B 反向栅极泄漏电流的主要漏电机理.图4(c)和4(d)分别是器件A 和器件B 的实验数据根据Arrhenius 方程[20]绘制的对数坐标下栅极反向泄漏电流电导率和温度的关系图,根据直线的斜率可以计算陷阱能级的活化能.由此提取得到器件A 和B 中的表面缺陷能级活化能如表1 所示,从表中看到,栅极电压从–1 V 变化到–10 V,器件表面的缺陷能级活化能随着栅极反向电压的增大而减小,说明除了热激发以外,电场也可以提供能量辅助电子从HR-GaN 层的表面陷阱能级间跃迁[21].从表1 还可以看出,在不同栅极反向电压下器件A 的缺陷能级活化能(Ea)要明显小于器件B 的缺陷能级活化能,这说明Al2O3薄膜阻挡层确实有效地改变了HR-GaN 的表面状态,降低了HR-GaN表面缺陷能级捕获和释放电子的能力,加大了电子在HR-GaN 表面缺陷能级间跃迁的难度,提高了表面漏电通道的开启门槛,因此器件表面的泄露电流减小,器件B 栅极反向电流下降了一个数量级.

图3 变温IG-VG 特性 (a)器件A;(b)器件BFig.3.Temperature dependent IG-VG characteristics :(a) Device A;(b) device B.

图4 (a)从–1—–10 V 器件A 的 l nσ 与 (1000/T)1/3 的函数关系;(b)从–1 V—–10 V 器件B 的 l nσ 与 (1000/T)1/3 的函数关系;(c)从–1—–10 V 器件A 的 l nσ 与 1 000/T 的函数关系;(d)从–1—–10 V 器件B 的 l nσ 与 1 000/T 的函数关系;点是实验值,直线是拟合值Fig.4.(a) l nσ of device A at VG from–1 V to–10 V as a function of (1/T)1/3 ;(b) l nσ of device B at VG from–1 V to–10 V as a function of (1/T)1/3 ;(c) l nσ of device A at VG from–1 V to–10 V as a function of 1 000/T ;(d) l nσ of device B at VG from–1 V to–10 V as a function of 1 000/T ;the point is experimental value and the fitted value is a straight line.

表1 在不同栅极电压下表面缺陷能级EaTable 1.Surface defect level Ea at different gate voltages.
器件的栅极反向漏电特性与器件的关态击穿特性息息相关,由于器件处于关态下,栅极电流是漏极电流组成部分,而栅极电流的突然增大会造成器件关态击穿[22].器件的关态击穿特性如图5(a)所示,在漏极电流为10 µA/mm 时,器件A 和B的关态击穿电压分别为410 V 和780 V,由此看出采用Al2O3阻挡层的器件B 关态击穿电压明显提高,器件B 比A 的关态击穿电压提高了90.24%,器件B 击穿电压的提高主要归因于Al2O3阻挡层使栅极关态电流明显降低,栅极关态电流降低的原因与栅极反向电流的原因一致,都是由于器件表面泄漏电流减小.图5(b)所示为器件电流崩塌对比的结果,采用Agilent B1505A N1267A 动态测量系统对器件的电流崩塌进行评估.测试条件设置与课题组之前的报道相同[23],开态下设置为VG=6 V 和VD=0.5 V,源极和衬底接地.关态下设置为VG为0 V,VD从1 V 变化到400 V,应力时间为10 ms,从关态切换到开态时间为200 µs,每隔100 V 测量一次动态电阻RON.从图中可以看出,当偏压在400 V 时,器件A 和B 的崩塌因子分别为1.49 和1.45,器件B 较器件A 的崩塌因子减小了2.6%,即表明其电流崩塌效应有所减轻.多数研究认为,AlGaN/GaN 型HEMT 电流崩塌与AlGaN势垒层中陷阱态有关[24,25].器件B 电流崩塌效应减轻即表明Al2O3阻挡层不仅使HR-GaN 的表面缺陷能级的活化能增大,也可能使HR-GaN/AlGaN势垒层中缺陷态数量减少,同时可能影响到AlGaN/GaN 异质结界面,使漏极饱和电流增大和导通电阻下降.计算了器件A 和器件B 的比导通电阻RON,SP分别为2.23 mΩ·cm2和1.97 mΩ·cm2,同时比较了文献[2,14,16,26−29]中p-GaN 栅HEMT器件的关态击穿电压,其中器件B 的器件性能在同类器件中也处于较高水平.为了进一步探究其作用机理,对器件进行了纵向元素分布二次离子质谱(SIMS)检测,如图5(c)所示,从图5(c)可以看出,通过器件A 和器件B 与未经过H 等离子体处理的器件相比,H 等离子体处理功率为2 W 的时候注入深度在90 nm 左右,注入深度已经达到AlGaN势垒层,在AlGaN 势垒中,器件A 的H 元素含量明显高于器件B 的H 元素含量,说明Al2O3薄膜起到了阻挡作用.由于到达AlGaN 层H 等离子体的减少,注入损伤所产生的缺陷也将减少,因此器件B 的电流崩塌效应有所削弱.图6 是H 等离子体注入过程以及2D-VRH 机制示意,从图6(a)可以看出,器件A 在H 等离子体在注入开始时,H等离子体率先破坏了p-GaN 表面的晶格结构,在p-GaN 表面形成了大量的晶格缺陷,这些缺陷会导致器件形成以2D-VRH 漏电机制为主的表面漏电通道,随着注入时间延长,越来越多H 等离子体到达AlGaN 势垒层和沟道层,势垒层和沟道界面附近也产生了越来越多具有类似于施主作用的缺陷态,缺陷态在电应力的作用下捕获沟道中的电子,在快速切换的情况下这些被捕获的电子来不及释放,导致电流崩塌效应的产生.而对于器件B,如图6(b)所示,当在p-GaN 表面沉积Al2O3薄膜再经H 等离子体处理后,Al2O3薄膜减小了H 等离子体对p-GaN 表面造成的晶格损伤,改变了HR-GaN 的表面态,使缺陷态的活化能升高,表面泄露电流减小,其次在H 等离子体处理时阻挡了过多的H 等离子体进入AlGaN 势垒层和沟道界面,在势垒层和沟道界面附近造成的缺陷态数量也随之减少,使电流崩塌效应减弱了.

图5 (a)器件A 和器件B 的关态击穿电压对比;(b)器件A 和器件B 的电流崩塌对比;(c)纵向元素分布SIMS 测试结果Fig.5.(a) OFF-state breakdown characteristics of device A and device B with substrate grounded;(b) normalized dynamic RON with various values of OFF-state VDS stress from 1 V to 400 V of device A and device B;(c) vertical anatomy of H distribution.
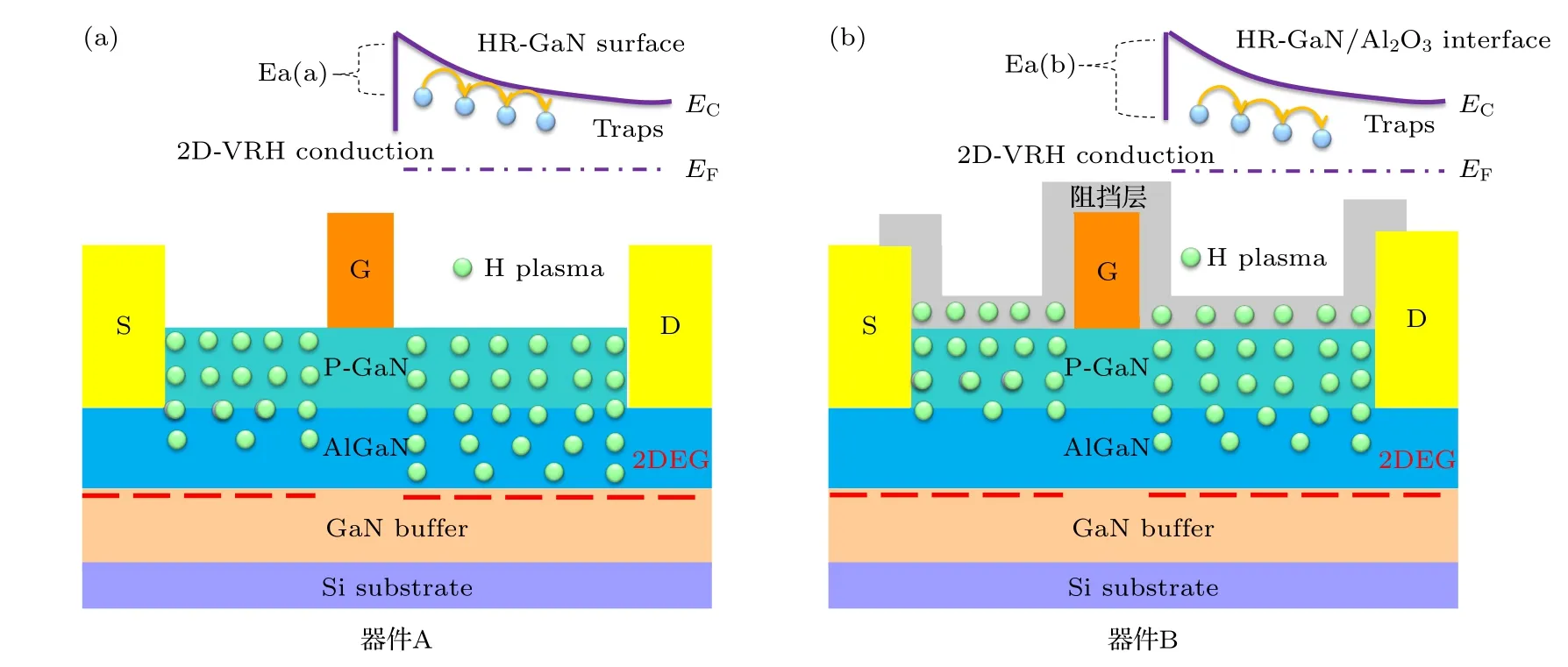
图6 器件2D-VRH 泄漏电流机制示意图和H 等离子注入示意图 (a)器件A;(b)器件BFig.6.Schematic of the Two-dimensional variable range hopping (2D-VRH) model for devices,and Hydrogen plasma treatment for(a) device A and (b) device B.
4 结论
本文采用H 等离子体处理p-GaN 盖帽层来制备的p-GaN 栅AlGaN/GaN 高电子迁移率晶体管(HEMT).利用了PEALD 在p-GaN 层上沉积2 nm Al2O3阻挡层,增大了p-GaN 表面陷阱态的活化能,减少了p-GaN 表面由于H 等离子体注入带来的损伤,因此栅极反向泄漏电流降低了一个数量级.同时,随着栅极反向泄漏电流的减小,关态击穿电压提高了90.24%.此外,器件的电流崩塌效应也表现出更加稳定的趋势,通过SIMS 测试纵向H 分布剖析图证明了Al2O3薄膜对H 的阻挡作用,并且进一步分析了H 等离子体注入过程以及2D-VRH 机制得出了Al2O3阻挡层对器件性能改善的机理.
